混合鍵合(Hybrid Bonding)工藝介紹
簡(jiǎn)介:
所謂混合鍵合(hybrid bonding),指的是將兩片以上不相同的Wafer或Die通過(guò)金屬互連的混合鍵合工藝,來(lái)實(shí)現(xiàn)三維集成,在Hybrid Bonding前,2D,2.5D及3D封裝都是采用焊錫球凸點(diǎn)(solder bump)或微凸點(diǎn)(Micro bump)來(lái)實(shí)現(xiàn)芯片與基板,芯片與中介層(Interposer),芯片與芯片間的電連接。Solder bump/micro bump在制備工藝中都有植球的步驟,所植的球就是焊錫球(Solder bump),所以在Hybrid Bonding之前芯片間的連接都是靠焊錫球進(jìn)行連接。
當(dāng)然Solder bump是植在銅柱(Copper bump)上的。當(dāng)copper bump pitch小于10~20um時(shí),焊錫球solder bump就變成了工藝難點(diǎn)及缺陷的主要來(lái)源。這時(shí)候就需要一種新的工藝來(lái)解決bump間距小于10微米芯片間鍵合的問(wèn)題。

混合鍵合兩種常見的類型:
1.Wafer to Wafer (W2W)晶圓對(duì)晶圓:適合高良率的芯片,如CMOS、3D NAND。2.Die to Wafer (D2W) 芯片對(duì)晶圓:適合不同種類型芯片集成,如異構(gòu)集成。
W2W可以提供更高的對(duì)準(zhǔn)精度、吞吐量和鍵合良率。但一個(gè)主要限制是無(wú)法選擇已知的合格芯片(KGD)。這會(huì)導(dǎo)致將有缺陷的芯片粘合到好的芯片上,從而導(dǎo)致優(yōu)質(zhì)芯片的浪費(fèi)。W2W 的另一個(gè)缺點(diǎn)是兩片晶圓上芯片的尺寸必須一致,因此這限制了異構(gòu)集成選項(xiàng)的靈活性。所以,W2W適用于良率高的晶圓,通常是設(shè)計(jì)尺寸較小芯片,如CMOS 圖像傳感器、3D NAND。
D2W允許將不同尺寸、工藝節(jié)點(diǎn)的芯片(如邏輯芯片與存儲(chǔ)芯片)選擇性集成到同一晶圓上,從而支持異構(gòu)集成和定制化設(shè)計(jì),避免了W2W因整片晶圓鍵合導(dǎo)致的良率損失問(wèn)題(例如一片晶圓存在缺陷時(shí),僅影響單個(gè)芯片而非整片)。此外,D2W可通過(guò)分步測(cè)試篩選合格芯片(KGD)再進(jìn)行鍵合,降低了整體成本。
這種特性使其在先進(jìn)封裝(如3D堆疊)中更具適應(yīng)性,尤其適用于需要整合多來(lái)源芯片的高性能計(jì)算場(chǎng)景。然而,D2W混合鍵合的技術(shù)實(shí)現(xiàn)難度更高,主要體現(xiàn)在亞微米級(jí)對(duì)準(zhǔn)精度和界面共面性控制兩大挑戰(zhàn)。
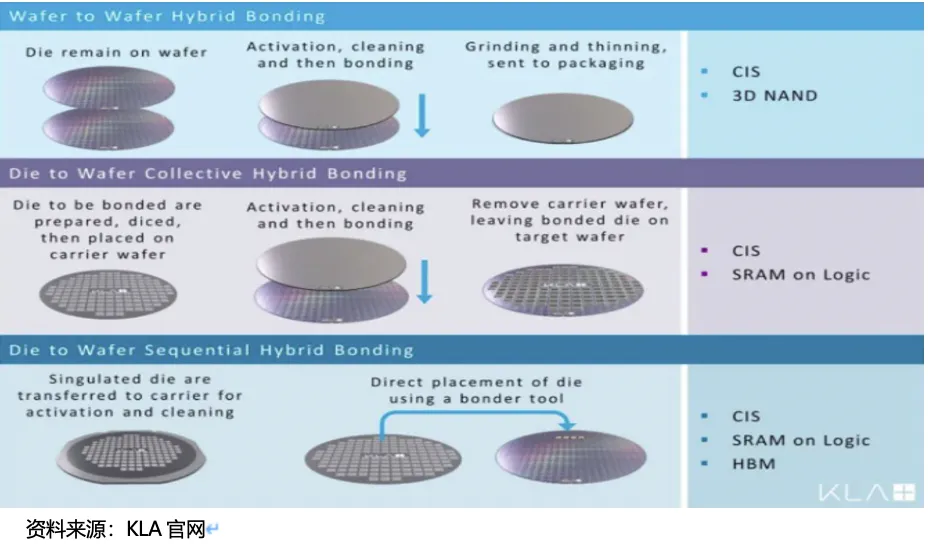
工藝流程:
混合鍵合結(jié)合了兩種不同的鍵合技術(shù):介電鍵合和金屬互連。一般采用介電材料(通常是SiO?)與嵌入式銅(Cu)焊盤結(jié)合,通過(guò)形成電介質(zhì)鍵(dielectric bond)和金屬鍵(metal bond)實(shí)現(xiàn)兩個(gè)晶圓(wafers)或裸片(dies)之間建立永久電連接,而無(wú)需焊料凸塊。這種無(wú)凸塊方法通過(guò)減少信號(hào)損耗和改善熱管理來(lái)提高電氣性能 。
一.表面準(zhǔn)備:晶圓需經(jīng)過(guò)化學(xué)機(jī)械拋光/平坦化(CMP)和表面活化及清洗處理。混合鍵合層的表面光滑度非常關(guān)鍵。Hybrid Bonding界面處對(duì)任何類型的凹凸都可能會(huì)產(chǎn)生空洞和無(wú)效的鍵合,通常需要確保表面粗糙度(Ra)低于0.5nm。,銅焊盤為1nm。為了達(dá)到這種平滑度,需要進(jìn)行化學(xué)機(jī)械平坦化(CMP)。
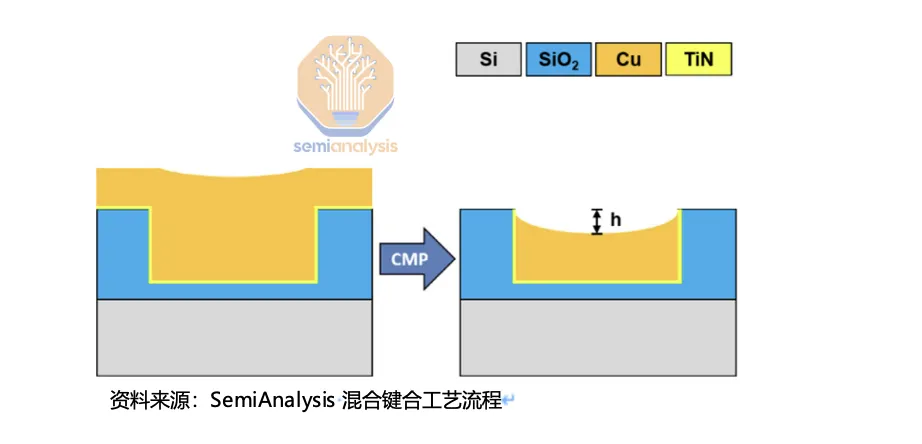
CMP完成后,還需要進(jìn)行表面活化(Activation)等離子體處理:對(duì)SiO?表面進(jìn)行Ar、N?或O?等離子體處理,增加表面羥基(-OH)密度,增強(qiáng)親水性。銅表面可能需還原性等離子體(如H?)去除氧化層。
二.對(duì)位:晶圓或芯片的對(duì)準(zhǔn)需要在潔凈室(Class 1-10)中進(jìn)行,避免顆粒污染。經(jīng)過(guò)精確對(duì)準(zhǔn),以確保金屬焊盤正確對(duì)應(yīng),從而實(shí)現(xiàn)有效的電氣互連。

需要注意的是:由于鍵合過(guò)程涉及兩個(gè)非常光滑且平坦的表面齊平地鍵合在一起,因此鍵合界面對(duì)任何顆粒的存在都非常敏感;高度僅為1 微米的顆粒會(huì)導(dǎo)致直徑為10 毫米的粘合空隙,從而導(dǎo)致鍵合缺陷。
三.預(yù)鍵合:經(jīng)過(guò)對(duì)位之后晶圓或芯片間僅形成初始電介質(zhì)鍵,此時(shí)只是通過(guò)范德華力結(jié)合在一起,還需要在室溫或略高的溫度、在N?或真空環(huán)境下,配合一定的壓力,通過(guò)原子擴(kuò)散和機(jī)械互鎖形成牢固的鍵合。
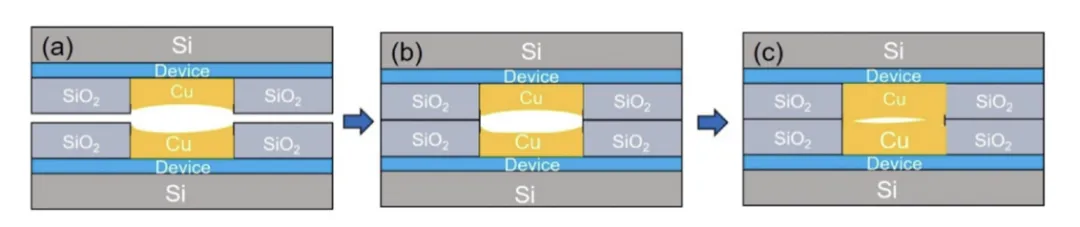
南京屹立芯創(chuàng)擁有多項(xiàng)創(chuàng)新發(fā)明專利技術(shù),設(shè)備可以通過(guò)在真空和升溫環(huán)境中對(duì)晶圓與芯片施加穩(wěn)定、均勻的壓力,讓芯片與晶圓之間更平坦化,實(shí)現(xiàn)晶圓或芯片間穩(wěn)定鍵合。
南京屹立芯創(chuàng)有著豐富的經(jīng)驗(yàn)和解決方式,致力于提高客戶產(chǎn)品的質(zhì)量及可靠度。公司的產(chǎn)品廣泛應(yīng)用于半導(dǎo)體封裝,電子組裝,5G通訊,新能源應(yīng)用,車用零件,航天模塊,生化檢測(cè)等各大科技領(lǐng)域。

四.鍵合后處理:初始鍵合后,還需要通過(guò)額外的熱處理來(lái)進(jìn)一步促進(jìn)銅向介電層擴(kuò)散,確保穩(wěn)固的互連,以此來(lái)增強(qiáng)鍵合強(qiáng)度和電氣性能。
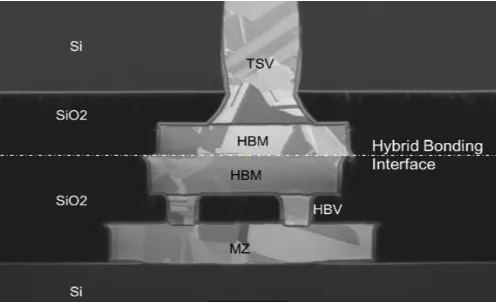
混合鍵合應(yīng)用:
混合鍵合用于芯片的垂直(或3D)堆疊。混合鍵合的顯著特點(diǎn)是無(wú)凹凸。它從基于焊接的凸塊技術(shù)轉(zhuǎn)向直接的銅對(duì)銅連接。這意味著頂模和底模彼此齊平。兩個(gè)芯片都沒(méi)有凸塊,只有可以縮放到超細(xì)間距的銅焊盤。沒(méi)有焊料,因此避免了與焊料相關(guān)的問(wèn)題。同時(shí)混合鍵合在電學(xué)性能方面也有獨(dú)特的優(yōu)勢(shì),Hybrid Bonding信號(hào)丟失率幾乎可以忽略不計(jì),這在高吞吐量,高性能計(jì)算領(lǐng)域優(yōu)勢(shì)明顯。
目前常見的應(yīng)用場(chǎng)景:
1.3D芯片堆疊:混合鍵合被廣泛應(yīng)用于處理器和內(nèi)存堆棧中,例如AMD的3D V-Cache技術(shù)和HBM高帶寬內(nèi)存的多層堆疊。通過(guò)混合鍵合,可以將CPU與額外緩存芯片緊密連接在一起,顯著提升系統(tǒng)性能;同時(shí),在圖形處理單元(GPU)和高性能計(jì)算領(lǐng)域,將內(nèi)存芯片直接堆疊到邏輯芯片上,極大地提高了數(shù)據(jù)帶寬和訪問(wèn)效率。

2.異構(gòu)集成:混合鍵合技術(shù)也促進(jìn)了異構(gòu)系統(tǒng)的集成,使得各種不同工藝節(jié)點(diǎn)制造的芯片可以有效地結(jié)合在一起,形成一個(gè)單一的高性能封裝體。例如,將射頻芯片、傳感器、處理器等多種類型的芯片整合在同一封裝內(nèi),優(yōu)化了物聯(lián)網(wǎng)設(shè)備、智能手機(jī)和其他智能硬件的空間利用和整體性能。
3.圖像傳感器:混合鍵合在CMOS圖像傳感器(CIS)領(lǐng)域也有重要應(yīng)用,如背照式(BSI)傳感器和堆疊式傳感器等,其中底層的像素陣列通過(guò)混合鍵合技術(shù)與頂層的電路層相連,降低了光路損失并實(shí)現(xiàn)了更小型化的相機(jī)模組設(shè)計(jì)。
總結(jié):
混合鍵合作為先進(jìn)封裝技術(shù)的核心組成部分,正逐漸成為推動(dòng)半導(dǎo)體行業(yè)向三維集成發(fā)展的重要驅(qū)動(dòng)力。從市場(chǎng)規(guī)模來(lái)看,當(dāng)前火爆的AI算力需求,推動(dòng)混合鍵合技術(shù)市場(chǎng)正以顯著增速擴(kuò)張,其在高密度集成、低功耗傳輸上的優(yōu)勢(shì)使其成為3D封裝的關(guān)鍵技術(shù)。
文章中圖片引用請(qǐng)參考出處標(biāo)注
審核編輯 黃宇
-
半導(dǎo)體
+關(guān)注
關(guān)注
339文章
30725瀏覽量
264011 -
先進(jìn)封裝
+關(guān)注
關(guān)注
2文章
533瀏覽量
1026
發(fā)布評(píng)論請(qǐng)先 登錄
NTC熱敏芯片鍵合工藝介紹
熱壓鍵合工藝的技術(shù)原理和流程詳解

半導(dǎo)體封裝“焊線鍵合(Wire Bonding)”線弧相關(guān)培訓(xùn)的詳解;

半導(dǎo)體“楔形鍵合(Wedge Bonding)”工藝技術(shù)的詳解;

氧濃度監(jiān)控在熱壓鍵合(TCB)工藝過(guò)程中的重要性

半導(dǎo)體后道制程“芯片鍵合(Die Bonding)”工藝技術(shù)的詳解;

詳解先進(jìn)封裝中的混合鍵合技術(shù)

3D集成賽道加速!混合鍵合技術(shù)開啟晶體管萬(wàn)億時(shí)代
LG電子重兵布局混合鍵合設(shè)備研發(fā),鎖定2028年大規(guī)模量產(chǎn)目標(biāo)
混合鍵合市場(chǎng)空間巨大,這些設(shè)備有機(jī)會(huì)迎來(lái)爆發(fā)
先進(jìn)封裝爆發(fā),但TC Bonding讓Hybrid Bonding推遲進(jìn)入市場(chǎng)
芯片封裝鍵合技術(shù)工藝流程以及優(yōu)缺點(diǎn)介紹




 混合鍵合(Hybrid Bonding)工藝介紹
混合鍵合(Hybrid Bonding)工藝介紹







評(píng)論