在現(xiàn)代高科技產(chǎn)業(yè)如半導(dǎo)體和新能源領(lǐng)域,厚度低于一微米的薄膜被廣泛應(yīng)用,其厚度精確測量是確保器件性能和質(zhì)量控制的核心挑戰(zhàn)。面對超薄、多層、高精度和非破壞性的測量需求,傳統(tǒng)的接觸式或破壞性方法已難以勝任。Flexfilm全光譜橢偏儀可以非接觸對薄膜的厚度與折射率的高精度表征,廣泛應(yīng)用于薄膜材料、半導(dǎo)體和表面科學等領(lǐng)域。
為解決這一難題,以光譜反射法(SR)和光譜橢偏法(SE)為代表的非接觸光學測量技術(shù)成為主流解決方案。光譜反射法通過分析薄膜反射的干涉光譜實現(xiàn)快速、大范圍的厚度檢測;光譜橢偏法進一步利用偏振態(tài)變化,不僅能測量極薄薄膜,還能同步獲取材料的光學常數(shù)。本文將系統(tǒng)綜述這兩類技術(shù)的原理、發(fā)展和應(yīng)用,并探討其在未來精密制造領(lǐng)域向更高速度、更寬動態(tài)范圍和更可靠測量演進的關(guān)鍵路徑。
1
光譜反射法(SR)
flexfilm
光譜反射法通過將一束寬帶光(如白光)照射到薄膜樣品上,并收集其反射光譜來進行測量。光在薄膜的上下界面會發(fā)生多次反射和干涉,形成的干涉光譜中包含了薄膜厚度與光學常數(shù)的信息。
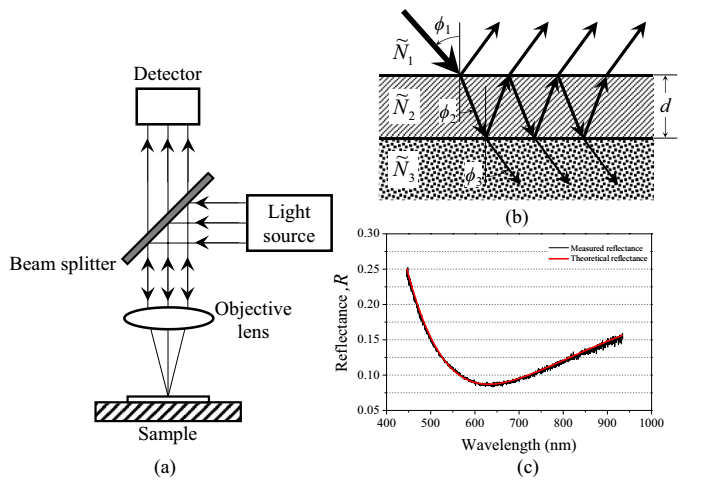
(a) 簡易反射儀的光學結(jié)構(gòu)示意圖(b) 單層薄膜結(jié)構(gòu)中兩個界面的反射與透射光路示意圖(c) 實測反射光譜與基于最小二乘法擬合的模型反射光譜對比圖
基本模型與厚度提取:
對于最簡單的單層膜結(jié)構(gòu)(空氣/薄膜/襯底),總反射率可通過菲涅爾公式和干涉項進行計算。

菲涅爾公式
測量時,已知(或預(yù)先標定)薄膜與襯底的光學常數(shù)(折射率、消光系數(shù))及入射角,通過將實測反射光譜與不同厚度下的理論模型光譜進行匹配(通常采用最小二乘法),即可反演出最匹配的薄膜厚度。

高數(shù)值孔徑物鏡中入射角對理論反射光譜建模的影響示意圖
技術(shù)演進與挑戰(zhàn):
模型精化: 早期模型常忽略材料的吸收。對于吸收不可忽略的材料,需采用復(fù)折射率來建立更精確的模型。此外,當使用高數(shù)值孔徑物鏡時,入射光包含一個角度范圍,需引入“有效入射角”概念來修正模型。
分析效率: 傳統(tǒng)的全光譜擬合計算量較大。為提高速度,研究提出了多種優(yōu)化算法,例如利用反射光譜的極值位置或光譜相位信息來快速估算厚度初值,再進行精修。
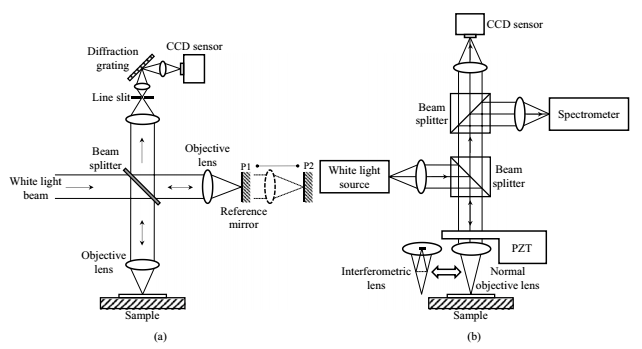
(a) 集反射法與干涉法兩種測量模式于一體的光學結(jié)構(gòu)示意圖(b) 光譜分辨白光干涉測量法的光學結(jié)構(gòu)示意圖
集成測量: 將SR與干涉測量技術(shù)結(jié)合,可實現(xiàn)對薄膜厚度與表面三維形貌的同步測量。通過巧妙的信號分離技術(shù)(如頻域分離),從同一組數(shù)據(jù)中提取出不同信息。

基于人工神經(jīng)網(wǎng)絡(luò)算法的薄膜厚度分析流程示意圖(a) 訓練階段(b) 訓練完成的網(wǎng)絡(luò)預(yù)測階段
人工智能的引入:
為應(yīng)對復(fù)雜模型擬合耗時、對初始值敏感等問題,人工神經(jīng)網(wǎng)絡(luò)(ANN)等AI方法被應(yīng)用于SR數(shù)據(jù)分析。通常使用大量基于理論模型生成的光譜-厚度數(shù)據(jù)對來訓練神經(jīng)網(wǎng)絡(luò)。訓練完成后,網(wǎng)絡(luò)可直接、快速地從實測光譜預(yù)測出厚度。然而,AI模型的可靠性驗證是關(guān)鍵,研究提出了利用有證標準物質(zhì)來評估其在實際測量環(huán)境中性能的方法。
多層膜測量與可靠性:
測量多層薄膜結(jié)構(gòu)中每一層的厚度更具挑戰(zhàn)性。研究基于傳輸矩陣法建立多層膜反射模型,并結(jié)合優(yōu)化算法進行反演。為確保測量結(jié)果的可靠性,韓國標準科學研究院的研究者提出了一種創(chuàng)新方法:在沉積多層膜的同時,制備一系列已知結(jié)構(gòu)的輔助單層膜樣品,用以交叉驗證和評估整個測量系統(tǒng)的不確定度。
2
光譜橢偏法(SE)
flexfilm
橢偏法通過測量偏振光與樣品相互作用后,其偏振態(tài)的改變來表征樣品。它能同時測定薄膜的厚度和光學常數(shù)(復(fù)折射率 n 和 k),對超薄膜(可達亞納米級)極為敏感。

橢偏儀的基本組成元件與光路布局示意圖
系統(tǒng)構(gòu)成與分類:
一臺典型橢偏儀的核心組件包括:光源、偏振態(tài)發(fā)生器、樣品臺、偏振態(tài)分析器和探測器。根據(jù)這些組件中可動元件(如偏振片、補償器)的類型和工作方式,橢偏儀主要分為五類:
單波長橢偏儀: 使用激光光源,結(jié)構(gòu)簡單。
光譜橢偏儀: 使用寬帶光源和光譜儀,可獲取隨波長變化的光學信息,應(yīng)用最廣。
旋轉(zhuǎn)元件橢偏儀: PSG或PSA中的元件(如偏振片)勻速旋轉(zhuǎn),通過分析探測器信號的諧波成分來提取數(shù)據(jù)。
零值橢偏儀: 通過調(diào)整偏振元件方位角使檢測信號歸零,常用于成像橢偏儀。
相位調(diào)制橢偏儀: 使用光彈性調(diào)制器等元件,測量速度極快。
其中,旋轉(zhuǎn)元件光譜橢偏儀(RE-SE)因其良好的性能平衡,在工業(yè)在線檢測和科研中應(yīng)用最為廣泛。
測量原理與數(shù)據(jù)分析:
橢偏測量的核心輸出是橢偏傳輸量(ETQ),用于描述偏振態(tài)的變化。對于各向同性樣品,最常用的ETQ是Ψ和Δ兩個角度,它們與樣品的光學參數(shù)和厚度通過復(fù)雜的物理模型相關(guān)聯(lián)。

RE-SE記錄隨旋轉(zhuǎn)元件角度變化的探測器信號

傅里葉分析提取諧波系數(shù)
測量時,RE-SE記錄隨旋轉(zhuǎn)元件角度變化的探測器信號,通過傅里葉分析提取諧波系數(shù),最終計算出ETQ。

ETQ
為了從測得的ETQ光譜(Ψ(λ), Δ(λ))反演出樣品的厚度和光學常數(shù),需要構(gòu)建精確的光學分析模型,并采用非線性最小二乘法進行擬合,尋找使理論ETQ與實測ETQ差異最小的參數(shù)解。

非線性最小二乘法
不確定度評估:
橢偏測量的可靠性依賴于嚴格的不確定度評估。其不確定度主要來源于兩部分:
ETQ測量值本身的不確定度(由儀器噪聲、元件校準誤差等引起)。
通過擬合分析得到樣品參數(shù)(厚度、折射率)時,由擬合過程引入的不確定度。
傳統(tǒng)方法在評估后者,尤其是針對復(fù)雜的光譜數(shù)據(jù)時存在局限。近期研究引入了基于隱函數(shù)定理的不確定度評估方法,能夠更完備地考量所有潛在誤差源的傳播效應(yīng),從而更可靠地評估測量結(jié)果的置信區(qū)間。
3
技術(shù)對比與發(fā)展趨勢
flexfilm
薄膜厚度測量是支撐現(xiàn)代精密制造的核心計量技術(shù)之一。本文詳細綜述了兩種主流的光學非接觸測量方法:光譜反射法和橢偏法。
光譜反射法原理直觀,系統(tǒng)相對簡單,通過與干涉等技術(shù)融合,功能不斷拓展,AI的引入顯著提升了其分析效率。
橢偏法信息量豐富,測量精度高,尤其擅長超薄膜與復(fù)雜光學常數(shù)的表征,其不確定度評估方法日趨完善。
兩類技術(shù)各有側(cè)重,并在不同應(yīng)用場景下衍生出多種變體。
光譜反射法與光譜橢偏法是薄膜厚度光學測量的兩大支柱。光譜反射法SR在工程應(yīng)用和集成測量方面展現(xiàn)出靈活性,而光譜橢偏法SE在極限精度和材料表征深度上具有不可替代的優(yōu)勢。未來,隨著器件尺寸不斷縮小和新型材料涌現(xiàn),對測量技術(shù)提出了“更快、更準、更廣、更可靠”的終極要求。兩大技術(shù)路徑將在自身優(yōu)化(如算法、校準)與相互融合(如橢偏成像、集成式多技術(shù)傳感器)中持續(xù)演進,共同支撐前沿制造業(yè)的精密計量需求。
Flexfilm全光譜橢偏儀
flexfilm

全光譜橢偏儀擁有高靈敏度探測單元和光譜橢偏儀分析軟件,專門用于測量和分析光伏領(lǐng)域中單層或多層納米薄膜的層構(gòu)參數(shù)(如厚度)和物理參數(shù)(如折射率n、消光系數(shù)k)
- 先進的旋轉(zhuǎn)補償器測量技術(shù):無測量死角問題。
- 粗糙絨面納米薄膜的高靈敏測量:先進的光能量增強技術(shù),高信噪比的探測技術(shù)。
- 秒級的全光譜測量速度:全光譜測量典型5-10秒。
- 原子層量級的檢測靈敏度:測量精度可達0.05nm。
Flexfilm全光譜橢偏儀能非破壞、非接觸地原位精確測量超薄圖案化薄膜的厚度、折射率,結(jié)合費曼儀器全流程薄膜測量技術(shù),助力半導(dǎo)體薄膜材料領(lǐng)域的高質(zhì)量發(fā)展。
#光譜橢偏法#光譜反射法#SE#SR
原文參考:《A Review ofThin?flm Thickness Measurements using Optical Methods》
*特別聲明:本公眾號所發(fā)布的原創(chuàng)及轉(zhuǎn)載文章,僅用于學術(shù)分享和傳遞行業(yè)相關(guān)信息。未經(jīng)授權(quán),不得抄襲、篡改、引用、轉(zhuǎn)載等侵犯本公眾號相關(guān)權(quán)益的行為。內(nèi)容僅供參考,如涉及版權(quán)問題,敬請聯(lián)系,我們將在第一時間核實并處理。
-
光學
+關(guān)注
關(guān)注
4文章
877瀏覽量
38186 -
測量
+關(guān)注
關(guān)注
10文章
5673瀏覽量
116856 -
光譜
+關(guān)注
關(guān)注
4文章
1047瀏覽量
37340
發(fā)布評論請先 登錄
VirtualLab Fusion應(yīng)用:氧化硅膜層的可變角橢圓偏振光譜(VASE)分析
VirtualLab Fusion應(yīng)用:氧化硅膜層的可變角橢圓偏振光譜(VASE)分析
芯片制造中的膜厚檢測 | 多層膜厚及表面輪廓的高精度測量

大面積薄膜光學映射與成像技術(shù)綜述:全光譜橢偏技術(shù)

薄膜厚度測量技術(shù)的綜述:從光譜反射法(SR)到光譜橢偏儀(SE)

半導(dǎo)體膜厚測量丨光譜反射法基于直接相位提取的膜厚測量技術(shù)

橢偏儀在半導(dǎo)體薄膜厚度測量中的應(yīng)用:基于光譜干涉橢偏法研究

橢偏儀常見技術(shù)問題解答(二)

光譜橢偏儀入門指南:原理、方法與基礎(chǔ)應(yīng)用

基于橢偏光譜法研究不同基底對TiO?/SiO?薄膜光學常數(shù)的影響




 光學膜厚測量技術(shù)對比:光譜反射法vs橢偏法
光學膜厚測量技術(shù)對比:光譜反射法vs橢偏法




評論