在半導體芯片和光學元件加工等應用中,精確測量薄膜的厚度和折射率至關重要。光譜橢偏儀是一種被廣泛應用于測量薄膜厚度和折射率的儀器。大多數傳統橢偏儀(圖1a)利用機械旋轉偏振器和基于光柵的光譜儀進行光譜偏振檢測,從而導致系統相對復雜、體積龐大,并且單次測量耗時較長。
據麥姆斯咨詢報道,為了解決以上難題,清華大學精密儀器系楊原牧副教授研究團隊提出了一種基于超構表面(metasurface)陣列的緊湊型光譜橢圓偏振測量系統,該系統可實現單次曝光(single-shot)光譜偏振檢測和精確測定薄膜特性,而無需任何機械運動。具有高度各向異性和多樣化光譜響應的硅基超構表面陣列與迭代優化相結合,可高保真地重建薄膜反射光的全斯托克斯(Stokes)偏振光譜。隨后,薄膜厚度和折射率可通過將測量結果與適當的材料模型進行高精度擬合來確定。研究團隊所提出的方法為開發高通量測量薄膜特性的緊湊型、魯棒的光譜橢圓偏振系統開辟了一條新途徑。相關成果近日以“Metasurface array for single-shot spectroscopic ellipsometry”為題發表于Light: Science & Applications期刊上。
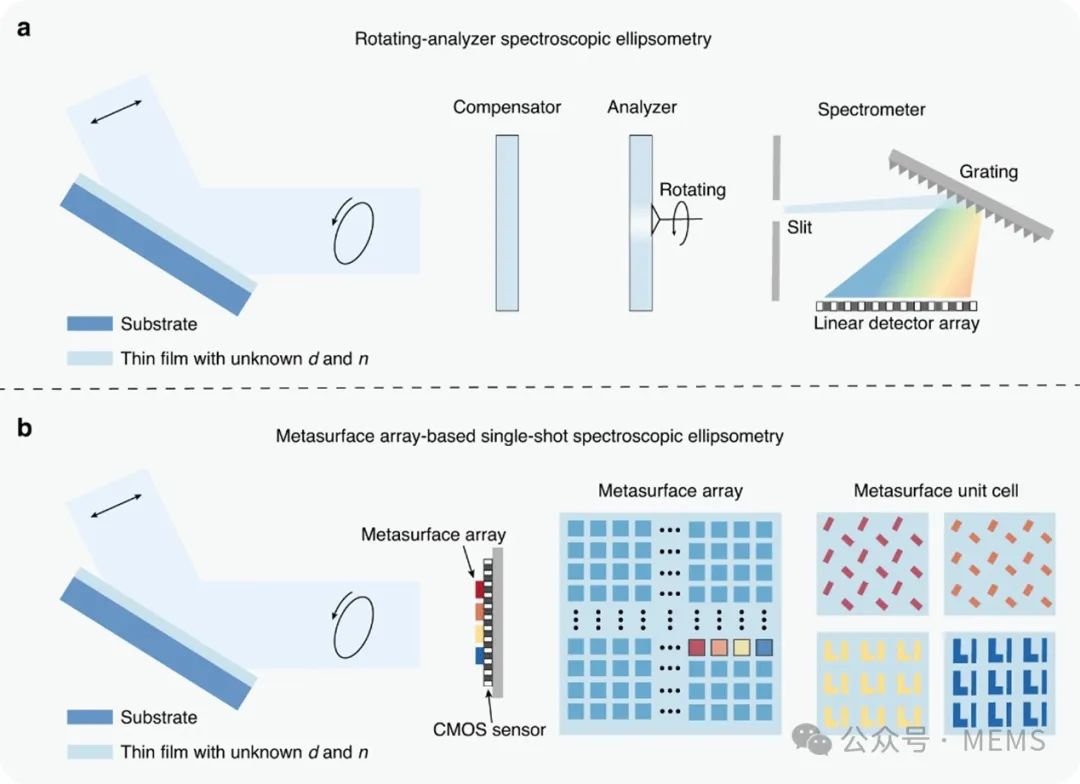
圖1 傳統橢偏儀與基于超構表面陣列的光譜橢偏儀的比較
基于超構表面陣列的光譜橢偏儀的詳細工作原理如圖2所示。該原型由集成在CMOS圖像傳感器頂部的單層超構表面陣列構成。超構表面陣列的Mueller矩陣(M0)是預先校準的。與圖像傳感器上測量的光強度(Iout)一起,入射光的全斯托克斯偏振光譜可以通過具有l2正則化的凸優化(convex optimizer)重建。接下來,通過利用多光束干涉模型擬合測量結果,可將重建的全斯托克斯偏振光譜轉換為橢圓偏振參數,用于確定薄膜厚度d和折射率n。
在上述架構中,精確重建橢圓偏振參數和薄膜特性的關鍵是設計具有高度各向異性和多樣化光譜特征的超構表面陣列,以使Mueller矩陣每行的相關系數最小化。在這項研究中,20?×?20超構表面陣列的每個單元均由藍寶石襯底上的300 nm厚的硅納米柱構成。每個單元的幾何形狀通過最小化不同單元之間的M0相關系數來優化。

圖2 基于超構表面陣列的單次曝光光譜橢偏儀的工作原理
為了通過實驗演示基于超構表面陣列的光譜偏振檢測系統,研究人員組裝了一個原型,如圖3a所示。超構表面陣列由20?×?20個單元構成,總尺寸為1.5? mm ×?1.5 mm。超構表面陣列是通過標準電子束光刻(EBL)和反應離子蝕刻(RIE)工藝在藍寶石襯底上制造的。研究人員使用5 μm厚的光學透明膠帶將超構表面陣列集成到CMOS圖像傳感器(Sony IMX-183)上。超構表面陣列的照片和超構表面單元的4幅代表性掃描電子顯微鏡(SEM)圖像分別如圖3b和3c所示。接下來,研究人員分別評估了系統的光譜偏振重構性能和分辨精細光譜特征的能力,結果如圖3d和3e所示。
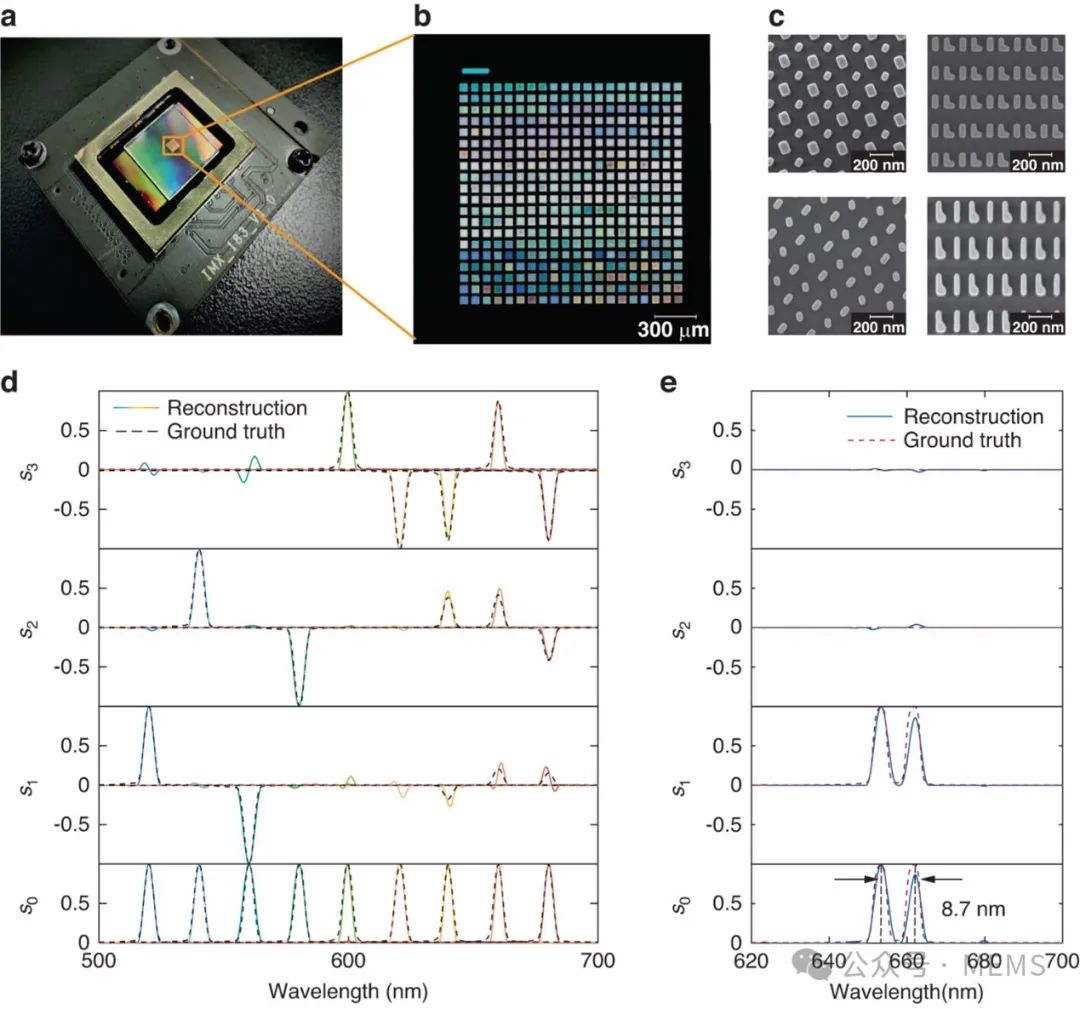
圖3 光譜偏振檢測性能的表征
最后,為了通過實驗演示光譜橢偏儀測量,研究人員選擇了沉積在硅襯底上的5個厚度范圍在100 nm到1000 nm之間的SiO2薄膜作為測試樣品。鹵素燈發出的白光通過45°線性偏振器后,以60°入射角(接近布儒斯特角)照射到薄膜樣品上,以確保顯著的偏振轉換效果。來自薄膜的反射光以垂直入射角照射到超構表面陣列上。厚度為100 nm和1000 nm的兩種代表性SiO2薄膜的重建全斯托克斯偏振光譜分別如圖4a和4b所示,并將其與使用四分之一波片、旋轉偏振器和傳統的基于光柵的光譜儀的測量結果進行了比較,顯示出極佳的一致性。
全斯托克斯偏振光譜可以轉換為橢圓偏振參數,厚度分別為100?nm和1000?nm的SiO2薄膜的轉換后的結果分別如圖4c和4d所示,并將其與基準真實值和理論估計結果作了比較。原型系統重建的薄膜厚度與商用光譜橢偏儀(JA Woollam,V-VASE)測量值之間的比較如圖4e所示。使用商用光譜橢偏儀測量的厚度作為基準真實值,對于五種SiO2薄膜,重建薄膜厚度與基準真實值之間的相對誤差平均僅為2.16%,標準差(10分鐘內10次測量)平均僅為1.28 nm。

圖4 SiO2薄膜的厚度和折射率測量
綜上所述,這項研究提出并通過實驗演示了一種新型的基于超構表面陣列的光譜橢圓偏振系統,用于薄膜特性的單次曝光測量。與傳統的光譜橢偏儀相比,本文提出的基于超構表面的系統無需機械移動部件或相位調制元件,因此,它可以實現半導體加工中薄膜特性的高通量在線測量,例如在薄膜蝕刻或沉積系統中。對于原型系統,橢圓偏振測量的光譜范圍主要受限于商用CMOS圖像傳感器在700 nm波長以上的低量子效率和在500 nm波長以下硅的高材料損耗。為了進一步擴展該范圍,可以選擇在近紅外范圍內具有更高量子效率的CMOS圖像傳感器,或者使用在更寬的光譜范圍內具有更低損耗的替代材料(例如SiN)來設計和制造超構表面。將其應用擴展至紫外(UV)、紅外(IR)或太赫茲(THz)范圍沒有根本限制。超構表面陣列還有望用于光譜偏振成像,這可以進一步實現空間不均勻薄膜的非破壞性表征。
論文鏈接:
https://doi.org/10.1038/s41377-024-01396-3
審核編輯:劉清
-
CMOS
+關注
關注
58文章
6217瀏覽量
242828 -
圖像傳感器
+關注
關注
68文章
2075瀏覽量
132204 -
光譜儀
+關注
關注
2文章
1249瀏覽量
32567 -
半導體芯片
+關注
關注
61文章
943瀏覽量
72633
原文標題:基于超構表面陣列的微型單次曝光光譜橢偏儀
文章出處:【微信號:MEMSensor,微信公眾號:MEMS】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
光譜橢偏儀在二維材料光學表征中的應用綜述

橢偏儀在半導體的應用|不同厚度c-AlN外延薄膜的結構和光學性質

橢偏術精準測量超薄膜n,k值及厚度:利用光學各向異性襯底

光譜橢偏儀入門指南:原理、方法與基礎應用

橢偏儀在精密薄膜中的應用:基于單驅動變角結構的高重復性精度控制系統

橢偏儀在半導體薄膜厚度測量中的應用:基于光譜干涉橢偏法研究

橢偏儀的原理和應用 | 薄膜材料或塊體材料光學參數和厚度的測量

橢偏儀薄膜測量原理和方法:光學模型建立和仿真

橢偏儀測量薄膜厚度的原理與應用

聚焦位置對光譜橢偏儀膜厚測量精度的影響

薄膜厚度測量技術的綜述:從光譜反射法(SR)到光譜橢偏儀(SE)




 基于超構表面陣列的微型單次曝光光譜橢偏儀研究
基于超構表面陣列的微型單次曝光光譜橢偏儀研究




評論