IGBT 作為功率半導(dǎo)體器件,其封裝結(jié)構(gòu)的機(jī)械可靠性對(duì)器件性能至關(guān)重要。IGBT 封裝底部與散熱器貼合面的平整度是影響封裝機(jī)械應(yīng)力分布的關(guān)鍵因素,當(dāng)貼合面存在平整度差時(shí),會(huì)通過封裝結(jié)構(gòu)的力學(xué)傳遞使 IGBT 芯片承受不均勻的機(jī)械應(yīng)力,進(jìn)而對(duì)器件的電性能和可靠性產(chǎn)生潛在影響。
貼合面平整度差會(huì)導(dǎo)致封裝底部與散熱器之間形成非均勻的接觸界面。在螺栓緊固或壓板夾持等裝配過程中,平整度差的貼合面會(huì)使封裝底部受到非對(duì)稱的壓力分布。例如,貼合面局部凸起區(qū)域會(huì)承受更大的接觸壓力,而凹陷區(qū)域的壓力則相對(duì)較小,這種壓力差通過封裝基板(如 DBC 陶瓷基板)和焊料層傳遞至芯片,形成芯片表面的機(jī)械應(yīng)力梯度。由于芯片材料(硅)的脆性特征,這種非均勻應(yīng)力極易導(dǎo)致芯片內(nèi)部產(chǎn)生晶格畸變甚至微裂紋。
從力學(xué)傳遞路徑看,平整度差引發(fā)的機(jī)械應(yīng)力主要包括剪切應(yīng)力和彎曲應(yīng)力。當(dāng)貼合面存在局部高度差時(shí),封裝底部在垂直壓力作用下會(huì)產(chǎn)生彎曲變形,使芯片表面承受彎曲應(yīng)力。以典型的 IGBT 模塊封裝為例,DBC 基板厚度通常在 0.3-0.6mm 之間,平整度差導(dǎo)致的基板彎曲會(huì)使芯片邊緣區(qū)域承受更大的拉應(yīng)力,而中心區(qū)域則可能出現(xiàn)壓應(yīng)力。同時(shí),由于封裝材料熱膨脹系數(shù)的差異(如硅的熱膨脹系數(shù)為 2.6×10??/℃,銅基板為 17×10??/℃),在工作溫度波動(dòng)下,平整度差引發(fā)的應(yīng)力會(huì)與熱應(yīng)力疊加,形成更為復(fù)雜的應(yīng)力分布。
不均勻機(jī)械應(yīng)力對(duì) IGBT 芯片的影響體現(xiàn)在多個(gè)層面。在材料微觀結(jié)構(gòu)上,應(yīng)力會(huì)導(dǎo)致硅晶體的晶格常數(shù)發(fā)生變化,進(jìn)而影響載流子的遷移率和壽命。研究表明,硅材料在壓應(yīng)力作用下載流子遷移率可提升 10%-15%,而拉應(yīng)力則可能導(dǎo)致載流子復(fù)合速率增加,這種變化會(huì)直接影響芯片的閾值電壓和導(dǎo)通電阻等電參數(shù)。在結(jié)構(gòu)層面,長(zhǎng)期的非均勻應(yīng)力作用會(huì)使焊料層產(chǎn)生疲勞開裂,尤其是在芯片邊緣等高應(yīng)力區(qū)域,焊料層的開裂會(huì)進(jìn)一步加劇應(yīng)力集中,形成 “應(yīng)力 - 開裂 - 應(yīng)力加劇” 的惡性循環(huán)。
當(dāng)芯片承受不均勻機(jī)械應(yīng)力時(shí),還可能引發(fā)封裝結(jié)構(gòu)的界面失效。例如,芯片與 DBC 基板之間的焊料層在應(yīng)力作用下會(huì)產(chǎn)生塑性變形,導(dǎo)致界面結(jié)合強(qiáng)度下降。在 IGBT 開關(guān)過程中,由于電流突變產(chǎn)生的電磁力會(huì)與機(jī)械應(yīng)力耦合,使芯片受到動(dòng)態(tài)載荷,加速界面失效進(jìn)程。更為嚴(yán)重的是,當(dāng)應(yīng)力超過硅材料的屈服強(qiáng)度(約 700MPa)時(shí),芯片內(nèi)部會(huì)產(chǎn)生微裂紋,這些微裂紋可能沿著晶界擴(kuò)展,直接破壞 pn 結(jié)結(jié)構(gòu),導(dǎo)致器件的擊穿電壓下降或出現(xiàn)漏電現(xiàn)象。
在 IGBT 模塊的實(shí)際應(yīng)用中,貼合面平整度差引發(fā)的不均勻機(jī)械應(yīng)力往往與熱應(yīng)力、電應(yīng)力相互作用。例如,在高功率密度工況下,芯片溫度升高會(huì)加劇材料熱膨脹差異,使機(jī)械應(yīng)力進(jìn)一步增大;而電應(yīng)力導(dǎo)致的芯片局部發(fā)熱又會(huì)與機(jī)械應(yīng)力耦合,形成熱 - 力耦合失效機(jī)制。這種多物理場(chǎng)的相互作用使得 IGBT 的失效模式更為復(fù)雜,增加了器件可靠性評(píng)估的難度。
激光頻率梳3D光學(xué)輪廓測(cè)量系統(tǒng)簡(jiǎn)介:
20世紀(jì)80年代,飛秒鎖模激光器取得重要進(jìn)展。2000年左右,美國(guó)J.Hall教授團(tuán)隊(duì)?wèi){借自參考f-2f技術(shù),成功實(shí)現(xiàn)載波包絡(luò)相位穩(wěn)定的鈦寶石鎖模激光器,標(biāo)志著飛秒光學(xué)頻率梳正式誕生。2005年,Theodor.W.H?nsch(德國(guó)馬克斯普朗克量子光學(xué)研究所)與John.L.Hall(美國(guó)國(guó)家標(biāo)準(zhǔn)和技術(shù)研究所)因在該領(lǐng)域的卓越貢獻(xiàn),共同榮獲諾貝爾物理學(xué)獎(jiǎng)。?
系統(tǒng)基于激光頻率梳原理,采用500kHz高頻激光脈沖飛行測(cè)距技術(shù),打破傳統(tǒng)光學(xué)遮擋限制,專為深孔、凹槽等復(fù)雜大型結(jié)構(gòu)件測(cè)量而生。在1m超長(zhǎng)工作距離下,仍能保持微米級(jí)精度,革新自動(dòng)化檢測(cè)技術(shù)。?

核心技術(shù)優(yōu)勢(shì)?
①同軸落射測(cè)距:獨(dú)特掃描方式攻克光學(xué)“遮擋”難題,適用于縱橫溝壑的閥體油路板等復(fù)雜結(jié)構(gòu);?

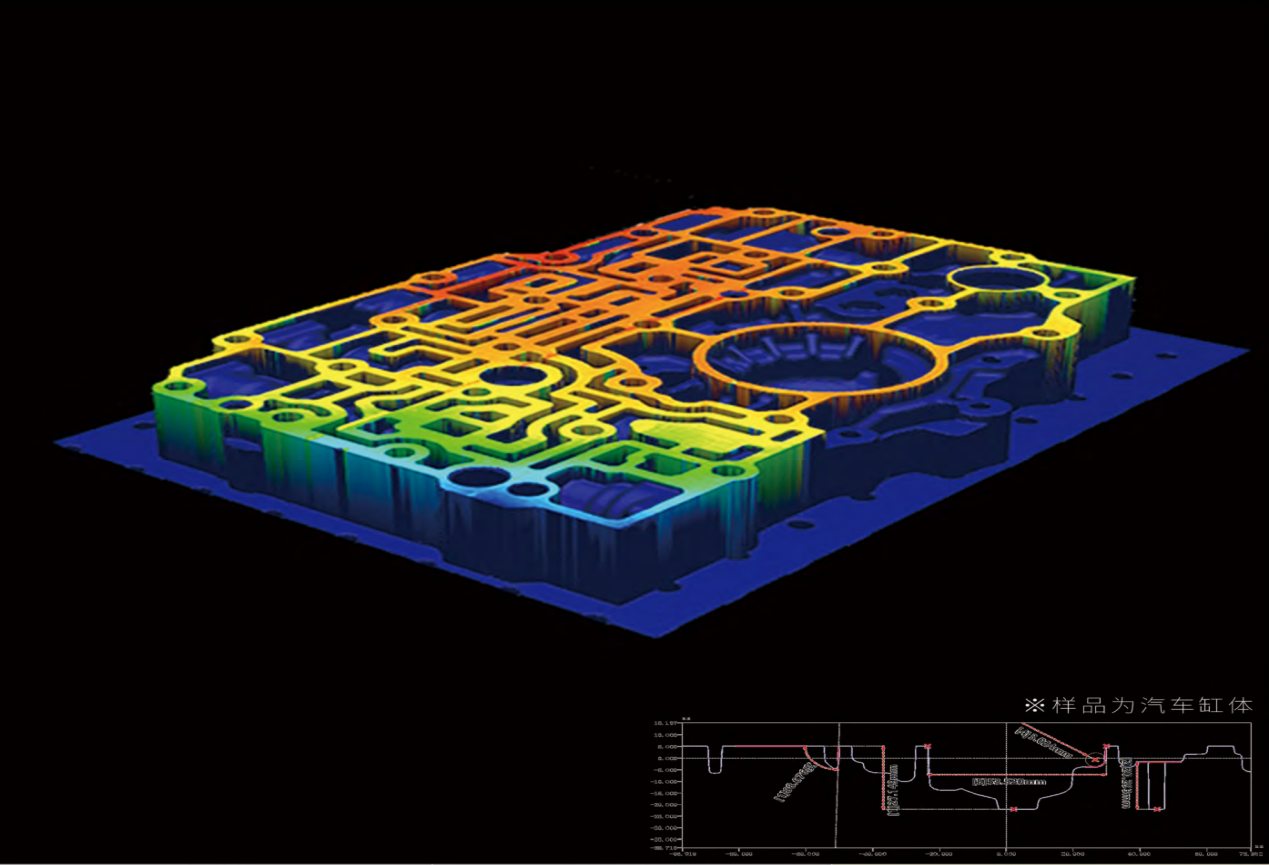
(以上為新啟航實(shí)測(cè)樣品數(shù)據(jù)結(jié)果)
②高精度大縱深:以±2μm精度實(shí)現(xiàn)最大130mm高度/深度掃描成像;?
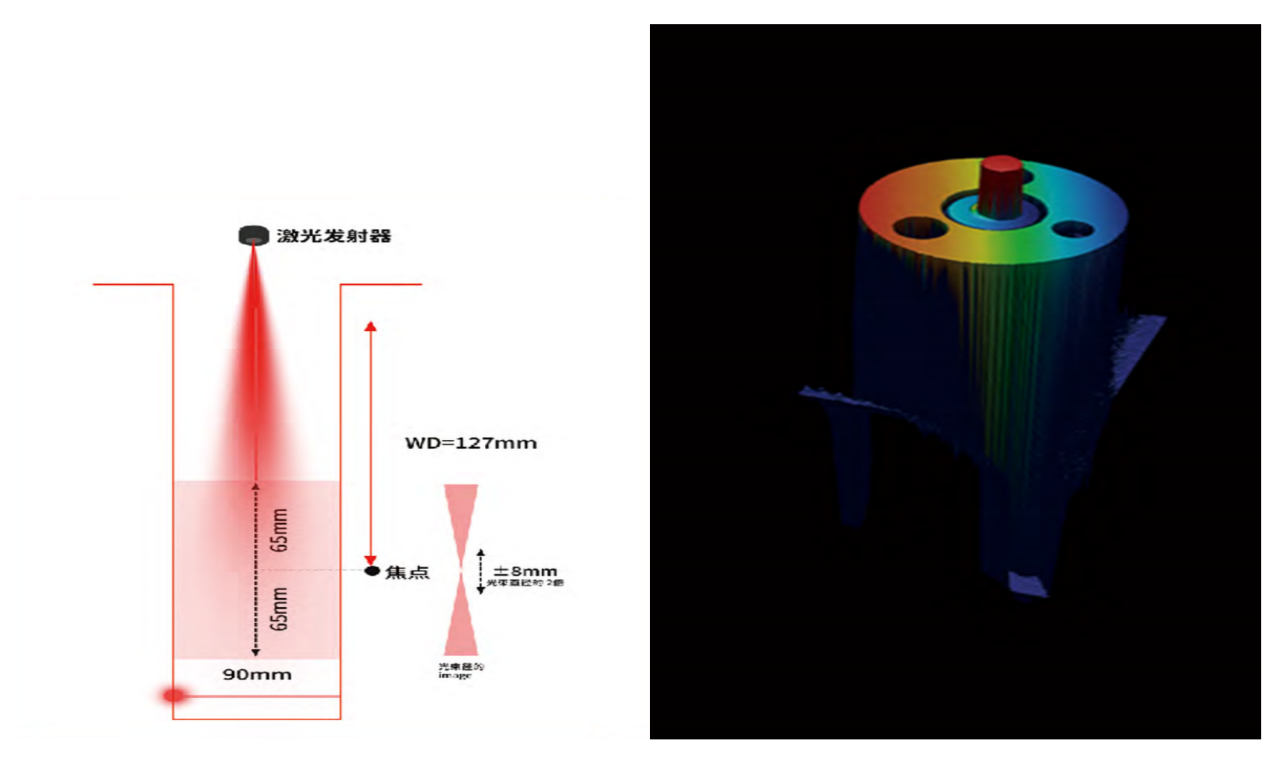
(以上為新啟航實(shí)測(cè)樣品數(shù)據(jù)結(jié)果)
③多鏡頭大視野:支持組合配置,輕松覆蓋數(shù)十米范圍的檢測(cè)需求。

(以上為新啟航實(shí)測(cè)樣品數(shù)據(jù)結(jié)果)
審核編輯 黃宇
-
芯片
+關(guān)注
關(guān)注
463文章
54007瀏覽量
465918 -
封裝
+關(guān)注
關(guān)注
128文章
9248瀏覽量
148610 -
散熱器
+關(guān)注
關(guān)注
2文章
1137瀏覽量
39647 -
IGBT
+關(guān)注
關(guān)注
1288文章
4331瀏覽量
262967
發(fā)布評(píng)論請(qǐng)先 登錄
薩科微slkor總經(jīng)理宋仕強(qiáng)介紹道,焊接層在IGBT模塊中起什么作用?其失效會(huì)帶來什么后果?
淺談IGBT模塊的散熱設(shè)計(jì)技巧
電機(jī)轉(zhuǎn)子磁場(chǎng)不均勻的原因有哪些?
IGBT 封裝底部與散熱器貼合面平整度差,引發(fā)鍵合線與芯片連接部位應(yīng)力集中,鍵合脆斷

IGBT模塊的封裝形式類型

IGBT 芯片平整度差,引發(fā)鍵合線與芯片連接部位應(yīng)力集中,鍵合失效

IGBT 模塊接觸熱阻增大與芯片表面平整度差關(guān)聯(lián)性

【新啟航】碳化硅襯底 TTV 厚度不均勻性測(cè)量的特殊采樣策略

碳化硅襯底 TTV 厚度不均勻性測(cè)量的特殊采樣策略

IGBT 封裝底部與散熱器貼合面平整度差與 IGBT 的短路失效機(jī)理相關(guān)性

IGBT 芯片表面平整度差與 IGBT 的短路失效機(jī)理相關(guān)性

太陽光模擬器丨輻照不均勻度的定義和標(biāo)準(zhǔn)

三防漆涂覆不均勻怎么解決

深視智能SCI系列光譜共焦位移傳感器以亞微米精度測(cè)量晶圓平整度
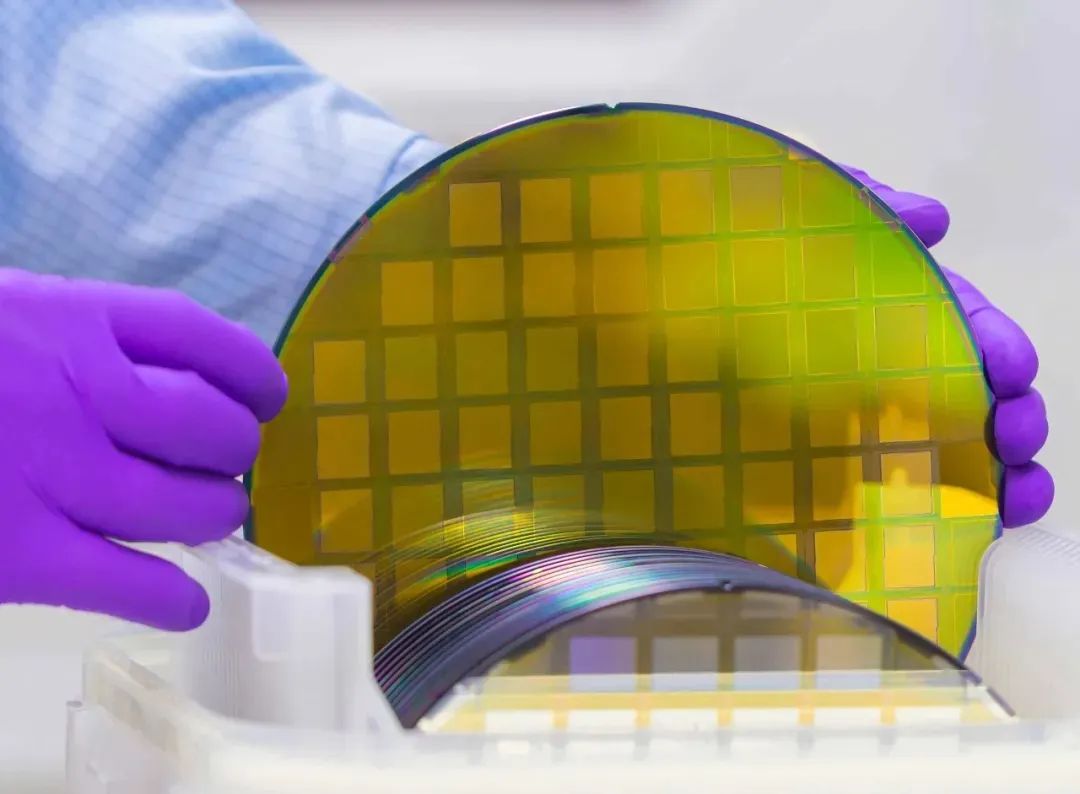
IGBT模塊封裝:高效散熱,可靠性再升級(jí)!




 IGBT 封裝底部與散熱器貼合面平整度差會(huì)使 IGBT 芯片受到不均勻的機(jī)械應(yīng)力
IGBT 封裝底部與散熱器貼合面平整度差會(huì)使 IGBT 芯片受到不均勻的機(jī)械應(yīng)力




評(píng)論