圖2.2是現代CMOS 器件剖面的示意圖。一般來說,水平方向的尺寸微縮幅度比垂直方向的幅度更大,這將導致溝槽(包含接觸孔)的深寬比(aspect ratio)也隨之提高,為避免溝槽填充過程中產生空穴(void),溝槽的填充工藝技術也不斷發展。從圖中可見,集成電路芯片的制造過程中包含很多種填充技術上的挑戰,包括淺溝槽隔離、接觸孔和溝槽。根據填充材料的不同,填充工藝主要分為絕緣介質的填充技術和導電材料的填充技術。
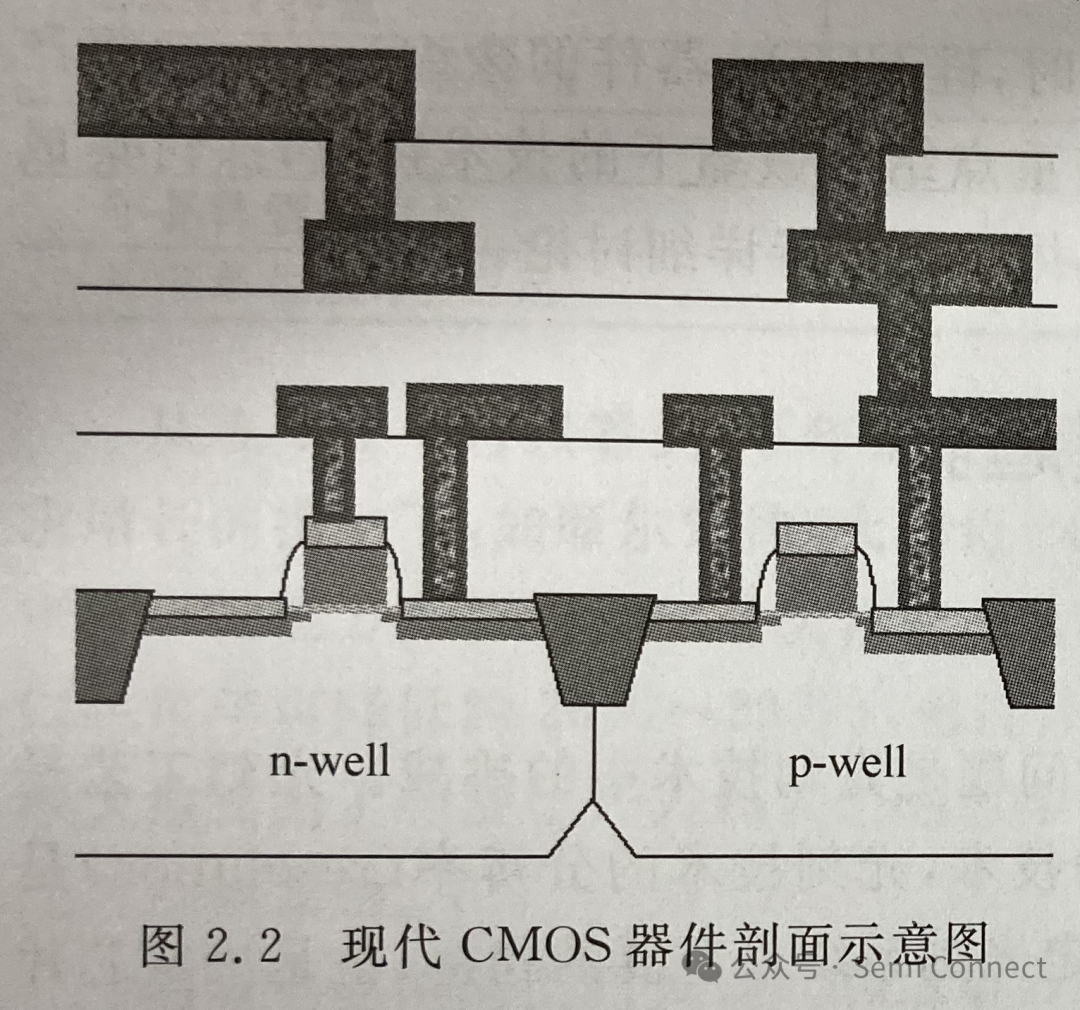
在大于0.8μm的間隙中填充絕緣介質時,普遍采用等離子體增強化學氣相沉積(Plasma Enhanced Chemical Vapor Deposition, PECVD);然而對于小于0.8μm 的間隙,用單步 PECVD 工藝填充間隙時會在其中部產生空穴。PECVD技術加上沉積-刻蝕-沉積工藝被用以填充0.5~0.8μm的間隙,也就是說,在初始沉積完成部分填孔尚未發生夾斷時緊跟著進行刻蝕工藝以重新打開間隙入口,之后再次沉積以完成對整個間隙的填充。
高密度等離子(High Density Plasma, HDP)化學氣相沉積技術工藝在同一個反應腔(chamber)中原位地進行沉積和刻蝕的工藝,通過控制間隙的拐角處沉積刻蝕比(depositionetch ratio),使得凈沉積速率接近零,從而提高其填充能力。該技術能夠適應深寬比在6:1左右的需求,并滿足 90nm 技術節點的需求。
當集成電路發展到 65nm 技術節點時,HDP工藝技術已經不能滿足小尺寸溝槽的填充需求,因而發展出一種新的填充工藝技術即商深寬比工藝(High Aspect Ratio Process,HARP)。HARP 工藝采用 O3和 TEOS 的熱化學反應,沒有等離子體的輔助,同時需要溝槽具有特定的形貌,如特定角度的V 字形溝槽。該技術能夠適應深寬比在7:1以上的需求。2008年,應用材料公司又推出eHARP工藝技術以適應32nm 工藝的需求。該技術在原有工藝引入水蒸氣,能夠提供無孔薄膜,用于填充小于30nm、深寬比大于12:1的空隙,從而滿足先進存儲器件和邏輯器件的關鍵制造要求。
更進一步地,在2010年8月,同樣是應用材料公司推出第4代填充技術,即流動式化學氣相沉積(FCVD)技術。采用該技術,沉積層材料可以在液體形態下自由流動到需要填充的各種形狀的結構中,填充形式為自底向上(bottom-up),而且填充結構中不會產生空隙,能夠滿足的深寬比可超過30:1。這種獨特工藝能夠以致密且無碳的介電薄膜從底部填充所有這些區域,并且其成本相對低廉,僅是綜合旋轉方式的一半左右,后者需要更多的設備和很多額外的工藝步驟。
對于導電材料的填充技術,早期的金屬沉積工藝采用物理氣相沉積(Physical VaporDeposition,PVD)工藝。但是,PVD技術的填充能力和臺階覆蓋能力都比較弱。為解決上述問題,化學氣相沉積(CVD)技術在接觸孔鎢栓填充上得到應用。在工藝優化后,CVD技術能夠提供保型沉積,這意味著比 PVD技術更為優越的填充能力。當集成電路工業引入銅互連技術后,不論 PVD還是CVD技術都不能滿足其填充能力的要求。研究發現,電化學沉積(ECD)技術能夠提供更為優越的填充技術以滿足銅互連技術中的挑戰。ECD 技術因其工藝具備自下而上(bottom-up)的特點,因而具有更優越的填充能力,對于高深寬比的間隙來說,這是一種理想的填充方式。在最近發展的替代柵工藝中,金屬沉積將面臨一些新的技術挑戰。
在接觸孔鎢栓填充、后端互連工藝銅填充以及后柵極工藝中的柵極填充中,一個共同的組成部分是阻擋層或晶籽層沉積或類阻擋層沉積,或可統一成為薄層金屬沉積。薄層金屬沉積需要良好的臺階覆蓋性(step coverage),傳統的 MOCVD或PVD工藝在阻擋層或晶籽層沉積上已經沿用多年,隨著互連通孔尺寸的減小,臺階覆蓋等問題已經成為限制其繼續應用的瓶頸。原子層氣相沉積(Atomic Layer Deposition,ALD)技術正在逐步成為主流。
ALD過程是在經過活性表面處理的襯底上進行,首先將第一種反應物引入反應室使之發生化學吸附,直至襯底表面達到飽和;過剩的反應物則被從系統中抽出清除,然后將第二種反應物放入反應室,使之和襯底上被吸附的物質發生反應;剩余的反應物和反應副產品將再次通過泵抽或惰性氣體清除的方法清除干凈,這樣就可得到目標化合物的單層飽和表面。這種ALD的循環可實現一層接一層的生長從而可以實現對沉積厚度的精確控制。ALD 技術在臺階覆蓋、側壁及底部覆蓋等方面都表現優異,但是ALD沉積速率較低的劣勢也亟待改善。
ALD相比傳統的MOCVD和 PVD等沉積工藝具有先天的優勢。它充分利用表面飽和反應天生具備厚度控制能力及高度的穩定性,對溫度和反應物通量的變化不太敏感。這樣得到的薄膜既純度高、密度高、平整,又具有高度的保型性,即使對于縱寬比高達100:1的結構也可實現良好的階梯覆蓋。ALD也順應工業界向更低的熱預算發展的趨勢,多數工藝都可以在400°C以下進行。由于 ALD是基于在交互反應過程中的自約束性生長,此工藝必須經過精細的調節來達到最合適的結果。
-
芯片
+關注
關注
463文章
54253瀏覽量
468217 -
集成電路
+關注
關注
5461文章
12635瀏覽量
375377 -
CMOS
+關注
關注
58文章
6221瀏覽量
243201 -
填充
+關注
關注
0文章
7瀏覽量
7340
原文標題:溝槽填充技術
文章出處:【微信號:Semi Connect,微信公眾號:Semi Connect】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
使用晶片處理技術在硅中產生溝槽結構
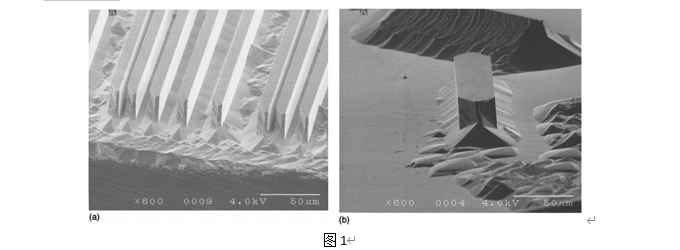
溝槽結構SiC-MOSFET與實際產品
CAD填充技巧之填充比例
ASM啟用功新的PowerFill外延技術的電源設備
ASM啟用新的PowerFill外延技術的電源設備
cad填充圖案大全下載_cad填充圖案怎么安裝

PCB設計之填充過孔介紹
底部填充膠膠水如何填充芯片
SiC MOSFET:是平面柵還是溝槽柵?




 溝槽填充技術介紹
溝槽填充技術介紹







評論