在晶圓級封裝與先進(jìn)互連工藝中,焊點(diǎn)問題往往并不出現(xiàn)在“設(shè)備”,而是出現(xiàn)在一個(gè)被低估的環(huán)節(jié)——助焊劑選擇。焊點(diǎn)不圓、橋連頻發(fā)、回流后殘留難清、良率波動大……這些問題,DW185 正是為此而來。
DW185:專為晶圓焊點(diǎn)成形與良率穩(wěn)定設(shè)計(jì)的工藝解決方案
DW185 是一款半導(dǎo)體級低黏度晶圓助焊劑,專為晶圓焊點(diǎn)成形與良率穩(wěn)定而設(shè)計(jì)。它不是“通用型材料”,而是直接服務(wù)于晶圓級焊接結(jié)果的工藝解決方案。在回流過程中,DW185 能高效去除焊點(diǎn)表面氧化物,并在焊料自身表面張力作用下,促使焊點(diǎn)自然收縮成高度一致的半球形結(jié)構(gòu):
? 焊點(diǎn)飽滿
? 形狀一致
? 無焊料損失
? 不易橋連
成形好,后段工藝才會更穩(wěn)。
真正解決產(chǎn)線“痛點(diǎn)”的性能設(shè)計(jì)
DW185 的每一項(xiàng)性能,都是圍繞量產(chǎn)穩(wěn)定性展開: ?水溶性配方→ 回流后易清洗,殘留風(fēng)險(xiǎn)低 ?適配 150–300 mm 晶圓黏度區(qū)間→ 大尺寸晶圓涂覆更均勻 ?多次回流 + 清洗后無殘留→ 滿足高可靠性封裝要求 ?無鹵素→ 更安全、更可靠 ?焊點(diǎn)形狀一致性高→ 有效提升良率與一致性 ?兼容有鉛 / 無鉛 / 高溫焊接制程→ 工藝切換無需更換材料 ?不侵蝕金屬化層→ 長期可靠性更有保障
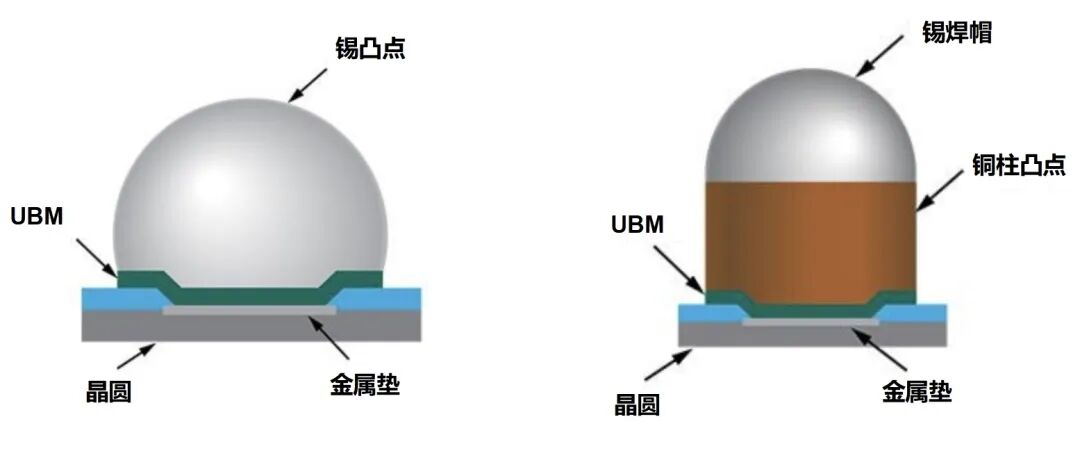
工藝兼容性強(qiáng),上線更快
DW185 可直接應(yīng)用于主流晶圓產(chǎn)線工藝:
旋涂工藝
?低速鋪展 → 高速減薄
?轉(zhuǎn)速范圍 15–800 rpm
?可根據(jù)晶圓尺寸、焊點(diǎn)間距靈活調(diào)整
噴涂工藝
?支持 8 小時(shí)連續(xù)穩(wěn)定供料
?涂覆均勻,適合量產(chǎn)
?只需常規(guī)系統(tǒng)清洗即可保持純凈度
清洗簡單,窗口寬
DW185 殘留物完全可溶于水,推薦使用加熱去離子水噴霧清洗: ?初始建議: ?壓力:60 psi ?溫度:55 ℃
清洗窗口寬,對設(shè)備和工藝友好,更適合規(guī)模化生產(chǎn)線長期運(yùn)行。
細(xì)間距應(yīng)用也有解法
?回流建議在氮?dú)猸h(huán)境下進(jìn)行 ?氧含量建議 <20 ppm(最高不超過 50 ppm) ?對于 <55 μm 銅柱微型焊點(diǎn) ?若出現(xiàn)橋連或缺錫 ?通過適當(dāng)降低峰值溫度即可有效改善
DW185 已在多種晶圓凸點(diǎn)結(jié)構(gòu)中驗(yàn)證,300 mm 晶圓可直接參考應(yīng)用曲線,并可根據(jù)客戶制程進(jìn)一步優(yōu)化。
-
半導(dǎo)體
+關(guān)注
關(guān)注
339文章
31074瀏覽量
265773 -
晶圓
+關(guān)注
關(guān)注
53文章
5436瀏覽量
132574 -
封裝
+關(guān)注
關(guān)注
128文章
9303瀏覽量
148939
發(fā)布評論請先 登錄
晶圓凸起封裝工藝技術(shù)簡介
晶圓級CSP的錫膏裝配和助焊劑裝配
晶圓級CSP貼裝工藝吸嘴的選擇
晶圓封裝有哪些優(yōu)缺點(diǎn)?
什么是半導(dǎo)體晶圓?
晶圓級封裝產(chǎn)業(yè)(WLP),晶圓級封裝產(chǎn)業(yè)(WLP)是什么意思
晶圓隱裂檢測提高半導(dǎo)體行業(yè)效率

晶圓級封裝Bump制作中錫膏和助焊劑的應(yīng)用解析




 晶圓級封裝良率提升方案:DW185半導(dǎo)體級低黏度晶圓助焊劑
晶圓級封裝良率提升方案:DW185半導(dǎo)體級低黏度晶圓助焊劑






評論