隨著晶圓代工制程不斷縮小,摩爾定律逼近極限,先進封裝是后摩爾時代的必然選擇。其中,利用高端封裝融合最新和成熟節點,采用系統封裝(SiP)和基于小芯片的方法,設計和制造最新的SoC產品已經成為
2023-05-23 12:29:11 5750
5750 
先進封裝是“超越摩爾”(More than Moore)時代的一大技術亮點。當芯片在每個工藝節點上的微縮越來越困難、也越來越昂貴之際,工程師們將多個芯片放入先進的封裝中,就不必再費力縮小芯片了。本文將對先進封裝技術中最常見的10個術語進行簡單介紹。
2023-07-12 10:48:03 1866
1866 
的研究,由深圳市華芯邦科技有限公司(Hotchip)提出,可解決元器件散熱、可靠性、成本、器件尺寸等問題,是替代傳統封裝技術解決方案之一。本文總結了HRP工藝的封裝特點和優勢,詳細介紹其工藝實現路線,為傳統封裝技術替代提供解決方案。HRP晶圓級先進封裝芯片
2023-11-30 09:23:24 3833
3833 
半導體器件有許多封裝形式,按封裝的外形、尺寸、結構分類可分為引腳插入型、表面貼裝型和高級封裝三類。從DIP、SOP、QFP、PGA、BGA到CSP再到SIP,技術指標一代比一代先進。總體說來,半導體
2024-01-16 09:54:34 2668
2668 
本文對5G試點背景及相關技術進行介紹,通過頻譜資源分析,確定采用3.5 GHz作為5G試點的主要頻段;通過不同信道的鏈路預算分析,發現采用64T64R的Massive MIMO設備進行5G組網的站址
2019-06-18 07:18:06
本文以汽車線束為中心,并對車載通信技術的現狀與今后發展動向作概要介紹。
2021-05-14 06:51:56
摘 要:先進封裝技術不斷發展變化以適應各種半導體新工藝和材料的要求和挑戰。在半導體封裝外部形式變遷的基礎上,著重闡述了半導體后端工序的關鍵一封裝內部連接方式的發展趨勢。分析了半導體前端制造工藝的發展
2018-11-23 17:03:35
《先進機器人控制》從控制的角度系統地介紹了機器人學的基礎知識和當前的發展狀況。全書共分為12章,由基礎篇、控制結構篇和先進控制篇構成。基礎篇著重介紹串聯關節機器人的運動學、運動規劃和動力學。其中
2017-09-19 15:30:57
以后到現在AiP技術在國內外取得的最新成果。此外,本文也是作者介紹封裝天線技術系列文章的第二篇:譜新篇。文章首先從新聞發布、媒體報道及市場分析報告角度出發關注當前AiP技術熱點,接著追蹤研討會、捕捉AiP技術新的發展動向,然后重點介紹AiP技術在材料、工藝、設計、測試等方面的新進展。
2019-07-16 07:12:40
編者按:封裝天線(AiP)技術是過去近20年來為適應系統級無線芯片出現所發展起來的天線解決方案。如今AiP 技術已成為60GHz無線通信和手勢雷達系統的主流天線技術。AiP 技術在79GHz汽車雷達
2019-07-17 06:43:12
,BGA封裝技術是一種現代集成電路封裝技術,它具有先進的封裝方式、較小的體積、優異的散熱性能和電性能等優點,已經成為現代計算機和移動設備等集成電路的主流封裝方式。BGA封裝技術的發展和應用將繼續推動電子產品
2023-04-11 15:52:37
構成IC產業的三大支柱。計算機輔助設計(CAD)作為一種重要的技術手段在IC產業中發揮了巨大作用,已廣泛應用于電子封裝領域。本文結合各個時期電子封裝的特點,介紹了封裝CAD技術的發展歷程,并簡要分析了今后
2018-08-23 08:46:09
本文對LTE-Advanced技術的發展及相關的主要技術進行了介紹,并就其關鍵技術做出了探究。可以預見,LTE-Advanced技術將在很長一段時間內作為世界范圍移動通信領域的熱點研究課題, 這將更有利于推動第四代通信技術的發展,人類進入4G 時代不再遙遠。
2021-05-24 06:46:32
向著更高速率、更大容量的通信系統發展,而先進的光纖制造技術既能保持穩定、可靠的傳輸以及足夠的富余度,又能滿足光通信對大寬帶的需求,并減少非線性損傷。
2019-10-17 06:52:52
微電子三級封裝是什么?新型微電子封裝技術介紹
2021-04-23 06:01:30
隨著計算機芯片技術的不斷發展和成熟,為了更好地與之相配合,內存產品也由后臺走出,成為除CPU外的另一關注焦點。作為計算機的重要組成部分,內存的性能直接影響計算機的整體性能。而內存制造工藝的最后一步
2018-08-28 16:02:11
現代先進的貼片機采用一系列先進的智能控制技術,逐漸向高速度、高靈活性和無差錯貼裝發展。關于速度和靈活性我們將在后面的章節中詳細討論,這里只介紹幾種流行先進貼裝技術。 (1)智能供料器 傳統
2018-09-07 16:11:53
龍 樂(龍泉長柏路98號l棟208室,四川 成都 610100)摘 要:分立器件封裝也是微電子生產技術的基礎和先導-本文介紹國內外半導體分立器件封裝技術及產品的主要發展狀況,評述了其商貿市場
2018-08-29 10:20:50
多芯片整合封測技術--種用先進封裝技術讓系統芯片與內存達到高速傳輸ASIC 的演進重復了從Gate Array 到Cell Base IC,再到系統芯片的變遷,在產業上也就出現了,負責技術開發的IC
2009-10-05 08:11:50
。隨著許多新技術的發展,可能會出現各種提案,比如各個封裝的物理尺寸和引出球。 在JDEC標準中,針對封裝有物理尺寸和電氣球引出等多種可變選項。選擇采用何種標準取決于頂層和底層封裝的可用性。JDEC標準
2018-08-27 15:45:50
本帖最后由 eehome 于 2013-1-5 09:50 編輯
常用IC封裝技術介紹
2012-12-05 08:21:29
和制造,所以封裝技術至關重要。衡量一個芯片封裝技術先進與否的重要指標是:芯片面積與封裝面積之比,這個比值越接近1越好。▍封裝時主要考慮的因素:芯片面積與封裝面積之比,為提高封裝效率,盡量接近1:1
2020-03-16 13:15:33
微機電系統的發展及其應用微機電系統是在微電子技術基礎上產生和發展起來的多學科交叉的前沿科學研究領域,是面向21 世紀的高新科技. 介紹了微機電系統產生的背景影響、組成特征和基礎研究內容,綜述了微機
2009-03-17 15:29:51
論述了微電子封裝技術的發展歷程 發展現狀及發展趨勢 主要介紹了微電子封裝技術中的芯片級互聯技術與微電子裝聯技術 芯片級互聯技術包括引線鍵合技術 載帶自動焊技術 倒裝芯片技術 倒裝芯片技術是目前
2013-12-24 16:55:06
。如比較小的阻抗值、較強的抗干擾能力、較小的信號失真等等。芯片的封裝技術經歷了好幾代的變遷,從DIP、QFP、PGA、BGA到CSP再到MCM。技術指標和電器性能一代比一代先進。
2011-10-28 10:51:06
掛鉤的產業鏈。(2)積極開展國際合作,主動迎接國際先進技術和先進原材料廠商來華投資建廠。既解決資金和技術問題,又能達到提升同內封裝企業的技術發展之目的,是謂“借雞生蛋”。(3)國家要加大政策扶持。從
2018-08-29 09:55:22
以來迅速發展的新型微電子封裝技術,包括焊球陣列封裝(BGA)、芯片尺寸封裝(CSP)、圓片級封裝(WLP)、三維封裝(3D)和系統封裝(SIP)等項技術。介紹它們的發展狀況和技術特點。同時,敘述了
2018-09-12 15:15:28
先進封裝發展背景晶圓級三維封裝技術發展
2020-12-28 07:15:50
半導體工藝和RF封裝技術的不斷創新完全改變了工程師設計RF、微波和毫米波應用的方式。RF設計人員需要比以往任何時候都更具體、更先進的技術和設計支持。設計技術持續發展,RF和微波器件的性質在不久的未來
2019-07-31 06:34:51
的主要制造技術。內容包括電子制造技術概述、集成電路基礎、集成電路制造技術、元器件封裝工藝流程、元器件封裝形式及材料、光電器件制造與封裝、太陽能光伏技術、印制電路板技術以及電子組裝技術。書中簡要介紹了
2017-03-23 19:39:21
鮮 飛(烽火通信科技股份有限公司,湖北 武漢 430074)摘 要:微電子技術的飛速發展也同時推動了新型芯片封裝技術的研究和開發。本文主要介紹了幾種芯片封裝技術的特點,并對未來的發展趨勢及方向進行了
2018-11-23 16:59:52
`本文指出了集成電源是電源技術發展的必然方向,目前混合封裝技術是集成電源模塊的主流方式,闡述了混合封裝技術的若干關鍵技術問題和發展方向,最后介紹了若干基于混合封裝技術的集成電源模塊。`
2011-03-09 17:15:59
建設推動共性、關鍵性、基礎性核心領域的整體突破,促進我國軟件集成電路產業持續快速發展,由國家集成電路封測產業鏈技術創新戰略聯盟、深圳市半導體行業協會主辦,上海樂麩教育科技有限公司、中科院深圳先進技術
2016-03-21 10:39:20
論文綜述了自 1990 年以來迅速發展的先進封裝技術,包括球柵陣列封裝(BGA)、芯片尺寸封裝(CSP)、圓片級封裝(WLP)、三維封裝(3D)和系統封裝(SiP)等項新技術;同時,敘述了我國封
2009-12-14 11:14:49 28
28 本文介紹了當今制造技術面臨的問題,論述了先進制造的前沿科學,并展望了先進制造技術的發展前景。
2009-12-29 15:40:07 9
9 關于先進封裝工藝的話題從未間斷,隨著移動電子產品趨向輕巧、多功能、低功耗發展,高階封裝技術也開始朝著兩大板塊演進,一個是以晶圓級芯片封裝WLCSP(Fan-In WLP、Fan-out WLP等
2018-07-12 14:34:00 20561
20561 SiP和Chiplet也是長電科技重點發展的技術。“目前我們重點發展幾種類型的先進封裝技術。首先就是系統級封裝(SiP),隨著5G的部署加快,這類封裝技術的應用范圍將越來越廣泛。其次是應用于
2020-09-17 17:43:20 10638
10638 的芯片,透過多芯片封裝包在一起,以最短的時程推出符合市場需求的產品,就成為重要性持續水漲船高的技術顯學。 而這些先進芯片封裝也成為超級電腦和人工智能的必備武器。別的不提,光論nVidia 和AMD 的高效能運算專用GPU、
2020-10-10 17:24:13 2841
2841 技術發展方向 半導體產品在由二維向三維發展,從技術發展方向半導體產品出現了系統級封裝(SiP)等新的封裝方式,從技術實現方法出現了倒裝(FlipChip),凸塊(Bumping),晶圓級封裝(Waferlevelpackage),2.5D封裝(interposer,RDL等),3D封裝(TSV)等先進封裝技術。
2020-10-12 11:34:36 19530
19530 
一、技術發展方向 半導體產品在由二維向三維發展,從技術發展方向半導體產品出現了系統級封裝(SiP)等新的封裝方式,從技術實現方法出現了倒裝(FlipChip),凸塊(Bumping),晶圓級封裝
2020-10-21 11:03:11 32866
32866 
隨著5G通信、汽車電子等領域的發展,對集成電路的先進封裝要求也更高,先進封裝技術有望逐漸成為市場主流。根據中國半導體行業協會封裝分會統計,當前以TVS、WLCSP、SiP、3D、MCM等先進技術在國內封裝市場已經占據了超三成的市場份額。
2020-11-23 10:09:20 3942
3942 先進封裝大部分是利用「晶圓廠」的技術,直接在晶圓上進行,由于這種技術更適合晶圓廠來做,因此臺積電大部分的先進封裝都是自己做的。
2021-02-22 11:45:21 2861
2861 
一項技術能從相對狹窄的專業領域變得廣為人知,有歷史的原因,也離不開著名公司的推波助瀾,把SiP帶給大眾的是蘋果(Apple),而先進封裝能引起公眾廣泛關注則是因為臺積電(TSMC)。 蘋果說,我的i
2021-04-01 16:07:24 37630
37630 
先進封裝技術FC/WLCSP的應用與發展分析。
2022-05-06 15:19:12 24
24 先進封裝形式μBGA、CSP的回流焊接技術介紹說明。
2022-05-06 15:17:46 4
4 隨著新一代 IGBT 芯片結溫及功率密度的提高,對功率電子模塊及其封裝技術的要求也越來越高。文
章主要介紹了功率電子模塊先進封裝互連技術的最新發展趨勢,重點比較了芯片表面互連、貼片焊接互連、導電端
2022-05-06 15:15:55 6
6 2021年對于先進封裝行業來說是豐收一年,現在包括5G、汽車信息娛樂/ADAS、人工智能、數據中心和可穿戴應用在內的大趨勢繼續迫使芯片向先進封裝發展。2021年先進封裝市場總收入為321億美元,預計
2022-06-13 14:01:24 2737
2737 先進半導體技術是我國必須搶占的高地,是推動我國現代高科技發展的核心。其中,先進封裝技術的發展是我國半導體全產業鏈邁向全球先進行列的重要環節之一。耐科裝備募資建設研發中心項目,是公司順應行業技術發展
2022-08-10 16:10:28 1674
1674 近年來,先進封裝技術的內驅力已從高端智能手機領域演變為高性能計算和人工智能等領域,涉及高性能處理器、存儲器、人工智能訓練和推理等。當前集成電路的發展受“四堵墻”(“存儲墻”“面積墻”“功耗墻
2022-12-28 14:16:29 6381
6381 來源:半導體芯科技SiSC 近年來,先進封裝市場已成為一條快速賽道,傳統封裝技術演進到先進2.5D/3D封裝技術已經成為未來的重點發展方向。“芯片國產化”的興起帶動封裝需求,同時先進封裝技術開始積極
2023-02-28 11:32:31 4771
4771 
來源:SiSC半導體芯科技 近年來,先進封裝市場已成為一條快速賽道,傳統封裝技術演進到先進2.5D/3D封裝技術已經成為未來的重點發展方向。“芯片國產化”的興起帶動封裝需求,同時先進封裝技術開始積極
2023-03-06 18:07:31 1479
1479 
芯片升級的兩個永恒主題:性能、體積/面積。芯片技術的發展,推動著芯片朝著高性能和輕薄化兩個方向提升。而先進制程和先進封裝的進步,均能夠使得芯片向著高性能和輕薄化前進。面對美國的技術封裝,華為難以在
2023-04-15 09:48:56 4395
4395 1 SiP技術的主要應用和發展趨勢 1. SiP技術的主要應用和發展趨勢
2.自主設計SiP產品介紹
3.高密度SiP封裝主要技術挑戰
4. SiP技術帶動MCP封裝工藝技術的發展
5. SiP技術促進BGA封裝技術的發展
6. SiP催生新的先進封裝技術的發展
2023-05-19 11:34:27 3386
3386 
半導體產品在由二維向三維發展,從技術發展方向半導體產品出現了系統級封裝(SiP)等新的封裝方式,從技術實現方法出現了倒裝(FlipChip),凸塊(Bumping),晶圓級封裝(Wafer
2023-08-05 09:54:29 1021
1021 
半導體產品在由二維向三維發展,從技術發展方向半導體產品出現了系統級封裝(SiP)等新的封裝方式,從技術實現方法出現了倒裝(FlipChip),凸塊(Bumping),晶圓級封裝
2023-08-14 09:59:24 1258
1258 
來源:ACT半導體芯科技 2023年8月31日 “先進封裝技術之設計·材料·工藝新發展” 在線主題會議已圓滿結束! 會議當天,演講嘉賓們的精彩分享 引得在線聽眾踴躍提問 由于時間原因 很多問題都嘉賓
2023-09-08 15:40:38 877
877 
焊線封裝是半導體封裝過程中的一種關鍵技術,用于連接芯片和外部電路。隨著半導體技術的進步,焊線封裝也經歷了多種技術的發展和創新。以下是關于焊線封裝技術的詳細介紹。
2023-09-13 09:31:25 2731
2731 
先進封裝技術以SiP、WLP、2.5D/3D為三大發展重點。先進封裝核心技術包括Bumping凸點、RDL重布線、硅中介層和TSV通孔等,依托這些技術的組合各廠商發展出了滿足多樣化需求的封裝解決方案,SiP系統級封裝、WLP晶圓級封裝、2.5D/3D封裝為三大發展重點。
2023-09-28 15:29:37 4970
4970 
隨著半導體工藝的不斷發展,先進封裝技術正在迅速發展,封裝設備市場也將迎來新的發展機遇。作為先進封裝設備中的關鍵設備之一,劃片機的發展也備受關注。劃片機是用于切割晶圓或芯片的設備,其精度和穩定性
2023-10-18 17:03:28 1324
1324 
半導體產品在由二維向三維發展,從技術發展方向半導體產品出現了系統級封裝(SiP)等新的封裝方式,從技術實現方法出現了倒裝(FlipChip),凸塊(Bumping),晶圓級封裝(Waferlevelpackage),2.5D封裝(interposer,RDL等),3D封裝(TSV)等先進封裝技術。
2023-10-31 09:16:29 3859
3859 
史、主流技術和應用場景,以及面臨的挑戰和問題。進而提出采用Chiplet技術,將不同的功能模塊獨立集成為獨立的Chiplet,并融合在一個AI芯片上,從而實現更高的計算能力。該設計不僅允許獨立開發和升級各個模塊,還可在封裝過程中將它們巧妙組合起
2023-12-08 10:28:07 2174
2174 
先進的封裝技術可以將多個半導體芯片和組件集成到高性能的系統中。隨著摩爾定律的縮小趨勢面臨極限,先進封裝為持續改善計算性能、節能和功能提供了一條途徑。但是,與亞洲相比,美國目前在先進封裝技術方面落后
2023-12-14 10:27:14 2276
2276 
共讀好書 半導體產品在由二維向三維發展,從技術發展方向半導體產品出現了系統級封裝(SiP)等新的封裝方式,從技術實現方法出現了倒裝(FlipChip),凸塊(Bumping),晶圓級封裝(Wafer
2024-02-21 10:34:20 1565
1565 
先進封裝開辟了 More-than-Moore的集成電路發展路線,能夠在不縮小制程節點的背景下,僅通過改進封裝方式就能提升芯片性能,還能夠打破“存儲墻”和“面積墻”。
2024-02-26 11:22:10 8616
8616 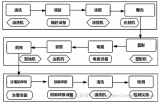
的電、熱、光和機械性能,決定著電子產品的大小、重量、應用方便性、壽命、性能和成本。針對集成電路領域先進封裝技術的現狀以及未來的發展趨勢進行了概述,重點針對現有的先進封裝技術,如晶圓級封裝、2.5D 和 3D 集成等先進封裝
2024-06-23 17:00:24 3482
3482 
隨著人工智能(AI)技術的迅猛發展,我們正站在第四次工業革命的風暴中, 這場風暴也將席卷我們整個芯片行業,特別是先進封裝領域。Chiplet是實現單個芯片算力提升的重要技術,也是AI網絡片內互聯
2024-09-11 09:47:02 1888
1888 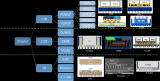
隨著半導體技術的飛速發展,摩爾定律逐漸逼近物理極限,傳統依靠縮小晶體管尺寸來提升性能的方法面臨嚴峻挑戰。在此背景下,先進封裝技術作為超越摩爾定律的重要途徑,正成為半導體行業新的焦點。晶圓廠和封測廠
2024-09-24 10:48:41 1615
1615 
之一。本文介紹了微凸點 制備的主要技術并進行優劣勢比較,同時詳述了錫球凸點和銅柱凸點兩種不同的微凸點結構,為微凸點技術的更深入研究提供 參考。最后,本文整理了微凸點技術在先進封裝中的應用,并展望了未來的發展趨勢。
2024-10-16 11:41:37 2939
2939 
隨著半導體技術的不斷發展,先進封裝作為后摩爾時代全球集成電路的重要發展趨勢,正日益受到廣泛關注。受益于AI、服務器、數據中心、汽車電子等下游強勁需求,半導體封裝朝著多功能、小型化、便攜式的方向發展
2024-10-28 09:10:22 2681
2681 
科技在不斷突破與創新,半導體技術在快速發展,芯片封裝技術也從傳統封裝發展到先進封裝,以更好地滿足市場的需求。先進封裝是相對傳統封裝所提出的概念,英文Advanced Packaging。
2024-10-28 15:29:10 1886
1886 
半導體封裝已從傳統的 1D PCB 設計發展到晶圓級的尖端 3D 混合鍵合。這一進步允許互連間距在個位數微米范圍內,帶寬高達 1000 GB/s,同時保持高能效。先進半導體封裝技術的核心是 2.5D
2024-11-05 11:22:04 1778
1778 
、電氣性能較差以及焊接溫度導致的芯片或基板翹曲等問題。在這樣的背景下,先進封裝技術應運而生,成為推動半導體行業繼續前行的關鍵力量。 一、集成電路封裝發展概況 半導體業界已明確五大增長引擎,這些應用推動了電子封裝技術的不
2024-11-26 09:59:25 1678
1678 
Advanced Packaging) - 4 Chiplet 異構集成(下) 先進封裝技術(Semiconductor Advanced Packaging) - 5 TSV 異構集成與等效熱仿真 隨著電子信息技術的快速發展,半導體電子行業及其基礎制造技術已成為過去半個世紀最重要的發展之一,集成
2024-12-06 11:37:46 3694
3694 
先進封裝技術(Semiconductor Advanced Packaging) - 1 混合鍵合技術(上) 先進封裝技術(Semiconductor Advanced Packaging) - 2
2024-12-06 11:43:41 4730
4730 
隨著人工智能、高性能計算為代表的新需求的不斷發展,先進封裝技術應運而生,與傳統的后道封裝測試工藝不同,先進封裝的關鍵工藝需要在前道平臺上完成,是前道工序的延伸。CoWoS作為英偉達-這一新晉市值冠軍
2024-12-17 10:44:27 4456
4456 
Hello,大家好,今天我們來分享下什么是先進封裝中的TSV/硅通孔技術。 TSV:Through Silicon Via, 硅通孔技術。指的是在晶圓的硅部分形成一個垂直的通道,利用這個垂直的通道
2024-12-17 14:17:51 3345
3345 
先進封裝簡介 先進封裝技術已成為半導體行業創新發展的主要推動力之一,為突破傳統摩爾定律限制提供了新的技術手段。本文探討先進封裝的核心概念、技術和發展趨勢[1]。 圖1展示了硅通孔(TSV)技術
2024-12-18 09:59:38 2451
2451 
在先進封裝技術蓬勃發展的背景下,瑞沃微先進封裝:1、首創面板級化學I/O鍵合技術。2、無載板鍵合RDL一次生成技術。3、新型TSV/TGV技術。4、新型Bumping技術。5、小于10微米精細線寬RDL技術。6、新型巨量轉移貼片技術等六大技術緊隨其后!
2024-12-03 13:49:08 1387
1387 
引言 隨著人工智能(AI)和高性能計算(HPC)應用的快速發展,半導體產業正面臨挑戰與機遇。計算能力、內存帶寬和能源效率需求的持續提升,使得半導體制程不斷挑戰性能極限。在這個背景下,先進封裝技術已經
2024-12-24 09:32:26 2322
2322 
先進封裝技術(Semiconductor Advanced Packaging) - 1 混合鍵合技術(上) 先進封裝技術(Semiconductor Advanced Packaging) - 2
2024-12-24 10:57:32 3383
3383 
先進封裝技術(Semiconductor Advanced Packaging) - 1 混合鍵合技術(上) 先進封裝技術(Semiconductor Advanced Packaging) - 2
2024-12-24 10:59:43 3078
3078 
(SAMSUNG)了。 隨著先進封裝技術的發展,芯片制造和封裝測試逐漸融合,我們驚奇地發現,在先進封裝領域的高端玩家,竟然也是臺積電、英特爾和三星,而傳統的封測廠商,已經被他們遠遠地拋在身后。 那么,這三家的先進封裝到底有什么獨到之處呢?他們
2025-01-03 11:37:44 1863
1863 
先進封裝技術(Semiconductor Advanced Packaging) - 1 混合鍵合技術(上) 先進封裝技術(Semiconductor Advanced Packaging) - 2
2025-01-08 11:17:01 3032
3032 
封裝方式的演進,2.5D/3D、Chiplet等先進封裝技術市場規模逐漸擴大。 傳統有機基板在先進封裝中面臨晶圓翹曲、焊點可靠性問題、封裝散熱等問題,硅基封裝晶體管數量即將達技術極限。 相比于有機基板,玻璃基板可顯著改善電氣和機械性能,
2025-01-09 15:07:14 3196
3196 
3D封裝與系統級封裝概述 一、引言:先進封裝技術的演進背景 隨著摩爾定律逐漸逼近物理極限,半導體行業開始從單純依賴制程微縮轉向封裝技術創新。3D封裝和系統級封裝(SiP)作為突破傳統2D平面集成限制
2025-03-22 09:42:56 1794
1794 
在集成電路(IC)產業中,封裝是不可或缺的一環。它不僅保護著脆弱的芯片,還提供了與外部電路的連接接口。隨著電子技術的不斷發展,IC封裝技術也在不斷創新和進步。本文將詳細探討IC封裝產線的分類,重點介紹金屬封裝、陶瓷封裝以及先進封裝等幾種主要類型。
2025-03-26 12:59:58 2174
2174 
本文聚焦于先進碳化硅(SiC)功率半導體封裝技術,闡述其基本概念、關鍵技術、面臨挑戰及未來發展趨勢。碳化硅功率半導體憑借低內阻、高耐壓、高頻率和高結溫等優異特性,在移動應用功率密度提升的背景下
2025-04-08 11:40:33 1493
1493 
在先進制程遭遇微縮瓶頸的背景下,先進封裝朝著 3D 異質整合方向發展,成為延續摩爾定律的關鍵路徑。3D 先進封裝技術作為未來的發展趨勢,使芯片串聯數量大幅增加。
2025-04-09 15:29:02 1022
1022 在半導體行業,芯片制造工藝的發展逐漸逼近物理極限,摩爾定律的推進愈發艱難。在此背景下,先進封裝技術成為提升芯片性能、實現系統集成的關鍵路徑,成為全球科技企業角逐的新戰場。近期,華為的先進封裝技術突破
2025-06-19 11:28:07 1256
1256 前面分享了先進封裝的四要素一分鐘讓你明白什么是先進封裝,今天分享一下先進封裝四要素中的再布線(RDL)。
2025-07-09 11:17:14 3219
3219 
半導體傳統封裝與先進封裝的分類及特點
2025-07-30 11:50:18 1058
1058 
 電子發燒友App
電子發燒友App


































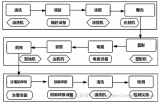

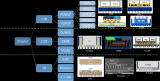


























評論