電子發燒友網報道(文/吳子鵬)熱壓鍵合技術(TC Bonding)作為一種先進封裝技術,通過同時施加熱量與壓力實現材料連接。其核心原理是借助熱能促使金屬凸點(如銅凸點)表面原子擴散,并結合機械壓力形成原子級鍵合,進而構建起穩定的電氣與機械連接。
在 SEMICON CHINA 2025 前夕,庫力索法執行副總裁兼總經理張贊彬(Chan Pin Chong)在接受媒體采訪時表示,隨著 AI 芯片尺寸持續增大,芯片利用率仍有提升空間,因此市場正逐步從傳統圓形晶圓(Wafer)向更大的方形 Panel 轉變。當前市場策略是從 310×310mm 發展至 600×600mm,這一趨勢旨在滿足 AI 發展帶來的更大封裝需求。針對這一趨勢,TC Bonding 技術具備諸多關鍵優勢:其一為無焊劑(Fluxless);其二是能夠實現超高密度封裝,間距可達 10 微米以下;其三是采用銅 - 銅結合方式,適配更大的 Panel Size。
基于此,張贊彬認為,目前 TC Bonding 依舊是市場上最為熱門的技術,而 Hybrid Bonding 可能在更晚時間才會廣泛應用。
TC Bonding 的優勢及庫力索法的設備方案?
正如張贊彬所說,在先進封裝領域,TC Bonding 具有眾多顯著優勢。首先,TC Bonding 的無焊劑(Fluxless)特性能夠大幅提升鍵合精度,減少傳統回流焊中常見的翹曲、偏移或橋接等缺陷。其次,TC Bonding 可拓展至多種材料體系,例如銅 - 銅直接鍵合,使其能夠契合未來的封裝需求。
庫力索法先進封裝事業部產品經理趙華闡述了該公司研發無焊劑(Fluxless)TC Bonding 的原因。隨著鍵合間距(bond pitch)不斷縮小,當 bond pitch 小于 45 微米時,芯片中間密度會越來越高,此時傳統助焊劑方式容易出現助焊劑清洗不徹底的情況。而且,目前針對助焊劑清洗是否干凈尚無標準檢測方法,只能在后續可靠性測試中才會發現助焊劑殘留問題,這給眾多客戶帶來了困擾。而庫力索法的無焊劑(Fluxless)TC Bonding 解決方案采用甲酸蒸汽去除錫或銅表面的氧化物,有效避免了這一問題。
更為關鍵的是,除了邏輯大芯片,現階段先進封裝的幾乎每一個步驟都離不開 TC Bonding。它能夠支持基板級和晶圓級封裝,為多芯片異構集成(如 EMIB、Foveros)奠定技術基礎。因其適用于高密度互連場景,已成為 HBM 主要堆疊技術之一。張贊彬指出,HBM 可能涉及 8 層、12 層甚至 16 層以上的堆疊,所以在 HBM 領域,TC Bonding 的需求量預計將遠超邏輯芯片,市場規模也將進一步擴大。“我們預計,TC Bonding 的總可用市場(TAM)可能超過 3 億美元(現有市場規模)。”?
當前,全球 HBM 市場正處于爆發階段。高盛研究報告顯示,預計 2023 年至 2026 年間,全球 HBM(高帶寬存儲芯片)市場規模將迎來約 100% 的復合年增長率,并在 2026 年達到 300 億美元的驚人規模。在市場的積極推動下,TC Bonding 的市場前景十分樂觀。
庫力索法推出的 APTURA 系列設備便是其 TC Bonding 解決方案,目前該系列有兩種型號,分別適用于芯片和基板(substrate)。據介紹,APTURA 系列設備能夠完全解決超大晶片及超精細微型凸塊中助焊劑殘留的問題,同時有助于異構集成以及將小晶片的微型凸塊焊接間距從 35μm 縮小至 10μm。?
談及技術迭代,張贊彬認為,Flip - chip 倒裝封裝從 100 微米發展到 70 微米,若要實現 50 微米以下的封裝間距,則需要 TC Bonding。目前,庫力索法的 TC Bonding 解決方案已能實現 10μm 以下的間距,而此前 10μm 以下的間距需要借助 Hybrid Bonding。如今有了庫力索法的方案,Hybrid Bonding 的布局時間得以進一步延后。
實際上,Hybrid Bonding 作為先進封裝的核心技術,雖然為 3D 集成和異構封裝提供了突破性解決方案,但在工藝實現、材料兼容性和量產能力等方面仍面臨諸多挑戰。更為棘手的是,Hybrid Bonding 嚴重依賴高精度設備,且需要額外工藝(如臨時鍵合 / 解鍵合、表面活化),導致整體成本居高不下。因此,張贊彬在采訪中表示,Hybrid Bonding 是一項大額投資,現階段 TC Bonding 具有顯著的性價比優勢。
趙華對 TC Bonding 和 Hybrid Bonding 進行了對比。首先是化學機械拋光(CMP),Hybrid Bonding 對 CMP 的要求極高,甚至要求達到 0.3 - 0.5 納米。相比之下,無焊劑(Fluxless)的 TC Bonding 在進行 Cu - CU Bonding 時,CMP 達到 3 納米左右即可。
其次是切割(Dicing),Hybrid Bonding 必須采用等離子切割,因為等離子能夠更好地控制顆粒(particle)的產生。若 Hybrid Bonding 過程中有一顆或兩顆 particle 存在于芯片中間,就會引發虛焊。而無焊劑(Fluxless)的 TC Bonding 僅需采用傳統刀切以及標準水洗即可。
再者是潔凈度要求,Hybrid Bonding 對工廠環境要求極高,甚至需達到 Class10 標準,機器則要達到 Class1 標準,這一標準等同于晶圓廠標準;而無焊劑(Fluxless)的 TC Bonding 只需在千級環境下即可,傳統封裝廠便能滿足這一要求,無需進行高額投資打造無塵環境。?
多設備亮相 SEMICON CHINA 2025
在 SEMICON CHINA 2025 上,庫力索法特別設置了無焊劑(Fluxless)TC Bonding 展區,同時還展示了一些新設備,如全新垂直線焊解決方案 ——ATPremier MEM PLUS?等。
ATPremier MEM PLUS?是庫力索法專為晶圓級存儲器件打造的球焊和線焊技術方案平臺,通過創新的垂直線焊技術,能夠解決當今快速發展的半導體市場中新興的高端存儲器應用問題。ATPremier MEM PLUS?的主要特性包括:?
·卓越的成本效益(CoO)優勢?
·先進的工藝能力,可滿足復雜的 memory 封裝需求?
·全線影像系統和檢測功能?
·能夠支持最大 300mm 的晶圓?
·自動晶圓送料系統?
庫力索法球焊機事業部資深產品經理范凱表示,ATPremier MEM PLUS?可提供三個主體模塊制程:傳統線焊鍵合方案支持、垂直線應用、球焊倒裝焊工藝支持。此外,在設備硬件方面,ATPremier MEM PLUS?也進行了拓展,配備了更優質的視覺系統。針對晶圓體迭代以及疊層芯片結構,視覺系統需要針對每一層不同芯片更清晰地識別焊接位置,這就需要拓展鏡頭。針對影像系統,ATPremier MEM PLUS?還提供配套監控檢查類功能。設備主體可支持 8 寸及 12 寸晶圓的應用,能夠提供晶圓級的互聯配套方案。
智能結果導向工藝套件是 ATPremier MEM PLUS?的一大亮點,包括:?
·針對第一焊點的球焊,該方案提供的 ProVertical 和 ProCascade Loop 可滿足垂直線焊和階梯線焊的精密互聯需求,從而確保存儲器應用的最佳性能。?
·針對優化類工具,如存儲類器件存在一些懸空(Overhang)結構,該方案也具備通過懸空方式進行芯片形變探測的功能,針對形變量擁有自我學習和優化工藝的工具。?
·針對疊層芯片需要可變焦鏡頭伸縮的配套能力,ATPremier MEM PLUS?提供可變焦視覺系統,可伸縮跨度可達 900 微米。?
·該解決方案提供相應工藝制程類監控功能,例如對垂直線尖端、形狀、線頭狀態進行監測。?
·通過影像系統,可對線弧的弧高進行檢測,針對球焊的球的位置大小、焊接精度是否存在工藝問題,也會提供相應監測。
·針對對位十字線,該解決方案能夠在焊接過程中檢測對位精度,若發現問題可自動糾偏。
因此,ATPremier MEM PLUS?為存儲元件提供了先進的晶圓級封裝能力,ATPremer 平臺旨在服務高端封裝市場,通過消除二維封裝的限制,提供傳統銅柱互聯技術的替代方案。這種新穎的技術能夠支持下一代存儲設備,包括消費類移動設備,從而實現高密度先進封裝的平替。ATPremier 有效降低了封裝的復雜性和成本,滿足了高容積半導體市場不斷增長的需求,助力客戶在競爭激烈的存儲器市場中保持領先地位。
-
封裝
+關注
關注
128文章
9249瀏覽量
148628
發布評論請先 登錄
2D、2.5D與3D封裝技術的區別與應用解析

半導體金線鍵合(Gold Wire Bonding)封裝工藝技術簡介;

熱壓鍵合工藝的技術原理和流程詳解

半導體封裝“焊線鍵合(Wire Bonding)”線弧相關培訓的詳解;

半導體后道制程“芯片鍵合(Die Bonding)”工藝技術的詳解;

混合鍵合(Hybrid Bonding)工藝介紹

從檢測到優化:推拉力測試儀在半導體封裝中的全流程應用解析

混合鍵合工藝介紹

芯片封裝鍵合技術工藝流程以及優缺點介紹




 先進封裝爆發,但TC Bonding讓Hybrid Bonding推遲進入市場
先進封裝爆發,但TC Bonding讓Hybrid Bonding推遲進入市場

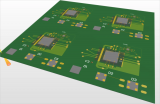








評論