隨著深度神經(jīng)網(wǎng)絡(luò)(DNN)和機(jī)器學(xué)習(xí)(ML)模型參數(shù)數(shù)量的指數(shù)級(jí)增長(zhǎng),AI訓(xùn)練和推理應(yīng)用對(duì)計(jì)算資源(如CPU、GPU和內(nèi)存)的需求不斷增加。
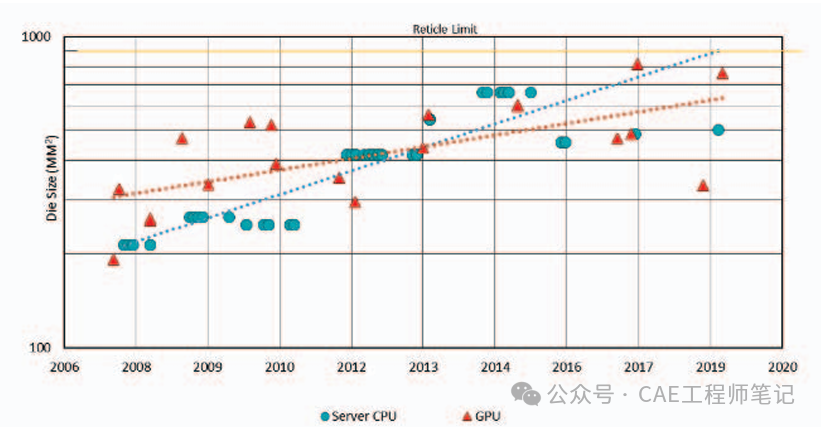
摩爾定律的放緩使得傳統(tǒng)單片系統(tǒng)芯片(SoC)的性能提升受限,而芯片級(jí)架構(gòu)通過(guò)將SoC分解為多個(gè)小芯片(chiplets),利用先進(jìn)封裝技術(shù)實(shí)現(xiàn)高性能和低成本。
芯片級(jí)架構(gòu)通過(guò)將傳統(tǒng)單片系統(tǒng)芯片(SoC)分解為多個(gè)小芯片(chiplets),利用先進(jìn)封裝技術(shù)實(shí)現(xiàn)高性能和低成本。
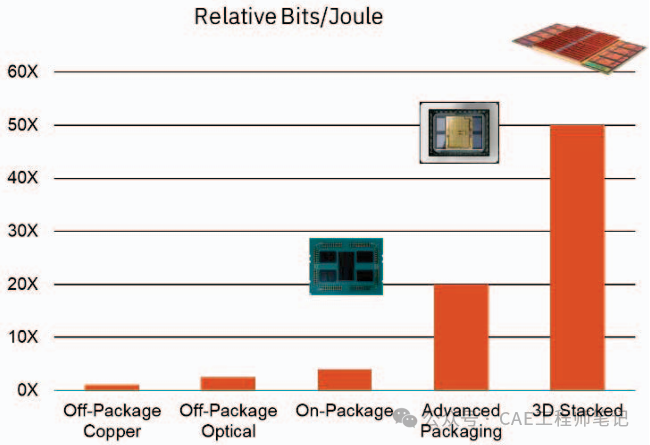
3.5D封裝結(jié)合了2.5D和3D封裝技術(shù)的優(yōu)點(diǎn),通過(guò)硅中介層將多個(gè)3D堆疊芯片(如CPU、GPU、HBM等)連接在一起。
3.5D封裝技術(shù)最簡(jiǎn)單的理解就是3D+2.5D,通過(guò)垂直堆疊芯片并使用銅-銅混合鍵合技術(shù),實(shí)現(xiàn)了更高的性能和密度,創(chuàng)造了一種新的架構(gòu)。能夠縮短信號(hào)傳輸?shù)木嚯x,大幅提升處理速度,這對(duì)于人工智能和大數(shù)據(jù)應(yīng)用尤為重要。
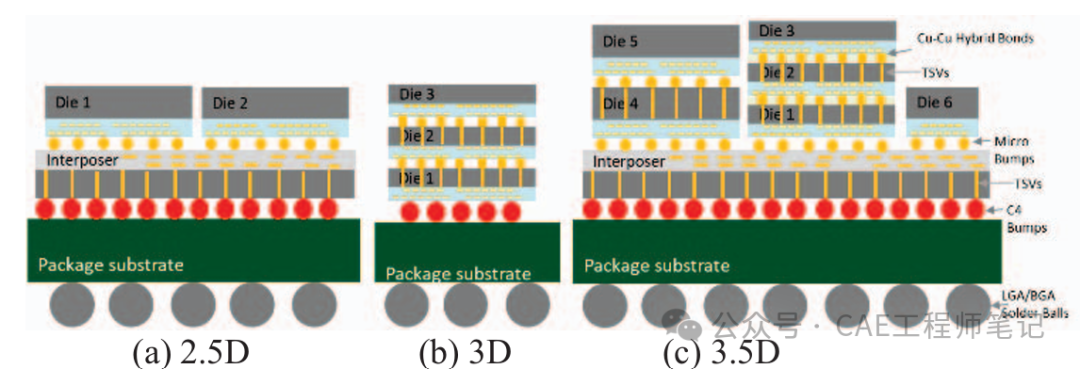
2.5D封裝:多個(gè)芯片并排放置,通過(guò)硅中介層或高密度橋接實(shí)現(xiàn)芯片間互連。
3D封裝:多個(gè)芯片垂直堆疊,通過(guò)銅-銅混合鍵合或微凸點(diǎn)(μbump)實(shí)現(xiàn)互連。
3.5D創(chuàng)新:將3D堆疊芯片與2.5D硅中介層結(jié)合,實(shí)現(xiàn)更高密度的互連。
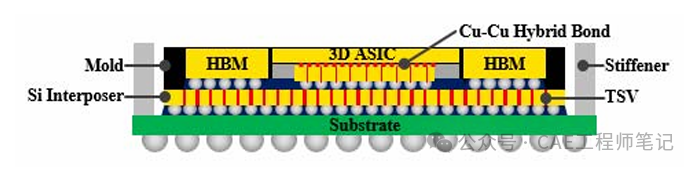
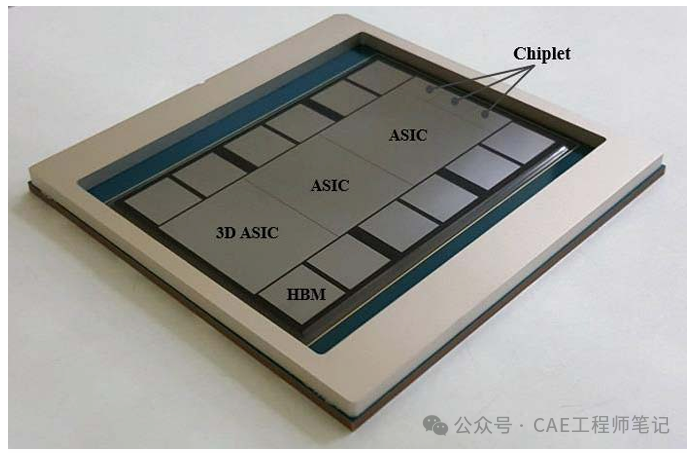
混合鍵合(Hybrid Bonding)技術(shù)成為關(guān)鍵使能者,其特點(diǎn)包括:
微縮互連間距:將傳統(tǒng)40μm凸點(diǎn)間距縮小至1μm級(jí)
三維互連密度:?jiǎn)挝幻娣e互連通道提升10倍以上
結(jié)構(gòu)穩(wěn)定性:銅-銅直接鍵合實(shí)現(xiàn)機(jī)械與電氣雙重連接
熱管理優(yōu)化:減少界面材料層,提升散熱效率
3.5D封裝技術(shù)的關(guān)鍵優(yōu)勢(shì)在于:
高帶寬與低功耗:3D混合鍵合技術(shù)提供了比傳統(tǒng)μbump互連更高的互連密度和更低的功耗。
系統(tǒng)級(jí)效率:通過(guò)緊密集成不同功能的芯片,減少了數(shù)據(jù)傳輸?shù)难舆t和功耗。
模塊化設(shè)計(jì):允許靈活配置不同的芯片組合,如MI300A(CPU+GPU)和MI300X(純GPU)。
AMD的3.5D封裝技術(shù)與AI加速器性能提升
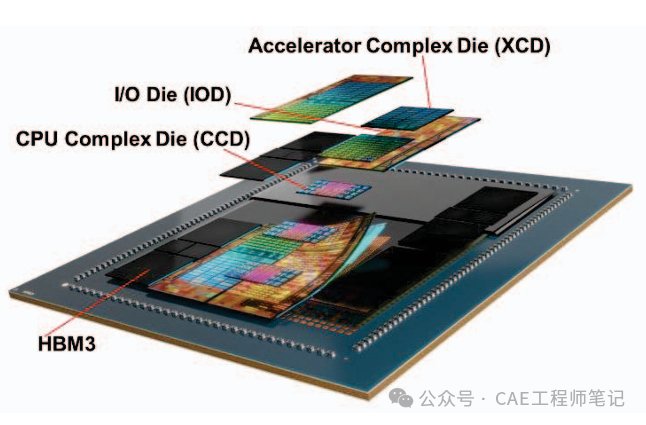
AMD的3.5D技術(shù)通過(guò)結(jié)合2.5D和3D封裝技術(shù)的優(yōu)勢(shì),實(shí)現(xiàn)了高性能計(jì)算(HPC)和人工智能(AI)加速器的異構(gòu)集成。具體來(lái)說(shuō),AMD的3.5D技術(shù)利用了以下三種關(guān)鍵技術(shù)來(lái)實(shí)現(xiàn)異構(gòu)集成:
1.直接銅-銅混合鍵合(Cu-Cu Hybrid Bonding)
銅-銅混合鍵合技術(shù)是實(shí)現(xiàn)3D堆疊芯片之間高密度、低功耗互連的關(guān)鍵。AMD在MI300X Instinct加速器中使用了銅-銅混合鍵合技術(shù),將多個(gè)CPU或GPU芯片垂直堆疊在一起。這種技術(shù)的主要優(yōu)勢(shì)包括:
高互連密度:相比傳統(tǒng)的微凸點(diǎn)(μbump)技術(shù),銅-銅混合鍵合可以實(shí)現(xiàn)更高的互連密度,從而顯著提高芯片之間的數(shù)據(jù)傳輸速率。
低功耗:銅-銅混合鍵合技術(shù)能夠降低互連的功耗,提高系統(tǒng)的能效。
低延遲:由于互連距離的縮短,數(shù)據(jù)傳輸延遲也相應(yīng)降低。
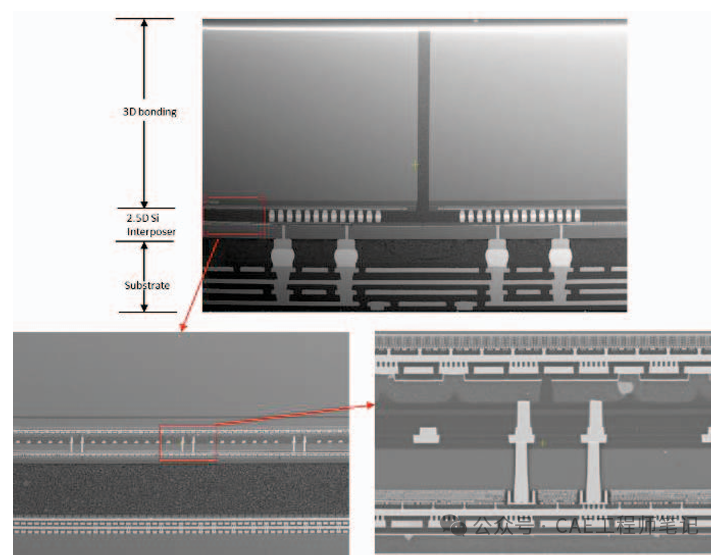
2.2.5D集成在大型硅中介層上
AMD開(kāi)發(fā)了一種大型硅中介層(Silicon Interposer),用于連接多個(gè)3D堆疊芯片和其他組件。硅中介層的主要作用包括:
高帶寬互連:通過(guò)硅中介層,可以實(shí)現(xiàn)多個(gè)芯片之間的高速互連。例如,AMD的MI300X加速器使用了2.5D硅中介層來(lái)連接3D堆疊的CPU/GPU芯片、高帶寬存儲(chǔ)器(HBM)和無(wú)源元件。
模塊化設(shè)計(jì):硅中介層允許將不同的功能模塊(如CPU、GPU、HBM等)集成到一個(gè)封裝中,從而實(shí)現(xiàn)靈活的系統(tǒng)設(shè)計(jì)。例如,MI300A和MI300X是兩種不同的產(chǎn)品配置,分別針對(duì)高性能計(jì)算(HPC)和人工智能(AI)應(yīng)用進(jìn)行了優(yōu)化。
擴(kuò)展性:大型硅中介層可以容納更多的芯片和組件,從而支持更復(fù)雜的系統(tǒng)集成。AMD的MI300X加速器使用了約3000mm2的硅中介層,是光刻掩模面積的3.6倍。
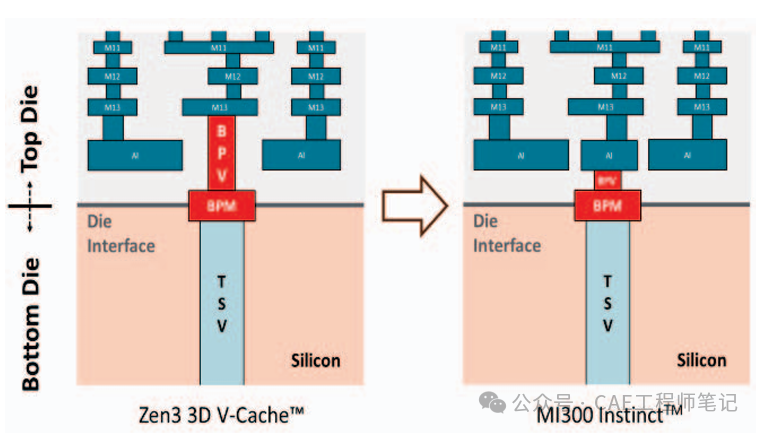
3.基于金屬熱界面材料(TIM)的冷卻解決方案
為了確保高性能計(jì)算和人工智能應(yīng)用中的散熱需求,AMD采用了金屬熱界面材料(TIM)來(lái)提高散熱效率。這種冷卻解決方案的主要特點(diǎn)包括:
高效散熱:金屬TIM材料具有較高的熱導(dǎo)率,能夠有效傳導(dǎo)熱量,確保芯片在高負(fù)載下的穩(wěn)定運(yùn)行。
可靠性:金屬TIM材料在高溫和長(zhǎng)時(shí)間運(yùn)行中表現(xiàn)出良好的可靠性,能夠滿(mǎn)足高性能計(jì)算和人工智能應(yīng)用的需求。
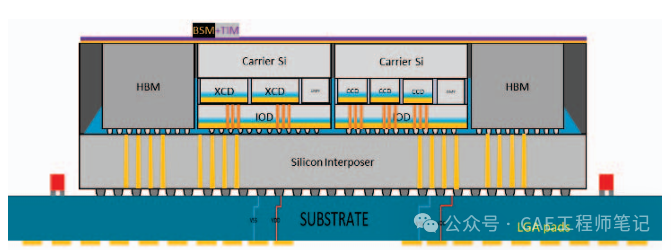
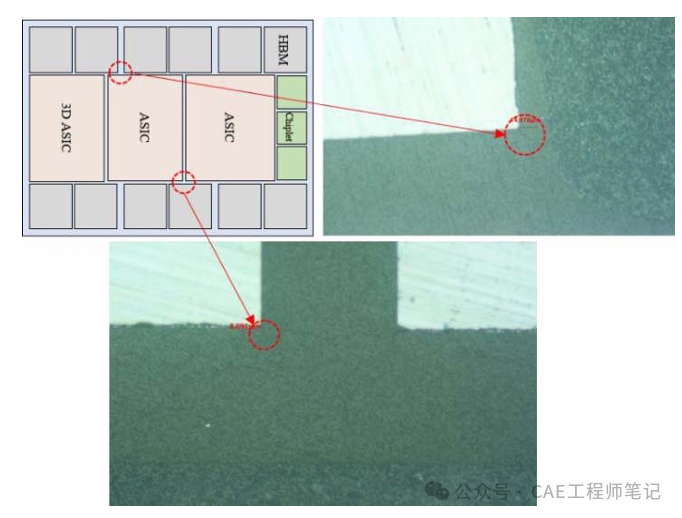
AMD的3.5D技術(shù)為高性能計(jì)算和人工智能應(yīng)用提供了一種高效、靈活且可靠的解決方案,顯著提升了系統(tǒng)的性能和能效。
高性能:通過(guò)高密度的銅-銅混合鍵合和2.5D硅中介層,實(shí)現(xiàn)了CPU、GPU和HBM之間的高速互連,顯著提高了系統(tǒng)的性能。
高能效:銅-銅混合鍵合技術(shù)降低了互連功耗,提高了系統(tǒng)的能效。
靈活性:模塊化設(shè)計(jì)允許根據(jù)不同的應(yīng)用需求進(jìn)行定制,如MI300A和MI300X分別針對(duì)HPC和AI應(yīng)用進(jìn)行了優(yōu)化。
擴(kuò)展性:大型硅中介層可以容納更多的芯片和組件,支持更復(fù)雜的系統(tǒng)集成。
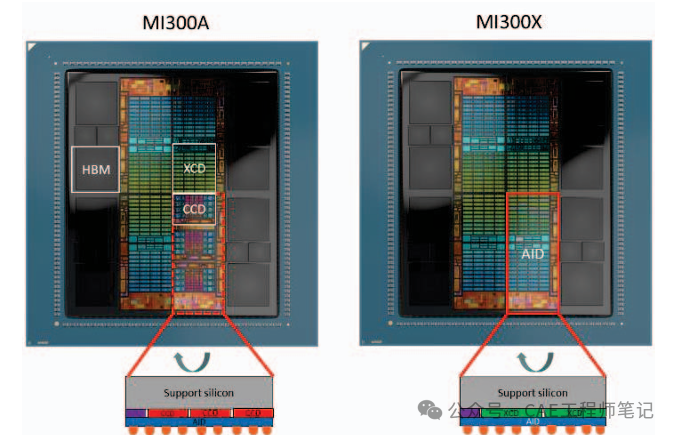
AMD的3.5D技術(shù)在AI加速器性能提升方面表現(xiàn)顯著,主要體現(xiàn)在以下幾個(gè)關(guān)鍵方面:
1.計(jì)算性能提升
更高的互連密度:通過(guò)銅-銅混合鍵合技術(shù),3.5D技術(shù)實(shí)現(xiàn)了比傳統(tǒng)微凸點(diǎn)(μbump)技術(shù)更高的互連密度。這使得CPU、GPU和內(nèi)存之間的數(shù)據(jù)傳輸速率大幅提高,從而顯著提升了計(jì)算性能。
多芯片集成:3.5D技術(shù)允許將多個(gè)CPU或GPU芯片垂直堆疊在一起,形成3D堆疊結(jié)構(gòu)。這種結(jié)構(gòu)不僅提高了計(jì)算密度,還通過(guò)縮短互連距離降低了延遲。例如,AMD的MI300X加速器通過(guò)3D堆疊技術(shù)集成了多個(gè)GPU芯片,顯著提升了并行計(jì)算能力。
2.內(nèi)存帶寬提升
高帶寬存儲(chǔ)器(HBM)集成:3.5D技術(shù)通過(guò)2.5D硅中介層將高帶寬存儲(chǔ)器(HBM)與CPU/GPU緊密集成在一起。HBM提供了極高的內(nèi)存帶寬,這對(duì)于AI訓(xùn)練和推理任務(wù)中的大規(guī)模并行數(shù)據(jù)操作至關(guān)重要。例如,MI300X加速器支持高達(dá)5324.8 GB/s的HBM3峰值內(nèi)存帶寬,相比上一代產(chǎn)品(如MI250X)提升了約62%。
統(tǒng)一內(nèi)存架構(gòu):在MI300A加速器中,CPU和GPU共享統(tǒng)一的HBM內(nèi)存空間,消除了傳統(tǒng)APU中CPU和GPU使用不同內(nèi)存類(lèi)型導(dǎo)致的數(shù)據(jù)傳輸延遲和冗余內(nèi)存拷貝問(wèn)題。這種統(tǒng)一內(nèi)存架構(gòu)簡(jiǎn)化了HPC編程,提高了數(shù)據(jù)傳輸效率。
3.能效提升
低功耗互連:銅-銅混合鍵合技術(shù)不僅提高了互連密度,還顯著降低了互連功耗。相比傳統(tǒng)的μbump技術(shù),銅-銅混合鍵合技術(shù)可以實(shí)現(xiàn)更高的能效比。
模塊化設(shè)計(jì):3.5D技術(shù)的模塊化設(shè)計(jì)允許根據(jù)不同的應(yīng)用需求進(jìn)行靈活配置,從而在性能和功耗之間實(shí)現(xiàn)更好的平衡。例如,MI300A和MI300X分別針對(duì)HPC和AI應(yīng)用進(jìn)行了優(yōu)化,以滿(mǎn)足不同的性能和功耗需求。
4.系統(tǒng)級(jí)性能提升
緊密集成:3.5D技術(shù)通過(guò)將多個(gè)功能模塊(如CPU、GPU、HBM等)緊密集成在一個(gè)封裝內(nèi),減少了芯片之間的通信延遲,提高了系統(tǒng)的整體性能。
更高的計(jì)算密度:通過(guò)3D堆疊和2.5D硅中介層的結(jié)合,3.5D技術(shù)在相同的封裝尺寸內(nèi)集成了更多的計(jì)算資源,從而提高了計(jì)算密度和性能。
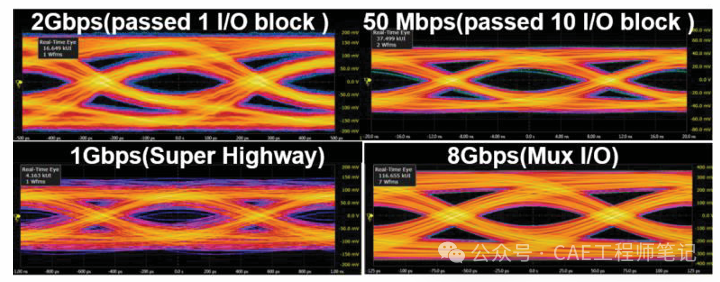

AI加速器性能提升具體數(shù)據(jù):
矩陣FMA FP16 KOPS/CLK:MI300X加速器相比上一代MI250X加速器,矩陣FMA FP16 KOPS/CLK性能提升了2.5倍。
HBM容量和帶寬:MI300X加速器的HBM容量和峰值帶寬相比MI250X提升了1.5倍。
系統(tǒng)級(jí)性能:MI300X加速器在AI訓(xùn)練和推理任務(wù)中的整體性能顯著提升,特別是在處理大規(guī)模并行數(shù)據(jù)操作時(shí)表現(xiàn)尤為突出。
AMD的3.5D技術(shù)通過(guò)高密度互連、多芯片集成、高帶寬內(nèi)存和模塊化設(shè)計(jì),顯著提升了AI加速器的性能。具體來(lái)說(shuō),3.5D技術(shù)在計(jì)算性能、內(nèi)存帶寬和能效方面都取得了顯著的提升,使得AI加速器能夠更高效地處理復(fù)雜的AI訓(xùn)練和推理任務(wù)。這種技術(shù)不僅提高了系統(tǒng)的整體性能,還為未來(lái)的高性能計(jì)算和人工智能應(yīng)用提供了強(qiáng)大的支持。
3.5D封裝與AI訓(xùn)練降本
3.5D技術(shù)通過(guò)多種方式降低了AI訓(xùn)練的成本,主要體現(xiàn)在硬件設(shè)計(jì)、制造成本、功耗和運(yùn)營(yíng)成本等方面。
1.硬件設(shè)計(jì)與制造成本
模塊化設(shè)計(jì):3.5D技術(shù)采用模塊化設(shè)計(jì),允許將不同的功能模塊(如CPU、GPU、HBM等)集成到一個(gè)封裝中。這種設(shè)計(jì)不僅提高了系統(tǒng)的靈活性,還降低了開(kāi)發(fā)和制造成本。例如,AMD的MI300A和MI300X加速器分別針對(duì)HPC和AI應(yīng)用進(jìn)行了優(yōu)化,通過(guò)模塊化設(shè)計(jì),可以在不同的產(chǎn)品中復(fù)用相同的芯片模塊,減少了開(kāi)發(fā)成本。
小芯片(Chiplet)架構(gòu):3.5D技術(shù)通過(guò)將傳統(tǒng)的單片系統(tǒng)芯片(SoC)分解為多個(gè)小芯片(Chiplet),并利用先進(jìn)封裝技術(shù)將它們重新連接在一起。這種架構(gòu)不僅提高了性能,還降低了制造成本。小芯片可以在不同的工藝節(jié)點(diǎn)上制造,從而優(yōu)化性能和成本。例如,某些高性能計(jì)算模塊可以采用先進(jìn)的工藝節(jié)點(diǎn),而其他模塊可以采用更成熟的工藝節(jié)點(diǎn),從而在性能和成本之間實(shí)現(xiàn)更好的平衡。
大規(guī)模集成:通過(guò)3D堆疊和2.5D硅中介層的結(jié)合,3.5D技術(shù)在相同的封裝尺寸內(nèi)集成了更多的計(jì)算資源。這種大規(guī)模集成不僅提高了性能,還降低了單位計(jì)算能力的成本。例如,MI300X加速器通過(guò)3D堆疊技術(shù)集成了多個(gè)GPU芯片,顯著提升了并行計(jì)算能力,同時(shí)降低了單位計(jì)算能力的制造成本。
2.功耗與運(yùn)營(yíng)成本
低功耗互連:3.5D技術(shù)通過(guò)銅-銅混合鍵合技術(shù)實(shí)現(xiàn)了高密度、低功耗的互連。相比傳統(tǒng)的微凸點(diǎn)(μbump)技術(shù),銅-銅混合鍵合技術(shù)可以顯著降低互連功耗。這對(duì)于長(zhǎng)時(shí)間運(yùn)行的AI訓(xùn)練任務(wù)尤為重要,因?yàn)榈凸囊馕吨偷倪\(yùn)營(yíng)成本和更高的系統(tǒng)穩(wěn)定性。
高能效:3.5D技術(shù)通過(guò)緊密集成和低延遲互連,提高了系統(tǒng)的整體能效。例如,MI300X加速器在AI訓(xùn)練任務(wù)中的能效比顯著高于上一代產(chǎn)品。高能效不僅降低了功耗,還減少了散熱需求,進(jìn)一步降低了運(yùn)營(yíng)成本。
統(tǒng)一內(nèi)存架構(gòu):在MI300A加速器中,CPU和GPU共享統(tǒng)一的HBM內(nèi)存空間,消除了傳統(tǒng)APU中CPU和GPU使用不同內(nèi)存類(lèi)型導(dǎo)致的數(shù)據(jù)傳輸延遲和冗余內(nèi)存拷貝問(wèn)題。這種統(tǒng)一內(nèi)存架構(gòu)不僅提高了數(shù)據(jù)傳輸效率,還減少了內(nèi)存需求,從而降低了硬件成本。
3.系統(tǒng)級(jí)優(yōu)化
緊密集成:3.5D技術(shù)通過(guò)將多個(gè)功能模塊(如CPU、GPU、HBM等)緊密集成在一個(gè)封裝內(nèi),減少了芯片之間的通信延遲,提高了系統(tǒng)的整體性能。這種緊密集成不僅提高了性能,還減少了系統(tǒng)復(fù)雜性和維護(hù)成本。
高性能與高密度:通過(guò)3D堆疊和2.5D硅中介層的結(jié)合,3.5D技術(shù)在相同的封裝尺寸內(nèi)集成了更多的計(jì)算資源,從而提高了計(jì)算密度和性能。這種高性能和高密度的集成不僅提高了系統(tǒng)的整體性能,還減少了數(shù)據(jù)中心的物理空間需求,降低了數(shù)據(jù)中心的建設(shè)和運(yùn)營(yíng)成本。
快速上市時(shí)間:3.5D技術(shù)的模塊化設(shè)計(jì)和小芯片架構(gòu)允許快速開(kāi)發(fā)和部署新的產(chǎn)品,從而縮短了產(chǎn)品上市時(shí)間。快速上市時(shí)間不僅提高了市場(chǎng)競(jìng)爭(zhēng)力,還降低了開(kāi)發(fā)和運(yùn)營(yíng)成本。
3.5D技術(shù)通過(guò)模塊化設(shè)計(jì)、小芯片架構(gòu)、低功耗互連、高能效設(shè)計(jì)和系統(tǒng)級(jí)優(yōu)化,顯著降低了AI訓(xùn)練的成本。具體來(lái)說(shuō),3.5D技術(shù)在硬件設(shè)計(jì)、制造成本、功耗和運(yùn)營(yíng)成本方面都取得了顯著的提升,使得AI加速器能夠更高效地處理復(fù)雜的AI訓(xùn)練任務(wù)。這種技術(shù)不僅提高了系統(tǒng)的整體性能,還為未來(lái)的高性能計(jì)算和人工智能應(yīng)用提供了強(qiáng)大的支持。
采用3.5D封裝架構(gòu)創(chuàng)新不僅延續(xù)了摩爾定律的經(jīng)濟(jì)效益,更開(kāi)創(chuàng)了"超越摩爾"的新技術(shù)路徑,為下一代計(jì)算平臺(tái)提供核心支撐。
-
soc
+關(guān)注
關(guān)注
40文章
4606瀏覽量
229793 -
先進(jìn)封裝
+關(guān)注
關(guān)注
2文章
553瀏覽量
1053
原文標(biāo)題:先進(jìn)封裝技術(shù)(Semiconductor Advanced Packaging) - 20 3.5D封裝、AMD、AI訓(xùn)練降本
文章出處:【微信號(hào):深圳市賽姆烯金科技有限公司,微信公眾號(hào):深圳市賽姆烯金科技有限公司】歡迎添加關(guān)注!文章轉(zhuǎn)載請(qǐng)注明出處。
發(fā)布評(píng)論請(qǐng)先 登錄
繞開(kāi)先進(jìn)制程卡脖子:2026先進(jìn)封裝成中國(guó)AI芯片自主突圍關(guān)鍵一戰(zhàn)
半導(dǎo)體先進(jìn)封裝之“2.5D/3D封裝技術(shù)”的詳解;


5G、AI爆發(fā),先進(jìn)封裝需求激增,晶圓級(jí)鍵合設(shè)備成關(guān)鍵,但選對(duì)廠家比降價(jià)10%更重要!

先進(jìn)封裝成破局,博通率先落地3.5D,6000mm2超大集成

先進(jìn)封裝時(shí)代,芯片測(cè)試面臨哪些新挑戰(zhàn)?
2D、2.5D與3D封裝技術(shù)的區(qū)別與應(yīng)用解析

3D-Micromac CEO展望2026半導(dǎo)體:AI 為核,激光微加工賦能先進(jìn)封裝

Socionext推出3D芯片堆疊與5.5D封裝技術(shù)

從 2D 到 3.5D 封裝演進(jìn)中焊材的應(yīng)用與發(fā)展




 先進(jìn)封裝技術(shù):3.5D封裝、AMD、AI訓(xùn)練降本
先進(jìn)封裝技術(shù):3.5D封裝、AMD、AI訓(xùn)練降本






評(píng)論