晶圓鍵合是十分重要的一步工藝,本文對(duì)其詳細(xì)介紹。????????????????????????????
什么是晶圓鍵合膠?
晶圓鍵合膠(wafer bonding adhesive)是一種用于將兩個(gè)晶圓永久性或臨時(shí)地粘接在一起的膠黏材料。
怎么鍵合與解鍵合?
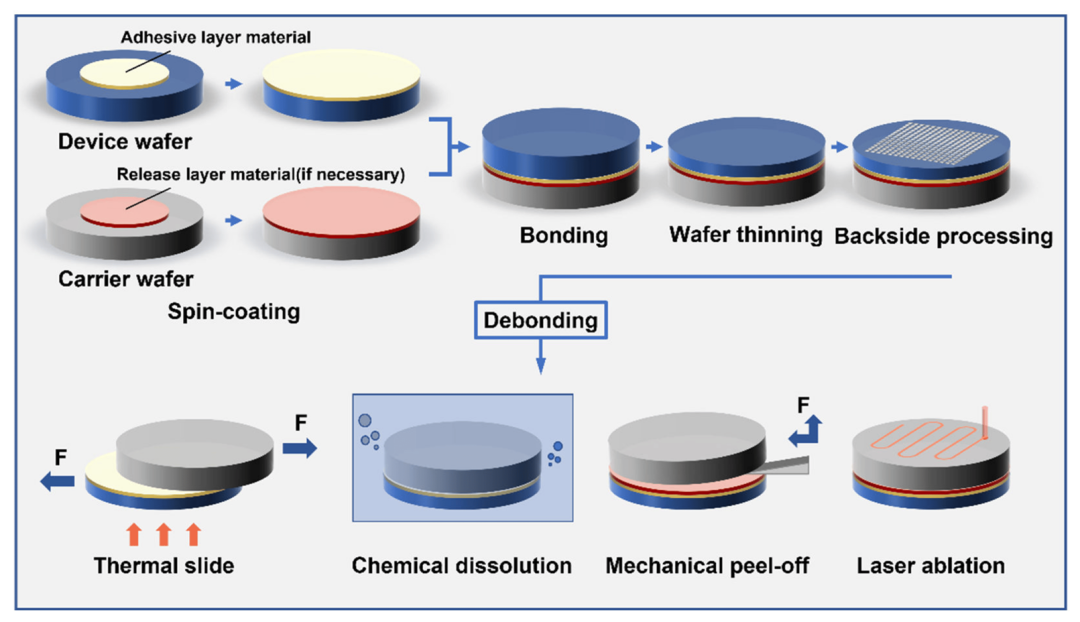
如上圖,鍵合過(guò)程:
1.清潔和處理待鍵合晶圓表面。
2.將兩個(gè)待鍵合的晶圓對(duì)準(zhǔn)并貼合在一起。
3.施加壓力和溫度,促進(jìn)鍵合膠之間的粘接。
4.繼續(xù)保溫,使鍵合材料達(dá)到最佳粘接強(qiáng)度。
解鍵合過(guò)程,有四種方案:
1,熱解鍵合:一種是高溫失去黏性,另一種是高溫將鍵合膠融化,再施加一個(gè)平移力,使其滑動(dòng)分離
2,化學(xué)藥水溶解:利用化學(xué)藥劑溶解鍵合膠
3,機(jī)械剝離,利用機(jī)械力將兩片晶圓分離
4,激光解鍵合:用激光照射晶圓鍵合膠,激光能量被粘合劑材料吸收,導(dǎo)致局部溫度急劇升高,鍵合膠被破壞而使兩片晶圓分離。
目前,12寸的先進(jìn)封裝廠,用激光解鍵合的方式較為普遍。
-
激光
+關(guān)注
關(guān)注
21文章
3694瀏覽量
69782 -
晶圓
+關(guān)注
關(guān)注
53文章
5441瀏覽量
132645
原文標(biāo)題:晶圓鍵合膠如何進(jìn)行鍵合與解鍵合的?
文章出處:【微信號(hào):bdtdsj,微信公眾號(hào):中科院半導(dǎo)體所】歡迎添加關(guān)注!文章轉(zhuǎn)載請(qǐng)注明出處。
發(fā)布評(píng)論請(qǐng)先 登錄
高頻超聲鍵合技術(shù):引線鍵合工藝優(yōu)化與質(zhì)量檢測(cè)方法

半導(dǎo)體封裝引線鍵合技術(shù):超聲鍵合步驟、優(yōu)勢(shì)與推拉力測(cè)試標(biāo)準(zhǔn)

北方華創(chuàng)發(fā)布12英寸芯片對(duì)晶圓混合鍵合設(shè)備Qomola HPD30
聚焦晶圓鍵合檢測(cè):深度解析探頭三大核心參數(shù)的權(quán)衡與選擇

NTC熱敏芯片鍵合工藝介紹
陽(yáng)極鍵合工藝的基本原理和關(guān)鍵參數(shù)
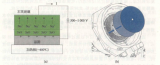
電子元器件失效分析之金鋁鍵合

IGBT 芯片平整度差,引發(fā)鍵合線與芯片連接部位應(yīng)力集中,鍵合失效

鋁絲鍵合的具體步驟
什么是引線鍵合?芯片引線鍵合保護(hù)膠用什么比較好?

芯片封裝中的四種鍵合方式:技術(shù)演進(jìn)與產(chǎn)業(yè)應(yīng)用




 晶圓鍵合膠的鍵合與解鍵合方式
晶圓鍵合膠的鍵合與解鍵合方式








評(píng)論