據IC Insights發布的最新IC市場預測分析報告數據顯示,中國成為2019年純晶圓代工市場增長最快的主要地區。 隨著過去十年來中國無晶圓廠IC公司(例如海思半導體)的興起,該國對代工服務的需求
2020-01-13 10:13:55 7603
7603 常規IC封裝需經過將晶圓與IC封裝基板焊接,再將IC基板焊接至普通PCB的復雜過程。與之不同,WLP基于IC晶圓,借助PCB制造技術,在晶圓上構建類似IC封裝基板的結構,塑封后可直接安裝在普通PCB
2025-05-14 11:08:16 2423
2423 
晶圓是指硅半導體集成電路制作所用的硅晶片,由于其形狀為圓形,故稱為晶圓;在硅晶片上可加工制作成各種電路元件結構,而成為有特定電性功能之IC產品。晶圓的原始材料是硅,而
2011-11-24 09:21:42 8021
8021 半導體設備、封測廠今年將擴大高階覆晶封裝(Flip Chip)研發支出。隨著半導體開始邁入3D IC架構,晶片封裝技術也面臨重大挑戰,因此一線半導體設備廠、封測業者皆積極布局高階覆晶封裝
2013-03-13 09:13:10 1589
1589 (underfills)、基板(substrates)及覆晶封裝焊接器(Flip-Chip bonders)之資訊;該報告更新了對該市場2010~2018年的預測數據、詳細的技術發展藍圖,以及從細節到總體性的方法途徑,并探討了針對 3DIC 與2.5D IC制程應用的微凸塊(micro bumping)封裝技術。
2013-03-21 09:30:27 2063
2063 3D IC將是半導體業者站穩手機晶片市場的必備武器。平價高規智慧型手機興起,已加速驅動內部晶片整合與制程演進;然而,20奈米以下先進制程研發成本極高,但所帶來的尺寸與功耗縮減效益卻相對有限,因此
2013-05-23 09:11:58 1150
1150 今年硅基氮化鎵(GaN-on-Si)基板市場發展急凍。去年5月底,普瑞光電(Bridgelux)與東芝(Toshiba)風光宣布,共同成功開發出基于8吋GaN-on-Si基板技術的發光二極體(LED
2013-06-21 09:18:32 2249
2249 全球最大類比晶片業者德州儀器(Texas Instruments;TI)便購并了奇夢達(Qimonda)、飛索(Spansion)、大陸成芯半導體等業者的晶圓廠,并在新并廠房與原有德州廠房改為12寸晶圓生產類比晶片,預估產線升級與調整可精省40%生產成本。
2015-11-22 13:09:52 745
745 電子發燒友網綜合報道 AMB覆銅陶瓷基板(Active Metal Brazing Ceramic Substrate)是一種通過活性金屬釬焊技術實現陶瓷與銅箔直接結合的高性能電子封裝材料。其核心
2025-12-01 06:12:00 4600
4600 大多數還是會提供只要利用電源IC的技術規格和增加數據,就能完成的基本的基板配線布局范例供用戶參考。有的業者甚至提供光繪文件等能直接利用的數值等。這些由經驗豐富的工程師完成的最佳成果,值得多加利用。以下
2018-11-27 17:05:56
晶圓切割主要采用金剛石砂輪刀片即輪轂型硬刀,半導體從業者不斷尋求能提高加工質量和加工效率的方法,以達到更低的加工成本。本文將分享從切割現場積累的經驗供半導體從業者參考。
2021-08-17 17:32:26
晶圓是指硅半導體集成電路制作所用的硅晶片,由于其形狀為圓形,故稱為晶圓;在硅晶片上可加工制作成各種電路元件結構,而成為有特定電性功能之IC產品。晶圓的原始材料是硅,而地殼表面有用之不竭的二氧化硅
2011-12-01 14:53:05
一般都采用NSMD設計。 NSMD的優點: ·受阻焊膜與基材CTE不匹配的影響小,由此產生的應力集中小; ·利于C4工藝; ·較高的尺寸精度,利于精細間距的CSP或倒裝晶片的裝配
2018-09-06 16:32:27
負載匹配過程,且使用了專業的振蕩IC,提高了產品的穩定性。32.768KHZ 鐘振,采用AT切MHZ晶片通過分頻方式,大大改良了產品的溫度頻差特性。然而,不得不指出,采用MHZ分頻做出的32.768KHZ在功耗上面會略比使用KHZ最為振蕩源的功耗會略大,一般工作輸入電流
2017-05-11 10:44:52
晶振隔振器是一種“彈簧組合型晶體TLC2272AIDR振蕩器用微型隔振器”晶振隔振器的彈性阻尼性能由于晶振自身幾何尺寸很小,質量也只有幾克到幾百克,所以不可能采用傳統的由四個隔振器組成的隔振系統,而
2015-01-08 09:18:00
`小弟我沒做過鋁基板,所以在畫LED PCB圖時,LED有散熱的裸銅,我畫好線路后,不知道如何將裸銅部分連接到鋁板上,PCB板子是否需要覆銅,為什么之前之家做的鋁基板表面看不到任何線路,求指點圖片的鋁基板是怎么做的`
2015-11-27 22:18:04
覆銅在PCB生產工藝中,具有非常重要的地位,有時候覆銅的成敗,關系到整塊板的質量。所謂覆銅,就是把固體銅填充到PCB基板的閑置空間上。覆銅有大面積覆銅和網格覆銅兩種方法,大面積覆銅加大了電流和屏蔽
2017-02-17 11:17:59
尺寸變化。 ⑶刷板時由于采用壓力過大,致使產生壓拉應力導致基板變形。 ⑷基板中樹脂未完全固化,導致尺寸變化。 ⑸特別是多層板在層壓前,存放的條件差,使薄基板或半固化片吸濕,造成尺寸穩定性差
2018-08-29 09:55:14
T型光纖涂覆機技術條件及說明書一、綜述濰坊華纖光電科技2020年初推出兩款全新的半自動/全自動光纖涂覆機(HXGK-T01、HXGK-T02),再涂覆的涂覆層直徑200um~1000um,并可定制
2020-05-17 19:18:31
覆銅需要處理好幾個問題:一是不同地的單點連接,二是晶振附近的覆銅,電路中的晶振為一高頻發射源,做法是在環繞晶振敷銅,然后將晶振的外殼另行接地。三是孤島(死區)問題,如果覺得很大,那就定義個地過孔添加
2013-01-29 15:43:38
先進的制程生產,另也獲得大陸在地晶圓代工業者的支援協助。在銷售方面,大陸IC設計業者仍以在地銷售為主,部分因國外業者的電子產品于大陸組裝生產,為追求支援與速度之便,而選用大陸業者的晶片。此外,因大陸
2013-01-07 17:12:11
、什么是晶振ppm晶振全稱是晶體振蕩器,是指從一塊石英晶體上按一定方位角切下薄片(簡稱為晶片),石英晶體諧振器,簡稱為石英晶體或晶體、晶振;而在封裝內部添加IC組成振蕩電路的晶體元件稱為晶體振蕩器。其
2020-03-16 17:13:02
民幣5220元)以下的晶圓才適用于功率半導體的量產。成功獲得適用于量產功率半導體的、高質量、大尺寸氮化鎵晶圓氮化鎵晶片存在以上問題的根源是其晶體生長方式。目前批量生產的 Bulk氮化鎵晶片采用以下方式制造,利用
2023-02-23 15:46:22
會繼續存在,而且正以15%的增長率在不斷發展。覆銅板行業協會發布的相關信息表明,今后五年,為了適應高密度的BGA技術、半導體封裝技術等發展趨勢,高性能薄型化FR-4、高性能樹脂基板等的比例將越來越大。:
2018-11-23 17:06:24
`晶圓級封裝(WLP)就是在其上已經有某些電路微結構(好比古董)的晶片(好比座墊)與另一塊經腐蝕帶有空腔的晶片(好比玻璃罩)用化學鍵結合在一起。在這些電路微結構體的上面就形成了一個帶有密閉空腔的保護
2011-12-01 13:58:36
半導體晶圓(晶片)的直徑為4到10英寸(10.16到25.4厘米)的圓盤,在制造過程中可承載非本征半導體。它們是正(P)型半導體或負(N)型半導體的臨時形式。硅晶片是非常常見的半導體晶片,因為硅
2021-07-23 08:11:27
什么是遺產型IC?討論一下為什么應該重新使用這些遺產型IC元件?
2021-04-12 06:35:18
:元件長: ·h:元件厚; ·s:元件離板間隙: ·r:邊緣圓角在基板上的寬。 ·n:焊球的數量則 填充材料流動速度或填充的時間除了與其特性相關外,還于晶片尺寸大小,離板間隙以及填充材料
2018-09-06 16:40:41
什么元件被稱為倒裝晶片(FC)?一般來說,這類元件具備以下特點。 ①基材是硅; ②電氣面及焊凸在元件下表面; ③球間距一股為0.1~0.3 mm,球徑為0.06~0,.15 mm,外形尺寸
2018-11-22 11:01:58
基板技術是倒裝晶片工藝需要應對的最大挑戰。因為尺寸很小(小的元件,小的球徑,小的球間距,小的貼裝 目標),基板的變動可能對制程良率有很大影響: ·密間距貼裝良率極易受限于阻焊膜和焊盤的尺寸公差
2018-11-27 10:47:46
工藝要求貼片機具有非常高的精度,同時貼片頭具有大壓力及加熱功能 。對于非C4元件(其焊凸材料為Au或其他)的裝配,趨向采用此工藝。這里,我們主要討論C4工藝,表1列出的 是倒裝晶片的焊凸材料與基板連接
2018-11-23 16:00:22
出現“彈簧床”現象,貼裝頭一移開,基板就回彈,造成元件偏移。一般 柔性電路板除了本身的支撐板外,還需要有夾具來保證其平整。為了獲得倒裝晶片清晰的影像,需要調整和優化 照相機光源,關鍵是增大明暗區域的色差
2018-11-22 11:02:17
有些倒裝晶片應用在柔性電路板或薄型電路板上,這時候對基板的平整支撐非常關鍵。解決方案往往會用到載 板和真空吸附系統,以形成一個平整的支撐及精確的定位系統,滿足以下要求: ①基板Z方向的精確支撐
2018-11-23 15:45:30
。 ②傳送板機構的結構與多功能貼片機相同,采用線路板固定在工作臺的方式。由于倒裝晶片貼裝的基板很多是在軟線路板、超薄的線路板和一些特殊的載具上,倒裝晶片貼裝設備提供高精度的線路板支撐升降平臺,并帶有真空
2018-11-27 10:45:28
和測試都在晶片上進行。隨著晶片尺寸的增大、管芯的縮小,WLP的成本不斷降低。作為最早采用該技術的公司,Dallas Semiconductor在1999年便開始銷售晶片級封裝產品。2 命名規則 業界在
2018-08-27 15:45:31
、數位攝影機、導航設備、遊戲控制器、其他可攜式/遠端產品和汽車的應用。晶圓級晶片尺寸封裝(WLCSP)是一種先進的封裝技術,完成凸塊後,不需要使用封裝基板便可直接焊接在印刷電路板上。它是受限於晶片尺寸
2019-09-17 09:05:03
Insights 對2016年半導體產業前景看法最樂觀 (來源:IC Insights) 但Jones則認為,記憶體晶片價格與智慧型手機銷售量將持續下滑;舉例來說,蘋果(Apple)今年
2016-01-14 14:51:30
印制電路板基板材料的分類基板材料按覆銅板的機械剛性劃分 按覆銅板的機械剛性劃分,可分為剛性覆銅板(CCI。)和撓性覆銅板(FCCI)。通常剛性覆銅板采用層壓成型的方式。麥|斯|艾|姆|P|CB樣板
2013-10-22 11:45:58
基板材料按覆銅板的機械剛性劃分 按覆銅板的機械剛性劃分,可分為剛性覆銅板(CCI。)和撓性覆銅板(FCCI)。通常剛性覆銅板采用層壓成型的方式。 印制電路板基板材料可分為:單、雙面PCB用
2018-09-10 15:46:14
常見的好像都有常用晶振封裝尺寸.pdf (4.07 MB )
2019-07-25 01:19:54
AT-CUT,如果對晶振要求的頻率較高時則采用BT-CUT。晶片的切割方式、幾何形狀、尺寸等決定了晶振的頻率。 3、晶片研磨 對晶片的表面進行研磨,使其厚度及表面粗糙平整度達到要求。一般實際的晶片的厚度
2021-03-15 14:08:53
科研工作者研究的重點。斯利通DPC陶瓷封裝基板又稱直接鍍銅陶瓷板,DPC產品具備線路精準度高與表面平整度高的特性,非常適用于LED覆晶/共晶工藝,配合高導熱的陶瓷基體,顯著提升了散熱效率,是最適合高功率、小尺寸LED發展需求的陶瓷散熱基板。
2020-12-23 15:20:06
,采用氮化鋁陶瓷基板的IGBT模塊具有更好的熱疲勞穩定性和更高的集成度。二、版圖設計 工程技術人員會根據所設計的模塊絕緣耐壓、模塊結構特點、芯片排布方式等級選擇不同尺寸的基板尺寸,上下銅層邊緣距離陶瓷
2017-09-12 16:21:52
更小。正因如此近年來,在剛性PCB中(包括剛性IC封裝基板在內),HDI(高密度互連)基板(即微孔板)和撓性印制電路板成為了市場比率增長最快的2大類品種。 還出現了這2類PCB的相互“融合
2018-11-26 17:04:35
晶振在電路中匹配不理想和晶振的溫度漂移太大,不僅僅會影響其使用效果,對其產品性能也會產生一定不良影響,這是很多工程師最為煩惱和亟待解決的問題。為此,松季電子提到振蕩IC可以有效實現時鐘晶振高精度
2013-11-08 15:56:44
到它們。 TPS82740A是一款具有負載開關的超低功耗DC/DC轉換器,采用TI MicroSiP封裝并集成了所有必要的組件。解決方案總尺寸僅為2.3mm x 2.9mm,比許多采用QFN封裝的IC都小。 此外,一定要選擇具有最小尺寸的無源組件,但務必要核實電壓和溫度降額是否能滿足應用需求。
2018-09-10 11:57:30
` 有源晶振和無源晶振的基本原理區別,具體介紹如下: 石英晶片之所以能作為振蕩器使用,是基于它的壓電效應:在晶片的兩個極上加一電場,會使晶體產生機械變形;在石英晶片上加上交變電壓,晶體就會產生
2013-12-27 16:46:24
是十分不變的。當外加交變電壓的頻率與晶片的固有頻率(由晶片的尺寸以及外形決定)相等時,機械振動的幅度將急速增加,這種征象稱為"壓電諧振"。 有源晶振不需要CPU的內部振蕩器,不需要龐大的配置電路。相對于無源晶體,有源晶振的缺陷是需要選擇好合適輸出電平,靈活性較差,而且價格高。
2018-07-13 07:26:59
?工藝提供了一種經濟高效的方式進行單個晶片堆疊,并能產出高良率以及穩固可靠的連接。在未來,我們期待Durendal?工藝能促進扇出型晶圓級封裝在單個晶片堆疊中得到更廣泛的應用。
2020-07-07 11:04:42
相對簡單(主要是做好電源濾波,通常使用一個電容和電感構成的PI型濾波網絡,輸出端用一個小阻值的電阻過濾信號即可如下圖),不需要復雜的配置電路。相對于無源晶體,有源晶振的缺陷是其信號電平是固定的,需要選擇
2012-12-14 11:26:55
、全尺寸(長方體)、半尺寸(正方體)、音叉型(圓柱狀晶振)。HC-49U一般稱49U,有些采購俗稱“高型”,而HC-49S一般稱49S,俗稱“矮型”,音叉型(圓柱狀晶振)按照體積分可以分為φ3*10
2013-12-09 16:11:36
、切割型指晶片相對于石英晶體結晶軸(物理結構)的切割取向。由于石英晶體是各向異性體,故不同方法、角度、精度切割的晶片,其頻率溫度特性、使用頻率范圍以及等效電路的各項參數也有所不同。有源晶振晶體產業生產
2012-11-19 21:10:06
`什么是硅晶圓呢,硅晶圓就是指硅半導體積體電路制作所用的硅晶片。晶圓是制造IC的基本原料。硅晶圓和晶圓有區別嗎?其實二者是一個概念。集成電路(IC)是指在一半導體基板上,利用氧化、蝕刻、擴散等方法
2011-12-02 14:30:44
1 前言 環保型覆銅板也稱綠色型覆銅板,它在加工、應用、
2006-04-16 21:07:46 1973
1973 LED晶片的組成,作用及分類
一、LED晶片的作用:LED晶片為LED的主要原材料,LED主要依靠晶
2009-05-09 09:05:58 1920
1920 
印制電路板基板材料的分類
按覆銅板的機械剛性劃分,可分為剛性覆銅板(CCI。)和撓性覆銅板(FCCI)。通常剛性覆銅板采用層壓成型的方式。
2009-11-11 17:05:00 1565
1565 什么是硅晶圓呢,硅晶圓就是指硅半導體積體電路制作所用的硅晶片。晶圓是制造IC的基本原料。
2011-08-07 16:29:09 11781
11781 半導體業者嗅到三維晶片( 3D IC)導入行動裝置的商機,紛紛投入技術研發;然而,要加速量產時程,制定邏輯與記憶體IC接合標準已成首要關鍵。因此,全球十八家晶片商正透過聯合電子
2011-09-15 09:59:24 539
539 PCB制造過程基板尺寸的變化問題,講述了產生的原因及解決方法
2011-12-15 14:03:55 1436
1436 卷帶式覆晶薄膜(Chip on Film;COF)封裝、COF基板可望持續受到終端產品包括大尺寸4K UHD(分辨率3,840x2,160)液晶電視、OLED面板手機、采用LTPS制程的高端液晶面板手機等產品趨勢帶動,相關業者包括驅動IC封測的南茂、頎邦、COF基板廠易華電可望在2017年持續受惠。
2017-01-12 08:43:02 4584
4584 經緯方向差異造成基板尺寸變化;由于剪切時,未注意纖維方向,造成剪切應力殘留在基板內,一旦釋放,直接影響基板尺寸的收縮。基板表面銅箔部分被蝕刻掉對基板的變化限制,當應力消除時產生尺寸變化。
2018-03-14 09:55:02 2773
2773 
本文開始介紹了晶圓的概念和晶圓的制造過程,其次詳細的闡述了晶圓的基本原料,最后介紹了晶圓尺寸的概念及分析了晶圓的尺寸是否越大越好。
2018-03-16 14:50:23 147634
147634 
本文開始介紹了覆銅板的分類與覆銅板的用途,其次闡述了鋁基板工作原理與鋁基板的構成,最后從四個方面介紹了覆銅板和鋁基板的區別。
2018-05-02 14:28:30 20105
20105 傳統的IC封裝是采用導線框架作為IC導通線路與支撐IC的載具,它連接引腳于導線框架的兩旁或四周。隨著IC技術的發展,引腳數量增多、布線密度增大、基板層數增多,傳統封裝形式無法滿足市場需要。近年來以
2018-06-12 14:36:00 32593
32593 手持電子產品的薄型化催生了IC封裝無芯基板,它不僅比IC封裝有芯基板更薄,而且電氣性能更加優越。介紹了IC封裝無芯基板的發展趨勢和制造中面臨的問題。IC封裝無芯基板以半加成法制造,翹曲是目前制程中
2018-12-07 08:00:00 15
15 業者透露,IC后段封裝用的覆晶封裝如FC-BGA、FC-CSP等封裝,甚或晶圓測試探針卡,華為要求擴大服務緊密度,卻早已是不爭事實。此外,海思推出的高階芯片也同樣爭取臺積電或是日月光投控等10/7/5納米先進晶圓制造、CoWoS、SoIC、FC等先進封裝工藝。
2019-02-20 16:08:42 6487
6487 熟悉驅動IC封測業者表示,傳統的中小尺寸驅動IC玻璃覆晶封裝(COG)產能利用率下滑,不過,在COF封測通吃TDDI IC、OLED驅動IC的態勢下,輕薄短小、全屏幕設計絕對是今年中階手機「高規平價」策略的重點特色之一。
2019-02-20 16:23:41 5243
5243 印制板(PCB)的主要材料是覆銅板,而覆銅板(敷銅板)是由基板、銅箔和粘合劑構成的。下面介紹一下PCB板材質知識。
2019-04-24 14:33:24 15221
15221 科技IC封裝基板業務經過四五年的磨礪,在2018年取得較好增長,目前存儲類產品出貨面積占比超過70%,已經達到滿產,其他產品也在陸續的開發和導入量產中,并組建了“廣東省封裝基板工程技術
2019-05-05 16:47:24 5248
5248 全球IC封裝基板市場穩步增長,2022年將破100億美元。
2019-05-09 09:29:13 21670
21670 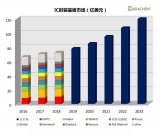
華為采購端高層已經大力催促臺系COF基板兩強易華電子、頎邦提升良率、并包下多數COF產能,而2019年COF基板供不應求的態勢才剛開始,5月起供需缺口就陸續放大。
2019-05-10 10:23:30 14320
14320 印制電路板基板材料可分為:單、雙面pcb用基板材料;多層板用基板材料(內芯薄型覆銅板、半固化片、預制內層多層板);積層多層板用基板材料(有機樹脂薄膜、涂樹脂銅箔、感光性絕緣樹脂或樹脂薄膜、有機涂層
2019-05-13 11:03:40 6937
6937 隨著BGA(球柵陣列)和CSP(芯片級封裝)等新型IC的蓬勃發展,IC基板一直在蓬勃發展,這些IC需要新的封裝載體。作為最先進的PCB(印刷電路板)中的一種,IC基板PCB與任何層HDI PCB和柔性剛性PCB一起在流行和應用方面都有爆炸性增長,現在廣泛應用于電信和電子更新。
2019-08-02 14:58:58 28433
28433 告訴參加年度國際空間站會議的高管們,日益增加的芯片出貨量,更高的基板價格和更強的日元匯率將使2000年空白硅片材料的收入總體增長10.1%。晶圓加工廠預計將購買今年價值64.75億美元的硅基板與1999年的58.83億美元相比。
2019-08-12 15:53:52 2829
2829 經緯方向差異造成基板尺寸變化;由于剪切時,未注意纖維方向,造成剪切應力殘留在基板內,一旦釋放,直接影響基板尺寸的收縮。
2019-08-22 11:12:54 977
977 電路板采用網格覆銅還是實心覆銅,你用對了嗎?
2020-01-15 16:59:04 6766
6766 、智慧城市等新興應用中,強力支援無線通訊網絡的角色。 面對全球Wi-Fi 6終端產品市場需求在2020年下半的爆發增長情形,客戶第4季訂單依舊踴躍,而且初步判定2021年Wi-Fi 6相關芯片出貨量還將倍幅增長,近期各大IC設計業者仍不斷向上游晶圓代工廠尋求更多的產能支
2020-12-21 09:40:32 612
612 Durendal?工藝提供了一種經濟高效的方式進行單個晶片堆疊,并能產出高良率以及穩固可靠的連接。在未來,我們期待Durendal?工藝能促進扇出型晶圓級封裝在單個晶片堆疊中得到更廣泛的應用。
2020-12-24 17:39:43 1299
1299 ,Mini LED背光顯示器想要保證性能的同時尺寸要做得更大,采用原有的小尺寸背光基板拼接的方案已經難以滿足要求。如果大屏幕采用傳統小尺寸Mini LED背光基板,需要多次拼接才能達到相應尺寸,拼接
2021-06-23 14:16:23 2490
2490 一般PCB板用基板材料可分為兩大類:剛性基板材料和柔性基板材料,剛性基板材料中最常見的是覆銅板。 ? ? ? ?覆銅板是由木漿紙或玻纖布等作增強材料,浸以樹脂,單面或雙面覆以銅箔,經熱壓而成的一種
2021-07-21 09:41:41 31153
31153 覆銅基板工藝流程簡介
2021-12-13 17:13:50 0
0 功率型LED封裝技術發展至今,可供選用的散熱基板主要有環氧樹脂覆銅基板、金屬基覆銅基板、金屬基復合基板、陶瓷覆銅基板等。
2022-10-14 10:06:54 1349
1349 隨著技術發展,IC的線寬不斷縮小,集成度穩步提高,IC封裝逐步向著超多引腳、窄節距、超小型化方向發展。20世紀90年代中期,一種以球柵陣列封裝(Ball Grid Array,簡稱BGA)、芯片尺寸
2022-10-17 17:20:51 6144
6144 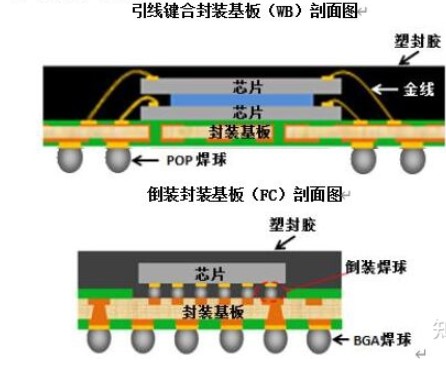
在剛性覆銅板中,IC 封裝載板用覆銅板(即 IC 載板)、射頻/微波電路用覆銅板(即高頻覆銅板)以及高速數字電路用覆銅板(即高速覆銅板)三大類特殊覆銅板,屬于生產制造過程技術難度和下游應用領域性能要求較高的高端覆銅板板材。
2023-01-10 10:48:02 3012
3012 陶瓷覆基板是影響模塊長期使用的關鍵部分之一,IGBT模塊封裝中所產生的熱量主要是經陶瓷覆銅板傳到散熱板最終傳導出去。陶瓷基板材料的性能是陶瓷覆銅板性能的決定因素。
2023-04-17 09:54:48 2105
2105 覆銅陶瓷基板(Direct Plating Copper, DPC)工藝:是一種用于制備高密度電子封裝材料的工藝方法。
2023-06-06 15:31:51 1952
1952 高溫下DPC(磁控濺射工藝)覆銅陶瓷基板的設計和應用
2023-06-19 17:35:30 2617
2617 
PCB板上,并連接它們。
3. 生成Gerber文件:將設計完成的PCB布局導出為Gerber文件,這是一種標準的PCB生產文件格式。
4. 準備基板:選擇合適的基板材料,如玻璃纖維布,然后切割和打磨成所需尺寸。在基板上涂覆一層銅箔。
2023-08-22 15:37:09 4641
4641 隨著電子技術的飛速發展,各種新型材料也不斷涌現。其中,直接覆鋁陶瓷基板(DBA基板)因其優良的性能表現備受矚目,成為電子行業中備受關注的材料之一。
2023-09-14 09:14:55 2601
2601 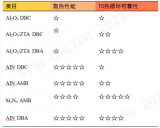
覆銅板(CCL),是電子工業的原料。覆銅板的結構包括了基板、銅箔、覆銅板粘合劑等。
2023-12-14 09:40:01 7044
7044 
的工藝,將其同現有的DAF膜的性能進行了對比,并對采用這種方法的封裝工藝的劃片、裝片等后續關鍵工序及其變更作了詳細的描述;對于影響晶圓背面涂覆質量的各個關鍵因素也做了
2023-12-30 08:09:58 2375
2375 
芯片基板是承載芯片的重要載體,主要用來固定從晶圓切好的晶片,是芯片封裝環節不可或缺的一部分。基板能固定的晶片越多,整個芯片的晶體管就越多,功能更多,性能更好。因此,如何在有限的尺寸容納更多的晶體管就成為了整個行業不斷探索的發展方向。
2024-09-06 10:52:29 1288
1288 玻璃基板的出現滿足了業界對人工智能等高性能應用的巨大需求及其嚴格的要求,包括進一步減小玻璃通孔 (TGV) 的尺寸和間距。到目前為止,有機基板采用鍍通孔 (PTH) 型通孔,但這些通孔無法滿足這些
2024-11-27 10:11:02 1330
1330 
在生產過程中保持優秀的品質。 在晶片的制造過程中,硅晶片會放在FOUP晶圓盒中,每個晶圓盒都會承載著相應數量的硅晶片。而TI標簽(即RFID標簽)則嵌入到晶圓盒中,記錄著硅晶片的尺寸、數量等重要信息。TI標簽擁有著全球唯一不可被修
2024-11-29 17:46:58 1223
1223 
在電子電路領域,覆銅陶瓷基板因其優異的電氣性能和機械性能而得到廣泛應用。其中,DPC(直接鍍銅)、AMB(活性金屬釬焊)和DBC(直接覆銅)是三種主流的覆銅陶瓷基板技術。本文將詳細對比這三種技術的特點、優勢及應用場景,幫助企業更好地選擇適合自身需求的覆銅陶瓷基板……
2025-03-28 15:30:07 4865
4865 
為什么選擇DPC覆銅陶瓷基板?
選擇DPC覆銅陶瓷基板的原因主要基于其多方面的優勢,這些優勢使得DPC技術在眾多電子封裝領域中脫穎而出……
2025-04-02 16:52:41 882
882 支持4-12英寸晶圓,針對超薄晶圓(如≤300μm)采用低應力夾持方案,避免破損。通過模塊化托盤設計,快速切換不同規格載具,兼容方形基板等非標準樣品。污染物分層處
2025-12-17 11:25:31 443
443 
太陽誘電 株式會社研發出2012尺寸(2.0×1.25mm)下的100μF電容基板內置型多層陶瓷電容器(以下簡稱"MLCC"),在商品化,并已開始量產。 該產品是一種用于IC電源線的去耦MLCC
2025-12-18 13:25:24 128
128
 電子發燒友App
電子發燒友App














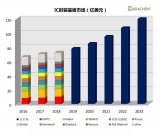
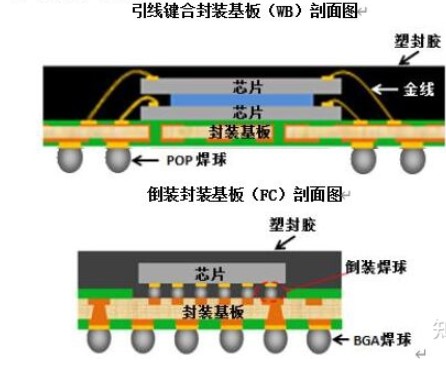
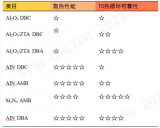









評論