先進封裝(advanced packaging)的后端工藝(back-end)之一,將晶圓或組件進行劃片或開槽,以利后續制程或功能性測試。
2022-07-10 16:18:38 7045
7045 作為半導體制造的后工序,封裝工藝包含背面研磨(Back Grinding)、劃片(Dicing)、芯片鍵合(Die Bonding)、引線鍵合(Wire Bonding)及成型(Molding)等步驟。
2023-03-27 09:33:37 17003
17003 經過前端工藝處理并通過晶圓測試的晶圓將從背面研磨(Back Grinding)開始后端處理。背面研磨是將晶圓背面磨薄的工序,其目的不僅是為了減少晶圓厚度,還在于聯結前端和后端工藝以解決前后兩個工藝
2023-05-22 12:44:23 2648
2648 
介紹了晶圓級封裝的基本流程。本篇文章將側重介紹不同晶圓級封裝方法所涉及的各項工藝。晶圓級封裝可分為扇入型晶圓級芯片封裝(Fan-In WLCSP)、扇出型晶圓級芯片封裝(Fan-Out WLCSP
2023-11-08 09:20:19 11649
11649 
晶圓承載系統是指針對晶圓背面減薄進行進一步加工的系統,該工藝一般在背面研磨前使用。晶圓承載系統工序涉及兩個步驟:首先是載片鍵合,需將被用于硅通孔封裝的晶圓貼附于載片上;其次是載片脫粘,即在如晶圓背面凸點制作等流程完工后,將載片分離。
2023-11-13 14:02:49 6499
6499 
在本文中,我們將重點介紹半導體封裝的另一種主要方法——晶圓級封裝(WLP)。本文將探討晶圓級封裝的五項基本工藝,包括:光刻(Photolithography)工藝、濺射(Sputtering)工藝
2024-01-24 09:39:09 3633
3633 
在半導體制造的復雜流程中,晶圓歷經前道工序完成芯片制備后,劃片工藝成為將芯片從晶圓上分離的關鍵環節,為后續封裝奠定基礎。由于不同厚度的晶圓具有各異的物理特性,因此需匹配不同的切割工藝,以確保切割效果與芯片質量。
2025-02-07 09:41:00 3050
3050 
晶圓制備是材料科學、熱力學與精密控制的綜合體現,每一環節均凝聚著工程技術的極致追求。而晶圓清洗本質是半導體工業與污染物持續博弈的縮影,每一次工藝革新都在突破物理極限。
2025-05-07 15:12:30 2193
2193 
本內容詳解了晶圓制造工藝流程,包括表面清洗,初次氧化,熱處理,光刻技術和離子刻蝕技術等
2011-11-24 09:32:10 7546
7546 一些后處理步驟,例如研磨、化學機械研磨(CMP)、SiC外延、注入、檢測、化學氣相沉積(CVD)和物理氣相沉積(PVD)。SiC晶圓因其半透明性質和材料硬度而面臨許多挑戰,這需要對關鍵工藝步驟設備進行
2019-05-12 23:04:07
小弟想知道8寸晶圓盒的制造工藝和檢驗規范,還有不知道在大陸有誰在生產?
2010-08-04 14:02:12
` 晶圓級封裝是一項公認成熟的工藝,元器件供應商正尋求在更多應用中使用WLP,而支持WLP的技術也正快速走向成熟。隨著元件供應商正積極轉向WLP應用,其使用范圍也在不斷擴大。 目前有5種成熟
2011-12-01 14:33:02
`晶圓切割目的是什么?晶圓切割機原理是什么?一.晶圓切割目的晶圓切割的目的,主要是要將晶圓上的每一顆晶粒(Die)加以切割分離。首先要將晶圓(Wafer)的背面貼上一層膠帶(Wafer Mount
2011-12-02 14:23:11
`晶圓制造總的工藝流程芯片的制造過程可概分為晶圓處理工序(Wafer Fabrication)、晶圓針測工序(Wafer Probe)、構裝工序(Packaging)、測試工序(Initial
2011-12-01 15:43:10
+ 4HNO3 + 6 HF? 3H2SiF6 +4 NO + 8H2O 拋光:機械研磨、化學作用使表面平坦,移除晶圓表面的缺陷八、晶圓測試主要分三類:功能測試、性能測試、抗老化測試。具體有如:接觸測試
2019-09-17 09:05:06
有人又將其稱為圓片級-芯片尺寸封裝(WLP-CSP),以晶圓圓片為加工對象,在晶圓上封裝芯片。晶圓封裝中最關鍵的工藝為晶圓鍵合,即是通過化學或物理的方法將兩片晶圓結合在一起,以達到密封效果。如下
2021-02-23 16:35:18
` 硅是由石英沙所精練出來的,晶圓便是硅元素加以純化(99.999%),接著是將些純硅制成硅晶棒,成為制造積體電路的石英半導體的材料,經過照相制版,研磨,拋光,切片等程序,將多晶硅融解拉出單晶硅晶棒
2011-09-07 10:42:07
晶圓級CSP的返修工藝包括哪幾個步驟?晶圓級CSP對返修設備的要求是什么?
2021-04-25 08:33:16
晶圓級CSP裝配回流焊接工藝控制,看完你就懂了
2021-04-25 06:28:40
晶圓級CSP的裝配對貼裝壓力控制、貼裝精度及穩定性、照相機和影像處理技術、吸嘴的選擇、助焊劑應 用單元和供料器,以及板支撐及定位系統的要求類似倒裝晶片對設備的要求。WLCSP貼裝工藝的控制可以參
2018-09-06 16:32:18
測量。
(2)系統覆蓋襯底切磨拋,光刻/蝕刻后翹曲度檢測,背面減薄厚度監測等關鍵工藝環節。
晶圓作為半導體工業的“地基”,其高純度、單晶結構和大尺寸等特點,支撐了芯片的高性能與低成本制造。其戰略價值不僅
2025-05-28 16:12:46
納米到底有多細微?什么晶圓?如何制造單晶的晶圓?
2021-06-08 07:06:42
的輔助。 測試是為了以下三個目標。第一,在晶圓送到封裝工廠之前,鑒別出合格的芯片。第二,器件/電路的電性參數進行特性評估。工程師們需要監測參數的分布狀態來保持工藝的質量水平。第三,芯片的合格品與不良品
2011-12-01 13:54:00
1、為什么晶圓要做成圓的?如果做成矩形,不是更加不易產生浪費原料?2、為什么晶圓要多出一道研磨的工藝?為什么不能直接做成需求的厚度?
2014-01-20 15:58:42
宜特檢測不僅可以提供一般剖面研磨(Cross-section),也提供樣品從背面進行研磨(晶背研磨,Backside Polishing),將基材磨至特定的厚度后再進行拋光。剖面、斷面研磨與晶背研磨
2018-09-11 10:24:52
的有氧化爐、沉積設備、光刻機、刻蝕設備、離子注入機、清洗機、化學研磨設備等。以上是今日Enroo關于晶圓制造工藝及半導體設備的相關分享。
2018-10-15 15:11:22
is not preferred; instead, use ‘back surface’.)背面 - 晶圓片的底部表面。(注:不推薦該術語,建議使用“背部表面”)Base Silicon Layer
2011-12-01 14:20:47
`所謂多項目晶圓(簡稱MPW),就是將多種具有相同工藝的集成電路設計放在同一個硅圓片上、在同一生產線上生產,生產出來后,每個設計項目可以得到數十片芯片樣品,這一數量足夠用于設計開發階段的實驗、測試
2011-12-01 14:01:36
服務。其雙軸劃片功能可同時兼顧正背面劃片質量,加裝二流體清洗功能可對CMOS Sensor等潔凈度要求較高組件,提供高質量劃片服務。晶圓劃片機為廠內自有,可支持至12吋晶圓。同時,iST宜特檢測可提供您
2018-08-31 14:16:45
是什么推動著高精度模擬芯片設計?如何利用專用晶圓加工工藝實現高性能模擬IC?
2021-04-07 06:38:35
怎么選擇晶圓級CSP裝配工藝的錫膏?
2021-04-25 08:48:29
招聘6/8吋晶圓測試工藝工程師/主管1名工作地點:無錫工資:面議要求:1. 工藝工程師:晶圓測試經驗3年以上,工藝主管:晶圓測試經驗5年以上;2. 精通分立器件類產品晶圓測試,熟悉IC晶圓測試尤佳
2017-04-26 15:07:57
激光用于晶圓劃片的技術與工藝 激光加工為無接觸加工,激光能量通過聚焦后獲得高能量密度,直接將硅片
2010-01-13 17:01:57
%),接著是將這些純硅制成長硅晶棒,成為制造積體電路的石英半導體的材料,經過照相制版,研磨,拋光,切片等程序,將多晶硅融解拉出單晶硅晶棒,然后切割成一片一片薄薄的晶圓。我們會聽到幾寸的晶圓廠,如果硅晶圓的直徑
2011-12-02 14:30:44
芯片背面研磨,上海IC研磨,IC集成電路研磨公司,宜特檢測集成電路背面研磨(Backside Polishing)工作原理:透過自動研磨機,從芯片背面進行研磨將Si基材磨薄至特定厚度后再進行拋光
2018-10-24 10:57:21
氧化鋯基氧化鋁 - 半導體晶圓研磨粉 (AZ) 系列半導體晶圓研磨粉是一種細粉磨料,是作為需要高精度的包裹材料而開發的。原材料粒度分布尖銳,粒度穩定,形狀呈塊狀。再以熔融氧化鋁為原料,鋯英
2022-05-31 14:21:38
晶圓級封裝產業(WLP),晶圓級封裝產業(WLP)是什么意思
一、晶圓級封裝(Wafer Level Packaging)簡介 晶圓級封裝(WLP,Wafer Level Package) 的一般定
2010-03-04 11:35:01 46790
46790 晶圓是微電子產業的行業術語之一。
2017-12-07 15:41:11 41078
41078 晶圓制造總的工藝流程 芯片的制造過程可概分為晶圓處理工序(Wafer Fabrication)、晶圓針測工序(Wafer Probe)、構裝工序(Packaging)、測試工序(Initial
2017-12-20 10:46:54 35404
35404 晶圓制造總的工藝流程 芯片的制造過程可概分為晶圓處理工序(Wafer Fabrication)、晶圓針測工序(Wafer Probe)、構裝工序(Packaging)、測試工序(Initial Test and Final Test)等幾個步驟。
2018-04-16 11:27:00 15246
15246 將二氧化矽經過純化,融解,蒸餾之后,制成矽晶棒,晶圓廠再拿這些矽晶棒研磨,拋光和切片成為晶圓母片.目前晶圓片越來越多的受到了應用,本文詳細介紹了全球十大晶圓片的供應商。
2018-03-16 15:05:08 75274
75274 硅晶圓就是硅元素加以純化(99.999%),接著是將這些純硅制成長硅晶棒,成為制造積體電路的石英半導體的材料,經過照相制版,研磨,拋光,切片等程序,將多晶硅融解拉出單晶硅晶棒,然后切割成一片一片薄薄的晶圓。
2018-03-26 10:57:17 44221
44221 
有人已經考慮將暗視野檢測用于檢測薄晶圓缺陷。基于光學技術,暗視野是指進行較低角度反射光測量。 暗視野對于晶圓前端檢測是有效的,但是由于研磨造成晶圓背面粗糙,對于背面檢測它是無效的。因此,晶圓背面研磨
2019-03-12 09:26:00 931
931 本文主要介紹了晶圓的結構,其次介紹了晶圓切割工藝,最后介紹了晶圓的制造過程。
2019-05-09 11:15:54 12823
12823 
硅是由石英砂所精練出來的,晶圓便是硅元素加以純化(99.999%),接著是將這些純硅制成硅晶棒,成為制造集成電路的石英半導體的材料,經過照相制版,研磨,拋光,切片等程序,將多晶硅融解拉出單晶硅晶棒,然后切割成一片一片薄薄的晶圓。
2019-05-09 11:34:37 10653
10653 晶圓的制造在半導體領域,科技含量相當的高,技術工藝要求非常高。而我們國半導體事業起步較晚,在晶圓的制造上還處于建設發展階段。現在我國主要做的是晶圓的封測。我國的晶圓封測規模和市場都是全球首屈一指的,約占全球約1/4。
2019-08-12 14:13:00 48167
48167 晶圓切割(即劃片)是芯片制造工藝流程中一道不可或缺的工序,在晶圓制造中屬于后道工序。晶圓切割就是將做好芯片的整片晶圓按芯片大小分割成單一的芯片(晶粒)。最早的晶圓是用切片系統進行切割(劃片)的,這種方法以往占據了世界芯片切割市場的較大份額,特別是在非集成電路晶圓切割領域
2020-12-24 12:38:37 20276
20276 (熱處理)和鈀金屬(背面金屬;BM)沉積等。晶移動研磨曲后產生的爆發和翹曲,如果會過大,就會擴展到銳化的區域。工藝之良率例如:膠膜去除(De-tap)、使用持取(Wafer Handling)和封裝(Packaging & Assembly)等工藝,必須工藝之能及破壞層。
2022-03-23 14:15:31 1833
1833 
晶圓薄化是實現集成電路小型化的主要工藝步驟,硅片背面磨至70微米的厚度被認為是非常關鍵的,因為它很脆弱。本文將討論關鍵設備檢查項目的定義和設置險。 所涉及的設備是內聯晶圓背面研磨和晶圓安裝。本研究
2022-03-31 14:58:24 5901
5901 
在傳統晶圓封裝中,是將成品晶圓切割成單個芯片,然后再進行黏合封裝。不同于傳統封裝工藝,晶圓級封裝是在芯片還在晶圓上的時候就對芯片進行封裝,保護層可以黏接在晶圓的頂部或底部,然后連接電路,再將晶圓切成單個芯片。
2022-04-06 15:24:19 12071
12071 晶圓是指制作硅半導體電路所用的硅晶片,其原始材料是硅。高純度的多晶硅溶解后摻入硅晶體晶種,然后慢慢拉出,形成圓柱形的單晶硅。硅晶棒在經過研磨,拋光,切片后,形成硅晶圓片,也就是晶圓。
2022-07-19 14:05:25 3209
3209 
碳化硅在電動汽車和新能源等市場的重要性促使許多公司重新審視和投資晶圓技術,以制定符合需求的發展計劃。 X-Trinsic 是一家旨在改進制造工藝并專注于盡快加速產品在 SiC 領域采用的公司
2022-08-03 10:57:44 2685
2685 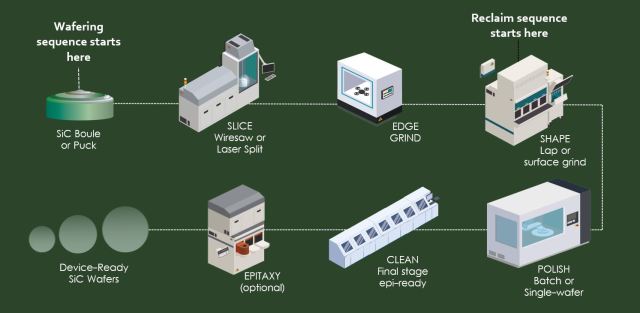
工藝);(2)在晶片上形成IC的
工藝(前一工藝);以及(3)切割、組裝、檢查和安裝芯片的工藝(后一工藝)。在晶片制造過程中,通過雙面研磨、單面
研磨、蝕刻等對從晶錠切片的晶片進行厚度調節,以消除加工表面的變形,然后將晶
2023-02-20 16:13:41 1
1 晶圓是指制作硅半導體電路所用的硅晶片,其原始材料是硅。高純度的多晶硅溶解后摻入硅晶體晶種,然后慢慢拉出,形成圓柱形的單晶硅。硅晶棒在經過研磨,拋光,切片后,形成硅晶圓片,也就是晶圓。晶圓的主要加工
2023-02-22 14:46:16 4
4 】晶圓 FOL– Back Grinding背面減薄 將從晶圓廠出來的Wafer進行背面研磨,來減薄晶圓達到 ? ?封裝需要的厚度(5mils~10mils); 磨片時,需要在正面(Active
2023-05-23 09:56:41 5825
5825 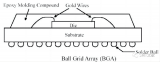
將從晶圓廠出來的Wafer進行背面研磨,來減薄晶圓達到 封裝需要的厚度(5mils~10mils);
磨片時,需要在正面(Active Area)貼膠帶保護電路區域 同時研磨背面。研磨之后,去除膠帶,測量厚度;
2023-06-09 09:17:42 4962
4962 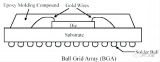
質變化。劃片機制(TheDicingMechanism)硅晶圓劃片工藝是“后端”封裝制程工藝中的第一步。該工藝將晶圓分成獨立帶有電氣性能的芯片,用于隨后的芯片粘合(d
2021-11-25 17:29:51 3607
3607 
陸芯精密切割解說晶圓的生產工藝流程從大的方面來講,晶圓生產包括晶棒制造和晶片制造兩大步驟,它又可細分為以下幾道主要工序(其中晶棒制造只包括下面的第一道工序,其余的全部屬晶片制造,所以有時又統稱它們為
2021-12-09 11:37:30 2812
2812 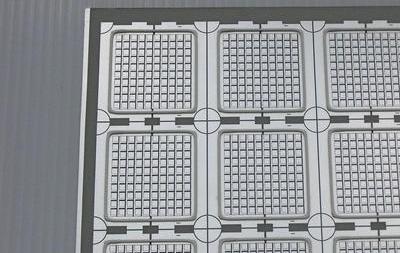
鍍銀晶圓的材料特性晶圓經過背面研磨減薄后,經由背面蒸鍍金屬,切片加工而成的芯片將在器件熱阻降低、工作散熱和冷卻、封裝厚度減薄等各個方面實現很大的改善。在晶圓背面金屬化過程中,一般選擇鈦、鎳、銀作為
2022-08-19 09:23:32 3175
3175 
晶圓經過前道工序后芯片制備完成,還需要經過切割使晶圓上的芯片分離下來,最后進行封裝。不同厚度晶圓選擇的晶圓切割工藝也不同:厚度100um以上的晶圓一般使用刀片切割;厚度不到100um的晶圓一般
2022-10-08 16:02:44 16400
16400 
半導體制造設備廠商DISCO Corporation(總部:東京都大田區;總裁:Kazuma Sekiya)采用了KABRA(一種使用激光加工的晶錠切片方法),并開發了一種針對GaN(氮化鎵)晶圓生產而優化的工藝。通過該工藝,可以同時提高GaN晶圓片產量,并縮短生產時間。
2023-08-25 09:43:52 1777
1777 
在我從事半導體設備的職業生涯之初,晶圓背面是個麻煩問題。當時發生了一件令我記憶深刻的事:在晶圓傳送的過程中,幾片晶圓從機器人刀片上飛了出來。
2023-08-31 14:28:31 1793
1793 
在我從事半導體設備的職業生涯之初,晶圓背面是個麻煩問題。當時發生了一件令我記憶深刻的事:在晶圓傳送的過程中,幾片晶圓從機器人刀片上飛了出來。收拾完殘局后,我們想到,可以在晶圓背面沉積各種薄膜,從而
2023-09-04 16:54:26 1028
1028 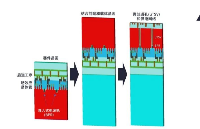
晶圓級封裝是指晶圓切割前的工藝。晶圓級封裝分為扇入型晶圓級芯片封裝(Fan-In WLCSP)和扇出型晶圓級芯片封裝(Fan-Out WLCSP),其特點是在整個封裝過程中,晶圓始終保持完整。
2023-10-18 09:31:05 4921
4921 
隨著半導體產業的飛速發展,晶圓鍵合設備及工藝在微電子制造領域扮演著越來越重要的角色。晶圓鍵合技術是一種將兩個或多個晶圓通過特定的工藝方法緊密地結合在一起的技術,以實現更高性能、更小型化的電子元器件。本文將詳細介紹晶圓鍵合設備的結構、工作原理以及晶圓鍵合工藝的流程、特點和應用。
2023-12-27 10:56:38 3181
3181 
摘要:論述了傳統的集成電路裝片工藝面臨的挑戰以及現有用DAF膜(DieAttachmentFilm,裝片膠膜)技術進行裝片的局限性;介紹了一種先進的、通過噴霧結合旋轉的涂膠模式制備晶圓背面涂覆膜
2023-12-30 08:09:58 2375
2375 
共讀好書 在本文中,我們將重點介紹半導體封裝的另一種主要方法——晶圓級封裝(WLP)。本文將探討晶圓級封裝的五項基本工藝,包括:光刻(Photolithography)工藝、濺射
2024-03-05 08:42:13 3555
3555 
5月23日, 中機新材對外宣布與南砂晶圓達成戰略合作框架協議。中機新材專注于高性能研磨拋光材料,尤其硬脆材料在先進制造過程中的應用,目前已在SiC晶圓研磨拋光領域取得關鍵技術突破,為客戶提供穩定優質的供應服務。
2024-05-24 10:22:23 1109
1109 。而硅晶圓是傳統的半導體材料,具有成熟的制造工藝和廣泛的應用領域。 制造工藝: 碳化硅晶圓的制造工藝相對復雜,需要高溫、高壓和長時間的生長過程。而硅晶圓的制造工藝相對成熟,可以實現大規模生產。此外,碳化硅晶圓的生長速度
2024-08-08 10:13:17 4710
4710 在本系列第七篇文章中,介紹了晶圓級封裝的基本流程。本篇文章將側重介紹不同晶圓級封裝方法所涉及的各項工藝。晶圓級封裝可分為扇入型晶圓級芯片封裝(Fan-In WLCSP)、扇出型晶圓級芯片封裝
2024-08-21 15:10:38 4450
4450 
GaAs晶圓作為常用的一類晶圓,在半導體功率芯片和光電子芯片都有廣泛應用。而如何處理好該類晶圓的清洗和進一步的鈍化工作是生產工藝過程中需要關注的點。
2024-10-30 10:46:56 2135
2135 
WAT是英文 Wafer Acceptance Test 的縮寫,意思是晶圓接受測試,業界也稱WAT 為工藝控制監測(Process Control Monitor,PCM)。
2024-11-25 15:51:29 3117
3117 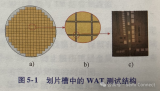
去除晶圓鍵合邊緣缺陷的方法主要包括以下幾種:
一、化學氣相淀積與平坦化工藝
方法概述:
提供待鍵合的晶圓。
利用化學氣相淀積的方法,在晶圓的鍵合面淀積一層沉積量大于一定閾值(如1.6TTV
2024-12-04 11:30:18 584
584 
大尺寸藍寶石晶圓平坦化的方法主要包括以下幾種:
一、傳統研磨與拋光方法
粗研磨
使用研磨墊配合綠碳化硅溶液對藍寶石晶圓進行雙面粗研磨,以去除晶圓表面的大部分不平整。通過控制研磨參數,如研磨壓力
2024-12-06 10:36:58 486
486 
一、概述
晶圓背面涂敷工藝是在晶圓背面涂覆一層特定的材料,以滿足封裝過程中的各種需求。這種工藝不僅可以提高芯片的機械強度,還可以優化散熱性能,確保芯片的穩定性和可靠性。
二、材料選擇
晶圓背面涂敷
2024-12-19 09:54:10 620
620 
帶冷卻功能的新型晶圓研磨盤技術是半導體制造領域中的一項重要創新,旨在解決傳統研磨盤在研磨過程中溫度變化的問題,確保研磨后產品的厚度和平整度達到極高標準。以下是對該技術的詳細介紹:
一、技術背景
在
2024-12-20 09:50:49 453
453 
半導體晶圓制造是現代電子產業中不可或缺的一環,它是整個電子行業的基礎。這項工藝的流程非常復雜,包含了很多步驟和技術,下面將詳細介紹其主要的制造工藝流程。第一步:晶圓生長晶圓生長是半導體制造的第一步
2024-12-24 14:30:56 5107
5107 
8寸晶圓的清洗工藝是半導體制造過程中至關重要的環節,它直接關系到芯片的良率和性能。那么直接揭曉關于8寸晶圓的清洗工藝介紹吧! 顆粒去除清洗 目的與方法:此步驟旨在去除晶圓表面的微小顆粒物,這些顆粒
2025-01-07 16:12:00 813
813 ?→ Pre-treatment?→back metal ? 即貼膠紙→減薄→硅刻蝕→撕膠紙→前處理→背面金屬化 ? ? 1,tape ? ? 在晶圓正面貼上上圖所示的藍色膠帶,保護晶圓正面的圖形
2025-02-12 09:33:18 2057
2057 
半導體制造是典型的“精度至上”領域,尤其在前道晶圓加工和后道封裝環節中,研磨(Grinding)與拋光(Polishing)技術直接決定了器件的性能和良率。以下從技術原理、工藝難點及行業趨勢三方面
2025-02-14 11:06:33 2772
2772 隨著半導體技術的飛速發展,晶圓級封裝(WLP)作為先進封裝技術的重要組成部分,正逐漸成為集成電路封裝的主流趨勢。在晶圓級封裝過程中,Bump工藝扮演著至關重要的角色。Bump,即凸塊,是晶圓級封裝中
2025-03-04 10:52:57 4980
4980 
晶圓濕法清洗工作臺是一個復雜的工藝,那我們下面就來看看具體的工藝流程。不得不說的是,既然是復雜的工藝每個流程都很重要,為此我們需要仔細謹慎,這樣才能獲得最高品質的產品或者達到最佳效果。 晶圓濕法清洗
2025-04-01 11:16:27 1009
1009 摘要:本文聚焦于降低晶圓 TTV(總厚度偏差)的磨片加工方法,通過對磨片設備、工藝參數的優化以及研磨拋光流程的改進,有效控制晶圓 TTV 值,提升晶圓質量,為半導體制造提供實用技術參考。 關鍵詞:晶
2025-05-20 17:51:39 1029
1029 
“減薄”,也叫 Back Grinding(BG),是將晶圓(Wafer)背面研磨至目標厚度的工藝步驟。這個過程通常發生在芯片完成前端電路制造、被切割前(即晶圓仍然整體時),是連接芯片制造和封裝之間的橋梁。
2025-05-30 10:38:52 1660
1660 在集成電路生產過程中,晶圓背面二氧化硅邊緣腐蝕現象是一個常見但復雜的問題。每個環節都有可能成為晶圓背面二氧化硅邊緣腐蝕的誘因,因此需要在生產中嚴格控制每個工藝參數,尤其是對邊緣區域的處理,以減少這種現象的發生。
2025-07-09 09:43:08 763
763 的背面減薄,通過研磨盤實現厚度均勻性控制(如減薄至50-300μm),同時保證表面粗糙度Ra≤0.1μm。 在化學機械拋光(CMP)工藝中,研磨盤配合拋光液對晶圓表面進行全局平坦化,滿足集成電路對層間平整度的要求。 ? 芯片封裝前處理 ? 對切
2025-07-12 10:13:41 895
895 一、引言
在半導體晶圓制造領域,晶圓總厚度變化(TTV)是衡量晶圓質量的關鍵指標,直接影響芯片制造的良品率與性能。淺切多道工藝通過分層切削降低單次切削力,有效改善晶圓切割質量,但該工藝過程中
2025-07-12 10:01:07 437
437 
晶圓清洗機中的晶圓夾持是確保晶圓在清洗過程中保持穩定、避免污染或損傷的關鍵環節。以下是晶圓夾持的設計原理、技術要點及實現方式: 1. 夾持方式分類 根據晶圓尺寸(如2英寸到12英寸)和工藝需求,夾持
2025-07-23 14:25:43 931
931 晶圓清洗工藝是半導體制造中的關鍵步驟,用于去除晶圓表面的污染物(如顆粒、有機物、金屬離子和氧化物),確保后續工藝(如光刻、沉積、刻蝕)的良率和器件性能。根據清洗介質、工藝原理和設備類型的不同,晶圓
2025-07-23 14:32:16 1370
1370 
退火工藝是晶圓制造中的關鍵步驟,通過控制加熱和冷卻過程,退火能夠緩解應力、修復晶格缺陷、激活摻雜原子,并改善材料的電學和機械性質。這些改進對于確保晶圓在后續加工和最終應用中的性能和可靠性至關重要。退火工藝在晶圓制造過程中扮演著至關重要的角色。
2025-08-01 09:35:23 2030
2030 
摘要
本文聚焦半導體晶圓研磨工藝,介紹梯度結構聚氨酯研磨墊的制備方法,深入探究其對晶圓總厚度變化(TTV)均勻性的提升作用,為提高晶圓研磨質量提供新的技術思路與理論依據。
引言
在半導體制造過程中
2025-08-04 10:24:42 683
683 
摘要
本文圍繞半導體晶圓研磨工藝,深入剖析聚氨酯研磨墊磨損狀態與晶圓 TTV 均勻性的退化關系,探究其退化機理,并提出相應的預警方法,為保障晶圓研磨質量、優化研磨工藝提供理論與技術支持。
引言
在
2025-08-05 10:16:02 686
686 
我將從超薄晶圓研磨面臨的挑戰出發,點明聚氨酯墊性能對晶圓 TTV 的關鍵影響,引出研究意義。接著分析聚氨酯墊性能與 TTV 的關聯,闡述性能優化方向及 TTV 保障技術,最后通過實驗初步驗證效果。
超薄晶圓(
2025-08-06 11:32:54 585
585 
在半導體制造的精密世界里,每一個微小的改進都可能引發效率的飛躍。今天,美能光子灣科技將帶您一探晶圓背面磨削工藝中的關鍵技術——總厚度變化(TTV)控制的奧秘。隨著三維集成電路3DIC制造技術
2025-08-05 17:55:08 3376
3376 
如有雷同或是不當之處,還請大家海涵。當前在各網絡平臺上均以此昵稱為ID跟大家一起交流學習! 在全球半導體技術飛速迭代的今天,芯片作為支撐現代科技運轉的 “核心引擎”,正朝著更輕薄、高性能的方向加速演進。而晶圓減薄技
2025-12-31 21:38:57 38
38 
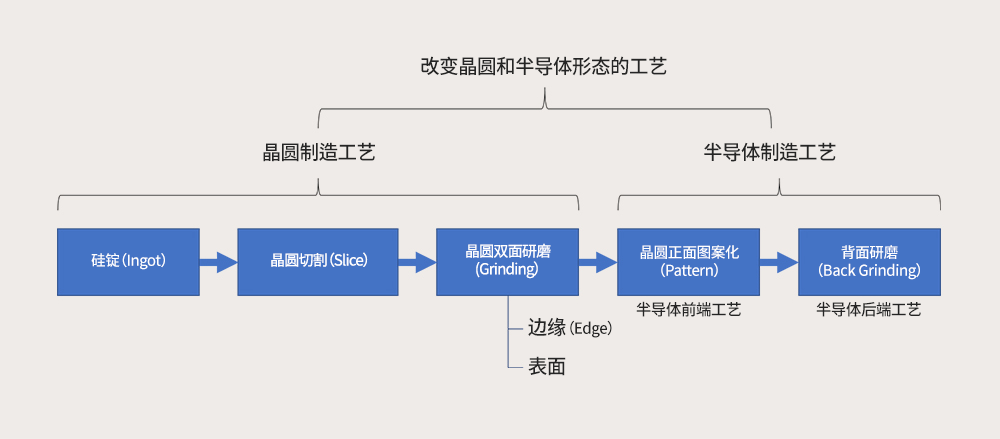

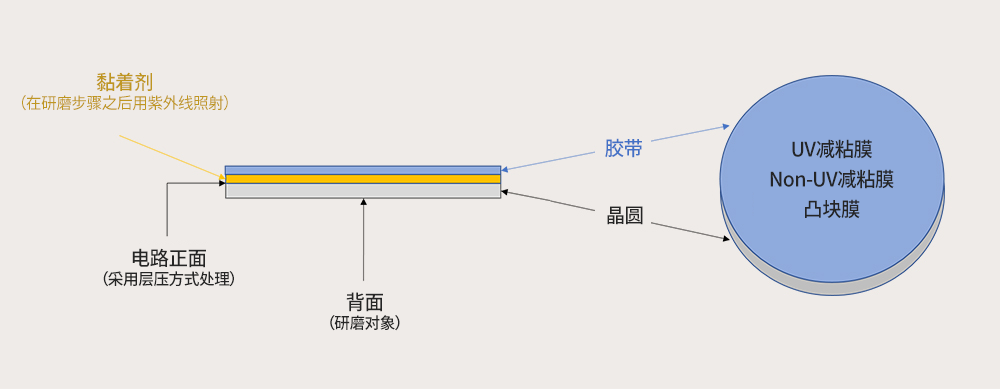
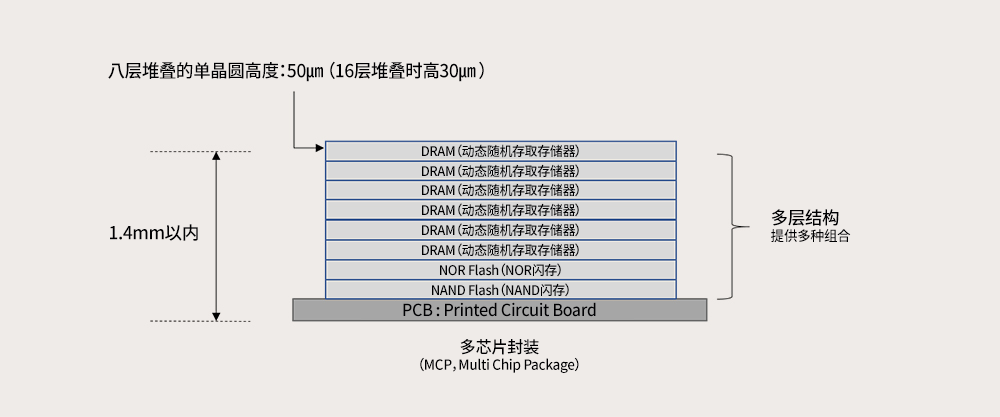
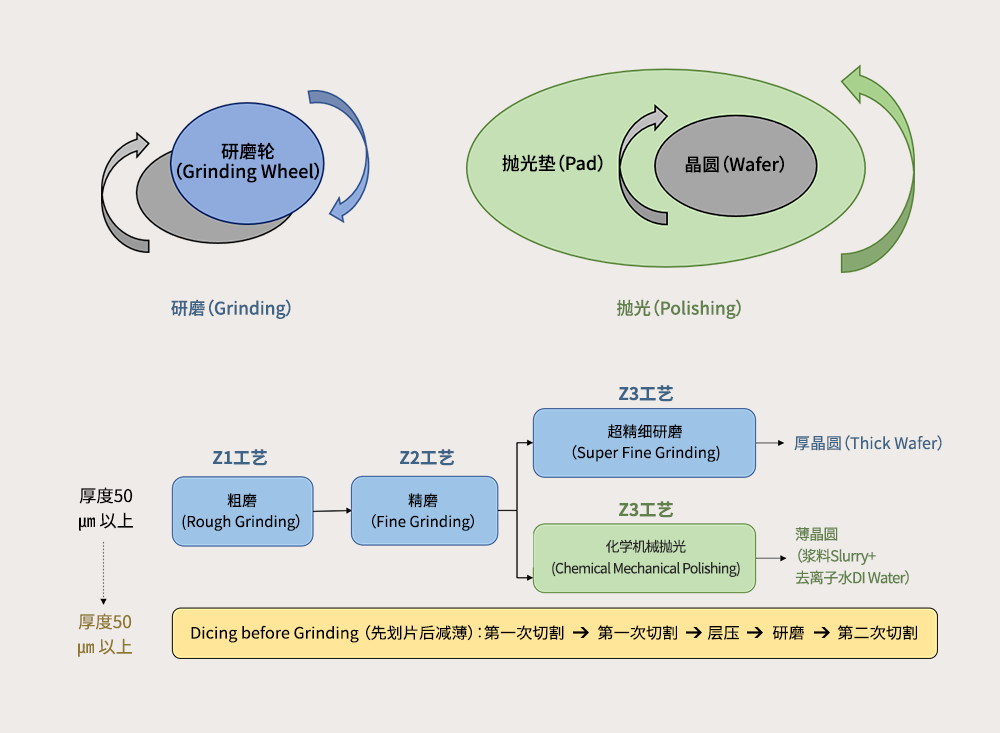
 電子發燒友App
電子發燒友App




















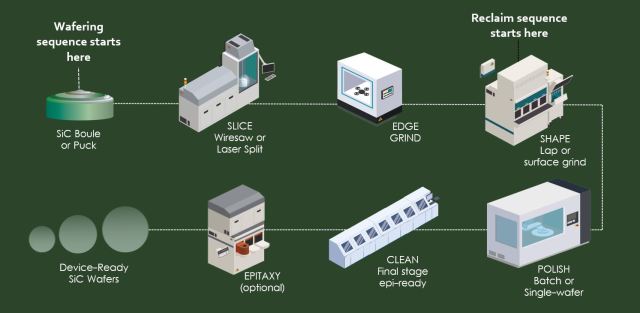

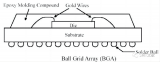
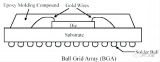

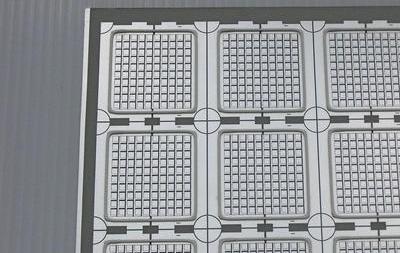




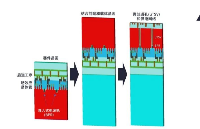






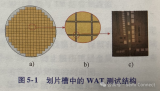













評論