)、重新分配層(RDL)封裝、倒片(Flip Chip)封裝、及硅通孔(TSV)封裝。此外,本文還將介紹應用于這些晶圓級封裝的各項工藝,包括光刻(Photolithography)工藝、濺射(Sputtering)工藝、電鍍(Electroplating)工藝和濕法(Wet)工藝。
2023-11-08 09:20:19 11649
11649 
芯片底部填充工藝流程有哪些?底部填充工藝(Underfill)是一種在電子封裝過程中廣泛使用的技術,主要用于增強倒裝芯片(FlipChip)、球柵陣列(BGA)、芯片級封裝(CSP)等高級封裝技術中
2024-08-09 08:36:49 2746
2746 
元件;圖(c)表示元件合適的壓入焊膏,后工序回流焊后會形成良好的焊點。 圖 元件貼裝不同壓入程度 上述元件壓入程度的情況,對于0603,0402及CSP等細小元件的影響更大。例如,0603元件的高度
2018-09-07 15:56:57
。 圖2 SnAgCu元件移除溫度曲線 對于錫鉛裝配,具有“實際意義”的元件重新貼裝溫度曲線可以描述如下,如圖3所示。 ·焊點回流溫度212℃; ·元件表面溫度240℃; ·上表面加熱器溫度
2018-11-22 11:04:18
焊盤整理完成之后就可以重新貼裝元件了。這時我們又面臨了新的問題:如果選擇錫膏裝配的話,如何印刷錫膏呢?對于密間距的晶圓級CSP來說,這的確是一個難題。有采用小鋼網,采用手工的方式來局部印刷錫膏
2018-09-06 16:32:16
晶圓級CSP的裝配對貼裝壓力控制、貼裝精度及穩定性、照相機和影像處理技術、吸嘴的選擇、助焊劑應 用單元和供料器,以及板支撐及定位系統的要求類似倒裝晶片對設備的要求。WLCSP貼裝工藝的控制可以參
2018-09-06 16:32:18
晶圓級CSP的返修工藝包括哪幾個步驟?晶圓級CSP對返修設備的要求是什么?
2021-04-25 08:33:16
晶圓級CSP的元件如何重新貼裝?怎么進行底部填充?
2021-04-25 06:31:58
是這種方法高度依賴操作員的經驗,刷子用過幾次之后容易破損。清理的時間由于焊盤的大小及殘留物的多少而不同。圖1 移除元件后以拋光刷整理焊盤 底部填充材料Loctite 221516 A(ver 1.0
2018-09-06 16:33:15
細間距的晶圓級CSP時,將其當做倒裝晶片并采用助焊劑浸蘸的方法進行組裝,以取代傳統的焊膏印刷組裝,如圖2所示,首先將晶圓級CSP浸蘸在設定厚度的助焊劑薄膜中,然后貼裝,再回流焊接,最后底部填充(如果有要求)。關于錫膏裝配和助焊劑裝配的優缺點。圖1 工藝流程1——錫膏裝配圖2 工藝流程2——助焊劑裝配
2018-09-06 16:24:04
,采用其他玻璃化 轉變溫度更高,熱膨脹系數較低,填充物含量較高的膠水,采用局部填充的裝配方式,其可靠性至少可以提 升5倍。但是周邊底部填充和四角底部填充的方法雖然可有效提升晶圓級CSP裝配件的可靠性,但
2018-09-06 16:40:03
晶圓級CSP裝配回流焊接工藝控制,看完你就懂了
2021-04-25 06:28:40
; ·尺寸和位置精度受阻焊膜窗口的影響,不適合密間距元件的裝配。 NSMD焊盤的尺寸和位置不受阻焊膜窗口的影響,在焊盤和阻焊膜之間有一定空隙,如圖2和圖3所示。對于 密間距晶圓級CSP,印刷電路板上的焊盤
2018-09-06 16:32:27
低,這樣焊錫膏可以很容易地沉積。 對于0.5 mm和0.4 mm晶圓級CSP的裝配,錫膏印刷面臨挑戰,選擇合適的錫膏是關鍵之一。0.5 mmCSP的印 刷可以選用免洗型type3。0.4 mmCSP
2018-11-22 16:27:28
,溫度升至25℃需要約4 h。使用前需要攪拌,可以利用自動攪拌機攪拌2~4 min。 4)印刷刮刀的選擇 刮刀材料一般有不銹鋼片和橡膠兩種,對于晶圓級CSP的錫膏印刷,一股采用金屬刮刀。金屬刀刃
2018-09-06 16:32:20
返修之后可以對重新裝配的元件進行檢查測試,檢查測試的方法包括非破壞性的檢查方法,如目視、光 學顯微鏡、電子掃描顯微鏡、超聲波掃描顯微鏡、X-Ray和一些破壞性的檢查測試,如切片和染色實驗、老 化
2018-09-06 16:39:59
整理過程不同于未做底部填充的CSP裝配。在元件移除過程中,需要更高的溫度 ,并且需要機械的扭轉動作來克服填充材料對元件的黏著力,只用真空吸取不能將元件移除。焊盤重新整理 變成了兩個步驟,首先清除PCB上殘留
2018-09-06 16:32:17
先進封裝發展背景晶圓級三維封裝技術發展
2020-12-28 07:15:50
晶圓級封裝技術源自于倒裝芯片。晶圓級封裝的開發主要是由集成器件制造廠家(IBM)率先啟動。1964年,美國IBM公司在其M360計算器中最先采用了FCOB焊料凸點倒裝芯片器件。
2020-03-06 09:02:23
晶圓級封裝類型及涉及的產品
2015-07-11 18:21:31
晶圓級芯片封裝技術是對整片晶圓進行封裝測試后再切割得到單個成品芯片的技術,封裝后的芯片尺寸與裸片一致。
2019-09-18 09:02:14
有人又將其稱為圓片級-芯片尺寸封裝(WLP-CSP),以晶圓圓片為加工對象,在晶圓上封裝芯片。晶圓封裝中最關鍵的工藝為晶圓鍵合,即是通過化學或物理的方法將兩片晶圓結合在一起,以達到密封效果。如下
2021-02-23 16:35:18
。分別如圖1(a)和(b)所示。 就貼裝技術本身的工作原理和要求而言,實際上是相當簡單的。用一定的方式把SMC /SMD(表面貼裝元件和表面貼裝器件)從它的包裝中取出并貼放在印制板的規定的位置上
2018-09-05 16:40:48
的熱門先進技術。 比如說,如何處理在CSP和0201組裝中常見的超小開孔(250um)問題,就是焊膏印刷以前從未有過的基本物理問題。板級光電子組裝,作為通信和網絡技術中發展起來的一大領域,其工藝非常精細
2018-09-10 15:46:13
SiC SBD 晶圓級測試 求助:需要測試的參數和測試方法謝謝
2020-08-24 13:03:34
小,擊穿電壓穩定,良率高,鉗位 電壓一般,電容有低容,普容和高容,6寸可以做回掃型ESD產品;第三代TVS主要以8寸晶圓流片為主,以CSP晶圓級封裝為主(DFN),這種產品是高性能的ESD,采用8寸的先進
2020-07-30 14:40:36
,我們將采用穿硅通孔(TSV)用于晶圓級堆疊器件的互連。該技術基本工藝為高密度鎢填充穿硅通孔,通孔尺寸從1μm到3μm。用金屬有機化學汽相淀積(MOCVD)淀積一層TiN薄膜作為籽晶層,隨后同樣也采用
2011-12-02 11:55:33
,目前半導體封裝產業正向晶圓級封裝方向發展。它是一種常用的提高硅片集成度的方法,具有降低測試和封裝成本,降低引線電感,提高電容特性,改良散熱通道,降低貼裝高度等優點。借用下面這個例子來理解晶圓級封裝
2011-12-01 13:58:36
底部填充工藝就是將環氧樹脂膠水點涂在倒裝晶片邊緣,通過“毛細管效應”,膠水被吸往元件的對側完成底 部充填過程,然后在加熱的情況下膠水固化。為了加快膠水填充的速度,往往還需要對基板進行預熱。利用
2018-09-06 16:40:41
①非PoP面元件組裝(印刷,貼片,回流和檢查); ② PoP面錫膏印刷: ③底部元件和其他器件貼裝; ④頂部元件蘸取助焊劑或錫膏; ⑥項部元件貼裝: ⑥回流焊接及檢測。 由于錫膏印刷
2018-09-06 16:40:36
的元件數目減少,器件的組裝更快。板級組裝由于目前使用的放置元件設備和回流焊設備可以用于CSP的組裝,因此,板級組裝時不需要特別的設備把芯片放在PCB上。因為CSP是從卷帶上拾取并放置到PCB上,所以
2018-11-23 16:58:54
顆粒(如三星,現代,美光,力晶,爾必達等)有長期供貨能力(這方面渠道的)請與我公司聯系采購各類半導體報廢晶圓片,IC晶圓、IC硅片、IC裸片、IC級單晶硅片、單晶硅IC小顆粒、IC級白/藍膜片、蕓膜片
2020-12-29 08:27:02
元件貼裝范圍主要是指所能貼裝的最大和最小元件的范圍和所能識別元件的最小特征。由于硬件條件所限,每一臺機器也都由于它的特點而有一定的元件貼裝范圍。影響貼片機貼裝元器仵范圍的主要因素有: (1
2018-09-05 16:39:08
怎么選擇晶圓級CSP裝配工藝的錫膏?
2021-04-25 08:48:29
,12寸晶圓有較高的產能。當然,生產晶圓的過程當中,良品率是很重要的條件。晶圓是指硅半導體積體電路制作所用的硅晶片,由于其形狀為圓形,故稱為晶圓;在硅晶片上可加工制作成各種電路元件結構,而成為有特定電
2011-12-02 14:30:44
SRAM中晶圓級芯片級封裝的需求
2020-12-31 07:50:40
多數返修工藝的開發都會考慮盡量減少對操作員的依賴以提高可靠性。但是對經過底部填充的CSP的移除 ,僅僅用真空吸嘴不能將元件移除。經過加熱軟化的底部填充材料對元件具有黏著力,此力遠大于熔融的焊 料
2018-09-06 16:40:01
。這種材料的例子有Cookson Staychip/2078E.圖5. 底部填充(可以是在回流焊之后以液體形式填充,或者在芯片貼裝到PCB之前以膏體或固體形式涂敷填充)。 焊盤布局 垂直和水平安裝方向
2018-09-12 15:03:30
・采用索尼獨特的行星貼片頭,實現了高速貼裝-排列式貼片頭的2倍・可應用于TV的背光,照明基板的貼裝-貼裝范圍622mm/載板650mm※選購件・充分考慮LED元件的
2010-11-15 20:43:20 34
34 元件貼裝技術
SMT元件貼裝系統正在迅速地進化,特別的焦點在于兩個獨特的系統特征。第一個與處理所有出現在生產場合的最新包裝類型有關,這包括永遠在縮小的元
2009-10-10 16:18:33 1152
1152 晶圓級CSP的返修工藝
經底部填充的CSP裝配,其穩健的機械連接強度得到很大的提升。在二級裝配中,由于底部填充,其抵御 由于
2009-11-20 15:42:17 682
682 晶圓級CSP的裝配工藝流程
目前有兩種典型的工藝流程,一種是考慮與其他元件的SMT配,首先是錫膏印刷,然后貼裝CSP,回流焊接
2009-11-20 15:44:59 1607
1607 表面貼裝元件的手工焊接技巧
現在越來越多的電路板采用表面貼裝元件,同傳統的封裝相比,它可以減少電路板的面積,易于大批量加工,布線密
2010-01-16 11:58:59 3451
3451 晶圓級封裝產業(WLP),晶圓級封裝產業(WLP)是什么意思
一、晶圓級封裝(Wafer Level Packaging)簡介 晶圓級封裝(WLP,Wafer Level Package) 的一般定
2010-03-04 11:35:01 46790
46790 微芯科技晶圓級芯片封裝和TO-92封裝
Microchip Technology Inc.(美國微芯科技公司)宣布推出單I/O總線UNI/O EEPROM器件并且開始供貨,除了采用3引腳SOT-23封裝
2010-04-08 14:26:25 2858
2858 表面貼裝技術所用元器件包括表面貼裝元件(Surface Mounted Component,簡稱SMC)與表面貼裝器件(Surface Mounted Device,簡稱SMD)。
2011-12-23 11:58:36 2555
2555 超級CSP——讓倒裝芯片獲得最大可靠性一種晶圓片級封裝
2017-09-14 11:31:37 22
22 由于電子產品越來越細小,晶圓級CSP組裝已經廣泛地應用在不同產品了。
2018-10-30 09:51:06 47034
47034 MUNICH - Karl Suss KG GmbH&公司今天宣布與硅谷的Image Technology公司合作,開發和標準化9英寸掩模,用于大批量晶圓凸點和晶圓級芯片級封裝的生產。總體目標是降低晶圓級芯片級封裝的掩模成本。
2019-08-13 10:48:59 3097
3097 0201貼片元件的貼裝比其它貼片元件的貼裝更具挑戰性。主要原因是0201包裝大約為相應的0402尺寸的三分之一,原先可以接受的機器貼裝精度如果馬上變成引進 0201貼片元件就會產生很多的局限性。下面分享一下0201貼片元件貼裝關鍵技術點。
2020-03-12 11:15:58 8971
8971 填充點膠加工具有如下優點: PCB板芯片底部填充點膠加工主要用于PCB板的CSP/BGA的底部填充,點膠工藝操作性好,點膠加工后易維修,抗沖擊性能,抗跌落性能,抗振性能都比較好,在一定程度上提高了電子產品的穩定性與可靠性。 PCB板芯片底部填充點膠加工
2020-07-28 10:14:50 7304
7304 元件中,提供更多I/O連接口,同時達至最佳的電熱性能。 在采用扇出型晶圓級封裝技術時,需要采用精準度極高的貼裝平臺,確保能精準貼裝不同形狀的元件,不同類型的芯片及不同尺寸的無源器件,達至最高的生產效益。 傳統的
2020-09-23 13:52:28 3780
3780 晶圓在現實生活中具有重要應用,缺少晶圓,我們的手機、電腦等將無法制成。而且,高質量晶圓必將為我們制造的產品帶來更高的性能。為增進大家對晶圓的了解,本文將對晶圓級CSP的返修工藝予以介紹。如果你對晶圓,抑或是晶圓相關內容具有興趣,不妨繼續往下閱讀哦。
2021-02-11 17:38:00 2677
2677 表面貼裝元件的熱管理一般應用說明
2021-04-29 18:41:19 11
11 圓級封裝? 晶圓級封裝,即將晶圓作為加工對象,直接在整片晶圓上進行CSP封裝及測試,最后再切割成單個器件,同時具備更多的功能集成,尺寸也更小,可直接貼裝到基板或印刷電路板上。 1.傳統封裝 2.晶圓級封裝 這樣改變之后,芯片設計
2021-10-14 10:33:15 1836
1836 什么是底部填充膠?底部填充膠簡單來說就是底部填充用的膠水,主要是以主要成份為環氧樹脂的膠水對BGA 封裝模式的芯片進行底部填充,利用加熱的固化形式,將BGA芯片底部空隙大面積 (一般覆蓋80%以上)填滿,從而達到加固芯片的目的,進而增強芯片和PCBA 之間的抗跌落性能。
2021-07-19 09:30:50 8798
8798 在傳統晶圓封裝中,是將成品晶圓切割成單個芯片,然后再進行黏合封裝。不同于傳統封裝工藝,晶圓級封裝是在芯片還在晶圓上的時候就對芯片進行封裝,保護層可以黏接在晶圓的頂部或底部,然后連接電路,再將晶圓切成單個芯片。
2022-04-06 15:24:19 12070
12070 、CSP、Flipchip(倒裝芯片)封裝、QFP封裝、QFN封裝得到快速應用,封裝工藝要求越來越高,底部填充膠的作用越來越重要。底部填充膠是一種單組份環氧樹脂密
2023-03-10 16:10:57 2052
2052 
underfill底部填充工藝用膠解決方案由漢思新材料提供隨著手機、電腦等便攜式電子產品的發展趨向薄型化、小型化、高性能化,IC封裝也趨向小型化、高聚集化方向發展。而底部封裝點膠工藝可以解決精密電子元件
2023-04-14 15:04:16 3369
3369 
TF存儲卡晶圓和主控芯片貼裝用低溫熱固化膠水應用由漢思新材料提供通過和客戶工程人員詳細溝通了解到;以下信息;客戶生產的產品是:TF存儲卡使用部位:晶圓貼裝芯片尺寸:1.5*3.mm需求原因:新產品
2023-05-16 15:12:31 1846
1846 
光電傳感器WL-CSP封裝芯片底部填充膠應用由漢思新材料提供光電傳感器芯片(CCD)經過聯系客戶工程技術和研究其提供的封裝工藝流程。了解到以下信息。客戶用膠項目是:光電傳感器芯片(CCD
2023-05-18 05:00:00 1791
1791 
LED藍燈倒裝芯片底部填充膠應用由漢思新材料提供客戶的產品是LED藍燈倒裝芯片。芯片參數:沒有錫球,大小35um--55um不等有很多個,芯片厚度115um.客戶用膠點:需要芯片四周填充加固,銀漿
2023-05-26 15:15:45 2100
2100 
。漢思新材料推薦用膠:根據客戶提供的基本信息,無人機航空電子模塊用底部填充膠水,推薦漢思底部填充膠HS710給客戶。漢思新材料自主研發的芯片底部填充膠,是一種單組份、改性環氧樹脂膠,用于BGA、CSP和F
2023-06-16 14:45:44 2534
2534 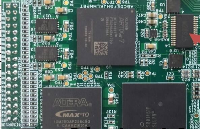
近幾年,我國的科技發現迅速,為了迎合電子市場的需求,市場上涌現出了一批底部填充膠廠家,面對這林林總總的底部填充膠廠家,我們該如何選擇呢?底部填充膠什么牌子好?底部填充膠國內有哪些廠家?下面一起聽一聽
2023-06-28 14:53:17 3016
3016 
底部填充膠十大品牌排行榜之一漢思底部填充膠應運而生,通過多年驗證及大量的終端客戶反饋,漢思底部填充膠HS700系列完全媲美海外品牌。據了解電子產品的生產商為了滿足終端銷費者的各種需求,也是為了在競爭
2023-07-11 13:41:53 2152
2152 
據了解現在很多3c電子工廠,電子產品都用底部填充膠來保護電路板芯片/BGA電子元件,其中電路板pcb也是有一定的成本,所以底部填充膠的返修也是個重要環節.底部填充膠的返修工藝步驟:1.把CSP
2023-07-31 14:23:56 2507
2507 
底部填充膠對SMT(電子電路表面組裝技術)元件(如:BGA、CSA芯片等)裝配的長期可靠性有了一定的保障性;還能很好的減少焊接點的應力,將應力均勻分散在芯片的界面上,在芯片錫球陣列中,底部填充膠能有
2023-08-07 11:24:38 1145
1145 工序: 絲印錫膏(頂面)=》貼裝元件=》回流焊接=》反面=》滴(印)膠(底面)=》貼裝元件=》烘干膠=》反面=》插元件=》波峰焊接
2023-08-15 12:05:29 785
785 就貼裝技術本身的工作原理和要求而言,實際上是相當簡單的。用一定的方式把SMC /SMD(表面貼裝元件和表面貼裝器件)從它的包裝中取出并貼放在印制板的規定的位置上。但是在工業系統迄今很少有其他工藝要求可以與SMT中的貼裝技術相比。
2023-09-11 15:32:11 1115
1115 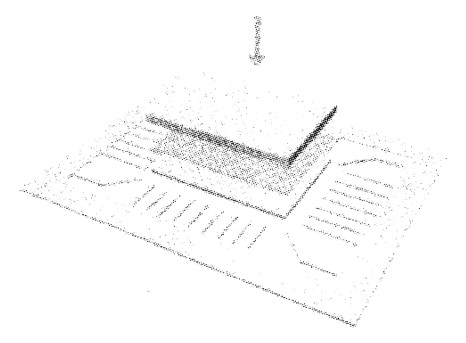
在元件貼裝完畢后,還可以對已經貼裝完的元件進行驗證。機器的線路板識別相機將會根據元件的貼裝順序對已貼裝的元件進行驗證,從而得知元件是否準確無誤地貼裝(如圖1所示)。
2023-09-12 15:28:07 782
782 
元件貼放是通過吸嘴在z軸方向下降并在元件接觸焊膏的時候去除吸嘴內的負壓,從而使元件黏附在焊膏上而完成貼裝過程。正確的貼裝應該使元件適度壓入焊膏,依靠焊膏的黏結力將元件固定在印制板上。
2023-09-13 15:26:49 830
830 
對0201元件和01005元件成像對中需要高倍率的相機,光源的使用和其他較大的片裝元件也有區別。一般的元 件如0603或0805等元件,使用背光,找到整個外形輪廓的中心就好。但是0201或01005元件需要使用前光,或仰 視照相,找到兩個電氣端之間的中心,以提高貼裝。
2023-09-15 15:10:35 1457
1457 
從圖2中可以看出,送板時間由兩部分組成,部分包含了單PCB送入到貼裝區的時間和在貼裝區夾持固定所 用的時間;第工部分包含了松開PCB所用時問和將PCB送出貼裝區的時問;貼裝時間則是指從送板時間計時結束開 始到一個元件貼裝結束之間的時間,包括PCB上基準點的識別、吸嘴的更換和所有元件貼裝所用的時間。
2023-09-18 15:09:39 925
925 
對于0.5 mm和0.4 mm晶圓級CSP的裝配,錫膏印刷面臨挑戰,選擇合適的錫膏是關鍵之一。0.5 mmCSP的印 刷可以選用免洗型type3。0.4 mmCSP的印刷可以選用免洗型type3或type4,但type4有時可能會出現連錫現 象。
2023-09-27 14:58:28 915
915 NSMD焊盤的尺寸和位置不受阻焊膜窗口的影響,在焊盤和阻焊膜之間有一定空隙,如圖2和圖3所示。對于 密間距晶圓級CSP,印刷電路板上的焊盤一般都采用NSMD設計。
2023-09-27 15:02:03 1441
1441 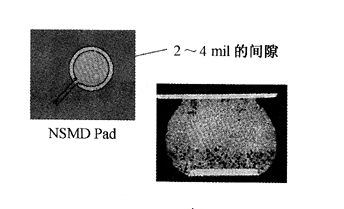
焊盤的清理分為兩個步驟,首先清理殘留的底部填充材料,然后再清理焊盤上多余的焊料,獲得平整的焊 盤表面,用IPA清潔焊盤區域。殘留填充材料的清除可以利用可以旋轉的拋光刷來清理
2023-09-28 15:50:02 1536
1536 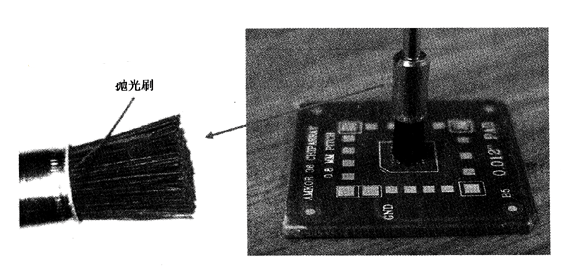
漢思HS711芯片BGA底部填充膠是專為手機、數碼相機以及手提電腦等數碼產品而研發生產的,用于這些數碼產品內部芯片的底部填充。那么為什么這些手機數碼產品需要用到芯片BGA底部填充膠呢?其實芯片BGA
2023-11-06 14:54:42 1012
1012 
【科普】什么是晶圓級封裝
2023-12-07 11:34:01 2771
2771 
共讀好書 在本文中,我們將重點介紹半導體封裝的另一種主要方法——晶圓級封裝(WLP)。本文將探討晶圓級封裝的五項基本工藝,包括:光刻(Photolithography)工藝、濺射
2024-03-05 08:42:13 3554
3554 
什么是芯片底部填充膠,它有什么特點?芯片底部填充膠是一種用于電子封裝的膠水,主要用于底部填充bga芯片電子組件,以增強組件的可靠性和穩定性。它通常是一種環氧樹脂,具有良好的粘接性和耐熱性。底部填充膠
2024-03-14 14:10:51 2008
2008 
底部填充膠在汽車電子領域的應用有哪些?在汽車電子領域,底部填充膠被廣泛應用于IC封裝等,以實現小型化、高聚集化方向發展。底部填充膠在汽車電子領域有多種應用,包括以下方面:傳感器和執行器的封裝:汽車中
2024-03-26 15:30:02 1541
1541 
晶圓貼膜機的半導體應用
2024-08-19 17:21:34 1244
1244 
(Fan-Out WLCSP)、重新分配層(RDL)封裝、倒片(Flip Chip)封裝、及硅通孔(TSV)封裝。此外,本文還將介紹應用于這些晶圓級封裝的各項工藝,包括光刻(Photolithography)工藝、濺射(Sputtering)工藝、電鍍(Electroplating)工藝和濕法(Wet)工藝。
2024-08-21 15:10:38 4447
4447 
芯片封裝底部填充材料如何選擇?芯片封裝底部填充材料的選擇是一個復雜而關鍵的過程,它直接影響到芯片封裝的可靠性和性能。底部填充材料(Underfill)的主要功能是在芯片與基板之間提供額外的機械支撐
2024-08-29 14:58:51 1584
1584 
高臺階基底晶圓貼蠟方法是半導體制造中的一個關鍵步驟,特別是在處理具有高階臺金屬結構的晶圓時。以下是一種有效的高臺階基底晶圓貼蠟方法:
一、方法概述
該方法利用膠厚和蠟厚將高臺階填平,并使用較輕
2024-12-18 09:47:05 406
406 
芯片底部填充膠種類有哪些?底部填充膠(Underfill)又稱底部填充劑,指以高分子材料為原材料制成的電子封裝膠,主要用于在芯片和基板之間的空隙中填充,以增強機械強度、熱穩定性和可靠性。根據其化學
2024-12-27 09:16:31 1764
1764 
(No-Flow Underfill,NUF)。 晶圓級底部填充膠(Wafer-Level Underfill, WLUF)。 模塑底部填充膠(Molded Underfill,MUF)。 每種Underf
2025-01-28 15:41:00 3970
3970 
產品特性1.高可靠性與機械強度漢思底部填充膠采用單組份改性環氧樹脂配方,專為BGA、CSP和Flipchip設計。通過加熱固化,能填充芯片底部80%以上的空隙,顯著
2025-02-20 09:55:59 1170
1170 
守護著車內的"電子大腦"。它們就是車規級芯片底部填充膠——這種像蜂蜜般流淌的電子封裝材料,正在重新定義汽車電子系統的可靠性。漢思新材料:車規級芯片底部填充膠守護你的智能汽車一、汽車芯片的"生存考驗"現代汽
2025-03-27 15:33:21 1390
1390 
漢思新材料HS711是一種專為板卡級芯片底部填充封裝設計的膠水。HS711填充膠主要用于電子封裝領域,特別是在半導體封裝中,以提供機械支撐、應力緩沖和保護芯片與基板之間的連接免受環境因素的影響。漢思
2025-04-11 14:24:01 785
785 
貼膜是指將一片經過減薄處理的晶圓(Wafer)固定在一層特殊的膠膜上,這層膜通常為藍色,業內常稱為“ 藍膜 ”。貼膜的目的是為后續的晶圓切割(劃片)工藝做準備。
2025-06-03 18:20:59 1180
1180 
底部填充膠返修難題分析與解決方案底部填充膠(Underfill)在電子封裝中(特別是BGA、CSP等封裝)應用廣泛,主要作用是提高焊點的機械強度和可靠性,尤其是在應對熱循環、機械沖擊和振動時。然而
2025-06-20 10:12:37 951
951 
解決方案,在半導體封裝領域占據了重要地位。底部填充膠主要用于BGA(球柵陣列)、CSP(芯片級封裝)和FlipChip(倒裝芯片)等先進封裝工藝中,通過填充芯片與
2025-09-05 10:48:21 2134
2134 
 電子發燒友App
電子發燒友App

















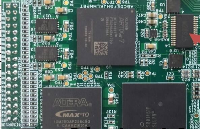



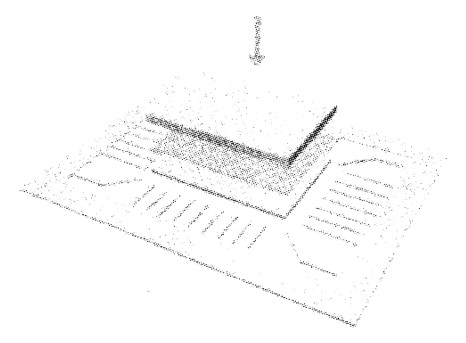




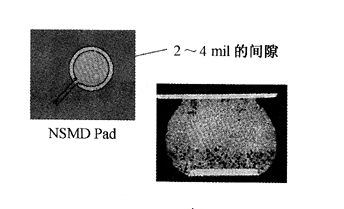
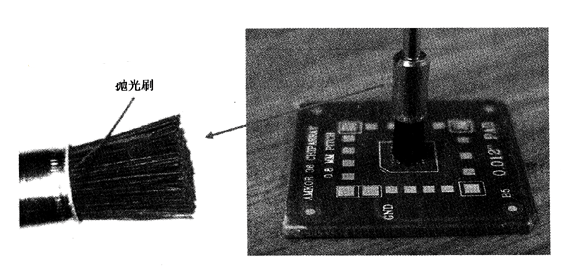


















評論