常規(guī)IC封裝需經(jīng)過(guò)將晶圓與IC封裝基板焊接,再將IC基板焊接至普通PCB的復(fù)雜過(guò)程。與之不同,WLP基于IC晶圓,借助PCB制造技術(shù),在晶圓上構(gòu)建類(lèi)似IC封裝基板的結(jié)構(gòu),塑封后可直接安裝在普通PCB
2025-05-14 11:08:16 2423
2423 
晶棒需要經(jīng)過(guò)一系列加工,才能形成符合半導(dǎo)體制造要求的硅襯底,即晶圓。加工的基本流程為:滾磨、切斷、切片、硅片退火、倒角、研磨、拋光,以及清洗與包裝等。
2025-08-12 10:43:43 4166
4166 
晶圓是指硅半導(dǎo)體集成電路制作所用的硅晶片,由于其形狀為圓形,故稱(chēng)為晶圓;在硅晶片上可加工制作成各種電路元件結(jié)構(gòu),而成為有特定電性功能之IC產(chǎn)品。晶圓的原始材料是硅,而
2011-11-24 09:21:42 8021
8021 經(jīng)過(guò)前端工藝處理并通過(guò)晶圓測(cè)試的晶圓將從背面研磨(Back Grinding)開(kāi)始后端處理。背面研磨是將晶圓背面磨薄的工序,其目的不僅是為了減少晶圓厚度,還在于聯(lián)結(jié)前端和后端工藝以解決前后兩個(gè)工藝
2023-05-12 12:39:18 3435
3435 
經(jīng)過(guò)前端工藝處理并通過(guò)晶圓測(cè)試的晶圓將從背面研磨(Back Grinding)開(kāi)始后端處理。背面研磨是將晶圓背面磨薄的工序,其目的不僅是為了減少晶圓厚度,還在于聯(lián)結(jié)前端和后端工藝以解決前后兩個(gè)工藝
2023-05-22 12:44:23 2648
2648 
晶圓承載系統(tǒng)是指針對(duì)晶圓背面減薄進(jìn)行進(jìn)一步加工的系統(tǒng),該工藝一般在背面研磨前使用。晶圓承載系統(tǒng)工序涉及兩個(gè)步驟:首先是載片鍵合,需將被用于硅通孔封裝的晶圓貼附于載片上;其次是載片脫粘,即在如晶圓背面凸點(diǎn)制作等流程完工后,將載片分離。
2023-11-13 14:02:49 6499
6499 
在本文中,我們將重點(diǎn)介紹半導(dǎo)體封裝的另一種主要方法——晶圓級(jí)封裝(WLP)。本文將探討晶圓級(jí)封裝的五項(xiàng)基本工藝,包括:光刻(Photolithography)工藝、濺射(Sputtering)工藝
2024-01-24 09:39:09 3633
3633 
在半導(dǎo)體制造的復(fù)雜流程中,晶圓歷經(jīng)前道工序完成芯片制備后,劃片工藝成為將芯片從晶圓上分離的關(guān)鍵環(huán)節(jié),為后續(xù)封裝奠定基礎(chǔ)。由于不同厚度的晶圓具有各異的物理特性,因此需匹配不同的切割工藝,以確保切割效果與芯片質(zhì)量。
2025-02-07 09:41:00 3050
3050 
晶圓制備是材料科學(xué)、熱力學(xué)與精密控制的綜合體現(xiàn),每一環(huán)節(jié)均凝聚著工程技術(shù)的極致追求。而晶圓清洗本質(zhì)是半導(dǎo)體工業(yè)與污染物持續(xù)博弈的縮影,每一次工藝革新都在突破物理極限。
2025-05-07 15:12:30 2193
2193 
本內(nèi)容詳解了晶圓制造工藝流程,包括表面清洗,初次氧化,熱處理,光刻技術(shù)和離子刻蝕技術(shù)等
2011-11-24 09:32:10 7546
7546 小弟想知道8寸晶圓盒的制造工藝和檢驗(yàn)規(guī)范,還有不知道在大陸有誰(shuí)在生產(chǎn)?
2010-08-04 14:02:12
的印刷焊膏。 印刷焊膏的優(yōu)點(diǎn)之一是設(shè)備投資少,這使很多晶圓凸起加工制造商都能進(jìn)入該市場(chǎng),為半導(dǎo)體廠(chǎng)商服務(wù)。隨著WLP逐漸為商業(yè)市場(chǎng)所接受,全新晶圓凸起專(zhuān)業(yè)加工服務(wù)需求持續(xù)迅速增長(zhǎng)。 實(shí)用工藝開(kāi)發(fā)
2011-12-01 14:33:02
`晶圓制造總的工藝流程芯片的制造過(guò)程可概分為晶圓處理工序(Wafer Fabrication)、晶圓針測(cè)工序(Wafer Probe)、構(gòu)裝工序(Packaging)、測(cè)試工序(Initial
2011-12-01 15:43:10
+ 4HNO3 + 6 HF? 3H2SiF6 +4 NO + 8H2O 拋光:機(jī)械研磨、化學(xué)作用使表面平坦,移除晶圓表面的缺陷八、晶圓測(cè)試主要分三類(lèi):功能測(cè)試、性能測(cè)試、抗老化測(cè)試。具體有如:接觸測(cè)試
2019-09-17 09:05:06
晶圓是指硅半導(dǎo)體集成電路制作所用的硅晶片,由于其形狀為圓形,故稱(chēng)為晶圓;在硅晶片上可加工制作成各種電路元件結(jié)構(gòu),而成為有特定電性功能之IC產(chǎn)品。晶圓的原始材料是硅,而地殼表面有用之不竭的二氧化硅
2011-12-01 14:53:05
有人又將其稱(chēng)為圓片級(jí)-芯片尺寸封裝(WLP-CSP),以晶圓圓片為加工對(duì)象,在晶圓上封裝芯片。晶圓封裝中最關(guān)鍵的工藝為晶圓鍵合,即是通過(guò)化學(xué)或物理的方法將兩片晶圓結(jié)合在一起,以達(dá)到密封效果。如下
2021-02-23 16:35:18
晶圓級(jí)CSP的返修工藝包括哪幾個(gè)步驟?晶圓級(jí)CSP對(duì)返修設(shè)備的要求是什么?
2021-04-25 08:33:16
晶圓級(jí)CSP裝配回流焊接工藝控制,看完你就懂了
2021-04-25 06:28:40
晶圓級(jí)CSP的裝配對(duì)貼裝壓力控制、貼裝精度及穩(wěn)定性、照相機(jī)和影像處理技術(shù)、吸嘴的選擇、助焊劑應(yīng) 用單元和供料器,以及板支撐及定位系統(tǒng)的要求類(lèi)似倒裝晶片對(duì)設(shè)備的要求。WLCSP貼裝工藝的控制可以參
2018-09-06 16:32:18
,、WAFER承載料盒、晶圓提籃,芯片盒,晶圓包裝盒,晶圓包裝,晶圓切片,晶圓生產(chǎn),晶圓制造,晶圓清洗,晶圓測(cè)試,晶圓切割,晶圓代工,晶圓銷(xiāo)售,晶圓片測(cè)試,晶圓運(yùn)輸用包裝盒,晶圓切割,防靜電IC托盤(pán)(IC
2020-07-10 19:52:04
所有的電子元器件。 d輔助工具少測(cè)試周期長(zhǎng)模擬IC設(shè)計(jì)者既需要全面的知識(shí),也需要長(zhǎng)時(shí)間經(jīng)驗(yàn)的積累。模擬IC設(shè)計(jì)者需要熟悉IC和晶圓制造工藝與流程,需要熟悉大部分元器件的電特性和物理特性。通常很少
2016-12-26 15:06:14
Memory、PLL 鎖相環(huán)電路、起振電路與溫補(bǔ)電路。上面六幅圖揭示了整個(gè)SITIME晶振生產(chǎn)工藝流程,SITIME MEMS 電子發(fā)燒友振采用上下兩個(gè)晶圓疊加的方式,外部用 IC 通用的塑料做為封裝。不僅大大減少的石英晶振的工序,而且更全面提升了產(chǎn)品性能。
2017-04-06 14:22:11
測(cè)量。
(2)系統(tǒng)覆蓋襯底切磨拋,光刻/蝕刻后翹曲度檢測(cè),背面減薄厚度監(jiān)測(cè)等關(guān)鍵工藝環(huán)節(jié)。
晶圓作為半導(dǎo)體工業(yè)的“地基”,其高純度、單晶結(jié)構(gòu)和大尺寸等特點(diǎn),支撐了芯片的高性能與低成本制造。其戰(zhàn)略?xún)r(jià)值不僅
2025-05-28 16:12:46
效應(yīng)和功耗。因此,三維系統(tǒng)集成技術(shù)在性能、功能和形狀因素等方面都具有較大的優(yōu)勢(shì)。用于三維集成的先進(jìn)晶圓級(jí)技術(shù)晶圓級(jí)封裝技術(shù)已在許多產(chǎn)品制造中得到廣泛應(yīng)用。目前正在開(kāi)發(fā)晶圓級(jí)封裝的不同工藝技術(shù),以滿(mǎn)足在提高性能
2011-12-02 11:55:33
產(chǎn)品重要性的同時(shí),不約而同地表示要將精力集中在高性能模擬產(chǎn)品上。那么,在眾說(shuō)紛紜“高性能”的情況下,什么產(chǎn)品才是高性能模擬產(chǎn)品?面對(duì)集成度越來(lái)越高的半導(dǎo)體行業(yè),高性能模擬產(chǎn)品是否生存不易?中國(guó)市場(chǎng)對(duì)高性能模擬產(chǎn)品的接受程度如何?
2019-06-20 06:22:00
納米到底有多細(xì)微?什么晶圓?如何制造單晶的晶圓?
2021-06-08 07:06:42
` 晶圓是指硅半導(dǎo)體集成電路制作所用的硅晶片,由于其形狀為圓形,故稱(chēng)為晶圓;在硅晶片上可加工制作成各種電路元件結(jié)構(gòu),而成為有特定電性功能之IC產(chǎn)品。晶圓的原始材料是硅,而地殼表面有用之不竭的二氧化硅
2011-12-01 11:40:04
的晶粒時(shí),標(biāo)有記號(hào)的不合格晶粒會(huì)被洮汰,不再進(jìn)行下一個(gè)制程,以免徒增制造成本。在晶圓制造完成之后,晶圓測(cè)試是一步非常重要的測(cè)試。這步測(cè)試是晶圓生產(chǎn)過(guò)程的成績(jī)單。在測(cè)試過(guò)程中,每一個(gè)芯片的電性能力和電路
2011-12-01 13:54:00
`晶圓級(jí)封裝(WLP)就是在其上已經(jīng)有某些電路微結(jié)構(gòu)(好比古董)的晶片(好比座墊)與另一塊經(jīng)腐蝕帶有空腔的晶片(好比玻璃罩)用化學(xué)鍵結(jié)合在一起。在這些電路微結(jié)構(gòu)體的上面就形成了一個(gè)帶有密閉空腔的保護(hù)
2011-12-01 13:58:36
本人做硅片,晶圓加工十三年,想做半導(dǎo)體行業(yè)的晶圓加工,不知道有沒(méi)有合適的工作?
2018-04-03 16:09:21
1、為什么晶圓要做成圓的?如果做成矩形,不是更加不易產(chǎn)生浪費(fèi)原料?2、為什么晶圓要多出一道研磨的工藝?為什么不能直接做成需求的厚度?
2014-01-20 15:58:42
翹曲度是實(shí)測(cè)平面在空間中的彎曲程度,以翹曲量來(lái)表示,比如絕對(duì)平面的翹曲度為0。計(jì)算翹曲平面在高度方向最遠(yuǎn)的兩點(diǎn)距離為最大翹曲變形量。翹曲度計(jì)算公式:晶圓翹曲度影響著晶圓直接鍵合質(zhì)量,翹曲度越小,表面
2022-11-18 17:45:23
的加工工藝流程,加工過(guò)程中需要運(yùn)用刻蝕機(jī)在晶圓上把復(fù)雜的3D圖形一層一層“堆疊”起來(lái),實(shí)現(xiàn)單片機(jī)IC芯片的更小化。芯片,本質(zhì)上是一片載有集成電路(IC:Integrated circuit)的半導(dǎo)體元件
2018-08-23 17:34:34
今日分享晶圓制造過(guò)程中的工藝及運(yùn)用到的半導(dǎo)體設(shè)備。晶圓制造過(guò)程中有幾大重要的步驟:氧化、沉積、光刻、刻蝕、離子注入/擴(kuò)散等。這幾個(gè)主要步驟都需要若干種半導(dǎo)體設(shè)備,滿(mǎn)足不同的需要。設(shè)備中應(yīng)用較為廣泛
2018-10-15 15:11:22
目晶圓提高了設(shè)計(jì)效率,降低了開(kāi)發(fā)成本,為設(shè)計(jì)人員提供了實(shí)踐機(jī)會(huì),并促進(jìn)了集成電路設(shè)計(jì)成果轉(zhuǎn)化,對(duì)IC設(shè)計(jì)人才的培訓(xùn),及新產(chǎn)品的開(kāi)發(fā)研制均有相當(dāng)?shù)拇龠M(jìn)作用。隨著制造工藝水平的提高,在生產(chǎn)線(xiàn)上制造芯片
2011-12-01 14:01:36
是什么推動(dòng)著高精度模擬芯片設(shè)計(jì)?如何利用專(zhuān)用晶圓加工工藝實(shí)現(xiàn)高性能模擬IC?
2021-04-07 06:38:35
在半導(dǎo)體晶圓的加工工藝中,對(duì)晶圓邊緣磨削是非常重要的一環(huán)。晶錠材料被切割成晶圓后會(huì)形成銳利邊緣,有棱角、毛刺、崩邊,甚至有小的裂縫或其它缺陷,邊緣的表面也比較粗糙。而晶圓的構(gòu)成材料如Si、Ge
2019-09-17 16:41:44
怎么選擇晶圓級(jí)CSP裝配工藝的錫膏?
2021-04-25 08:48:29
招聘6/8吋晶圓測(cè)試工藝工程師/主管1名工作地點(diǎn):無(wú)錫工資:面議要求:1. 工藝工程師:晶圓測(cè)試經(jīng)驗(yàn)3年以上,工藝主管:晶圓測(cè)試經(jīng)驗(yàn)5年以上;2. 精通分立器件類(lèi)產(chǎn)品晶圓測(cè)試,熟悉IC晶圓測(cè)試尤佳
2017-04-26 15:07:57
時(shí)鐘設(shè)備設(shè)計(jì)使用 I2C 可編程小數(shù)鎖相環(huán) (PLL),可滿(mǎn)足高性能時(shí)序需求,這樣可以產(chǎn)生零 PPM(百萬(wàn)分之一)合成誤差的頻率。高性能時(shí)鐘 IC 具有多個(gè)時(shí)鐘輸出,用于驅(qū)動(dòng)打印機(jī)、掃描儀和路由器等
2019-08-12 06:50:43
求晶圓劃片或晶圓分撿裝盒合作加工廠(chǎng)聯(lián)系方式:QQ:2691003439
2019-03-13 22:23:17
激光用于晶圓劃片的技術(shù)與工藝 激光加工為無(wú)接觸加工,激光能量通過(guò)聚焦后獲得高能量密度,直接將硅片
2010-01-13 17:01:57
`什么是硅晶圓呢,硅晶圓就是指硅半導(dǎo)體積體電路制作所用的硅晶片。晶圓是制造IC的基本原料。硅晶圓和晶圓有區(qū)別嗎?其實(shí)二者是一個(gè)概念。集成電路(IC)是指在一半導(dǎo)體基板上,利用氧化、蝕刻、擴(kuò)散等方法
2011-12-02 14:30:44
的兩維直線(xiàn)電機(jī)工作臺(tái)及直驅(qū)旋轉(zhuǎn)平臺(tái),專(zhuān)用 CCD監(jiān)視定位。采用紅外激光作為光源切割硅晶圓,具有最佳的切割性?xún)r(jià)比,切割速度達(dá)到160mm/s,無(wú)機(jī)械應(yīng)力作用,晶粒切割成品率高,切割后二極管芯片電學(xué)性能
2010-01-13 17:18:57
刻劃LED刻劃線(xiàn)條較傳統(tǒng)的機(jī)械刻劃窄得多,所以使得材料利用率顯著提高,因此提高產(chǎn)出效率。另外激光加工是非接觸式工藝,刻劃帶來(lái)晶圓微裂紋以及其他損傷更小,這就使得晶圓顆粒之間更緊密,產(chǎn)出效率高、產(chǎn)能高
2011-12-01 11:48:46
金屬材料的工藝性能和切削加工性能的介紹:http://www.gooxian.com/ 1.金屬材料的工藝性能 (1)鑄造性能鑄造性是指澆注鑄件時(shí),材料能充滿(mǎn)比較復(fù)雜的鑄型并獲得優(yōu)質(zhì)鑄件的能力
2017-08-25 09:36:21
` 集成電路按生產(chǎn)過(guò)程分類(lèi)可歸納為前道測(cè)試和后到測(cè)試;集成電路測(cè)試技術(shù)員必須了解并熟悉測(cè)試對(duì)象—硅晶圓。測(cè)試技術(shù)員應(yīng)該了解硅片的幾何尺寸形狀、加工工藝流程、主要質(zhì)量指標(biāo)和基本檢測(cè)方法;集成電路晶圓測(cè)試基礎(chǔ)教程ppt[hide][/hide]`
2011-12-02 10:20:54
什么是晶圓
晶圓是制造IC的基本原料
集成電路(IC)是指在一半導(dǎo)體基板上,利用氧化、蝕刻、擴(kuò)散等方法,將眾多電子電路組成
2009-06-30 10:19:34 9347
9347 Spartan EFEM系統(tǒng)可每小時(shí)加工450張晶圓
Crossing Automation公司 (www.crossinginc.com)宣布,已經(jīng)提高公司的Spartan設(shè)備前端模塊(EFEM)的性能,將其每小時(shí)的加工能力提高至450張晶
2010-03-31 09:50:52 1816
1816 什么是硅晶圓呢,硅晶圓就是指硅半導(dǎo)體積體電路制作所用的硅晶片。晶圓是制造IC的基本原料。
2011-08-07 16:29:09 11781
11781 2013年9月3日——領(lǐng)先的高性能模擬IC和傳感器解決方案供應(yīng)商奧地利微電子公司(SIX股票代碼:AMS)今日宣布投資逾2,500萬(wàn)歐元在其位于奧地利格拉茨附近的晶圓制造工廠(chǎng),用以建立3D IC專(zhuān)用的生產(chǎn)線(xiàn)。
2013-09-03 14:55:34 1433
1433 全球領(lǐng)先的高性能模擬IC和傳感器供應(yīng)商艾邁斯半導(dǎo)體(ams AG,SIX股票代碼:AMS)晶圓代工事業(yè)部今日公布其快速、低成本的集成電路原型服務(wù),該服務(wù)被稱(chēng)為多項(xiàng)目晶圓(MPW)或往復(fù)運(yùn)行
2015-11-11 17:02:40 1178
1178 晶圓是微電子產(chǎn)業(yè)的行業(yè)術(shù)語(yǔ)之一。
2017-12-07 15:41:11 41078
41078 晶圓制造總的工藝流程 芯片的制造過(guò)程可概分為晶圓處理工序(Wafer Fabrication)、晶圓針測(cè)工序(Wafer Probe)、構(gòu)裝工序(Packaging)、測(cè)試工序(Initial Test and Final Test)等幾個(gè)步驟。
2018-04-16 11:27:00 15246
15246 本文主要介紹了晶圓的結(jié)構(gòu),其次介紹了晶圓切割工藝,最后介紹了晶圓的制造過(guò)程。
2019-05-09 11:15:54 12823
12823 
IMT日前正式宣布:公司現(xiàn)已可提供8英寸(200mm)晶圓微電子機(jī)械系統(tǒng)(MEMS)工藝加工服務(wù),同時(shí)公司還可以為MEMS行業(yè)發(fā)展提供空前豐富的其他資源組合。8英寸晶圓改變了MEMS器件制造的經(jīng)濟(jì)指標(biāo),每張晶圓可以產(chǎn)出大約為6英寸晶圓兩倍數(shù)量的器件。
2019-06-13 14:32:53 3964
3964 晶圓是指硅半導(dǎo)體集成電路制作所用的硅晶片,由于其形狀為圓形,故稱(chēng)為晶圓;在硅晶片上可加工制作成各種電路元件結(jié)構(gòu),而成為有特定電性功能的集成電路產(chǎn)品。
2019-06-24 14:27:04 27809
27809 特種工藝技術(shù)包括高精度模擬CMOS、射頻CMOS、嵌入式存儲(chǔ)器CMOS、CIS、高壓CMOS、 BiCMOS和BCDMOS。這些特種技術(shù)對(duì)晶圓代工廠(chǎng)的工藝參數(shù)有較為嚴(yán)格的容差限制,常用的DC-DC轉(zhuǎn)換器、馬達(dá)驅(qū)動(dòng)器、電池充電器IC一般都使用8英寸晶圓生產(chǎn)。
2019-08-30 16:57:39 8128
8128 
晶圓的制造在半導(dǎo)體領(lǐng)域,科技含量相當(dāng)?shù)母撸夹g(shù)工藝要求非常高。而我們國(guó)半導(dǎo)體事業(yè)起步較晚,在晶圓的制造上還處于建設(shè)發(fā)展階段。現(xiàn)在我國(guó)主要做的是晶圓的封測(cè)。我國(guó)的晶圓封測(cè)規(guī)模和市場(chǎng)都是全球首屈一指的,約占全球約1/4。
2019-08-12 14:13:00 48167
48167 根據(jù)臺(tái)積電在第二十四屆年度技術(shù)研討會(huì)中的說(shuō)明,SoIC是一種創(chuàng)新的多芯片堆疊技術(shù),是一種晶圓對(duì)晶圓(Wafer-on-wafer)的鍵合(Bonding)技術(shù),這是一種3D IC制程技術(shù),可以讓臺(tái)積電具備直接為客戶(hù)生產(chǎn)3D IC的能力。
2019-08-14 11:21:06 4993
4993 
隨著模擬IC市場(chǎng)規(guī)模持續(xù)增長(zhǎng),模擬IC龍頭廠(chǎng)商德州儀器(TI)已計(jì)劃在美國(guó)德州Richardson地區(qū)投資32億美元新建工廠(chǎng),主要用于生產(chǎn)模擬IC的12英寸晶圓設(shè)施。
2019-11-28 15:05:36 1608
1608 晶圓切割(即劃片)是芯片制造工藝流程中一道不可或缺的工序,在晶圓制造中屬于后道工序。晶圓切割就是將做好芯片的整片晶圓按芯片大小分割成單一的芯片(晶粒)。最早的晶圓是用切片系統(tǒng)進(jìn)行切割(劃片)的,這種方法以往占據(jù)了世界芯片切割市場(chǎng)的較大份額,特別是在非集成電路晶圓切割領(lǐng)域
2020-12-24 12:38:37 20276
20276 晶圓在現(xiàn)實(shí)生活中具有重要應(yīng)用,缺少晶圓,我們的手機(jī)、電腦等將無(wú)法制成。而且,高質(zhì)量晶圓必將為我們制造的產(chǎn)品帶來(lái)更高的性能。為增進(jìn)大家對(duì)晶圓的了解,本文將對(duì)晶圓級(jí)CSP的返修工藝予以介紹。如果你對(duì)晶圓,抑或是晶圓相關(guān)內(nèi)容具有興趣,不妨繼續(xù)往下閱讀哦。
2021-02-11 17:38:00 2678
2678 晶圓是指制作硅半導(dǎo)體電路所用的硅晶片,其原始材料是硅。高純度的多晶硅溶解后摻入硅晶體晶種,然后慢慢拉出,形成圓柱形的單晶硅。硅晶棒在經(jīng)過(guò)研磨,拋光,切片后,形成硅晶圓片,也就是晶圓。晶圓的主要加工
2023-02-22 14:46:16 4
4 。 主要特點(diǎn) 化學(xué)品和晶圓消耗量低 占地面積小 3、層堆疊 4、通過(guò)優(yōu)化的機(jī)器人和過(guò)程校準(zhǔn)實(shí)現(xiàn)最佳性能 5、更高的安全標(biāo)準(zhǔn) 6、改進(jìn)的最小晶圓接觸 7、改進(jìn)的化學(xué)控制穩(wěn)定性 8、改進(jìn)的排氣壓力控制穩(wěn)定性 9、通過(guò)伺服電機(jī)改進(jìn)杯層控制 10、易于維護(hù) 11、晶圓尺寸
2023-06-07 17:12:42 806
806 加工能力一定程度上決定了芯片封裝的成品率與性能。IC晶圓,一般由硅(Si)構(gòu)成,分為6英寸、8英寸、12英寸規(guī)格不等,晶片就是基于wafer制造而成。IC需要將Waf
2022-05-12 14:50:50 2311
2311 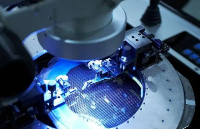
質(zhì)變化。劃片機(jī)制(TheDicingMechanism)硅晶圓劃片工藝是“后端”封裝制程工藝中的第一步。該工藝將晶圓分成獨(dú)立帶有電氣性能的芯片,用于隨后的芯片粘合(d
2021-11-25 17:29:51 3607
3607 
一、晶圓加工所有半導(dǎo)體工藝都始于一粒沙子!因?yàn)樯匙铀墓枋巧a(chǎn)晶圓所需要的原材料。晶圓是將硅(Si)或砷化鎵(GaAs)制成的單晶柱體切割形成的圓薄片。要提取高純度的硅材料需要用到硅砂,一種
2022-07-08 11:07:48 15325
15325 
晶圓經(jīng)過(guò)前道工序后芯片制備完成,還需要經(jīng)過(guò)切割使晶圓上的芯片分離下來(lái),最后進(jìn)行封裝。不同厚度晶圓選擇的晶圓切割工藝也不同:厚度100um以上的晶圓一般使用刀片切割;厚度不到100um的晶圓一般
2022-10-08 16:02:44 16401
16401 
晶圓切割是半導(dǎo)體制造中的關(guān)鍵環(huán)節(jié)之一。提升晶圓工藝制程需要綜合考慮多個(gè)方面,包括切割效率、切割質(zhì)量、設(shè)備性能等。針對(duì)這些問(wèn)題,國(guó)產(chǎn)半導(dǎo)體劃片機(jī)解決方案可以提供一些幫助。首先,在切割效率方面,國(guó)產(chǎn)
2023-06-05 15:30:44 20196
20196 
半導(dǎo)體制造設(shè)備廠(chǎng)商DISCO Corporation(總部:東京都大田區(qū);總裁:Kazuma Sekiya)采用了KABRA(一種使用激光加工的晶錠切片方法),并開(kāi)發(fā)了一種針對(duì)GaN(氮化鎵)晶圓生產(chǎn)而優(yōu)化的工藝。通過(guò)該工藝,可以同時(shí)提高GaN晶圓片產(chǎn)量,并縮短生產(chǎn)時(shí)間。
2023-08-25 09:43:52 1777
1777 
晶圓級(jí)封裝是指晶圓切割前的工藝。晶圓級(jí)封裝分為扇入型晶圓級(jí)芯片封裝(Fan-In WLCSP)和扇出型晶圓級(jí)芯片封裝(Fan-Out WLCSP),其特點(diǎn)是在整個(gè)封裝過(guò)程中,晶圓始終保持完整。
2023-10-18 09:31:05 4921
4921 
隨著半導(dǎo)體產(chǎn)業(yè)的飛速發(fā)展,晶圓鍵合設(shè)備及工藝在微電子制造領(lǐng)域扮演著越來(lái)越重要的角色。晶圓鍵合技術(shù)是一種將兩個(gè)或多個(gè)晶圓通過(guò)特定的工藝方法緊密地結(jié)合在一起的技術(shù),以實(shí)現(xiàn)更高性能、更小型化的電子元器件。本文將詳細(xì)介紹晶圓鍵合設(shè)備的結(jié)構(gòu)、工作原理以及晶圓鍵合工藝的流程、特點(diǎn)和應(yīng)用。
2023-12-27 10:56:38 3181
3181 
在本章當(dāng)中,我們將為大家介紹硅片制造中使用的四種基本工藝,這四種基本工藝常用于在晶圓片表面上加工集成電路(IC)的電子元件。
2024-01-15 09:33:51 1925
1925 
的容量和功能。在過(guò)去的幾十年中,基于薄晶圓 ( 通常厚度小于 100 μm) 的硅穿孔(Through-Silicon Via,TSV) 技術(shù)已經(jīng)實(shí)現(xiàn)了 3D-IC 封裝。但是由于薄晶圓的易碎性和易翹曲的傾向,在對(duì)器件晶圓進(jìn)行背部加工過(guò)程中,需要利用膠粘劑將其固定在載體上,并使薄晶圓在背部
2024-03-29 08:37:59 2196
2196 FRAM SF25C20晶圓合封MCU,滿(mǎn)足小尺寸和高性能需求
2024-04-22 09:49:21 1574
1574 
。而硅晶圓是傳統(tǒng)的半導(dǎo)體材料,具有成熟的制造工藝和廣泛的應(yīng)用領(lǐng)域。 制造工藝: 碳化硅晶圓的制造工藝相對(duì)復(fù)雜,需要高溫、高壓和長(zhǎng)時(shí)間的生長(zhǎng)過(guò)程。而硅晶圓的制造工藝相對(duì)成熟,可以實(shí)現(xiàn)大規(guī)模生產(chǎn)。此外,碳化硅晶圓的生長(zhǎng)速度
2024-08-08 10:13:17 4710
4710 在本系列第七篇文章中,介紹了晶圓級(jí)封裝的基本流程。本篇文章將側(cè)重介紹不同晶圓級(jí)封裝方法所涉及的各項(xiàng)工藝。晶圓級(jí)封裝可分為扇入型晶圓級(jí)芯片封裝(Fan-In WLCSP)、扇出型晶圓級(jí)芯片封裝
2024-08-21 15:10:38 4450
4450 
本文從硅片制備流程為切入點(diǎn),以方便了解和選擇合適的硅晶圓,硅晶圓的制備工藝流程比較復(fù)雜,加工工序多而長(zhǎng),所以必須嚴(yán)格控制每道工序的加工質(zhì)量,才能獲得滿(mǎn)足工藝技術(shù)要求、質(zhì)量合格的硅單晶片(晶圓),否則就會(huì)對(duì)器件的性能產(chǎn)生顯著影響。
2024-10-21 15:22:27 1991
1991 在半導(dǎo)體行業(yè),晶圓的制造、設(shè)計(jì)、加工、封裝等近千道工藝環(huán)節(jié)中,溫度始終貫穿其中。溫度的精密監(jiān)測(cè)對(duì)于確保晶圓的質(zhì)量和最終產(chǎn)品的性能至關(guān)重要。微小的溫度波動(dòng)可能對(duì)電路的穩(wěn)定性、可靠性以及功能性產(chǎn)生重大影響,因此,晶圓溫度的精準(zhǔn)測(cè)量已經(jīng)成為關(guān)鍵的技術(shù)需求。
2024-12-04 15:57:08 1024
1024 
改善晶圓出刀TTV(Total Thickness Variation,總厚度變化量)異常的加工方法主要包括以下幾種:
一、設(shè)備調(diào)整與優(yōu)化
主軸與承片臺(tái)角度調(diào)整
通過(guò)設(shè)備自動(dòng)控制,進(jìn)行工藝角度調(diào)整
2024-12-05 16:51:26 595
595 
一、概述
晶圓背面涂敷工藝是在晶圓背面涂覆一層特定的材料,以滿(mǎn)足封裝過(guò)程中的各種需求。這種工藝不僅可以提高芯片的機(jī)械強(qiáng)度,還可以?xún)?yōu)化散熱性能,確保芯片的穩(wěn)定性和可靠性。
二、材料選擇
晶圓背面涂敷
2024-12-19 09:54:10 620
620 
指的是由于晶圓邊緣的處理不同于中心區(qū)域,導(dǎo)致的電學(xué)和物理性能的差異。晶圓邊緣由于距離加工工具較遠(yuǎn)或光刻曝光時(shí)的處理不均,可能會(huì)出現(xiàn)性能不穩(wěn)定的情況。比如,金屬層和通孔的連接可能不良,或者材料沉積不均,導(dǎo)致邊緣區(qū)域的芯
2024-12-31 11:24:25 2163
2163 
8寸晶圓的清洗工藝是半導(dǎo)體制造過(guò)程中至關(guān)重要的環(huán)節(jié),它直接關(guān)系到芯片的良率和性能。那么直接揭曉關(guān)于8寸晶圓的清洗工藝介紹吧! 顆粒去除清洗 目的與方法:此步驟旨在去除晶圓表面的微小顆粒物,這些顆粒
2025-01-07 16:12:00 813
813 實(shí)現(xiàn)芯片與外部電路電氣連接的關(guān)鍵結(jié)構(gòu)。本文將深入解析晶圓級(jí)封裝Bump工藝的關(guān)鍵點(diǎn),探討其技術(shù)原理、工藝流程、關(guān)鍵參數(shù)以及面臨的挑戰(zhàn)和解決方案。
2025-03-04 10:52:57 4980
4980 
圓;TTV;磨片加工;研磨;拋光 一、引言 在半導(dǎo)體制造領(lǐng)域,晶圓的總厚度偏差(TTV)對(duì)芯片性能、良品率有著直接影響。高精度的 TTV 控制是實(shí)現(xiàn)高性能芯片制造的關(guān)鍵前提。隨著半導(dǎo)體技術(shù)不斷向更高精度發(fā)展,傳統(tǒng)磨片加工方法在 TTV 控制上
2025-05-20 17:51:39 1029
1029 
一、引言
在半導(dǎo)體制造領(lǐng)域,晶圓總厚度變化(TTV)是衡量晶圓質(zhì)量的關(guān)鍵指標(biāo)之一,直接影響芯片制造的良品率與性能。傳統(tǒng)切割工藝在加工過(guò)程中,易因單次切割深度過(guò)大引發(fā)應(yīng)力集中、振動(dòng)等問(wèn)題,導(dǎo)致晶圓
2025-07-11 09:59:15 472
472 
一、引言
在半導(dǎo)體晶圓制造領(lǐng)域,晶圓總厚度變化(TTV)是衡量晶圓質(zhì)量的關(guān)鍵指標(biāo),直接影響芯片制造的良品率與性能。淺切多道工藝通過(guò)分層切削降低單次切削力,有效改善晶圓切割質(zhì)量,但該工藝過(guò)程中
2025-07-12 10:01:07 437
437 
晶圓清洗機(jī)中的晶圓夾持是確保晶圓在清洗過(guò)程中保持穩(wěn)定、避免污染或損傷的關(guān)鍵環(huán)節(jié)。以下是晶圓夾持的設(shè)計(jì)原理、技術(shù)要點(diǎn)及實(shí)現(xiàn)方式: 1. 夾持方式分類(lèi) 根據(jù)晶圓尺寸(如2英寸到12英寸)和工藝需求,夾持
2025-07-23 14:25:43 931
931 晶圓清洗工藝是半導(dǎo)體制造中的關(guān)鍵步驟,用于去除晶圓表面的污染物(如顆粒、有機(jī)物、金屬離子和氧化物),確保后續(xù)工藝(如光刻、沉積、刻蝕)的良率和器件性能。根據(jù)清洗介質(zhì)、工藝原理和設(shè)備類(lèi)型的不同,晶圓
2025-07-23 14:32:16 1370
1370 
摘要:本文聚焦切割液多性能協(xié)同優(yōu)化對(duì)晶圓 TTV 厚度均勻性的影響。深入剖析切割液冷卻、潤(rùn)滑、排屑等性能影響晶圓 TTV 的內(nèi)在機(jī)制,探索實(shí)現(xiàn)多性能協(xié)同優(yōu)化的參數(shù)設(shè)計(jì)方法,為提升晶圓切割質(zhì)量、保障
2025-07-24 10:23:09 500
500 
切割工藝參數(shù)以實(shí)現(xiàn)晶圓 TTV 均勻性有效控制,為晶圓切割工藝改進(jìn)提供新的思路與方法。
一、引言
在半導(dǎo)體晶圓切割工藝中,晶圓 TTV 均勻性是影響芯片制造質(zhì)量與良
2025-07-25 10:12:24 420
420 
退火工藝是晶圓制造中的關(guān)鍵步驟,通過(guò)控制加熱和冷卻過(guò)程,退火能夠緩解應(yīng)力、修復(fù)晶格缺陷、激活摻雜原子,并改善材料的電學(xué)和機(jī)械性質(zhì)。這些改進(jìn)對(duì)于確保晶圓在后續(xù)加工和最終應(yīng)用中的性能和可靠性至關(guān)重要。退火工藝在晶圓制造過(guò)程中扮演著至關(guān)重要的角色。
2025-08-01 09:35:23 2030
2030 
在晶圓表面。這些殘留的顆粒會(huì)影響后續(xù)的加工步驟。例如,在進(jìn)行薄膜沉積時(shí),殘留顆粒可能會(huì)導(dǎo)致薄膜附著不良或產(chǎn)生缺陷,影響芯片的性能和可靠性。化學(xué)物質(zhì)殘留:去膠過(guò)程中
2025-12-16 11:22:10 111
111 




 電子發(fā)燒友App
電子發(fā)燒友App





















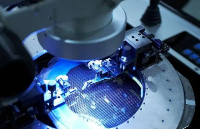






















評(píng)論