文章來源:學習那些事
原文作者:前路漫漫
本文介紹了從晶棒到晶圓的加工全流程。
晶棒需要經過一系列加工,才能形成符合半導體制造要求的硅襯底,即晶圓。加工的基本流程為:滾磨、切斷、切片、硅片退火、倒角、研磨、拋光,以及清洗與包裝等。
滾磨
滾磨工藝是利用金剛石磨輪對硅單晶棒的外徑進行磨削,使其達到目標直徑,并加工出平邊參考面或定位槽的加工過程。單晶爐制備的單晶棒外徑表面粗糙不平,且直徑大于最終應用的硅片直徑,通過外徑滾磨可獲得符合要求的棒料直徑。
滾磨機具備磨削硅單晶棒平邊參考面或定位槽的功能,即對磨削至目標直徑的單晶棒進行定向測試后,在同一設備上加工出平邊參考面或定位槽。通常,直徑 200mm 以下的單晶棒采用平邊參考面,直徑 200mm 及以上的則采用定位槽,不過直徑 200mm 的單晶棒也可根據需求制作平邊參考面。單晶棒定向參考面的作用包括:滿足集成電路制造中工藝設備自動化定位操作需求;標識硅片的晶向和導電類型等信息,便于生產管理;主定位邊或定位槽垂直于 <110> 方向,在芯片封裝的劃片工藝中可使晶片自然解理,同時定位功能可防止碎片產生。
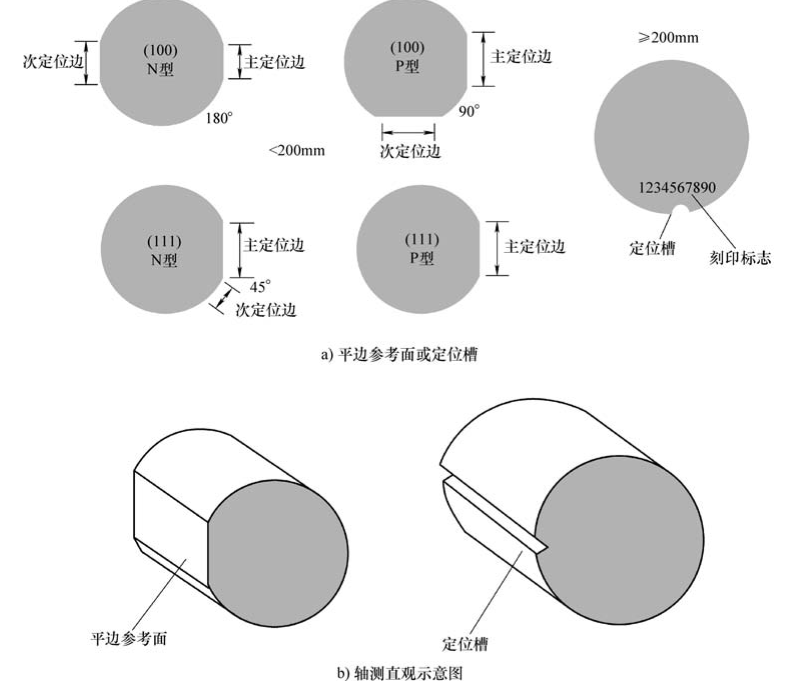
滾磨機的工作原理為:將單晶棒夾持在工作臺兩端的頂尖之間,頂尖旋轉帶動單晶棒轉動,磨頭上的金剛石磨輪(一般為杯形砂輪或圓柱砂輪)高速旋轉并相對單晶棒外徑橫向進給,單晶棒或磨輪做縱向往返運動完成磨削。
滾磨機的晶向定向裝置多為集成的 X 射線定向裝置,其工作方式如下:定向裝置對單晶棒外圓柱面進行測試,單晶棒分度旋轉,找到所需晶向參考面后停止旋轉;磨輪橫向進給一定磨削量,隨后單晶棒或磨輪做縱向往返運動,沿單晶棒晶軸方向在圓柱面上加工出所需參考面。對于直徑 150mm 以下的單晶棒,磨削平邊參考面可使用滾磨外圓的砂輪;對于直徑 200mm 以上的單晶棒,磨削定位槽則需使用設備上的另一種成型砂輪(通常為 “V” 形砂輪),沿晶軸方向在外圓圓柱面上磨削出定位槽。

滾磨機分為砂輪縱向移動型和工作臺縱向移動型兩種。隨著硅單晶棒直徑增大、長度加長,以及晶向定向裝置和定位槽磨削輔助砂輪的集成需求,目前主流滾磨機采用工作臺縱向移動方式。
切斷
晶錠切斷是指根據不同目的和需求,按特定角度或方向對硅單晶錠進行切割或截斷的過程。其主要目的包括:切除整根單晶硅棒的頭部(含籽晶和放肩部分)、尾部及直徑不符合規格的部分;將單晶硅切成特定長度的晶棒,以便切片機進行切片;切取樣片用于檢測電阻率、氧和碳含量、晶體缺陷等質量參數。
早期加工直徑 150mm 及以下的單晶硅時,晶錠切斷多采用外圓切割與內圓切割技術。隨著 IC 工藝技術發展,單晶硅直徑不斷增大,受刀片直徑和機械強度限制,外圓切割與內圓切割逐漸被帶鋸切割技術替代。在直徑 200mm 和 300mm 的單晶硅及拋光片生產中,先進的帶鋸切割技術及相應設備已被廣泛應用于晶錠切斷。

切片
硅片切片是將硅單晶棒切成具有精確幾何尺寸和目標厚度的薄硅片的加工工藝。20 世紀 90 年代前的切片機采用內圓刀具對硅單晶棒進行單片切割,稱為內圓切片機。其工作原理為:內圓切割刀片是厚度僅 0.12~0.15mm 的不銹鋼圓環,內環涂覆鍍金剛石的磨料,以固結磨料形式形成內圓刃口;刀片外端通過切片機上下刀盤夾持張緊,形成具有一定剛度的刀片,隨刀盤高速旋轉。單晶棒料黏結在裝夾頭上并安裝于送料裝置,送料裝置按預定厚度相對刀片分度運動一個切割距離(z 向進給)后,內圓切割刀片相對單晶棒料向下端方向(y 向)運動完成切割,切割后刀片退回初始位置。
內圓切割刀具的刃口采用金剛石磨料涂鍍層,厚度為 0.29~0.35mm,在切割硅片時,切口處的材料損耗量較高。同時,隨著硅片直徑增大,內圓切割后的硅片在厚度偏差、彎曲度、翹曲度及表面損傷層等方面的變化更為顯著,這無疑增加了硅片后續加工的難度與成本。20 世紀 90 年代后問世的多線切割機,現已成為硅片切割的主流設備。
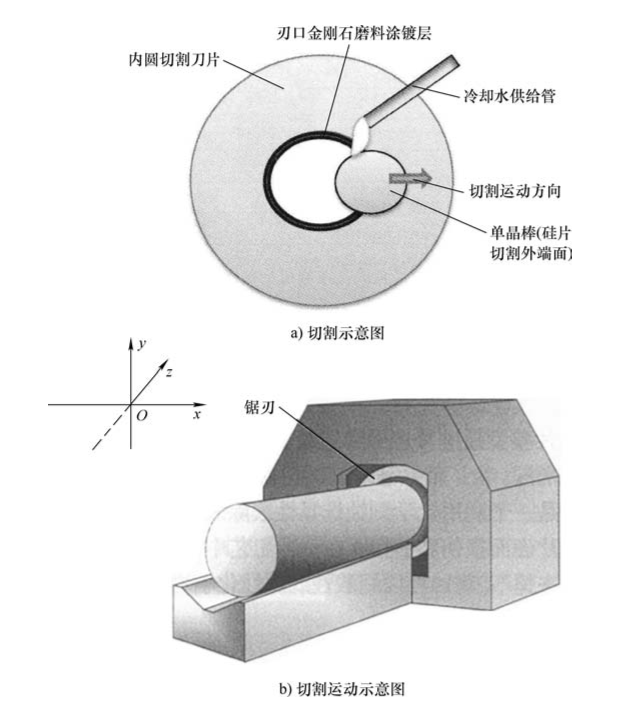
多線切割機中,最早投入應用的是基于游離磨料加工原理的游離磨料多線切割機,其工作原理如下:所用切割鋼線(直徑約 0.12mm)按固定間距均勻纏繞在軸輥(主軸輥數量為 2~4 個)上,形成切割線網框。網框的切割邊呈水平狀態,隨軸輥高速旋轉做纏繞運動;單晶棒沿長度方向水平黏結在進給裝置上,相對網框切割邊做低速進給運動。高速運動的鋼線與單晶棒料產生摩擦,同時 SiC 等磨料砂漿被澆注到摩擦區域,鋼線裹挾著 SiC 磨料對材料進行細微切割,直至形成一組預設厚度的硅片。
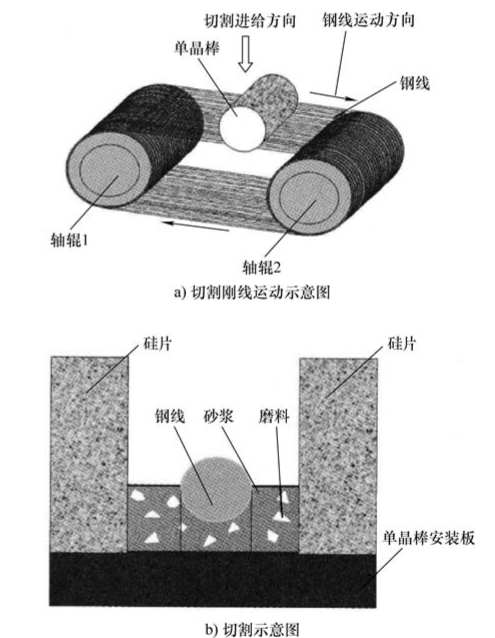
由于游離磨料多線切割機使用 SiC 磨料砂漿,工作環境較為惡劣,因此鋼線切割區需封閉處理。21 世紀初,出現了鍍覆金剛石磨料的鋼線,用其替代普通鋼線進行切割的設備稱為固結磨料多線切割機(或金剛石多線切割機),使技術回歸到固結磨料應用時代。在金剛石多線切割工藝中,以去離子水為主要成分的冷卻液對切割區域進行冷卻,大幅改善了工作環境。此類設備具有工作環境好、污染小、加工效率高等優勢,成為硅片切割設備的主要發展方向。
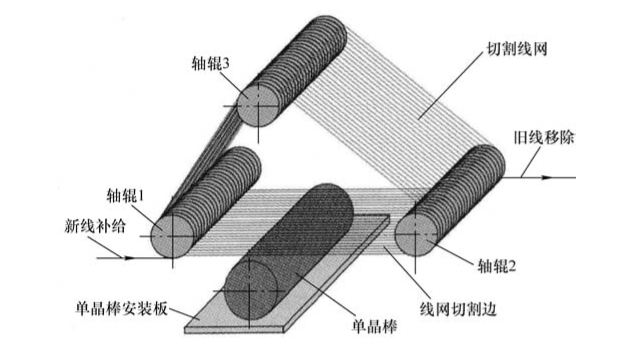
硅片退火
在多晶硅和直拉單晶硅的制造過程中,單晶硅中會含有氧元素。在特定溫度下,單晶硅中的氧會釋放電子,轉化為氧施主,這些電子會與硅片中的雜質結合,進而影響硅片的電阻率。退火爐是在氫氣或氬氣氛圍中,將爐內溫度升至 1000~1200℃,經保溫、降溫過程,使拋光硅片表層的氧揮發脫除,促使氧沉淀分層,溶解表層微缺陷,減少表層附近雜質與缺陷,最終在硅片表層形成相對潔凈區域的工藝設備。因爐管工作溫度較高,退火爐也被稱為高溫爐;行業內通常將硅片退火工藝稱為吸雜。

水平式退火爐的工作原理為:反應室是由熔融石英管、石英舟及溫度 / 氣壓控制系統構成的密封區域,可通入氫氣或氬氣,通過加熱器(一般為高頻感應加熱或鹵素燈管加熱)使反應室內達到所需溫度與壓力。硅片在反應室內經過一定時間的保溫,完成退火處理。
硅片退火爐主要分為水平式、立式及快速退火爐三種類型。水平式與立式退火爐的核心區別在于反應室的布局方向:水平式退火爐的反應室呈水平結構,可同時裝入一批硅片進行退火,通常退火時間為 20~30 分鐘,但反應室需較長加熱時間才能達到工藝所需溫度。其中,水平式退火爐反應室中熔融石英管長度方向的溫度控制是設備研發的關鍵技術點之一。
立式退火爐同樣采用批量處理方式,將多片硅片同時放入反應室進行退火。其反應室呈垂直排布,硅片以水平狀態放置在石英舟內,且石英舟可在反應室內整體旋轉,這一設計使反應室溫度分布更為均勻,硅片受熱一致性更佳,具備優異的退火均勻性,但立式退火爐的工藝成本高于水平式退火爐。快速退火爐則利用鹵鎢燈直接加熱硅片,可實現 1~250℃/s 的大范圍快速升降溫,速率遠高于傳統退火爐,僅需數秒就能將反應室溫度升至 1100℃以上。
倒角
倒角加工是指磨削掉晶圓邊緣的銳利棱角,其主要目的包括:防止晶圓邊緣碎裂、避免熱應力導致的損傷、提升外延層及光刻膠在晶圓邊緣的平坦度。倒角機是采用成型磨輪,將切割后的薄硅片邊緣加工成特定 R 形或 T 形輪廓,以防止硅片在后續加工中邊緣破損的工藝設備。
倒角機的工作原理如下:硅片通過真空吸附固定在主軸吸盤上,與主軸旋轉中心對準并高速轉動;磨輪主軸端部安裝成型倒角輪,硅片在 z 向電機驅動下與磨輪設定槽中心對準;磨輪隨主軸高速旋轉并橫向接觸硅片邊緣,x、y 向電機做插補驅動,使磨輪按硅片邊緣及參考面輪廓橫向進給至設定距離后停止,再反向退出,完成硅片邊緣的成型倒角。倒角磨削過程分為粗磨和精磨兩個階段。

研磨
研磨是通過機械研磨手段,去除硅片表面因切割產生的鋸痕,減小表面損傷層深度,從而有效改善硅片平坦度與表面粗糙度的加工工藝。在硅片制造領域,普遍采用雙面研磨的加工方式。以直徑 200mm 及以下的硅片為例,其雙面研磨機結構具有特定設計。
雙面研磨時,待加工硅片被置于行星片的定位孔中,行星片位于上下磨盤之間,在中心齒輪驅動下同時圍繞磨盤中心公轉和自身自轉,帶動硅片隨磨盤做行星式運動。同時,向加工區域通入研磨漿料并對硅片施加壓力,借助上下磨盤的壓力與研磨漿料的摩擦作用,實現硅片雙面的研磨加工。
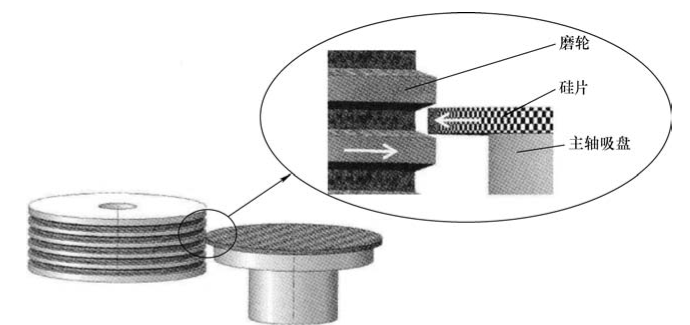
研磨盤通常采用鑄鐵材質,盤面設有垂直交錯的溝槽,槽寬 1~2mm、深約 10mm,便于研磨漿料均勻分布及碎屑排出。研磨漿料主要由磨砂(粒徑 5~10μm 的氧化鋁、氧化鋯微粉等)和液體(水、表面活性劑)組成。磨砂的硬度、粒徑及均勻性,液體對磨砂的懸浮性、分散性,以及液體的潤滑性和對設備的防銹能力,是衡量研磨漿料性能的重要指標。硅片雙面研磨的總去除厚度為 60~80μm,表面損傷層深度約為磨砂粒徑的 1.5 倍。
硅片研磨質量對后續拋光工藝的質量與整體效率有著直接影響,因此雙面研磨工藝通常采用粗研與精研相結合的方式提升研磨質量。粗研階段可選用顆粒尺寸較大的研磨漿料(磨料粒度約 15μm),配合較大的研磨壓力和較高的研磨轉速(通過調節上研磨盤、下研磨盤、內齒圈及中心輪的轉速實現),此時研磨去除率較高,加工后硅片表面粗糙度 Ra 可控制在 0.63μm 以下。精研階段則采用顆粒尺寸較小的研磨漿料(磨料粒度 3~5μm),搭配較低的研磨壓力和較慢的研磨轉速,研磨去除率較低,最終硅片表面粗糙度 Ra 能達到 0.16μm 以下。
拋光
拋光是通過化學與機械協同作用對硅片表面進行加工的工藝,旨在去除表面殘留的微缺陷與損傷層,獲得具有極高幾何精度和極低表面粗糙度的 “鏡面” 硅片,這類硅片被稱為硅拋光片。硅片拋光包含表面拋光與邊緣拋光:邊緣拋光的目的是降低加工過程中因碰撞導致碎片的概率,并減少顆粒附著。
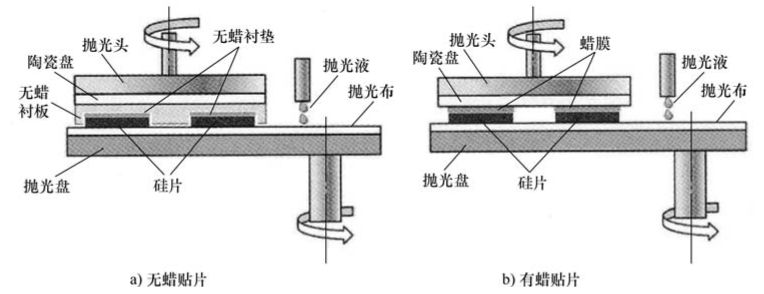
硅片拋光是一個化學與機械共同作用的過程。表面拋光前,需先通過液體黏附(有蠟貼片)或襯板與軟性襯墊真空吸附(無蠟貼片)的方式,將硅片固定在載體盤(陶瓷盤)上。拋光時,硅片被加壓于旋轉的拋光布上,同時通入拋光液。過程中,拋光液中的堿性成分與硅片表面發生化學反應,生成可溶性硅酸鹽;這些反應產物通過拋光液中 SiO?膠粒(粒徑 50~70nm)的負電荷吸附作用,以及與拋光布的機械摩擦作用被去除。化學腐蝕與機械摩擦交替循環,實現對硅片表面的連續化學機械拋光。
實際應用中,硅片拋光機分為多片單面拋光機和多片雙面拋光機兩類。硅片制造商根據下游需求,將直徑小于 200mm 的硅片分為單面拋光片和雙面拋光片:由于化學機械拋光效率較低且成本較高,直徑小于 200mm 的單面拋光片通常在研磨片基礎上僅對一個表面進行拋光,加工時采用多片單面拋光機,通過一個拋光臺上的多個拋光頭(承載器)同時作業,以提升效率、降低成本。

直徑 200mm 的雙面拋光片是市場需求較大的品類,一般采用多片雙面拋光機加工。這類設備在雙面研磨機基礎上,于上下拋光盤加裝拋光墊,并增加拋光液供給與回收裝置,可同時對多片硅片進行拋光;通過更換行星載具規格,還能適配 100~200mm 硅片的拋光需求。
為達到所需的拋光精度,硅片需經過兩步(粗拋光 - 精拋光)、三步(粗拋光 - 中拋光 - 精拋光)或四步(粗拋光 - 中拋光 - 精拋光 - 最終拋光)的分步拋光工藝,每步工藝的條件各不相同,其作用與去除厚度可參考相關參數表。影響拋光效果的工藝參數包括拋光壓力、拋光液的組分、粒度濃度及 pH 值、拋光布的材質、結構與硬度,以及拋光溫度和去除厚度等。
清洗與包裝
器件制造工藝對硅片表面潔凈度有嚴格要求,而硅片在加工過程中,表面會殘留有機物、金屬離子、微粒等污染物,硅片清洗的目的就是去除這些污染物,以獲得符合要求的潔凈表面。硅片表面的污染物主要分為三類:一是有機類污染物,主要來源于承載硅片的支架、環境中的有機蒸氣及加工過程中使用的化學試劑;二是金屬離子污染物,這類污染物要么吸附在硅片表面的氧化層上,要么通過與硅片表面的電荷交換(類似 “電鍍” 作用)直接鍵合在硅表面;三是顆粒污染物,主要產生于硅片加工環節及所用化學試劑中。
硅片加工過程包含多個清洗步驟,其中拋光后的清洗最為關鍵,直接決定硅片表面的最終潔凈度。硅拋光片的最終清洗通常采用多槽浸泡式化學清洗,即 RCA 清洗法,典型工藝參數可參考相關標準。
1.SC-1 溶液(1 號液)主要用于去除顆粒和有機污染物,同時可清除部分金屬雜質。其作用原理是:硅片表面先經 H?O?氧化形成氧化膜,隨即被 NH?OH 腐蝕,氧化與腐蝕過程循環進行,附著在硅片表面的顆粒會隨氧化膜的持續腐蝕而脫離,進入清洗液中;有機污染物在 H?O?的強氧化作用和 NH?OH 的溶解作用下,轉化為水溶性化合物進入清洗液,經去離子水沖洗后被去除。此外,SC-1 溶液的強氧化性可將 Cr、Cu、Zn、Ag、Ni、Fe、Ca、Mg 等金屬氧化為高價離子,這些離子再與堿反應生成可溶性絡合物,經去離子水沖洗去除。清洗時配合使用超聲波(可去除粒徑不小于 0.4μm 的顆粒)或兆聲波(可去除粒徑不大于 0.2μm 的顆粒),能進一步提升顆粒去除效果。
2.SC-2 溶液(2 號液)是由 H?O?和 HCl 組成的酸性溶液,具有強氧化性和絡合性,可去除堿金屬離子、Cu、Au 等殘留金屬,以及 Al (OH)?、Fe (OH)?、Mg (OH)?、Zn (OH)?等氫氧化物中的金屬離子。經 SC-2 溶液清洗后,硅片表面的 Si 原子多以 Si-O 鍵結合,形成自然氧化層,使表面呈現親水性。
早期硅片的脫水干燥多采用離心甩干技術,近年來在異丙醇(IPA)脫水干燥技術的基礎上,開發出多種基于馬蘭戈尼效應的脫水干燥技術,已廣泛應用于大直徑硅片的最終清洗。
為保證硅片表面質量、防止二次污染、便于儲存和運輸,清洗后的硅片需進行包裝。硅拋光片的包裝操作通常在 10 級乃至 1 級潔凈室中進行,具體步驟如下:首先將硅拋光片放入匹配尺寸的包裝盒內;接著將包裝盒裝入對應規格的塑料薄膜內層包裝袋,采用真空或充高純氮氣的方式密封袋口;最后將內層包裝袋放入具備防潮、防靜電功能的金屬 - 塑料復合膜外層包裝袋,真空密封后即可送入成品倉庫保存。
-
半導體
+關注
關注
339文章
31006瀏覽量
265493 -
晶圓
+關注
關注
53文章
5431瀏覽量
132499 -
工藝
+關注
關注
4文章
716瀏覽量
30372
原文標題:晶圓加工概述
文章出處:【微信號:bdtdsj,微信公眾號:中科院半導體所】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
晶片是用來干嘛的?圖解晶圓代工流程!
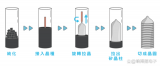



 一文詳解晶圓加工的基本流程
一文詳解晶圓加工的基本流程











評論