越來越多的封裝/ PCB系統設計需要熱分析。 功耗是封裝/ PCB系統設計中的一個關鍵問題,需要仔細考慮熱區域和電氣區域。 為了更好地理解熱分析,我們可以以固體中的熱傳導為例,并使用兩個域的對偶性
2018-04-17 18:54:05 11339
11339 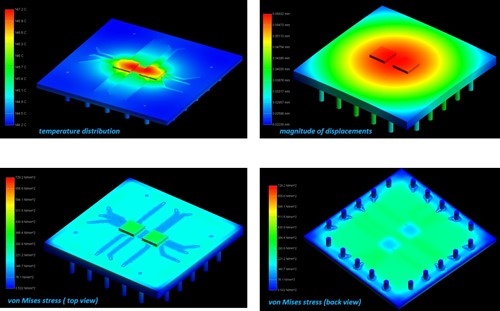
本算例中建立了包括1個機箱、1個PCB 板、1個雙熱阻封裝、1個軸流風扇、1個散熱器的簡單強迫對流換熱模型,目的在于雙熱阻封裝模塊的應用,便于熟悉雙熱阻封裝模塊的設置。穩態計算,不考慮輻射。軸流風扇固定流量為 2CFM,垂直出風。
2017-12-19 14:05:00 55079
55079 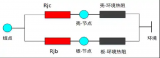
板(MCPCB)和雙層FR4基板上的結果與散熱器與實驗數據進行了比較。在比較討論之后,注意到用于具有散熱器的LED封裝的熱建模技術。結果非常令人印象深刻,表明該技術可用于LED系統級別。
2019-03-27 08:13:00 5740
5740 
在有限的封 裝空間內,如何把芯片的耗散熱及時高效的釋放到外界環境中以降低芯片結溫及器件內部各封裝材料的工作溫度,已成 為當前功率器件封裝設計階段需要考慮的重要問題之一。本文聚焦于功率器件封裝結構
2023-04-18 09:53:23 8419
8419 
本文要點要想準確預測集成電路封裝的結溫和熱阻,進而優化散熱性能,仿真的作用舉足輕重。準確的材料屬性、全面的邊界條件設置、真實的氣流建模、時域分析以及實證數據驗證是成功進行集成電路封裝熱仿真的關鍵。要
2024-05-18 08:12:46 2961
2961 
隨著半導體技術的不斷發展,芯片封裝技術也在持續進步。目前,2D封裝和3D封裝是兩種主流的封裝技術。這兩種封裝技術在散熱路徑和熱設計方面有著各自的特點和挑戰。本文將深入探討2D封裝和3D封裝的散熱路徑及熱設計考慮。
2024-07-25 09:46:28 2651
2651 
UCSP封裝的熱考慮因素有哪些?
2021-06-07 06:55:42
%的電能轉換成光,其余的全部變成了熱能,熱能的存在促使我們金鑒必須要關注LED封裝器件的熱阻。一般,LED的功率越高,LED熱效應越明顯,因熱效應而導致的問題也突顯出來,例如,芯片高溫的紅移現象;結溫
2015-07-29 16:05:13
MOS管瞬態熱阻測試(DVDS)失效品分析如何判斷是封裝原因還是芯片原因,有什么好的建議和思路
2024-03-12 11:46:57
封裝中流出的主要熱通道是通過器件下方的器件漏極片。因此,電路的拓撲結構對熱設計和相應的器件運行溫度有很大的影響。 本指南將考慮幾種不同的拓撲,并且相信這些拓撲將與大量典型的最終用戶應用場景相關
2023-04-20 16:49:55
5.1 介紹 在前一章中考慮了不同的PCB和器件配置對熱行為的影響。通過對多種情況的分析和比較,可以得出許多關于提供LFPAK MOSFETs散熱片冷卻的最佳方式的結論。 在第4章中考慮
2023-04-20 17:08:27
區域必須設置有導熱通孔。對內部一排引線和熱焊盤之間的容差是有要求的,以便通過導通孔來布設內排信號的線路。對容差量的要求取決于具體應用。在設計PCB印腳時必須考慮到這一點,由于封裝、PCB和板組裝諸多方面
2010-07-20 20:08:10
請教各位大蝦一個問題,SMA,SMAJ與SMB封裝除了尺寸不同之外,它們的熱阻有沒有什么區別?(例如SS14 SMAJ,SS14 SMA,SS14 SMB熱阻的區別)
2013-08-25 22:47:42
目錄—T3Ster的應用案例 ◇ 測量結殼熱阻◇ 封裝結構的質量檢查 △ 結構無損檢測△ 失效分析◇ 老化試驗表征手段◇ 利用T3Ster研究新型微通道散熱結構◇ 提供器件的熱學模型 ◇ 仿真模型
2013-01-08 15:29:44
`如下圖,為 48-PIN-LQFP 的PCB封裝 ;請教:1. pads中,想給 這個封裝加個 熱焊盤,怎么加 ?2. 添加過程是在 PCB decal editor環境下操作,還是 在PCB環境
2017-08-23 00:08:19
泛的額定電流和額定電壓、散熱及故障保護機制等。本文列出了工程師在為半導體器件評估封裝技術特性時需要考慮的關鍵因素。我們從最通常的疑惑開始:小型的封裝尺寸。 1. 更小的封裝尺寸現在,我們希望IC封裝能夠
2020-12-01 15:40:26
5.1 介紹 在前一章中考慮了不同的PCB和器件配置對熱行為的影響。通過對多種情況的分析和比較,可以得出許多關于提供LFPAK MOSFETs散熱片冷卻的最佳方式的結論。 在第4章中考慮
2023-04-21 15:19:53
我注意到VR熱限制引起的一些限制。VR熱限制警報由不同的軟件(ThrottleStop,HWiNFO64等)標記。我的問題:主板上的VRM或CPU封裝上的集成FIVR是否達到VR熱限制?提前致謝。以上
2018-10-30 11:26:32
什么是封裝?封裝時主要考慮的因素有哪些?具體的封裝形式有哪幾種?
2021-04-25 07:06:22
晶片級封裝(倒裝芯片和UCSP)代表一種獨特的封裝外形,不同于利用傳統的機械可靠性測試的封裝產品。封裝的可靠性主要與用戶的裝配方法、電路板材料以及其使用環境有關。用戶在考慮使用WLP型號之前,應認真
2018-08-27 15:45:31
上圖是OPA564規格書中的熱阻參數:
問題:
1)如果使用DWP封裝,按照參考的PCB銅皮散熱設計,是否總的熱阻就是為83W/°C(33+50);
2)如果使用DWD封裝,自己選用散熱片,是否總的熱阻= (散熱器熱阻+6.3)W/°C
2024-09-05 07:07:12
射頻(RF)放大器可采用引腳架構芯片級封裝(LFCSP)和法蘭封裝,通過成熟的回流焊工藝安裝在印刷電路板(PCB)上。PCB不僅充當器件之間的電氣互聯連接,還是放大器排熱的主要途徑(利用封裝底部
2021-01-13 06:22:54
基于元件封裝選擇PCB元件時需要考慮的六件事
??1.考慮元件封裝的選擇
??在整個原理圖繪制階段,就應該考慮需要在版圖階段作出的元件封裝和焊盤圖案決定。下面給出了在根據元件封裝選擇元件時需要考慮
2023-12-21 09:04:38
性能和條件在了解封裝供應商給出的熱阻值后,應計算出芯片可能達到的最高溫度,計算時應先確定最壞的外界環境溫度。對于密封或敞開、有無通風等不同情況,外界環境溫度會有明顯的差別。同時還要考慮周圍是否有耗散
2018-11-26 16:19:58
大家好, 我對M95256-WMN3TP /ABE2PROM的最高結溫感興趣。 3級器件的最高環境工作溫度為125°C,因此結溫必須更高。數據手冊中沒有提到最大結溫。 我還在尋找SO-8封裝中M95256-W的結至環境熱阻。 最好的祝福, 托馬斯
2019-08-13 11:08:08
MAX9515提供微型、1mmx1mm、4焊球UCSP封裝,電源電壓范圍為2.7V至3.6V,器件工作在-40℃至+125℃溫度范圍。
2021-04-16 06:30:20
上升。這個是熱傳導面積增加導致熱 阻降低。
像這樣,分散熱源(功率損耗)是降低一個器件溫度的有效手段。這個例子以 IC 封裝為例,電阻器等被動元件也有同樣的效果。
考慮耐高溫的被動元件
眾所周知,電解電容器
2024-09-20 14:07:53
有什么方法可以降低IC封裝的熱阻嗎?求解
2021-06-23 07:24:48
一、溫升和熱設計是選取封裝最基本的要求 不同的封裝尺寸具有不同的熱阻和耗散功率,除了考慮系統的散熱條件和環境溫度,如是否有風冷、散熱器的形狀和大小限制、環境是否封閉等因素,基本原則就是在保證
2018-11-19 15:21:57
隨著大規模集成電路和大功率電子器件的發展,20世紀90年代鎢銅材料作為新型電子封裝和熱沉材料得到了發展,并以其明顯的優勢得到日益廣泛的應用。目前鎢銅材料主要用于大規模集成電路和大功率微波器中作為基片
2010-05-04 08:07:13
XT Bus Zig-Zag Inline Package LAMINATE UCSP 32L uBGA uBGA TSSOP or TSOP II Thin Small Outline
2011-01-23 10:48:24
65dB (典型值)的PSRR 確保200mA輸出電流驅動 開/關控制0.1μA超低關斷電流 2.7V至5.5V供電電壓范圍 熱關斷 微型2mm x 2mm x 0.7mm、WLP和UCSP封裝(4 x
2012-02-23 20:35:26
方案。DC-DC電源芯片的選取和使用要點。一、電源芯片型號選取要考慮的要點。1)輸入輸出電壓;2)負載電流大小;3)輸出的通道數量;4)成本;5)封裝形式;6)效率;二、實際應用中元件選取的計算。1)分壓電阻R1、R2的選取。其中VOut為輸出電壓,VFB為芯片自身預設的參考電壓,一般為0
2021-11-17 07:36:36
電阻電容的封裝形式如何選擇?有哪些原則需考慮?
2021-03-16 08:09:25
表面積,那么SOT-223和WSON將是不錯的選擇。 封裝選擇中另一個關鍵的考慮因素是熱阻。在產品說明書里常常可以看到兩種技術規格 —— θJc被指定為封裝表面溫度與結(或集成電路裸片的背面)溫之間的溫差
2018-09-05 15:37:21
紅外熱成像的原理是什么?紅外熱成像技術有什么作用?
2021-06-26 07:26:34
HI:我將使用FLASS25FL128SAGN作為FPGA配置芯片。這不是董事會上的事。FLASH是8接觸WSON封裝,具有大的暴露熱墊,但是沒有足夠的空間來焊接熱墊。所以熱墊沒有焊接,可以嗎?謝謝您的回復!
2019-10-23 11:22:44
選擇IC封裝時的五項關鍵設計考慮
2021-01-08 06:49:39
MAX4758, MAX4759 四路DPDT音頻/數據開關,UCSP/QFN封裝
2008-05-04 09:15:31 19
19 package(UCSP™). The MAX6023 series-mode (three-terminal)references, which operate with input voltages from 2.5Vto 12.6V (1.2
2008-10-01 22:37:25 17
17 電路板設計中的熱考慮:隨著一些大功率產品的小型化、標準化、模塊化。使得電子產品設計中,對產品的電磁兼容性設計、熱設計和防振動抗沖擊設計這三個要素的重視度日漸提
2009-03-24 14:05:08 0
0 SO-8封裝熱阻抗的
2009-06-03 14:55:45 23
23 測量激光二極管條微溝道封裝熱沉的熱阻尼系數
2009-11-11 10:09:35 9
9 大功率LED封裝界面材料的熱分析
基于簡單的大功率LED器件的封裝結構,利用ANSYS有限元分析軟件進行了熱分析,比較了四種不同界面材料LED封裝結構的溫度場分布。同時對
2010-04-19 15:43:22 44
44 熱阻值用于評估電子封裝的散熱效能,是熱傳設計中一個相當重要的參數,正確了解其物理意義以及使用方式對于電子產品的設計有很大的幫助,本文中詳細介紹了熱阻的定義、
2010-07-04 12:51:32 48
48 MAX6023精密的、低功耗、低壓差、UCSP封裝電壓基準
MAX6023是低壓差、微功耗、串聯型電壓基準,采用5引腳、芯片規模封裝(UCSP™)。MAX6023串聯型(3端
2008-10-01 22:45:31 1491
1491 
MAX9938 1µA、4焊球UCSP/SOT23封裝、高精度電流檢測放大器
MAX9938為高精度高邊電流檢測放大器,VO
2009-03-02 14:55:37 1422
1422 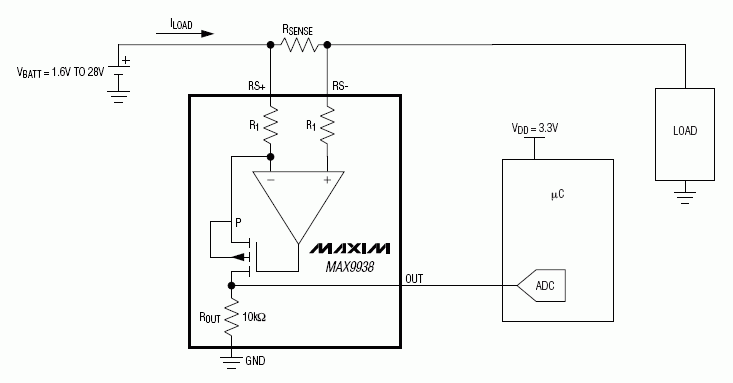
MAX3803 直流耦合、UCSP封裝、3.125Gbps均衡器
概述
MAX3803均衡器自動提供FR4帶狀
2010-03-04 08:55:08 1123
1123 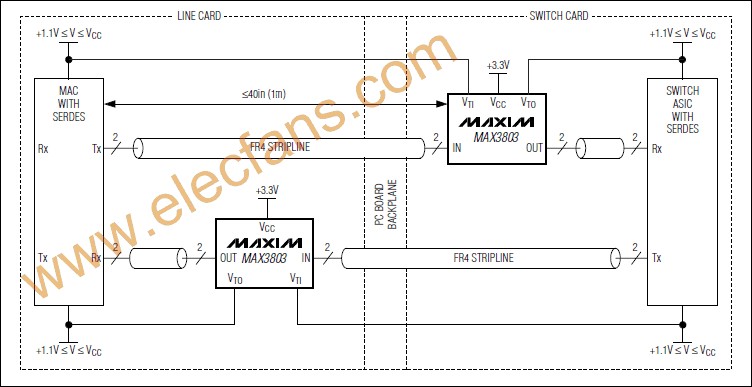
為確保產品的高可靠性,在選擇 IC封裝 時應考慮其熱管理指標。所有IC在有功耗時都會發熱,為了保證器件的結溫低于最大允許溫度,經由封裝進行的從IC 到周圍環境的有效散熱十分重
2011-10-27 10:47:53 38
38 本標準規定了半導體集成電路封裝結到外殼熱阻測試方法 本標準適用于半導體集成電路陶瓷、金屬、塑料封裝結到外殼熱阻的測量
2011-11-22 17:39:04 70
70 MAX8532采用微型UCSP封裝,提供低壓差和超低功率穩壓等優點,尤其適合于空間受限的手持設備
2012-02-14 10:02:39 1151
1151 
外殼熱設計的12點重要考慮 — 高級“應用方法”指南
2016-01-06 14:53:07 0
0 外殼熱設計的12點重要考慮 — 高級應用方法指南
2016-06-01 17:48:06 0
0 PowerPAD熱增強封裝設計提供了更大的靈活性和提高熱標準尺寸器件封裝的效率。PowerPAD封裝的性能改進的許可證更高的時鐘速度,更緊湊的系統和更積極的設計標準。自動包可在幾個標準的表面貼裝配
2017-05-24 11:00:11 22
22 介紹了有限元軟件在大功率 LED 封裝熱分析中的應用 , 對一種多層陶瓷金屬(MLCMP) 封裝結構的 LED 進行了熱模擬分析 , 比較了不同熱沉材料的散熱性能 , 模擬了輸入功率以及強制空氣冷卻
2017-11-13 14:23:26 7
7 如今越來越多的封裝/ PCB系統設計需要進行熱分析。功耗是封裝/ PCB系統設計中的關鍵問題,需要仔細考慮熱和電兩個領域的問題。為了更好地理解熱分析,我們以固體中的熱傳導為例,并利用兩個領域的對偶性。圖1和表1描述了電域與熱域之間的基本關系。
2018-03-17 11:08:43 8581
8581 
在繪畫原理圖的時候,就應該考慮需要在版圖階段作出的元件封裝和焊盤圖案決定。下面給出了在根據元件封裝選擇元件時需要考慮的一些建議
2018-04-30 17:22:00 5773
5773 PowerPAD?熱增強封裝提供了更大的設計靈活性,并提高了在標準尺寸器件封裝中的熱效率。PowerPAD包的改進性能允許更高的時鐘速度,更緊湊的系統和更積極的設計標準。PowerPAD軟件包在幾種標準的表面安裝配置中是可用的。
2018-05-03 14:37:00 19
19 PowerPAD熱增強封裝在標準尺寸器件封裝中提供更大的設計靈活性和提高的熱效率。
2018-05-18 16:46:26 14
14 白板向導-熱功率器件設計中的幾點思考視頻教程
2018-06-26 07:35:00 4698
4698 本技術簡介討論了IC封裝的熱設計技術,例如QFN,DFN和MLP,它們包含一個裸露的散熱墊。
2019-09-01 09:25:28 8657
8657 在PCB設計階段,關于元件封裝選擇時需要考慮的以下六件事。本文中的所有例子都是用Multisim設計環境開發的,不過即使使用不同的EDA工具,同樣的概念仍然適用。
2019-09-20 10:52:53 9362
9362 LED封裝主要是提供LED芯片一個平臺,讓LED芯片有更好的光、電、熱的表現,好的封裝可讓LED有更好的發光效率與好的散熱環境,好的散熱環境進而提升LED的使用壽命。LED封裝技術主要建構在五個主要考慮因素上,分別為光學取出效率、熱阻、功率耗散、可靠性及性價比(Lm/$)。
2020-01-21 11:18:00 3730
3730 運作中的 PCB 熱設計是工程師和電路板設計師的眾所周知的考慮因素。確保電路板散熱,并且組件不會過熱是設計期間必須解決的關鍵因素,通常使用散熱器和散熱風扇。盡管經常被忽略,但熱設計因素也會
2020-10-12 20:59:45 2335
2335 本文檔是關于如何使用封裝熱分析計算器(PTA)的簡短指南,該工具由Maxim Integrated設計,可簡化熱IC封裝分析。包括使用該工具必不可少的參數,以及示例,以更好地了解用戶。 封裝熱分析
2021-05-07 16:35:43 3879
3879 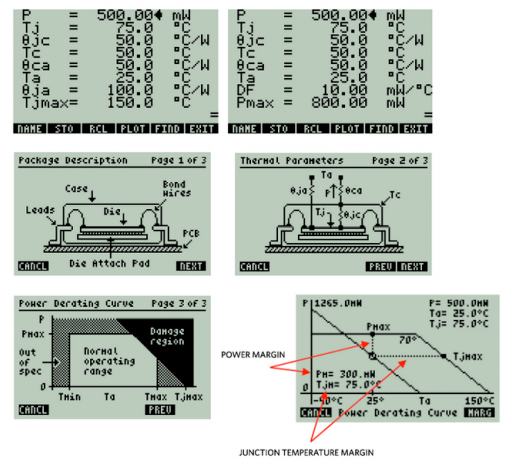
UCSP 是一種封裝技術,它消除了傳統的密封集成電路(IC)的塑料封裝,直接將硅片焊接到 PCB 上,節省了 PCB 空間。但也犧牲了傳統封裝的一些優點,尤其是散熱能力。大多數音頻放大器的封裝都帶有
2020-12-15 22:03:00 18
18 線性技術uModule BGA封裝的組裝考慮
2021-04-14 14:12:14 5
5 線性技術uModule LGA封裝的組裝考慮
2021-04-15 15:50:27 3
3 熱增強型鉛塑封裝的應用注意事項
2021-05-14 14:34:48 5
5 熱阻即熱量在熱流路徑上遇到的阻力,反映介質或介質間的傳熱能力的大小,表明了1W熱量所引起的溫升大小,單位為℃/W或K/W。可以用一個類比來解釋,如果熱量相當于電流,溫差相當于電壓,則熱阻相當于電阻
2021-05-26 15:45:15 4025
4025 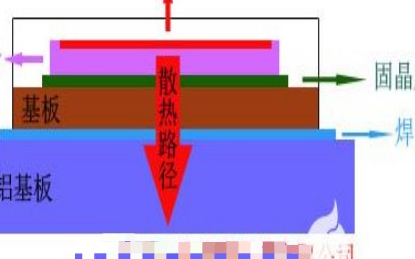
封裝PCB系統的熱分析綜述
2021-06-09 10:37:33 11
11 可以用與電阻幾乎相同的思路來考慮熱阻,并且可以以與歐姆定律相同的方式來處理熱計算的基本公式。
2022-02-08 16:51:34 21
21 本文闡述了采用 SOT-223 封裝的集成電路的散熱,包括熱參數和內部結構。最后,我們將介紹 SOT-223 封裝的 PCB 銅布局的熱分析。
2022-04-19 17:12:10 22074
22074 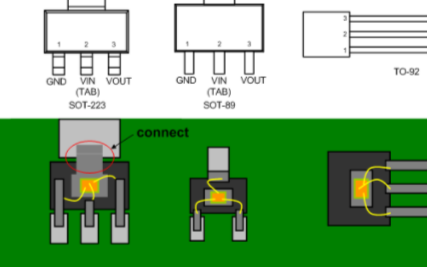
最近,熱評估已成為電源管理系統中的熱門話題。隨著許多應用對功率要求的提高,應考慮熱管理以避免過熱。尤其是在芯片中集成了功率MOSFET的DC-DC轉換器產品,其功耗面臨著封裝尺寸和PCB布局面積有限
2022-04-19 17:19:04 5348
5348 
帶有外露焊盤封裝的電力電子設備的快速 PCB 熱計算
2022-11-14 21:08:20 2
2 國內對CBGA焊球可靠性的熱分析研究得較多,但是對整個封裝體,尤其是封裝體本身的熱衷研究卻很少。高輝等[3]對多芯片陶瓷封裝的結-殼熱阻分析方法進行了研究,研究了多芯片熱耦合對熱阻的影響;Ravl等
2022-12-01 09:21:41 2684
2684 MAX5860和MAX5862是高性能、高集成度器件,采用緊湊的12mm x 17mm封裝。正確設計熱系統以將結溫保持在安全工作范圍內非常重要。封裝中有兩個電路:數字上變頻器(DUC)和數模轉換器(DAC)。本指南介紹了一種測量兩個電路內部結溫的方法。
2023-01-23 07:30:00 1031
1031 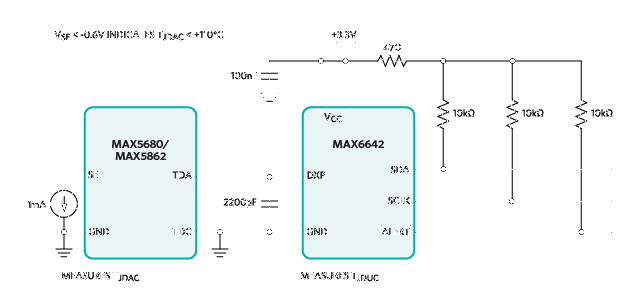
JESD 51封裝器件的熱測量方法(單個半導體器件)
2023-01-15 11:46:41 3
3 MAX5860和MAX5862是高性能、高集成度器件,采用緊湊的12mm x 17mm封裝。正確設計熱系統以將結溫保持在安全工作范圍內非常重要。封裝中有兩個電路:數字上變頻器(DUC)和數模轉換器(DAC)。本指南介紹了一種測量兩個電路內部結溫的方法。
2023-02-10 11:07:25 1034
1034 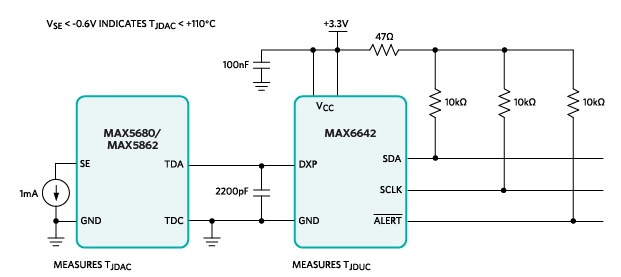
封裝熱分析計算器 (PTA) 是為 HP 50g 計算器編寫的程序,有助于分析 IC 封裝熱。使用數據表參數,從芯片(結點)、外殼到環境跟蹤熱量和耗散。探討了最大結溫下的功率降額因數和最大功耗。
2023-02-10 11:10:37 1803
1803 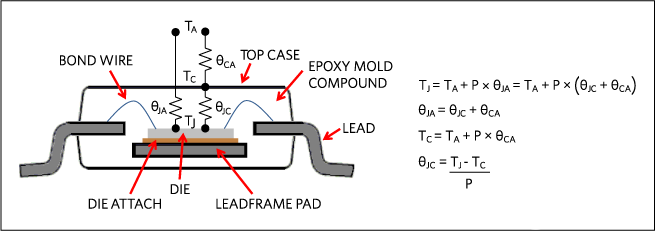
繼上一篇文章“封裝選型時的熱計算示例 1”之后,本文將作為“熱計算示例 2”,繼續探討為了使用目標封裝而采取的相應對策。封裝選型時的熱計算示例 2,首先,為了方便確認,給出上次的損耗計算及計算結果、以及其條件下的熱計算結果。
2023-02-23 10:40:52 4464
4464 
隨著半導體器件向著微型化、髙度集成化及高功率密度方向發展,其發熱量急劇增大,熱失效已經成為阻礙微電子封裝器件性能和壽命的首要問題。
2023-03-25 09:31:09 3358
3358 為確保產品的高可靠性,在選擇IC封裝時應考慮其熱管理指標。所有IC在有功耗時都會發熱,為了保證器件的結溫低于最大允許溫度,經由封裝進行的從IC到周圍環境的有效散熱十分重要。本文有助于設計人員和客戶
2023-06-10 15:43:05 2468
2468 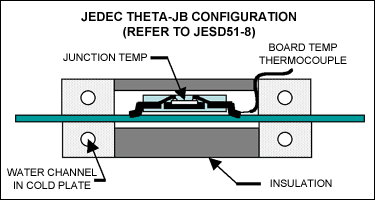
摘要:隨著半導體器件向著微型化、髙度集成化及高功率密度方向發展,其發熱量急劇增大,熱失效已經成為阻礙微電子封裝器件性能和壽命的首要問題。高性能的熱管理材料能有效提高微電子封裝內部元器件散熱能力,其中封裝
2023-03-03 14:26:57 4099
4099 
圓級封裝(WLP)技術的發展。接下來討論了使用晶圓級封裝器件的實際方面。討論的主題包括:確定給定器件的倒裝芯片/UCSP封裝的可用性;通過其標記識別倒裝芯片/UCSP;圓片級封裝件的可靠性;尋找適用的可靠性信息。
2023-10-16 15:02:47 2019
2019 UCSP and 5 SOT23 Data Sheet的引腳圖、接線圖、封裝手冊、中文資料、英文資料,MAX9060-MAX9064: Ultra-Small, nanoPower Single
2023-10-16 18:38:05

的引腳圖、接線圖、封裝手冊、中文資料、英文資料,MAX9634: nanoPower, 4-Bump UCSP/SOT23, Precision Current-Sense Amplifier Data
2023-10-16 19:17:55

為什么PCB設計時要考慮熱設計? PCB(Printed Circuit Board)設計是指通過軟件將電路圖轉化為PCB布局圖,以導出一個能夠輸出到電路板的文件。在進行電路設計時,我們需要考慮
2023-10-24 09:58:27 1404
1404 電子發燒友網站提供《AN50019:MOSFET封裝的熱邊界條件研究.pdf》資料免費下載
2023-12-19 15:59:58 0
0 電子發燒友網站提供《TAS5805M D類音頻放大器的熱設計考慮.pdf》資料免費下載
2024-09-14 10:31:50 3
3 電子發燒友網站提供《封裝天線毫米波傳感器的熱設計指南.pdf》資料免費下載
2024-09-26 10:54:29 2
2 氮化鎵(GaN)功率器件系列能夠設計出體積更小,成本更低,效率更高的電源系統,從而突破基于硅的傳統器件的限制。 這里我們給大家介紹一下GaNPX?和PDFN封裝器件的熱設計。 *附件:應用筆
2025-02-26 18:28:47 1206
1206 能夠通過添加界面材料和散熱片將其熱模型擴展到其系統中。 附詳細文檔免費下載: *附件:基于RC熱阻SPICE模型的GaNPX?和PDFN封裝的熱特性建模.pdf 基于RC熱阻SPICE模型的GaNPX
2025-03-11 18:32:03 1435
1435 




 電子發燒友App
電子發燒友App









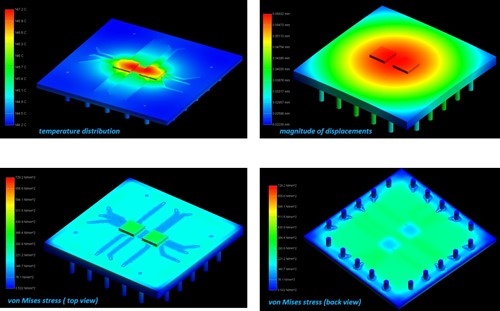
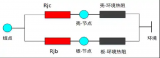






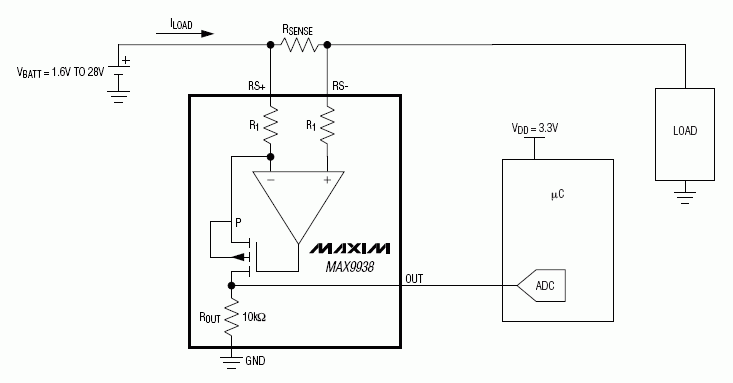
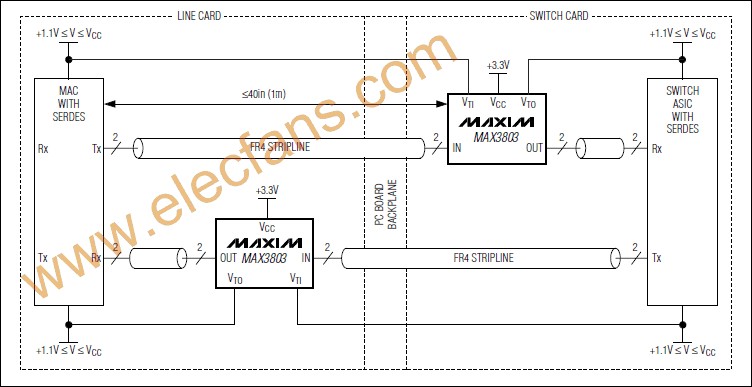


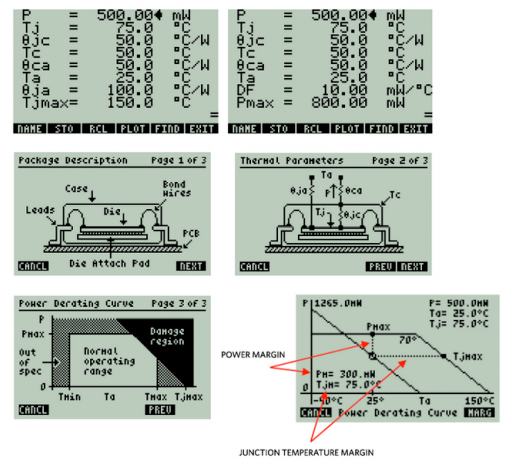
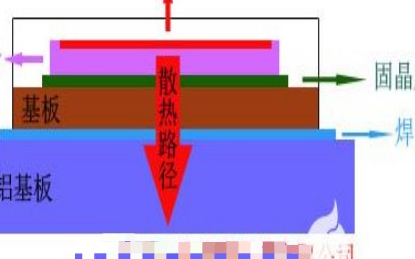
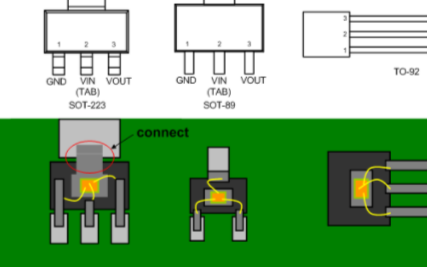

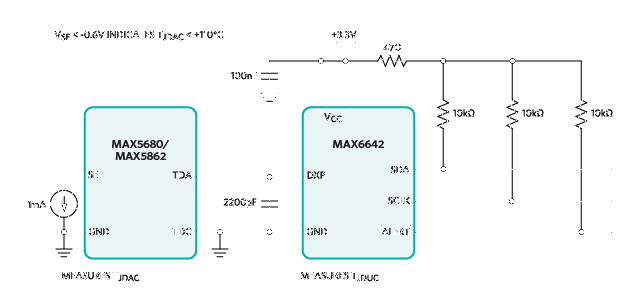
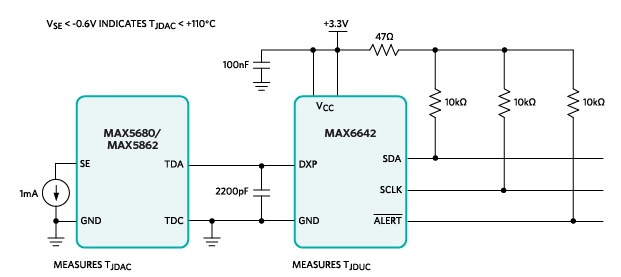
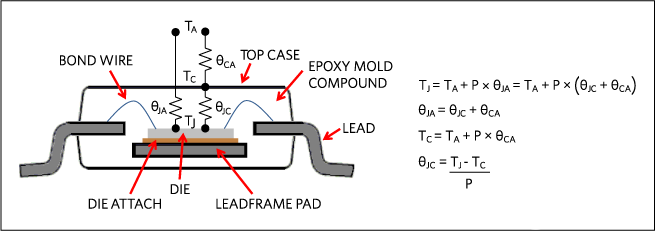

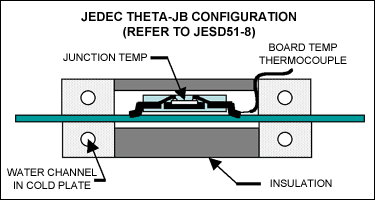






評論