本文將詳細探討清洗和紋理的相互作用,在清潔過程中使用的化學類型對平等有著深遠的影響,并在紋理中產生不可預測的影響。
經過線鋸、除膠和切割,最終清理的目的是清除所有泥漿、切削液和線鋸殘留物,通常,這種殘留物由不同量的聚乙二醇或礦物油(切削液)、鐵和銅的氧化物、碳化硅和研磨硅,這些殘留物可以通過鋸切過程中產生的摩擦熱燒到晶片表面,為了去除這些殘留物,需要選擇正確的化學物質來補充所使用的設備。
在晶片清洗并給予足夠的時間形成天然氧化層后,單晶硅晶片將顯示出具有0o接觸角的親水性表面,如果這些晶片經過一個典型的堿性紋理過程,金字塔將成核到一個首選的密度,并增長到5-8μ之間的高度。

當紋理立即跟隨堿性清洗過程時,晶片表面狀態的重要性可見,導致不均勻的錐形成核,>反射率為20%,一個典型的堿性清洗過程將去除晶片中的天然氧化物,這可以通過產生的表面疏水性得到證明。接觸角從0o增加到>50o,堿性清洗后,紋理蝕刻深度也從8μ/邊到3μ/邊降低(如圖6),這是由于晶體平面在非最佳紋理晶片表面的暴露增加,光捕獲在隨機表面不成功,這可能導致細胞效率下降。眾所周知,酸基清潔劑能夠從表面去除金屬而不蝕刻硅表面,由于已知金屬會影響硅的蝕刻速率,因此預計蝕刻速率應該會隨著酸清潔劑的使用而變化。在這個實驗中,在紋理之前清洗晶圓,清洗后晶片接觸角保持不變,保持在0o,紋理化后,觀察到紋理化速率的增加,反射率與中性控制相當(圖6),峰高度和密度也與對照組非常相似,峰高度略大。
在紋理化步驟之前,評估了其他清潔劑,包括酸性和中性溶液,酸基清潔劑是已知的,具有在不蝕刻硅表面的情況下從表面去除金屬的能力,因為金屬會影響硅的蝕刻速率,預計蝕刻速率會隨著酸清潔劑的使用而改變。
一個已知的涉及氫氟酸暴露的氧化物去除步驟也證明了在進入下游處理步驟之前的硅表面狀態的重要性,特別是晶片紋理,在HF酸停留后,晶片接觸角從0o增加到69o,曝光后的堿性紋理導致金字塔成核點的高密度,并顯示了低蝕刻損失(<4μ/side)和增加的反射率(>14%)。
了解到去除天然氧化物層而沒有足夠的時間再生會對紋理產生負面影響,因此有機會加速氧化物的生長以實現最佳紋理,堿性清洗后,晶片接觸角增加到>50o,如果晶片經過專有的再氧化步驟,接觸角恢復到零,紋理恢復到首選狀態(圖5)。

晶片的清洗會對硅晶片的表面狀態和紋理化結果產生深遠的影響;特別是當這種清洗干擾了晶片的天然氧化物層時,堿性清潔劑通過天然氧化層產生不良的效果時,可以觀察到蝕刻量減少,反射率百分比增加,氫氟酸同樣去除天然氧化層,也產生較差的紋理結果,進一步的工作表明,這是一個可逆的發生,因為一個再氧化步驟可以恢復天然氧化物和紋理返回到一個最佳水平,替代清潔劑,包括酸性和pH中性產品,不會干擾天然氧化物層,因此不會影響隨后的紋理步驟。本文已經表明,晶圓處理步驟并不是完全相互獨立的,而是證明了可以對細胞構建產生負面影響的相互作用,如果理解這些相互作用,它們可以避免或糾正,以產生最佳效率的光伏電池。
審核編輯:符乾江
 電子發燒友App
電子發燒友App













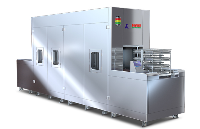

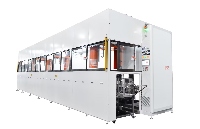
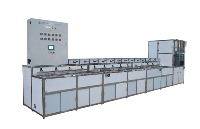




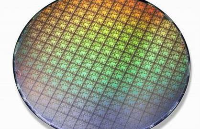

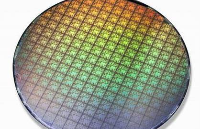








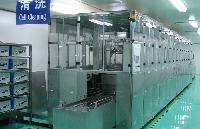




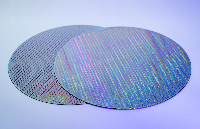
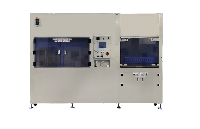
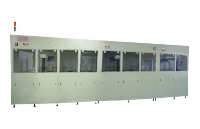


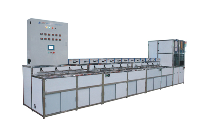

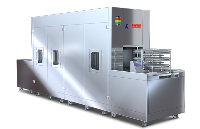

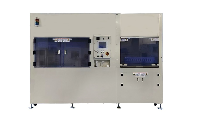

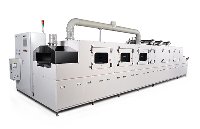


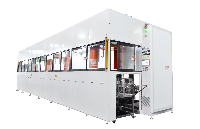
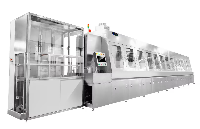

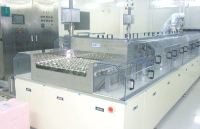




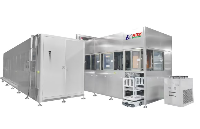










評論