來源:半導體行業觀察 ,作者杜芹DQ
隨著摩爾定律逐漸進入其發展軌跡的后半段,芯片產業越來越依賴先進的封裝技術來推動性能的飛躍。在封裝技術由平面走向更高維度的2.5D和3D時,互聯技術成為關鍵中的關鍵。面對3D封裝日益增長的復雜性和性能要求,傳統互聯技術如引線鍵合、倒裝芯片鍵合和硅通孔(TSV)鍵合等,正逐步顯露其局限。在這種背景下,混合鍵合技術以其革命性的互聯潛力,正成為行業的新寵。
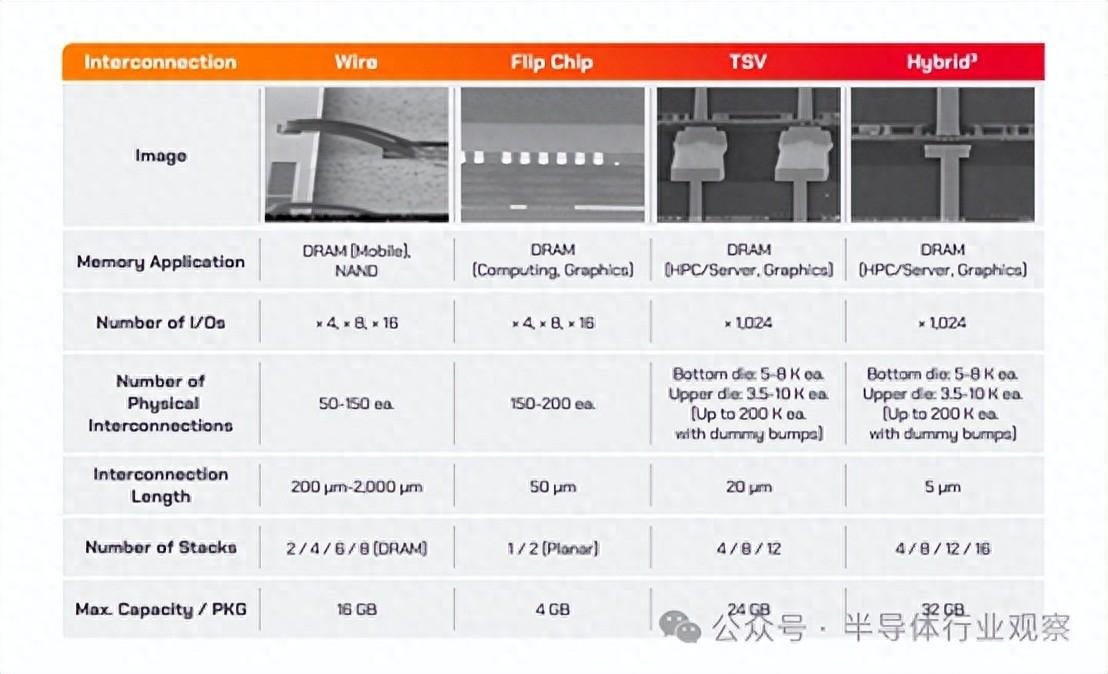
四大主要的互聯技術
(圖源:SK海力士)
混合鍵合,或稱為Hybrid Bonding,主要有兩種使用方式。第一種是晶圓到晶圓,用于CIS 和NAND,在這些領域,混合鍵合已經證明了其效率。銅混合鍵合最早出現在2016年,當時索尼將這項技術用于CMOS圖像傳感器;另一種是裸片到晶圓混合鍵合,這比晶圓間鍵合更加困難,但這種工藝變化對于邏輯和高帶寬內存 (HBM) 很有意義。

晶圓對晶圓(Wafer-to-Wafer,W2W)混合鍵合的步驟流程(來源:應用材料)

裸片對晶圓(Die-to-Wafer,D2W)混合鍵合的步驟流程(來源:應用材料)
混合鍵合技術具有以下特點:1)它允許不同的芯片層,如存儲器層和邏輯層,在無需通過硅通孔(TSV)的情況下直接互連,顯著提高信號傳輸速度并降低功耗;2)通過芯片和晶圓之間的直接銅對銅鍵合,最大限度地縮短導線長度;3)與傳統TSV技術相比,混合鍵合減少了層間物理連接的需求,使芯片設計更緊湊,有利于實現更高性能和密度。據悉,在應用混合鍵合時,1平方毫米的面積內可連接10,000至100,000個通孔;4)混合鍵合還可減少芯片內部的機械應力,提高產品的整體可靠性,同時支持更高的數據傳輸速度和更低的能耗。
混合鍵合已成為芯片蓋樓、未來3D封裝的一項關鍵技術,是實現高性能、高密度和低功耗芯片設計的關鍵技術之一。在這樣的背景下,晶圓廠、存儲廠、設備廠,都盯上了混合鍵合。
混合鍵合的先行者們
混合鍵合技術已成為晶圓制造業的共識,行業巨頭如臺積電、三星和英特爾正在競相推進5納米及更先進制程技術的開發。在這一進程中,混合鍵合技術顯得尤為關鍵,被視為高端制造的必由之路。
臺積電:唯一實現混合鍵合商業化的公司
在混合鍵合領域,全球排名第一的晶圓代工公司臺積電最有發言權。臺積電是迄今為止唯一一家將混合鍵合商業化的芯片公司。臺積電的3D封裝-SoIC就是使用的混合鍵合技術,該服務名為3DFabric,已應用于AMD V-Cache。
據臺積電的公開資料顯示,憑借創新的鍵合方案,SoIC技術為芯片 I/O 提供了強大的鍵合間距可擴展性,從而實現了高密度芯片間互連。鍵距從低于10 μm的規則開始。與當前業界最先進的封裝解決方案相比,短芯片到芯片連接具有更小的外形尺寸、更高的帶寬、更好的電源完整性 (PI)、信號完整性 (SI) 和更低的功耗。
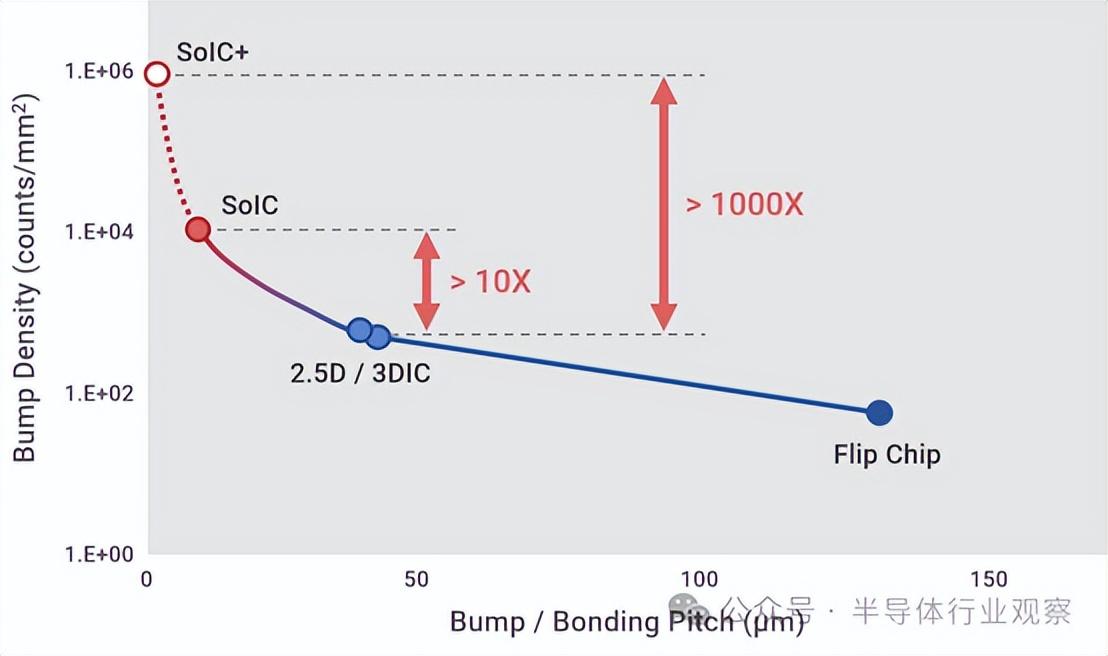
臺積電展示的SoC-Exceptional-scalability
(來源:臺積電)
臺積電的SoIC技術將同構和異構小芯片集成到單個類似 SoC 的芯片中,該芯片具有更小的占地面積和更薄的外形,可以整體集成到先進的 WLSI(又名 CoWoS 服務和 InFO)中。從外觀上看,新集成的芯片就像通用的SoC芯片一樣,但嵌入了所需的異構集成功能。
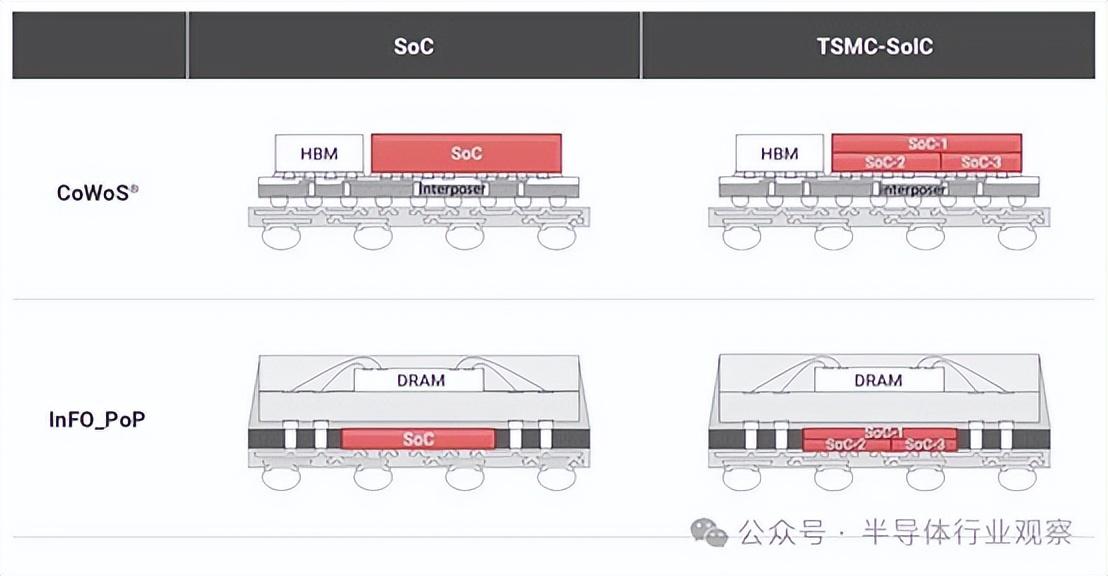
SoIC與SoC的外觀對比
(來源:臺積電)
三星:積極引入混合鍵合
三星電子正開始認真引入混合鍵合,三星“一條腿”是為了增強其代工能力,另一條腿是在HBM上發力。
據業界2月1日消息,Besi Semiconductor和應用材料正在三星電子天安園區安裝混合鍵合相關設備。天安園區是三星電子的先進封裝生產基地。該設備預計將用于 X-Cube 和 SAINT 等下一代封裝解決方案。據業內人士透露:“據我所知,該設備用于非內存封裝。”
據了解,三星電子的最新投資主要是為了加強其先進封裝能力。三星電子正準備推出采用混合鍵合的 X-Cube。業界預測,混合鍵合也可以應用于三星電子計劃從今年開始推出的Saint平臺。該公司計劃提供3D封裝服務,例如Saint-S(將SRAM堆疊在邏輯芯片上)、Saint-L(將邏輯芯片堆疊在邏輯芯片上)以及Saint-D(將DRAM芯片堆疊在邏輯芯片上)。
業界預測,三星電子對混合鍵合設施的投資可能會贏得英偉達和AMD等大客戶的青睞。這是因為這些無晶圓廠客戶的AI芯片中所用的CoWoS封裝對混合鍵合的需求正在增加。
另一方面,據三星電子執行副總裁兼 DRAM 產品與技術團隊負責人 SangJoon Hwang 在三星博客上發表的社論博客文章,三星的HBM4 將于 2025 年推出。HBM4內存將采用一些針對高熱性能進行優化的技術,例如非導電膜(NCF)組裝和混合銅鍵合(HCB)。
英特爾:混合鍵合呼之欲出
在晶體管誕生75周年的2022年IEDM會議上,英特爾就展示了其采用混合鍵合技術,致力于將封裝技術密度提升10倍的雄心。英特爾計劃將這一技術應用于其3D封裝技術Foveros Direct,該技術已在去年實現了商業化推廣。
在今年的ECTC上,英特爾發表了一篇有關混合鍵合技術的論文。圖左側的技術稱為 Foveros,凸塊間距為50微米,每平方毫米大約有400個凸塊。未來,英特爾的目標是將凸塊間距縮小至約10微米,并實現每平方毫米10,000個凸塊。
下圖比較了傳統凸點接合技術與混合接合技術。與底部填充相比,混合鍵合技術可將互連間距減小至10微米以下,從而實現更高的載流能力、更密集的銅互連密度以及更好的熱性能。但是,混合鍵合技術需要新的制造、處理、清潔和測試方法。
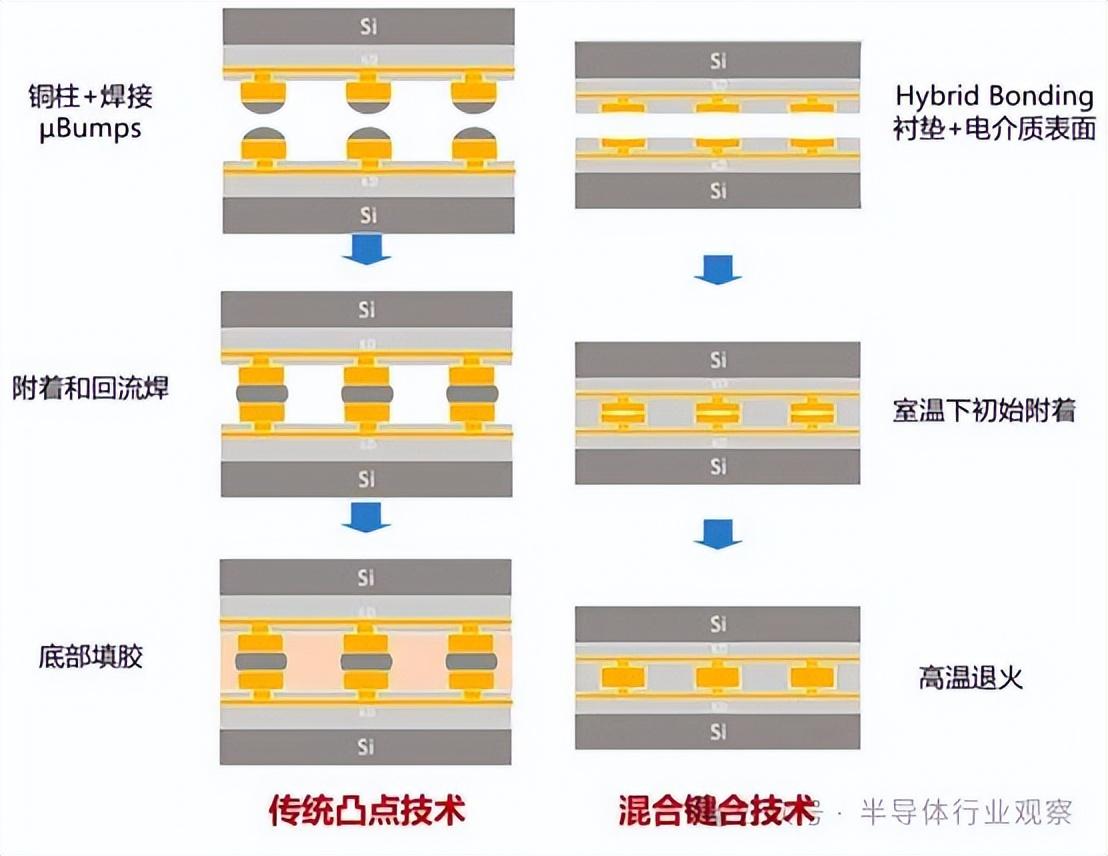
據報道,英特爾有望在2024年率先在其邏輯芯片與互連器之間采用混合鍵合技術。Foveros Direct預計將采用晶粒對晶圓的混合鍵合方法,其間距預計在9至10微米之間。相比之下,英特爾的Meteor Lake產品采用熱壓縮鍵合(TCB)技術的間距為36微米,而Lakefield產品采用通過硅孔(TSV)的凸塊連接技術的間距為55微米。
SK海力士:HBM率先引入混合鍵合
存儲廠商SK海力士也盯上了混合鍵合。
去年,SK海力士憑借在高帶寬存儲器(HBM)芯片的領先,成為這一輪AI熱潮的重度獲利者。但你可能不知道的是,SK海力士在封裝技術也有很聞名。例如,SK海力士所開發的CoC(片上芯片)封裝技術,能將兩個(或更多)芯片電連接在一起,無需 TSV(硅通孔);K海力士還開發了異構集成和扇出RDL技術等先進封裝技術。去年,SK海力士正是由于率先在第五代HBM的生產中引入了大規模回流成型底部填充 (MR-MUF) 工藝,從而保持了HBM行業領導者的地位。
SK海力士的MR-MUF技術提高了HBM超過100,000個微凸塊互連的質量。此外,該封裝技術充分增加了熱虛擬凸塊的數量,同時由于采用了高導熱率的模制底部填充(MUF)材料,因此與競爭對手相比,散熱性能更加出色。這一進步幫助SK海力士增加了其在HBM市場的份額,并最終在HBM3領域占據了領先地位。
如今SK海力士正在HBM芯片中積極推進“混合鍵合”新工藝,以維持其在全球市場的領先地位。那么,為什么HBM要采用混合鍵合技術呢?
首先讓我們再來熟悉下HBM芯片,所謂的HBM,其實就是通過堆疊DRAM層數來提高數據處理速度的存儲器。其主要通過TSV+填充物的方式來連接DRAM層。據SK海力士稱,HBM芯片目前的標準厚度為720微米(μm)。“當HBM的層數達到12層甚至更多時,可能會出現高度方面的問題,這就需要運用混合鍵合技術來解決”SK海力士的晶圓鍵合負責人Kang Ji-ho曾在一次會議上表示。SK海力士預計,2026年左右投入量產的的第六代HBM(即HBM4),其層數要求可高達16層,這對現有封裝技術提出了巨大的挑戰。
混合鍵合技術是HBM領域的未來發展趨勢。簡單來說,如果把HBM想象成一座多層大樓,其中每一層都承載著存儲數據的任務,當大樓層數過多時,僅靠傳統的通過硅通孔(TSV)+填充物的連接方式不足以維持其穩定且可靠。而混合鍵合技術就好比在每一層之間涂上了一種特殊的“膠水”,這樣就不需要額外的支撐物來固定這些層了,能顯著減小芯片的厚度。
簡而言之,通過混合鍵合技術,他們能夠制造出既高效又小巧的高層內存芯片。混合鍵合也被稱為是“夢想封裝技術”。
SK海力士率先宣布在今年將混合鍵合應用于HBM4產品,繼續引領HBM技術發展,這將為HBM4產品的性能和功耗帶來革命性的提升。
目前,SK海力士取得了一定的進展。就在去年12月份在美國舉行的全球半導體會議IEDM 2023上,SK海力士透露了其已確保HBM制造中使用的混合鍵合工藝的可靠性。該公司報告稱,其第三代HBM產品(HBM2E)采用了8層堆疊DRAM,并且在采用混合鍵合工藝后順利通過了所有可靠性測試。在這次測試中,SK海力士對HBM在高溫環境下的使用壽命進行了評估,并檢查了產品在客戶焊接芯片過程中可能出現的潛在問題,涵蓋了四個主要方面。雖然本次測試是在第三代產品上進行的,其要求遠低于HBM4規格,但這也展示出了混合鍵合的潛力。

使用SK海力士混合鍵合的HBM2E可靠性測試結果
據報道,SK海力士預計將在2025至2026年間實現其混合鍵合技術的商業化。最新的韓國媒體消息指出,SK海力士近期與臺積電共同發起了名為“One Team Strategy”的聯盟,兩家將共同研發第六代HBM(高帶寬存儲器)芯片,即HBM4。在這一合作中,臺積電預計將承擔HBM4芯片部分工藝的制造任務,特別可能包括關鍵的封裝工藝,以增強產品的兼容性和性能。對此,SK海力士方面表示:“對于聯盟的具體情況,公司不予置評。”
設備廠商,混合鍵合的“賣鏟人”
混合鍵合技術,不是易事。其面臨的主要技術挑戰是:以經濟成本實現無缺陷的銅對銅接合,并且芯片對芯片的對準誤差幾乎為零。這需要對上下游工藝以及設備設計進行重大修改。在此過程中,集成流程開發和協同優化在這里發揮著關鍵作用。
在執行芯片或晶圓間的混合鍵合時,必須保證它們的表面達到接近原子層級的極致清潔度,并進行至關重要的步驟——精確地對齊并鍵合二氧化硅絕緣層與銅接觸點。這一過程需要極度潔凈和高精度的鍵合設備。首先,需要利用清潔和等離子體激活設備為鍵合做好充分準備。緊接著,在第二階段,使用鍵合機器精確地將集成電路放置到晶圓上。考慮到這些設備的高端精密性要求,它們的成本相對較高,與前端制造設備的價格不相上下。根據Besi的報價,每臺鍵合設備的成本在200萬至250萬歐元之間。
在混合鍵合領域,主要的設備供應商包括應用材料公司(Applied Materials)、KLA Tencor、Lam Research、ASM Pacific Technology(ASMPT)和BE Semiconductor Industries(BESI)。正如淘金時代的鏟子、篩網對淘金者至關重要一樣,混合鍵合設備是芯片制造商實現技術突破的基礎工具。它們的設備精度、可靠性和創新程度直接關系到芯片制造商是否能在激烈的市場競爭中勝出。
由于與英特爾和臺積電的長期合作關系,荷蘭后端專家Besi目前在芯片對晶圓混合鍵合領域處于有利地位。據其首席執行官布里克曼表示,八年前臺積電要求Besi公司開始為其技術開發鍵合機。“臺積電在整個學習曲線過程中幫助了我們,”他在去年接受New Street Research公司Pierre Ferragu采訪時說。“我們處于一個獨特的情況,擁有正確的客戶。從一開始我們就一直在選擇贏家。與應用材料的合作在理解潔凈室環境的要求方面極為有幫助。”
Besi和應用材料在混合鍵合領域有著密切的合作。自2020年10月以來,Besi和 Applied 公司通過在新加坡建立卓越中心 (CoE) 來進行技術開發。縱觀兩家公司的混合鍵合產品組合,Besi主要是批量生產混合鍵合芯片貼裝設備,而Applied則生產從電介質沉積設備到等離子體設備和化學機械拋光(CMP)設備等各種設備。應用材料公司的Insepra SiCN和 Catalyst CMP系統可實現與新材料的最先進的混合鍵合并增強表面處理。如前文所述的三星的產線也是Besi和應用材料共同作用的結果。據Besi透露,建設一條清潔和鍵合生產線的總成本約為500萬到600萬歐元。應用材料公司和Besi各自占據其中的一半,具體取決于應用領域——存儲器或邏輯芯片。
2021年,在COVID危機期間的半導體熱潮中,Besi宣布,英特爾和臺積電都承諾購買50臺混合鍵合機。訂單真正開始增長是在2023年,所以這些計劃似乎有些延遲,但Besi表示它已經有能力每年生產180臺混合鍵合機。如果這個產能得到充分利用,將意味著額外的4億歐元銷售額。
奧地利的EV Group多年來提供了一種用于清潔芯片和晶圓并為放置系統做準備的等離子體激活系統。EVG與ASM Pacific合作,后者提供鍵合機。EVG已經在混合晶圓對晶圓鍵合市場上證明了自己,在這個市場上領先,擁有數百臺機器。幾乎所有手機中的傳感器都經過了EVG設備的晶圓對晶圓過程。在高端CMOS傳感器市場,EVG正在與日本的TEL競爭。
混合鍵合,已成為芯片發展的重要趨勢。目前的首要任務是,行業需要共同努力,推動芯片到晶圓混合鍵合技術的大規模生產。隨著越來越多的企業投身于這一創新領域,我們有理由相信混合鍵合技術將在不久的將來迎來突破性的發展。
展望未來,隨著高速通信需求的不斷增長,銅互連將無法滿足傳輸需求,光互連技術將成為未來發展的一大選擇。
-
芯片
+關注
關注
463文章
54007瀏覽量
465952 -
半導體
+關注
關注
339文章
30731瀏覽量
264054 -
封裝
+關注
關注
128文章
9249瀏覽量
148614
發布評論請先 登錄
NTC熱敏芯片鍵合工藝介紹
詳解先進封裝中的混合鍵合技術

白光掃描干涉法在先進半導體封裝混合鍵合表面測量中的應用研究




 混合鍵合,成為“芯”寵
混合鍵合,成為“芯”寵










評論