8隨著半導體器件特征尺寸不斷縮小,三維(3D)封裝技術已成為延續摩爾定律的重要途徑。銅-介質混合鍵合(Hybrid Bonding)通過直接連接銅互連與介電層,實現了高密度、低功耗的異質集成。然而,化學機械拋光(CMP)工藝引入的納米級表面形貌變化(如銅凹陷/凸起)會顯著影響鍵合質量。傳統測量方法如原子力顯微鏡(AFM)雖然具有埃級分辨率,但其接觸式測量方式存在效率低、易損傷樣品等缺點。本研究借助光子灣白光干涉輪廓儀重點開發基于白光掃描干涉法(WSI)的新型測量方案,通過系統優化和相位補償,實現了非接觸、高精度、高效率的表面形貌表征。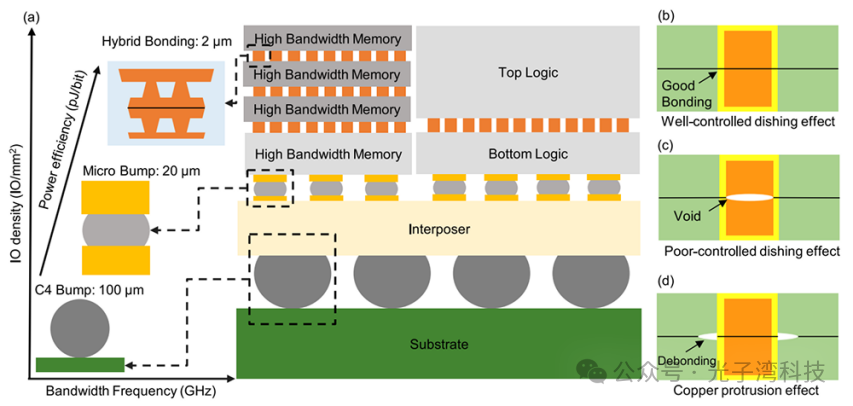 半導體封裝異質集成的混合鍵合技術
半導體封裝異質集成的混合鍵合技術
#Photonixbay.01
混合鍵合測試樣品制備
本研究制備了兩組具有典型特征的混合鍵合測試樣品: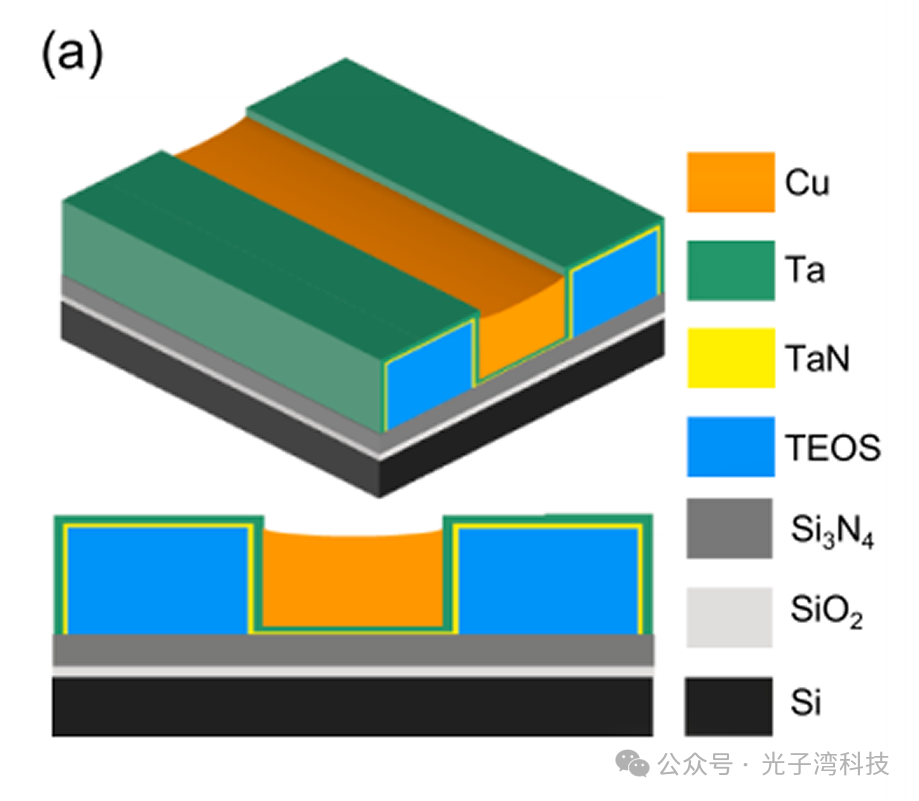 樣品#1結構:TEOS圖案表面覆蓋Ta/TaN薄膜樣品#1(標準CMP工藝):
樣品#1結構:TEOS圖案表面覆蓋Ta/TaN薄膜樣品#1(標準CMP工藝):
- 薄膜堆疊:Si 襯底 / 800nm Cu / 220 nm TEOS / 10nm Ta / 5nm TaN
- 關鍵工藝參數:
○ 拋光壓力:24.1 kPa○ 拋光盤轉速:80 rpm○ 拋光時間:90 s
- 目標形貌:100±5 nm銅凹陷(TEOS高于Cu)
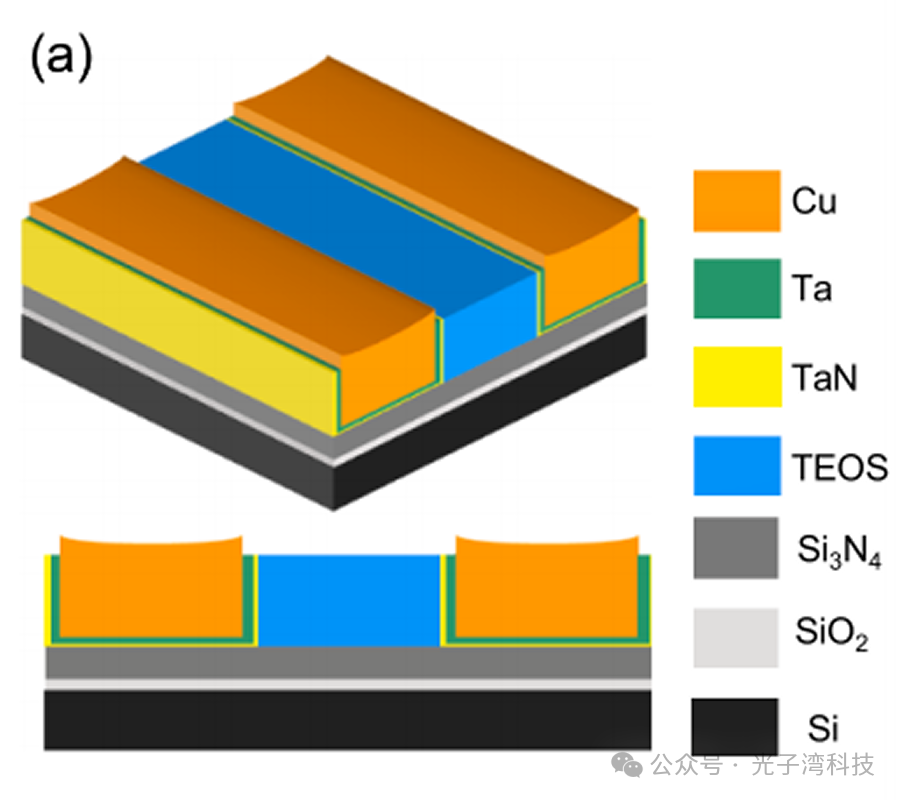 樣品#2結構:無Ta/TaN層,銅因過度拋光高于TEOS樣品#2(過拋光工藝):
樣品#2結構:無Ta/TaN層,銅因過度拋光高于TEOS樣品#2(過拋光工藝):
- 在樣品#1基礎上進行二次拋光:
○ 壓力提升至35.9 kPa○ 轉速增至90 rpm○ 拋光時間20 s○ 添加專用銅腐蝕抑制劑
- 目標形貌:7±2 nm銅凸起(完全去除Ta/TaN阻擋層)
#Photonixbay.02
高分辨率表面形貌測量方法
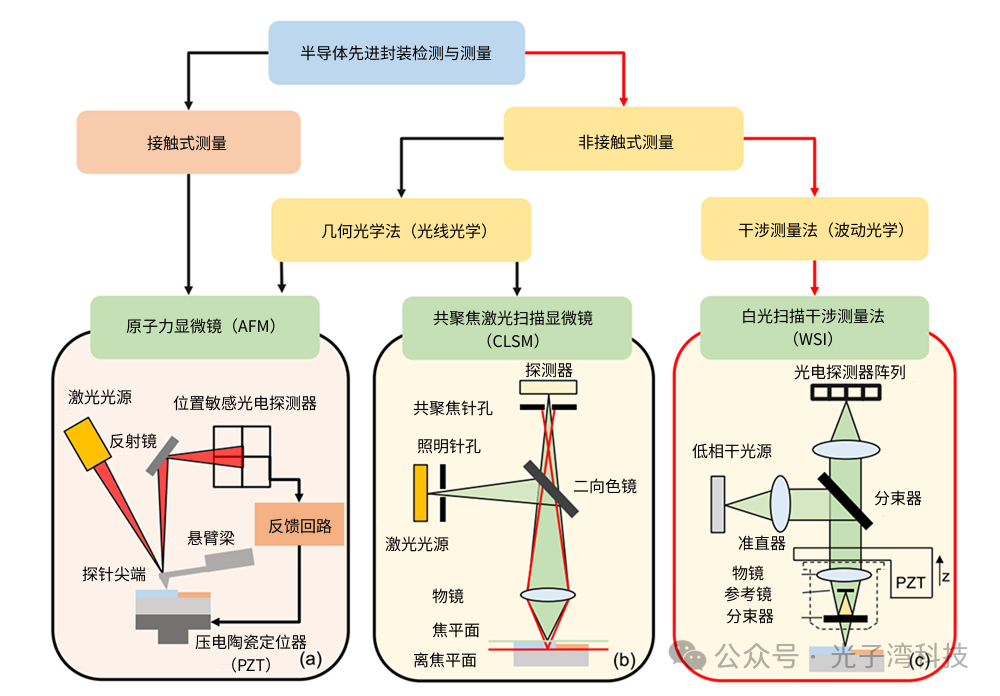 半導體封裝異質集成的表面計量方法
半導體封裝異質集成的表面計量方法
原子力顯微鏡 (AFM)
共聚焦顯微鏡 (CLSM)
- 原理:激光聚焦+針孔過濾,僅捕捉焦平面信號
- 關鍵組件:共聚焦針孔、二向色鏡、物鏡、垂直掃描模塊
- 用途:亞微米級三維成像(如TSV孔深測量)
白光干涉儀 (WSI)
- 原理:白光干涉條紋分析,消除相位模糊
- 關鍵組件:低相干光源、參考鏡、壓電Z軸掃描、分束器
- 用途:毫米級表面全場測量(如凸塊高度一致性)
#Photonixbay.03
高度測量結果對比
 樣品#1(左)樣品#2(右)AFM測量的表面重建與截面圖
樣品#1(左)樣品#2(右)AFM測量的表面重建與截面圖 樣品#1(左)樣品#2(右)(c)(d) WSI在10×和20×放大倍率下的表面重建與截面圖
樣品#1(左)樣品#2(右)(c)(d) WSI在10×和20×放大倍率下的表面重建與截面圖 樣品#1(左)樣品#2(右)(e)(f) CLSM在10×和20×下的表面重建與截面圖三種測量方法的表面高度測量結果對比
樣品#1(左)樣品#2(右)(e)(f) CLSM在10×和20×下的表面重建與截面圖三種測量方法的表面高度測量結果對比 AFM、WSI和CLSM對兩個混合鍵合樣品進行了測量和分析。AFM記錄的樣品#1和樣品#2的高度分別為100 nm和7 nm。WSI測量的樣品#1和樣品#2的高度分別為128.1 nm和334.2 nm,而CLSM的結果分別為132.5 nm和128.1 nm。CLSM的結果與AFM參考值存在顯著差異,表明薄膜去除對測量結果有強烈影響。
AFM、WSI和CLSM對兩個混合鍵合樣品進行了測量和分析。AFM記錄的樣品#1和樣品#2的高度分別為100 nm和7 nm。WSI測量的樣品#1和樣品#2的高度分別為128.1 nm和334.2 nm,而CLSM的結果分別為132.5 nm和128.1 nm。CLSM的結果與AFM參考值存在顯著差異,表明薄膜去除對測量結果有強烈影響。
#Photonixbay.04
測量方法重復性評估
測量方法重復性評估(20次連續測量) WSI在20次連續測量中表現出顯著的穩定性,標準差分別為0.97 nm和0.79 nm。CLSM的重復性較差,樣品#1和樣品#2的標準差分別為9.15 nm和13.07 nm。Allan偏差分析顯示,WSI系統在32次平均測量后對非平穩噪聲的影響較小,噪聲幅度為0.34 nm。
WSI在20次連續測量中表現出顯著的穩定性,標準差分別為0.97 nm和0.79 nm。CLSM的重復性較差,樣品#1和樣品#2的標準差分別為9.15 nm和13.07 nm。Allan偏差分析顯示,WSI系統在32次平均測量后對非平穩噪聲的影響較小,噪聲幅度為0.34 nm。
#Photonixbay.05
相位變化效應的理論與補償
 WSI在20×放大倍率下(a) 樣品#1的100次連續測量結果及艾倫偏差;(b) 樣品#2的100次連續測量結果及艾倫偏差
WSI在20×放大倍率下(a) 樣品#1的100次連續測量結果及艾倫偏差;(b) 樣品#2的100次連續測量結果及艾倫偏差
通過FDTD模擬分析了WSI測量中的復雜相位變化行為,并進行了補償。補償后,樣品#1的高度誤差從28.1 nm降低到0.52 nm,接近AFM測量結果。本文評估了WSI和CLSM作為非接觸方法在混合鍵合樣品表面輪廓測量中的技術優勢。結果表明,WSI在精度和重復性方面表現出色,經過相位變化效應補償后,測量精度顯著提高。基于這些理論和模擬,驗證了光學計量方法的普遍性和亞納米級精度。
-
半導體封裝
+關注
關注
4文章
324瀏覽量
15264 -
測量
+關注
關注
10文章
5682瀏覽量
116902 -
干涉儀
+關注
關注
0文章
149瀏覽量
10758
發布評論請先 登錄
混合鍵合在先進封裝領域取得進展
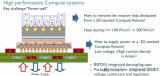



 白光掃描干涉法在先進半導體封裝混合鍵合表面測量中的應用研究
白光掃描干涉法在先進半導體封裝混合鍵合表面測量中的應用研究












評論