【博主簡介】本人“愛在七夕時”,系一名半導體行業質量管理從業者,旨在業余時間不定期的分享半導體行業中的:產品質量、失效分析、可靠性分析和產品基礎應用等相關知識。常言:真知不問出處,所分享的內容如有雷同或是不當之處,還請大家海涵。當前在各網絡平臺上均以此昵稱為ID跟大家一起交流學習!

相信一聊到HBM DRAM(高帶寬內存)和3D Stacked Memory(3D堆疊內存),大家都會有同樣一個疑問:它們之間有什么關系?為什么很多的時候這兩者會同時出現?......其實,具體來講:HBM是3D Stacked的核心技術分支與典型代表,二者是“具體技術實例”與“廣義技術類別”的關系——HBM是3D Stacked技術在高性能計算場景下的核心落地形態,而3D Stacked是HBM實現性能突破的關鍵技術基礎。
簡言之:3D Stacked Memory是“技術方法”,而HBM是“用這種方法解決特定問題的產品”。
同時,HBM也是3D Stacked Memory在高性能計算場景下的具體實現,其3D堆疊架構解決了傳統內存的“帶寬瓶頸”與“功耗問題”,是AI、HPC等前沿領域的核心支撐技術。未來隨著HBM3D、定制化HBM的發展,其在存儲產業的地位將進一步提升。
關于HBM的部分,我曾在之前的章節中有詳細介紹過,這里就不過多贅述了,有興趣的朋友可以一起探討。所以,本章節想要跟大家分享的還是HBM DRAM(高帶寬內存)和3D Stacked Memory(3D堆疊內存)技術相關的內容。
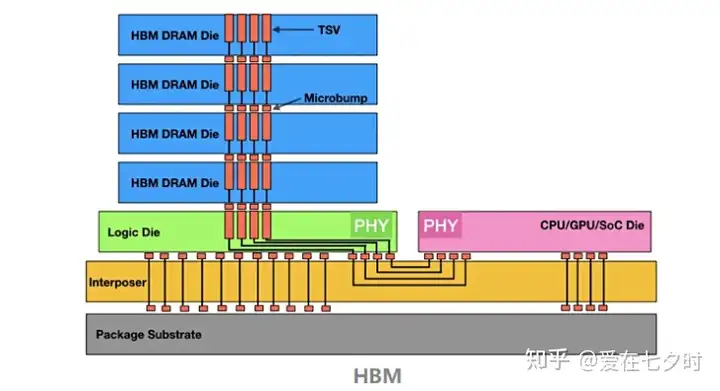
一、HBM DRAM和3D Stacked Memory技術的簡介
1、HBM DRAM(高帶寬內存)
以下是關于HBM技術詳解介紹:
半導體“高帶寬內存(HBM)”芯片技術的詳解;
2、3D Stacked Memory(3D堆疊內存)
3D堆疊內存,英文全稱:3D Stacked Memory,3D堆疊內存芯片則是通過3D封裝技術,將多層DRAM堆疊而成的新型內存。3D堆疊內存芯片能提供很大的內存容量和內存帶寬,其中混合內存立方體(Hybrid Memory Cube)和高帶寬內存(High Bandwidth Memory)是兩種新型的3D堆疊內存技術。利用3D堆疊內存,可以進行許多PIM設計,比如改變整個系統,或者實現簡單的功能卸載,主要思想是將某種形式的處理邏輯(通常是加速器、簡單內核或可重構邏輯)放在3D堆疊內存的邏輯層中。取決于體系結構的設計,這個PM處理邏輯(PIM核心或PIM引擎)可以執行應用程序的一部分(從單個指令到函數)或整個線程和應用程序。本節將討論利用3D堆疊內存的PM在圖處理、移動設備、圖形處理單元上的使用。
說白了,3D DRAM就是一種通過堆疊多個存儲層和使用垂直互聯技術來增加存儲密度和性能的先進DRAM的技術。3D DRAM能夠提供更高的存儲密度、更低的功耗和更高的帶寬,適用于高性能計算、數據中心和AI等應用場景。
(1)3D DRAM的結構
3D DRAM與傳統的2D DRAM相比,采用了垂直堆疊的結構。傳統的2D DRAM將存儲單元橫向排布在單個硅基晶圓平面上,而3D DRAM通過將多個存儲層垂直堆疊在一起,以形成更高的存儲密度。
a.堆疊結構
3D DRAM的結構由多個DRAM層組成,每一層都包含大量的存儲單元。每一層中的存儲單元按照行和列的方式排列,類似于傳統DRAM的平面排列方式。
b.垂直互聯(Through-Silicon Via, TSV)
垂直互聯技術在3D DRAM中至關重要,它通過在晶圓中穿孔并填充導電材料來連接不同的存儲層。TSV技術可以顯著減少信號傳輸路徑,降低延遲并提高數據傳輸速率。
(2)3D DRAM的制程技術
3D DRAM的制程技術比2D DRAM更復雜,涉及到多層堆疊、熱處理、垂直互聯的形成和各層之間的電氣隔離。
a.晶圓級堆疊
3D DRAM制造過程中,首先在多個晶圓上分別制造出DRAM存儲單元,然后通過晶圓粘合技術將這些晶圓堆疊在一起。
b.TSV制造和填充
通過刻蝕和化學機械拋光(CMP)工藝,形成垂直穿孔,隨后在這些孔中填充銅或鎢等導電材料以形成垂直互連。
c.熱處理和電氣隔離
由于多個晶圓堆疊在一起,熱處理工藝和電氣隔離至關重要。需要確保各層之間的熱應力和電荷干擾被最小化。
(3)3D DRAM的優勢
3D DRAM相較于傳統的2D DRAM,具有許多顯著的技術優勢:
a.更高的存儲密度
由于采用垂直堆疊結構,3D DRAM可以在相同的平面面積上容納更多的存儲單元,從而顯著提高存儲密度。
b.更低的功耗
3D DRAM通過縮短信號傳輸路徑,降低了數據訪問的延遲和能量損耗,能夠在較低的工作電壓下實現更高的性能。
c.更高的帶寬和更快的速度
由于TSV技術的應用,層與層之間的數據傳輸速度更快,帶寬也更高,從而可以更好地支持高性能計算和數據中心應用。
所以,未來,隨著制程技術的進一步提升和對更高性能的需求增加,3D DRAM將繼續朝著更高層數堆疊、更小的制程節點和更低功耗的方向發展。可能會引入新的材料和結構,如垂直晶體管技術(如Gate-All-Around FETs)以及更先進的封裝方式(如Chiplet封裝),以進一步提升3D DRAM的性能和應用廣度。

二、HBM DRAM和3D Stacked Memory技術之間的關系
因為HBM與3D Stacked Memory是“具體技術實例”與“廣義技術類別”的關系,所以想要講清楚這兩者之間的具體關系,得從以下三個方面說起:
1、HBM是3D Stacked Memory的核心技術與典型應用
3D堆疊內存是通過垂直堆疊多層存儲芯片實現高帶寬、大容量的廣義內存技術類別;而HBM是其中專為AI、高性能計算(HPC)等超高性能場景優化的技術實例。
根據搜索結果,HBM的定義明確指向“3D堆疊DRAM”:它是將多個DRAM芯片(Core Die)通過**硅通孔(TSV)與微凸點(Microbump)**垂直堆疊,并與底層邏輯芯片(Base Die)封裝在一起,形成“處理器-內存”緊耦合架構的新型內存。例如,HBM3E單封裝容量可達24GB,帶寬高達8Gbps/Pin,正是依托3D堆疊技術突破了傳統內存的帶寬瓶頸。
2、3D Stacked是HBM突破性能瓶頸的關鍵技術基礎
HBM的核心優勢(超高帶寬、低功耗、小尺寸)完全依賴3D堆疊技術實現:
a.縮短數據傳輸距離
通過垂直堆疊DRAM芯片,數據無需在平面上長距離傳輸,而是“抄近道”在層間傳遞,大幅降低延遲;
b.提升位寬與帶寬
HBM采用超寬I/O總線(如1024位、2048位),遠高于傳統GDDR5的32位,結合多層堆疊,帶寬可達傳統內存的5-10倍;
c.降低功耗
短距離傳輸與高帶寬特性,使HBM每瓦帶寬比GDDR5高3倍以上,解決了高性能計算的“功耗墻”問題。
3、HBM與其他3D Stacked Memory的差異與定位
3D Stacked Memory是一個廣義范疇,HBM與其他3D Stacked技術(如NAND、3D DRAM)的核心區別在于技術路徑與應用場景:
a.與偽3D堆疊(如NAND)的區別
NAND是“多顆Die獨立連接基板”的偽3D堆疊,層數受限(≤8層)、成本較低,用于SSD等長期存儲;而HBM是“多層Die通過TSV互連邏輯Die”的真3D堆疊,專注高性能緩存;
b.與3D DRAM的區別
3D DRAM側重“存儲單元的垂直化”(如三星的VS-CAT DRAM),是單元結構層面的創新;而HBM是“封裝級的DRAM堆疊”,強調與處理器的緊耦合,兩者形成互補。

三、HBM DRAM和3D Stacked Memory技術詳解
以下內容就是本章節要跟大家分享的重點,希望有興趣的朋友可以一起交流學習,具體分享內容如下:


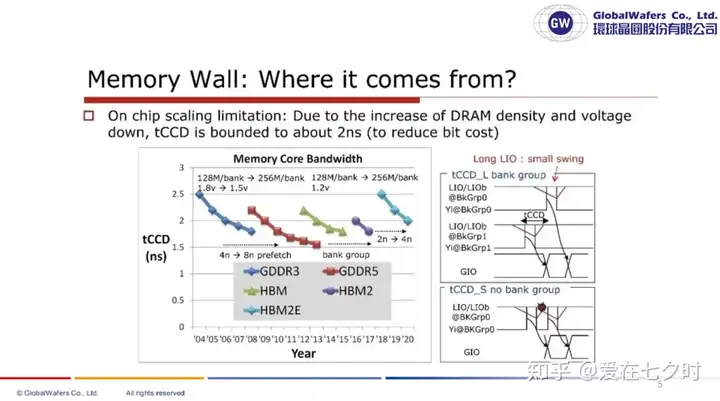
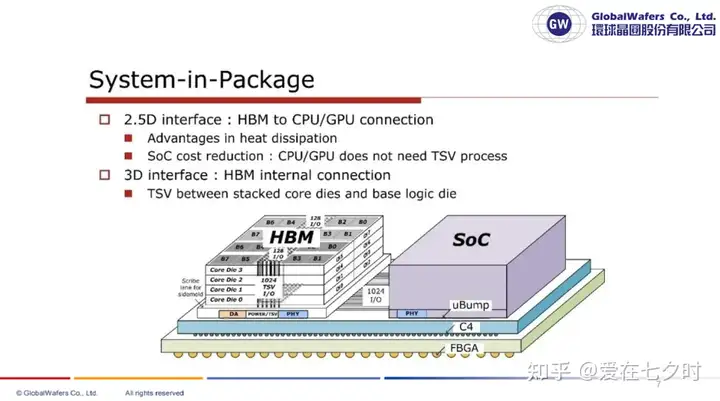
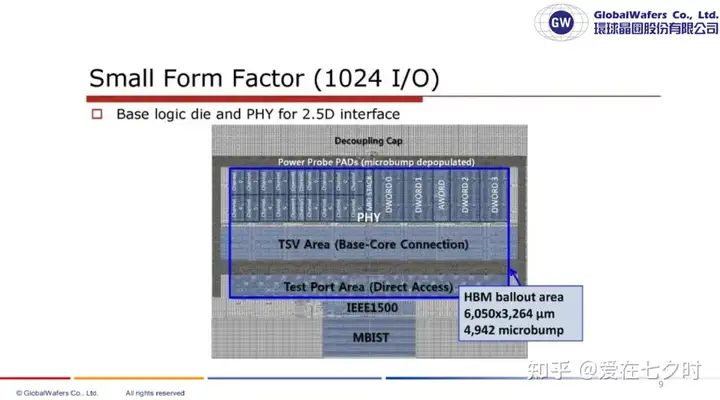


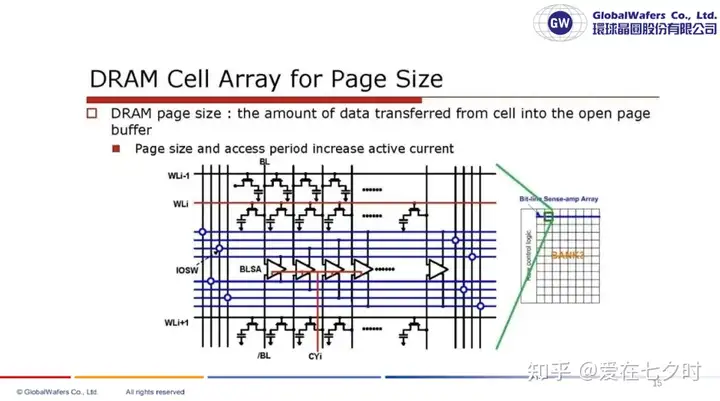






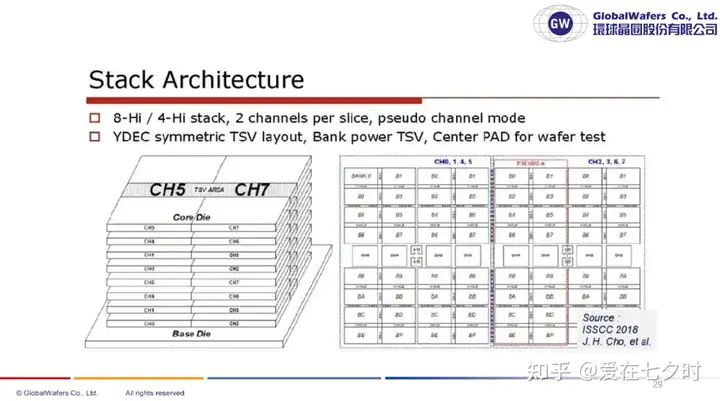











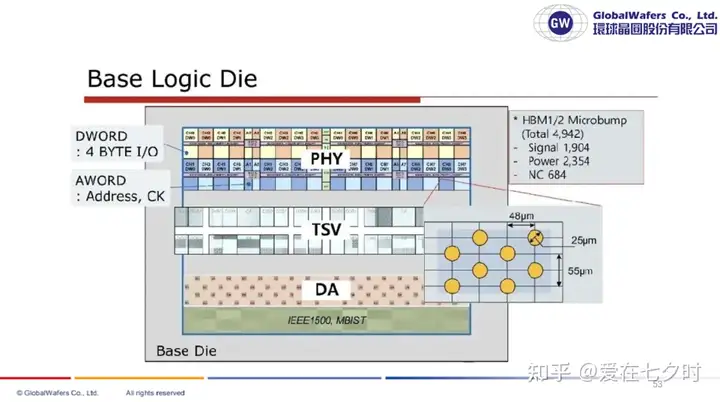

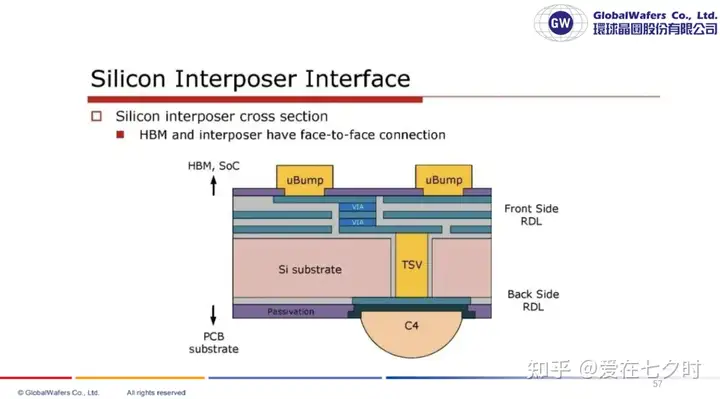



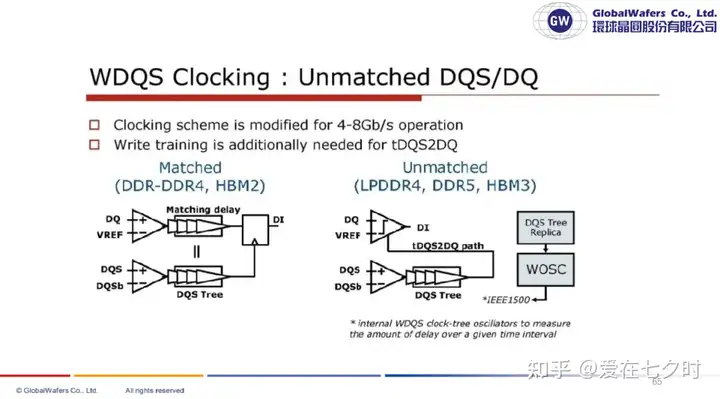
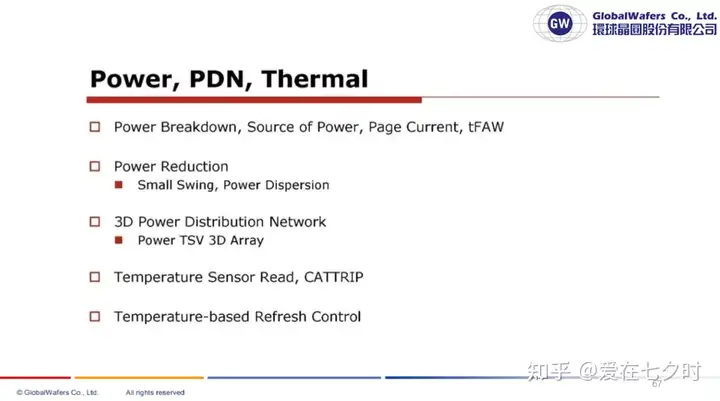
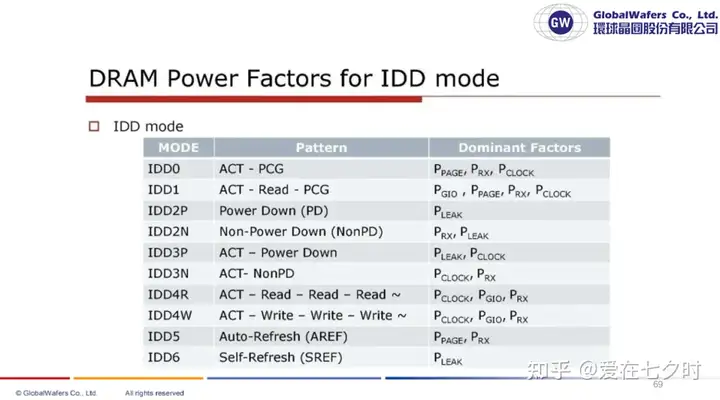
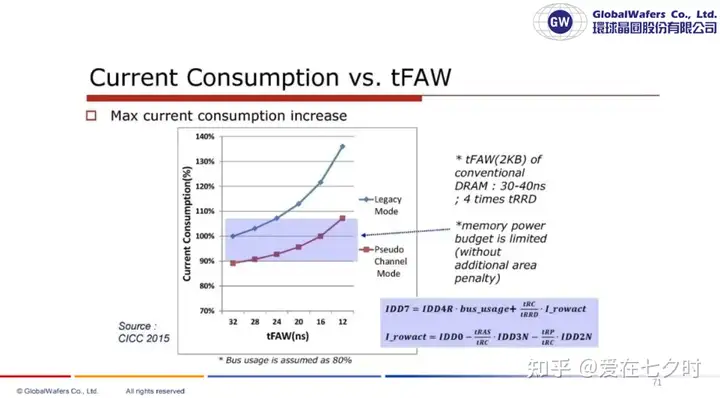
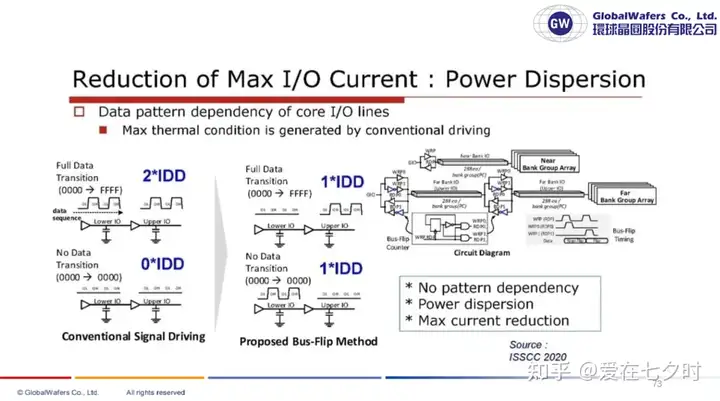


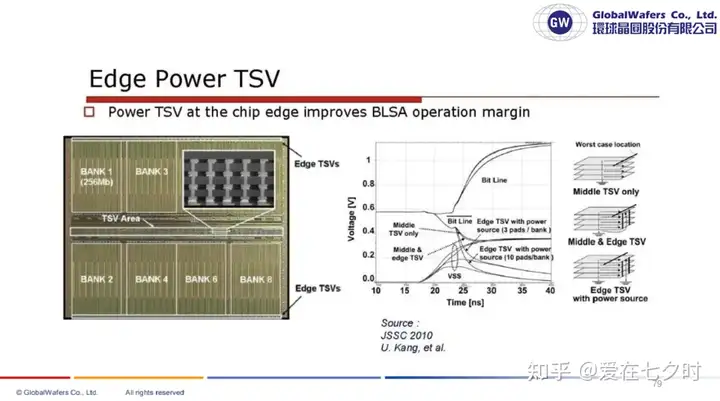


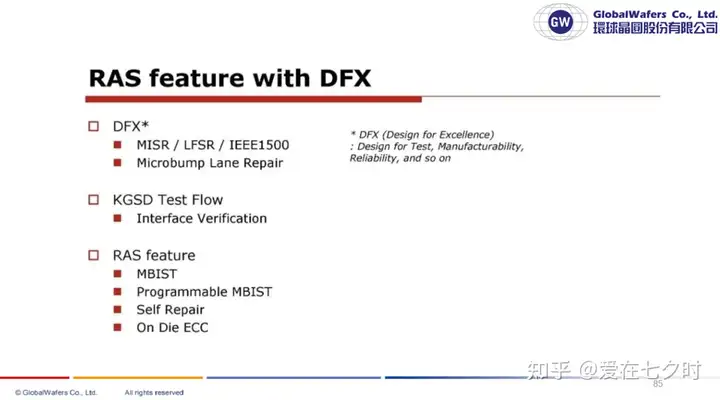



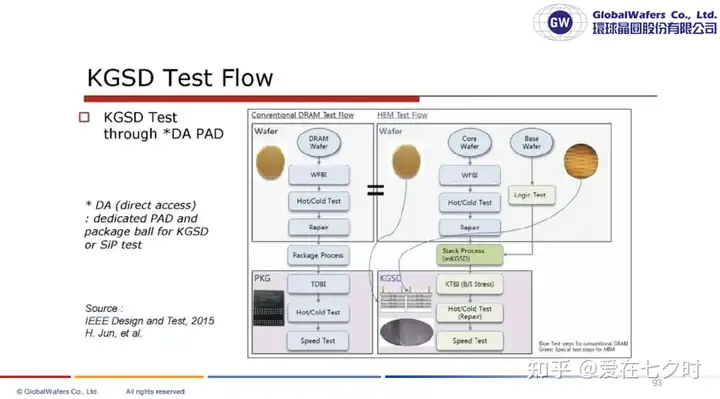


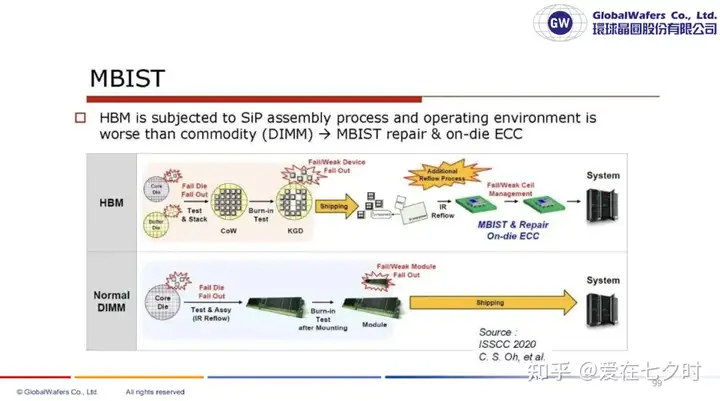



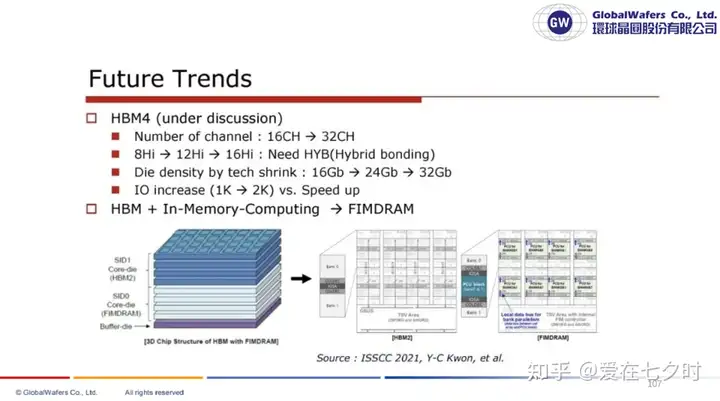


因為本PPT章節太多,剩下部分如有朋友有需要,可私信我邀請您加入我“知識星球”免費下載PDF版本。注意:此資料只可供自己學習,不可傳閱,平臺有下載記錄,切記!歡迎加入后一起交流學習。

四、HBM DRAM和3D Stacked Memory技術的應用
高帶寬內存(HBM)作為3D堆疊內存的核心落地形態,與廣義的3D堆疊內存(如3D DRAM、3D數字內存內計算(3DIMC))的應用場景高度重疊,均聚焦于高帶寬、低功耗、高算力需求的領域。所以結合具體技術與產品,分場景說明兩者的應用情況如下:
AI模型(尤其是大型語言模型LLM、深度神經網絡)對內存帶寬與容量的需求呈指數級增長,HBM與3D堆疊內存成為突破“內存墻”的關鍵:
a.HBM的當前主流應用
HBM已成為AI GPU/TPU的“標配”,用于解決模型訓練與推理中的數據搬運瓶頸。例如:
英偉達H100 GPU搭載HBM,帶寬高達3TB/s,支撐大模型訓練的高吞吐量需求;
AMD MI300 GPU集成HBM,用于生成式AI與高性能計算,性能較上一代提升數倍;
超級計算機如富士通A64FX,通過HBM實現高速數據交互,支撐氣候模擬等復雜計算。
b.3D堆疊內存的未來潛力
針對LLM的大容量、低延遲需求,單片3D堆疊DRAM與3DIMC成為下一代解決方案:
單片3D堆疊DRAM:通過垂直位線(VBL)/字線(VWL)設計與異質集成,其加速器推理吞吐量可達NVIDIA H100的15倍,能效高55倍;
d-Matrix的3DIMC技術:將內存與計算深度集成,宣稱AI推理速度比HBM快10倍、能耗降低90%,直接挑戰HBM在AI推理中的地位。
2、高性能計算(HPC):提升系統算力密度
HPC場景(如科學計算、數據分析)需要處理海量數據,HBM與3D堆疊內存通過縮短數據傳輸路徑提升系統效率:
a.HBM的應用
HBM常與高性能CPU/GPU結合,用于超級計算機的互連與存儲。例如,日本理化學研究所(RIKEN)的Fugaku超級計算機,通過HBM實現節點間的高速數據傳輸,峰值性能達442 PFlops。
b.3D堆疊內存的補充
3D堆疊技術可提升存儲密度,減少HPC系統的占地面積。例如,3D NAND閃存的堆疊架構已被用于HPC的輔助存儲,未來或擴展至主存領域。
3、圖形處理與消費電子:提升視覺體驗
HBM的高帶寬特性使其成為高端圖形處理的理想選擇,支撐高幀率游戲、4K/8K渲染等場景:
a.HBM的應用
高端顯卡(如英偉達RTX 40系列、AMD Radeon 7000系列)搭載HBM2e/HBM,提升圖形數據的傳輸速度,使游戲最低幀數較前一代提升25%以上。
b.3D堆疊內存的延伸
3D堆疊技術可用于消費級設備的存儲與計算集成,例如將3D DRAM與圖像處理器(ISP)結合,提升手機的圖像處理速度與AI運算能力。
4、細分領域:傳感器與專用芯片
3D堆疊內存的非易失性、高集成度特性,還被用于專用傳感器芯片:
SPAD(單光子雪崩二極管)芯片:通過3D堆疊技術(如晶圓級混合鍵合),將像素陣列與邏輯電路垂直集成,提升光子探測效率(PDE)并降低暗計數率(DCR),用于自動駕駛的激光雷達、醫療成像等領域。
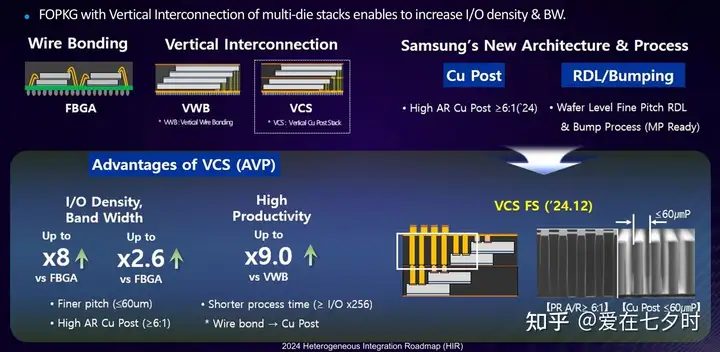
五、總結一下
說實話,要做HBM DRAM和3D Stacked Memory技術的總結還是挺難的,因為兩者的關系比較特殊,在其終端的應用場景里,既有共性,也有差異,所以只能簡單地分開總結吧:
1、共性方面
兩者均聚焦于高帶寬、低功耗需求,核心是解決“數據搬運慢、能耗高”的問題;
2、差異方面
HBM是當前AI/HPC的主流解決方案,強調“成熟量產”;3D堆疊內存(如3D DRAM、3DIMC)是未來方向,側重“更高密度、更低延遲”,尤其在LLM與AI推理中潛力巨大。
隨著AI模型的持續增大與算力需求的爆發,HBM與3D堆疊內存的應用將向更廣泛的消費電子、邊緣計算等領域滲透,成為未來計算系統的“內存基石”。
簡而言之:HBM是3D堆疊內存的“現在時”,其他3D堆疊技術是“未來時”——兩者協同推動內存性能邊界,最終服務于不同場景的計算需求。

免責聲明
【我們尊重原創,也注重分享。文中的文字、圖片版權歸原作者所有,轉載目的在于分享更多信息,不代表本號立場,如有侵犯您的權益請及時私信聯系,我們將第一時間跟蹤核實并作處理,謝謝!】
-
半導體
+關注
關注
339文章
30800瀏覽量
264693 -
3D
+關注
關注
9文章
3013瀏覽量
115173 -
HBM
+關注
關注
2文章
431瀏覽量
15845
發布評論請先 登錄
AR0237IR圖像傳感器推動3D成像技術的發展
半導體制程邁入3D 2013年為量產元年
3D工藝成為半導體微細加工技術必然趨勢
半導體制冷的巧克力3D打印成型
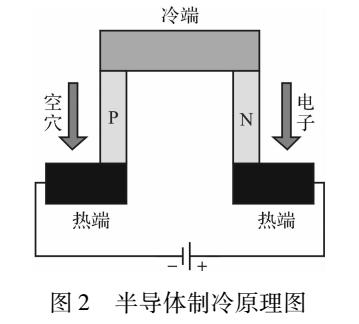
3D SiC技術閃耀全場,基本半導體參展PCIM Asia引關注
半導體2.5D/3D封裝技術:趨勢和創新
SuperView W3光學3D表面輪廓儀助力半導體智能制造




 半導體“HBM和3D Stacked Memory”技術的詳解
半導體“HBM和3D Stacked Memory”技術的詳解







評論