電子發燒友網綜合報道 頂部散熱(TSC)封裝在今年受到市場歡迎,在年中的上海慕尼黑展上我們注意到多家廠商推出了TSC封裝產品,并提到這些產品目前市場需求量較大,尤其是在汽車OBC等應用中。
近期,Wolfspeed 面向汽車和工業市場發布商業化量產的頂部散熱U2封裝器件,來擴展系統設計選項。U2封裝可作為對其他供應商生產的 MOSFET 的直接替代,為客戶成熟的設計提供了采購靈活性,并改善了封裝爬電距離,以支持 650 V 至 1200 V 系統的設計。符合車規級 AEC-Q101 標準的 1200 V 器件即將發布,涵蓋 16 mΩ 至 160 mΩ 范圍。工規器件可作為預生產或生產就緒樣品提供。
根據wolfspeed介紹,傳統上,大多數標準的表面貼裝分立功率半導體器件通過與PCB接接觸,從器件底部散熱,PCB下方附有散熱器或冷卻板。這種方法在許多不同的電力電子應用中都很常見,特別是在 PCB安裝和散熱器設計不受到系統尺寸和重量嚴格限制的應用場合。
另一方面,TSC器件通過封裝的上表面散熱。在頂部散熱TSC封裝內部,芯片直接焊接在頂部漏極銅框架上,芯片通過封裝上表面導熱到上方的散熱器。相對于傳統底部散熱封裝,TSC封裝可以實現更大的耗散功率和更優的散熱性能,助力客戶從容應對系統熱設計要求。頂部散熱設計還允許雙面使用 PCB,因為 PCB 下表面不再需要用于散熱器貼裝。
安森美此前的實測顯示,如果使用具有底面裸露焊盤的MOSFET,同時使用經過熱優化的PCB進行導熱和散熱,則散熱片無論是安裝 PCB的底面還是MOSFET的頂面,MOSFET溫度之間的差異僅為不到3°C。
這意味著MOSFET溫度取決于散熱片尺寸。在20.0A負載電流下,與沒有任何散熱片的設置相比,使用60mm散熱片的MOSFET溫度大約低30°C。
與沒有任何散熱片的設置相比,使用25mm散熱片時,MOSFET的溫度大約降低15至20°C;使用10mm散熱片時,MOSFET的溫度比沒有任何散熱片的設置低10°C。
該溫度變化與三個散熱片的熱阻成正比。它還表明,如果使用熱優化的PCB布局,散熱片需要一定的質量和導熱性才能顯著降低溫度。
而具有頂面裸露焊盤和散熱片的MOSFET可實現與底面裸露焊盤安裝在經過熱優化的PCB上且散熱片位于封裝頂面的MOSFET類似的熱性能。如果要盡量減少流入PCB的熱量,則帶有頂面裸露焊盤的MOSFET是正確的選擇,因為它們對安裝在封裝頂面的散熱片具有最小的熱阻。
目前Wolfspeed也推出了基于Wolfspeed第四代 (Gen 4) 芯片技術的頂部散熱器件的樣品,工程師可進行申請。第四代 (Gen 4) MOSFET 在全溫度范圍內具備業界領先的開關性能,并具有寬 Vgs兼容性,允許 +18 V 和 -0 V 門極驅動。第四代 (Gen 4) 技術還具有體二極管軟恢復特性,可在關斷時刻產生更低的 Vds 峰值——這使得 Wolfspeed 第四代 (Gen 4) MOSFET 能應對更嚴酷工況并且具有更低的 FIT 失效率。
除了wolfspeed之外,其他功率器件廠商也已經推出了相關封裝技術和產品。包括英飛凌DDPAK和QDPAK封裝的SiC器件;瞻芯電子推出的TC3Pak封裝1200V SiC MOSFET;威世PowerPAK封裝產品;英諾賽科的Dual-Cool En-FCLGA封裝;派恩杰 T7 系列SiC MOSFET器件;安森美推出的頂部散熱封裝TCPAK57;華潤微推出的QDPAK&TOLT頂部散熱封裝等。
小結:
隨著汽車、工業等領域的需求不斷提高,頂部散熱封裝得益于其優異的散熱性能以及支持更高的器件功率密度,正在在汽車、工業領域迅速滲透,并持續擴展到更多的應用場景。
近期,Wolfspeed 面向汽車和工業市場發布商業化量產的頂部散熱U2封裝器件,來擴展系統設計選項。U2封裝可作為對其他供應商生產的 MOSFET 的直接替代,為客戶成熟的設計提供了采購靈活性,并改善了封裝爬電距離,以支持 650 V 至 1200 V 系統的設計。符合車規級 AEC-Q101 標準的 1200 V 器件即將發布,涵蓋 16 mΩ 至 160 mΩ 范圍。工規器件可作為預生產或生產就緒樣品提供。
根據wolfspeed介紹,傳統上,大多數標準的表面貼裝分立功率半導體器件通過與PCB接接觸,從器件底部散熱,PCB下方附有散熱器或冷卻板。這種方法在許多不同的電力電子應用中都很常見,特別是在 PCB安裝和散熱器設計不受到系統尺寸和重量嚴格限制的應用場合。
另一方面,TSC器件通過封裝的上表面散熱。在頂部散熱TSC封裝內部,芯片直接焊接在頂部漏極銅框架上,芯片通過封裝上表面導熱到上方的散熱器。相對于傳統底部散熱封裝,TSC封裝可以實現更大的耗散功率和更優的散熱性能,助力客戶從容應對系統熱設計要求。頂部散熱設計還允許雙面使用 PCB,因為 PCB 下表面不再需要用于散熱器貼裝。
安森美此前的實測顯示,如果使用具有底面裸露焊盤的MOSFET,同時使用經過熱優化的PCB進行導熱和散熱,則散熱片無論是安裝 PCB的底面還是MOSFET的頂面,MOSFET溫度之間的差異僅為不到3°C。
這意味著MOSFET溫度取決于散熱片尺寸。在20.0A負載電流下,與沒有任何散熱片的設置相比,使用60mm散熱片的MOSFET溫度大約低30°C。
與沒有任何散熱片的設置相比,使用25mm散熱片時,MOSFET的溫度大約降低15至20°C;使用10mm散熱片時,MOSFET的溫度比沒有任何散熱片的設置低10°C。
該溫度變化與三個散熱片的熱阻成正比。它還表明,如果使用熱優化的PCB布局,散熱片需要一定的質量和導熱性才能顯著降低溫度。
而具有頂面裸露焊盤和散熱片的MOSFET可實現與底面裸露焊盤安裝在經過熱優化的PCB上且散熱片位于封裝頂面的MOSFET類似的熱性能。如果要盡量減少流入PCB的熱量,則帶有頂面裸露焊盤的MOSFET是正確的選擇,因為它們對安裝在封裝頂面的散熱片具有最小的熱阻。
目前Wolfspeed也推出了基于Wolfspeed第四代 (Gen 4) 芯片技術的頂部散熱器件的樣品,工程師可進行申請。第四代 (Gen 4) MOSFET 在全溫度范圍內具備業界領先的開關性能,并具有寬 Vgs兼容性,允許 +18 V 和 -0 V 門極驅動。第四代 (Gen 4) 技術還具有體二極管軟恢復特性,可在關斷時刻產生更低的 Vds 峰值——這使得 Wolfspeed 第四代 (Gen 4) MOSFET 能應對更嚴酷工況并且具有更低的 FIT 失效率。
除了wolfspeed之外,其他功率器件廠商也已經推出了相關封裝技術和產品。包括英飛凌DDPAK和QDPAK封裝的SiC器件;瞻芯電子推出的TC3Pak封裝1200V SiC MOSFET;威世PowerPAK封裝產品;英諾賽科的Dual-Cool En-FCLGA封裝;派恩杰 T7 系列SiC MOSFET器件;安森美推出的頂部散熱封裝TCPAK57;華潤微推出的QDPAK&TOLT頂部散熱封裝等。
小結:
隨著汽車、工業等領域的需求不斷提高,頂部散熱封裝得益于其優異的散熱性能以及支持更高的器件功率密度,正在在汽車、工業領域迅速滲透,并持續擴展到更多的應用場景。
聲明:本文內容及配圖由入駐作者撰寫或者入駐合作網站授權轉載。文章觀點僅代表作者本人,不代表電子發燒友網立場。文章及其配圖僅供工程師學習之用,如有內容侵權或者其他違規問題,請聯系本站處理。
舉報投訴
-
封裝
+關注
關注
128文章
9248瀏覽量
148605 -
TSC
+關注
關注
0文章
40瀏覽量
26607
發布評論請先 登錄
相關推薦
熱點推薦
TSC427雙功率 MOSFET 驅動芯片詳解
MAX626/7/8 - TSC426/7/8 雙功率 MOSFET 驅動芯片詳解 在電子工程師的日常設計中,功率 MOSFET 驅動芯片是一個常見且關鍵的元件。今天我們就來詳細聊聊 Maxim
TSC426雙功率MOSFET驅動器
深入解析MAX626/7/8 - TSC426/7/8雙功率MOSFET驅動器 引言 在電子工程師的日常設計工作中,MOSFET驅動器是至關重要的元件,它能有效控制功率MOSFET的開關動作。今天
TSC428雙功率 MOSFET 驅動器:設計與應用解析
MAX626/7/8 - TSC426/7/8 雙功率 MOSFET 驅動器:設計與應用解析 在電子設計的領域中,功率 MOSFET 驅動器是至關重要的組件,它能將低電平的控制信號轉換為高電壓
TSC2200:PDA模擬接口電路的全面解析
TSC2200:PDA模擬接口電路的全面解析 在電子設備的設計中,模擬接口電路起著至關重要的作用,它能實現模擬信號與數字信號的轉換和處理。今天我們要深入探討的是德州儀器(Texas
淺析助焊劑在功率器件封裝焊接中的應用匹配要求
本文聚焦助焊劑在功率器件封裝焊接中的應用環節與匹配要求,其核心作用為清除氧化層、降低焊料表面張力、保護焊點。應用環節覆蓋焊接前預處理、焊接中成型潤濕、焊接后防護。不同功率

江西薩瑞微電子P6SMFTHE系列產品深度解析:小封裝承載大能量的功率器件
在電子設備小型化與高功率密度需求日益凸顯的今天,功率器件的封裝與性能平衡成為行業技術突破的核心痛點。江西薩瑞微電子作為國內領先的功率半導體I

STMicroelectronics TSC1641高精度功率監控器技術解析
的I^2^C/SMbus到12.5MHz的MIPI I^3^C的數據速率,從而與各種STM32產品兼容。TSC1641支持在特定寄存器中配置電壓、電流、功率和溫度的警報閾值。該器件采用塑料DFN10
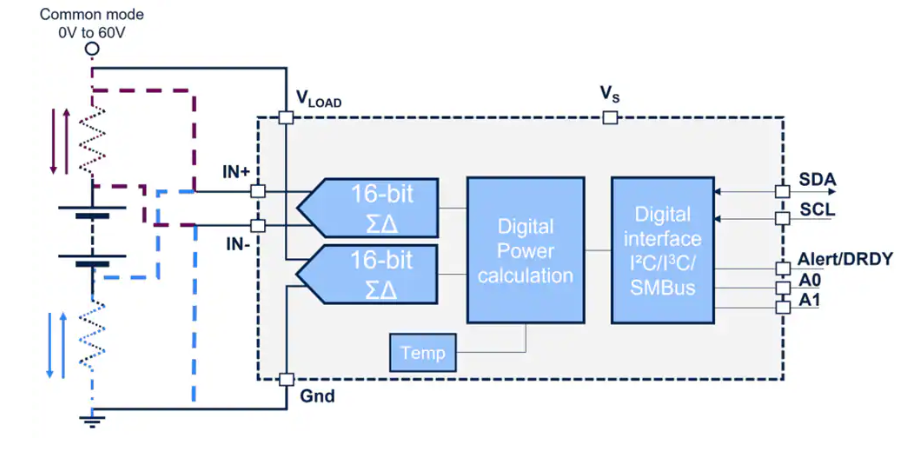
TSC1214功率監測器AFE技術解析:低側數字監控的創新設計
STMicroelectronics TSC1214功率監測器模擬前端(AFE)設計用于監測低壓電源。數字電流、電壓和溫度監測器TSC1214采用雙重監測路徑,通過14位ADC監測電流,通過11位ADC監測電壓或溫度。該AFE可
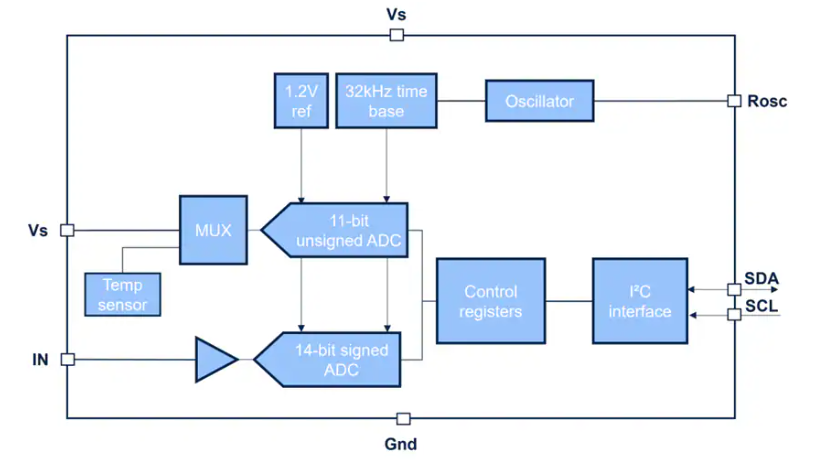
羅姆與英飛凌攜手推進SiC功率器件封裝兼容性,為客戶帶來更高靈活度
全球知名半導體制造商羅姆(總部位于日本京都市)宣布,與英飛凌科技股份公司(總部位于德國諾伊比貝格,以下簡稱“英飛凌”)就建立SiC功率器件封裝合作機制簽署了備忘錄。雙方旨在對應用于車載充電器、太陽能
芯片收縮對功率半導體器件封裝領域發展的影響
、0.3 mm極致封裝間距、200 W/cm2級三維散熱、混合鍵合與FOPLP量產落地,以及AI驅動的設計-檢測一體化,正共同重塑功率器件的可靠性邊界、集成密度與成本曲線。以上預示著一個由“尺寸微縮+異構集成+系統級優化”定義的
英飛凌推出采用Q-DPAK 封裝的CoolSiC? MOSFET 1200V G2,將工業應用功率密度提升至新高度
【2025年8月1日,德國慕尼黑訊】全球功率系統和物聯網領域的半導體領導者英飛凌科技股份公司(FSE代碼:IFX/OTCQX代碼:IFNNY)近日推出了采用頂部散熱(TSC)Q-DPAK封裝

功率器件測量系統參數明細
(Wafer Sort),剔除不良品,提升后端封裝良率。 功率器件研發與特性分析:全面表征器件靜態參數(IV特性:BVdss, Rds(on), Vth, Igss等)和動態參數研究
發表于 07-29 16:21
電源功率器件篇:線路寄生電感對開關器件的影響
、降低線路寄生電感影響的方案
1、優化PCB布局設計
▍縮短功率回路路徑
? 將功率開關器件、直流母線電容、驅動電路等盡可能靠近布局,減少功率回路的面積。
? 采用雙面布線的方式,在
發表于 07-02 11:22
功率器件電鍍的原理和步驟
在功率半導體制程里,電鍍扮演著舉足輕重的角色,從芯片前端制程到后端封裝,均離不開這一關鍵工序。目前,我國中高檔功率器件在晶圓背面金屬化方面存在技術短板,而攻克這些技術難題的關鍵在于電鍍




 TSC封裝:功率器件冰涼體驗
TSC封裝:功率器件冰涼體驗




評論