SiC碳化硅功率器件頂部散熱封裝:TOLT與QDPAK的結構優勢、熱電動力學分析及工程安裝指南
BASiC Semiconductor基本半導體一級代理商傾佳電子(Changer Tech)是一家專注于功率半導體和新能源汽車連接器的分銷商。主要服務于中國工業電源、電力電子設備和新能源汽車產業鏈。傾佳電子聚焦于新能源、交通電動化和數字化轉型三大方向,代理并力推BASiC基本半導體SiC碳化硅MOSFET單管,SiC碳化硅MOSFET功率模塊,SiC模塊驅動板等功率半導體器件以及新能源汽車連接器。?
傾佳電子楊茜致力于推動國產SiC碳化硅模塊在電力電子應用中全面取代進口IGBT模塊,助力電力電子行業自主可控和產業升級!
傾佳電子楊茜咬住SiC碳化硅MOSFET功率器件三個必然,勇立功率半導體器件變革潮頭:
傾佳電子楊茜咬住SiC碳化硅MOSFET模塊全面取代IGBT模塊和IPM模塊的必然趨勢!
傾佳電子楊茜咬住SiC碳化硅MOSFET單管全面取代IGBT單管和大于650V的高壓硅MOSFET的必然趨勢!
傾佳電子楊茜咬住650V SiC碳化硅MOSFET單管全面取代SJ超結MOSFET和高壓GaN 器件的必然趨勢!
1. 執行摘要
隨著以Hybrid inverter混合逆變器、戶儲、光伏儲能及大功率工業驅動為代表的電力電子系統向高頻、高壓、高功率密度方向演進,以碳化硅(SiC)為代表的寬禁帶半導體材料正逐步取代硅基器件。然而,SiC芯片卓越的材料特性——高擊穿場強、高飽和電子漂移速度及高熱導率——長期以來受限于傳統的封裝技術。傳統的通孔插裝器件(如TO-247)存在較大的寄生電感,限制了開關速度;而傳統的底部散熱表面貼裝器件(如D2PAK)則受限于PCB(印制電路板)的熱導率瓶頸,無法有效耗散高功率芯片產生的熱量。
傾佳電子楊茜旨在對兩項突破性的頂部散熱(Top-Side Cooling, TSC)封裝技術——TOLT (TO-Leaded Top-side cooled) 和 QDPAK (Quadruple DPAK) ——進行詳盡的工程分析。報告基于基本半導體(BASIC Semiconductor) 的最新產品數據(包括B3M025065B, AB3M025065CQ等)及行業權威技術文獻,深入探討這兩種封裝的內部物理結構、熱電耦合特性以及在實際工程應用中的安裝與制造工藝。
分析顯示,相比傳統封裝,TSC技術通過解耦熱路徑與電氣路徑,實現了結殼熱阻(RthJC?)降低約12.5%至50%的性能躍升,同時將寄生電感從10nH量級大幅降低至2nH以下。傾佳電子楊茜將為電力電子工程師提供從器件選型、PCB熱設計、焊盤布局(IPC標準)到散熱器機械裝配的全方位技術指南。
2. 功率電子封裝的熱-電瓶頸與頂部散熱范式轉移
2.1 傳統封裝的物理局限性分析
在深入TOLT和QDPAK之前,必須量化傳統封裝在SiC應用中的失效模式。
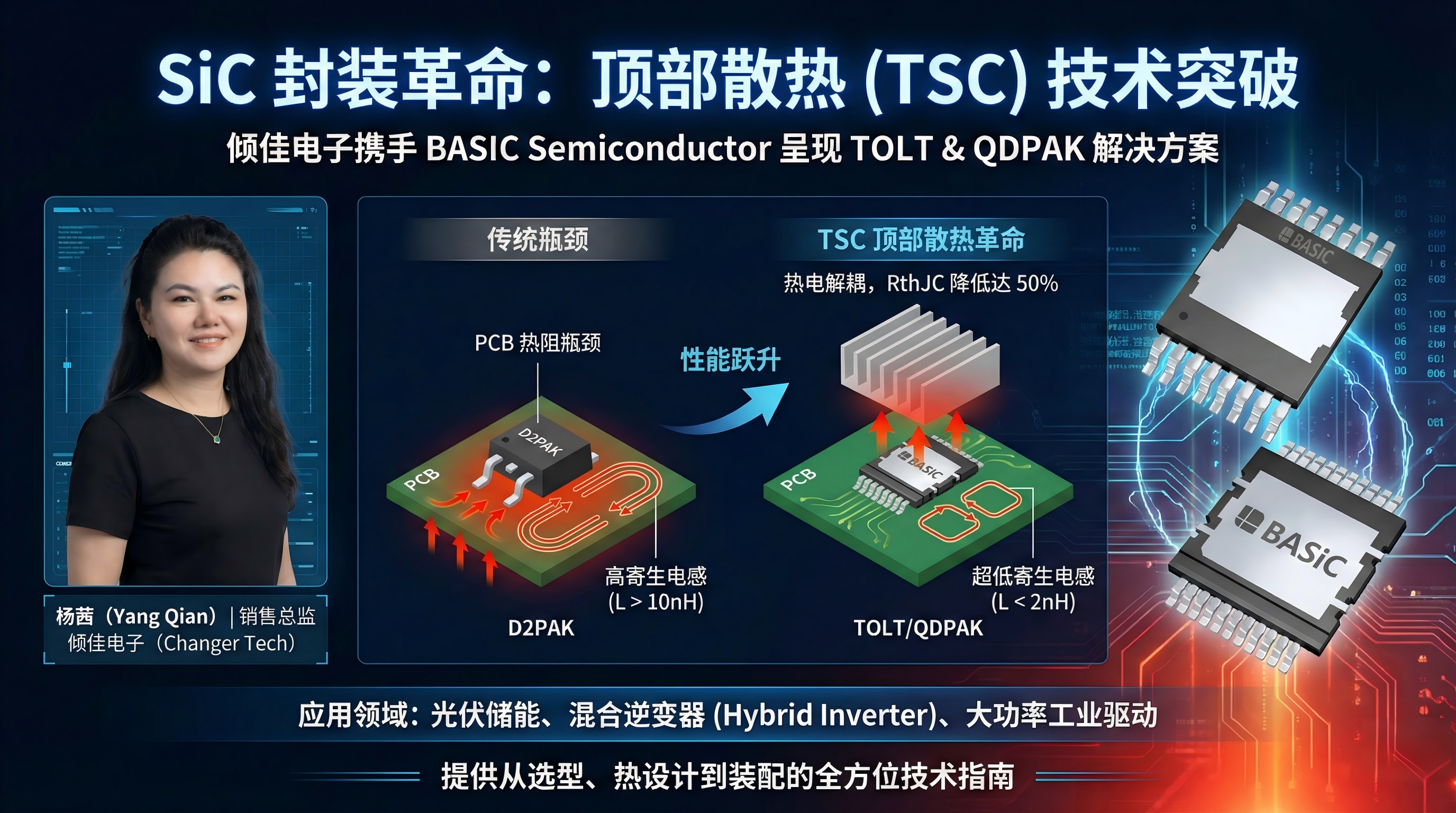
2.1.1 底部散熱(BSC)的熱阻墻
以D2PAK(TO-263)為代表的底部散熱SMD封裝,其散熱路徑為:芯片 → 焊料 → 銅引線框架 → 底部焊盤 → PCB銅箔 → FR4介質層/熱過孔 → 底部散熱器。 FR4材料的熱導率極低(約 0.25?0.35W/m?K),即便是采用金屬基電路板(IMS),其絕緣層的熱阻依然是主要瓶頸。研究表明,在典型應用中,PCB引入的熱阻可占系統總熱阻的30%-50% 。這意味著SiC芯片的高溫耐受能力被封裝散熱路徑的低效所浪費。
2.1.2 通孔插裝(THD)的電感懲罰
TO-247等通孔器件雖然通過直接貼合散熱器解決了熱問題,但其長引腳引入了巨大的寄生電感(Lstray?)。
在SiC MOSFET的高頻開關過程中(di/dt 可達數A/ns),寄生電感會導致嚴重的電壓過沖(Vovershoot?):
Vovershoot?=Lstray?×dtdi?
這不僅增加了開關損耗(Eon?,Eoff?),還可能導致柵極振蕩,甚至擊穿器件氧化層。此外,TO-247的裝配通常需要人工或異形插件機,且螺絲鎖緊工藝的一致性難以保證 。
2.2 頂部散熱(TSC)的物理架構重構
頂部散熱封裝(TOLT, QDPAK)通過翻轉芯片或引線框架結構,將散熱焊盤(Drain Pad)直接暴露在封裝頂部。這種架構帶來了三個維度的物理優勢:
熱路徑垂直化與解耦:熱量直接從芯片經由頂部銅排傳導至散熱器,完全繞過PCB。基本半導體的數據顯示,這種設計可使RthJC?降低至0.35 K/W ,遠低于同規格D2PAK。
電氣回路平面化:由于不再需要為散熱片留出物理空間或引腳長度,封裝可以緊貼PCB表面,極大縮短了功率回路(Power Loop)和柵極驅動回路(Gate Loop)的長度,從而將寄生電感降低至納亨(nH)級別 。
PCB空間利用率倍增:由于熱量不經過PCB,板子背面不再需要安裝散熱器,這使得雙面貼裝成為可能,或者可以在功率器件正下方布置柵極驅動電路,進一步壓縮回路面積 。
3. TOLT封裝技術深度解析
TOLT(TO-Leaded Top-side cooled)可以被視為TO-Leadless(TOLL)封裝的“倒置”版本,但其內部結構進行了專門的優化。

3.1 結構特征與機械動力學
3.1.1 鷗翼式引腳(Gull-wing Leads)與熱循環可靠性
TOLT封裝通常保留了類似SOIC的鷗翼式引腳設計。這種設計不僅是為了電氣連接,更是為了機械應力釋放。 在汽車級應用(-40°C 至 +175°C)的熱循環測試(TCoB)中,SiC芯片、銅引線框架、塑封料和FR4 PCB具有不同的熱膨脹系數(CTE)。剛性連接(如無引腳封裝)容易在焊點處產生巨大的剪切應力,導致焊點疲勞斷裂。 TOLT的鷗翼引腳充當了機械彈簧,能夠吸收部分應力。英飛凌和基本半導體的研究表明,這種結構使得TOLT在板級熱循環測試中能夠承受超過6000次循環而無電氣失效,遠超標準AEC-Q101要求 。
3.1.2 負對峙高度(Negative Standoff)的設計哲學
TOLT封裝常采用負對峙高度設計,即封裝體的底部略低于引腳的焊接平面(通常為-50μm左右)。
優勢:這種設計確保了在安裝散熱器施加壓力時,封裝體底部緊緊壓在PCB表面,消除了引腳高度公差對熱界面材料(TIM)厚度的影響。這使得整體熱阻的一致性極高 。
挑戰:由于封裝體緊貼PCB,焊劑殘留物的清洗變得困難。因此,TOLT工藝通常推薦使用免洗助焊劑 。
3.2 基本半導體TOLT產品性能剖析
依據上傳的BASiC-B3M025065B_Rev_0_0.pdf 和 BASiC-B3M040065B_Rev_0_0.pdf 數據手冊,我們可以深入量化TOLT的具體優勢。
3.2.1 極低的熱阻特性
對于型號 B3M025065B(650V SiC MOSFET):
結殼熱阻 (RthJC?) :僅為 0.40 K/W。
這一數值意味著在耗散100W功率時,結溫僅比殼溫高40°C。相比之下,傳統的TO-263封裝在依賴PCB散熱時,系統熱阻通常高達1.0 K/W以上。
連續漏極電流 (ID?) :達到 108 A (TC?=25°C)。對于一個緊湊的SMD封裝而言,這是極高的電流密度,直接得益于頂部高效的散熱路徑。
3.2.2 凱爾文源極(Kelvin Source)配置
基本半導體的TOLT封裝引腳定義如下:
Pin 1-6: 功率源極(Power Source)。
Pin 7: 凱爾文源極(Kelvin Source / Driver Source)。
Pin 8: 柵極(Gate)。
Pin 9-16 (Topside) : 漏極(Drain)。
技術分析:Pin 7的存在至關重要。在沒有凱爾文源極的封裝(如TO-220)中,源極電感 LS? 是公共支路。當di/dt發生劇變時,在LS?上產生的感應電壓 VLS?=LS?×di/dt 會直接疊加在柵極驅動電壓上,形成負反饋,減緩開關速度并增加損耗。TOLT通過將驅動回路的參考點(Pin 7)直接連接到芯片內部源極金屬化層,旁路了功率回路的LS?,從而實現了極快的開關速度( td(on)?=14ns )。
4. QDPAK封裝技術深度解析
QDPAK(Quadruple DPAK)是專為替代TO-247而生的大功率SMD封裝,屬于HDSOP(Heat-Spreader Dual Small Outline Package)家族。它代表了目前高壓SiC SMD封裝的最高水平。

4.1 結構特征與高壓絕緣設計
4.1.1 對稱布局與低電感
QDPAK通常采用對稱的引腳布局和內部結構。這種對稱性有助于抵消部分互感,進一步降低寄生參數。與TOLT相比,QDPAK通常采用更短的引腳或無引腳(Leadless)設計,極大地減少了傳導路徑上的電阻和電感 。
4.1.2 1200V高壓應用的爬電距離優化
對于1200V SiC器件(如基本半導體的 AB3M040120CQ),安規距離是SMD封裝面臨的巨大挑戰。 QDPAK通過特殊的塑封體設計,實現了**>4.8 mm**的爬電距離 。這使得它在無需額外灌封或涂覆的情況下,能夠滿足大多數800V電池系統或工業1000V系統的基本絕緣要求(具體取決于污染等級)。
4.1.3 正對峙高度(Positive Standoff)
與TOLT不同,QDPAK通常設計有正對峙高度(約150 μm)。
優勢:封裝體底部與PCB之間留有間隙。這不僅有利于焊后清洗,去除去助焊劑殘留,還允許在底部填充底部填充膠(Underfill)或紅膠以增強機械強度。
熱學影響:正對峙高度意味著在頂部施加壓力時,引腳會發生彈性形變。這種“浮動”安裝方式可以更好地適應散熱器的平面度誤差,但需要更仔細地控制熱界面材料(TIM)的厚度。
4.2 基本半導體QDPAK產品性能剖析
參考 BASiC-AB3M025065CQ_Rev_0_2.pdf 和 BASiC-AB3M040120CQ_Rev_0_0.pdf :
4.2.1 極致的熱性能
AB3M025065CQ (650V) : RthJC? 僅為 0.35 K/W。
對比分析:這比同電壓等級TOLT封裝的0.40 K/W低了12.5%。這表明QDPAK擁有更大的有效散熱面積或采用了更先進的芯片貼合技術(如銀燒結或擴散焊)。
電流能力:支持 115 A 的連續電流,略高于TOLT的108 A。
4.2.2 1200V高壓性能
AB3M040120CQ (1200V) : 即使在高耐壓下,RthJC? 也控制在 0.48 K/W。
開關能量:Etotal?(Eon?+Eoff?) 在800V總線電壓下表現優異。數據手冊顯示其專為車載充電機(OBC)和DC/DC轉換器優化,這些應用對效率和體積要求極高。
4.2.3 降低的開關損耗
由于極低的封裝電感(通常<2nH),QDPAK器件的關斷損耗(Eoff?)顯著降低。AB3M025065CQ的 Eoff? 僅為 135 μJ (配合SiC二極管),而同規格TOLT為 190 μJ。這意味著在相同頻率下,QDPAK的熱耗散更小,效率更高。
5. TOLT與QDPAK的綜合技術對比
為了幫助工程師進行選型,下表基于基本半導體數據及通用行業標準進行了詳細對比。
| 特性參數 | TOLT (e.g., B3M025065B) | QDPAK (e.g., AB3M025065CQ) | 優勢分析 |
|---|---|---|---|
| 結殼熱阻 (RthJC?) | 0.40 K/W | 0.35 K/W | QDPAK熱效率高12.5%,適合極致功率密度。 |
| 連續電流能力 (25°C) | 108 A | 115 A | QDPAK載流能力更強。 |
| 寄生電感 (Lstray?) | ~2 - 3 nH | < 2 nH | QDPAK回路更短,更適合>100kHz高頻開關。 |
| 開關損耗 (Etot?) | 570 μJ | 445 μJ | QDPAK損耗降低約22%,效率優勢明顯。 |
| 引腳結構 | 鷗翼形(Gull-wing) | 短引腳/無引腳 | TOLT應力釋放更好;QDPAK電氣性能更好。 |
| 對峙高度 (Standoff) | 通常為負(Negative) | 通常為正(Positive) | TOLT熱接觸一致性好;QDPAK易于清洗。 |
| PCB占用面積 | 較小 (類似TOLL) | 較大 (類似D2PAK-7或更大) | TOLT更節省PCB空間。 |
| 主要應用場景 | 工業驅動、改造設計、高可靠性要求 | 戶儲、高壓服務器電源 |
結論:QDPAK是追求極致性能的首選,特別是在1200V高壓和超大電流應用中;而TOLT則在機械可靠性和PCB空間受限的場景中表現出更好的平衡性,且由于其鷗翼引腳,對PCB的熱膨脹更具包容性。
6. 安裝與裝配工程指南
頂部散熱器件的引入改變了傳統的PCB裝配流程。以下是基于IPC標準及行業最佳實踐的詳細指南。

6.1 PCB焊盤設計與布局 (IPC-7351)
6.1.1 焊盤定義
TOLT封裝:建議采用非阻焊定義(NSMD, Non-Solder Mask Defined) 焊盤。銅箔面積應略小于阻焊層開口,這允許焊錫包裹住銅箔邊緣,增加焊點強度,對抗TCoB測試中的剪切力 。
QDPAK封裝:由于電流極大(>100A),源極(Source)區域的PCB設計至關重要。建議在源極焊盤區域打熱過孔(Thermal Vias) ,雖然主要散熱在頂部,但這能增加PCB銅箔的熱容,有助于吸收瞬態熱沖擊。PCB銅厚建議使用 3oz 或 4oz,甚至采用埋銅(Copper Inlay)技術 。
6.1.2 柵極驅動回路布局
為了最大化利用TOLT和QDPAK的低電感特性,柵極驅動器(Gate Driver)應盡可能靠近器件的 Pin 8 (Gate) 和 Pin 7/2 (Kelvin Source) 。最佳實踐是將驅動器放置在PCB的底層(Bottom Layer) ,直接位于功率器件的正下方,通過過孔連接。這種垂直布局能將柵極回路電感降至最低,防止誤導通。
6.2 鋼網設計與焊料控制
鋼網厚度:推薦 125 μm - 150 μm 。
孔徑設計:對于TOLT的負對峙高度,必須嚴格控制錫膏量。過多的錫膏會導致器件在回流焊時“漂浮”或傾斜,導致頂部散熱面與散熱器之間產生楔形間隙,嚴重惡化熱阻。建議采用架橋式(Window Pane) 開口設計來控制大面積焊盤上的錫膏覆蓋率(通常控制在50%-70%)。
真空回流焊:對于高功率密度應用,焊點內的空洞(Voiding)是致命的。空洞會阻礙熱傳導并引起局部熱點。強烈建議使用真空回流焊工藝,將空洞率控制在 5%以下 。
6.3 散熱器安裝與熱界面材料(TIM)選擇
這是TSC應用中最關鍵的環節。
6.3.1 絕緣與安全
基本半導體的TOLT和QDPAK器件頂部的裸露金屬面是漏極(Drain)電位,即連接到高壓母線(650V/1200V)。因此,散熱器與器件之間必須進行電氣絕緣。
絕緣TIM:必須選用具有高介電強度的TIM(如陶瓷填充的硅膠片或相變材料),耐壓值需留有足夠裕量(建議 >3-5 kV/mm)。
絕緣片:也可以使用AlN(氮化鋁)或Al2O3(氧化鋁)陶瓷片作為絕緣層,再配合薄層導熱硅脂,以獲得最佳的熱導率和絕緣性 。
6.3.2 夾持力與安裝方式
嚴禁直接在器件上打螺絲,這會導致封裝破裂。
推薦方案:使用彈簧夾(Spring Clips) 或 推針(Push-Pins) 。
壓力控制:理想的接觸壓力范圍是 20 - 50 PSI (0.14 - 0.35 MPa) 或單顆器件 20N - 60N 。
TOLT:由于是負對峙,剛性較強,可承受較大壓力,但需通過TIM厚度來補償器件高度公差。
QDPAK:由于正對峙和引腳彈性,壓力會使器件下沉。必須使用彈簧結構來維持恒定的接觸力,避免因熱膨脹導致的壓力波動造成焊點疲勞 。
間隙填充(Gap Filler) :在多器件共用一個大散熱器(冷板)時,由于各器件的高度公差(Tolerance Stack-up),建議使用液態導熱填縫膠(Liquid Gap Filler) 。它能自動填充不同高度的間隙,固化后形成柔軟的導熱層,對應力極其敏感的SiC芯片提供保護 。
6.3.3 TIM的熱導率與厚度
根據基本半導體的性能,推薦使用熱導率 λ>3?6W/m?K 的TIM。
厚度權衡:TOLT可能需要較厚的TIM(200-300 μm)來吸收公差;而QDPAK配合高精度冷板時,可以使用超薄TIM(50-100 μm),從而顯著降低熱阻 RthCS? 。
6.4 爬電距離與電氣間隙設計規則
對于1200V器件(AB3M040120CQ),必須嚴格遵守安規:
PCB開槽(Slotting) :在漏極焊盤與源極/柵極焊盤之間的PCB區域進行銑槽,可以有效增加表面爬電距離,防止高壓電弧沿PCB表面閃絡。
三防漆(Conformal Coating) :涂覆Type I或Type II絕緣漆可以降低對爬電距離的要求,是緊湊型設計的常用手段 。
散熱器邊緣距離:TIM材料必須超出器件金屬面邊緣至少 2-3mm,以防止高壓從金屬面邊緣直接對散熱器放電 。
7. 結論與建議
TOLT和QDPAK封裝技術的出現,標志著SiC功率器件應用進入了一個新階段。通過消除PCB熱阻瓶頸和引腳電感瓶頸,這兩款封裝充分釋放了基本半導體SiC MOSFET的潛能。
工程建議總結:
選型策略:若追求極致的開關速度(>100kHz)和最高功率密度(如陽臺光儲),選用 QDPAK(如AB3M025065CQ);若關注板級熱循環可靠性及現有產線兼容性,選用 TOLT(如B3M025065B)。
熱設計核心:將“封裝-TIM-散熱器”視為一個整體系統。務必使用彈簧加載的安裝方式和高性能絕緣TIM。對于1200V應用,絕緣和爬電距離設計是重中之重。
制造工藝:升級至真空回流焊以減少空洞,并嚴格控制錫膏厚度以適應不同的對峙高度設計。
遵循本指南,工程師將能夠構建出體積更小、效率更高、且在惡劣工況下長期可靠的碳化硅電力電子系統。
審核編輯 黃宇
-
功率器件
+關注
關注
43文章
2142瀏覽量
95325 -
SiC
+關注
關注
32文章
3798瀏覽量
69718 -
碳化硅
+關注
關注
26文章
3505瀏覽量
52534
發布評論請先 登錄
碳化硅 (SiC) MOSFET 功率器件熱設計基礎與工程實踐

QDPAK封裝SiC碳化硅MOSFET安裝指南

電力電子變換器中環流動力學:產生機理、利用策略與碳化硅(SiC) MOSFET技術的范式轉變

SiC碳化硅MOSFET微觀動力學綜述:開關瞬態全景解析

從微積分的視角結構功率電子:碳化硅(SiC)技術的數學原理與工程價值解析報告

碳化硅 (SiC) MOSFET 分立器件與功率模塊規格書深度解析與應用指南




 SiC碳化硅功率器件頂部散熱封裝:TOLT與QDPAK的結構優勢、熱電動力學分析及工程安裝指南
SiC碳化硅功率器件頂部散熱封裝:TOLT與QDPAK的結構優勢、熱電動力學分析及工程安裝指南








評論