
今年似乎每個人都在討論Multi-Die(集成多個異構小芯片)系統。隨著計算需求激增和摩爾定律放緩,這種將多個異構晶粒或小芯片集成到同一封裝系統中的方式,能夠為實現苛刻PPA、控制成本以及滿足上市時間的一系列需求提供一個更合理的解決方案。Multi-Die系統讓開發者能夠以具有成本效益的價格加速擴展系統功能、降低風險、快速打造新的產品型號,從而實現靈活的產品組合管理。
Multi-Die系統現在已經上市了,但這個概念是早在一兩年前就被提出的,只不過進展一直十分緩慢。2023年對Multi-Die系統來說也許會是個轉折點。
首先,以這些架構為基礎的更廣泛的生態系統日漸成熟,為實現成本效益以及取得成功提供了更大的機會。其次,設計和驗證工具、IP以及制造方面的投資相結合,將會有效克服之前的障礙,為Multi-Die系統的普及鋪平道路。Multi-Die正在逐漸被主流半導體世界所接受。
2023年,Multi-Die系統
被大規模采用的開端之年
從疫苗研發到氣候變化,從智能手機到先進機器人,設備和系統的智能水平在不斷提升,但對芯片的要求卻是在尺寸不變或者更小的情況下,提供更高的帶寬、更好的性能和更低的功耗。芯片尺寸正在接近極限,在單個SoC中,處理能力、內存、帶寬也都遇到了瓶頸。
解決上述困境正是Multi-Die系統的價值所在,它為激發持續創新提供了新的途徑。
Multi-Die系統可以擁有數萬億個晶體管,開發者可以根據特定功能的獨特要求以及整體系統性能和成本目標,靈活地指定特定功能的晶粒采用特定的工藝技術。
我們預計從2023年開始,未來幾年將是Multi-Die系統設計顯著增長的幾年。
-
高性能計算(HPC)和超大規模數據中心領域因為存在大量計算密集型工作負載,預計將成為Multi-Die架構的最大采用者。
-
移動設備領域的芯片開發者需要在設備尺寸和內存都受限的情況下實現更好的PPA,因此也會采用Multi-Die設計。考慮到Multi-Die的多種形式,一些移動設備制造商正在利用先進的封裝來提高芯片密度。
-
汽車芯片開發者也在采用Multi-Die架構,例如用于人工智能模型訓練的Tesla D1。業內越來越多的芯片制造商對此愈加重視。通過針對不同的專業功能使用不同的晶粒,汽車子系統可以更好地滿足整體PPA和成本要求。
憑借在成本、功能集成和擴展方面的優勢,Multi-Die系統正迅速滲透到各個應用領域。所有跡象都表明,2023年將成為Multi-Die系統被大規模采用的開端之年。
Multi-Die生態系統越來越成熟
目前不僅AMD、蘋果、亞馬遜和英特爾等芯片制造商推出了Multi-Die設計,業內其他主要廠商也在這方面取得了重大進展。Multi-Die架構的生態系統正在迅速走向成熟,這將加速Multi-Die系統在市場上的大規模采用。
工具支持是Multi-Die系統走向成熟的重要推動因素。
之前開發者們大多使用需要手動分析的專有工具和腳本,但現在有了更多統一而成熟的整體性工具,這些工具可以簡化設計、驗證、測試、簽核和芯片生命周期管理等功能,讓開發者不再被深層的設計復雜性所困擾。此外,標準化IP可以提供安全穩定的die-to-die連接,降低集成風險并加速chiplet市場發展。
聯盟、流程和先進封裝技術是推動Multi-Die生態系統走向成熟的另一個標志。
新思科技是主要行業聯盟的一員,新思科技的3DIC Compiler協同設計和分析平臺經過認證,可用于關鍵流程,并且針對先進的封裝技術獲得了生產驗證。外包半導體封裝和測試(OSAT)供應商則提供了Multi-Die封裝所需的技術。此外,硅中介層、重分布層(RDL)和3D堆疊等先進封裝技術取得了重大突破,能夠實現高集成密度、更低功耗和更高性能。
在標準方面, 通用芯粒互連技術(UCIe)規范是關鍵的推動因素之一,并且成為目前die-to-die連接的首選標準:
-
該規范目前支持2D、2.5D和橋接封裝,預計將支持3D封裝。
-
唯一一種具有完整的die-to-die接口堆棧的標準。
-
它支持每個引腳高達32 Gbps的帶寬,足以滿足當前和未來的應用。
Multi-Die系統,從拐點到騰飛
如果2022年末是Multi-Die系統發展的轉折點,那么2023年將是這類架構真正騰飛的一年。憑借包括EDA工具和IP在內的全面Multi-Die解決方案,新思科技實現了早期架構探索、快速軟件開發和系統驗證、高效設計實施、穩定的晶粒間連接以及改進的制造和可靠性。
新思科技的Multi-Die系統解決方案包括晶粒/封裝協同設計、驗證、IP、測試和修復、簽核分析和芯片生命周期管理等技術。
與采用新的工藝節點相比,開發者們應該已經發現采用Multi-Die系統更具成本效益。另一些設計團隊采用此系統是希望利用其實現PPA、成本和上市時間等方面的優勢。無論如何,Multi-Die系統有望與單個晶粒一樣成為主流芯片,推動應用實現更高性能,讓人們的生活更快向數智低碳邁進。
 ? ?
? ?
原文標題:2023是否會成為Multi-Die的騰飛之年?
文章出處:【微信公眾號:新思科技】歡迎添加關注!文章轉載請注明出處。
-
新思科技
+關注
關注
5文章
956瀏覽量
52892
原文標題:2023是否會成為Multi-Die的騰飛之年?
文章出處:【微信號:Synopsys_CN,微信公眾號:新思科技】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
嵌入式開發是否會成為下一個被看好的領域?

英諾達Palladium Z3集群并機投入運營
軟件定義的硬件輔助驗證如何助力AI芯片開發

新思科技Multi-Die方案助力車企邁向汽車電子新時代
新思科技助力UCIe 3.0快速落地
新思科技以AI驅動EDA加速Multi-Die創新
新思科技斬獲2025年臺積公司開放創新平臺年度合作伙伴大獎
面向芯粒設計的最佳實踐
DAF膠膜(Die Attach Film)詳解
新思科技UCIe IP解決方案實現片上網絡互連
新思科技網頁端虛擬原型工具的工作流程
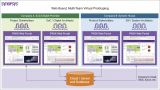
新思科技與三星深化合作加速AI和Multi-Die設計
手機芯片:從SoC到Multi Die




 2023是否會成為Multi-Die的騰飛之年?
2023是否會成為Multi-Die的騰飛之年?




評論