這項研究首先集中于去除直接沉積在硅襯底上的193納米厚的光刻膠和BARC層,使用傅里葉變換紅外光譜(FTIR)和橢圓偏振光譜(SE)來評估去除效率,在第二部分中,研究了金屬硬掩模/多孔低k鑲嵌結構上蝕刻后光刻膠和BARC層的去除,掃描電子顯微鏡(SEM)和X射線光電子能譜(XPS)用于評估清洗效率,使用平面電容器結構確定暴露于等離子體和濕化學對低k膜的介電常數的影響。
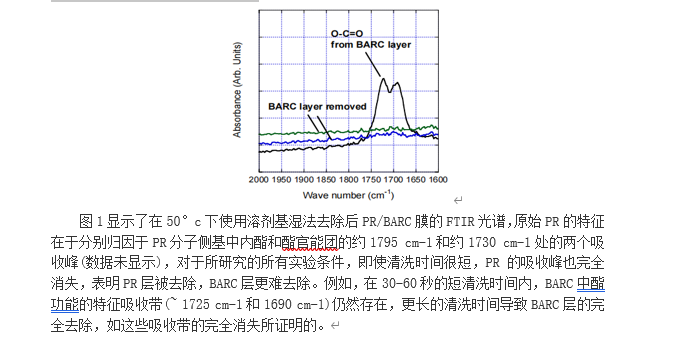
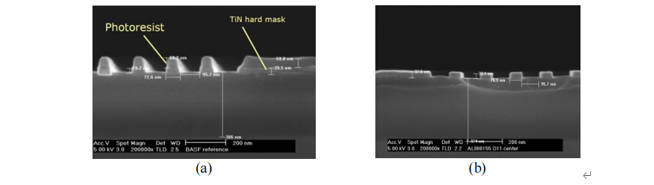
對圖案化結構的橫截面SEM檢查表明,在幾種實驗條件和化學條件下可以實現蝕刻后PR的完全去除,其中在50℃和低兆聲功率(10 W)下2分鐘代表了有機溶劑基化學(例如化學1)的最佳條件,圖3比較了使用化學清洗之前(a)和之后(b)的單鑲嵌低k疊層,很明顯,PR層被去除了,對輪廓的仔細檢查和對殘留在表面的層(錫)厚度的測量表明,BARC層也被清洗溶液完全去除。該結果證實了上面給出的XPS數據
通過傳統的干法工藝,在同一等離子體室中進行低k圖案化,包括BARC和錫開口、PR和BARC剝離以及隨后的低k蝕刻,在PR/BARC濕法剝離的情況下,必須打破真空工藝順序,這可能影響低k蝕刻的結果/性能,為了進一步了解PR濕法去除工藝的影響,隨后使用標準蝕刻配方進行低k蝕刻,在濕法PR和BARC去除之后進行的多孔低k層的圖案化產生了良好的低k輪廓。
在高兆頻超聲波功率下清洗時間在1-4分鐘之間導致k值顯著增加。然而發現在350℃下低壓(Ar下3-5托)烘烤1分鐘對該濕法工藝后的k值恢復具有有益的影響。
顯然,在圖中所示的條件下烘烤后,初始k值完全恢復,這些數據表明,即使用H2O/IPA沖洗,溶劑和最可能的其它化學物質仍然保留在低k膜內部,在高溫烘烤期間被釋放出來,此外,這意味著基于有機溶劑的清洗溶液不會與多孔低k材料反應,并保持其特性。
我們已經證明,對于具有90 nm間距的單鑲嵌結構,使用各種化學物質并在不同的兆頻超聲波功率和清洗時間的實驗條件下,PR和BARC層都被完全去除,所述實驗條件的范圍從10-100 W在2到3分鐘之間,其中10 W/2分鐘代表最溫和的條件,電介質疊層的后續等離子體蝕刻表明,在濕法去除PR和BARC之后,可以獲得良好的電介質輪廓,表明濕法工藝不影響多孔低k蝕刻的結果/性能。使用Chem1在50°C下清洗1-4分鐘的濕法工藝,由于加入了溶劑和其他化學物質,導致多孔低介電常數的k值顯著增加,然而,在低壓氬氣下350°C烘烤1分鐘后,k值可以恢復。
?審核編輯:符乾江
-
半導體
+關注
關注
339文章
30737瀏覽量
264093 -
光刻膠
+關注
關注
10文章
354瀏覽量
31779
發布評論請先 登錄
中國打造自己的EUV光刻膠標準!
光刻膠涂層如何實現納米級均勻性?橢偏儀的工藝控制與缺陷分析

半導體濕法去膠原理

國產光刻膠突圍,日企壟斷終松動
行業案例|膜厚儀應用測量之光刻膠厚度測量

用于 ARRAY 制程工藝的低銅腐蝕光刻膠剝離液及白光干涉儀在光刻圖形的測量

低含量 NMF 光刻膠剝離液和制備方法及白光干涉儀在光刻圖形的測量

金屬低刻蝕的光刻膠剝離液及其應用及白光干涉儀在光刻圖形的測量

減少光刻膠剝離工藝對器件性能影響的方法及白光干涉儀在光刻圖形的測量




 使用全濕法去除Cu BEOL中的光刻膠和BARC
使用全濕法去除Cu BEOL中的光刻膠和BARC








評論