光刻膠(亦稱光致抗蝕劑)是集成電路制造中的關鍵材料,其純度直接決定光刻圖形的質量與芯片良率。隨著光刻技術向極紫外(EUV,13.5?nm)工藝節點演進,光刻膠的膜厚均勻性、光學常數穩定性及缺陷控制要求日益嚴格,Flexfilm費曼儀器全光譜橢偏儀作為一種非接觸、高精度的光學薄膜表征工具,在光刻膠工藝段中發揮著關鍵的監控與優化作用,尤其與材料純化工藝相輔相成,共同提升光刻膠的綜合性能。
超純電子級光刻材料的純化處理方法主要有膜分離法、離子交換法、吸附法和溶劑萃取法等,針對不同的光刻膠原料和光刻膠,所采用的純化處理方法也不同。本文從光刻膠制備、光刻工藝、光刻膠純化方法及存在的問題等方面進行分析總結,在此基礎上,對技術發展趨勢進行了展望。
1
光刻膠的組成分類與應用概況
flexfilm

光刻工藝與光刻膠反應機制:(a)光刻膠酸催化反應機制(b)正負性光刻膠光化學反應分子結構對比(c)光刻工藝示意圖
光刻膠為聚合物基復配體系,主要包括溶劑(占50–90%)、樹脂(10–40%)、感光劑(1–6%)及少量添加劑。根據曝光區域的溶解性差異,可分為正性膠與負性膠:正性膠曝光后曝光區溶于顯影液,圖形精度高,是目前主流;負性膠則通過交聯形成不溶區域。
在應用方面,光刻膠廣泛用于半導體、液晶顯示(LCD)和印刷電路板(PCB)制造。我國在PCB光刻膠領域已形成一定產能,但在半導體高端光刻膠(如KrF、ArF、EUV)方面仍嚴重依賴進口,EUV光刻膠尚處研發階段,國產化進程亟待突破。
2
光刻工藝中的膠層缺陷與純化必要性

典型光刻工藝的過程
典型光刻流程包括涂膠、軟烘、曝光、后烘、顯影等多道工序。若膠液中存在顆粒或金屬離子雜質,易引發三類缺陷:
凸起缺陷:因雜質干擾顯影,造成圖形局部凸起;
針孔缺陷:因遮光顆粒阻礙曝光,形成微孔;
暗斑缺陷:因掩模污染導致曝光區出現暗區。
這些缺陷會顯著降低圖形保真度與產品良率,因此必須對光刻膠原料及成品進行高效純化。
3
光刻膠材料純化關鍵技術進展
flexfilm

光刻膠圖形化過程反應機制
純化主要面向光刻膠樹脂、溶劑、光產酸劑(PAG)及最終膠液,目標是去除顆粒物與金屬離子,使其滿足超純電子化學品標準(如SEMI C12級以上,金屬離子濃度低于10?12 g/mL)。

光刻化學品中的有機雜質和金屬雜質
樹脂純化
樹脂決定光刻膠基本性能,其雜質主要包括未聚合單體、低聚物及金屬離子。
去除單體與低聚物:常用溶劑萃取(如甲醇、正己烷)及膜過濾。近年來發展的溶劑萃取–陶瓷超濾耦合工藝,提高了分離效率并減少溶劑消耗。
去除金屬離子:離子交換法雖有效,但存在再生頻繁、周期長等問題。液相萃取–離心分離組合技術可實現連續運行,將處理時間從數十小時縮短至數小時,更適合規模化生產。
溶劑純化
PGMEA(丙二醇甲醚醋酸酯)為代表溶劑,需達電子級純度。傳統離子交換法易引起溶劑水解;螯合樹脂則可避免該問題。膜技術因精度高、運行穩,成為主流方案,如尼龍膜可吸附金屬離子,經表面改性后可進一步提升性能。此外,綠色合成工藝(如反應蒸餾耦合變壓精餾)可直接制備高純溶劑,減少后續純化負擔。
光產酸劑(PAG)純化
PAG是化學增幅膠的核心,合成中易殘留酸性雜質與金屬離子。純化方式包括水洗、離子交換、重結晶及組合工藝。例如通過絡合吸附與溶劑萃取聯用,可有效去除鎂、鎢等金屬雜質。
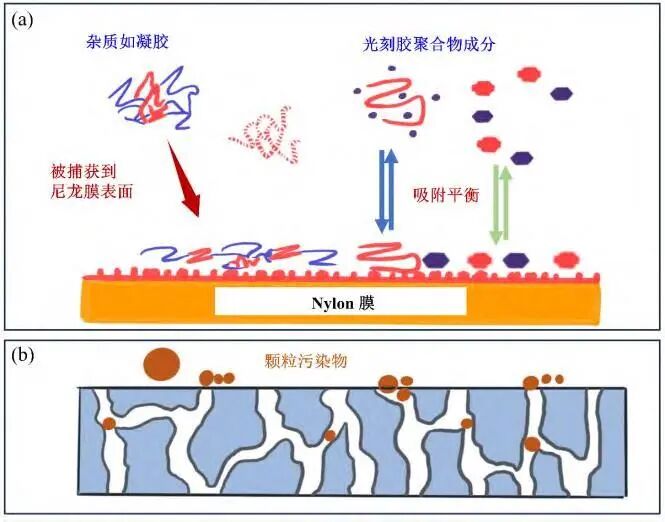
膜過濾法去除顆粒污染物機制(a)尼龍膜吸附示意圖(b)顆粒篩分示意圖
光刻膠溶液純化
成品膠液需進一步去除顆粒與金屬離子。
顆粒去除:主要依靠膜過濾,常用尼龍、UPE、PTFE等膜材。通過表面改性(如引入吸附基團)或梯度孔道設計,可提升對凝膠及有機污染物的截留效果。
金屬離子去除:除傳統離子交換與吸附法外,功能化濾膜成為重要方向。例如羧基改性尼龍膜兼具吸附與離子交換功能,且不釋放酸性物質;采用樹脂固化微床的過濾器可實現金屬離子濃度降至10?12 g/mL級別。生產中常采用多級串聯工藝,同步凈化顆粒與離子雜質。
4
橢偏儀在光刻膠工藝段的主要應用
flexfilm

在光刻膠涂布、烘烤及曝光前后工藝環節中,橢偏儀主要用于以下方面:
膜厚與均勻性測量
光刻膠旋涂后需快速、精確測定膠膜厚度及其在晶圓表面的分布均勻性。橢偏儀通過分析偏振光與薄膜相互作用后的振幅比與相位差,可實時獲取納米級膜厚數據,為工藝調整提供依據。尤其在化學增幅型光刻膠中,膜厚均勻性直接影響曝光后酸擴散行為與圖形輪廓。
光學常數(n、k)監測
光刻膠的光學常數(折射率n與消光系數k)是曝光模擬與工藝窗口評估的關鍵參數。橢偏儀可在不同波長(如193?nm、EUV對應波長)下測量光刻膠的n、k值,用于監控材料批次一致性、烘烤工藝穩定性以及曝光過程中的光吸收特性變化。
工藝相關變化分析
在軟烘、曝光后烘烤等熱處理過程中,光刻膠會發生交聯、脫保護等化學變化,導致膜厚收縮與光學性質改變。橢偏儀可動態跟蹤這些變化,輔助優化烘烤溫度與時間,減少因工藝波動引起的圖形偏差。
光刻膠材料純化與橢偏監控的協同關系
光刻膠純化旨在去除樹脂、溶劑、光產酸劑及最終膠液中的顆粒物與金屬離子雜質,其效果直接影響膠膜的光學均勻性與缺陷密度。橢偏儀可在純化前后對材料進行表征,形成“純化–表征–工藝調整”的閉環控制。
5
純化技術進展與橢偏表征的融合趨勢

光刻膠工藝
當前光刻膠純化技術正向綠色高效、功能化集成方向發展:
膜技術功能化:如尼龍膜、UPE膜經表面改性后兼具過濾與吸附功能,可選擇性去除金屬離子與有機污染物。橢偏儀可用于評價改性膜處理后膠膜的光學均勻性,驗證純化效果。
工藝耦合化:萃取–離心、離子交換–膜分離等多工藝聯用,提升純化效率。橢偏儀可對多級純化中間產物進行快速光學表征,優化工藝參數。
材料–工藝協同優化:通過橢偏儀系統測量光刻膠在不同純化階段的光學響應,建立“材料純度–光學性能–圖形質量”關聯模型,推動純化工藝的精準調控。
光刻膠純化是保障集成電路制造良率與性能的關鍵環節。隨著EUV光刻等先進技術發展,純化工藝正朝著更高精度、更高效率、更綠色可持續的方向演進。通過材料創新、工藝優化與系統集成,將有力支撐高端光刻膠的自主可控與產業升級。
Flexfilm費曼儀器全光譜橢偏儀
flexfilm

Flexfilm費曼儀器全光譜橢偏儀擁有高靈敏度探測單元和光譜橢偏儀分析軟件,專門用于測量和分析光伏領域中單層或多層納米薄膜的層構參數(如厚度)和物理參數(如折射率n、消光系數k)
- 先進的旋轉補償器測量技術:無測量死角問題。
- 粗糙絨面納米薄膜的高靈敏測量:先進的光能量增強技術,高信噪比的探測技術。
- 秒級的全光譜測量速度:全光譜測量典型5-10秒。
- 原子層量級的檢測靈敏度:測量精度可達0.05nm。
Flexfilm費曼儀器全光譜橢偏儀能非破壞、非接觸地原位精確測量超薄圖案化薄膜的厚度、折射率,結合費曼儀器全流程薄膜測量技術,助力半導體薄膜材料領域的高質量發展。
-
材料
+關注
關注
3文章
1571瀏覽量
28688 -
光刻膠
+關注
關注
10文章
356瀏覽量
31845
發布評論請先 登錄
Futurrex高端光刻膠
光刻膠殘留要怎么解決?
Microchem SU-8光刻膠 2000系列
光刻膠
光刻膠在集成電路制造中的應用
《炬豐科技-半導體工藝》光刻前 GaAs 表面處理以改善濕化學蝕刻過程中的光刻膠附著力和改善濕蝕刻輪廓
光刻膠的原理和正負光刻膠的主要組分是什么
光刻膠黏度如何測量?光刻膠需要稀釋嗎?
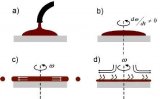
光刻膠剝離工藝




 光刻膠涂層如何實現納米級均勻性?橢偏儀的工藝控制與缺陷分析
光刻膠涂層如何實現納米級均勻性?橢偏儀的工藝控制與缺陷分析


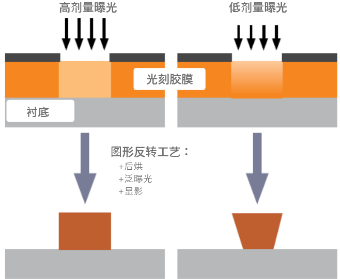






評論