散熱基板之厚膜與薄膜制程差異分析,我們將LED散熱基板在兩種不同制程上做出差異分析,以薄膜制程備制陶瓷散熱基板具有較高的設(shè)備與技術(shù)
2012-02-21 15:29:18 2934
2934 
BGA基板工藝制程簡(jiǎn)介
2022-11-28 14:58:00 2983
2983 球柵陣列 (Ball Crid Array, BGA)封裝在封裝基板底部植球,以此作為電路的 I/O接口,因此大大提升了 IC 的接口數(shù)量,并因其I/O間距較大,使得其SMT 失效率大幅降低。自20
2023-04-21 09:58:47 3524
3524 1986年,意法半導(dǎo)體(ST)公司率先研制成功BCD工藝制程技術(shù)。BCD工藝制程技術(shù)就是把BJT,CMOS和DMOS器件同時(shí)制作在同一芯片上。BCD工藝制程技術(shù)除了綜合了雙極器件的高跨導(dǎo)和強(qiáng)負(fù)載驅(qū)動(dòng)
2024-07-19 10:32:00 7161
7161 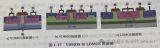
按照基本工藝制程技術(shù)的類型,BiCMOS 工藝制程技術(shù)又可以分為以 CMOS 工藝制程技術(shù)為基礎(chǔ)的 BiCMOS 工藝制程技術(shù),或者以雙極型工藝制程技術(shù)為基礎(chǔ)的 BiCMOS 工藝制程技術(shù)。以
2024-07-23 10:45:57 4121
4121 
電子發(fā)燒友網(wǎng)報(bào)道(文/李寧遠(yuǎn))先進(jìn)封裝與先進(jìn)制程工藝是推動(dòng)半導(dǎo)體行業(yè)進(jìn)步的關(guān)鍵技術(shù),尤其是在人工智能推動(dòng)的算力暴漲而工藝節(jié)點(diǎn)微縮減緩的行業(yè)形勢(shì)下,先進(jìn)封裝為芯片更高計(jì)算能力、更低延遲和更高帶寬提供了
2024-05-30 00:02:00 5251
5251 、BGA簡(jiǎn)介BGA(英文全稱Ball Grid Array),即球形觸點(diǎn)陣列,也有人翻譯為“球柵陣列封裝”、“網(wǎng)格焊球陣列”和“球面陣”等等。球柵陣列封裝BGA是20世紀(jì)90年代開始應(yīng)用,現(xiàn)主要應(yīng)用于高端
2015-10-21 17:40:21
和基板介質(zhì)間還要具有較高的粘附性能。 BGA封裝技術(shù)通常采用引線鍵合、等離子清洗、模塑封裝、裝配焊料球、回流焊等工藝流程。引線鍵合PBGA的封裝工藝流程包括PBGA基板的制備和封裝工藝
2023-04-11 15:52:37
更小,更易于加工。 BGA設(shè)計(jì)規(guī)則 凸點(diǎn)塌落技術(shù),即回流焊時(shí)錫鉛球端點(diǎn)下沈到基板上形成焊點(diǎn),可追溯到70年代中期。但直到現(xiàn)在,它才開始快速發(fā)展。目前,Motorola、IBM、Citizen
2018-09-05 16:37:49
應(yīng)用受到制約。而球柵陣列封裝BGA器件,由于芯片的管腳分布在封裝底面,將封裝外殼基板原四面引出的引腳變成以面陣布局的鉛/錫凸點(diǎn)引腳,就可容納更多的I/O數(shù),且用較大的引腳間距(如1.5、1.27 mm
2018-12-30 14:01:10
曲線時(shí),對(duì)于BGA元件其測(cè)量點(diǎn)應(yīng)在BGA引腳與線路板之間。BGA盡量不要用高溫膠帶,而采用高溫焊錫焊接與熱電偶相固定,以保證獲得較為準(zhǔn)確的曲線數(shù)據(jù)。 總之BGA的焊接是一門十分復(fù)雜的工藝,它還受到線路板
2008-06-13 13:13:54
BGA虛焊檢測(cè)、BGA電路焊接工藝質(zhì)量評(píng)估與完好性快速檢測(cè)預(yù)警系統(tǒng)
2020-07-01 16:39:44
COMS工藝制程技術(shù)主要包括了:1.典型工藝技術(shù):①雙極型工藝技術(shù)② PMOS工藝技術(shù)③NMOS工藝技術(shù)④ CMOS工藝技術(shù)2.特殊工藝技術(shù)。BiCOMS工藝技術(shù),BCD工藝技術(shù),HV-CMOSI藝
2019-03-15 18:09:22
FPC全制程技術(shù)講解單片單面撓性印制板制造工藝單片多層,剛撓印制板制造工藝單片單面撓性印制板工藝(一)? 材料的切割:撓性印制印制板的材料主要分為二大部份;第一類是:覆銅基板材料,按絕緣材料的類型
2009-05-16 20:34:57
:旋轉(zhuǎn)式材料與工藝主體材料:插座底座、壓縮螺絲、蓋板等關(guān)鍵部件采用 7075-T6 鋁合金,兼顧輕量化與高強(qiáng)度。接觸介質(zhì):使用 導(dǎo)電彈性體(銀顆粒嵌入非導(dǎo)電聚合物基板),提供高適應(yīng)性接觸,確保低回路電阻
2025-12-18 10:00:10
一. MID 立體基板 與 傳統(tǒng) 平面 電路板PCB 電子成品的設(shè)計(jì)制造朝向輕薄短小,電路板也明顯朝細(xì)線路化、多層化發(fā)展,在成品體積的控制上,則講求省空間及合理化的要求。 基于組裝方便及配線容易
2018-11-23 16:47:52
摘抄自正點(diǎn)原子官方PPTOLED簡(jiǎn)介??OLED,即有機(jī)發(fā)光二極管(Organic Light-Emitting Diode),又稱為有機(jī)電激光顯示(Organic
2021-08-09 08:33:07
PCB制程中的COB工藝是什么呢?
2023-04-23 10:46:59
佳,使用此一類板材,在經(jīng)過高溫的加熱之后,預(yù)覆于PAD上的保護(hù)膜勢(shì)必受到破壞,而導(dǎo)致焊錫性降低,尤其當(dāng)基板經(jīng)過二次回焊后的情況更加嚴(yán)重,因此若制程上還需要再經(jīng)過一次DIP制程,此時(shí)DIP端將會(huì)面臨焊接上的挑戰(zhàn)
2018-08-31 14:28:05
工藝簡(jiǎn)介</strong></font></p><p>&nbsp;&
2009-10-21 09:42:26
SMT回流焊制程的影響因素很多,比如:PCB 材料、助焊劑、焊膏、焊料合金,以及生產(chǎn)場(chǎng)地、設(shè)備、環(huán)境等等,所以每一個(gè) SMT 的回流焊制程是獨(dú)一無二的。當(dāng)使用高云公司芯片時(shí),應(yīng)根據(jù)芯片的鍍層工藝
2022-09-28 08:45:01
打個(gè)比方,四層板的外層是正片設(shè)計(jì)的,在制作四層板時(shí),我是不是可以選擇使用負(fù)片工藝制程(通過曝光--顯影---蝕刻)去制作出我需要的線路呢?
2021-09-14 14:56:49
書籍:《炬豐科技-半導(dǎo)體工藝》文章:用于半導(dǎo)體封裝基板的化學(xué)鍍 Ni-P/Pd/Au編號(hào):JFSJ-21-077作者:炬豐科技 隨著便攜式電子設(shè)備的普及,BGA(球柵陣列)越來越多地用于安裝在高密度
2021-07-09 10:29:30
、進(jìn)行電路板焊接時(shí)點(diǎn)烙鐵的溫度是多少?線路板廠家答:一般為200~300度左右 具體調(diào)節(jié)根據(jù)焊點(diǎn)的大小 焊絲的粗細(xì)來調(diào)節(jié)。4、鋁基板板材不貼膜會(huì)怎么樣?答:會(huì)擦花,會(huì)上藥水易氧化,和制程工藝也有關(guān)。生產(chǎn)
2017-09-12 16:02:05
的尺寸穩(wěn)定性和低的吸潮性,具有較好的電氣性能和高可靠性。金屬薄膜、絕緣層和基板介質(zhì)間還要具有較高的粘附性能。三大BGA封裝工藝及流程一、引線鍵合PBGA的封裝工藝流程1、PBGA基板的制備在BT樹脂
2018-09-18 13:23:59
本人有多年焊接工作經(jīng)驗(yàn),對(duì)電子產(chǎn)品的焊接方法 工藝要求及性能測(cè)試都非常熟悉,現(xiàn)主要從事對(duì)各種BGA芯片的焊接。植球及返修。另承接各種實(shí)驗(yàn)板,手工板的焊接,價(jià)格優(yōu)惠,技術(shù)熟練,工藝先進(jìn),保證質(zhì)量。有需要請(qǐng)聯(lián)系我,***,岑小姐。
2017-06-15 11:24:22
基板技術(shù)是倒裝晶片工藝需要應(yīng)對(duì)的最大挑戰(zhàn)。因?yàn)槌叽绾苄。ㄐ〉脑〉那驈剑〉那蜷g距,小的貼裝 目標(biāo)),基板的變動(dòng)可能對(duì)制程良率有很大影響: ·密間距貼裝良率極易受限于阻焊膜和焊盤的尺寸公差
2018-11-27 10:47:46
半導(dǎo)體發(fā)展至今,無論是從結(jié)構(gòu)和加工技術(shù)多方面都發(fā)生了很多的改進(jìn),如同Gordon E. Moore老大哥預(yù)測(cè)的一樣,半導(dǎo)體器件的規(guī)格在不斷的縮小,芯片的集成度也在不斷提升,工藝制程從90nm
2020-12-10 06:55:40
:■ BGA 封裝簡(jiǎn)介■ PCB 布板術(shù)語■ 高密度BGA 封裝PCB 布板BGA 封裝簡(jiǎn)介在BGA 封裝中,I/O 互聯(lián)位于器件內(nèi)部。基片底部焊球矩陣替代了封裝四周的引線。最終器件直接焊接在PCB 上,采用
2009-09-12 10:47:02
`千呼萬喚始出來,華秋電路(原“華強(qiáng)PCB”)制程能力強(qiáng)勢(shì)升級(jí)、新計(jì)價(jià)頁煥新上線▼圖:新計(jì)價(jià)頁截圖一覽:與高多層板生產(chǎn)密切相關(guān)的「九大」工藝逐一升級(jí)華秋電路帶你一項(xiàng)項(xiàng)分解:▼第1類:核心制程能力升級(jí)
2019-09-30 14:19:44
TFT array之制程主要清洗,成膜,而后黃光制板,后再經(jīng)蝕刻制程形成所要的圖樣,然后依光罩?jǐn)?shù)而作 循環(huán)制程,在這循環(huán)制程中要先將洗凈的玻璃基板送進(jìn)濺鍍機(jī)臺(tái)鍍上一層金屬后,再用黃光及蝕刻制程形成
2020-04-03 09:01:06
芯片制造-半導(dǎo)體工藝制程實(shí)用教程學(xué)習(xí)筆記[/hide]
2009-11-18 11:44:51
l玻璃基板的結(jié)構(gòu)
l玻璃基板的制造流程簡(jiǎn)介
l玻璃基板的具體流程簡(jiǎn)介
l制程DEFECT
l發(fā)展趨勢(shì)
2010-12-15 09:58:37 0
0 制卡工藝簡(jiǎn)介
A.打圓孔
2009-03-30 18:16:01 832
832 
BGA、TAB、零件、封裝及Bonding制程
1、Active parts(Devices) 主動(dòng)零件指半導(dǎo)體類之各種主動(dòng)性集成電路器或晶體管,相對(duì)另有 Passive﹣Parts被動(dòng)零件,如電阻器、電容器等
2010-01-11 23:50:45 4855
4855 BGA、TAB、零件、封裝及Bonding制程術(shù)語解析
1、Active parts(Devices) 主動(dòng)零件指半導(dǎo)體類之各種主動(dòng)性集成電路器或晶體管,相對(duì)另有 Passive﹣Parts被動(dòng)
2010-02-21 10:31:47 9525
9525 BGA無鉛焊接技術(shù)簡(jiǎn)介
鉛(Pb),是一種有毒的金屬,對(duì)人體有害。并且對(duì)自然環(huán)境有很大的破壞性,出于環(huán)境保護(hù)的要求,特別
2010-03-04 11:19:42 1343
1343 BGA封裝的類型和結(jié)構(gòu)原理圖
BGA的封裝類型多種多樣,其外形結(jié)構(gòu)為方形或矩形。根據(jù)其焊料球的排布方式可分為周邊型、交錯(cuò)型和全陣列型BGA。根據(jù)其基板的不同
2010-03-04 13:30:48 10857
10857 BGA的封裝工藝流程基本知識(shí)簡(jiǎn)介
基板或中間層是BGA封裝中非常重要的部分,除了用于互連布線以外,還可用于阻抗控制及用于電感/電阻/電容的集成。因此要求
2010-03-04 13:44:06 7030
7030 在無鉛制程中藥了解的事項(xiàng)很多,因此建議先從以下6大方向來加以討論 1 PCB基板材質(zhì)的選擇 2 無鉛零件材質(zhì)的選擇 3 焊接設(shè)備注意事項(xiàng) 4 焊接材料選擇 5制程變更 6可靠度試驗(yàn)
2011-04-01 10:10:05 0
0 對(duì)于PCB抄板工程師來說,除了掌握一定的抄板技術(shù)技巧和軟件應(yīng)用技能之外,還應(yīng)該對(duì)各類電路板基板材料有初步的了解,本文我們將為大家介紹一種新的基板--PALUP基板的結(jié)構(gòu)工藝和性
2011-06-23 11:27:05 1597
1597 制程工藝就是通常我們所說的CPU的“制作工藝”,是指在生產(chǎn)CPU過程中,集成電路的精細(xì)度,也就是說精度越高,生產(chǎn)工藝越先進(jìn)。在同樣的材料中可以制造更多的電子元件,連接線也越細(xì),精細(xì)度就越高,反之
2012-09-09 16:37:30

目前在LED制程中,藍(lán)寶石基板雖然受到來自Si與GaN基板的挑戰(zhàn),但是考慮到成本與良率,藍(lán)寶石在近兩年內(nèi)仍然具有優(yōu)勢(shì).由于藍(lán)寶石硬度僅次于鉆石,因此對(duì)它進(jìn)行減薄與表面平坦化加
2012-10-18 09:58:49 2993
2993 BGA焊接的工藝方法很值得學(xué)習(xí)呀,BGA焊接的工藝方法很值得學(xué)習(xí)呀,BGA焊接的工藝方法很值得學(xué)習(xí)呀。
2015-11-17 15:41:57 0
0 BGA_焊盤設(shè)計(jì)BGA走線打孔敷銅檢查等問題
2015-11-20 17:01:48 0
0 BGA 的焊接工藝要求,詳細(xì)介紹各個(gè)步驟的要求,讓初學(xué)者可以迅速的成長(zhǎng)起來。
2016-03-21 11:32:00 11
11 BGA焊球重置工藝,有想法的小伙伴可以看看。
2016-06-15 15:53:57 0
0 一、LED藍(lán)寶石基板加工工藝 首先對(duì)于藍(lán)寶石基板來說,它在成為一片合格的襯底之前大約經(jīng)歷了從切割、粗磨、精磨、以及拋光幾道工序。以2英寸藍(lán)寶石為例: 1.切割:切割是從藍(lán)寶石晶棒通過線切割機(jī)切割成
2017-10-12 16:32:06 8
8 BGA返修臺(tái)是對(duì)應(yīng)焊接不良的
BGA重新加熱焊接的設(shè)備,它不可以修復(fù)
BGA元件本身出廠的品質(zhì)問題。不過按目前的
工藝水平,
BGA元件出廠有問題的幾率很低。有問題的話只會(huì)在SMT
工藝端和后段的因?yàn)闇囟仍?/div>
2017-11-13 11:06:20 14389
14389 本文開始介紹了什么是鋁基板與鋁基板的工作原理,其次介紹了鋁基板的構(gòu)成及PCB鋁基板用途,最后詳細(xì)介紹了鋁基板生產(chǎn)工藝流程。
2018-02-27 10:58:22 45469
45469 目前在LED制程中,藍(lán)寶石基板雖然受到來自Si與GaN基板的挑戰(zhàn),但是考慮到成本與良率,藍(lán)寶石在近幾年來具有一定的優(yōu)勢(shì),因此對(duì)它進(jìn)行減薄與表面平坦化加工非常困難,在逐漸的摸索中,業(yè)界形成了一套大致相同的對(duì)于藍(lán)寶石基板進(jìn)行減薄與平坦化的工藝。
2018-08-09 09:18:37 5053
5053 BGA封裝的構(gòu)造為在通常情況下,具有比等效的QFP較短的引線長(zhǎng)度,因此具有較好的電性能。不過BGA構(gòu)造引起的最大缺陷之一為成本問題,BGA較QFP昂貴的主要原因是與元件載體基板有關(guān)的疊層板和樹脂的成本。
2019-01-22 15:45:47 12376
12376 本文首先介紹了什么是BGA,其次介紹了BGA主要工藝,最后介紹了BGA焊盤脫落的補(bǔ)救方法及詳細(xì)步驟。
2019-04-25 14:30:48 14023
14023 BGA焊接一般指電路板焊接。線路板,電路板, PCB板,pcb焊接技術(shù)近年來電子工業(yè)工藝發(fā)展歷程,可以注意到一個(gè)很明顯的趨勢(shì)就是回流焊技術(shù)。原則上傳統(tǒng)插裝件也可用回流焊工藝,這就是通常所說的通孔回流焊接。
2019-04-25 19:31:12 24964
24964 鋁基板工藝是指以技術(shù)上的先進(jìn)和經(jīng)濟(jì)上的合理為原則,以最終制成品的優(yōu)良品質(zhì)為目的,對(duì)鋁基板的加工和處理過程制定合理可行的的規(guī)范。保證生產(chǎn)過程順利進(jìn)行。
2019-05-09 16:50:46 6471
6471 氧化鋁陶瓷基板的機(jī)械強(qiáng)度高,且絕緣性和避光性較好,在多層布線陶瓷基板、電子封裝及高密度封裝基板中收到了廣泛應(yīng)用。但目前國內(nèi)在氧化鋁陶瓷基板的生產(chǎn)中存在一些問題,例如燒結(jié)溫度過高等,導(dǎo)致我國在該部件的應(yīng)用主要依靠進(jìn)口。小編今天針對(duì)氧化鋁陶瓷基板的工藝展開概述。
2019-05-21 16:11:00 14066
14066 在薄膜工藝中,基于薄膜電路工藝,陶瓷表面通過磁控濺射金屬化,銅層和金層的厚度大于10通過電鍍測(cè)微計(jì)。也就是說,DPC(直板銅)。
2019-07-31 11:39:18 15596
15596 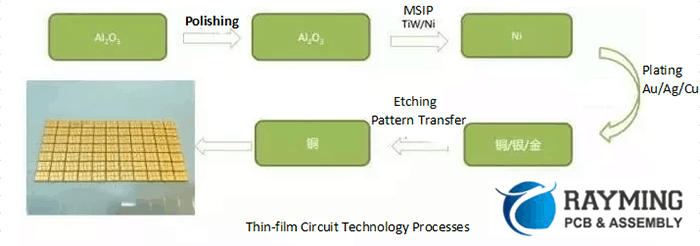
BGA封裝技術(shù)早在20世紀(jì)60年代就已開始,并由IBM公司首次應(yīng)用。然而,BGA封裝技術(shù)直到20世紀(jì)90年代初才進(jìn)入實(shí)用階段。
2019-08-03 10:06:37 8220
8220 BGA元件檢測(cè)不易實(shí)現(xiàn),但由于工藝技術(shù)難度水平的降低導(dǎo)致問題盡快得到解決,使產(chǎn)品質(zhì)量更容易控制,與現(xiàn)代制造的概念兼容。本文將根據(jù)實(shí)際批量生產(chǎn),討論和分析BGA元件在各個(gè)方向的SMT裝配過程。
2019-08-05 08:41:28 4502
4502 BGA(即Ball GridAray)有多種結(jié)構(gòu),如塑封BGA (P-BGA)、倒裝BGA( F-BGA )、載帶BGA(T-BGA)和陶瓷BGA(C-BGA)。其工藝特點(diǎn)如下:
2019-11-08 11:45:03 7162
7162 BGA是smt加工中很多高精密的電路板都會(huì)出現(xiàn)的最小焊點(diǎn)封裝,而BGA那么小,我們錫膏量要控制以外,如何加固BGA使得更加牢固呢?無鉛焊料降低了BGA封裝的可靠性,特別是抗沖擊與彎曲性能。采用傳統(tǒng)的底部填充工藝需要花費(fèi)更多的時(shí)間,而采用角部點(diǎn)膠工藝可以有效增強(qiáng)BGA的抗沖擊與彎曲性能。
2020-01-17 11:23:20 9783
9783 本文檔的主要內(nèi)容詳細(xì)介紹的是封裝基板的技術(shù)簡(jiǎn)介詳細(xì)說明包括了:封裝類型與發(fā)展, BGA的分類與基本結(jié)構(gòu), BGA基板的發(fā)展與簡(jiǎn)介, BGA封裝的發(fā)展。
2020-07-28 08:00:00 0
0 生瓷片上的打孔制作是LTCC制作的關(guān)鍵工藝技術(shù)之一。通孔孔徑、位置精度均直接影響基板的成品率和最終電性能。對(duì)于常規(guī)的LTCC工藝,孔徑在0.1~0.3 mm 之間,根據(jù)布線密度和基板的電性能選擇
2020-10-22 14:19:12 7222
7222 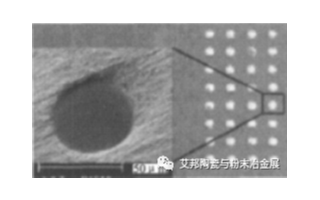
MEMS制程各工藝相關(guān)設(shè)備的極限能力又是限定器件尺寸的關(guān)鍵要素,且其相互之間的配套方能實(shí)現(xiàn)設(shè)備成本的最低;下面先簡(jiǎn)要介紹一下前段制程的特點(diǎn)及涉及的設(shè)備。
2021-01-11 10:35:42 3099
3099 FC-BGA基板是能夠?qū)崿F(xiàn)LSI芯片高速化與多功能化的高密度半導(dǎo)體封裝基板,可應(yīng)用于CPU、GPU、高端服務(wù)器、網(wǎng)絡(luò)路由器/轉(zhuǎn)換器用ASIC、高性能游戲機(jī)用MPU、高性能ASSP、FPGA以及車載設(shè)備中的ADAS等。
2021-03-03 11:28:28 14412
14412 簡(jiǎn)單介紹BT封裝基板的流程及制程能力,原創(chuàng)分享,歡迎討論交流。
2021-03-16 11:50:00 0
0 半導(dǎo)體封裝制程與設(shè)備材料知識(shí)簡(jiǎn)介。
2021-04-09 09:52:37 190
190 BGA封裝形式解讀 BGA(ball grid array)球形觸點(diǎn)陣列是表面貼裝型封裝之一;BGA封裝最早是美國Motorola 公司開發(fā)的。 BGA是在印刷基板的背面按陳列方式制作出球形凸點(diǎn)用以
2021-12-08 16:47:18 59434
59434 覆銅基板工藝流程簡(jiǎn)介
2021-12-13 17:13:50 0
0 pcb工藝相關(guān)知識(shí)BGA特性原理
2022-08-18 16:04:38 0
0 LTCC多層電路基板制造工藝流程較長(zhǎng),工藝復(fù)雜,基板收縮率、翹曲度、層間對(duì)位精度等都是影響產(chǎn)品性能的重要因素,目前這些都是LTCC基板制造工藝中控制的難點(diǎn),需要不斷進(jìn)行研究,改進(jìn)優(yōu)化LTCC制造工藝。
2022-12-16 14:19:06 2373
2373 UltraScale是基于20nm工藝制程的FPGA,而UltraScale+則是基于16nm工藝制程的FPGA。
2023-03-09 14:12:54 8669
8669 切開的這個(gè)CPU是BGA封裝的,底部的圓珠就是BGA錫球,在往上一層就是PCB基板,然后中間是CPU核心及導(dǎo)熱材料,上面的就是金屬保護(hù)蓋。
2023-04-03 11:27:13 2624
2624 直接鍍銅陶瓷基板(Direct Plating Copper, DPC)是在陶瓷薄膜工藝加工基礎(chǔ)上發(fā)展起來的陶瓷電路加工工藝。以氮化鋁/氧化鋁陶瓷作為線路的基板,采用濺鍍工藝于基板表面復(fù)合金屬層,并以電鍍和光刻工藝形成電路。
2023-05-31 10:32:02 4941
4941 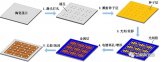
覆銅陶瓷基板(Direct Plating Copper, DPC)工藝:是一種用于制備高密度電子封裝材料的工藝方法。
2023-06-06 15:31:51 1952
1952 高溫下DPC(磁控濺射工藝)覆銅陶瓷基板的設(shè)計(jì)和應(yīng)用
2023-06-19 17:35:30 2617
2617 
陶瓷基板DPC(Direct Plating Copper)工藝和DBC(Direct Bond Copper)工藝是兩種常用的陶瓷基板制作工藝。盡管它們都是用于制作陶瓷基板的方法,但它們之間存在一些重要的區(qū)別,導(dǎo)致DPC工藝比DBC工藝更貴。
2023-07-28 10:57:27 2539
2539 
據(jù)了解現(xiàn)在很多3c電子工廠,電子產(chǎn)品都用底部填充膠來保護(hù)電路板芯片/BGA電子元件,其中電路板pcb也是有一定的成本,所以底部填充膠的返修也是個(gè)重要環(huán)節(jié).底部填充膠的返修工藝步驟:1.把CSP
2023-07-31 14:23:56 2507
2507 
BGA焊球重置工藝
2022-12-30 09:19:44 3
3 IC封裝制程簡(jiǎn)介
2022-12-30 09:20:09 11
11 [半導(dǎo)體前端工藝:第二篇] 半導(dǎo)體制程工藝概覽與氧化
2023-11-29 15:14:34 2642
2642 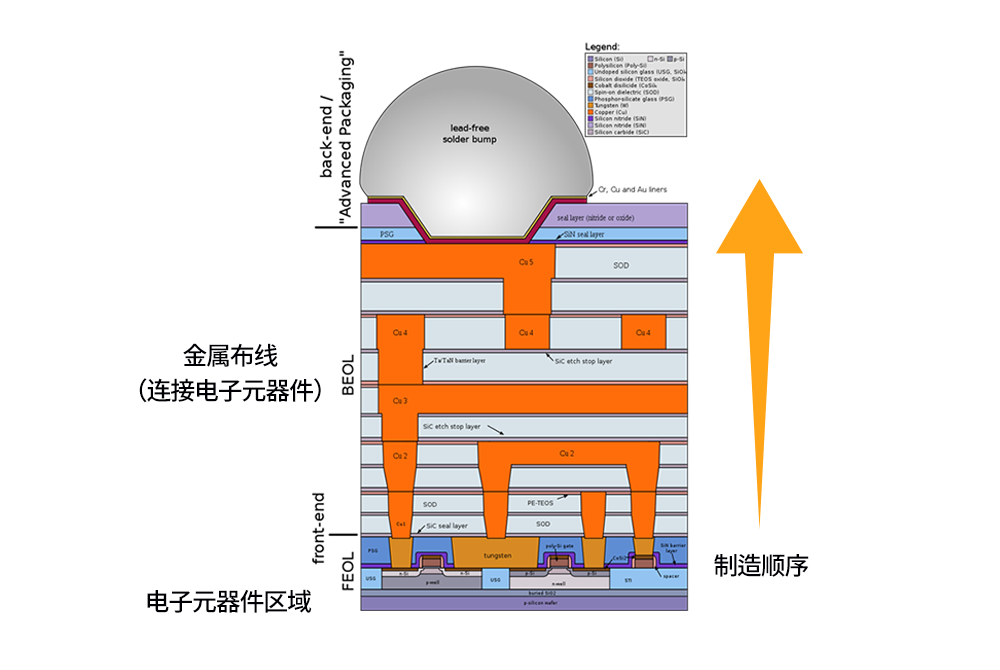
Toppan計(jì)劃從破產(chǎn)的顯示器企業(yè)joled收購位于日本石川縣中部尾的工廠,生產(chǎn)半導(dǎo)體封裝用fc-bga基板,并設(shè)立產(chǎn)品開發(fā)中心。該工廠的目標(biāo)是在2027年或之后開始生產(chǎn)。
2023-12-05 11:19:30 1478
1478 公司還透露,其位于廣州的封裝基板項(xiàng)目涵蓋FC-BGA、RF以及FC-CSP三大類別基板。一期工程已于2023年10月上線,目前正在穩(wěn)步調(diào)試生產(chǎn)線和產(chǎn)量提升中。
2024-01-24 14:01:51 1641
1641 LGA和BGA是兩種常見的封裝工藝,它們?cè)诩呻娐贩庋b中起著重要的作用。
2024-01-24 18:10:55 5202
5202 隨著BGA、CSP封裝器件向密間距、微型化的方向發(fā)展,無鉛制程的廣泛應(yīng)用給電子裝聯(lián)工藝帶來了新的挑戰(zhàn)。球窩(Pillow-head Effect)缺陷是BGA、CSP類器件回流焊接中特有的一種缺陷
2024-04-10 09:08:24 1617
1617 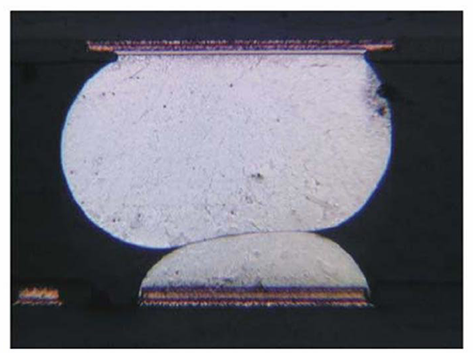
BGA混裝工藝中,存在關(guān)于鉛相擴(kuò)散不完整的誤區(qū)。隨著全球無鉛工藝的普及,大多數(shù)BGA器件已采用無鉛工藝,但由于特殊需求部分企業(yè)仍使用有鉛制程進(jìn)行焊接。對(duì)于不涉及BGA器件的產(chǎn)品,其工藝可以完全按照有鉛工藝進(jìn)行操作。只有含有無鉛BGA的有鉛制程才屬于真正的混裝工藝。對(duì)此,業(yè)界存在不同的觀點(diǎn)。
2024-04-28 09:50:39 67099
67099 
球柵陣列(Ball Grid Array,BGA)封裝具有體積小、引腳密度高、信號(hào)完整性和散熱性能佳等優(yōu)點(diǎn),因而廣泛應(yīng)用于大規(guī)模集成電路的封裝領(lǐng)域。植球工藝作為BGA封裝(連接器)生產(chǎn)中的關(guān)鍵工藝會(huì)
2024-07-15 15:42:26 761
761 
本章主要介紹了集成電路是如何從雙極型工藝技術(shù)一步一步發(fā)展到CMOS 工藝技術(shù)以及為了適應(yīng)不斷變化的應(yīng)用需求發(fā)展出特色工藝技術(shù)的。
2024-07-17 10:09:50 3052
3052 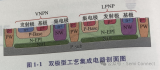
PMOS(Positive channel Metal Oxide Semiconductor,P 溝道金屬氧化物半導(dǎo)體)工藝制程技術(shù)是最早出現(xiàn)的MOS 工藝制程技術(shù),它出現(xiàn)在20世紀(jì)60年代。早期
2024-07-18 11:31:03 5079
5079 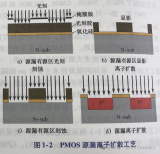
BCD 工藝制程技術(shù)只適合某些對(duì)功率器件尤其是BJT 或大電流 DMOS 器件要求比較高的IC產(chǎn)品。BCD 工藝制程技術(shù)的工藝步驟中包含大量工藝是為了改善 BJT 和 DMOS 的大電流特性,所以它
2024-07-22 09:40:32 6760
6760 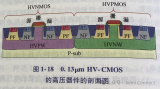
LG電子正考慮一項(xiàng)重要決策,計(jì)劃在其電視產(chǎn)品線中引入由關(guān)聯(lián)企業(yè)LG Innotek制造的倒裝芯片球柵陣列(FC-BGA)基板。此舉對(duì)LG Innotek而言意義非凡,作為公司重點(diǎn)培育的高端芯片基板新業(yè)務(wù),贏得LG電子這一重量級(jí)客戶的青睞,無疑將是其業(yè)務(wù)發(fā)展的重大利好。
2024-08-14 11:46:16 1254
1254 隨著電子技術(shù)的發(fā)展,集成電路的封裝技術(shù)也在不斷進(jìn)步。BGA封裝因其高密度、高性能和良好的電氣特性而廣泛應(yīng)用于高性能電子設(shè)備中。 1. 基板制備 BGA封裝的第一步是基板的制備。基板通常由玻璃纖維增強(qiáng)
2024-11-20 09:22:19 3676
3676 隨著電子技術(shù)的飛速發(fā)展,BGA封裝因其高集成度和高性能而廣泛應(yīng)用于各種電子產(chǎn)品中。然而,BGA封裝的焊接工藝相對(duì)復(fù)雜,需要精確控制以確保焊接質(zhì)量和產(chǎn)品的可靠性。 1. 準(zhǔn)備工作 1.1 材料準(zhǔn)備
2024-11-20 09:37:45 3992
3992 芯片封裝隨著制程的越來越先進(jìn),其生產(chǎn)制造工藝也開始從宏觀制程轉(zhuǎn)向微縮制程,量產(chǎn)工藝也越來越半導(dǎo)體制程化。 而在2D平面封裝越來越難以適應(yīng)更大的帶寬傳輸容量,以及更高的互聯(lián)速度性能要求時(shí)。2.5D3D
2025-01-02 10:06:46 4009
4009 人員改進(jìn)設(shè)計(jì)與工藝,提升良率。 設(shè)計(jì)缺陷 首先,開窗設(shè)計(jì)不合理是返修的關(guān)鍵因素。開窗面積過大、位置靠近基板邊緣或鉆孔,會(huì)引發(fā)應(yīng)力集中,導(dǎo)致開裂或翹曲。另外,線路布局過于密集、線寬線距超出工藝極限,也易引發(fā)短路和斷
2025-07-30 15:45:27 451
451 已全部加載完成


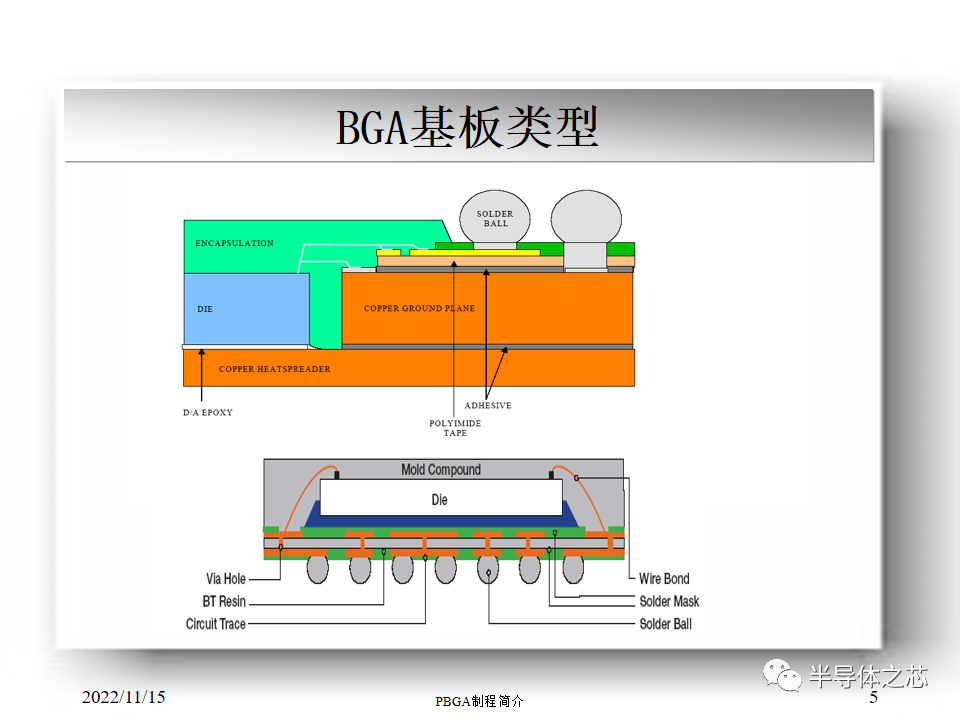


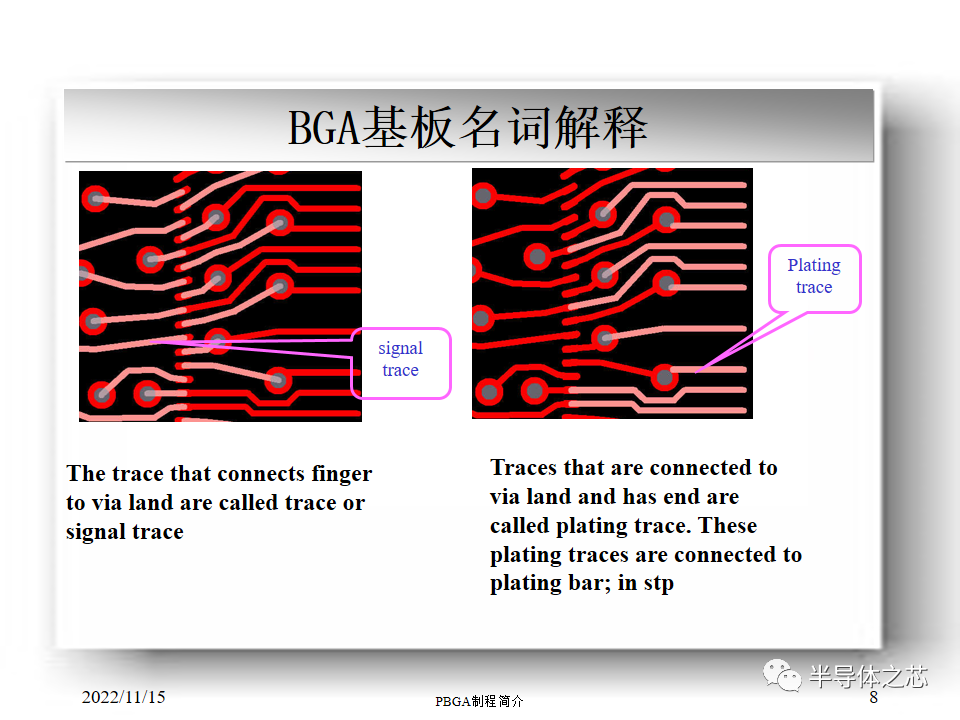

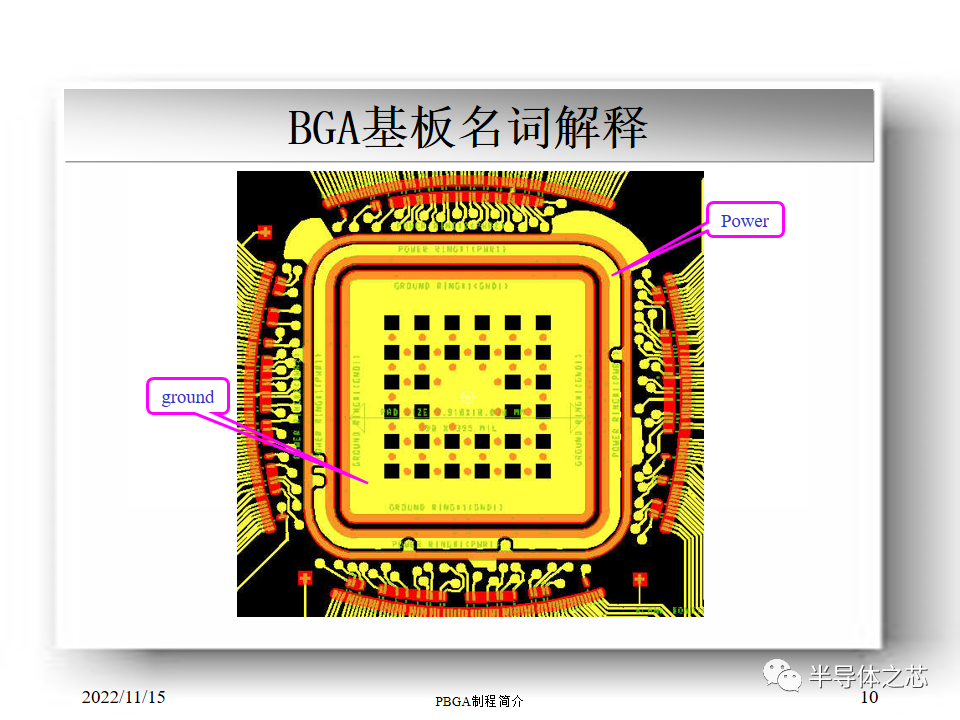

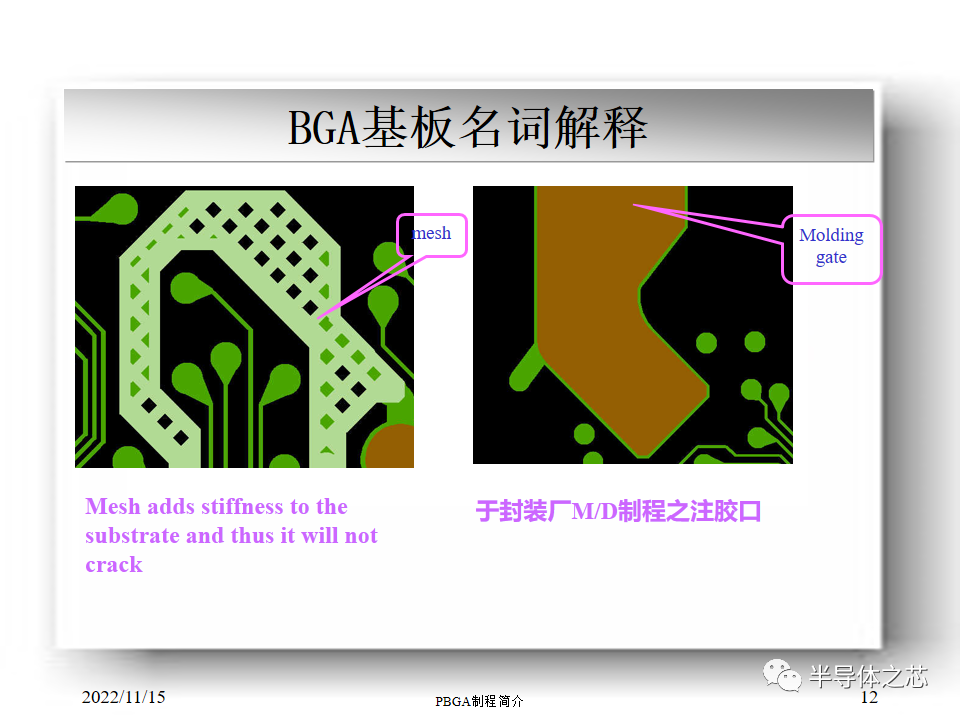



















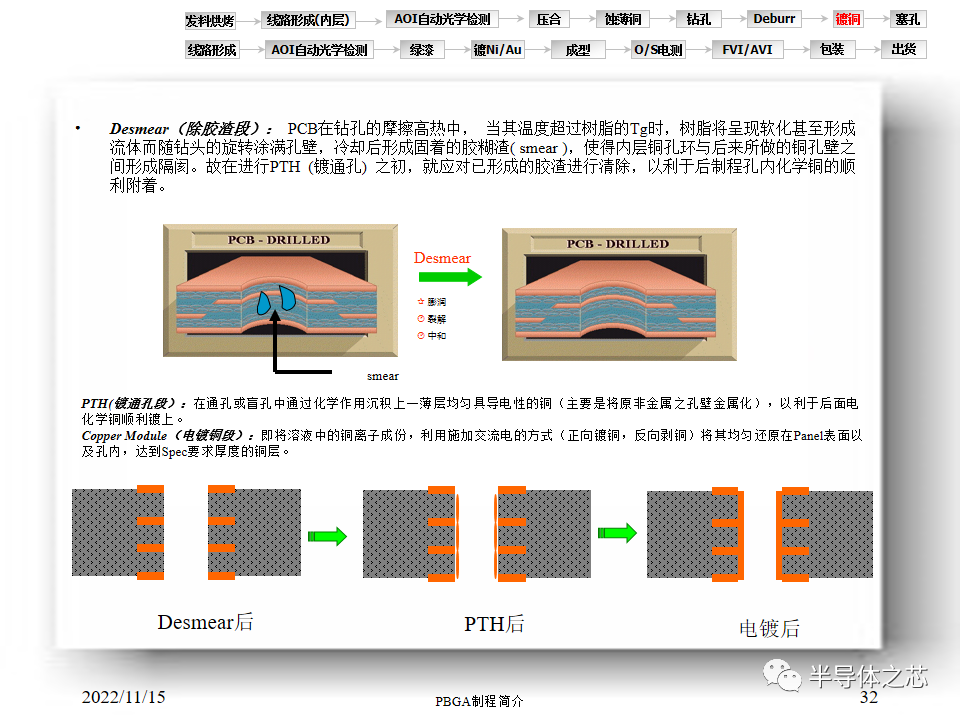














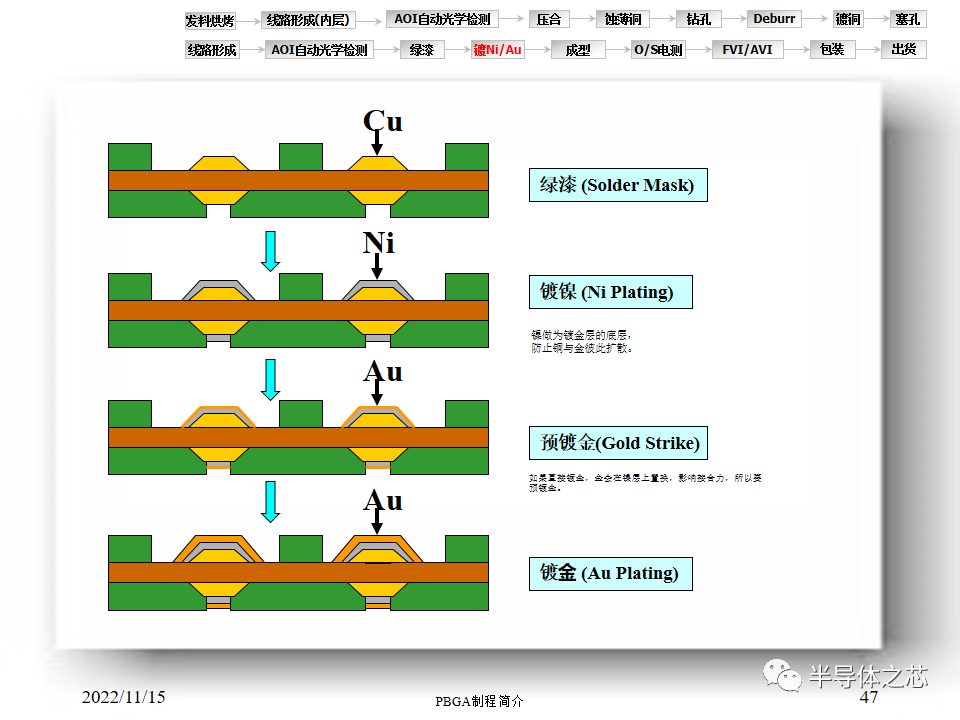



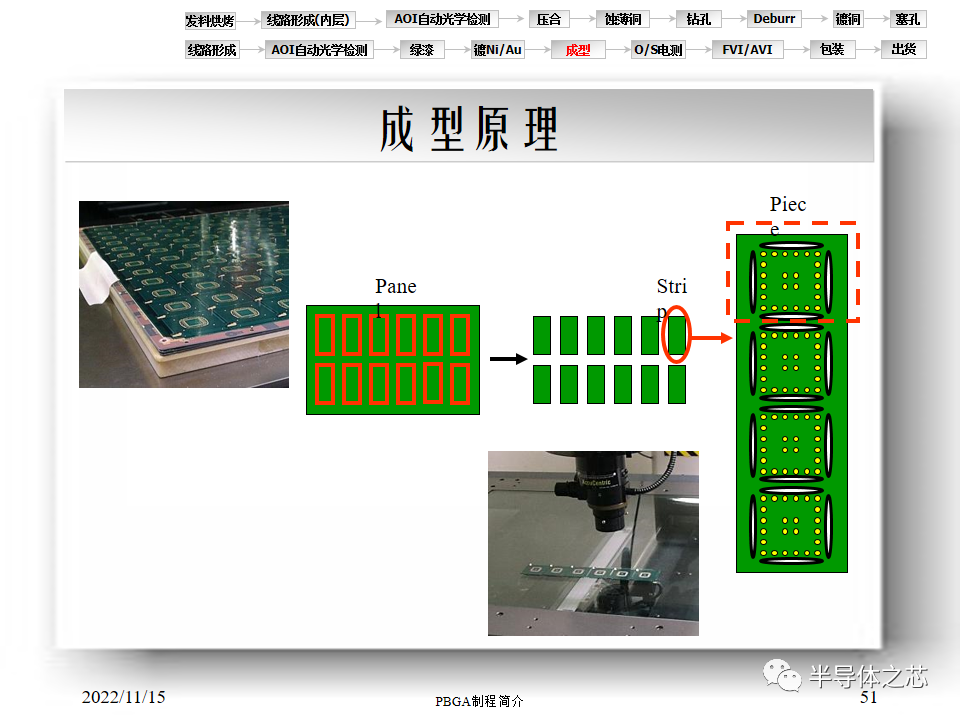






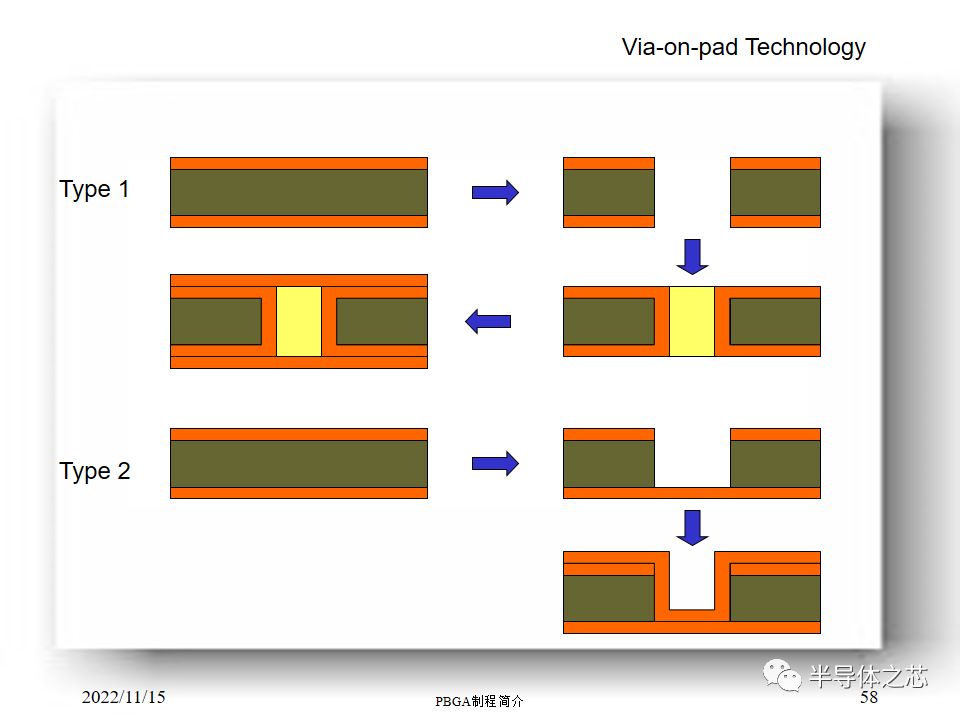



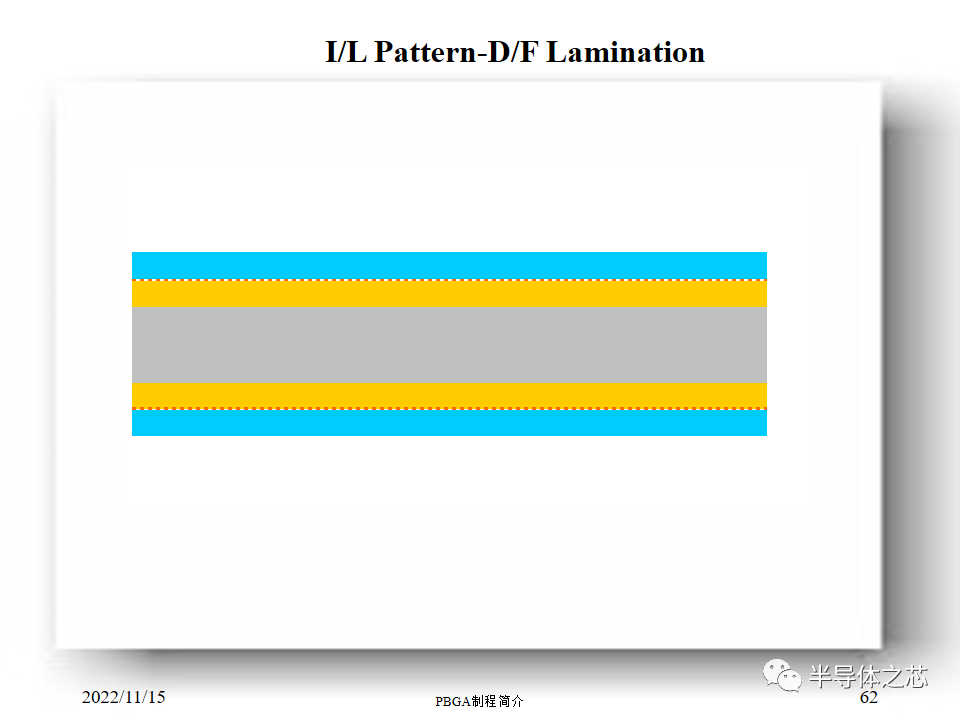

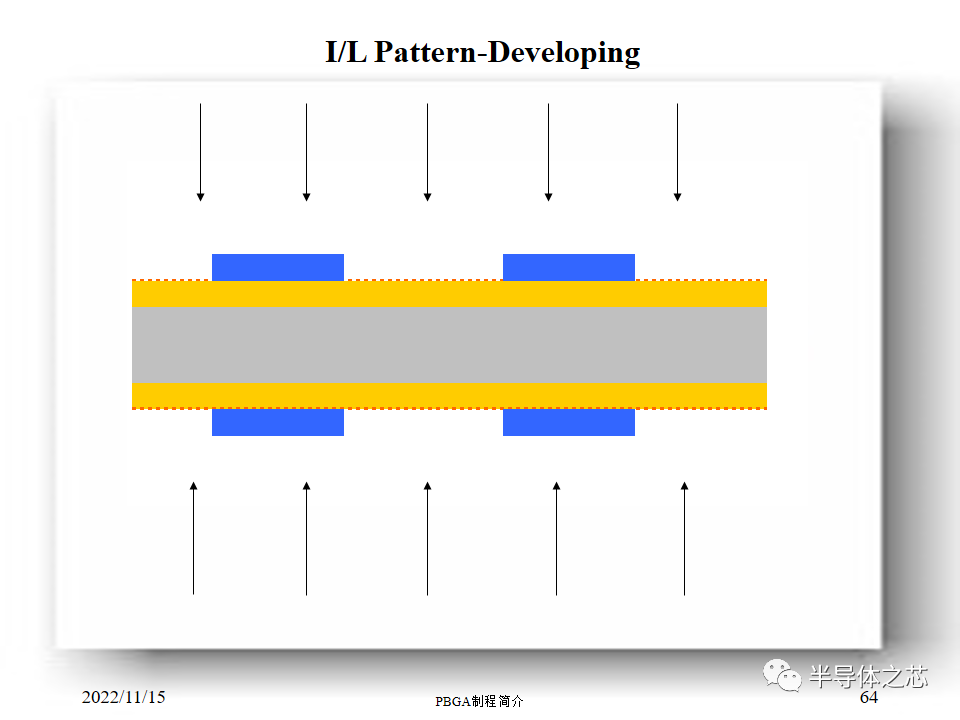
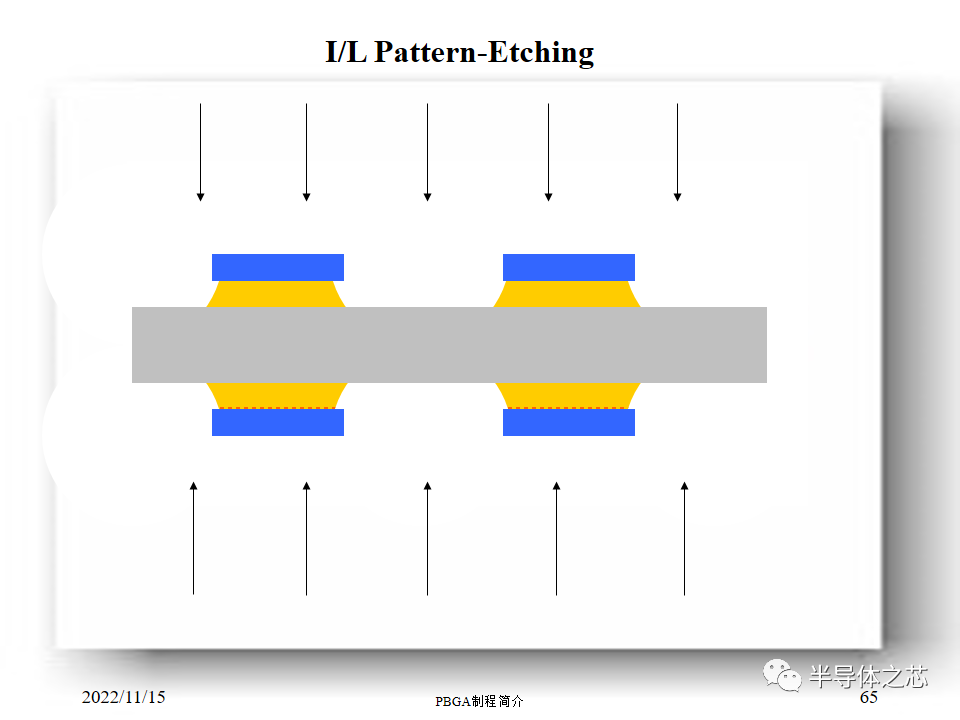
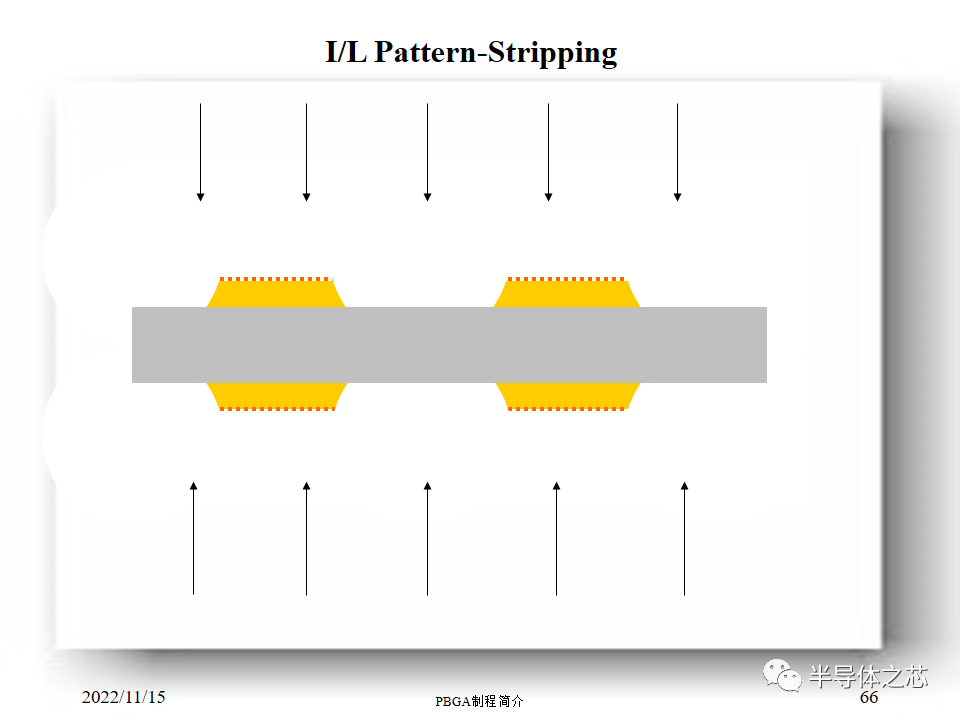




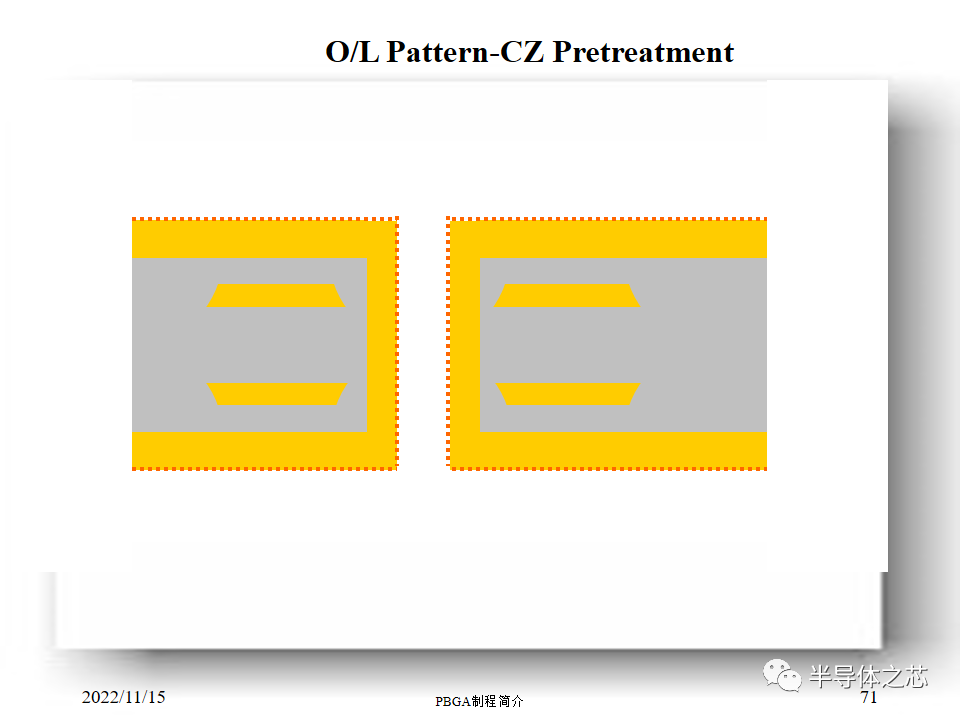
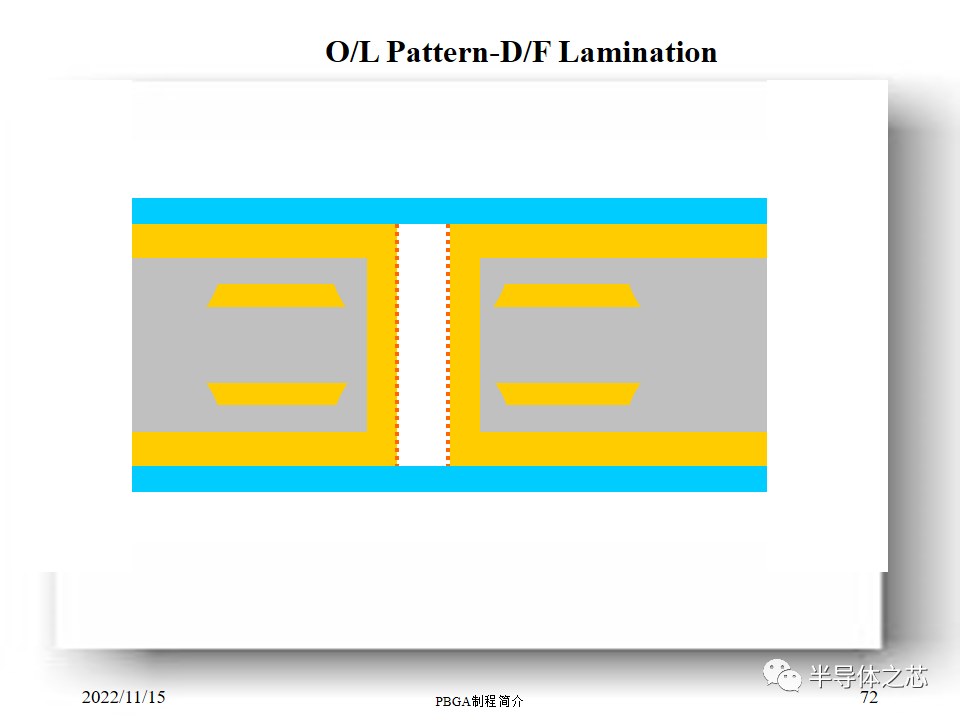
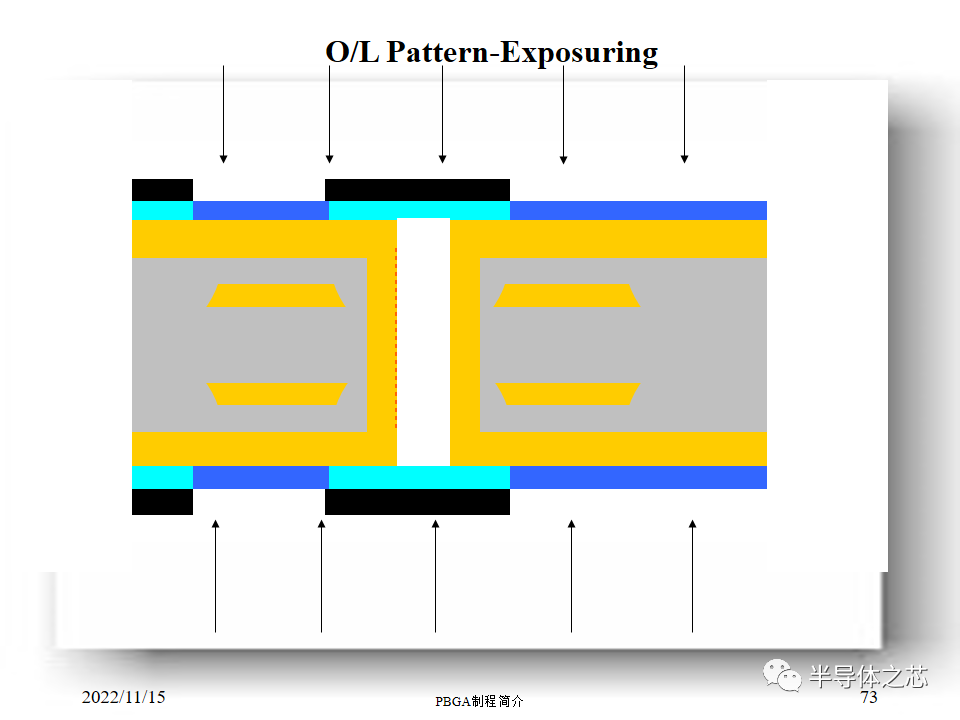
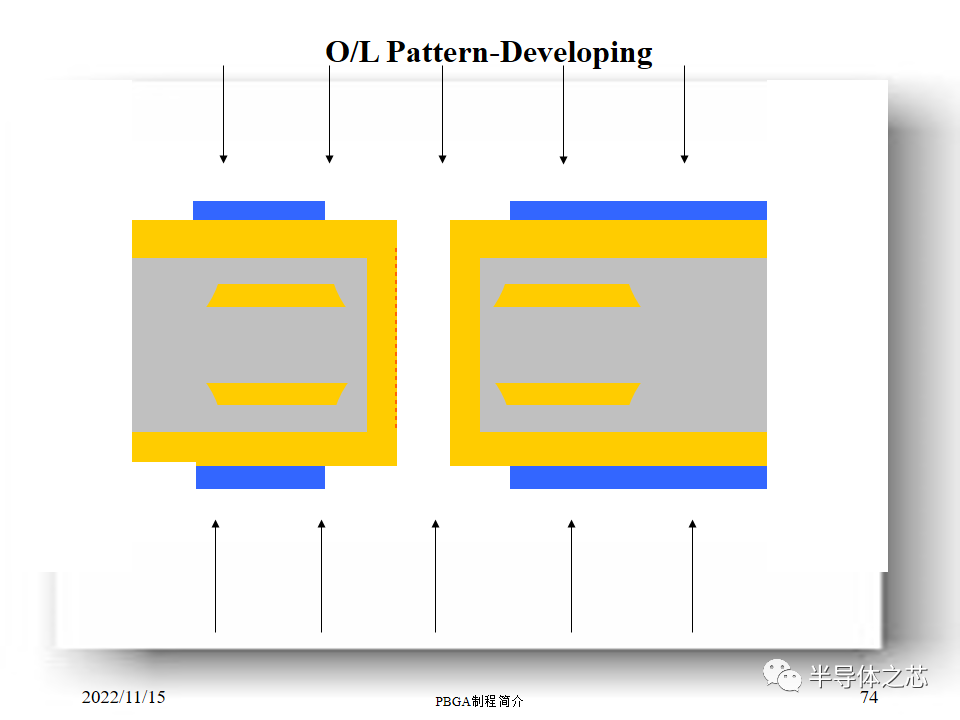
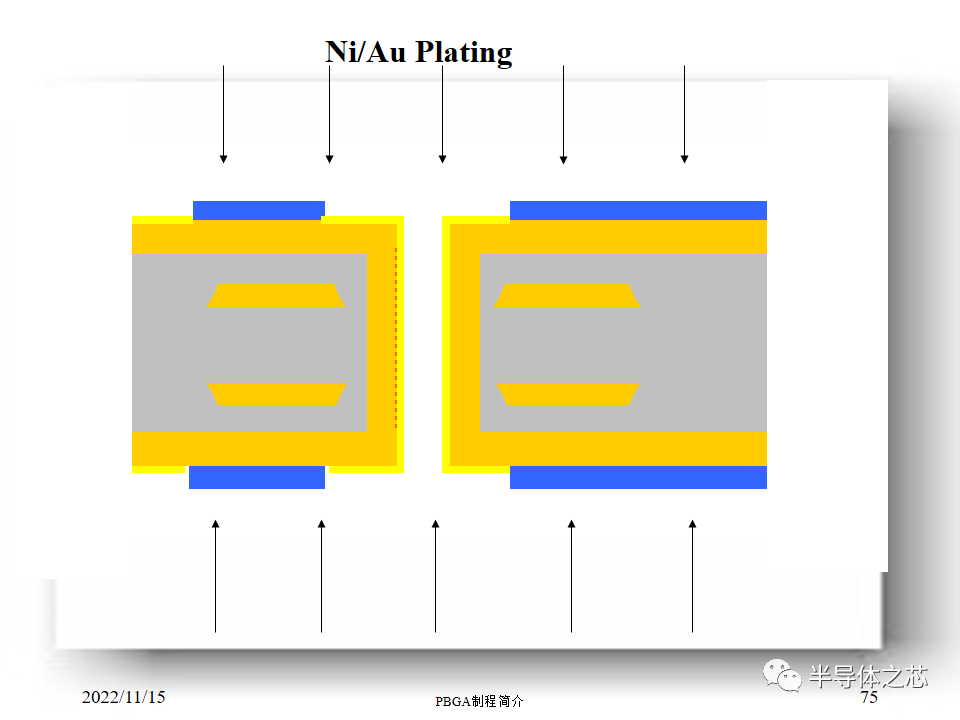
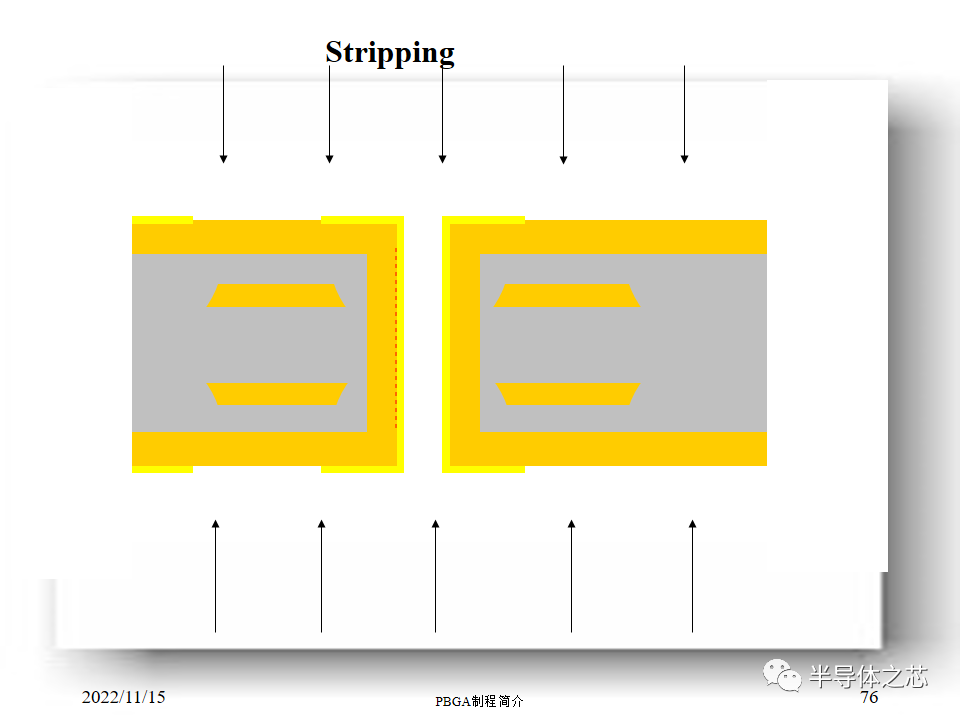
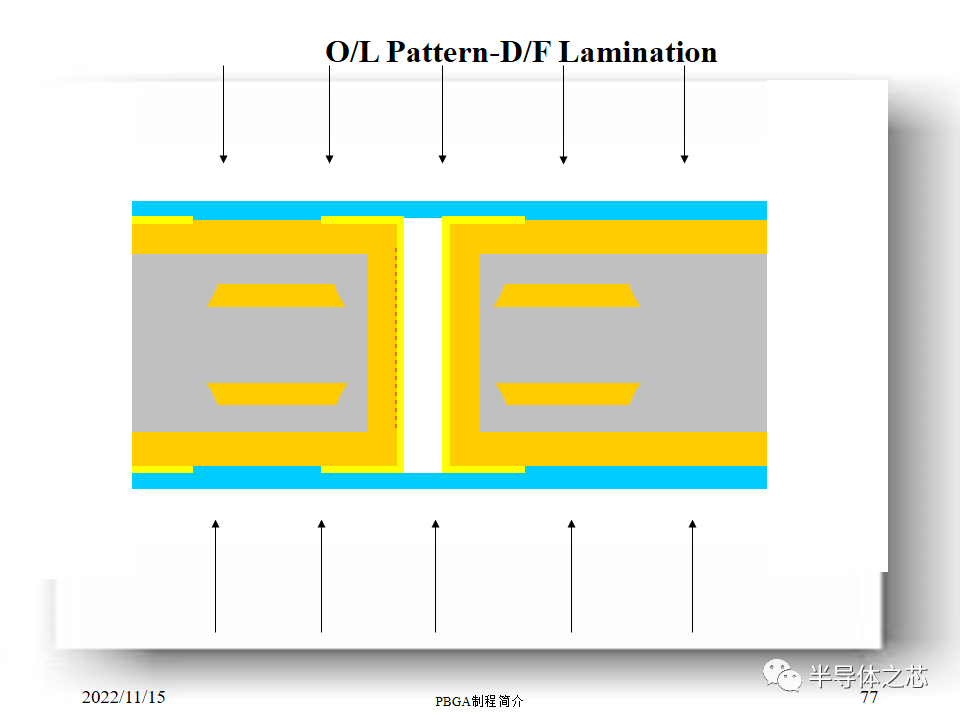
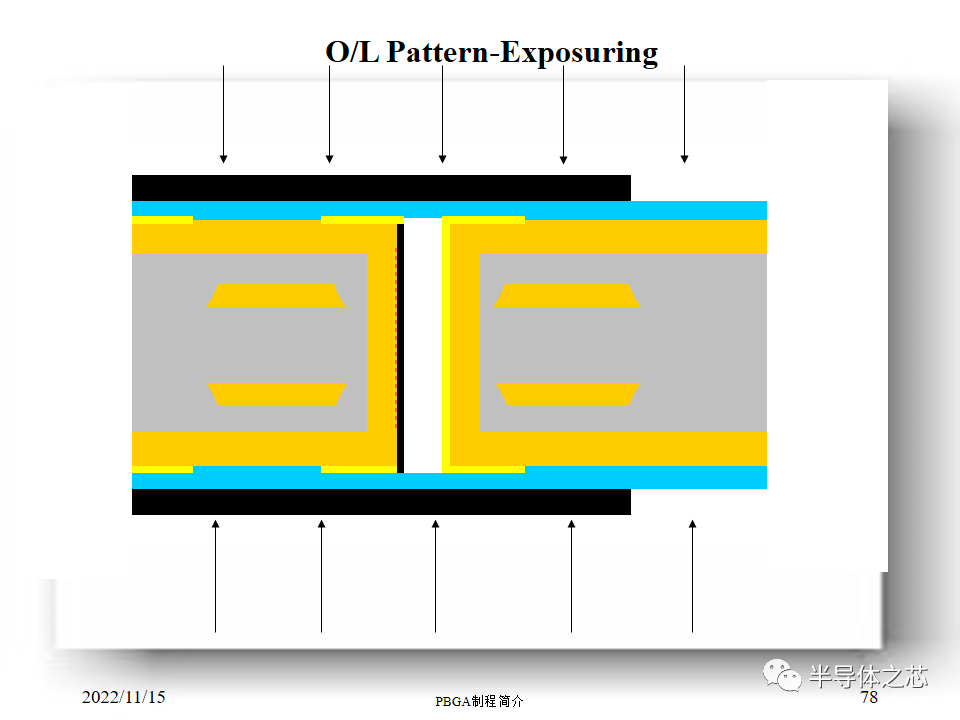
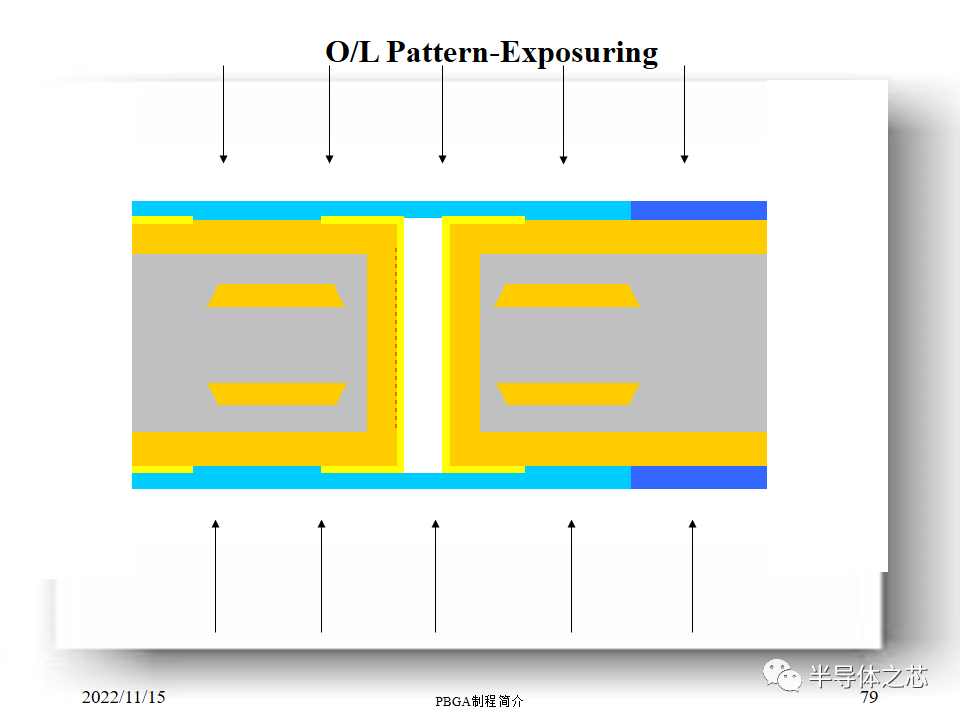
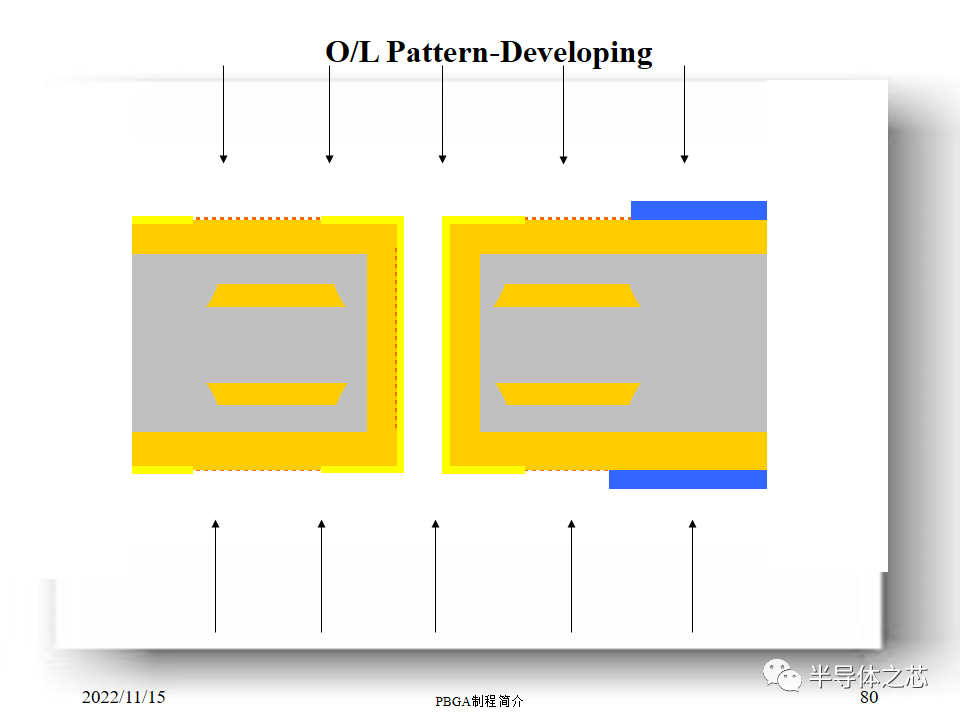
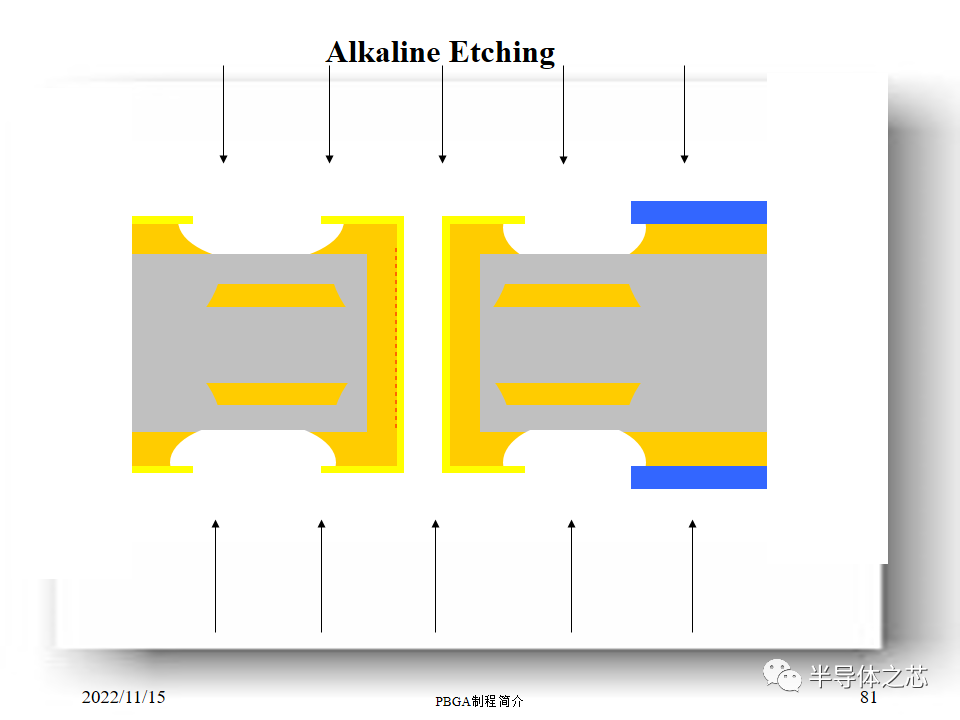
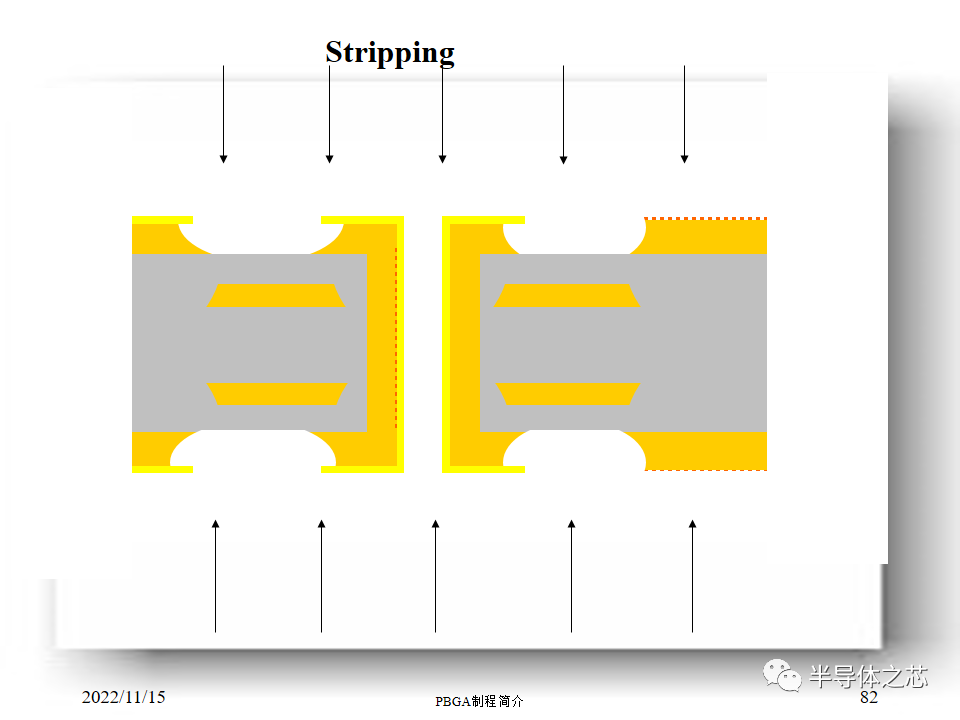
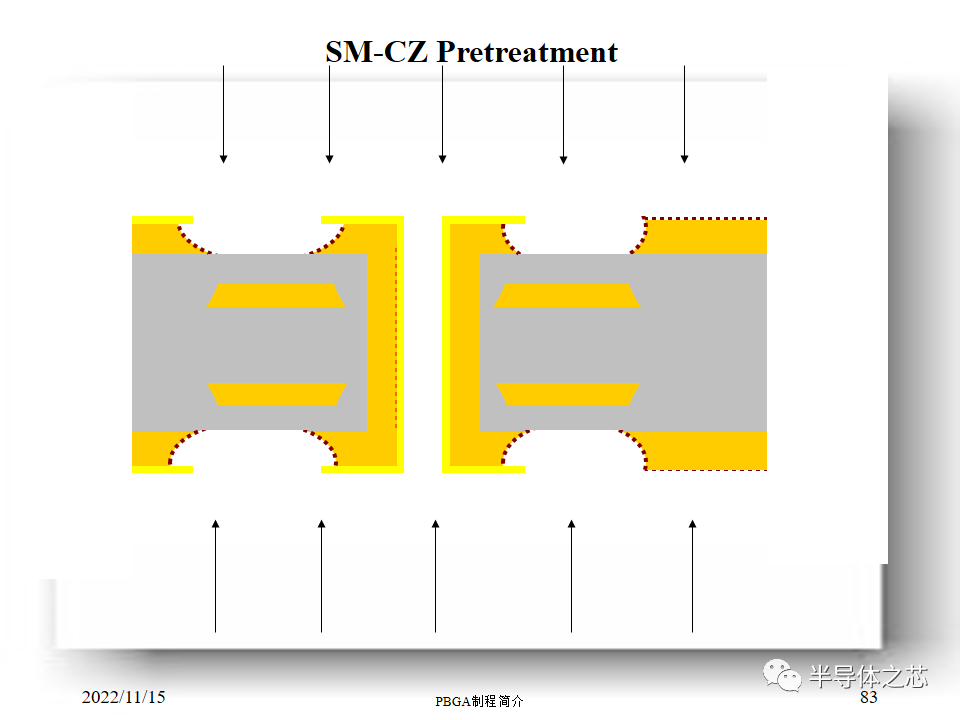




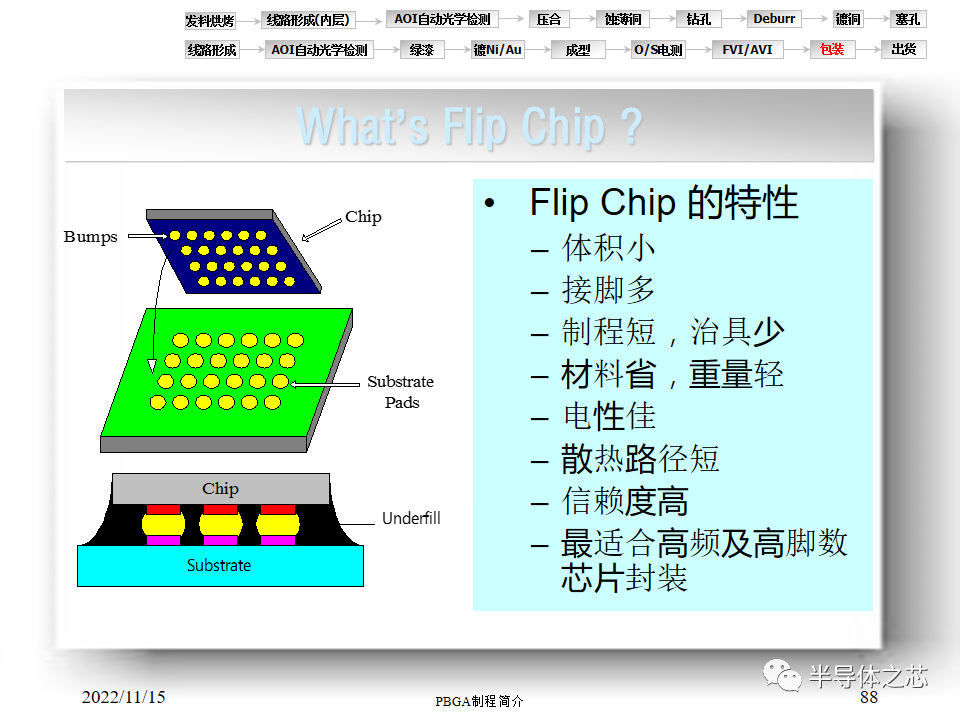
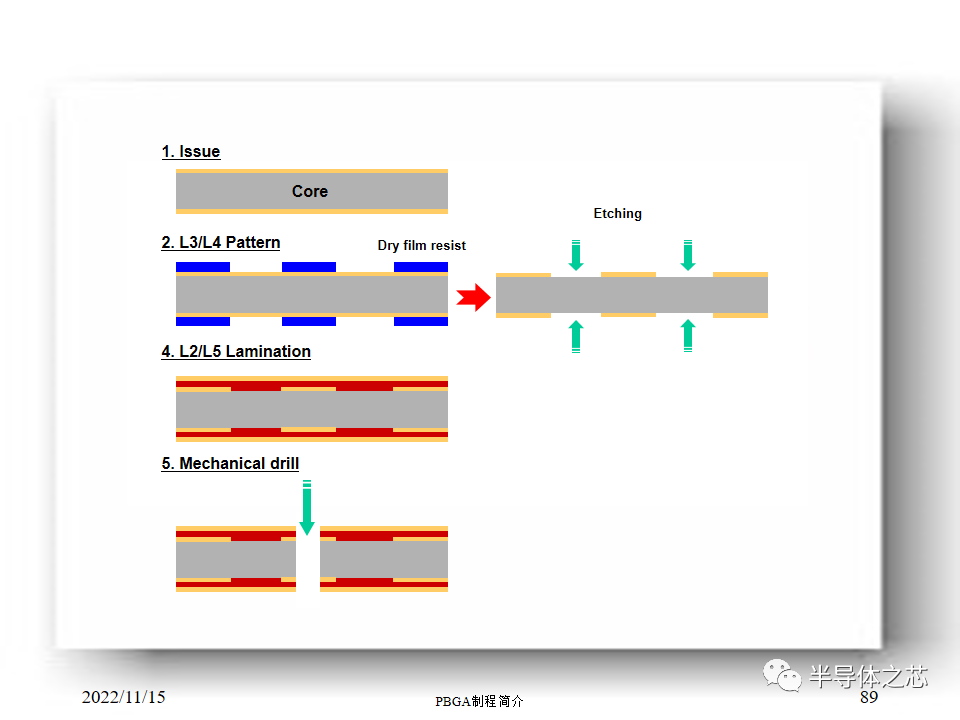
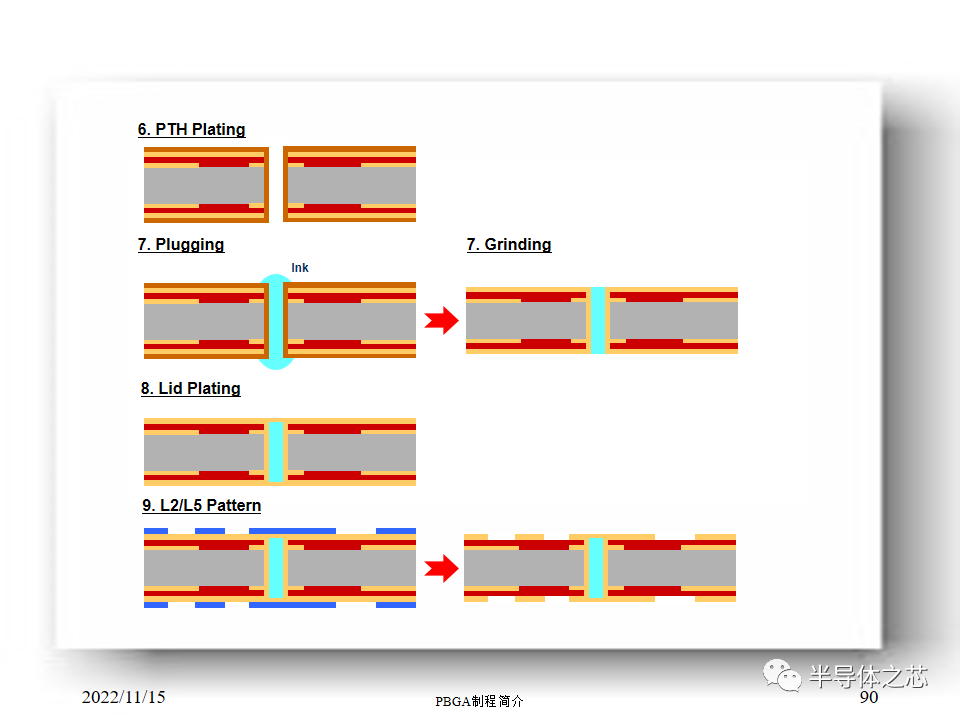
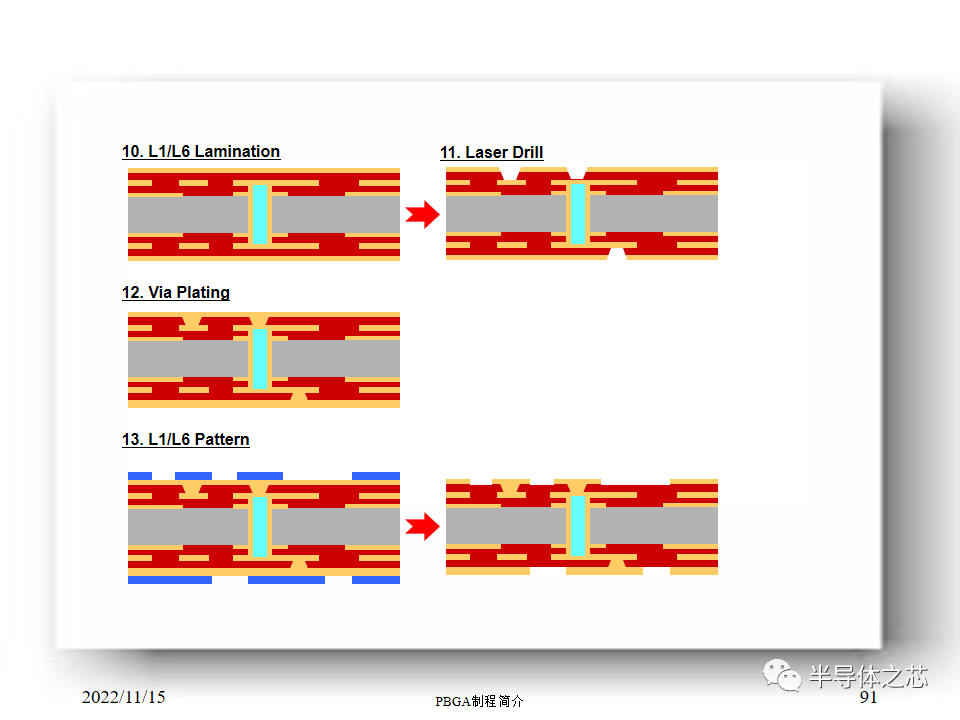
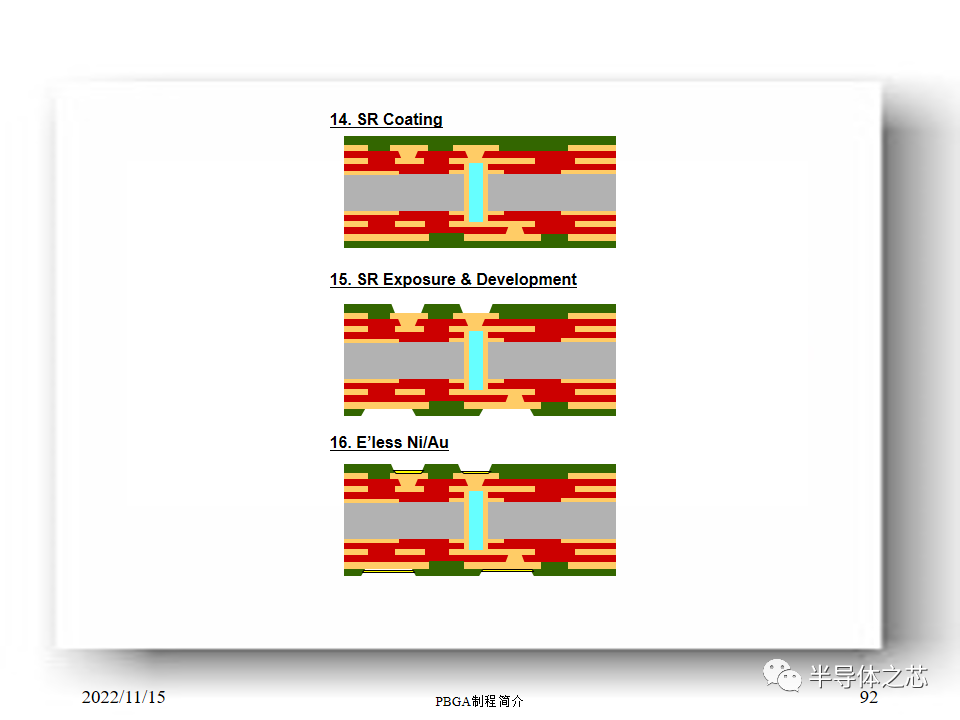
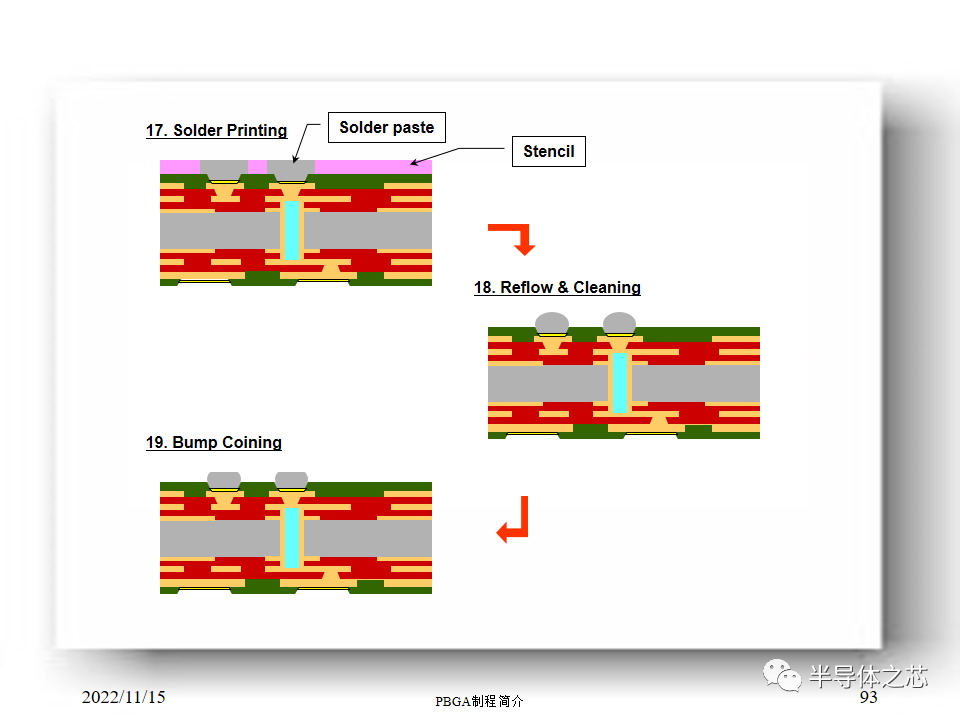
 電子發(fā)燒友App
電子發(fā)燒友App

 硬聲App
硬聲App


 2934
2934
 3524
3524 7161
7161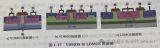
 4121
4121
 5251
5251 0
0 4855
4855 9525
9525 1343
1343 10857
10857 7030
7030 0
0 1597
1597
 2993
2993 0
0 8
8 14389
14389 45469
45469 5053
5053 12376
12376 24964
24964 6471
6471 14066
14066 15596
15596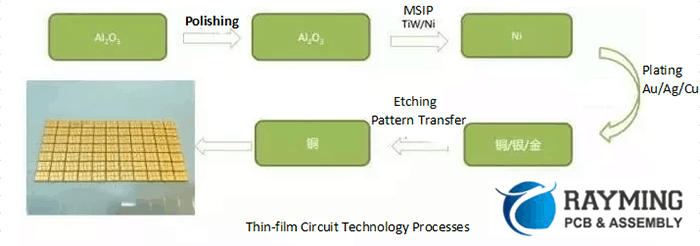
 8220
8220 4502
4502 7162
7162 9783
9783 0
0 7222
7222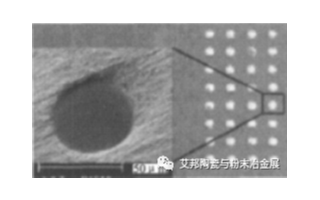
 3099
3099 14412
14412 59434
59434 2373
2373 8669
8669 2624
2624 4941
4941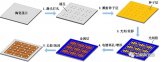
 2617
2617 2539
2539
 2507
2507
 1478
1478 1641
1641 1617
1617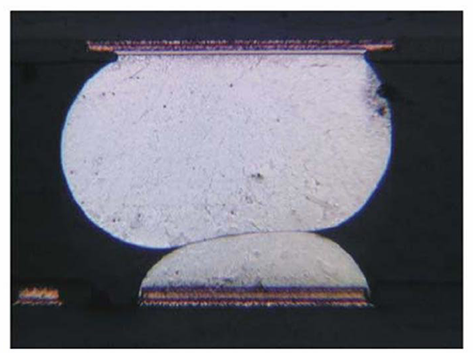
 67099
67099
 761
761
 3052
3052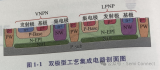
 5079
5079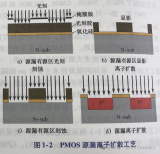
 6760
6760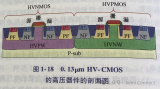
 1254
1254 3676
3676 3992
3992 4009
4009 451
451
評(píng)論