引言
本文主要報(bào)道了ProTEK PSB在實(shí)際應(yīng)用條件下的圖形化特性、抗蝕性和去除特性。研究發(fā)現(xiàn)了ProTEK PSB的兩個(gè)問題:不可接受的大側(cè)刻和有機(jī)溶劑或氧化灰難以去除引物。為了制造一個(gè)lsi集成的觸覺傳感器,我們使用了帶有低溫氧化物底層的ProTEK PSB。這種組合解決了ProTEK PSB的側(cè)面刻蝕問題和低溫氧化物的針孔問題,提供了可以在低溫下制備的實(shí)用堿性刻蝕掩膜。
實(shí)驗(yàn)
首先,在Si基板上適量滴加底漆,在3000pm下旋轉(zhuǎn)涂布1分鐘。 涂布底漆后,使用熱板在110C下280°℃分鐘 用加熱1分鐘。 然后,滴下ProTEKPSB,與底漆相同,在3000 rpm下旋涂1分鐘。 涂上ProTEK PSB后,用熱板在110℃下加熱1分鐘加熱。加熱后,用I線以1000mJ/cm2的曝光量進(jìn)行曝光。 曝光后,用熱板在110℃下加熱2分鐘。 影時(shí),在乳酸乙酯中浸泡5分鐘,充分?jǐn)嚢瑁?顯影后,用異丙醇( IPA )清洗,用旋轉(zhuǎn)干燥器干燥。 最后,用熱板在220C下加熱3分鐘使之硬化。
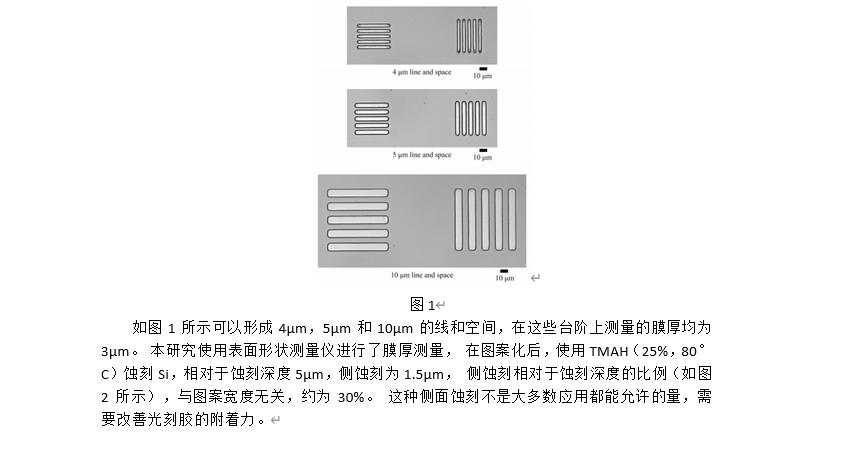
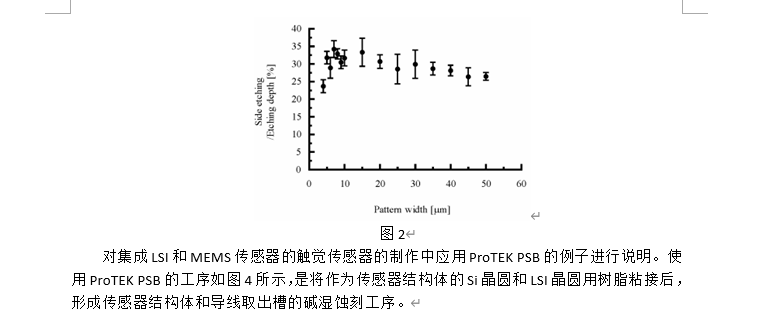

作為能夠低溫形成的堿性濕法蝕刻用掩模,與單獨(dú)使用低溫氧化膜和ProTEK PSB的掩模相比,低溫氧化膜和ProTEK PSB組合的掩模能夠抑制側(cè)面蝕刻,為了更容易理解而進(jìn)行的比較實(shí)驗(yàn)的結(jié)果。 作為掩膜,顯示了使用(a)ProTEK PSB、(b)通過等離子CVD堆積的低溫氧化膜、(c)通過等離子CVD堆積的低溫氧化膜和ProTEK PSB的組合、以及(d)通過高頻磁控濺射堆積的低溫氧化膜和ProTEK PSB的組合的結(jié)果。 這里,蝕刻深度為200μm。 僅將低溫氧化膜用于掩模時(shí),針孔不僅會(huì)產(chǎn)生蝕刻坑,特別是在掩模端通過針孔進(jìn)行側(cè)面蝕刻。 另一方面,如果將低溫氧化膜與ProTEK組合,則可以得到良好的結(jié)果。
結(jié)論
對(duì)新型堿性濕法蝕刻用負(fù)型光敏性抗蝕劑ProTEK PSB和非光敏性的ProTEK B3進(jìn)行了評(píng)價(jià)。 使用ProTEK PSB可以形成4μm的線和空間。 另外,側(cè)面蝕刻相對(duì)于蝕刻深度的比例約為30%,與蝕刻寬度無關(guān)。 另外,ProTEK PSB可以用O2灰化除去,殘留的底漆可以用1%HF完全除去。 側(cè)面蝕刻較大,以及底漆剝離需要HF,這是ProTEK PSB實(shí)際應(yīng)用于器件時(shí)的問題。 本論文提出了回避這些問題的方法。
將涂有ProTEK B3的Si基板在TMAH(25%,80°C)中浸泡24小時(shí)后,通過側(cè)面蝕刻從晶圓端剝離了1 mm。 另外,ProTEK B3可以用丙酮和O2灰化除去,殘留的引物可以用1%HF完全除去,將LSI和MEMS傳感器集成化的觸覺傳感器的制作工藝適用于ProTEK PSB。 在從LSI晶圓背面取出器件的電線的工序中,通過TMAH對(duì)LSI晶圓背面進(jìn)行蝕刻,但由于工藝溫度的限制,無法在LSI晶圓上形成熱氧化膜和高溫氮化膜作為掩模材料。
因此,在利用等離子CVD在350°C下沉積,或者利用高頻磁控濺射沉積的低溫氧化膜上對(duì)ProTEK PSB進(jìn)行圖案化,利用HF對(duì)低溫氧化膜進(jìn)行蝕刻,直接利用TMAH進(jìn)行了蝕刻。 因此防止了低溫氧化膜從針孔中的蝕刻,如果使用通過等離子體CVD在350℃下沉積的低溫氧化膜,則側(cè)蝕刻可以控制在9μm,如果使用通過高頻磁控濺射沉積的低溫氧化膜,則側(cè)蝕刻可以控制在15μm。
審核編輯:湯梓紅
 電子發(fā)燒友App
電子發(fā)燒友App




























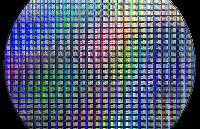
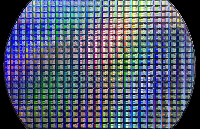
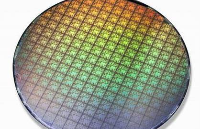
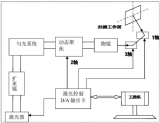

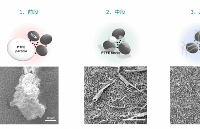





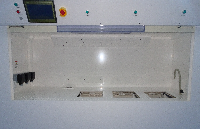
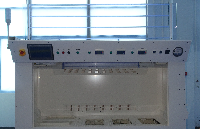
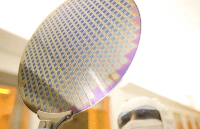


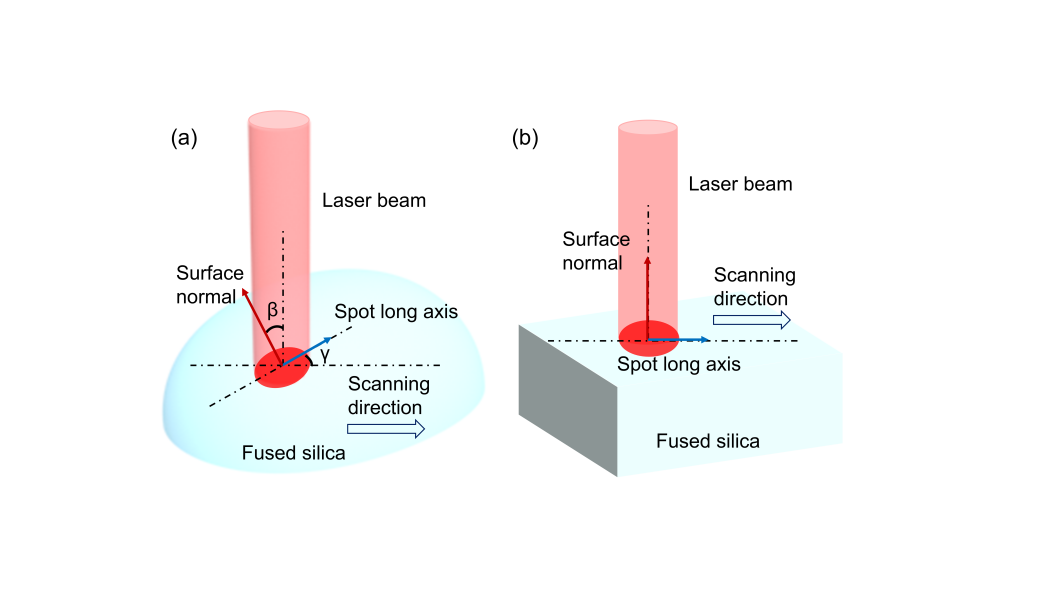







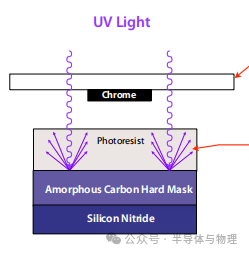





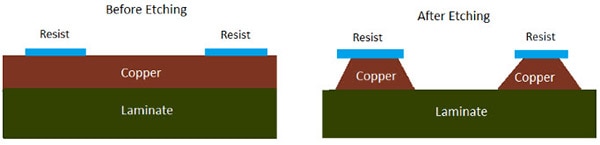







評(píng)論