一 MEMS加速度計所用的材料
例如用于做襯底的襯底材料,用于做掩膜的掩膜材料,用于表面微加工的犧牲層材料等等。Mems加速度計常用的材料有單晶硅、二氧化硅、碳化硅、氮化硅、多晶硅等等,具體哪種材料用于哪一部分不是固定的,需要在設(shè)計過程中根據(jù)其物理化學(xué)性質(zhì)以及在加速度計中的作用加以綜合考慮。
因為該傳感器動態(tài)要求比較高因此在進行完結(jié)構(gòu)設(shè)計,得到結(jié)構(gòu)的尺寸以后進行有限元分析是必不可少的。運用有限元分析軟件ANSYS對加速度計模型進行分析,可以得到下面的結(jié)果:?
(1)?進行靜力分析,可以發(fā)現(xiàn)承受應(yīng)力最大的部位。
(2)??進行模態(tài)分析,可以得到結(jié)構(gòu)的固有頻率和各固有頻率下的振型。
(3)??進行瞬態(tài)動力學(xué)分析,可以得到結(jié)構(gòu)對外界激勵的響應(yīng)。
通過以上有限元分析的結(jié)果,可以進一步改進設(shè)計,使所設(shè)計的加速度計具有更好的性能。
二 MEMS加速度計所用的工藝法
工藝的選擇電容式MEMS加速度計的工藝一般采用的有:表面工藝、體硅工藝、LIGA工藝及SOI+DRIE工藝等對這幾種工藝進行了對比。
1、?表面工藝是在集成電路平面工藝基礎(chǔ)上發(fā)展起來的一種微工藝,只進行單面光刻。它利用硅平面上不同材料的順序淀積和選擇腐蝕來形成各種微結(jié)構(gòu)。主要包括犧牲層淀積、犧牲層刻蝕、結(jié)構(gòu)層淀積、結(jié)構(gòu)層刻蝕、犧牲層去除(釋放結(jié)構(gòu))等。最后使結(jié)構(gòu)材料懸空于基片之上,形成各種形狀的二維或三維結(jié)構(gòu)。
2、體硅工藝是指沿著硅襯底的厚度方向?qū)枰r底進行刻蝕的工藝,包括濕法刻蝕和干法刻蝕,是實現(xiàn)三維結(jié)構(gòu)的重要方法。為了形成完整的微結(jié)構(gòu),往往在加工的基礎(chǔ)上用到鍵合或粘接技術(shù),將硅的鍵合技術(shù)和體硅加工方法結(jié)合起來。硅的微結(jié)構(gòu)經(jīng)過多次掩膜、單面或雙面光刻以及各向異性刻蝕等工藝而成,然后將有關(guān)部分精密對準(zhǔn)鍵合成一整體。體硅加工工藝過程比硅表面加工復(fù)雜,體積大,成本高。
3、SO1+DRIE工藝是體硅工藝的一種延伸與發(fā)展。利用絕緣體上硅(SOI)制造單晶硅三維微結(jié)構(gòu)是最近幾年發(fā)展異常迅速的方法。利用SOI制造微結(jié)構(gòu)的方法幾乎都是利用DINE(深反應(yīng)離子刻蝕)對單晶硅進行深刻蝕。根據(jù)結(jié)構(gòu)的不同、性能要求等可采用正面結(jié)構(gòu)釋放和背面結(jié)構(gòu)釋放。
fqj
 電子發(fā)燒友App
電子發(fā)燒友App















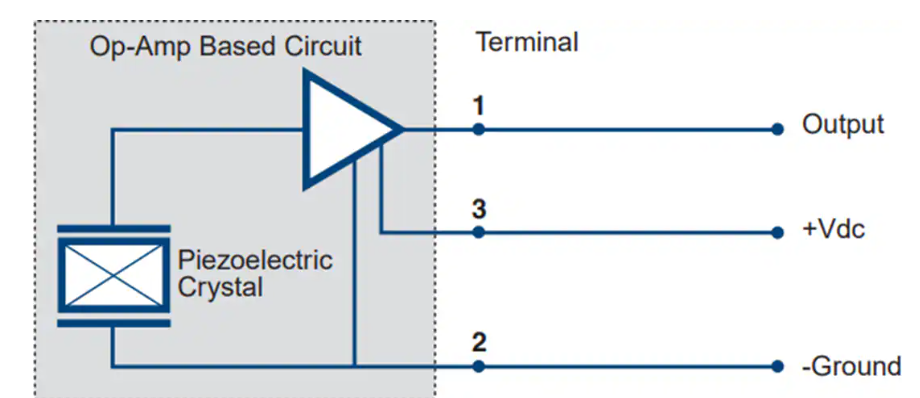

















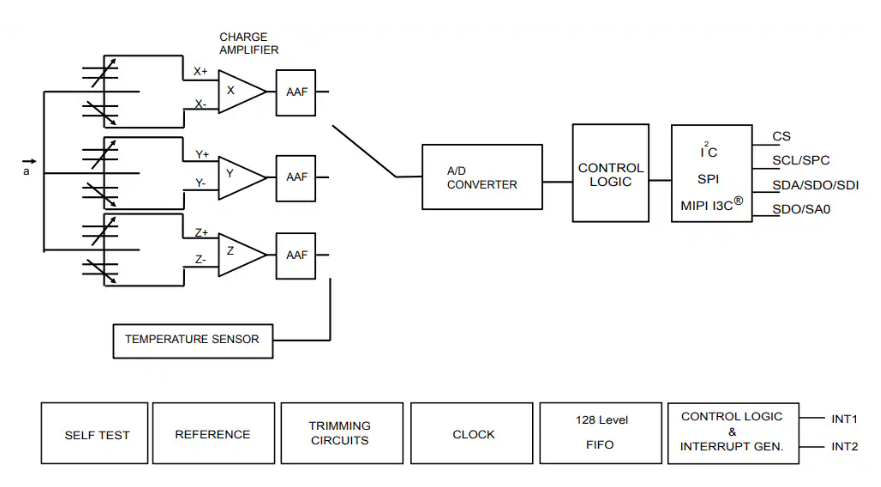
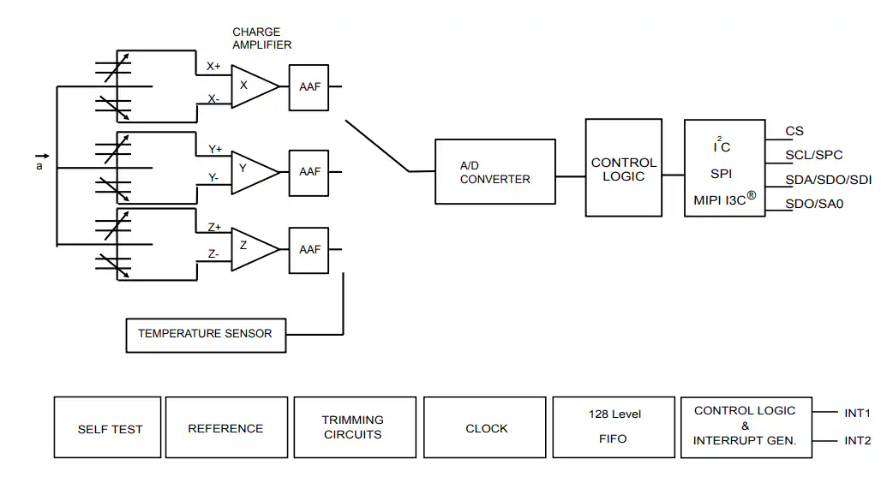

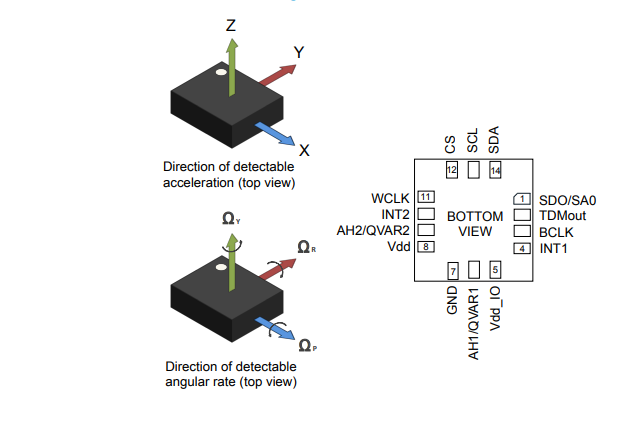



























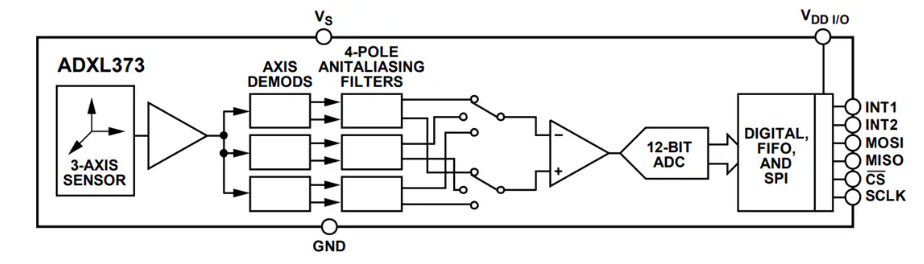
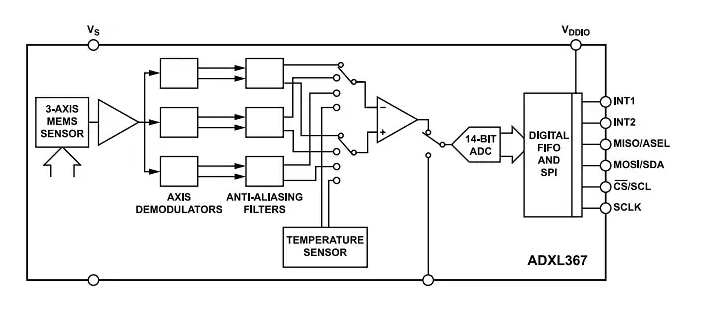

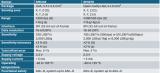
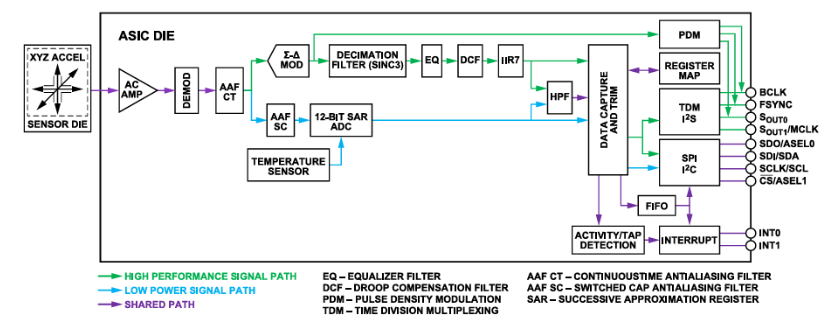


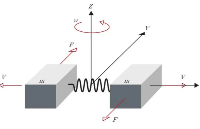
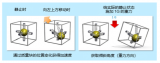






評論