圖9-5展示了使用Kirchhof方法與嚴(yán)格的電磁場(chǎng)(EMF)仿真進(jìn)行掩模建模所得結(jié)果之間的區(qū)別。Kirchhoff方法假設(shè)掩模無(wú)限薄,透過(guò)掩模的光直接從掩模版圖中獲得。掩模無(wú)吸收層區(qū)域的透射率為1.0,鉻覆蓋區(qū)域的透射率為0.0,透射光的相位在整個(gè)掩模上是恒定的。

嚴(yán)格的EMF仿真計(jì)算吸收層圖形附近區(qū)域光的強(qiáng)度和相位。圖9-5所示光強(qiáng)分布圖的左上角和右上角的駐波圖形是人射光和來(lái)自襯底/吸收層界面的反射光之間的干涉引起的。部分光通過(guò)吸收層中的蝕刻開(kāi)口透射傳播到投影物鏡,透射光的相位類似于從蝕刻掩模開(kāi)口處發(fā)射的圓柱波,圖9-5所示透射近場(chǎng)的光強(qiáng)和相位為直接從吸收層下方獲得的。與Kirchhoff方法的結(jié)果相反,透射光的強(qiáng)度和相位沿x軸呈現(xiàn)連續(xù)變化。
兩種掩模建模方法獲得的透射光之間的差異非常大。然而,并非該差異的所有細(xì)節(jié)對(duì)于在掩模遠(yuǎn)場(chǎng)處獲得的圖像都重要,例如,該差異的一個(gè)重要部分是倏逝波引起的,但它傳播不到遠(yuǎn)場(chǎng)。此外,利用投影鏡頭的有限數(shù)值孔徑充當(dāng)帶通濾波器,可進(jìn)一步消除這種差異。接下來(lái)的兩個(gè)小節(jié)將研究遠(yuǎn)場(chǎng)中的衍射光和使用光刻投影系統(tǒng)獲得的圖像。
9.2.1 掩模衍射分析
首先考慮平面波對(duì)掩模上周期性線空?qǐng)D形的衍射。掩模衍射分析研究單個(gè)衍射級(jí)的強(qiáng)度和相位值與偏振、周期和入射角的關(guān)系。此類分析的結(jié)果用于確定應(yīng)用嚴(yán)格EMF建模所需要條件。此外,掩模衍射分析提供了對(duì)掩模形貌引起的成像偽影更深人的理解。掩模衍射分析除了用于系統(tǒng)性研究掩模材料和幾何特性的影響,它還用于設(shè)計(jì)消除或利用掩模形貌效應(yīng)的策略。
周期性掩模圖形將入射光衍射成幾個(gè)離散的衍射級(jí),如圖9-6所示。周期P和波長(zhǎng)入的離散衍射級(jí)或衍射角的方向由光柵方程給出:

該值給出有多少非偏振人射光被衍射成m級(jí)的TE或TM偏振光。極化率fpol=1.0/-1.0描述了在第m個(gè)衍射級(jí)掩模實(shí)際充當(dāng)了TE/TM的偏振器。fpol=0.0表示兩種偏振具有相同的衍射效率。
圖9-7為MoSi型AtPSM的掩模衍射分析結(jié)果。結(jié)果展示了在垂直人射光條件下,線寬和掩模周期之間的占空比為1:2密集線的零級(jí)和一級(jí)衍射。請(qǐng)注意,周期值是以掩模上的尺寸定義的,4倍縮放系統(tǒng)的晶圓級(jí)周期(和尺寸)值必須除以4。Kirchhof方法預(yù)測(cè)的零階衍射效率為恒定值,其值對(duì)應(yīng)于掩模的平均透射率。第一級(jí)衍射僅在周期大于193nm波長(zhǎng)處傳播。除了這個(gè)截止之外,第一衍射級(jí)具有恒定值。

相比之下,嚴(yán)格的EMF仿真預(yù)測(cè)了與偏振和周期相關(guān)的衍射效率。對(duì)于較大的周期,嚴(yán)格仿真計(jì)算的衍射效率接近Kirchhoff模型預(yù)測(cè)的值。換言之,Kirchhoff方法為大于800 nm的掩模尺寸周期提供了合理的精度,這分別對(duì)應(yīng)于晶圓尺寸上200 nm和100 nm的周期和線寬。Kirchhof方法無(wú)法準(zhǔn)確描述較小圖形的衍射性能。
嚴(yán)格的EMF仿真表明,TM偏振光的衍射效率高于TE偏振光的衍射效率,這也可以在圖9-7右下方的極化率圖中看到,具有較小圖形的MoSi掩模充當(dāng)TM偏振器。這與偏向TE偏振光的高NA系統(tǒng)的成像要求相沖突(參見(jiàn)8.3.2節(jié)),這種MoSi型掩模光衍射的不利特性有時(shí)被稱為"MoSi危機(jī)"。鉻和其他掩模吸收材料可以提供更有利的偏振特性[25,26]。
掩模上尺寸較小圖形的衍射的另一個(gè)重要特征,如圖9-7左下圖所示。特別是在600nm以下的周期范圍內(nèi),掩模形貌引人了與周期相關(guān)的相位效應(yīng),這些都是在衍射光的遠(yuǎn)場(chǎng)中觀察到的。它們對(duì)成像性能的影響類似于投影鏡頭的波像差[27]。下一節(jié)將討論幾種掩模引起的像差效應(yīng)及其對(duì)光刻成像的影響。
類似的掩模衍射分析也可以用于其他掩模類型和材料[28]。該分析表明,具有波長(zhǎng)數(shù)量級(jí)及更小的特征尺寸的掩模充當(dāng)了散射體,會(huì)對(duì)衍射光的振幅和相位產(chǎn)生與偏振態(tài)相關(guān)的影響。
9.2.2 斜入射效應(yīng)
光刻掩模上光的衍射不僅取決于掩模的形貌和材料特性,而且還取決于入射光的方向。光在掩模吸收層圖形上的典型入射角范圍由下式給出:

式中,0m.為光源的最大張角,NA為投影物鏡在晶圓方的數(shù)值孔徑,M為光刻機(jī)的縮放倍率,n。為掩模襯底的折射率。DUV光刻機(jī)照明的人射角范圍相對(duì)于6=0的光軸對(duì)稱。EUV光刻機(jī)的相關(guān)人射角范圍取決于圖形方向。對(duì)于垂直圖形,它也相對(duì)于0=0對(duì)稱;對(duì)于水平圖形,它圍繞物面主光線角度(CRAO)變化。
圖9-8為不同數(shù)值孔徑的DUV和EUV光刻的密集線空?qǐng)D形的仿真衍射效率的典型值。特征尺寸被縮放以提供可比較的工藝因子k1。為了進(jìn)行更好地比較,將EUV吸收層置于真空中(無(wú)多層膜)。同時(shí)考慮到光兩次通過(guò)具有多層膜的實(shí)際吸收層的傳播(即多層膜反射之前和之后的厚度),EUV掩模吸收層厚度采用了2倍的因子。
接下來(lái),先討論DUV的仿真結(jié)果。對(duì)于小于5的人射角0ms,來(lái)自光學(xué)掩模的光衍射幾乎與掩模上人射光方向的變化保持不變。在這個(gè)人射光的方向范圍內(nèi),非垂直人射的衍射光譜可以通過(guò)垂直人射光的衍射光譜的簡(jiǎn)單移動(dòng)來(lái)獲得,只需要一個(gè)嚴(yán)格的EMF仿真來(lái)計(jì)算部分相干照明的圖像。利用掩模衍射的這種位移不變性進(jìn)行圖像計(jì)算通常被稱為霍普金斯(Hopkins)方法。方程(9-15)表明Hopkins近似可以應(yīng)用于數(shù)值孔徑低于0.8的系統(tǒng)和具有較小部分相干因子()的更高數(shù)值孔徑的系統(tǒng)。
Hopkins方法對(duì)于具有明顯離軸照明的高數(shù)值孔徑浸沒(méi)式DUV中較大范圍的人射角是無(wú)效的,在人射角的相應(yīng)范圍內(nèi),其第0級(jí)和第1級(jí)衍射都表現(xiàn)出衍射效率的顯著變化。較厚的吸收層(與波長(zhǎng)相比)和斜人射,使得NA=0.33的EUV系統(tǒng)的水平圖形對(duì)人射光方向的變化非常敏感。高數(shù)值孔徑EUV光刻機(jī)(參見(jiàn)6.7.2節(jié))對(duì)人射光方向變化更加敏感。該系統(tǒng)中這種對(duì)人射角的高敏感度表現(xiàn)在垂直圖形和水平圖形,盡管它們晶圓上相同尺寸相同,但掩模上垂直圖形(4x)比水平圖形(8x)的尺寸小一半[29]。

大多數(shù)先進(jìn)高數(shù)值孔徑DUV系統(tǒng)采用激進(jìn)的離軸照明或o值大于0.5,掩模的光衍射與Hopkins假設(shè)的位移不變衍射效率存在顯著偏差。在典型的EUy系統(tǒng)中,來(lái)自掩模的光衍射并不是位移不變的,因此,所有EUV系統(tǒng)和高數(shù)值孔徑DUV系統(tǒng)都需要沒(méi)有Hopkins假設(shè)的嚴(yán)格EMF建模。必須針對(duì)幾個(gè)有代表性的人射角進(jìn)行掩模衍射計(jì)算,最終圖像是通過(guò)那些部分的光源對(duì)應(yīng)的圖像進(jìn)行不相干疊加獲得的,可以稱為"局部"Hopkins方法[30)來(lái)計(jì)算。盡管針對(duì)多個(gè)人射角的EMF建模增加了掩模和圖像建模的數(shù)值計(jì)算量,但它對(duì)于EUV成像的精確建模和高NA狀態(tài)下的DUV成像是必不可少的[31]。
9.2.3掩模引起的成像效應(yīng)
第一個(gè)證明嚴(yán)格掩模建模重要性的例子涉及交替型相移掩模(AlIPSM)的強(qiáng)度不平衡[32],吸收層中蝕刻開(kāi)口的較大深度使得AlIuPSM對(duì)掩模形貌效應(yīng)非常敏感。AluPSM的近場(chǎng)仿真如圖9-2所示,這里采用波導(dǎo)法結(jié)合矢量成像來(lái)研究AltPSM65nm密集線空?qǐng)D形的成像性能。在這個(gè)和下面的成像示例中,掩模圖形的橫向尺寸以晶圓尺寸為準(zhǔn)。與通過(guò)未蝕刻空間的光相比,產(chǎn)生180的相移所選取的蝕刻開(kāi)口(移位器)的深度為

圖9-9左圖為仿真的空間向橫截面。實(shí)線為相同寬度的蝕刻和未蝕刻空的圖像橫截面。與(左圖)未蝕刻開(kāi)口的圖像強(qiáng)度相比,來(lái)自(右圖)蝕刻開(kāi)口/移位器邊緣的光散射降低了圖像強(qiáng)度。未蝕刻掩模開(kāi)口處的較大的光強(qiáng),導(dǎo)致了由兩個(gè)光強(qiáng)峰值決定的線向右移動(dòng)了將近12nm。
補(bǔ)償AlrPSM的強(qiáng)度不平衡和由此產(chǎn)生的偏置誤差的一種策略是增加右側(cè)蝕刻開(kāi)口的寬度。圖9-9(左)橫截面圖中的虛線顯示了較大移位器寬度wshite的橫截面。移位器寬度為85 nm時(shí)兩個(gè)強(qiáng)度最大值的高度幾乎相同。圖9-9右圖顯示了中心線相對(duì)于移位器寬度的仿真位置,82.5nm的移位器寬度將偏置誤差降至零。
上述仿真僅研究了在單個(gè)焦點(diǎn)位置時(shí)掩模形貌引起的圖像不平衡,更全面的仿真和實(shí)驗(yàn)研究表明,與簡(jiǎn)單地偏置刻蝕開(kāi)口相比,淺刻蝕或預(yù)刻蝕等不平衡補(bǔ)償策略可以提供更好的離焦性能[33]。

觀察到較小圖形的衍射效應(yīng)也會(huì)對(duì)衰減型和二元掩模的設(shè)計(jì)產(chǎn)生影響。圖9-10中顯示了MoSi型AtPSM上50 nm線空?qǐng)D形的光學(xué)鄰近效應(yīng)曲線。本示例中未應(yīng)用任何輔助圖形,將閾值模型應(yīng)用到光刻膠折射率與襯底匹配的光刻膠內(nèi)部的圖像,可以仿真晶圓CD;掩模線寬和晶圓CD都是以晶圓尺寸為準(zhǔn)。圖9-10左圖顯示了在沒(méi)有OPC的情況下,給定的掩模線寬(LW)和仿真的晶圓CD與圖形周期的關(guān)系。Kirohhor方法和嚴(yán)格掩模模型得到的結(jié)果相差270高達(dá)5nm。圖9-10右圖也可以看到類似的差異,該圖顯示了在所有周期下,為獲得50nm恒定目標(biāo)晶圓CD而計(jì)算得到的掩模線寬。這一結(jié)果和許多其他仿真結(jié)果證明,OPC模型中必須考慮掩模形貌效應(yīng)以進(jìn)行掩模圖形設(shè)計(jì)。

圖9-10的OPC仿真是在沒(méi)有輔助圖形的情況下完成的,輔助圖形比掩模上的主要圖形還要小。9.2.1節(jié)1.0中對(duì)掩模形貌效應(yīng)的特征尺0.8寸依賴性的觀察表明,輔助0.6圖形的成像性能對(duì)掩模形貌0.4效應(yīng)更加敏感。圖9-11中的仿真結(jié)果證實(shí)了這一點(diǎn),02該圖顯示了MoSi型衰減0.0LPSM上孤立線的仿真結(jié)果橫截面。為了比較不同代光刻技術(shù)的結(jié)果,孤立線使用根據(jù)第一個(gè)阿貝-瑞利方程縮放的數(shù)值孔徑成像:NA=0.3A/LW,其中LW表示晶圓特征尺寸或線寬。

與Kirchhoff仿真的預(yù)測(cè)相比,較小的暗輔助圖形的嚴(yán)格電磁場(chǎng)仿真得到的光散射表明輔助圖形附近的強(qiáng)度最小值更小。定義OPC適當(dāng)?shù)妮o助圖形寬度時(shí),必須考慮這種影響,這里所觀察到的影響取決于所用光的偏振特性和掩模的色調(diào)。一般而言,Kirchhoff方法低估了TE偏振照明成形暗輔助圖形的風(fēng)險(xiǎn),高估了成形亮輔助圖形的風(fēng)險(xiǎn);TM偏振照明則表現(xiàn)出相反的趨勢(shì)。
如9.2.1節(jié)所述,掩模形貌效應(yīng)不僅影響衍射光的振幅,還會(huì)影響衍射光的相位。這些相位效應(yīng)會(huì)產(chǎn)生類似像差的成像現(xiàn)象,例如不對(duì)稱工藝窗口、與圖形周期和方向相關(guān)的最佳焦點(diǎn)位置偏移等[27,34,35]。圖9-12展示了其中一些影響,該圖顯示了不同掩模材料的工藝窗口和不同圖形周期的最佳焦點(diǎn)偏移的分析。玻璃襯底上不透明MoSi(OMOG)掩模[36]和傳統(tǒng)MoSi掩模的工藝窗口,在最佳焦面相對(duì)于標(biāo)稱圖像平面不對(duì)稱。對(duì)最佳焦點(diǎn)位置的分析表明,最佳焦點(diǎn)隨著圖形周期而變化,類似的成像現(xiàn)象已經(jīng)在有球面像差的投影鏡頭中被觀察到;可參見(jiàn)8.1.6節(jié)。

此例以及其他更多例子都表明,光學(xué)光刻所用的高級(jí)掩模的形貌會(huì)產(chǎn)生相位效應(yīng),對(duì)成像性能產(chǎn)生類似于像差的影響。這存在將掩模引起的像差現(xiàn)象歸因于投影鏡頭波像差的風(fēng)險(xiǎn)。特定的像差測(cè)量技術(shù)的應(yīng)用必須考慮這些影響,像差測(cè)量技術(shù)可以從特別設(shè)計(jì)的掩模圖像的離焦分析中檢測(cè)波像差[37-39]。
投影物鏡的波前控制和新型掩模吸收材料的使用可以補(bǔ)償掩模引起的像差效應(yīng)[40-42]。投影光刻機(jī)和掩模引起的像差之間關(guān)系的詳細(xì)討論可以在本章后的參考文獻(xiàn)[35]中找到,其中介紹了嚴(yán)格仿真的衍射光譜的Zerike分析,可以作為量化掩模效應(yīng)的有效方法。
圖9-13展示了使用Kirchof法和掩模缺陷成形的嚴(yán)格電磁場(chǎng)仿真結(jié)果之間的差異。兩條45 nm寬的線條之間的中心處有一個(gè)邊長(zhǎng)為20nm的方形暗缺陷,此缺陷可能是掩模制作缺陷,也可能是在掩模使用過(guò)程中沉積的顆粒。該圖顯示了掩模版圖上層幾個(gè)略有不同強(qiáng)度閾值的圖像輪廓。Kirchhoff方法低估了缺陷的影響,盡管它預(yù)測(cè)到線條之間的空隙變窄。相比之下,嚴(yán)格的掩模建模預(yù)測(cè)到線條之間空隙區(qū)域發(fā)生橋連,特別是對(duì)于略低于閾值的強(qiáng)度值。
缺陷成形的預(yù)測(cè)對(duì)不同掩模模型的這種高敏感性并不出人意料。缺陷是光刻掩模上最小的圖形,因此,它們對(duì)掩模形貌效應(yīng)非常敏感。一般而言,Kirchhoff方法低估了暗色缺陷的成形性能,而高估了亮缺陷的成形性能。交替型PSM上的相位缺陷可以會(huì)聚或發(fā)散來(lái)自缺陷附近的光,因而它們被成形的風(fēng)險(xiǎn)相對(duì)于離焦位置會(huì)呈現(xiàn)出不對(duì)稱的變化[43]。

9.2.4EUV光刻中的掩模形貌效應(yīng)及緩解策略
上一節(jié)中的示例已經(jīng)證明了嚴(yán)格掩模建模對(duì)DUV光刻的重要性。通常,所描述的掩模形貌效應(yīng)的幅度隨著(掩模尺度)橫向特征尺寸與所用波長(zhǎng)之間的比率減小而增加。EUV光波長(zhǎng)的顯著減少增加了掩模圖形橫向特征尺寸與波長(zhǎng)之間的比率,這是否意味著EUV光刻對(duì)掩模形貌效應(yīng)不太敏感?
然而,事實(shí)并非如此。掩模形貌效應(yīng)重要性的第二個(gè)指標(biāo)是掩模圖形的厚度或高度。EUV掩模吸收層的物理厚度與DUV光刻掩模吸收層的厚度相似,EUV光刻掩模的典型吸收層厚度約為4~5個(gè)波長(zhǎng)。吸收層厚度和波長(zhǎng)之間的這種大比例關(guān)系使得EUV光刻對(duì)掩模形貌效應(yīng)非常敏感。EUV掩模的特定幾何形狀及其在成像裝置中的集成引入了EUV光刻中掩模形貌效應(yīng)的幾個(gè)特點(diǎn)。
圖9-14 比較了EUV光刻的反射掩模與DUV光刻的透射掩模。在EUV光刻波長(zhǎng)下,光學(xué)材料特性(折射率n和消光系數(shù)k)與DUV光刻的相應(yīng)數(shù)據(jù)相比,表現(xiàn)出的變化要小得多。為了獲得所需的強(qiáng)度和相位調(diào)制,EUV掩模需要更厚的吸收層。
EUV光刻吸收層特征的相對(duì)厚度(由波長(zhǎng)歸一化)遠(yuǎn)大于DUV 光刻的相應(yīng)值。EUV掩模吸收層厚度的重要性因光要通過(guò)吸收層兩次而被強(qiáng)化:第一次是來(lái)自照明系統(tǒng)的光照射掩模;第二次是來(lái)自多層膜的背反射光再次照射吸收層時(shí)。

EUV掩模的多層膜引入了額外的特定掩模效應(yīng)。光不在多層膜的頂部反射,而是從多層膜內(nèi)部的幾個(gè)界面反射,這增加了掩模的有效厚度。斜照明、多層膜反射率的角度依賴性以及(厚)吸收層對(duì)光的雙重衍射增強(qiáng)了斜入射效應(yīng)對(duì)EUV光刻的重要性(參見(jiàn)9.2.2節(jié))。
光衍射與掩模上人射光方向的顯著相關(guān)性對(duì)成像性能具有重要影響。圖9-15顯示了二極照明下,NA=0.33的EUV成像系統(tǒng)對(duì)16 mm密集線的離焦圖像,該圖顯示了單極和完整二極照明的圖像。
由于照射方向不同,因此兩個(gè)單獨(dú)極子相對(duì)于不同離焦的圖像差異很大。它們不僅表現(xiàn)出相反的遠(yuǎn)心行為(圖形位置隨離焦的變化),而且也具有不同的對(duì)比度和平均光強(qiáng),這些差異歸因于衍射效率隨照明方向的不同變化。在其他周期和成像條件下,也可以觀察到類似的現(xiàn)象[29,45]。通常,來(lái)自EUV照明光瞳的幾個(gè)部分的(不同)圖像的疊加會(huì)導(dǎo)致圖像對(duì)比度降低或?qū)Ρ榷人p[46,47]0EUV光刻中掩模形貌效應(yīng)與照明幾何形狀的強(qiáng)烈相互作用增加了EUV光源掩模協(xié)同優(yōu)化(SMO)的重要性。例如,在本章后的參考文獻(xiàn)[48,49]中描述了最重要的挑戰(zhàn)和可能的解決方案。
另一種掩模形貌效應(yīng)如圖9-16所示,左圖展示了EUV吸收層引起的波前形變,對(duì)應(yīng)的反射近場(chǎng)的相位形變已經(jīng)在圖6-9中進(jìn)行了介紹和討論;圖9-16右圖顯示(歸一化)對(duì)比度值相對(duì)于仿真空間像的離焦位置曲線,這些數(shù)據(jù)表明不同周期引起的最佳焦點(diǎn)位置(具有最高對(duì)比度)偏移約為20nm,DUV光刻中也觀察到類似的效應(yīng)[50]。由于焦深預(yù)算(范圍)的減少,因此這類效應(yīng)在EUV光刻比 DUV光刻更為顯著。

為了進(jìn)一步減小EUV光刻中所能實(shí)現(xiàn)的特征尺寸和工藝因子,EUV光刻中需要緩解這些掩模形貌效應(yīng)的影響,為此有幾種方法已經(jīng)被開(kāi)發(fā)。下面給出三個(gè)例子:前兩種方法采用對(duì)光源形狀和/或掩模設(shè)計(jì)圖的不對(duì)稱修改,來(lái)提高目前使用的EUV掩模吸收層的成像性能,這兩種方法的實(shí)現(xiàn)相對(duì)簡(jiǎn)單,但嚴(yán)重依賴于掩模設(shè)計(jì);第三個(gè)例子是利用新型吸收層材料,這會(huì)對(duì)掩模基礎(chǔ)結(jié)構(gòu)造成重大影響。然而,這些新型吸收層從根本上解決了掩模形貌效應(yīng),并提供了更通用的解決方案。
圖9-17展示了優(yōu)化用戶定義照明形狀的方法,可用于減少兩個(gè)相鄰空隙線圖形離焦成像的不對(duì)稱性[51]。該圖左列部分顯示了對(duì)稱二極照明的仿真圖像和CD值與離焦位置的顯著不對(duì)稱性。通過(guò)圖9-17右列中優(yōu)化用戶定義非對(duì)稱照明,這些全焦距范圍的不對(duì)稱性可以得到完全補(bǔ)償。在光源優(yōu)化的過(guò)程中還必須特別注意,要在保持高對(duì)比度的同時(shí)避免引人異常的像差靈敏度。

另一種減少EUV成像對(duì)比度衰減的方法是應(yīng)用非對(duì)稱輔助圖形,圖9-18276展示了Stephen Hsu和Jinging Liu對(duì)變形高NA EUV成像系統(tǒng)的仿真結(jié)果[52]。

需要特別注意的是:非對(duì)稱輔助圖形的應(yīng)用有助于改善不同照明方向衍射級(jí)的平衡。因?yàn)槠淇梢员WC輔助圖形良好的離焦性能,并避免在相關(guān)離焦點(diǎn)位置范圍內(nèi)輔助圖形的成形。關(guān)于EUV光刻的非對(duì)稱輔助圖形及其對(duì)工藝性能的影響的進(jìn)一步詳細(xì)信息,請(qǐng)參閱本章后的參考文獻(xiàn)[52]。
解決掩模形貌效應(yīng)的最通用方法是使用優(yōu)化的掩模材料。高k:吸收層材料的應(yīng)用能夠減少吸收層厚度。折射率接近1的吸收材料引起的光波前變形和相位變化較小,圖9-19的近場(chǎng)圖證明了這一點(diǎn)。
然而,具有較低消光系數(shù)和折射率介于0.88~0.95的吸收材料可用作EUV光刻的衰減型相移掩模[54]。具有小折射率的吸收材料也有利于引導(dǎo)光進(jìn)入掩模的無(wú)吸收層區(qū)域,并減少不同照明方向之間的圖像偏移[45]。
優(yōu)化掩模吸收材料和掩模結(jié)構(gòu)的研究仍在進(jìn)行中[55-57]。確定最佳選擇需要考慮不同的成像指標(biāo)(NILS、尺寸閾值、非遠(yuǎn)心度等),更重要的是,這些材料對(duì)掩模結(jié)構(gòu)的適用性(圖案化、壽命、檢查、修復(fù)等)。EUV光刻機(jī)中,高k:吸收層材料成像性能的首次實(shí)驗(yàn)研究顯示出套刻性能的改善[58]。最后,還必須考慮多層膜的特性[59]。

9.2.5各種三維掩模模型
將嚴(yán)格的掩模建模應(yīng)用于較大的掩模設(shè)計(jì)圖形區(qū)域需要大量的計(jì)算資源,這可以通過(guò)算法[60,61]和專用硬件[62,63]的并行化來(lái)部分解決。然而,用于光刻成像計(jì)算的掩模衍射建模是一項(xiàng)特殊的任務(wù),它允許一些方法具有合理的精度損失。例如,掩模衍射光譜的高空間頻率對(duì)使用具有有限數(shù)值孔徑的投影系統(tǒng)獲得的遠(yuǎn)場(chǎng)圖像沒(méi)有貢獻(xiàn),因而針對(duì)這些高空間頻率出現(xiàn)的數(shù)值誤差是可以忽略的。此外,光刻掩模上的掩模圖形大多是層次分明的,并具有優(yōu)先圖形設(shè)計(jì)方向。上述這些結(jié)果可用于建立更有效的模型來(lái)捕捉掩模形貌效應(yīng)。
掩模分解技術(shù)用于將大面積、全3D問(wèn)題拆分為更簡(jiǎn)單的小面積或2D/1D問(wèn)題。Kostas Adam和Andrew Neureuther提出了一種結(jié)合 FDTDo4]的域分解技術(shù)(DDT)。DDT使用FDTD計(jì)算來(lái)自掩模孤立邊緣光的衍射。此后,特征衍射圖案被應(yīng)用于掩模設(shè)計(jì)圖形中的所有邊緣。如果設(shè)計(jì)圖形離掩模的邊緣不是太近,這種方法可以提供非常好的精度。該模型還可以擴(kuò)展到描述角效應(yīng)或不同入射角的光[31]。類似的分解技術(shù)也被用于波導(dǎo)法[65],這種方法將完全3D問(wèn)題(例如來(lái)自接觸孔陣列或更復(fù)雜布局的光衍射)分解為幾個(gè)2D問(wèn)題,類似來(lái)自線空?qǐng)D形的光衍射。
其他更近似的模型試圖在不求解麥克斯韋方程組的情況下捕捉掩模形貌
效應(yīng),這些緊湊模型通過(guò)修改Kirchof掩模模型或成像系統(tǒng)來(lái)模擬掩模形貌效應(yīng)。邊界層模型是在Kirchoff型掩模設(shè)計(jì)圖形中采用薄的半透明層包圍圖形邊緣(m0)。該半透明層的寬度、透射率和相位是由完全嚴(yán)格的掩模模型校準(zhǔn)確定的。邊緣脈沖模型采用了類似的方法,將具有特定高度和相位的脈沖添加到Kirchoff型掩模的所有邊緣。邊緣脈沖模型已被用于光學(xué)[34]和EUy掩模[67,68]
由掩模形貌引起的偏振幅度和相位效應(yīng)也可以通過(guò)修改投影物鏡的光瞳函數(shù)來(lái)近似,將復(fù)雜的光瞳濾波器引人到投影物鏡的瓊斯光瞳中(60)。光瞳濾波器的形狀是由Zemike或Tschebyscheff多項(xiàng)式來(lái)描述的,并且多項(xiàng)式系數(shù)由完全嚴(yán)格的掩模和成像仿真來(lái)進(jìn)行校準(zhǔn)。或者,這些多項(xiàng)式可以直接應(yīng)用于掩模的衍射光譜.701。另一種更靈活的方法是應(yīng)用神經(jīng)網(wǎng)絡(luò)來(lái)仿真掩模形貌引起的衍射光譜修改(71。神經(jīng)網(wǎng)絡(luò)針對(duì)特定的測(cè)試圖形進(jìn)行訓(xùn)練,能夠高精度地再現(xiàn)許多掩模形貌效果。
所有描述的緊湊型掩模模型都必須通過(guò)完全嚴(yán)格的EMF仿真進(jìn)行校準(zhǔn),這些模型的精度、性能、靈活性和可擴(kuò)展性取決于所考慮的掩模類型、成像條件和特定的應(yīng)用場(chǎng)景。
圖9-20給出了不同版本掩模模型的分類。它們的范圍從薄掩模或Kirchhof模型到?jīng)]有Hopkins假設(shè)的完全嚴(yán)格的模型。與Kirchhoff模型相比,緊湊模型提高了仿真精度,但需要使用完全嚴(yán)格的模型進(jìn)行校準(zhǔn)。域分解技術(shù)能夠?qū)?yán)格的仿真技術(shù)應(yīng)用于更大的掩模區(qū)域。圖9-20中,這些模型的精度和計(jì)算工作量從左到右增加,選擇最合適的模型取決于具體的應(yīng)用。不同的模型相組合有助于在光學(xué)鄰近效應(yīng)校正和光源掩模協(xié)同優(yōu)化中有效地包含掩模形貌效應(yīng)。

-
仿真
+關(guān)注
關(guān)注
55文章
4507瀏覽量
138533 -
掩模
+關(guān)注
關(guān)注
0文章
15瀏覽量
7749 -
電磁場(chǎng)
+關(guān)注
關(guān)注
0文章
806瀏覽量
49422
原文標(biāo)題:掩模形貌效應(yīng)-------光學(xué)光刻和極紫外光刻 安迪?愛(ài)德曼 著
文章出處:【微信號(hào):Semi Connect,微信公眾號(hào):Semi Connect】歡迎添加關(guān)注!文章轉(zhuǎn)載請(qǐng)注明出處。
發(fā)布評(píng)論請(qǐng)先 登錄
光刻中使用的掩模對(duì)準(zhǔn)器曝光模式
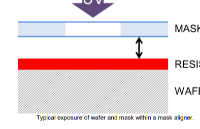
VirtualLab Fusion應(yīng)用:泰伯效應(yīng)
光刻技術(shù)原理及應(yīng)用
助力高級(jí)光刻技術(shù):存儲(chǔ)和運(yùn)輸EUV掩模面臨的挑戰(zhàn)
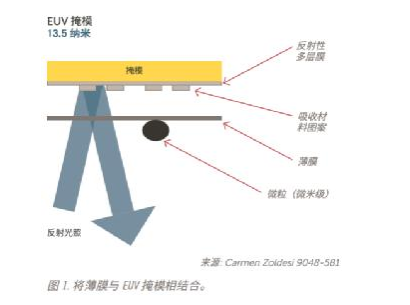
用于后端光刻的新型無(wú)掩模技術(shù)分析
計(jì)算光刻技術(shù)的發(fā)展
淺談EUV光刻中的光刻膠和掩模等材料挑戰(zhàn)
考慮光刻中厚掩模效應(yīng)的邊界層模型
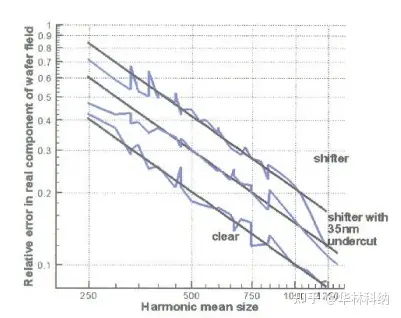
解析光刻芯片掩模的核心作用與設(shè)計(jì)

硅片形貌效應(yīng)及其與底部抗反射涂層(BARC)沉積策略關(guān)系的解析
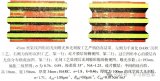
高數(shù)值孔徑投影光刻中的偏振效應(yīng)

光刻技術(shù)中的晶圓形貌效應(yīng)詳解




 光刻技術(shù)中的掩模形貌效應(yīng)詳解
光刻技術(shù)中的掩模形貌效應(yīng)詳解





評(píng)論