隨著半導體制程向先進節點演進,3D 晶體管架構與多層互連堆疊技術的規模化應用,使得器件缺陷的隱蔽性與檢測難度顯著提升。傳統光學檢測技術已難以滿足電學相關缺陷的識別需求,而電子束檢測的效率瓶頸又制約了量產應用。DirectScan 檢測通過核心技術創新破解了這一行業痛點,為下一代半導體制造提供了高效、精準的檢測解決方案。
本文將從技術原理、核心優勢、應用場景及落地實踐等方面,對該技術進行系統性解析。
一、先進工藝節點的檢測挑戰與技術缺口
當前半導體制造技術正經歷關鍵變革:鰭式場效應晶體管逐步被全環繞柵極(GAA)納米帶晶體管替代,中段制程(MOL)因多重圖形化技術的應用,堆疊復雜度持續增加。這一變革導致致命缺陷多隱匿于 3D 結構內部,傳統光學檢測手段難以有效識別。
同時,先進工藝節點的缺陷呈現顯著的產品特異性,集中分布于特定工藝 - 版圖組合的 “熱點區域”,此類缺陷由芯片設計固有的版圖特征引發,成為影響良率的核心因素。
行業面臨的核心矛盾在于:電子束電壓襯度檢測是識別電學缺陷的關鍵技術,但傳統電子束檢測采用光柵掃描模式,效率遠低于光學檢測,無法匹配大批量生產的需求。DirectScan 技術的出現,為破解這一矛盾提供了可行路徑。

二、DirectScan 核心技術架構:PointScan 的創新邏輯
DirectScan 檢測方案由eProbe 電子束檢測工具、FIRE GDS 版圖分析平臺及Exensio 大數據智能分析平臺三大核心組件構成,其技術突破的核心在于PointScan 掃描技術對傳統電子束檢測邏輯的重構,主要體現在以下三方面:
1
設計感知驅動的靶向檢測
傳統電子束檢測采用無差別光柵掃描,需覆蓋包括介質區域在內的全部區域,且無法識別被測目標的圖形特征;PointScan 技術具備非接觸式電學測試特性,可精準跳轉至目標器件的關鍵位置(如焊盤、接觸點),僅對有效檢測區域實施電壓襯度檢測,完全規避介質區域的無效掃描,實現 “按需檢測”。

2
檢測效率的量級提升
通過 FIRE 平臺的精細化版圖分析,可精準篩選出需檢測的 “關鍵區域”,大幅縮減檢測范圍:
后段制程金屬 3 層通孔檢測:僅需掃描總可檢測面積的 2.5%
中段制程柵極 - 漏極短路檢測:僅需掃描總接觸點的 1%
柵極殘筋檢測:可規避 50%-75% 的介質區域,檢測面積縮減至傳統方案的 10% 以下
基于上述優化,PointScan 技術的檢測吞吐量可達傳統單束電子束檢測設備的 20-100 倍,每小時可完成數十億個被測器件的掃描。
3
設計感知學習與屬性分析能力
DirectScan 與 FIRE 平臺的深度整合,可實現跨多層版圖的屬性提取,包括觸點類型(漏極 / 柵極)、晶體管閾值電壓、極性、與擴散區隔離槽的距離等關鍵參數。
eProbe 輸出的 KLARF 格式數據含專屬屬性識別碼,可與版圖特征精準匹配,工程師可直接計算特定屬性或屬性組合對應的缺陷率,快速定位高風險晶體管類型與版圖設計方案,為工藝優化提供數據支撐。
三、高難度場景的應用突破
PointScan 技術的低電荷沉積特性,使其在傳統電子束檢測難以覆蓋的場景中實現突破:
背側供電網絡(BSPDN)晶圓檢測
鍵合晶圓形成的絕緣層會阻礙電荷傳導,導致傳統電子束檢測出現電荷累積、電子束偏折與失焦問題;PointScan 技術大幅降低單位面積電荷沉積量,有效緩解上述問題,已完成實際應用驗證。
3D DRAM 檢測
3D DRAM 的結構特性同樣易引發電荷累積,此前檢測難度較高,DirectScan 技術的應用使該類器件的精準檢測成為可能。
DRAM 陣列短路檢測
獨有的可控 “充電 - 檢測” 功能,可在指定位置施加電荷后跳轉至目標區域采集電壓襯度信號,使特定島狀節點呈現高亮狀態,清晰識別與浮空相鄰觸點的短路問題,該功能為傳統光柵掃描技術所不具備。
四、行業落地實踐與全流程應用
自 2022 年初起,eProbe 檢測系統已在多家先進邏輯芯片制造工廠落地,目前兩套設備投入大批量生產,第三套設備處于產能爬坡階段,應用場景覆蓋半導體制造全流程:
先進邏輯芯片制造
中段制程:GAA 柵極 - 漏極短路、柵極接觸孔開路、柵極外延層 / 硅化物層開路檢測
后段制程:M0 層、1X 層、2X 層系統性接觸孔開路與金屬布線短路檢測
背側供電網絡:電源通孔、源極 / 漏極通孔接觸孔開路與短路檢測
隨機邏輯電路漏電情況評估
先進 DRAM 制造(2024-2025 年)
外圍電路:柵極 - 柵極殘筋短路、柵極 - 漏極短路、字線 - 字線短路與開路檢測及缺陷定位
存儲陣列:基于可控 “充電 - 檢測” 技術的存儲節點短路檢測
技術總結
在半導體制程向更精密 3D 架構演進的背景下,檢測技術的創新成為保障良率的關鍵。DirectScan 方案通過 PointScan 靶向掃描技術、設計感知分析能力與產品特異性缺陷學習功能的融合,在保留電子束檢測高靈敏度的基礎上,實現了檢測吞吐量的量級提升,同時破解了高難度場景的檢測難題。
該技術不僅解決了先進工藝節點下缺陷“難識別、難檢測” 的問題,更推動半導體檢測從 “缺陷識別” 向 “工藝優化賦能” 升級,為下一代半導體制造提供了核心技術支撐和全新路徑。
-
半導體
+關注
關注
339文章
30964瀏覽量
265348 -
檢測
+關注
關注
5文章
4877瀏覽量
94225 -
電子束
+關注
關注
2文章
135瀏覽量
14052
發布評論請先 登錄
功率放大器在電子束金屬3D打印中的應用

意法半導體推進下一代芯片制造技術 在法國圖爾工廠新建一條PLP封裝試點生產線
適用于下一代 GGE 和 HSPA 手機的多模/多頻段 PAM skyworksinc

從電路板到創新領袖:電子技術人才的進階之路
國產首臺28 納米關鍵尺寸電子束量測量產設備出機

意法半導體攜手Flex推動下一代移動出行發展
下一代高速芯片晶體管解制造問題解決了!
NVIDIA 采用納微半導體開發新一代數據中心電源架構 800V HVDC 方案,賦能下一代AI兆瓦級算力需求
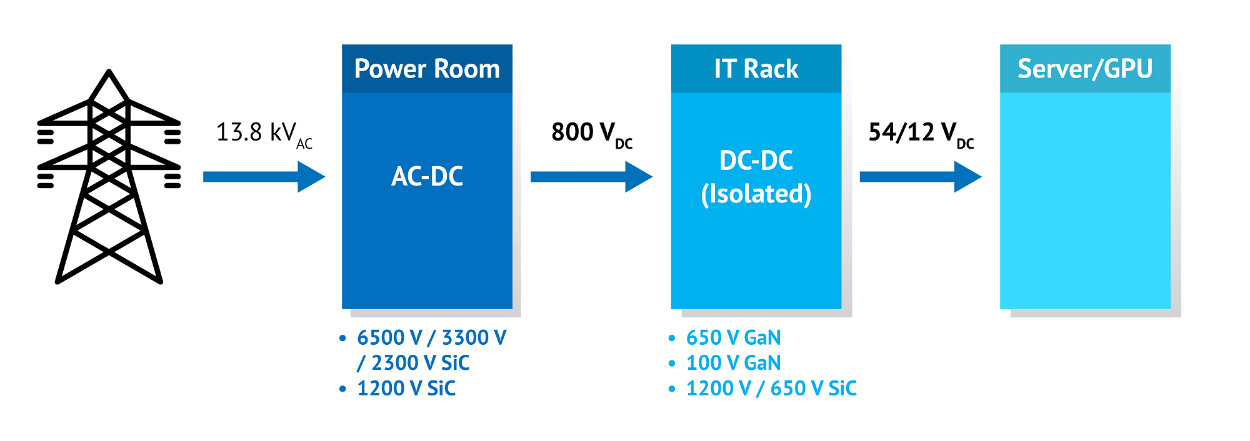
電子束半導體圓筒聚焦電極
APEX經濟型減速器——助力TETA電子束焊機高性價比焊接




 DirectScan 技術解析:下一代半導體電子束檢測的創新路徑與應用
DirectScan 技術解析:下一代半導體電子束檢測的創新路徑與應用




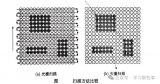



評論