商用車電驅(qū)動SiC模塊選型返璞歸真:從DCM/HPD封裝回歸ED3封裝碳化硅功率模塊的市場報告
傾佳電子(Changer Tech)是一家專注于功率半導(dǎo)體和新能源汽車連接器的分銷商。主要服務(wù)于中國工業(yè)電源、電力電子設(shè)備和新能源汽車產(chǎn)業(yè)鏈。傾佳電子聚焦于新能源、交通電動化和數(shù)字化轉(zhuǎn)型三大方向,代理并力推BASiC基本半導(dǎo)體SiC碳化硅MOSFET單管,SiC碳化硅MOSFET功率模塊,SiC模塊驅(qū)動板等功率半導(dǎo)體器件以及新能源汽車連接器。?
傾佳電子楊茜致力于推動國產(chǎn)SiC碳化硅模塊在電力電子應(yīng)用中全面取代進(jìn)口IGBT模塊,助力電力電子行業(yè)自主可控和產(chǎn)業(yè)升級!
傾佳電子楊茜咬住SiC碳化硅MOSFET功率器件三個必然,勇立功率半導(dǎo)體器件變革潮頭:
傾佳電子楊茜咬住SiC碳化硅MOSFET模塊全面取代IGBT模塊和IPM模塊的必然趨勢!
傾佳電子楊茜咬住SiC碳化硅MOSFET單管全面取代IGBT單管和大于650V的高壓硅MOSFET的必然趨勢!
傾佳電子楊茜咬住650V SiC碳化硅MOSFET單管全面取代SJ超結(jié)MOSFET和高壓GaN 器件的必然趨勢!
當(dāng)前,全球商用車(Commercial Vehicle, CV)電驅(qū)動行業(yè)的SiC模塊選型正經(jīng)歷一場深刻的技術(shù)路線修正與供應(yīng)鏈重構(gòu)。在經(jīng)歷了對乘用車SiC模塊高密度封裝(如DCM1000、HybridPack Drive)的短暫追捧后,主流商用車電驅(qū)動研發(fā)制造企業(yè)紛紛擱淺或取消相關(guān)項目,轉(zhuǎn)而全面回歸并鎖定基于EconoDual 3(ED3)標(biāo)準(zhǔn)封裝的碳化硅(SiC)功率模塊技術(shù)路線。
傾佳電子剖析這一“逆技術(shù)流向”現(xiàn)象背后的根本原因。通過對基本半導(dǎo)體(BASiC Semiconductor)BMF540R12MZA3等代表性產(chǎn)品的技術(shù)解析,結(jié)合商用車在800V+高壓架構(gòu)下的特殊需求,本報告揭示了四大核心驅(qū)動力: (1)“無縫升級”的存量經(jīng)濟(jì)學(xué)優(yōu)勢,即在保留現(xiàn)有IGBT(如FF900R12ME7和2MBI800XNE-120)機(jī)械與冷卻接口的前提下實現(xiàn)SiC性能躍升; (2)高壓絕緣與宇宙射線可靠性的物理硬約束,ED3封裝在1400V-1700V高壓等級上的天然適應(yīng)性遠(yuǎn)優(yōu)于緊湊型塑封模塊; (3)重載工況下的熱機(jī)械可靠性差異,特別是氮化硅(Si3?N4?)AMB基板在ED3中的應(yīng)用解決了塑封模塊在大溫差循環(huán)下的失效痛點(diǎn); (4)供應(yīng)鏈安全與多源化戰(zhàn)略,ED3作為開放標(biāo)準(zhǔn)封裝避免了DCM/HPD類專有封裝的單一來源風(fēng)險。
涵蓋材料科學(xué)、封裝物理、熱管理工程、電力電子拓?fù)?a target="_blank">仿真及產(chǎn)業(yè)經(jīng)濟(jì)學(xué)等多個維度,為行業(yè)決策者提供詳盡的戰(zhàn)略參考。
第一章 緒論:商用車電動化的岔路口
1.1 商用車與乘用車電驅(qū)動系統(tǒng)的需求分異
在電動汽車產(chǎn)業(yè)發(fā)展的早期階段,商用車電驅(qū)動技術(shù)往往被視為乘用車技術(shù)的放大版或衍生版。然而,隨著電動重卡、電動客車及工程機(jī)械進(jìn)入深度商業(yè)化推廣期,行業(yè)逐漸意識到兩者在工況負(fù)載、壽命要求及系統(tǒng)架構(gòu)上存在本質(zhì)區(qū)別。
乘用車(PV)邏輯:追求極致的功率密度(kW/L)和輕量化。由于底盤空間極度受限,且工況多為短時峰值功率輸出(加速),乘用車傾向于采用高度集成、直接水冷、轉(zhuǎn)模塑封(Transfer Molded)的功率模塊,如英飛凌的HybridPack Drive(HPD)或丹佛斯的DCM1000平臺 。這些模塊通過犧牲一定的維修便利性和電壓擴(kuò)展性,換取了體積的最小化。
商用車(CV)邏輯:追求極致的可靠性(百萬公里無大修)、全生命周期成本(TCO)最優(yōu)及持續(xù)功率輸出能力。重型卡車在爬坡或滿載高速巡航時,逆變器需長時間承受接近額定電流的負(fù)載,導(dǎo)致芯片結(jié)溫(Tj?)長期處于高位 。此外,商用車底盤空間相對充裕,對體積的敏感度低于乘用車,但對維護(hù)性、抗振動能力及高壓絕緣性能的要求極為嚴(yán)苛。
1.2 市場現(xiàn)象:DCM1000與HPD項目的擱淺
2020年至2023年間,受乘用車SiC技術(shù)爆發(fā)的影響,多家商用車Tier 1供應(yīng)商啟動了基于DCM1000和HPD封裝的SiC逆變器預(yù)研項目,試圖將乘用車的“先進(jìn)封裝”紅利引入商用車。然而,進(jìn)入2024-2025年周期,大量此類項目被叫停、延期或取消。與此同時,以基本半導(dǎo)體BMF540R12MZA3為代表的ED3封裝SiC模塊迅速占據(jù)了設(shè)計主流 。
這種“技術(shù)回退”并非創(chuàng)新的停滯,而是工程理性的回歸。行業(yè)發(fā)現(xiàn),塑封模塊在應(yīng)對商用車800V-1000V高壓平臺及劇烈熱循環(huán)工況時,存在先天性的物理局限,且由此帶來的系統(tǒng)重新設(shè)計成本(NRE)遠(yuǎn)超預(yù)期。
第二章 存量市場的引力:ED3封裝的“無縫升級”經(jīng)濟(jì)學(xué)
商用車電驅(qū)動產(chǎn)業(yè)鏈具有極大的慣性。過去十年間,基于ED3mm標(biāo)準(zhǔn)封裝(即EconoDual 3及其衍生品)的IGBT逆變器構(gòu)成了全球商用車電驅(qū)的基石。
2.1 現(xiàn)有IGBT霸主的技術(shù)畫像
在深入分析SiC替代方案前,必須理解被替代對象的地位。目前商用車逆變器市場被兩款核心IGBT模塊產(chǎn)品統(tǒng)治:
Infineon FF900R12ME7 (EconoDual 3) :采用IGBT7微溝槽柵技術(shù),額定電流900A,電壓1200V 。它是中高端重卡和客車的標(biāo)配,定義了冷卻流道、母排連接及驅(qū)動板接口的行業(yè)標(biāo)準(zhǔn)。
Fuji Electric 2MBI800XNE-120 (Dual XT) :富士電機(jī)的800A/1200V模塊,同樣采用62mm封裝,以高魯棒性和短路耐受能力著稱 。
這兩款產(chǎn)品建立了龐大的生態(tài)系統(tǒng)。OEM廠商圍繞它們投入了數(shù)以億計的資金開發(fā)液冷散熱器、疊層母排(Laminated Busbar)及結(jié)構(gòu)殼體。
2.2 “布朗運(yùn)動”式開發(fā)與沉沒成本
對于商用車制造商而言,采用DCM1000或HPD模塊意味著“綠地開發(fā)”(Greenfield Development)——即從零開始。
機(jī)械重構(gòu):HPD和DCM模塊通常采用PinFin(針翅)直接水冷結(jié)構(gòu),需要逆變器殼體本身加工出高精度的冷卻槽,并使用O型圈密封 。這與ED3模塊使用的平底板(Flat Baseplate)涂抹導(dǎo)熱硅脂后貼合在水道蓋板上的方式完全不同。
成本黑洞:若切換至塑封模塊,OEM必須報廢現(xiàn)有的散熱器模具、重新設(shè)計母排連接方式(從螺栓連接改為激光焊接或壓接),并重新驗證整個系統(tǒng)的氣密性與抗震性。對于年產(chǎn)量僅為乘用車幾十分之一的商用車企,這種巨額的模具與驗證成本(NRE)難以通過規(guī)模效應(yīng)攤薄。
2.3 BMF540R12MZA3的戰(zhàn)略卡位:無縫替代
基本半導(dǎo)體推出的BMF540R12MZA3(及后續(xù)的BMF720/900系列)精準(zhǔn)切中了這一痛點(diǎn) 。
物理兼容性:該模塊完全復(fù)刻了ED3的物理尺寸(152mm x 62mm)、安裝孔位及端子高度。這意味著OEM可以在不更改散熱器、不更改母排、甚至不更改殼體鑄造模具的前提下,直接將IGBT模塊拆下,換上SiC模塊。
性能躍升:雖然標(biāo)稱電流為540A(低于IGBT的900A),但由于SiC的開關(guān)損耗極低(BMF540的總開關(guān)損耗約為同級IGBT的1/5),其在高頻(>10kHz)下的實際電流輸出能力反而超過了900A的IGBT 。
驅(qū)動適配:雖然SiC需要更高的柵極電壓(+18V/-5V vs. IGBT的+15V/-8V)和更快的保護(hù)響應(yīng),但通過驅(qū)動適配即可解決,無需改動主功率回路 。
這種“換芯不換殼”的方案,將產(chǎn)品迭代周期從24個月壓縮至6個月以內(nèi),成為商用車企在成本壓力下放棄全新DCM/HPD架構(gòu)的最直接誘因。
第三章 高壓架構(gòu)的物理挑戰(zhàn):1200V的局限與1700V的剛需
隨著兆瓦級充電(MCS)標(biāo)準(zhǔn)的推進(jìn),電動重卡的電池電壓正在從600V-750V向850V-1000V遷移。這一電壓等級的躍升,直接判了1200V塑封模塊的“死刑”,確立了ED3封裝的統(tǒng)治地位。
3.1 宇宙射線失效與電壓降額
在高海拔或高緯度地區(qū)運(yùn)行的商用車,面臨著嚴(yán)峻的宇宙射線(中子流)轟擊風(fēng)險。功率半導(dǎo)體在高壓偏置下,極易被高能粒子誘發(fā)單粒子燒毀(SEB)。
1200V器件的困境:為了保證在15-20年的使用壽命內(nèi)FIT(Failure In Time)失效率達(dá)標(biāo),1200V器件通常只能長期運(yùn)行在800V以下的直流母線電壓。當(dāng)電池電壓提升至850V甚至900V時,1200V器件的安全裕度(Derating margin)不足,導(dǎo)致失效率呈指數(shù)級上升。
商用車的特殊性:相比私家車,商用車運(yùn)行時間長、暴露概率大,且對可靠性要求更高,因此無法接受乘用車常用的激進(jìn)電壓策略。
3.2 1400V與1700V:ED3的天然領(lǐng)地
為了適應(yīng)850V+架構(gòu),行業(yè)急需1400V或1700V耐壓的功率器件 。
爬電距離(Creepage)與電氣間隙(Clearance) :電壓升高意味著模塊內(nèi)部和外部端子之間需要更大的絕緣距離。DCM和HPD是為了緊湊性而生的,其端子間距和內(nèi)部布局是針對800V(最高1200V芯片)優(yōu)化的。要在這些緊湊封裝內(nèi)實現(xiàn)1700V等級的絕緣,必須大幅犧牲芯片面積或使用昂貴的特殊灌封材料,這在工程上極難平衡 。
ED3的冗余優(yōu)勢:EconoDual 3封裝最初設(shè)計時就考慮到了1700V IGBT的應(yīng)用(如風(fēng)電變流器),其端子間距(Creepage > 12mm)和內(nèi)部絕緣設(shè)計天然滿足1700V甚至更高電壓的要求 。
基本半導(dǎo)體的路線圖:BMF540R12MZA3所在的Pcore?2系列,不僅覆蓋1200V,還規(guī)劃了1400V和1700V產(chǎn)品 。這使得OEM廠商可以在同一機(jī)械平臺上,通過更換不同電壓等級的ED3模塊,靈活開發(fā)400V中卡、800V重卡甚至1000V礦卡,這是DCM/HPD平臺無法提供的靈活性。
3.3 1400V SiC:黃金分割點(diǎn)
報告特別指出,1400V SiC MOSFET正在成為商用車的“殺手級”產(chǎn)品。相比1700V器件,1400V SiC不僅成本更低,而且通態(tài)電阻(RDS(on)?)更小(無需過厚的漂移層),同時又能為900V母線提供足夠的宇宙射線裕量 。ED3封裝是目前承載1400V SiC芯片最成熟、最具性價比的載體。
第四章 封裝材料學(xué)的較量:塑封 vs. 灌膠
商用車惡劣的運(yùn)行環(huán)境——劇烈的振動、極端的溫度沖擊(-40°C至175°C)以及長達(dá)數(shù)萬小時的運(yùn)行壽命,對封裝材料提出了極其苛刻的要求。這正是DCM/HPD等轉(zhuǎn)模塑封(Transfer Molded)模塊在商用車領(lǐng)域遭遇滑鐵盧的核心技術(shù)原因。
4.1 熱機(jī)械應(yīng)力與CTE失配
DCM/HPD的阿喀琉斯之踵:轉(zhuǎn)模塑封模塊使用環(huán)氧樹脂(Epoxy Molding Compound, EMC)將芯片、引線鍵合及引線框架整體包裹成型。雖然這種結(jié)構(gòu)緊湊且抗?jié)駳饽芰?qiáng),但環(huán)氧樹脂很硬,且其熱膨脹系數(shù)(CTE)與硅/碳化硅芯片及銅框架存在差異。在商用車頻繁的大跨度熱循環(huán)(例如:滿載爬坡芯片急劇升溫 -> 下坡制動急劇降溫)中,這種CTE失配會在芯片表面和鍵合點(diǎn)產(chǎn)生巨大的剪切應(yīng)力,長期運(yùn)行極易導(dǎo)致芯片裂紋或鍵合線根部斷裂 18。
ED3的柔性防護(hù):ED3模塊采用經(jīng)典的硅凝膠(Silicone Gel)灌封。硅凝膠呈果凍狀,極其柔軟,能夠允許內(nèi)部芯片和鍵合線在熱脹冷縮時自由形變,從而釋放熱應(yīng)力。這種“軟保護(hù)”機(jī)制在應(yīng)對商用車的大溫差、長壽命工況時,表現(xiàn)出遠(yuǎn)超硬質(zhì)塑封模塊的疲勞壽命 19。
4.2 氮化硅(Si3?N4?)AMB基板的決定性勝利
基本半導(dǎo)體BMF540R12MZA3的一個關(guān)鍵技術(shù)亮點(diǎn)是采用了氮化硅(Si3?N4?)活性金屬釬焊(AMB)基板 7。這是ED3 SiC模塊在可靠性上碾壓傳統(tǒng)IGBT模塊及部分低成本塑封模塊的核心武器。
| 特性 | 氧化鋁 (Al2?O3?) | 氮化鋁 (AlN) | 氮化硅 (Si3?N4?) |
|---|---|---|---|
| 熱導(dǎo)率 (W/mK) | 24 (低) | 170 (極高) | 90 (中高) |
| 抗彎強(qiáng)度 (MPa) | 450 (一般) | 350 (脆,易裂) | 700 (極強(qiáng),韌性好) |
| 斷裂韌性 (MPa?m1/2) | 4.2 | 3.4 | 6.0 |
| 熱沖擊壽命 | 差 (銅層易剝離) | 差 (陶瓷易碎) | 極優(yōu) (>5000次循環(huán)無分層) |
物理分析:雖然AlN熱導(dǎo)率最高,但其極脆,在商用車的劇烈振動和熱沖擊下容易碎裂。Si3?N4?雖然熱導(dǎo)率稍低,但其機(jī)械強(qiáng)度是AlN的兩倍,允許基板做得更薄(如360微米),從而在降低熱阻的同時,獲得了極高的抗熱沖擊和抗機(jī)械振動能力 7。
商用車適配性:對于要求百萬公里壽命的重卡,基板的銅層剝離(Delamination)是IGBT模塊失效的主要模式之一。Si3?N4? AMB基板幾乎完美解決了這一問題,使得ED3 SiC模塊的功率循環(huán)能力(Power Cycling Capability)達(dá)到了傳統(tǒng)模塊的數(shù)倍。
第五章 供應(yīng)鏈安全:單源風(fēng)險與多源保障
在經(jīng)歷了2020-2022年的“缺芯”危機(jī)后,供應(yīng)鏈安全成為商用車企選型的核心考量。
5.1 DCM/HPD的封閉生態(tài)風(fēng)險
DCM1000:該平臺主要是Danfoss(現(xiàn)Semikron Danfoss)的專利技術(shù) 1。盡管技術(shù)先進(jìn),但市場上缺乏完全兼容的第二供應(yīng)商(Second Source)。一旦遭遇地緣政治、工廠停產(chǎn)或產(chǎn)能擠兌,商用車企將面臨斷供風(fēng)險。
HPD:雖然Infineon授權(quán)了部分廠商生產(chǎn)HPD兼容產(chǎn)品,但其核心供應(yīng)鏈仍高度集中在少數(shù)頭部大廠,且產(chǎn)能優(yōu)先向乘用車巨頭傾斜。商用車訂單量小、批次多,在產(chǎn)能分配中處于劣勢 2。
5.2 ED3的開放生態(tài)優(yōu)勢
ED3(62mm封裝)是全球電力電子行業(yè)最通用的“標(biāo)準(zhǔn)件”。
多源供應(yīng):除了基本半導(dǎo)體(Basic Semiconductor),Infineon、Fuji、Mitsubishi、Semikron、StarPower(斯達(dá))、CRRC(中車)、Leapers(利普思)等全球數(shù)十家廠商均提供引腳兼容的ED3模塊 15。
供應(yīng)鏈韌性:BMF540R12MZA3作為標(biāo)準(zhǔn)ED3封裝產(chǎn)品,意味著OEM廠商可以隨時引入其他品牌的同類產(chǎn)品作為二供、三供。這種供應(yīng)鏈的極度安全性,對于追求穩(wěn)健經(jīng)營的商用車企具有致命的吸引力。
第六章 深度技術(shù)解析:BMF540R12MZA3的性能優(yōu)勢
基于提供的Datasheet 7 和仿真報告 7,我們對BMF540R12MZA3進(jìn)行詳細(xì)的技術(shù)解構(gòu),以證明其為何能“無縫升級”并替代IGBT。
6.1 靜態(tài)參數(shù)與導(dǎo)通損耗
RDS(on)? :BMF540R12MZA3在VGS?=18V時的典型導(dǎo)通電阻僅為2.2 mΩ 7。
對比IGBT:傳統(tǒng)的900A IGBT(如FF900R12ME7)存在膝點(diǎn)電壓(VCE(sat)?約1.5V-1.8V),即無論電流多小,都有約1.5V的壓降損耗。而SiC MOSFET呈阻性特性,在中小負(fù)載(商用車巡航典型工況)下,其導(dǎo)通壓降遠(yuǎn)低于1V(2.2mΩ×200A=0.44V)。這意味著在占據(jù)車輛運(yùn)行時間80%的巡航工況下,SiC的導(dǎo)通損耗僅為IGBT的1/3甚至更低。
6.2 動態(tài)特性與開關(guān)損耗
開關(guān)速度:BMF540的開通損耗(Eon?)和關(guān)斷損耗(Eoff?)總和約為36mJ(@540A/600V)7。相比之下,同級IGBT受拖尾電流(Tail Current)影響,關(guān)斷損耗巨大。
頻率紅利:SiC的低損耗允許將開關(guān)頻率從IGBT時代的3-5kHz提升至15-20kHz。這不僅優(yōu)化了電機(jī)輸出波形(諧波更少,電機(jī)發(fā)熱更低),還大幅減小了被動元件(電容、電感)的體積和重量,間接抵消了SiC芯片的成本溢價。
6.3 米勒鉗位(Miller Clamp)的必要性
在ED3封裝中應(yīng)用SiC,最大的挑戰(zhàn)在于高dv/dt導(dǎo)致的橋臂直通風(fēng)險。
米勒效應(yīng):當(dāng)上管快速開通時,巨大的電壓變化率(dv/dt>50V/ns)會通過下管的米勒電容(Cgd?)耦合到下管柵極,導(dǎo)致下管誤導(dǎo)通 7。
解決方案:基本半導(dǎo)體在推廣BMF540時,配套了帶有**有源米勒鉗位(Active Miller Clamp)**功能的驅(qū)動方案(如BTD25350芯片)7。通過在關(guān)斷期間將柵極低阻抗接地,徹底消除了誤導(dǎo)通風(fēng)險。這種系統(tǒng)級的解決方案消除了客戶從IGBT切換到SiC時的技術(shù)顧慮。
6.4 仿真數(shù)據(jù)實證
根據(jù)基本半導(dǎo)體的仿真數(shù)據(jù) 7:
工況:800V母線,400Arms輸出,8kHz開關(guān)頻率。
結(jié)果:BMF540R12MZA3的結(jié)溫顯著低于IGBT模塊,或者在相同結(jié)溫限制下,能夠輸出更大的電流。例如,在Buck拓?fù)渲校琒iC方案的總損耗降低了60%以上。這意味著在同樣的散熱條件下,使用ED3 SiC模塊的逆變器可以輕松實現(xiàn)功率倍增,或者大幅縮小散熱器體積。
第七章 總結(jié)與展望
7.1 根本原因綜述
商用車電驅(qū)研發(fā)制造企業(yè)之所以擱淺DCM1000和HPD項目,轉(zhuǎn)而擁抱ED3封裝SiC模塊,根本原因在于DCM/HPD的“乘用車屬性”(極致密度、難以維修、單一供應(yīng)、低壓基因)與商用車的“生產(chǎn)資料屬性”(極致可靠、易于維護(hù)、多源供應(yīng)、高壓剛需)發(fā)生了嚴(yán)重的錯配。
相反,以BMF540R12MZA3為代表的ED3 SiC模塊,通過**Si3?N4? AMB材料革新解決了可靠性問題,通過標(biāo)準(zhǔn)封裝解決了供應(yīng)鏈和兼容性問題,通過1200V/1400V/1700V全覆蓋**解決了高壓架構(gòu)升級問題,從而構(gòu)成了當(dāng)前技術(shù)與商業(yè)的最佳平衡點(diǎn)。
7.2 行業(yè)建議
對于車企(OEM) :應(yīng)立即停止對DCM/HPD在重卡領(lǐng)域的強(qiáng)制適配,轉(zhuǎn)而利用ED3 SiC模塊的兼容性,快速推出800V高壓重卡平臺,搶占市場先機(jī)。
對于Tier 1:重點(diǎn)優(yōu)化基于ED3封裝的SiC驅(qū)動設(shè)計,特別是加強(qiáng)米勒鉗位和短路保護(hù)設(shè)計,以充分釋放SiC的高頻性能。
對于供應(yīng)鏈:關(guān)注1400V規(guī)格的SiC芯片資源,這將在未來3-5年內(nèi)成為800V商用車平臺的主流選擇。
7.3 結(jié)語
在商用車電動化的下半場,技術(shù)炫技將讓位于工程實用主義。ED3封裝的“復(fù)興”,不是技術(shù)的倒退,而是產(chǎn)業(yè)鏈成熟的標(biāo)志。它證明了在重資產(chǎn)、長周期的商用車領(lǐng)域,能夠兼容存量生態(tài)并提供極致可靠性的技術(shù),才是最終的贏家。
附錄:關(guān)鍵數(shù)據(jù)對比表
| 維度 | BMF540R12MZA3 (SiC ED3) | FF900R12ME7 (IGBT ED3) | DCM1000 / HPD (塑封模塊) |
|---|---|---|---|
| 電壓等級 | 1200V / 1400V / 1700V (靈活) | 1200V / 1700V | 主流 750V / 1200V (1700V難) |
| 標(biāo)稱電流 | 540A (等效能力 >800A IGBT) | 900A | 200A - 800A |
| 基板材料 | Si3?N4? AMB (高韌性、抗熱沖) | Al2?O3? (普通) | 塑封/直接水冷 (CTE失配風(fēng)險大) |
| 封裝形式 | 灌膠、銅基板、螺栓連接 | 灌膠、銅基板、螺栓連接 | 環(huán)氧樹脂塑封、激光焊/壓接 |
| 熱循環(huán)壽命 | 極高 (適合重載工況) | 標(biāo)準(zhǔn) | 較低 (受限于材料熱膨脹差異) |
| 維修性 | 高 (可單體更換) | 高 | 低 (通常不可修) |
| 升級成本 | 低 (Drop-in Replacement) | 基準(zhǔn) | 極高 (需重新設(shè)計逆變器) |
| 供應(yīng)鏈 | 多源 (全球標(biāo)準(zhǔn)) | 多源 | 單源/少源 (私有協(xié)議) |
| 主要應(yīng)用 | 商用車、重工、光儲 | 商用車、工控 | 乘用車 (Tesla, VW等) |
審核編輯 黃宇
-
封裝
+關(guān)注
關(guān)注
128文章
9310瀏覽量
148977 -
SiC
+關(guān)注
關(guān)注
32文章
3838瀏覽量
69971
發(fā)布評論請先 登錄
250kW固態(tài)變壓器(SST)子單元設(shè)計方案-ED3封裝SiC模塊

QDPAK封裝SiC碳化硅MOSFET安裝指南

基本半導(dǎo)體汽車級Pcore6 HPD Mini封裝碳化硅MOSFE模塊介紹

商用車電驅(qū)動SiC功率模塊選型的結(jié)構(gòu)性分析:HPD封裝的局限與ED3封裝的技術(shù)復(fù)興

商用車電驅(qū)動SiC功率模塊選型變革報告:從封裝路線的博弈到ED3碳化硅的主宰

基本半導(dǎo)體1200V工業(yè)級碳化硅MOSFET半橋模塊Pcore2 ED3系列介紹

DCM?1000及同類封裝碳化硅功率模塊商業(yè)化困境報告:當(dāng)“包子皮”貴過“包子餡”的經(jīng)濟(jì)學(xué)悖論

商用車電驅(qū)動系統(tǒng)中國產(chǎn)SiC模塊的演進(jìn):以ED3封裝BMF540R12MZA3替代DCM與HPD的技術(shù)與商業(yè)邏輯分析

雙脈沖測試技術(shù)解析報告:國產(chǎn)碳化硅(SiC)功率模塊替代進(jìn)口IGBT模塊的驗證與性能評估

傾佳電子市場報告:國產(chǎn)SiC碳化硅功率器件在全碳化硅戶用儲能領(lǐng)域的戰(zhàn)略突破




 商用車電驅(qū)動SiC模塊選型返璞歸真:從DCM/HPD封裝回歸ED3封裝碳化硅功率模塊的市場報告
商用車電驅(qū)動SiC模塊選型返璞歸真:從DCM/HPD封裝回歸ED3封裝碳化硅功率模塊的市場報告




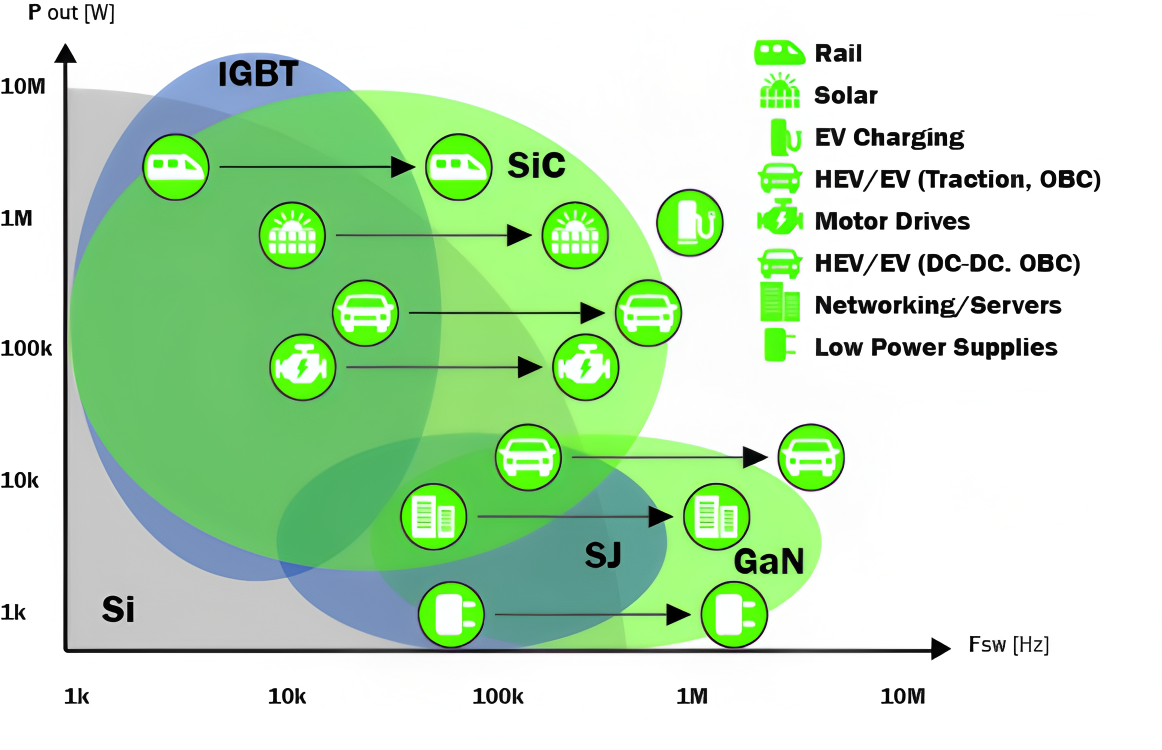



評論