DCM?1000及同類封裝碳化硅功率模塊商業(yè)化困境報(bào)告:當(dāng)“包子皮”貴過“包子餡”的經(jīng)濟(jì)學(xué)悖論
傾佳電子(Changer Tech)是一家專注于功率半導(dǎo)體和新能源汽車連接器的分銷商。主要服務(wù)于中國工業(yè)電源、電力電子設(shè)備和新能源汽車產(chǎn)業(yè)鏈。傾佳電子聚焦于新能源、交通電動(dòng)化和數(shù)字化轉(zhuǎn)型三大方向,代理并力推BASiC基本半導(dǎo)體SiC碳化硅MOSFET單管,SiC碳化硅MOSFET功率模塊,SiC模塊驅(qū)動(dòng)板等功率半導(dǎo)體器件以及新能源汽車連接器。?

傾佳電子楊茜致力于推動(dòng)國產(chǎn)SiC碳化硅模塊在電力電子應(yīng)用中全面取代進(jìn)口IGBT模塊,助力電力電子行業(yè)自主可控和產(chǎn)業(yè)升級(jí)!
傾佳電子楊茜咬住SiC碳化硅MOSFET功率器件三個(gè)必然,勇立功率半導(dǎo)體器件變革潮頭:
傾佳電子楊茜咬住SiC碳化硅MOSFET模塊全面取代IGBT模塊和IPM模塊的必然趨勢!
傾佳電子楊茜咬住SiC碳化硅MOSFET單管全面取代IGBT單管和大于650V的高壓硅MOSFET的必然趨勢!
傾佳電子楊茜咬住650V SiC碳化硅MOSFET單管全面取代SJ超結(jié)MOSFET和高壓GaN 器件的必然趨勢!
摘要
隨著全球汽車產(chǎn)業(yè)向電氣化轉(zhuǎn)型的深入,牽引逆變器作為電動(dòng)汽車(EV)核心動(dòng)力總成部件,其技術(shù)路線的選擇已成為決定整車性能與成本的關(guān)鍵。碳化硅(SiC)功率半導(dǎo)體憑借其耐高壓、耐高溫及高開關(guān)頻率的特性,被視為800V高壓平臺(tái)的必然選擇。在此背景下,丹佛斯硅動(dòng)力(Danfoss Silicon Power)推出的DCM?1000平臺(tái)代表了功率模塊封裝技術(shù)的巔峰:它集成了Danfoss Bond Buffer? (DBB)銅燒結(jié)互連、轉(zhuǎn)模封裝(Transfer Molding)以及ShowerPower? 3D直接液冷技術(shù),旨在徹底釋放SiC芯片的性能潛力。

然而,盡管在技術(shù)指標(biāo)上表現(xiàn)卓越,DCM?1000及其類似封裝形式在商業(yè)推廣層面卻遭遇了顯著阻力,未能像英飛凌HybridPACK?系列那樣成為行業(yè)通用的事實(shí)標(biāo)準(zhǔn)。傾佳電子楊茜旨分析這一現(xiàn)象背后的根本原因:“包子皮(封裝成本)貴過包子餡(芯片成本)”。
通過對(duì)制造工藝、供應(yīng)鏈結(jié)構(gòu)、良率物理學(xué)及市場競爭格局的詳盡解構(gòu),傾佳電子楊茜認(rèn)知如下:DCM?1000的商業(yè)困境并非單純的技術(shù)失敗,而是過度工程化(Over-engineering)與半導(dǎo)體摩爾定律(成本下降趨勢)發(fā)生錯(cuò)配的結(jié)果。隨著SiC芯片產(chǎn)能釋放導(dǎo)致“包子餡”價(jià)格快速下行,DCM?1000所采用的復(fù)雜封裝工藝導(dǎo)致“包子皮”的固定成本與良率損耗成本居高不下,最終破壞了模塊的整體成本競爭力。與此同時(shí),非IDM(垂直整合制造)的商業(yè)模式使得丹佛斯在與擁有芯片定價(jià)權(quán)的巨頭競爭時(shí),面臨著無法內(nèi)部化封裝成本的結(jié)構(gòu)性劣勢。
1. 緒論:功率半導(dǎo)體封裝的范式轉(zhuǎn)移與價(jià)值重構(gòu)
在電動(dòng)汽車動(dòng)力總成的成本結(jié)構(gòu)中,功率半導(dǎo)體占據(jù)了至關(guān)重要的地位。如果說電池是電動(dòng)汽車的“血液”,那么牽引逆變器就是其“肌肉”,控制著能量的流動(dòng)與轉(zhuǎn)換。傳統(tǒng)的硅基IGBT模塊在過去三十年中已經(jīng)形成了一套成熟、低成本的封裝標(biāo)準(zhǔn),主要以焊接工藝、鋁線鍵合和灌膠封裝為特征。然而,碳化硅(SiC)的引入打破了這一平衡。

1.1 碳化硅時(shí)代的封裝挑戰(zhàn)
SiC器件不僅昂貴,而且“嬌貴”。其物理特性允許其在更高的結(jié)溫(Tj > 175°C)和更快的開關(guān)速度下運(yùn)行,但這恰恰擊中了傳統(tǒng)封裝技術(shù)的軟肋:
- 熱機(jī)械應(yīng)力: SiC芯片面積通常只有同電流等級(jí)IGBT芯片的1/3到1/4,這意味著熱流密度(Heat Flux)成倍增加。
- 可靠性短板: 傳統(tǒng)的鋁線鍵合在SiC的高溫沖擊下極易發(fā)生鍵合點(diǎn)脫落(Lift-off),成為系統(tǒng)的短板。
- 寄生電感: SiC的高頻開關(guān)特性要求極低的回路電感,傳統(tǒng)引腳封裝難以滿足。
1.2 DCM?1000的技術(shù)愿景
為了解決上述問題,丹佛斯推出了DCM?1000平臺(tái)。這是一個(gè)徹底拋棄傳統(tǒng)設(shè)計(jì)理念的產(chǎn)物。它不使用鋁線,而是采用銅帶;不使用硅凝膠,而是采用環(huán)氧樹脂模塑;不使用導(dǎo)熱硅脂,而是采用直接液冷。從工程角度看,這是對(duì)SiC特性的完美回應(yīng) 。
1.3 “包子皮”與“包子餡”的隱喻

在半導(dǎo)體行業(yè),通常遵循“芯片為王”的價(jià)值規(guī)律。芯片(Die)作為活性功能部件,通常占據(jù)模塊成本(BOM)的50%以上,被稱為“包子餡”;而封裝材料(基板、外殼、樹脂)作為保護(hù)支撐部件,成本較低,被稱為“包子皮”。
傾佳電子楊茜的核心議題在于探討在DCM?1000案例中,這一價(jià)值比例是否發(fā)生了倒置。如果為了保護(hù)昂貴的SiC芯片,開發(fā)了一套極其昂貴的封裝系統(tǒng),而隨著時(shí)間推移,SiC芯片本身的價(jià)格大幅下降,那么這套昂貴的“包子皮”就將成為模塊成本中無法削減的重負(fù),從而導(dǎo)致商業(yè)邏輯的崩塌。
2. 技術(shù)解構(gòu):昂貴“包子皮”的工藝物理學(xué)
要理解DCM?1000的成本結(jié)構(gòu),必須深入其制造工藝的微觀物理層面。每一項(xiàng)旨在提升性能的技術(shù)創(chuàng)新,都在無形中增加了制造的復(fù)雜度(Complexity)和資本支出(CAPEX)。

2.1 Danfoss Bond Buffer? (DBB) 技術(shù):銅互連的代價(jià)
DCM?1000的核心技術(shù)之一是DBB,它用銅帶(Copper Ribbon)和銅線替代了傳統(tǒng)的鋁線鍵合。銅的電導(dǎo)率和熱導(dǎo)率遠(yuǎn)高于鋁,且熱膨脹系數(shù)(CTE)更接近硅,理論上能將功率循環(huán)壽命提升15倍 。
2.1.1 工藝復(fù)雜度的指數(shù)級(jí)躍升
然而,銅不能直接鍵合在標(biāo)準(zhǔn)的鋁金屬化芯片表面,因?yàn)殂~太硬,鍵合時(shí)的超聲波能量會(huì)震碎脆弱的芯片。
燒結(jié)緩沖層(Sintered Buffer): 丹佛斯必須在芯片表面先燒結(jié)一層銅箔作為緩沖層。
雙重?zé)Y(jié)工藝: 傳統(tǒng)的焊接工藝只需一次回流焊。而DBB工藝需要:
- 將芯片燒結(jié)在DBC/AMB基板上。
- 將銅緩沖層燒結(jié)在芯片上。
燒結(jié)材料成本: 燒結(jié)通常使用銀(Ag)漿料或銅(Cu)漿料。雖然銅漿料原材料便宜,但極易氧化。因此,燒結(jié)過程必須在嚴(yán)格控制的惰性氣體(如氮?dú)饣蚣姿釟夥眨┥踔吝€原性氣氛中進(jìn)行,且需要施加高達(dá)10-30 MPa的壓力 。
設(shè)備成本: 壓力燒結(jié)設(shè)備(Sinter Press)的價(jià)格遠(yuǎn)高于回流焊爐。且由于需要加壓和保壓,其生產(chǎn)節(jié)拍(UPH)遠(yuǎn)低于焊接。
成本影響: 這一層“皮”不僅增加了昂貴的燒結(jié)銀材料,更重要的是增加了巨大的設(shè)備折舊和工時(shí)成本。
2.2 轉(zhuǎn)模封裝(Transfer Molding):不可逆的良率賭博

DCM?1000摒棄了傳統(tǒng)的塑料框+灌膠模式,采用了類似于分立器件的轉(zhuǎn)模封裝技術(shù) 。
2.2.1 模具與材料
- 環(huán)氧樹脂模塑料(EMC): 雖然EMC本身是相對(duì)廉價(jià)的化工產(chǎn)品,但為了匹配SiC的高溫特性,DCM必須使用高填充、低CTE的特種EMC 。
- 模具磨損: 這種高填充材料含有大量二氧化硅(沙子),對(duì)鋼制模具具有極強(qiáng)的磨損性。DCM模塊體積巨大(相比于單管),模具極其復(fù)雜且昂貴,維護(hù)成本極高。
2.2.2 翹曲(Warpage)與應(yīng)力
這是“包子皮”中最隱蔽的成本殺手。DCM模塊是一個(gè)非對(duì)稱結(jié)構(gòu):底部是銅基板,頂部是厚厚的樹脂。
- 雙金屬片效應(yīng): 在模塑后的冷卻過程中(從175°C降至室溫),樹脂的收縮率與銅、陶瓷完全不同。這會(huì)導(dǎo)致模塊發(fā)生嚴(yán)重的翹曲 。
- 良率損失: 翹曲會(huì)導(dǎo)致基板與散熱器無法貼合。對(duì)于依靠ShowerPower密封的DCM來說,平面度是生死的關(guān)鍵。如果在制造末端發(fā)現(xiàn)翹曲超標(biāo),整個(gè)模塊(包含內(nèi)部昂貴的SiC芯片)必須報(bào)廢。轉(zhuǎn)模封裝是不可返修的(Non-reworkable)。相比之下,灌膠模塊如果在灌膠前發(fā)現(xiàn)鍵合不良,往往還有補(bǔ)救或部分回收的機(jī)會(huì)。
2.3 ShowerPower? 3D:精密流體工程的溢價(jià)
DCM?1000集成了直接液冷底板。這不僅僅是一塊銅板,而是一個(gè)包含復(fù)雜塑料導(dǎo)流插件(Plastic Insert)的組件 。
- 結(jié)構(gòu)復(fù)雜性: 傳統(tǒng)的針翅(Pin Fin)散熱器可以一體鍛造。而ShowerPower需要精密的注塑插件來引導(dǎo)冷卻液形成渦流(Swirl Effect)。
- 密封風(fēng)險(xiǎn): 這種設(shè)計(jì)需要在模塊與逆變器殼體之間建立復(fù)雜的密封結(jié)構(gòu)。為了防止冷卻液泄漏,對(duì)密封圈和壓緊力的要求極高,這實(shí)際上將一部分封裝成本和風(fēng)險(xiǎn)轉(zhuǎn)移給了系統(tǒng)集成商,或者要求丹佛斯提供更昂貴的預(yù)集成組件。
3. 經(jīng)濟(jì)學(xué)模型:“包子皮”與“包子餡”的成本倒掛分析
為了驗(yàn)證“包子皮貴過包子餡”的假說,我們需要建立一個(gè)詳細(xì)的成本拆解模型。

3.1 傳統(tǒng)SiC模塊成本結(jié)構(gòu)(基準(zhǔn))
以一個(gè)基于英飛凌HybridPACK? Drive封裝的1200V SiC模塊為例,根據(jù)Yole Group及行業(yè)共識(shí)數(shù)據(jù) ,其成本結(jié)構(gòu)大致如下:
| 成本構(gòu)成 | 占比估計(jì) | 備注 |
|---|---|---|
| SiC芯片(包子餡) | 55% - 60% | 受襯底良率和Epi生長成本驅(qū)動(dòng)。 |
| 陶瓷基板 (AMB) | 15% | Si3N4 AMB基板,成本較高但由于芯片占比大,比例尚可。 |
| 散熱底板 | 10% | 銅針翅底板。 |
| 封裝材料與組裝 | 15% - 20% | 塑殼、端子、鋁線、硅凝膠、組裝工時(shí)。 |
結(jié)論: 在傳統(tǒng)模式下,芯片占據(jù)絕對(duì)主導(dǎo),封裝成本是次要的。
3.2 DCM?1000成本結(jié)構(gòu)重構(gòu)
在DCM?1000中,由于引入了DBB、燒結(jié)和轉(zhuǎn)模,疊加非IDM的供應(yīng)鏈模式,成本結(jié)構(gòu)發(fā)生了劇烈變化。
3.2.1 封裝材料與工藝成本的膨脹(Variable Cost Inflation)
- 銀燒結(jié)漿料 vs 焊料: 成本差異可達(dá)5-10倍 。
- 銅緩沖層與銅線: 雖然銅材便宜,但加工精度和燒結(jié)工藝增加了巨大的附加值。
- 轉(zhuǎn)模模具攤銷: 由于DCM是針對(duì)特定功率等級(jí)和尺寸定制的,且未能像TO-247單管那樣實(shí)現(xiàn)數(shù)十億級(jí)的標(biāo)準(zhǔn)化出貨,其昂貴的模具費(fèi)用(NRE)分?jǐn)偟矫總€(gè)模塊上,顯著推高了單體成本。
3.2.2 隱性良率成本(The Yield Tax)
如前所述,轉(zhuǎn)模封裝的大尺寸翹曲問題導(dǎo)致了不可忽視的廢品率。如果傳統(tǒng)封裝良率為98%,而DCM封裝初期良率為70%左右 ,那么這額外30%的報(bào)廢成本(包含了昂貴的SiC芯片)在財(cái)務(wù)核算上往往會(huì)被歸入“制造費(fèi)用”,即計(jì)入“包子皮”的成本中。這意味著,每生產(chǎn)一個(gè)合格的“包子皮”,都需要分?jǐn)傄徊糠謭?bào)廢的“餡”和“皮”的成本。
3.2.3 SiC芯片價(jià)格下行導(dǎo)致的比例失衡
近年來,隨著中國材料廠商(如天岳先進(jìn)、天科合達(dá)等)在6英寸SiC襯底上的產(chǎn)能爆發(fā),以及國產(chǎn)SiC碳化硅MOSFET器件廠商比如基本半導(dǎo)體的技術(shù)進(jìn)步,SiC正在經(jīng)歷劇烈的價(jià)格戰(zhàn) 。
- 趨勢: 當(dāng)SiC芯片價(jià)格每年下降20%時(shí),“包子餡”越來越便宜。
- 剛性: 然而,DCM的封裝成本(模具、銅材、設(shè)備折舊、復(fù)雜的工序)是剛性的,甚至因?yàn)橥浐筒牧希ㄣ~、銀)價(jià)格上漲而上升。
- 交叉點(diǎn): 某一時(shí)刻,當(dāng)芯片成本降至總成本的40%以下,而復(fù)雜的封裝成本仍維持高位時(shí),就出現(xiàn)了“包子皮貴過包子餡”的現(xiàn)象。對(duì)于客戶而言,這意味著他們支付的錢主要買到了丹佛斯的封裝技術(shù),而不是SiC本身的半導(dǎo)體性能。這在商業(yè)上是極難說服車企采購部門的。
4. 供應(yīng)鏈政治:非IDM模式的結(jié)構(gòu)性困局
除了物理成本,商業(yè)模式的結(jié)構(gòu)性缺陷也是DCM失敗的重要推手。丹佛斯堅(jiān)持“芯片獨(dú)立(Chip Independent)”戰(zhàn)略,這在IGBT時(shí)代是優(yōu)勢,但在SiC時(shí)代卻變成了劣勢。
利潤疊加(Double Margin)效應(yīng)
IDM模式(如英飛凌、ST):
-
模塊售價(jià) = 芯片制造成本 + 封裝制造成本 + 綜合利潤 - 英飛凌可以內(nèi)部調(diào)節(jié),甚至以零利潤提供封裝,僅靠芯片賺錢。
丹佛斯模式:
-
芯片采購價(jià) = 芯片制造成本 + 芯片廠利潤 -
模塊售價(jià) = 芯片采購價(jià) + 封裝制造成本 + 丹佛斯利潤 -
模塊售價(jià) = (芯片制造成本 + 芯片廠利潤) + 封裝制造成本 + 丹佛斯利潤
困境: 丹佛斯的成本結(jié)構(gòu)中天生多了一層“芯片廠利潤”。為了使最終模塊售價(jià)具有競爭力,丹佛斯必須極度壓縮封裝成本或自身利潤。然而,DCM恰恰采用的是一種高成本的封裝技術(shù)。這導(dǎo)致丹佛斯陷入了兩難:要么定價(jià)過高失去市場,要么賠本賺吆喝。
5. 市場博弈:標(biāo)準(zhǔn)化與定制化的戰(zhàn)爭
DCM?1000的技術(shù)優(yōu)勢(高功率密度、長壽命)是毋庸置疑的,但汽車行業(yè)更看重標(biāo)準(zhǔn)化和供應(yīng)鏈安全。
5.1 HybridPACK? Drive的標(biāo)準(zhǔn)霸權(quán)
英飛凌的HybridPACK? Drive(HPD)封裝已經(jīng)成為了電動(dòng)汽車行業(yè)的“USB接口” 。
- 生態(tài)系統(tǒng): 幾乎所有主流逆變器設(shè)計(jì)都圍繞HPD的占地面積(Footprint)和安裝孔位進(jìn)行。
- 兼容性: 基本半導(dǎo)體(BASiC)、比亞迪(BYD)、安森美(Onsemi)等廠商紛紛推出了兼容HPD封裝的產(chǎn)品 。這意味著主機(jī)廠可以輕松切換供應(yīng)商(Second Source),供應(yīng)鏈極其安全。
- DCM的孤島效應(yīng): DCM采用獨(dú)特的ShowerPower接口和外形尺寸。一旦主機(jī)廠選擇了DCM,就需要重新設(shè)計(jì)冷卻水道和逆變器殼體,且難以找到第二供應(yīng)商(雖然后期有少量兼容品,但遠(yuǎn)不如HPD普及)。這種**轉(zhuǎn)換成本(Switching Cost)和單一來源風(fēng)險(xiǎn)(Single Source Risk)**是車企極力避免的。
5.2 中國市場的殘酷競爭
中國是全球最大的EV市場,也是SiC應(yīng)用最激進(jìn)的區(qū)域。
- 基本半導(dǎo)體與比亞迪的崛起: 這些本土廠商利用IDM優(yōu)勢(比亞迪)或靈活的供應(yīng)鏈(基本半導(dǎo)體),推出了性價(jià)比極高的HPD兼容模塊 。
- DCM的定位尷尬: DCM定位高端,但在中國市場,極致的性價(jià)比和快速迭代才是王道。當(dāng)國產(chǎn)模塊性能“夠用”且價(jià)格只有DCM的50%時(shí),DCM的技術(shù)溢價(jià)就變得蒼白無力。
6. 深度分析:為何“包子皮”會(huì)變貴?——隱形成本的黑洞
除了上述顯性因素,還有一系列隱形成本導(dǎo)致DCM的“包子皮”價(jià)格居高不下。

6.1 定制化NRE(一次性工程費(fèi)用)
DCM的ShowerPower底板通常需要根據(jù)客戶的冷卻水道進(jìn)行定制 。
每一款新車型的適配,都需要重新開模、重新驗(yàn)證流體動(dòng)力學(xué)。
相比之下,平底板(Flat Baseplate)模塊是通用的,NRE成本極低。
在汽車行業(yè)車型迭代加速的今天,這種高昂的時(shí)間成本和金錢成本是致命的。
7.2 測試與老化成本

由于DBB和轉(zhuǎn)模技術(shù)引入了新的失效模式(如內(nèi)部樹脂分層),為了保證車規(guī)級(jí)可靠性,DCM模塊可能需要更嚴(yán)苛、更長時(shí)間的出廠篩選(Burn-in)和測試。
- SiC的高壓特性本身就增加了測試設(shè)備的成本。
- 對(duì)于無法返修的模塑模塊,測試不僅是篩選,更是燒錢。
7.3 專利墻與排他性
DCM集成了大量丹佛斯的專利技術(shù)(DBB, ShowerPower)。這雖然保護(hù)了技術(shù),但也阻礙了第二供應(yīng)商的出現(xiàn)。在汽車行業(yè),沒有競爭對(duì)手的技術(shù)往往也是沒有客戶的技術(shù),因?yàn)榭蛻舨桓冶绘i定。為了打破這種鎖定,客戶會(huì)要求極低的價(jià)格,進(jìn)一步壓縮了丹佛斯的利潤空間,使得“包子皮”的研發(fā)回報(bào)率極低。
8. 結(jié)論與展望:成也蕭何,敗也蕭何
DCM?1000商業(yè)困境的根源,確實(shí)可以用**“包子皮貴過包子餡”**來概括,但這不僅僅是BOM成本的簡單加減,而是一個(gè)多維度的經(jīng)濟(jì)學(xué)悖論。

8.1 悖論總結(jié)
- 技術(shù)過剩(Over-Performance): DCM提供了遠(yuǎn)超當(dāng)前市場平均需求的可靠性和功率密度。但在SiC芯片本身還在快速跌價(jià)的階段,市場更需要的是“足夠好(Good Enough)”且便宜的封裝,而不是昂貴且完美的封裝。客戶不愿意為額外的壽命支付溢價(jià),因?yàn)殡姵乜赡鼙饶K先壞。
- 成本結(jié)構(gòu)剛性: SiC芯片(餡)遵循摩爾定律,價(jià)格指數(shù)下降;而DCM封裝(皮)涉及銅、模具、復(fù)雜工藝,遵循傳統(tǒng)制造業(yè)規(guī)律,成本下降緩慢。時(shí)間越久,“皮”在總成本中的占比就越高,價(jià)值倒掛越嚴(yán)重。
- 商業(yè)模式錯(cuò)位: 在“芯片為王”的SiC時(shí)代,丹佛斯作為非IDM廠商,試圖通過封裝技術(shù)(皮)來主導(dǎo)價(jià)值鏈,這與IDM巨頭通過芯片(餡)主導(dǎo)價(jià)值鏈的趨勢相悖。IDM可以用芯片利潤補(bǔ)貼封裝,而丹佛斯只能靠封裝賺錢,這注定了價(jià)格戰(zhàn)中的劣勢。
8.2 行業(yè)啟示

DCM?1000的案例給功率半導(dǎo)體行業(yè)留下了深刻的教訓(xùn):
- 標(biāo)準(zhǔn)化優(yōu)于極致性能: 在大規(guī)模量產(chǎn)階段,兼容性和供應(yīng)鏈安全比單一技術(shù)指標(biāo)更重要。
- 垂直整合的必要性: 在SiC等新材料領(lǐng)域,IDM模式在成本控制上具有天然的統(tǒng)治力。
- 工藝做減法: 未來的封裝技術(shù)演進(jìn)方向,應(yīng)當(dāng)是在保持性能的同時(shí)簡化工藝(如助焊劑免清洗、無壓燒結(jié)),而不是像DCM那樣不斷疊加復(fù)雜的工藝步驟。
綜上所述,DCM?1000是一款在工程學(xué)上令人贊嘆,但在商業(yè)經(jīng)濟(jì)學(xué)上生不逢時(shí)的產(chǎn)品。它證明了SiC封裝的物理極限,也用市場表現(xiàn)證明了成本結(jié)構(gòu)的殘酷真理。
附錄:數(shù)據(jù)對(duì)比表
表1:主要SiC汽車功率模塊封裝技術(shù)對(duì)比
| 特性 | 英飛凌 HybridPACK? Drive (及兼容品) | 丹佛斯 DCM?1000 | STMicroelectronics STPAK |
|---|---|---|---|
| 封裝類型 | 塑料外殼 + 硅凝膠 (Gel-filled) | 全模塑轉(zhuǎn)模 (Transfer Molded) | 模塑 (Molded) |
| 互連技術(shù) | 鋁線/銅線鍵合 | DBB? (銅帶 + 燒結(jié)) | 銅燒結(jié) / 夾片 (Clip) |
| 冷卻方式 | 針翅 (Pin Fin) | ShowerPower? 3D (直接液冷) | 雙面冷卻 / 平底板 |
| 標(biāo)準(zhǔn)化程度 | 極高 (行業(yè)標(biāo)準(zhǔn)) | 低 (私有協(xié)議) | 中低 (主要用于特斯拉/ZF) |
| 可維修性 | 低 (灌膠前可返修) | 無 (不可返修) | 無 |
| 主要優(yōu)勢 | 供應(yīng)鏈成熟,成本低,供應(yīng)商多 | 功率密度極高,壽命極長 | 適合自動(dòng)化大規(guī)模生產(chǎn) |
| 主要劣勢 | 功率循環(huán)壽命相對(duì)較低 | 封裝成本高,良率敏感,獨(dú)家供應(yīng) | 需要專用產(chǎn)線 |
表2:假設(shè)成本結(jié)構(gòu)演變模型 (單位:相對(duì)值)
| 年份 | SiC芯片成本 (餡) | 標(biāo)準(zhǔn)封裝成本 (皮) | DCM封裝成本 (皮) | 標(biāo)準(zhǔn)模塊總成本 | DCM模塊總成本 | DCM皮/餡比例 |
|---|---|---|---|---|---|---|
| 2020 (推出期) | 100 | 20 | 40 | 120 | 140 | 0.4 |
| 2023 (成長期) | 70 | 19 | 38 | 89 | 108 | 0.54 |
| 2025 (激戰(zhàn)期) | 30 | 18 | 36 | 48 | 66 | 1.2 |
| 趨勢 | 快速下降 | 緩慢下降 | 剛性/微降 | 更具競爭力 | 失去競爭力 | 倒掛 |
審核編輯 黃宇
-
封裝
+關(guān)注
關(guān)注
128文章
9309瀏覽量
148964 -
功率模塊
+關(guān)注
關(guān)注
11文章
678瀏覽量
47016
發(fā)布評(píng)論請(qǐng)先 登錄
電位的本質(zhì)與碳化硅(SiC)功率器件應(yīng)用研究報(bào)告

基本半導(dǎo)體汽車級(jí)Pcore6 HPD Mini封裝碳化硅MOSFE模塊介紹

碳化硅(SiC)功率模塊替代IGBT模塊的工程技術(shù)研究報(bào)告

商用車電驅(qū)動(dòng)SiC模塊選型返璞歸真:從DCM/HPD封裝回歸ED3封裝碳化硅功率模塊的市場報(bào)告
基于碳化硅MOSFET的T-NPC拓?fù)湓诠夥c儲(chǔ)能PCS中的技術(shù)與商業(yè)價(jià)值分析報(bào)告

雙脈沖測試技術(shù)解析報(bào)告:國產(chǎn)碳化硅(SiC)功率模塊替代進(jìn)口IGBT模塊的驗(yàn)證與性能評(píng)估

簡單認(rèn)識(shí)博世碳化硅功率半導(dǎo)體產(chǎn)品
傾佳電子市場報(bào)告:國產(chǎn)SiC碳化硅功率器件在全碳化硅戶用儲(chǔ)能領(lǐng)域的戰(zhàn)略突破

EAB450M12XM3全碳化硅半橋功率模塊CREE
基本股份SiC功率模塊的兩電平全碳化硅混合逆變器解決方案
碳化硅在多種應(yīng)用場景中的影響

基于SiC碳化硅功率模塊的高效、高可靠PCS解決方案

國產(chǎn)SiC碳化硅功率模塊全面取代進(jìn)口IGBT模塊的必然性
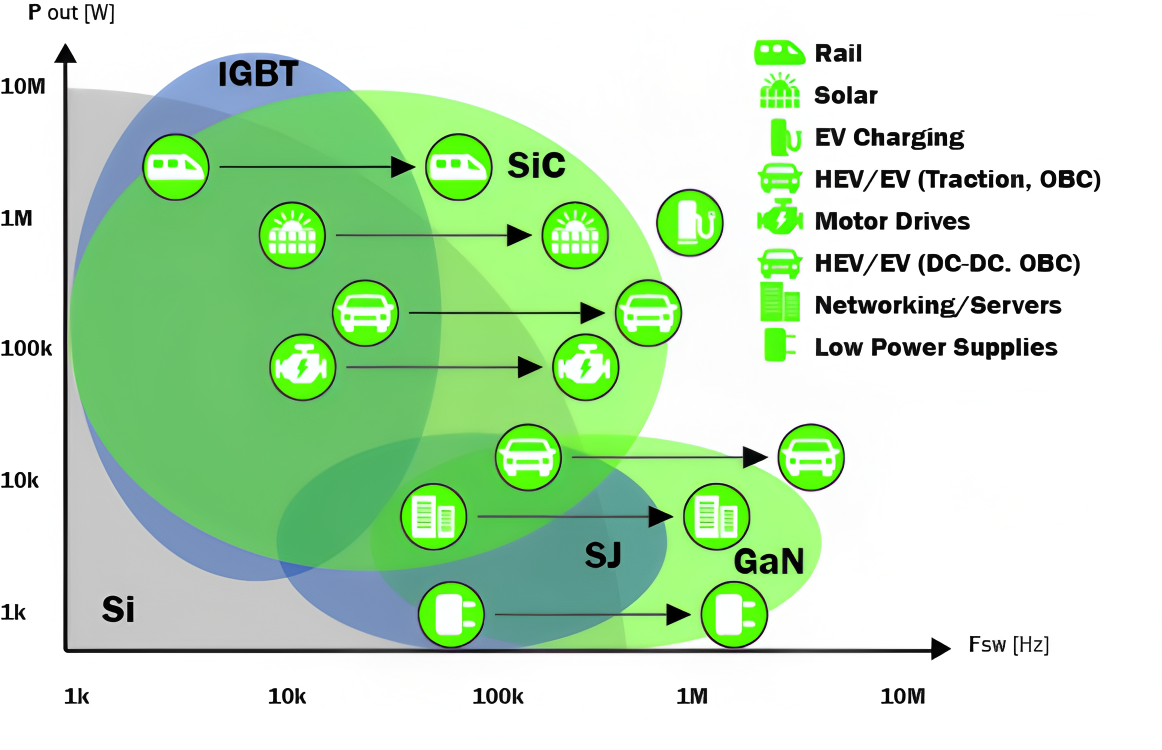
SiC(碳化硅)模塊設(shè)計(jì)方案在工商業(yè)儲(chǔ)能變流器(PCS)行業(yè)迅速普及




 DCM?1000及同類封裝碳化硅功率模塊商業(yè)化困境報(bào)告:當(dāng)“包子皮”貴過“包子餡”的經(jīng)濟(jì)學(xué)悖論
DCM?1000及同類封裝碳化硅功率模塊商業(yè)化困境報(bào)告:當(dāng)“包子皮”貴過“包子餡”的經(jīng)濟(jì)學(xué)悖論





評(píng)論