【博主簡(jiǎn)介】本人“愛在七夕時(shí)”,系一名半導(dǎo)體行業(yè)質(zhì)量管理從業(yè)者,旨在業(yè)余時(shí)間不定期的分享半導(dǎo)體行業(yè)中的:產(chǎn)品質(zhì)量、失效分析、可靠性分析和產(chǎn)品基礎(chǔ)應(yīng)用等相關(guān)知識(shí)。常言:真知不問出處,所分享的內(nèi)容如有雷同或是不當(dāng)之處,還請(qǐng)大家海涵。當(dāng)前在各網(wǎng)絡(luò)平臺(tái)上均以此昵稱為ID跟大家一起交流學(xué)習(xí)!
20 世紀(jì) 80 年代初,IBM 公司在制造DRAM的過程中,為了達(dá)到圓片表面金屬間介電質(zhì)層(IMD)的全局平坦,建立起了硅氧化物(SiO2)的 CMP 工藝,后來(lái)又?jǐn)U展到對(duì)金屬鎢(W)的 CMP。隨著晶體管集成度的不斷提高,從0.13um 工藝節(jié)點(diǎn)開始,銅互連成為集成電路后段工藝流程的唯一選擇,這就使銅連線的平坦化工藝(Cu CMP)變得舉足輕重。隨著摩爾定律的向前延伸,在從 28nm 開始的高端工藝中,場(chǎng)效應(yīng)管柵極的制造流程也引入了 CMP 工藝,以求獲得更加均勻的柵極高度。
隨著半導(dǎo)體工業(yè)沿著摩爾定律的曲線急速下降,驅(qū)使加工工藝向著更高的電流密度、更高的時(shí)鐘頻率和更多的互聯(lián)層轉(zhuǎn)移。由于器件尺寸的縮小、光學(xué)光刻設(shè)備焦深的減小,要求片子表面可接受的分辨率的平整度達(dá)到納米級(jí)。

一、CMP的簡(jiǎn)介
化學(xué)機(jī)械拋光是集成電路制造的重要工藝之一,又被稱為化學(xué)機(jī)械平坦化(Chemical Mechanical Plamarization, CMP)。
CMP是利用與被加工基片相匹配的拋光液在基片表層發(fā)生快速化學(xué)作用,形成一層相對(duì)于基體硬度較軟、強(qiáng)度較低、結(jié)合力較弱的表面軟化層;然后通過拋光墊與被加工基片之間的相對(duì)運(yùn)動(dòng),利用拋光液中的磨料和拋光墊對(duì)被加工基片表面進(jìn)行機(jī)械去除,降低拋光作用力而獲得高品質(zhì)的加工表面。該方法是借助磨料機(jī)械作用及化學(xué)作用的協(xié)同來(lái)完成微量材料去除,能夠避免依靠單純使用機(jī)械拋光作用造成的加工損傷和單純使用化學(xué)拋光作用造成的拋光效率低、表面平整度和拋光一致性差等缺點(diǎn)。

如下圖所示,主要包括硅片制造、IC制造(前端工藝、后端工藝)、測(cè)試與封裝幾個(gè)階段。在IC制造過程中,無(wú)論是氧化擴(kuò)散、化學(xué)氣相沉積還是濺鍍和保護(hù)層沉積,均需要多次使用CMP技術(shù)。

二、CMP的工作原理
CMP 所采用的設(shè)備及耗材包括拋光機(jī)、拋光液(又稱研磨液)、拋光墊、拋光后清洗設(shè)備、拋光終點(diǎn)(End Point)檢測(cè)及工藝控制設(shè)備、廢物處理和檢測(cè)設(shè)備等。應(yīng)用 CMP 工藝的設(shè)備一般稱為拋光機(jī),主流的拋光機(jī)通常具備一個(gè)較大的圓形拋光臺(tái),拋光臺(tái)上貼附著根據(jù)工藝需要所采用的不同材質(zhì)制成的拋光墊,通過裝載頭在圓片背面施加壓力,使得圓片表面向下緊壓于拋光墊上;拋光液通過拋光機(jī)的液體輸送管路從微小的噴嘴勻速流落在拋光墊的特定位置,隨著拋光墊的運(yùn)動(dòng)自然分散于圓片和拋光墊之間。
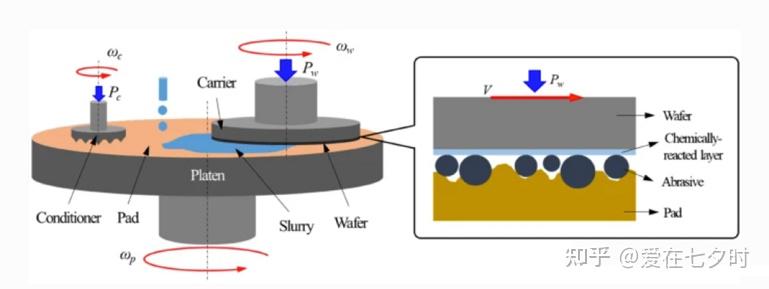
CMP 工藝的物理基礎(chǔ)是摩擦原理,其化學(xué)基礎(chǔ)是氧化反應(yīng)。在拋光過程中,圓片與拋光墊一般具有同向但不同速的旋轉(zhuǎn)運(yùn)動(dòng),裝載頭帶著圓片還會(huì)產(chǎn)生徑向的擺動(dòng),圓片與拋光墊之間由于速度差會(huì)產(chǎn)生相對(duì)運(yùn)動(dòng)。拋光液中的化學(xué)藥劑與圓片表面的材料發(fā)生氧化反應(yīng),將圓片表面的材料轉(zhuǎn)化成易于分離的物質(zhì),同時(shí)拋光液中的研磨顆粒以機(jī)械摩擦的方式將物質(zhì)從圓片表面逐層剝離。化學(xué)反應(yīng)和機(jī)械研磨同時(shí)進(jìn)行,當(dāng)二者達(dá)到平衡時(shí),可以獲得穩(wěn)定的拋光速率,以及圓片表面較好的缺陷移除效果。由于 CMP 工藝可以通過圓片表面微觀圖形高、低處之間的拋光速率差(高處的速率大于低處的速率)達(dá)到去除高處圖形從而獲得均勻的圖形表面的目的,因此 CMP 工藝既可以進(jìn)行全局平坦化,也可以達(dá)到局部平坦化的效果,而后者使得CMP 工藝在先進(jìn)集成電路制造流程中具有不可替代的地位。
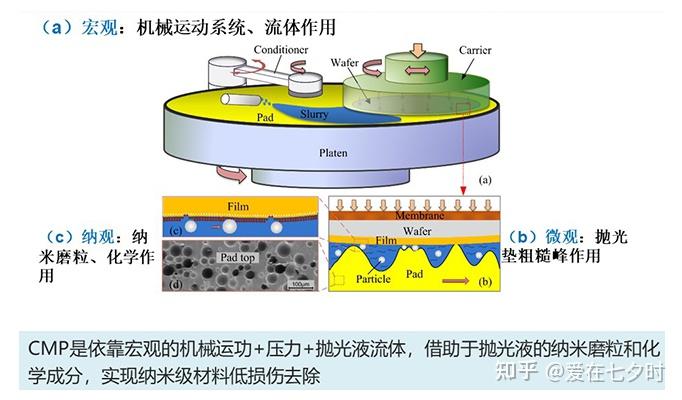
CMP 工藝融合了化學(xué)研磨和物理研磨的過程,而單一的化學(xué)或物理研磨在表面精度、粗糙度、均勻性、材料去除率及表面損失程度上都不能同時(shí)滿足要求。CMP 工藝兼具了二者的優(yōu)點(diǎn),可以在保證材料去除效率的同時(shí),得到準(zhǔn)確的表面材料層的厚度,較好的圓片表面平坦度和均勻性,以及實(shí)現(xiàn)納米級(jí)甚至原子級(jí)的表面粗糙度,同時(shí)還能保證較小的表面損失程度。 基于簡(jiǎn)單的物理和化學(xué)原理過程,CMP 工藝就能得到精準(zhǔn)和穩(wěn)定的微觀工藝結(jié)果,因此它已經(jīng)成為集成電路制造工藝流程中一種最廣泛采用且不斷擴(kuò)張應(yīng)用領(lǐng)域的技術(shù),如在先進(jìn)技術(shù)研發(fā)中,CMP 工藝直接影響晶體管柵極的形成,對(duì)器件最終性能的影響越來(lái)越重要。CMP 工藝的獨(dú)特之處是可以通過適當(dāng)設(shè)計(jì)拋光液和拋光墊來(lái)滿足不同需求的拋光工藝。根據(jù)對(duì)象的不同,CMP 工藝主要分為硅拋光(Poly CMP)、硅氧化物拋光(Silicon Oxide CMP)、碳化硅拋光 ( Silicon Carbide CMP)、鎢拋光(W CMP)和銅拋光 (Cu CMP)。以下就是本期要跟大家分享的內(nèi)容:






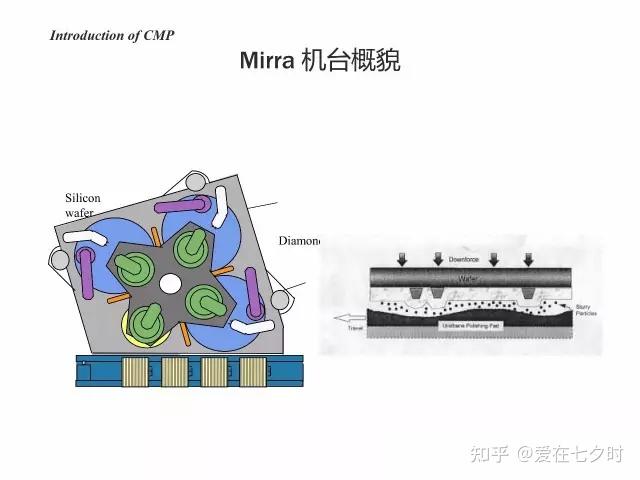



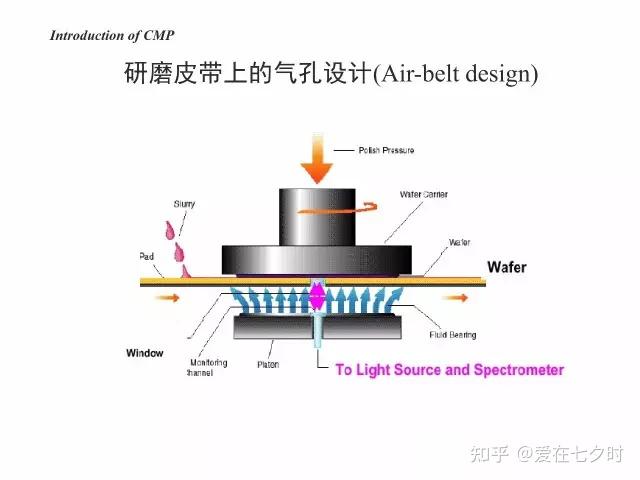

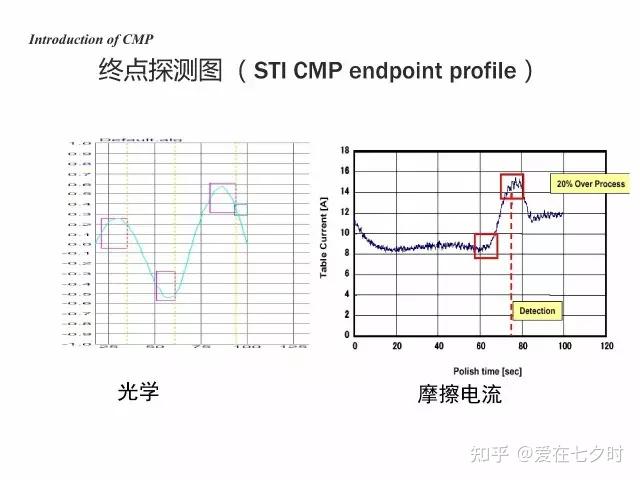


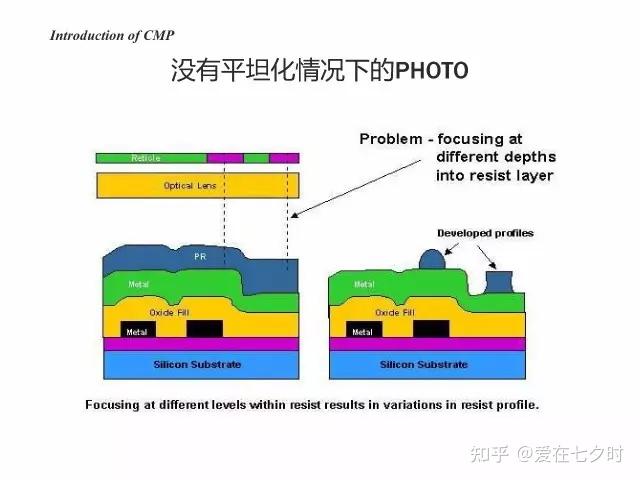
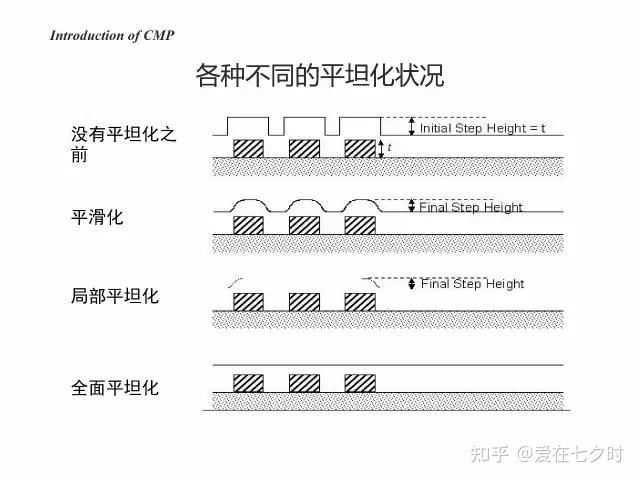
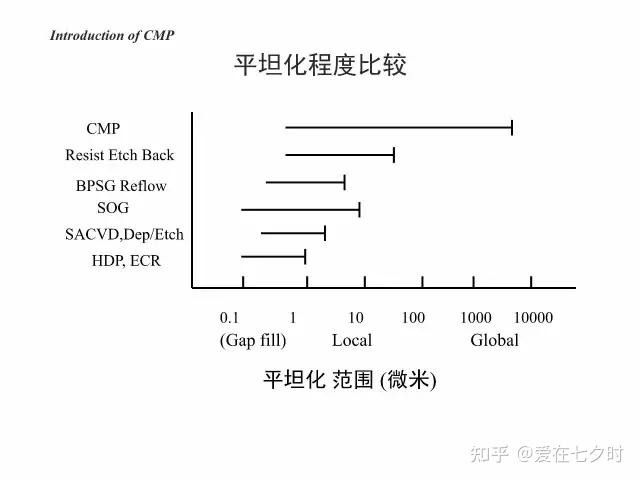




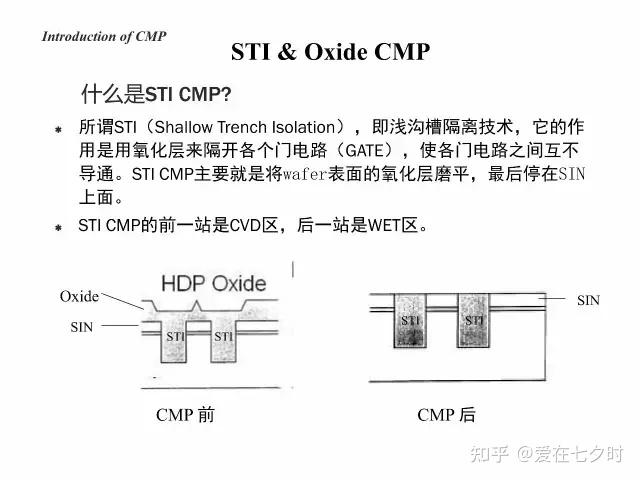
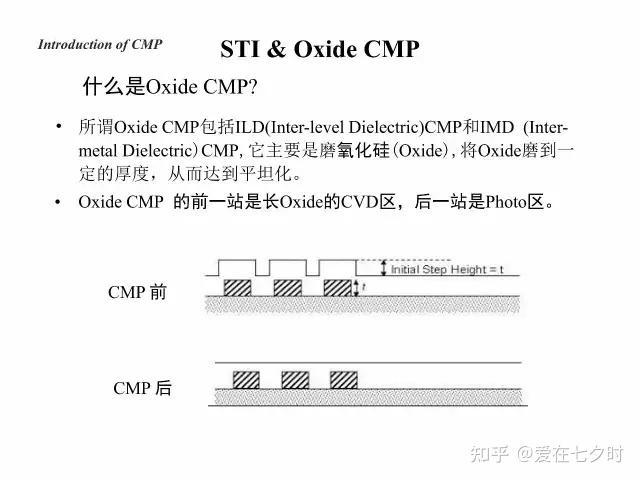
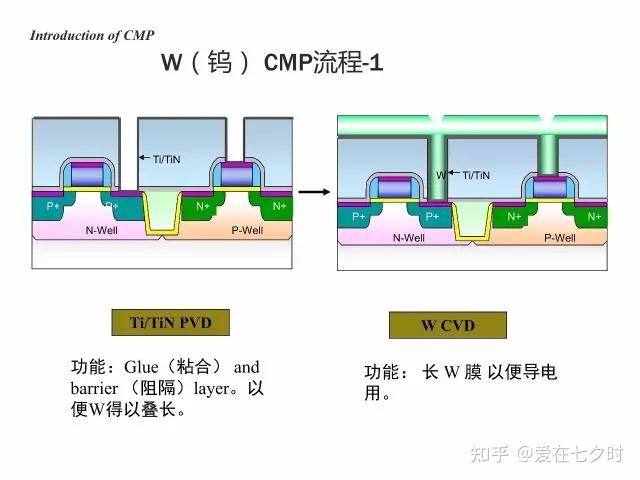
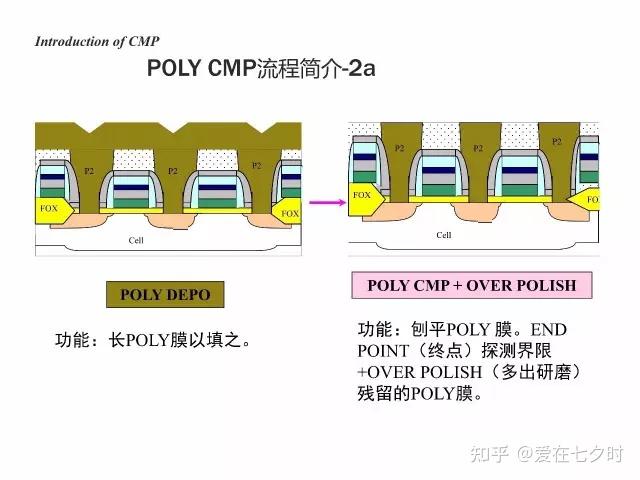





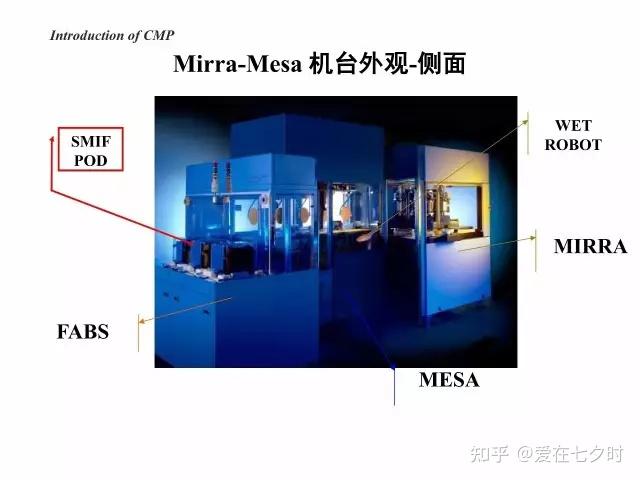

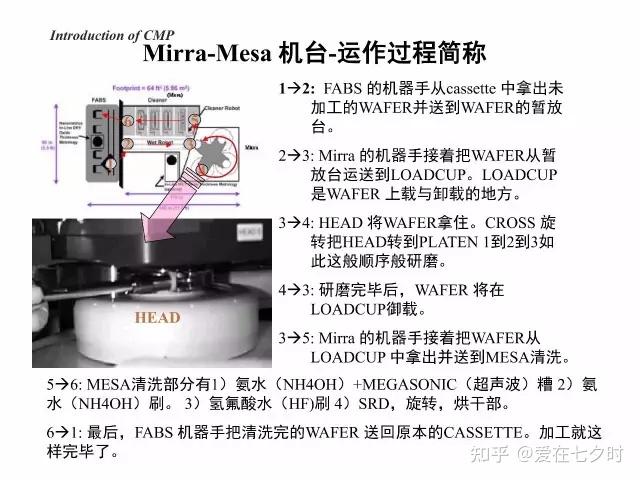
寫在最后面的話
CMP技術(shù)可用于各種高性能和特殊用途的集成電路制造,且應(yīng)用領(lǐng)域日益擴(kuò)展,已成為最為重要的超精細(xì)表面全局平面化技術(shù),也是國(guó)際競(jìng)爭(zhēng)的關(guān)鍵技術(shù),其增長(zhǎng)勢(shì)頭和發(fā)展前景非常可觀。深入研究和開發(fā)CMP技術(shù),并形成擁有自主知識(shí)產(chǎn)權(quán)的材料和工藝,將促進(jìn)我國(guó)IC產(chǎn)業(yè)的良性發(fā)展,提高我國(guó)在這一方面的國(guó)際地位,同時(shí)也將帶來(lái)了巨大的經(jīng)濟(jì)和社會(huì)效益。

免責(zé)聲明
【我們尊重原創(chuàng),也注重分享。文中的文字、圖片版權(quán)歸原作者所有,轉(zhuǎn)載目的在于分享更多信息,不代表本號(hào)立場(chǎng),如有侵犯您的權(quán)益請(qǐng)及時(shí)私信聯(lián)系,我們將第一時(shí)間跟蹤核實(shí)并作處理,謝謝!】
審核編輯 黃宇
-
CMP
+關(guān)注
關(guān)注
7文章
161瀏覽量
27831
發(fā)布評(píng)論請(qǐng)先 登錄
芯片制造中硅片的表面拋光加工工藝介紹

功率放大器在超聲化學(xué)機(jī)械拋光設(shè)備研究中的應(yīng)用

集成電路制造中常用濕法清洗和腐蝕工藝介紹

功率放大器在UV-CMP拋光機(jī)中的應(yīng)用
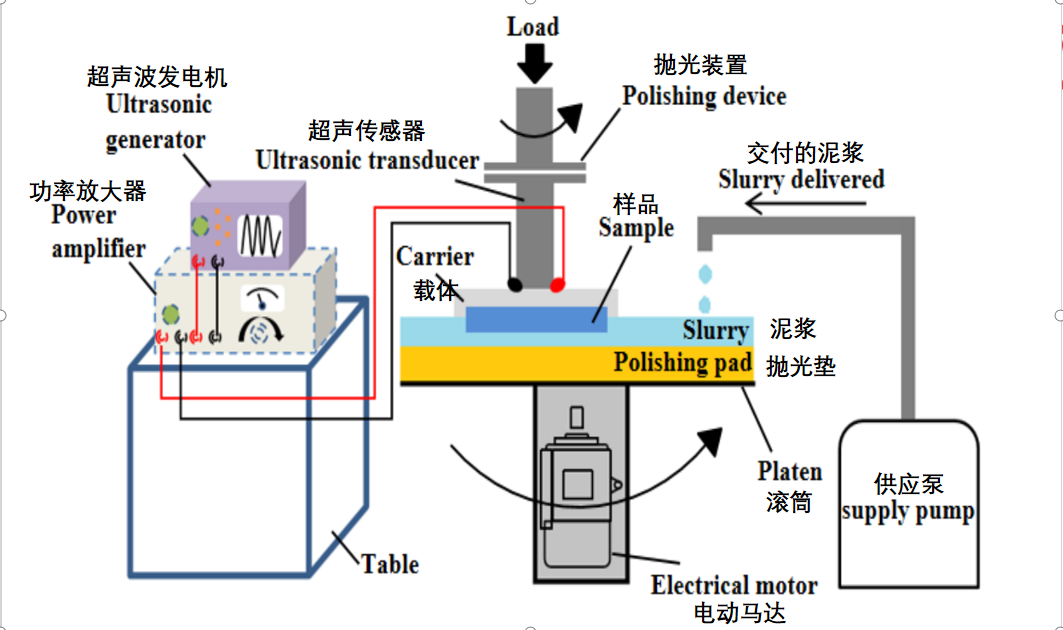
碳化硅 TTV 厚度在 CMP 工藝中的反饋控制機(jī)制研究

半導(dǎo)體碳化硅SiC制造工藝CMP后晶圓表面粗糙度檢測(cè)

TSV制造技術(shù)里的通孔刻蝕與絕緣層
CMP工藝中的缺陷類型
半導(dǎo)體國(guó)產(chǎn)替代材料 | CMP化學(xué)機(jī)械拋光(Chemical Mechanical Planarization)

深度解析芯片化學(xué)機(jī)械拋光技術(shù)
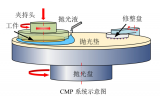
全球CMP拋光液大廠突發(fā)斷供?附CMP拋光材料企業(yè)盤點(diǎn)與投資邏輯(21361字)

一文詳解銅互連工藝

注塑加工半導(dǎo)體CMP保持環(huán):高性能材料與精密工藝的結(jié)合
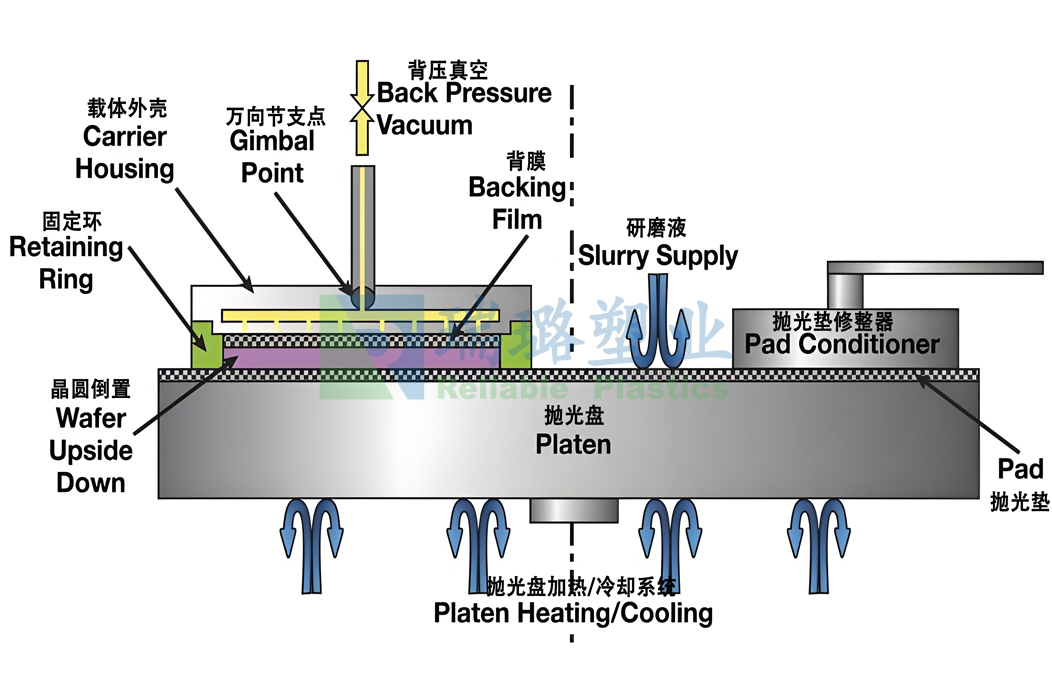
化學(xué)機(jī)械拋光液的基本組成
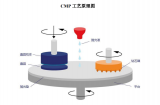
PEEK與PPS注塑CMP固定環(huán)的性能對(duì)比與工藝優(yōu)化




 化學(xué)機(jī)械拋光(CMP)工藝技術(shù)制程詳解;
化學(xué)機(jī)械拋光(CMP)工藝技術(shù)制程詳解;




評(píng)論