文章來源:老虎說芯
原文作者:老虎說芯
本文主要講述化學機械拋光液的原理、組成與應用邏輯。
什么是化學機械拋光液
化學機械拋光液是化學機械拋光(CMP)工藝中關鍵的功能性耗材,其本質是一個多組分的液體復合體系,在拋光過程中同時起到化學反應與機械研磨的雙重作用,目的是實現晶圓表面多材料的平整化處理。
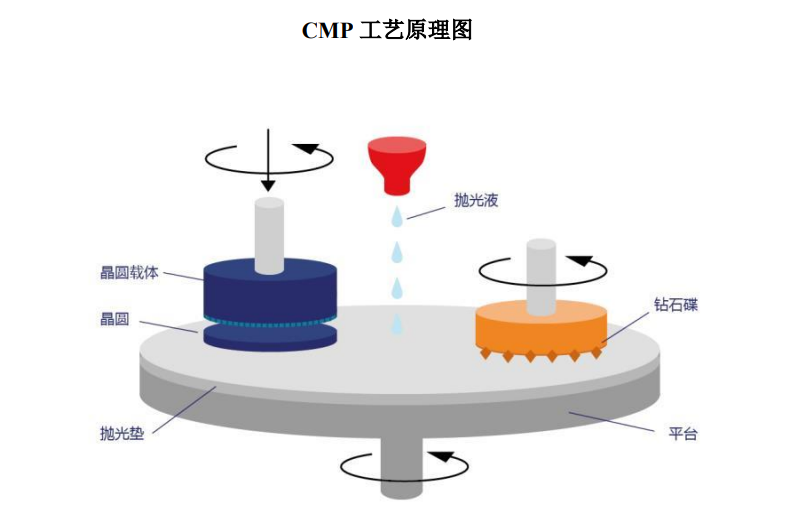
就像洗衣粉不僅僅洗衣服靠摩擦,它里面的酶和表面活性劑要分解污漬,CMP液不僅靠“磨”,還靠“化”,共同作用才精準高效。
化學機械拋光液的基本組成
CMP液的配方設計高度專業化,通常包括以下幾個核心組分:
研磨顆粒(Abrasive Particles):
常見類型:膠體二氧化硅(SiO?)、氣相二氧化硅、氧化鋁(Al?O?)
作用:提供機械“打磨”能力,相當于“微米級砂紙”,決定去除速率與表面粗糙度。
包括氧化劑、絡合劑、pH調節劑等。
作用:與待拋材料發生選擇性化學反應(如氧化銅形成易去除物質),提高材料的“可拋性”。
腐蝕抑制劑:
防止材料在非目標區域發生腐蝕,控制側蝕和表面缺陷生成。
溶劑(通常為高純水):
用于將其他組分均勻分散并形成穩定的工作體系。
為何CMP液對不同材料需要"量體裁衣"
由于芯片結構包含多種材料(銅、鎢、氧化硅、氮化物等),不同材料的物理/化學特性差異巨大,因此需要有選擇性地去除,而不是一刀切。
例如:
銅拋光液:需拋掉銅互連而保留絕緣層,因此對銅要“既能溶解又能保護邊界”。
鎢拋光液:因為鎢硬度高、化學惰性強,要求化學組分能活化表面,機械顆粒要更強。
硅粗拋液:主要在晶圓初加工階段,目的在于快速整平,允許表面略粗糙。
CMP液對核心挑戰與技術壁壘
材料去除速率與選擇比的平衡:太快會“過拋”,太慢則影響產能;關鍵是“只拋想拋的”。
顆粒分布與穩定性控制:防止結塊、沉降,確保液體均勻、持續可用。
微觀缺陷控制:如刮痕、凹坑、腐蝕斑等,這是決定芯片良率的關鍵因素之一。
CMP液對發展趨勢
高選擇性:對不同材料的識別與反應更精準;
低缺陷:以最小顆粒造成最小劃傷;
材料適配性:隨著10nm以下節點鈷互連等新材料引入,需新型CMP液配合;
國產替代化:由于高端顆粒等原料仍依賴進口,國內廠商在加速研發替代技術。
總結類比
你可以把CMP液理解為一個“智能打磨劑”:不僅像細砂紙一樣研磨,還像化學試劑一樣溶解目標層,而且還得“識人識物”——只對目標材料下手,對其他材料“禮貌以待”。這一點,在工藝窗口極窄的先進制程中,尤為關鍵。
-
機械
+關注
關注
8文章
1766瀏覽量
43863 -
拋光
+關注
關注
0文章
63瀏覽量
12172
原文標題:化學機械拋光液(CMP Slurry)的原理、組成與應用邏輯
文章出處:【微信號:bdtdsj,微信公眾號:中科院半導體所】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
深度解析芯片化學機械拋光技術
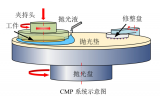
關于薄膜金剛石的化學機械拋光的研究報告
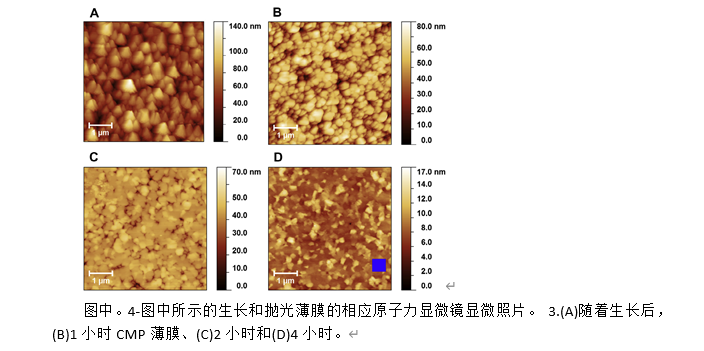
碳化硅晶片的化學機械拋光技術研究

新型銅互連方法—電化學機械拋光技術研究進展
化學機械拋光CMP技術的發展應用及存在問題
化學機械拋光(CMP)技術的發展、應用及存在問題
多晶硅薄膜后化學機械拋光的新型清洗解決方案

CMP后化學機械拋光清洗中的納米顆粒去除報告
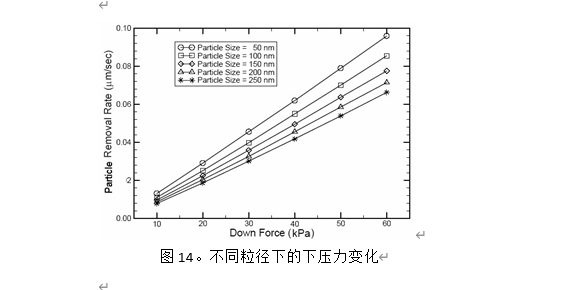
化學機械拋光(CMP)的現狀和未來
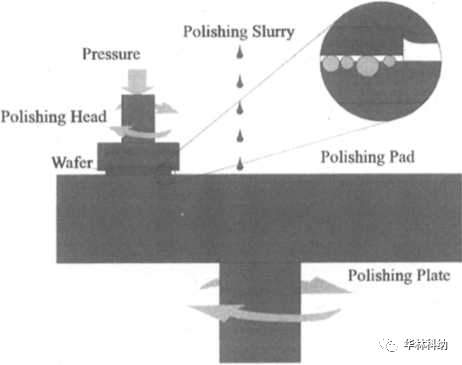
9.6.7 化學機械拋光液∈《集成電路產業全書》

芯秦微獲A+輪融資,用于化學機械拋光液產線建設
日本研發電化學機械拋光(ECMP)技術
全球CMP拋光液大廠突發斷供?附CMP拋光材料企業盤點與投資邏輯(21361字)




 化學機械拋光液的基本組成
化學機械拋光液的基本組成





評論