有機薄膜晶體管(TFTs)的高頻性能受限于接觸電阻(RC),尤其是在短通道L < 10 μm 和高遷移率μ > 1 cm2(V?s)條件下。即使采用相同材料和工藝,接觸電阻仍存在顯著的批次間差異。這種變異性對器件性能的可靠性和規模化生產提出了挑戰。本研究通過Xfilm埃利TLM接觸電阻測試儀的高精度傳輸線法分析,結合通道形貌的納米級表征,系統揭示了接觸電阻的測量誤差來源及其變異性機制,旨在為優化器件設計和工藝控制提供理論依據。
材料與器件制備
/Xfilm
 (a) 底柵-底接觸(倒置共面)器件架構的有機TFT橫截面示意圖;(b)研究中使用的分子化學結構
(a) 底柵-底接觸(倒置共面)器件架構的有機TFT橫截面示意圖;(b)研究中使用的分子化學結構
- 半導體材料:DPh-DNTT、DNTT、PhC? - BQQDI、DN4T等,真空沉積于硅基底。
- 器件結構:底柵-底接觸(倒置共面)架構,金源漏電極通過模板光刻制備,表面功能化PFBT或MeSTP單層以調節功函數。
- 工藝參數:基底溫度(p型90°C,n型140°C)、沉積速率(0.03–0.04 nm/s)、真空壓力(10??–10?? mbar)。

接觸電阻的顯著變化性
/Xfilm
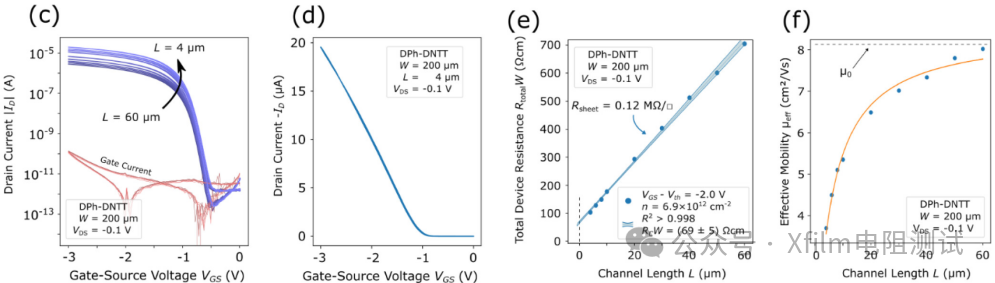 (c) DPh-DNTT TFT的典型轉移特性曲線;(d) 通道長度4 μm的DPh-DNTT TFT轉移特性曲線;(e) TLM分析:總器件電阻與通道長度的關系;(f) 有效載流子遷移率與通道長度的關系
(c) DPh-DNTT TFT的典型轉移特性曲線;(d) 通道長度4 μm的DPh-DNTT TFT轉移特性曲線;(e) TLM分析:總器件電阻與通道長度的關系;(f) 有效載流子遷移率與通道長度的關系

(a)模板光刻制備的金源漏電極TFT的SEM圖像;(b)超過1100個TFT的實際通道長度(SEM測量)與標稱通道長度的關系;(c) 使用實際通道長度與標稱通道長度進行TLM分析提取的DPh-DNTT接觸電阻對比;(d) 數據重繪以突出 (RCW)actual與 (RCW)nom的相對偏差通過電學表征,研究團隊發現:
- 當使用標稱通道長度(Lnom)進行TLM分析時,接觸電阻被系統性地高估。
- SEM圖像顯示,金源漏電極的實際通道長度 (Lactual= 2.53μm)比標稱值(2μm)長0.53 μm。統計1100多個TFT的通道長度偏差,中位值(ΔL = +0.6μm),導致接觸電阻被高估約10%。
這一結果表明,通道長度的工藝偏差是TLM分析中不可忽視的系統誤差來源,尤其在短通道器件中影響更為顯著。
TLM的可靠性剖析
/Xfilm
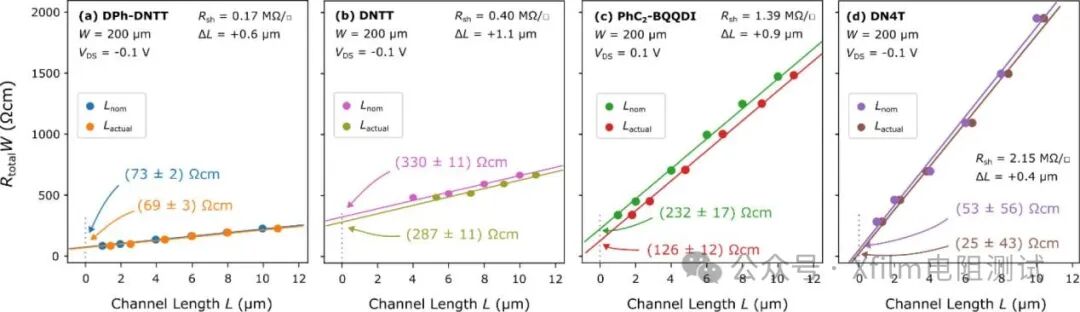
半導體薄層電阻對TLM提取接觸電阻可靠性的影響半導體器件關鍵參數對比

TLM的核心是通過線性擬合RtotalW = RsheetL + RCW提取接觸電阻。然而,其可靠性受以下因素制約:
- 半導體薄層電阻(Rsheet)的影響:當Rsheet較高時(如PhC?? BQQDI的1.39 MΩ/),忽略ΔL會引入高達46%的系統誤差。
- 統計誤差與最小通道長度的選擇:對于高Rsheet材料(如DN4T的2.15 MΩ/),其統計誤差σ = 43Ωcm甚至超過接觸電阻本身(25Ωcm)。此時需通過Λ = RCW / Rsheet確定最小通道長度(如DN4T需L < 0.12 μm),否則TLM結果不可靠。
TLM分析的優化需結合實際通道長度測量,并針對不同半導體材料調整通道長度范圍。
接觸電阻的變異性
/Xfilm
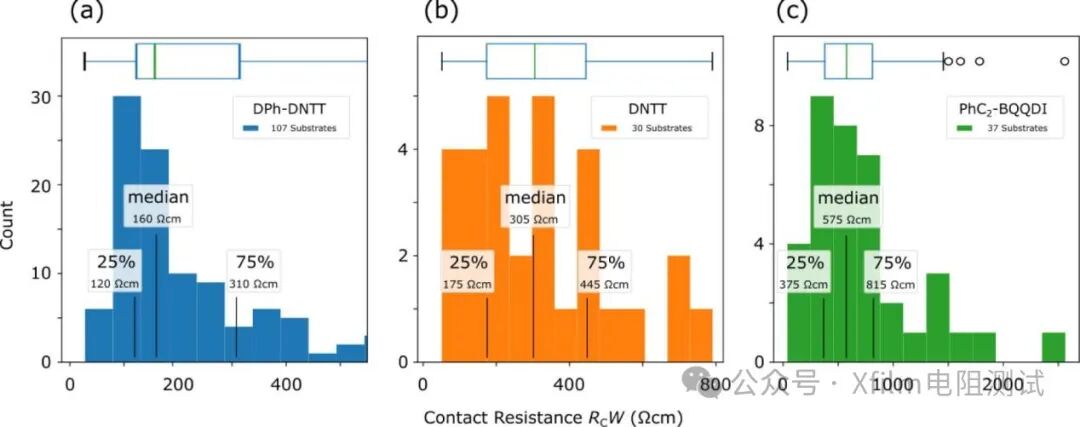 接觸電阻分布直方圖通過分析174個基底上的TFT數據,研究發現:
接觸電阻分布直方圖通過分析174個基底上的TFT數據,研究發現:
- 批次間差異顯著:DPh-DNTT器件的接觸電阻中位值為160 Ωcm,但跨度達28Ωcm至1 kΩcm;DNTT與PhC??BQQDI的變異性同樣顯著。
- 批次內一致性較高:同一批次基底的接觸電阻變異僅為12%(DPh-DNTT)和16%(PhC?? BQQDI),遠低于批次間差異(>100%)。
這表明,接觸電阻的變異性主要源于不可控的隨機工藝波動,而非系統性參數偏差。
環境參數的相關性
/Xfilm
 DPh-DNTT TFT性能參數與環境條件的相關性DPh-DNTT TFT工藝參數與器件參數的相關系數矩陣
DPh-DNTT TFT性能參數與環境條件的相關性DPh-DNTT TFT工藝參數與器件參數的相關系數矩陣 為探究變異性來源,研究團隊分析了實驗室濕度(rH)、半導體沉積真空壓力(pOSC)及電極沉積壓力(pcontact)的影響:
為探究變異性來源,研究團隊分析了實驗室濕度(rH)、半導體沉積真空壓力(pOSC)及電極沉積壓力(pcontact)的影響:
- 弱相關性:所有環境參數與接觸電阻的相關系數|c| < 0.25。僅觀察到微弱趨勢,如低pOSC(更高真空度)可能減少界面缺陷,略微降低RCW(c = -0.25)。
- 遷移率與閾值電壓的獨立性:本征遷移率μ0與閾值電壓Vth同樣未表現出強相關性,表明接觸電阻的波動主要與接觸-半導體界面特性相關。
環境參數對接觸電阻的影響有限,變異性更可能源于微觀界面形貌的隨機差異(如分子排列、缺陷分布)。TLM優化方向:必須通過SEM精確測量實際通道長度,避免ΔL引入系統誤差。針對高薄層電阻材料,需包含更短通道器件(L < Λ)以提高分析可靠性。接觸電阻的隨機性本質: 批次間差異主要由不可控的隨機工藝波動主導,環境參數影響微弱。未來研究需聚焦界面形貌的微觀表征(如AFM、XPS),以揭示分子級機制。
Xfilm埃利TLM電阻測試儀
/Xfilm
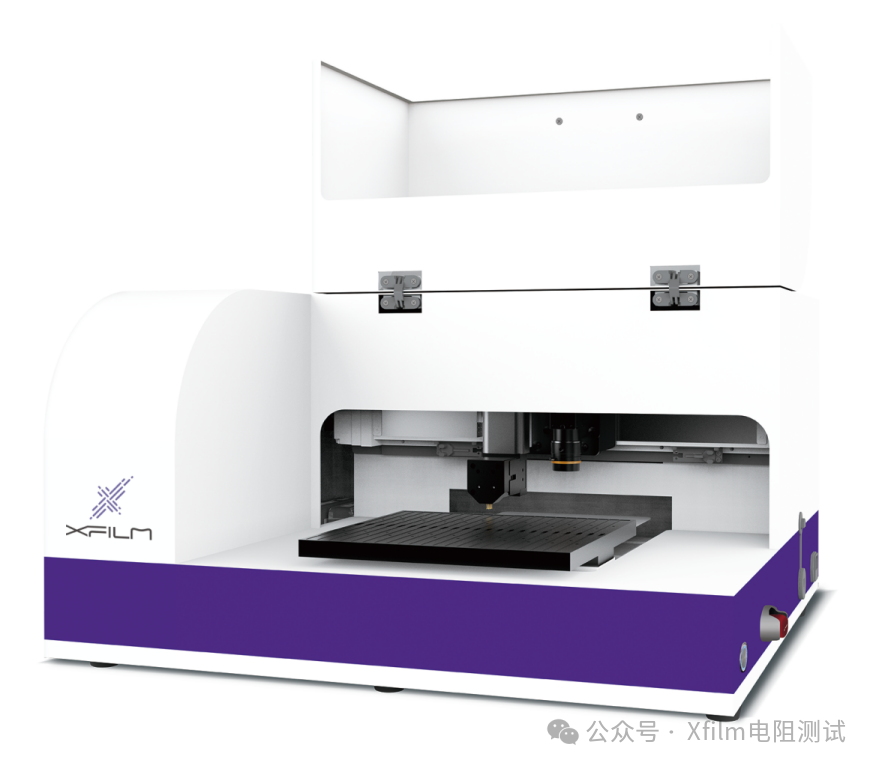
Xfilm埃利TLM接觸電阻測試儀用于測量材料表面接觸電阻或電阻率的專用設備,廣泛應用于電子元器件、導電材料、半導體、金屬鍍層、光伏電池等領域。■靜態測試重復性≤1%,動態測試重復性≤3%■ 線電阻測量精度可達5%或0.1Ω/cm■ 接觸電阻率測試與線電阻測試隨意切換■ 定制多種探測頭進行測量和分析本研究通過Xfilm埃利TLM接觸電阻測試儀的系統性數據采集與誤差分析,明確了有機TFT接觸電阻的核心挑戰,為高頻、高可靠性器件的開發提供了關鍵方法論支持。
原文出處:《Reliability of the Transmission Line Method and Reproducibility of the Measured Contact Resistance of Organic Thin-Film Transistors》
*特別聲明:本公眾號所發布的原創及轉載文章,僅用于學術分享和傳遞行業相關信息。未經授權,不得抄襲、篡改、引用、轉載等侵犯本公眾號相關權益的行為。內容僅供參考,如涉及版權問題,敬請聯系,我們將在第一時間核實并處理。
-
晶體管
+關注
關注
78文章
10415瀏覽量
148155 -
接觸電阻
+關注
關注
1文章
128瀏覽量
12686 -
TLM
+關注
關注
1文章
46瀏覽量
25367
發布評論請先 登錄
薄膜晶體管技術架構與主流工藝路線

TFTLCD薄膜晶體管液晶顯示器簡介
液態金屬接觸電阻精確測量:傳輸線法(TLM)的新探索

傳輸線法(TLM)優化接觸電阻:實現薄膜晶體管電氣性能優化

基于傳輸線法(TLM)的多晶 In?O?薄膜晶體管電阻分析及本征遷移率精準測量

基于傳輸線法TLM與隔離層優化的4H-SiC特定接觸電阻SCR精準表征

基于傳輸線模型(TLM)的特定接觸電阻率測量標準化

鋰電池嵌入電極顆粒的傳輸線法TLM 模擬研究

精確表征有機異質界面:解析傳輸長度法TLM中的幾何偏差與接觸電阻物理關聯




 采用傳輸線法(TLM)探究有機薄膜晶體管的接觸電阻可靠性及變異性
采用傳輸線法(TLM)探究有機薄膜晶體管的接觸電阻可靠性及變異性





評論