4H-碳化硅(4H-SiC)因其寬禁帶(3.26 eV)、高熱導(dǎo)率(4.9 W·cm?1·K?1)和高擊穿場強(qiáng)(2.5 MV·cm?1),成為高溫、高功率電子器件的核心材料。然而,其歐姆接觸的精準(zhǔn)表征面臨關(guān)鍵挑戰(zhàn):商用襯底的高摻雜特性導(dǎo)致電流擴(kuò)散至襯底深層,使得傳統(tǒng)傳輸線法(TLM)測得的特定接觸電阻(SCR)顯著偏離真實(shí)值。本研究結(jié)合Xfilm埃利TLM接觸電阻測試儀,通過TCAD模擬與實(shí)驗(yàn)驗(yàn)證,提出一種基于隔離層的優(yōu)化結(jié)構(gòu),為SCR的準(zhǔn)確測定提供了新方案。
TLM測量原理
/Xfilm
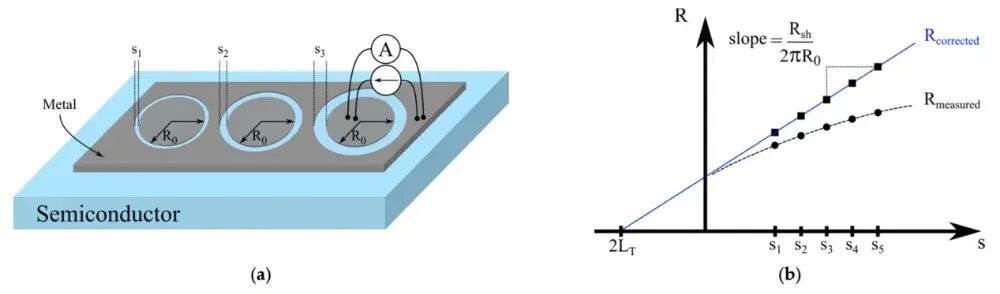
(a) 圓形c-TLM方法示意圖(b) 歐姆接觸電阻隨電極間距變化的典型曲線
TLM模型:通過測量不同間距s電極的電阻R,結(jié)合修正因子C?(R?為內(nèi)電極半徑) 可提取轉(zhuǎn)移長度 LT與SCR,R??為薄層電阻。
可提取轉(zhuǎn)移長度 LT與SCR,R??為薄層電阻。 

商用襯底的測量瓶頸
/Xfilm

激光退火Ti/4H-SiC接觸的I-V特性曲線(b) 校正后電阻隨間距的變化
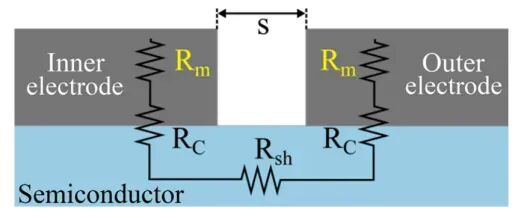
金屬-半導(dǎo)體結(jié)構(gòu)中的電阻組成示意圖實(shí)驗(yàn)采用
激光退火制備Ti/4H-SiC接觸,I-V曲線雖呈線性,但修正電阻-間距曲線線性度差(相關(guān)系數(shù)0.46),且電阻值極低(150-180 mΩ)。仿真重現(xiàn)該結(jié)構(gòu)發(fā)現(xiàn),350μm厚襯底中電流深入擴(kuò)散,導(dǎo)致總電阻Rtotal=Rm+RC+Rsh中Rsh占比過小,間距變化對電阻影響微弱,難以準(zhǔn)確提取SCR。
高摻雜襯底對SCR測定的影響
/Xfilm

直接制備于350 μm厚4H-SiC襯底上的c-TLM結(jié)構(gòu)圖(b) 1 V偏壓下電流密度分布(c) 橫截面視圖(d) 不同間距的模擬I-V曲線(e) 電阻隨間距的變化
厚襯底(350μm)仿真
- 電流分布:電子主要沿電極間流動(dòng),但顯著向襯底深處擴(kuò)散。
- 電阻特性:不同間距下電阻集中分布在150-180 mΩ,間距依賴性弱,與實(shí)驗(yàn)結(jié)果一致。
- 問題根源:高摻雜(1×101? cm?3)襯底電阻率低,電流無法局域化。

(a) 2 μm薄襯底上c-TLM結(jié)構(gòu)的模擬I-V曲線(b) 電阻隨間距顯著變化薄襯底(2μm)仿真
- 電流局域化:超薄襯底強(qiáng)制電流集中在接觸附近,I-V曲線間距依賴性顯著,電阻隨間距線性增加(1.3-3.5Ω)。
- 局限性:實(shí)際工藝難以實(shí)現(xiàn)2μm厚SiC襯底加工。
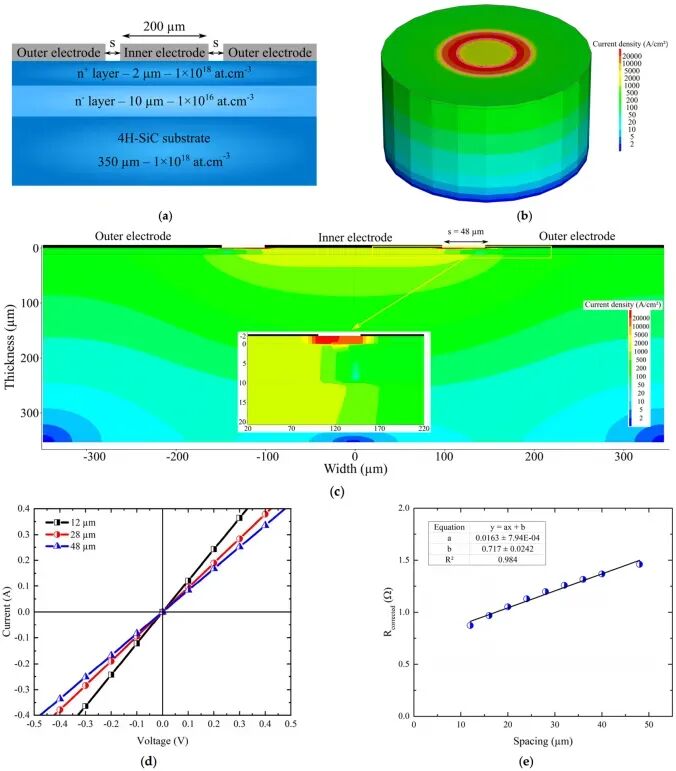
(a) 含隔離層的結(jié)構(gòu)示意圖(b)-(c) 1 V偏壓下電流密度的3D與橫截面分布(d) 不同間距的I-V曲線(e) 電阻隨間距變化
結(jié)構(gòu)設(shè)計(jì):在襯底與n?層間插入低摻雜隔離層,通過調(diào)節(jié)其厚度(1?40 μm)與摻雜濃度(5×1013?1×101? cm?3)優(yōu)化電流限制效果。 關(guān)鍵結(jié)論:
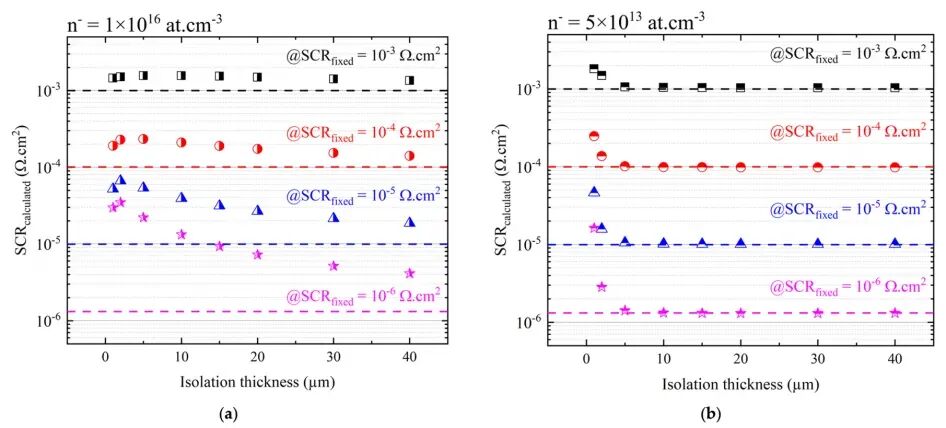
(a) 隔離層摻雜為1×101??at?cm?3時(shí),SCR計(jì)算值隨厚度的變化;(b) 隔離層摻雜為5×1013?at?cm?3時(shí)的變化;虛線:2 μm厚理想隔離層的參考SCR值
- 摻雜濃度:隔離層需≤5×1013 cm?3。若摻雜為1×101? cm?3,SCR測定誤差可達(dá)5.5倍(如SCR真實(shí)值1×10?? Ω·cm2時(shí),測得值5.5×10?? Ω·cm2)。
- 厚度:厚度≥5 μm時(shí),SCR誤差<7%。例如,5 μm/5×1013 cm?3隔離層可將SCR=1×10?? Ω·cm2的誤差降至1.07倍。
- 物理機(jī)制:低摻雜隔離層顯著提升電阻率,迫使電流集中于頂部n?層。
實(shí)驗(yàn)驗(yàn)證與性能對比
/Xfilm

(a) 激光退火Ti/4H-SiC接觸的I-V特性;(b) 校正后電阻隨間距的變化
鈦(Ti)接觸實(shí)驗(yàn):
- 結(jié)構(gòu)參數(shù):5.6 μm厚隔離層(5×1013 cm?3) + 2.6 μm n?層(1.9×101? cm?3)。
- 工藝:100 nm Ti濺射 + 激光退火(5.0 J·cm?2) + 離子束刻蝕c-TLM圖案。
- 結(jié)果:I-V曲線線性,SCR=1×10?? Ω·cm2,電阻-間距曲線相關(guān)性顯著提升(R2 ≈ 1)。
鎳(Ni)接觸對比:相同結(jié)構(gòu)下,SCR進(jìn)一步降至2.4×10?? Ω·cm2,驗(yàn)證了方案的普適性。 本研究通過系統(tǒng)模擬與實(shí)驗(yàn),揭示了高摻雜襯底對特定接觸電阻(SCR)測定的干擾機(jī)制,并提出了一種基于傳輸線法(TLM)-隔離層的優(yōu)化方案。摻雜的隔離層可有效限制電流分布,將特定接觸電阻(SCR)測定誤差降至7%以內(nèi),為4H-SiC功率器件的歐姆接觸優(yōu)化提供了可靠表征方法。
Xfilm埃利TLM電阻測試儀
/Xfilm
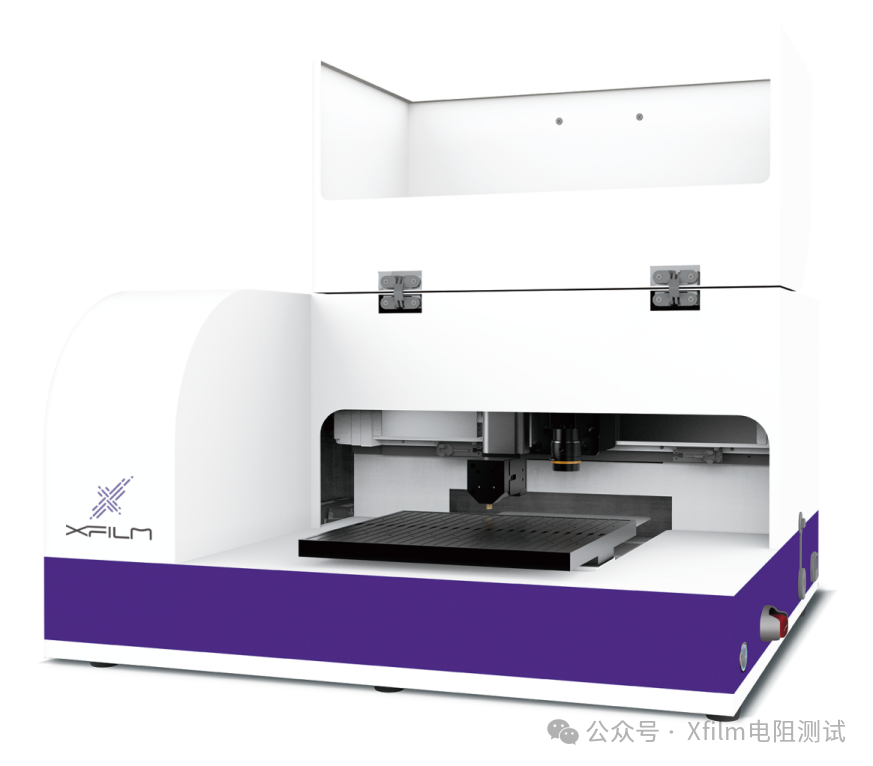
Xfilm埃利TLM接觸電阻測試儀用于測量材料表面接觸電阻或電阻率的專用設(shè)備,廣泛應(yīng)用于電子元器件、導(dǎo)電材料、半導(dǎo)體、金屬鍍層、光伏電池等領(lǐng)域。■靜態(tài)測試重復(fù)性≤1%,動(dòng)態(tài)測試重復(fù)性≤3%■ 線電阻測量精度可達(dá)5%或0.1Ω/cm■ 接觸電阻率測試與線電阻測試隨意切換■ 定制多種探測頭進(jìn)行測量和分析本文提出的隔離層-傳輸線法(TLM)聯(lián)合方案,結(jié)合Xfilm埃利TLM接觸電阻測試儀的高精度測量能力,為4H-SiC功率器件的歐姆接觸工藝優(yōu)化提供了標(biāo)準(zhǔn)化測試流程。
原文參考:《How to Accurately Determine the Ohmic Contact Properties on n-Type 4H-SiC》
*特別聲明:本公眾號(hào)所發(fā)布的原創(chuàng)及轉(zhuǎn)載文章,僅用于學(xué)術(shù)分享和傳遞行業(yè)相關(guān)信息。未經(jīng)授權(quán),不得抄襲、篡改、引用、轉(zhuǎn)載等侵犯本公眾號(hào)相關(guān)權(quán)益的行為。內(nèi)容僅供參考,如涉及版權(quán)問題,敬請聯(lián)系,我們將在第一時(shí)間核實(shí)并處理。
-
SCR
+關(guān)注
關(guān)注
2文章
154瀏覽量
46614 -
SiC
+關(guān)注
關(guān)注
32文章
3796瀏覽量
69699 -
接觸電阻
+關(guān)注
關(guān)注
1文章
128瀏覽量
12684
發(fā)布評論請先 登錄
4H-SiC離子注入層的歐姆接觸的制備
4H-SiC缺陷概述
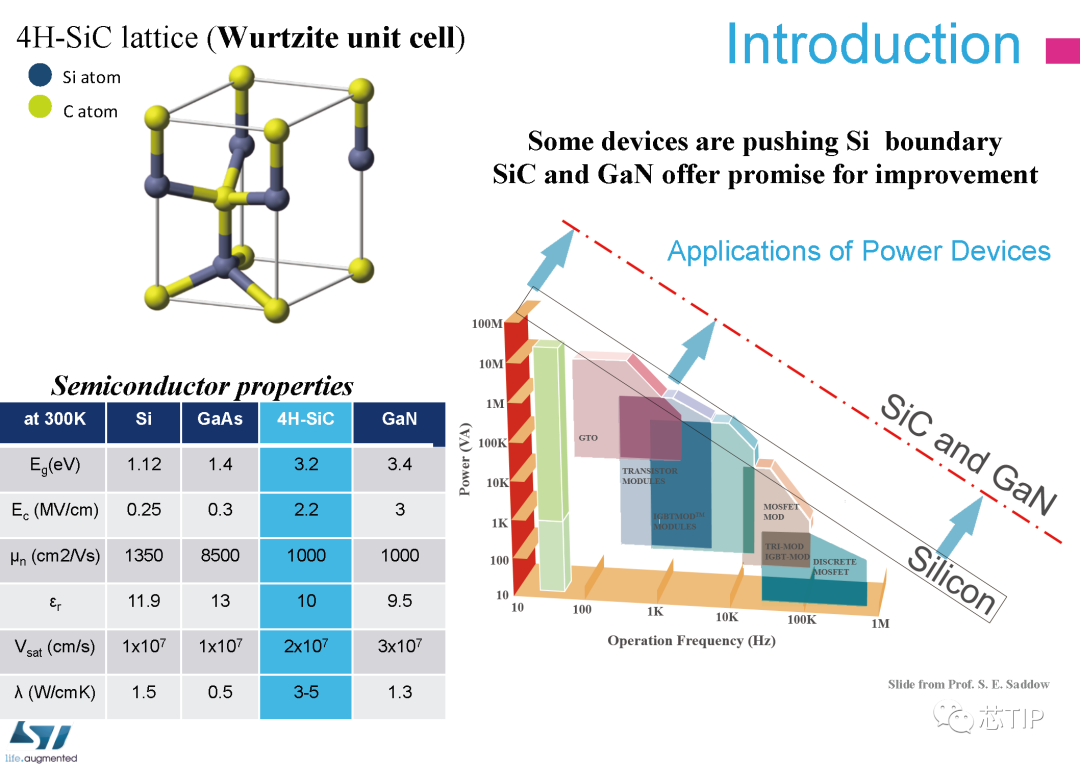
太陽能電池接觸電阻測試中的影響因素

摻雜分布對太陽能電池薄膜方阻和接觸電阻的影響

液態(tài)金屬接觸電阻精確測量:傳輸線法(TLM)的新探索

接觸電阻與傳輸線法TLM技術(shù)深度解密:從理論到實(shí)操,快速掌握精準(zhǔn)測量核心

傳輸線法(TLM)優(yōu)化接觸電阻:實(shí)現(xiàn)薄膜晶體管電氣性能優(yōu)化

基于傳輸線法(TLM)的多晶 In?O?薄膜晶體管電阻分析及本征遷移率精準(zhǔn)測量

基于改進(jìn)傳輸線法(TLM)的金屬 - 氧化鋅半導(dǎo)體界面電阻分析

采用傳輸線法(TLM)探究有機(jī)薄膜晶體管的接觸電阻可靠性及變異性

基于傳輸線模型(TLM)的特定接觸電阻率測量標(biāo)準(zhǔn)化

鋰電池嵌入電極顆粒的傳輸線法TLM 模擬研究

精確表征有機(jī)異質(zhì)界面:解析傳輸長度法TLM中的幾何偏差與接觸電阻物理關(guān)聯(lián)




 基于傳輸線法TLM與隔離層優(yōu)化的4H-SiC特定接觸電阻SCR精準(zhǔn)表征
基于傳輸線法TLM與隔離層優(yōu)化的4H-SiC特定接觸電阻SCR精準(zhǔn)表征




評論