【博主簡介】本人系一名半導體行業質量管理從業者,旨在業余時間不定期的分享半導體行業中的:產品質量、失效分析、可靠性分析和產品基礎應用等相關知識。常言:真知不問出處,所分享的內容如有雷同或是不當之處,還請大家海涵,如有需要可看文尾聯系方式,當前在網絡平臺上均以“愛在七夕時”的昵稱為ID跟大家一起交流學習!
愛在七夕時https://www.zhihu.com/people/duan.yu
半導體封裝是指將通過測試的晶圓按照產品型號及功能需求加工得到獨立芯片的過程。封裝過程為:來自晶圓前道工藝的晶圓通過劃片工藝后被切割為小的晶片(Die),然后將切割好的晶片用膠水貼裝到相應的基板(引線框架)架的小島上,再利用超細的金屬(金錫銅鋁)導線或者導電性樹脂將晶片的接合焊盤(Bond Pad)連接到基板的相應引腳(Lead),并構成所要求的電路;然后再對獨立的晶片用塑料外殼加以封裝保護,塑封之后還要進行一系列操作,封裝完成后進行成品測試,通常經過入檢Incoming、測試Test和包裝Packing等工序,最后入庫出貨。
而其中的Wire Bonding是一種將微電子芯片連接到外部電路的常用工藝。在Wire Bonding工藝中,通過使用電極焊絲將芯片電極和外部金屬電路連接起來。其中,焊絲是用金屬材料制成的細絲,通過焊絲焊接機械手進行精確的位置控制和焊接操作。Wire Bonding工藝中的一些重要術語包括焊絲直徑、焊絲彈性、焊點大小和焊點形狀等,這些術語對于確保高質量的焊接連接至關重要。

Wire Bonding是一種常用的半導體封裝技術,用于連接芯片和封裝基板之間的金屬線。該工藝涉及多個術語,如金線、金球、焊盤、焊點、焊線、焊點間距等。
金線是連接芯片和封裝基板的主要組成部分,通常由金、鋁或銅制成。金球是金線的一端,用于連接芯片的金屬引腳。
焊盤是封裝基板上的金屬墊片,用于接收金線的焊接。焊點是金線與焊盤之間的連接點。焊線是金線的另一端,用于連接封裝基板上的其他電路元件。焊點間距是指相鄰焊點之間的距離,影響著連接的可靠性和性能。
坦白來講,對于半導體后端封裝工序的相關內容分享,在我各平臺上均已分享得比較多了:
超聲波焊接(Ultrasonic welding)工藝應在半導體引線鍵合中的詳解;mp.weixin.qq.com/s?__biz=Mzk0MzYyODY5Mg==&mid=2247515757&idx=1&sn=f9163fa9bbf9e0502251a81918650e83&scene=21#wechat_redirect
半導體封裝Wire Bonding (引線鍵合)工藝技術的詳解;mp.weixin.qq.com/s?__biz=Mzk0MzYyODY5Mg==&mid=2247509620&idx=1&sn=65c3a7f3343807cc633cf20511f04876&scene=21#wechat_redirect
半導體“楔形鍵合(Wedge Bonding)”工藝技術的詳解;mp.weixin.qq.com/s?__biz=Mzk0MzYyODY5Mg==&mid=2247515918&idx=1&sn=65d5d8c22f576eb637586aefa250cb52&scene=21#wechat_redirect
半導體“封裝過程”工藝技術的詳解;mp.weixin.qq.com/s?__biz=Mzk0MzYyODY5Mg==&mid=2247514778&idx=1&sn=00fe6a0db439331830cb111f6c3b89da&scene=21#wechat_redirect
半導體封裝“焊線鍵合(Wire Bonding)”線弧相關培訓的詳解;mp.weixin.qq.com/s?__biz=Mzk0MzYyODY5Mg==&mid=2247512372&idx=1&sn=f1dd55515a10bc67a663c2f55bde02c7&scene=21#wechat_redirect
半導體IC封裝工藝技術的詳解;mp.weixin.qq.com/s?__biz=Mzk0MzYyODY5Mg==&mid=2247507180&idx=1&sn=d86dfdb3ab276c06fa732d3b9765f95c&scene=21#wechat_redirect
半導體金線鍵合(Gold Wire Bonding)封裝工藝技術簡介;mp.weixin.qq.com/s?__biz=Mzk0MzYyODY5Mg==&mid=2247507082&idx=1&sn=f6aad777d848e50482cf5a8004ab496f&scene=21#wechat_redirect
半導體“金線鍵合(Gold Wire Bonding)”工藝技術的詳解;mp.weixin.qq.com/s?__biz=Mzk0MzYyODY5Mg==&mid=2247502190&idx=1&sn=cf81535e395a50d6baa88c7942fd4da4&scene=21#wechat_redirect
半導體Wire Bonding 工藝技術的詳解;mp.weixin.qq.com/s?__biz=Mzk0MzYyODY5Mg==&mid=2247494587&idx=1&sn=8fc08e6ca23866c754833dafdbb244b8&scene=21#wechat_redirect
所以,本章節主要想跟大家分享的還是半導體封裝Wire Bonding工藝的基礎知識,感覺其中有些內容還是可圈可點的:





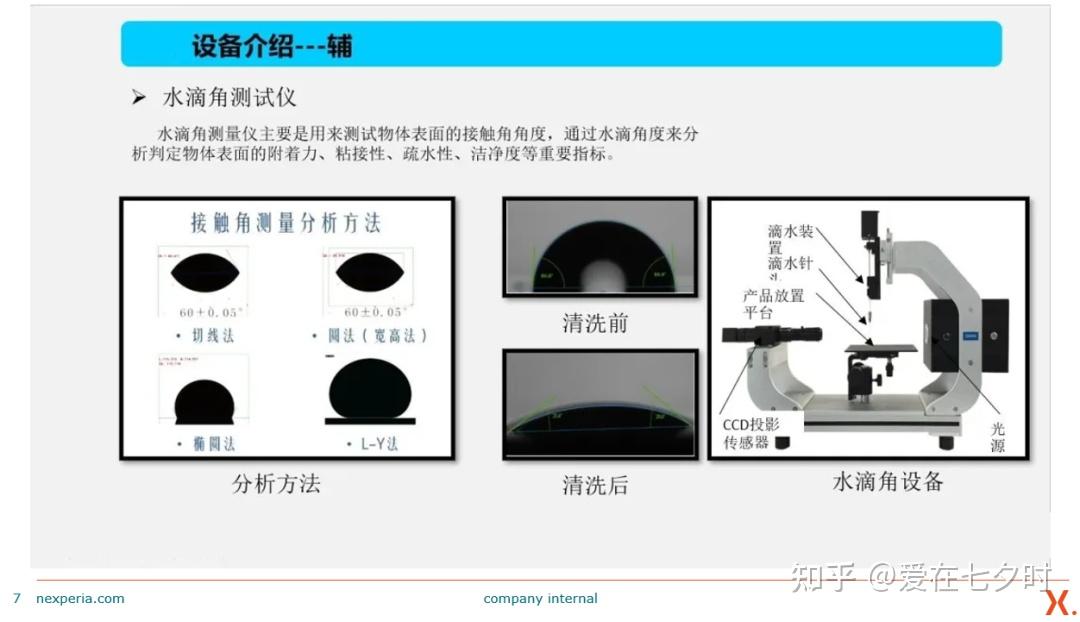




http://weixin.qq.com/r/QhAjO9TE64mUrZBY90VQ (二維碼自動識別)
因為本PPT章節太多,剩下部分如有朋友有需要,可加入我“知識星球”免費下載PDF版本。注意:此資料只可供自己學習,不可傳閱,平臺有下載記錄,切記!文末有加入“星球”方式,歡迎加入后一起交流學習。
總之,引線鍵合(Wire Bonding)工藝技術是微電子封裝中不可或缺的一部分,它通過精細的金屬線連接技術,實現了芯片與外部電路的電氣互連,對于確保電子設備的性能和可靠性發揮著重要作用。隨著技術的不斷進步,引線鍵合也在不斷優化,以適應更高性能和更低成本的需求。

-----End-----
免責聲明
我們尊重原創,也注重分享;文字、圖片版權歸原作者所有。轉載目的在于分享更多信息,不代表本號立場,如有侵犯您的權益請及時聯系(一三七 二八三五 六二六五),我們將第一時間刪除,謝謝!
審核編輯 黃宇
-
半導體封裝
+關注
關注
4文章
326瀏覽量
15265 -
引線鍵合
+關注
關注
2文章
38瀏覽量
8627
發布評論請先 登錄
高頻超聲鍵合技術:引線鍵合工藝優化與質量檢測方法

半導體封裝引線鍵合技術:超聲鍵合步驟、優勢與推拉力測試標準

一文讀懂引線鍵合可靠性:材料選型、失效風險與測試驗證全解析

一文了解什么是半導體引線鍵合中的彈坑?

半導體金線鍵合(Gold Wire Bonding)封裝工藝技術簡介;

半導體芯片制造技術——“芯片鍵合”工藝技術的詳解;

半導體封裝Wire Bonding (引線鍵合)工藝技術的詳解;

半導體封裝“焊線鍵合(Wire Bonding)”線弧相關培訓的詳解;

半導體“金(Au)絲引線鍵合”失效機理分析、預防及改善的詳解;

半導體“楔形鍵合(Wedge Bonding)”工藝技術的詳解;

什么是引線鍵合?芯片引線鍵合保護膠用什么比較好?




 半導體封裝“引線鍵合(Wire Bonding)”基礎知識詳解
半導體封裝“引線鍵合(Wire Bonding)”基礎知識詳解








評論