來源:集成電路材料研究
日本電氣玻璃與VIA Mechanics于11月19日宣布,雙方已簽署共同開發協議,以加速玻璃及玻璃陶瓷制成的半導體封裝用無機芯板的開發。
目前的半導體封裝中,核心基板主要采用玻璃環氧樹脂基板等有機材料基板。然而,針對未來高性能半導體的封裝需求,核心基板上的電路和微孔(通孔,via)需要實現更高的微細化和高密度化,同時具備支持高速傳輸的優良電氣特性。這些需求使得有機材料基板難以滿足。因此,玻璃作為替代材料受到越來越多的關注。
然而,在普通玻璃基板中,若使用CO2激光進行打孔,容易出現裂紋(破裂),導致基板損壞。為了解決這一問題,需要采用激光改性和蝕刻工藝來形成通孔。然而,這種加工方法存在工藝難度高、加工時間長等問題。
此次的共同開發旨在通過合作解決上述課題,將日本電氣玻璃多年來積累的玻璃與玻璃陶瓷技術經驗與VIA Mechanics的激光加工技術相結合。為此,日本電氣玻璃引入了VIA Mechanics的激光加工設備,以加速無機芯板的早期開發。
在共同開發中,日本電氣玻璃的職責包括以下三個方面:
1. 針對無機芯板所需的玻璃基板及玻璃陶瓷基板核心材料的設計與開發;
2. 為玻璃基板及玻璃陶瓷基板的量產開發相關技術;
3. 提供試制品,并提出解決技術課題的方案。
而VIA Mechanics的職責包括以下兩點:
1. 支援開發基于CO2激光的無裂紋通孔形成技術;
2. 提出實現無機芯板實用化的評價方法。
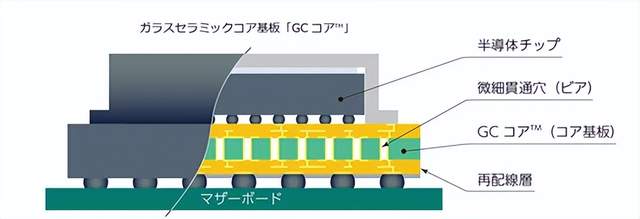
圖1:日本電氣玻璃的面向半導體封裝的玻璃陶瓷核心基板“GC Core”示意圖(來源:日本電氣玻璃)
聲明:本網站部分文章轉載自網絡,轉發僅為更大范圍傳播。 轉載文章版權歸原作者所有,如有異議,請聯系我們修改或刪除。聯系郵箱:viviz@actintl.com.hk, 電話:0755-25988573
審核編輯 黃宇
-
封裝
+關注
關注
128文章
9249瀏覽量
148624 -
半導體封裝
+關注
關注
4文章
319瀏覽量
15243
發布評論請先 登錄
鍵合玻璃載板:半導體先進封裝的核心支撐材料
艾邁斯歐司朗:推出面向下一代汽車激光雷達應用的新型激光器

羅姆面向下一代800 VDC架構發布電源解決方案白皮書
AMEYA360 | 羅姆面向下一代800 VDC架構發布電源解決方案白皮書

半導體無機清洗是什么意思
Telechips與Arm合作開發下一代IVI芯片Dolphin7
意法半導體推進下一代芯片制造技術 在法國圖爾工廠新建一條PLP封裝試點生產線
意法半導體攜手Flex推動下一代移動出行發展
恩智浦與長城汽車深化合作,圍繞電氣化、下一代電子電氣架構
下一代高速芯片晶體管解制造問題解決了!
NVIDIA 采用納微半導體開發新一代數據中心電源架構 800V HVDC 方案,賦能下一代AI兆瓦級算力需求
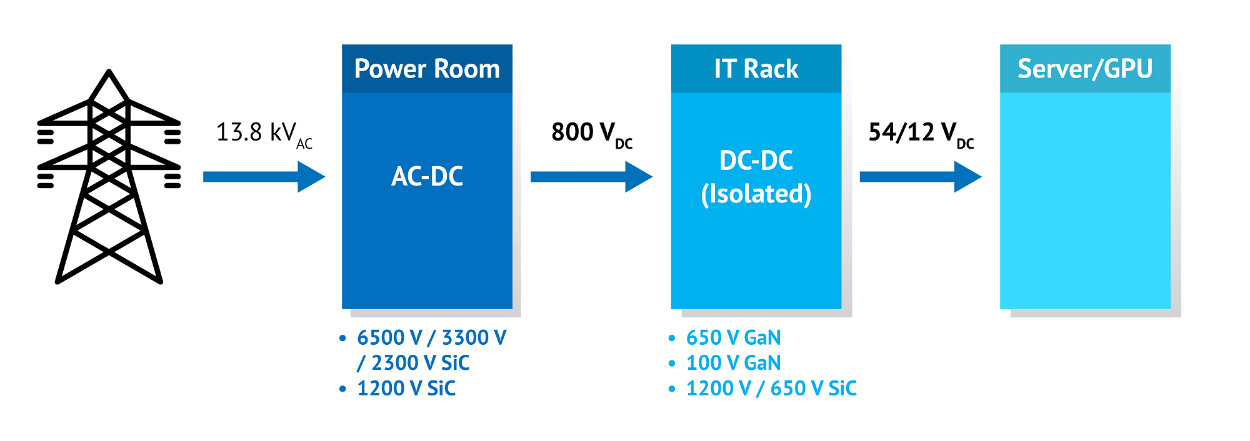
Rambus推出面向下一代AI PC內存模塊的業界領先客戶端芯片組
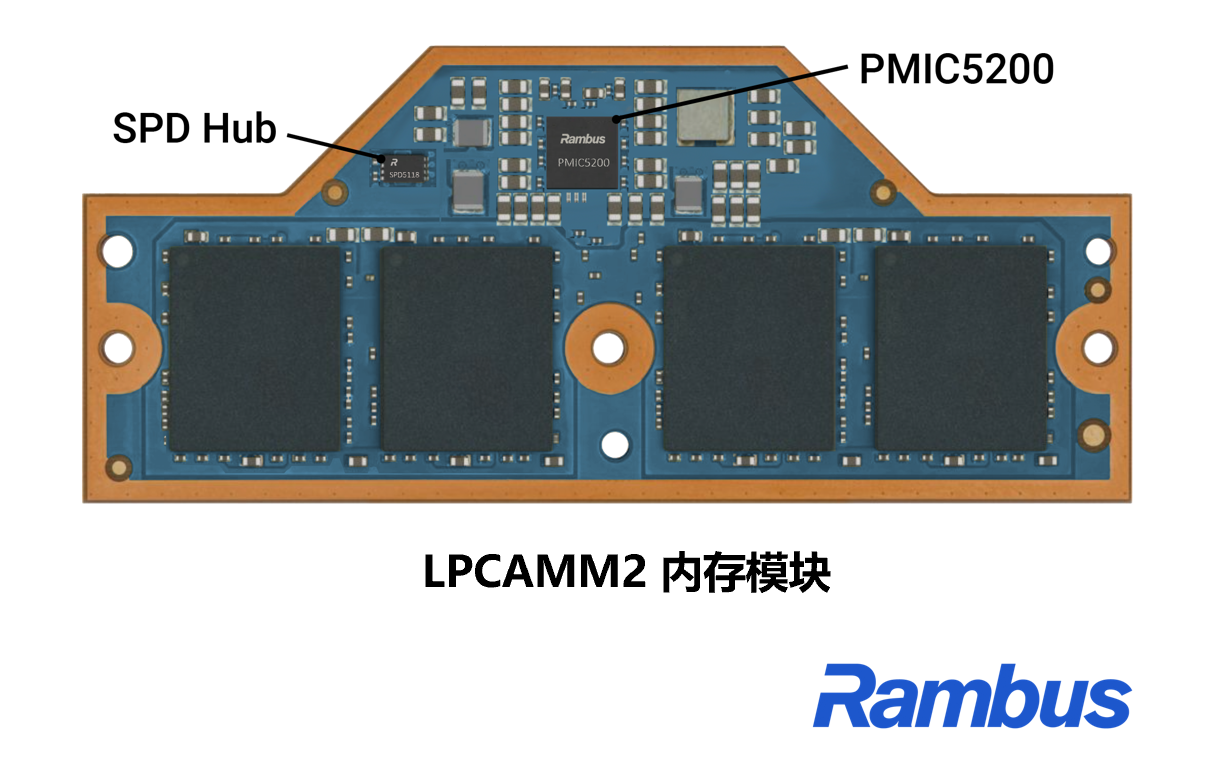



 日本電氣玻璃與VIA Mechanics簽署面向下一代半導體封裝的無機芯板開發協議
日本電氣玻璃與VIA Mechanics簽署面向下一代半導體封裝的無機芯板開發協議






評論