工藝原理
CSP(Chip Scale Package,芯片級封裝)技術是一種先進的封裝技術,其焊端通常設計為直徑0.25mm的焊球。這種設計不僅減小了封裝尺寸,還提高了集成度。在焊接過程中,焊膏首先融化,隨后焊球融化,這種順序融化機制有助于避免焊球間的橋連問題,但可能因印刷過程中的少印而導致球窩、開焊等缺陷。因此,對于0.4mm間距的CSP,確保印刷過程中獲得足夠的焊膏量是關鍵。
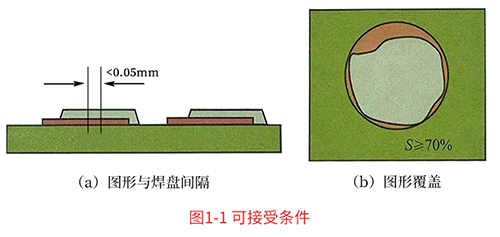
基準工藝
為了優化CSP的焊接效果,基準工藝設定如下:
模板厚度:0.08mm。這一厚度選擇旨在平衡焊膏的填充性和溢出控制,確保焊膏能夠均勻且適量地覆蓋焊盤。
模板開口直徑:ф0.25mm,與焊球直徑相匹配,以確保焊膏能夠準確、完整地填充到焊球下方的區域。
模板類型:推薦使用FG模板。FG模板(Fine Grain模板)以其精細的網孔結構和優異的脫模性能,有助于實現高精度的焊膏印刷。
接受條件
可接受條件:
焊膏圖形中心位置:焊膏圖形中心偏離焊盤中心應小于0.05mm,以確保焊膏的準確位置,避免焊接不良。
焊膏量:焊膏量覆蓋率超出焊盤75%~125%的范圍(通過SPI檢測)。這一范圍確保了焊膏的充足性,同時避免了過量焊膏可能導致的短路問題。
焊膏覆蓋面積:焊膏覆蓋面積應大于或等于模板開口面積的70%,以確保焊膏能夠充分覆蓋焊盤,提高焊接的可靠性和穩定性。
印刷質量:
無漏印現象,且擠印引發的焊膏與焊盤最小間隔應大于或等于0.5mm2,以避免短路風險。
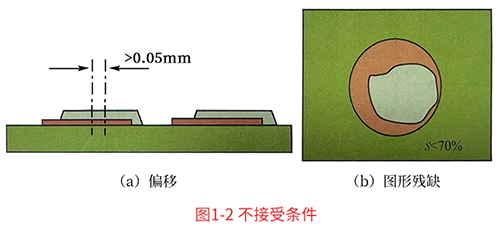
不接受條件
焊膏圖形中心位置偏移:圖形中心偏離焊盤中心大于0.05mm,這可能導致焊接不良,產生錫珠,影響封裝質量。
焊膏量異常:焊膏量覆蓋率超出焊盤75%~125%的范圍,無論是過多還是過少,都可能對焊接質量產生不利影響。
焊膏覆蓋面積不足:圖形覆蓋面積小于模板開口面積的70%,這可能導致焊盤部分區域無焊膏覆蓋,進而影響焊接的可靠性。
印刷缺陷:出現焊膏漏印、嚴重擠印與拉尖等缺陷,這些都會直接影響焊接的質量和穩定性,因此不被接受。
總的來說,CSP封裝工藝的成功實施需要嚴格控制焊膏的印刷過程,確保焊膏的準確位置、適量填充和良好覆蓋,以滿足嚴格的焊接質量要求。
審核編輯 黃宇
-
封裝
+關注
關注
128文章
9249瀏覽量
148626 -
CSP
+關注
關注
0文章
129瀏覽量
29488 -
焊盤
+關注
關注
6文章
604瀏覽量
39770
發布評論請先 登錄
熱壓鍵合工藝的技術原理和流程詳解

SK海力士HBS存儲技術,基于垂直導線扇出VFO封裝工藝

詳解芯片封裝的工藝步驟

半導體封裝工藝流程的主要步驟

芯片封裝工藝詳解
全面剖析倒裝芯片封裝技術的內在機制、特性優勢、面臨的挑戰及未來走向
半導體貼裝工藝大揭秘:精度與效率的雙重飛躍




 CSP(Chip Scale Package)封裝工藝詳解?
CSP(Chip Scale Package)封裝工藝詳解?








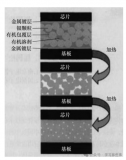



評論