文章來源:半導體與物理
原文作者:jjfly686
本文介紹了芯片封裝的類型與流程。
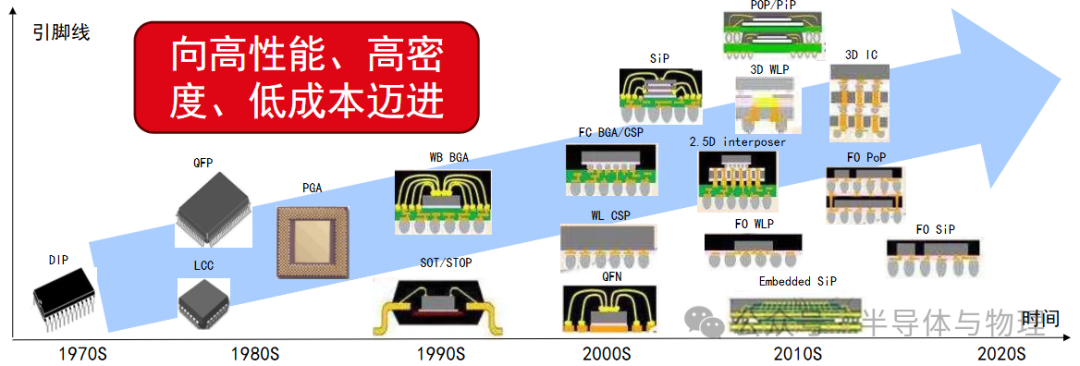
芯片封裝是半導體制造過程中至關重要的一步,它不僅保護了精密的硅芯片免受外界環境的影響,還提供了與外部電路連接的方式。通過一系列復雜的工藝步驟,芯片從晶圓上被切割下來,經過處理和封裝,最終成為可以安裝在各種電子設備中的組件。
晶圓減薄
在進行封裝之前,通常需要對硅片進行減薄處理。這是因為較薄的硅片更容易進行后續的切割和加工,還有助于多個die封裝在一起。背面減薄技術主要包括磨削、研磨、干式拋光、化學機械平坦工藝(CMP)、常壓等離子腐蝕等方法。
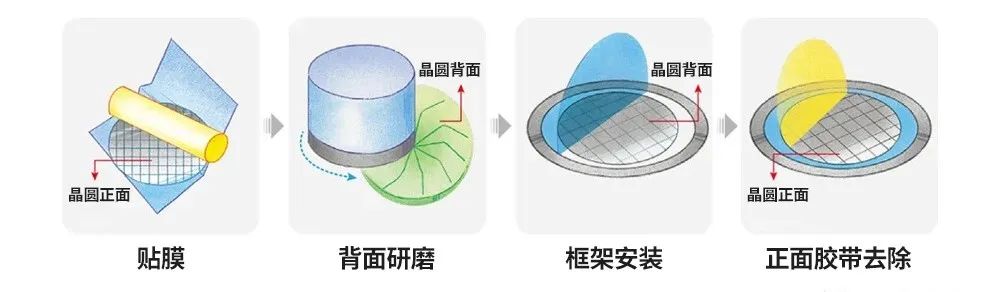
切割工藝:DBG與DBT
為了減少硅片減薄過程中的翹曲問題及劃片引起的芯片邊緣損害,有兩種改進的切割工藝:先切割后減薄(DBG)和減薄切割法(DBT)。
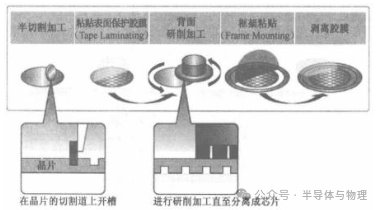
芯片貼裝:固定芯片的方法

將IC芯片固定于封裝基板或引腳架上的過程被稱為芯片貼裝。常用的工藝包括:
共晶粘貼法:利用金-硅合金在高溫下熔合的特點實現固定。
焊接粘貼法:使用鉛錫合金焊接。
導電膠粘貼法:適用于塑料封裝,使用高分子聚合物作為粘合劑。
玻璃膠粘貼法:采用玻璃材料進行粘合。

芯片互連:連接內部與外部世界

芯片互連是指將芯片焊區與封裝外殼的I/O引線或基板上的金屬布線相連接的過程。這可以通過以下幾種技術實現:
打線鍵合技術(WB):如超聲波鍵合、熱壓鍵合和熱超聲波鍵合。

載帶自動鍵合技術(TAB):一次性完成所有接口的連接。

倒裝芯片鍵合技術(FCB):直接將芯片焊區與基板焊區相連,減少了信號傳輸的距離,提高了效率。

成型技術:給芯片穿上“外衣”
成型技術指的是將芯片與引線框架一起封裝起來,以提供物理保護并便于安裝。根據材料的不同,可分為金屬封裝、塑料封裝和陶瓷封裝等。
后處理步驟
去飛邊毛刺:去除封裝過程中產生的多余材料,確保表面光滑。
上焊錫:為引腳涂覆焊錫,便于后續焊接。
切筋成型:將引腳彎曲成特定形狀,方便裝配。
打碼:在封裝模塊上印上制造商信息、國家代碼和器件代碼等,以便識別和追蹤
-
半導體
+關注
關注
339文章
30725瀏覽量
264045 -
晶圓
+關注
關注
53文章
5408瀏覽量
132280 -
芯片封裝
+關注
關注
13文章
614瀏覽量
32261
原文標題:芯片封裝
文章出處:【微信號:bdtdsj,微信公眾號:中科院半導體所】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄



 詳解芯片封裝的工藝步驟
詳解芯片封裝的工藝步驟




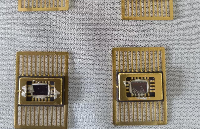
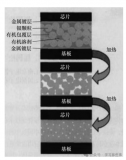



評論