底部填膠模塊的操作步驟
1、實(shí)例化網(wǎng)格
2、設(shè)定溢流區(qū)(overflow)
環(huán)氧樹脂在流動過程中,溢出芯片區(qū)是可能的路線,故溢流區(qū)是必須的選項(xiàng)。設(shè)定實(shí)體網(wǎng)格屬性為溢流。
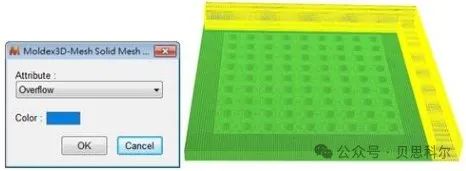
溢流設(shè)定
3、點(diǎn)擊Solid Model B.C. Setting設(shè)定底膠出口邊界條件
底膠出口邊界條件設(shè)定,協(xié)助判斷沒有表面張力的位置,以避免熔膠注入不合理的區(qū)域。
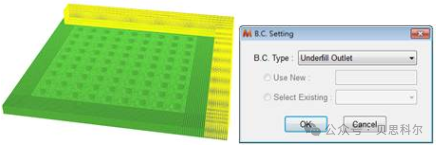
邊界條件設(shè)定
4、設(shè)定進(jìn)澆點(diǎn)
選擇表面網(wǎng)格并設(shè)定屬性為3D進(jìn)澆點(diǎn)。
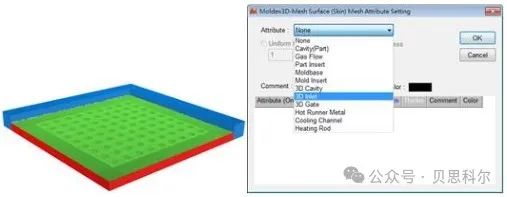
進(jìn)澆點(diǎn)設(shè)定
5、輸出實(shí)體封裝模型
想要了解更多Moldex3D產(chǎn)品信息,歡迎聯(lián)系貝思科爾!
聲明:本文內(nèi)容及配圖由入駐作者撰寫或者入駐合作網(wǎng)站授權(quán)轉(zhuǎn)載。文章觀點(diǎn)僅代表作者本人,不代表電子發(fā)燒友網(wǎng)立場。文章及其配圖僅供工程師學(xué)習(xí)之用,如有內(nèi)容侵權(quán)或者其他違規(guī)問題,請聯(lián)系本站處理。
舉報投訴
-
3D
+關(guān)注
關(guān)注
9文章
3016瀏覽量
115319 -
Model
+關(guān)注
關(guān)注
0文章
343瀏覽量
26498 -
Mesh
+關(guān)注
關(guān)注
5文章
232瀏覽量
31395
發(fā)布評論請先 登錄
相關(guān)推薦
熱點(diǎn)推薦
Moldex3D模流分析之CUF Simulation Quick Start
演示目的,Moldex3D支持更多、更多樣的毛細(xì)底部填膠(CUF)功能。本教學(xué)所涵蓋的功能如下表所列,其詳細(xì)的功能介紹和參數(shù)定義將與其他功能一起在前面的章節(jié)中進(jìn)行

【Moldex3D丨干貨】別耗費(fèi)過多時間在IC封裝建模
封裝為何需要CAE?封裝是半導(dǎo)體組件制造過程的最后一個環(huán)節(jié),會以環(huán)氧樹脂材料將精密的集成電路包覆在內(nèi),以達(dá)到保護(hù)與散熱目的。在芯片尺寸逐年縮小的趨勢下,封裝制程所要面臨的挑戰(zhàn)更趨復(fù)雜,牽涉到組件

TechWiz LCD 3D應(yīng)用:撓曲電效用仿真
本案例確認(rèn)了FFS模式下的撓曲電效應(yīng)
建模任務(wù)
1.1堆棧結(jié)構(gòu)
建模過程
以下是建模過程中部分重要步驟的說明
2.1在TechWiz Layout中創(chuàng)建結(jié)構(gòu)(生成項(xiàng)目和
發(fā)表于 12-10 13:43
TechWiz LCD 3D應(yīng)用:撓曲電效用仿真
本案例確認(rèn)了FFS模式下的撓曲電效應(yīng)
建模任務(wù)
1.1堆棧結(jié)構(gòu)
建模過程
以下是建模過程中部分重要步驟的說明
2.1在TechWiz Layout中創(chuàng)建結(jié)構(gòu)(生成項(xiàng)目和
發(fā)表于 05-14 08:55
生成顯示4D數(shù)據(jù)——LabVIEW中3D Mesh的研究,附贈256色色譜生成器
曲線”可以自動顯示4D數(shù)據(jù),需要將第四維數(shù)據(jù)轉(zhuǎn)換為顏色,并且賦值給“顏色數(shù)組”2 使用復(fù)雜,可以看到程序框圖里要創(chuàng)建“三位對象”和“網(wǎng)格(mesh)”,設(shè)置“視角”“光源”等等。3 在
發(fā)表于 07-11 13:34
BLE MESH的相關(guān)問題求解
我用3塊ESP32C3的開發(fā)板,分別燒錄并運(yùn)行“ESP BLE Mesh Client Model Demo”、“ESP BLE Mesh
發(fā)表于 03-07 08:52
電子灌膠封裝——成就高精度電子灌膠未來
引言使用聚氨酯(PU)、硅膠或環(huán)氧樹脂進(jìn)行電子灌封具有多重優(yōu)勢:Moldex3D解決方案透過Moldex3D電子灌封仿真技術(shù),可針對在灌封過程中的流動應(yīng)力進(jìn)行模擬,并有效預(yù)測氣泡位置及大小。同時也

Moldex3D模流分析之晶片轉(zhuǎn)注成型
Moldex3D芯片封裝模塊,能協(xié)助設(shè)計(jì)師分析不同的芯片封裝成型制程。在轉(zhuǎn)注成型分析(TransferMolding)與成型底部填膠分析(MoldedUnderfill)中,Moldex3D芯片封裝

Moldex3D模流分析之建立IC組件
分辨率的仿真,而AutoHybrid則適用于在厚度方向設(shè)計(jì)相對單純(純2D配置)的模型。如果模型需要有在厚度方向的復(fù)雜性且需要相對高的網(wǎng)格分辨率時,一般Hybrid模

Moldex3D模流分析之Electronic Potting Process Simulation Quick Start
,Moldex3D支持電子灌膠制程仿真的功能更加豐富。本教學(xué)涉及的參數(shù)如下,其詳細(xì)的參數(shù)介紹和參數(shù)定義于先前的章節(jié)中介紹。1.準(zhǔn)備模型(PrepareModel)啟動Moolde

【Moldex3D丨產(chǎn)品技巧】使用金線精靈與樣板快速建立金線組件
在IC封裝產(chǎn)業(yè)中,打線接合(WireBonding)是利用微米等級的金屬線材,連接起芯片與導(dǎo)線架或基板的技術(shù),讓電子訊號能在芯片與外部電路間傳遞。Moldex3D芯片封裝成型模塊支持金線偏移分析

【Moldex3D丨技術(shù)技巧】運(yùn)用Moldex3D Studio進(jìn)行CoWos自動網(wǎng)格建模
IC封裝仿真中,由于網(wǎng)格結(jié)構(gòu)相當(dāng)復(fù)雜,使得手動建立網(wǎng)格模型十分耗時。Moldex3DStudio提供了自動建構(gòu)網(wǎng)格技術(shù),幫助使用者將2D圖面設(shè)計(jì)自動生成實(shí)體網(wǎng)格。此技術(shù)可有效降低前處理的時間成本,讓

【Moldex3D丨復(fù)合材料】樹脂轉(zhuǎn)注成型(RTM)制程已可用非匹配網(wǎng)格模擬
時間在網(wǎng)格前處理上。否則模擬結(jié)果不理想,也會影響后面結(jié)果的判讀。Moldex3D過去的版本在RTM的網(wǎng)格前處理上會較為耗時;在流道設(shè)計(jì)變更時,也會需要重新制作實(shí)體

【Moldex3D丨技巧分享】__ 壓縮制程模溫分析支援模板移動
納入模擬分析中,使模擬更貼近于實(shí)際狀況,將可以得到更準(zhǔn)確的模內(nèi)溫度預(yù)測。以下將說明如何在Moldex3D壓縮制程模擬中納入模板移動行為以及其影響。part01操作流

【Moldex3D丨技巧分享】使用Moldex3D FEA接口讓結(jié)構(gòu)分析更貼近現(xiàn)實(shí)
模擬,然而這忽略了塑料加工的過程中,各個成型階段對產(chǎn)品造成的影響,也無法考慮在使用如含纖維塑料時的材料非等向性。透過Moldex3DFEA接口,可以有效整合Mold




 在Moldex3D Mesh建模 (Prepare Model in Moldex3D Mesh)
在Moldex3D Mesh建模 (Prepare Model in Moldex3D Mesh)




評論