基本概念(Basic Concept)
本章教程帶您快速的從頭開始分析簡(jiǎn)易IC封裝的打點(diǎn)制程的仿真工作流程,并分成以下部分:準(zhǔn)備模型、材料與成型條件、底部填膠設(shè)定和執(zhí)行分析。
注:本教學(xué)中所介紹的功能僅供演示目的,Moldex3D支持更多、更多樣的毛細(xì)底部填膠(CUF)功能。
本教學(xué)所涵蓋的功能如下表所列,其詳細(xì)的功能介紹和參數(shù)定義將與其他功能一起在前面的章節(jié)中進(jìn)行介紹。
1.準(zhǔn)備模型(Prepare Model)
開啟Mooldex3D Studio以開始毛細(xì)底部填膠CUF(打點(diǎn))模型的開發(fā),透過點(diǎn)擊主頁簽上的匯入模型并建立新項(xiàng)目,并選擇MFE檔案創(chuàng)建一個(gè)具有用戶指定名稱和位置的新項(xiàng)目。然后,點(diǎn)擊匯入幾何匯入IGS檔案(點(diǎn)膠BC)以定義點(diǎn)膠頭可以在模型表面上移動(dòng)的位置。然而路徑的邊界條件需在生成實(shí)體網(wǎng)格與完成最終檢查之后才能進(jìn)行設(shè)定。

注:也可使用封裝組件(Encapsulation Component)精靈和實(shí)體網(wǎng)格精靈(Encapsulation Solid Mesh)設(shè)定2D封裝網(wǎng)格模型,其步驟與前述介紹的封裝類型過程相似。
在封裝組件精靈完成后,點(diǎn)擊網(wǎng)格BC中的BC功能,在模型面上分配邊界條件。在進(jìn)行網(wǎng)格生成之前,CUF建模應(yīng)包含屬性組件和BC如下所示:
屬性(Attribute):環(huán)氧樹脂(Epoxy)定義為充填材料的主要區(qū)域,且被溢流區(qū)(Overflow)、充填材料進(jìn)入的開放區(qū)域及其他組件(例如:基板與芯片)包圍著,而非通過區(qū)域用來限制流動(dòng)以確定成型形狀。邊界條件(BC):對(duì)于守恒模式(推薦是打點(diǎn)制程)而言,進(jìn)澆口(MeltEntrance)邊界條件需設(shè)置在溢流區(qū)(Overflow)上,并且有足夠的空間讓材料能夠從打點(diǎn)路徑落下;對(duì)于無限模式而言,由于模型被簡(jiǎn)化且尚未指定路徑,進(jìn)澆口(MeltEntrance)邊界條件將被設(shè)置在環(huán)氧樹脂區(qū)上。
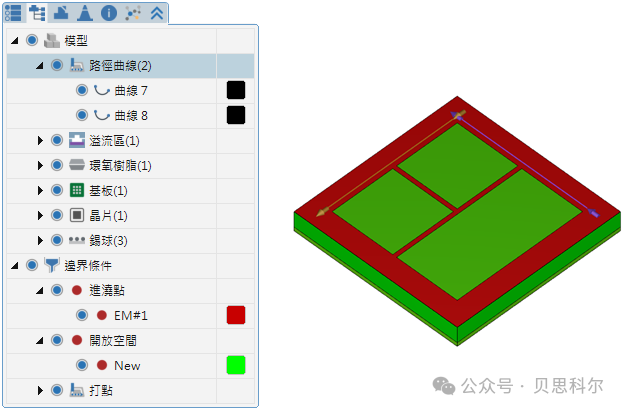
打點(diǎn)路徑設(shè)定(DottingPassSetting)
點(diǎn)選邊界條件頁簽的打點(diǎn)(Dotting)精靈,設(shè)定進(jìn)料尺寸(Drop Size)為[0.1mm]。點(diǎn)選選取圖示,選擇指定線段為打點(diǎn)路徑,并設(shè)定啟動(dòng)時(shí)間(Start Time)、持續(xù)時(shí)間(Duration)及重量(Weight)來描述材料在移動(dòng)中如何掉落。

范例中,在基板角落進(jìn)行兩條路徑的點(diǎn)膠,每條路徑各3次(分別開始于[0,0.1,0.2秒]和[0.01,0.11,0.21秒]),在[0.01秒]內(nèi)落下[0.035毫克]。而在打點(diǎn)精靈的下方會(huì)顯示制程期間掉落的材料總重量和最大填充時(shí)間,供使用者指定整個(gè)過程的時(shí)間限制。

2.材料與制程條件
(Material and Process Condition)
Studio將自動(dòng)切換回首頁簽,點(diǎn)擊材料以展開材料樹。從Inlet EM#1項(xiàng)目的下拉式選單中點(diǎn)選材料精靈,啟動(dòng)Moldex3D材料數(shù)據(jù)庫。

在材料精靈中,右鍵點(diǎn)選目標(biāo)材料(Epoxy>UnderFill>CAE>UF-1),然后選擇新增到項(xiàng)目以確認(rèn)選擇。關(guān)閉材料精靈,可以看到材料檔案已匯入到這個(gè)組別的材料樹中。使用相同的方法設(shè)定基板/芯片/錫球的材料如下。

在所有對(duì)象指定完材料后,接著點(diǎn)選成型條件(Process),由于在模型中檢測(cè)到打點(diǎn)路徑,分析方式(Analysis Type)已被鎖定為毛細(xì)底部填膠模塊。接著切換到加工精靈中的底部填膠頁簽以進(jìn)行詳細(xì)的制程條件設(shè)定。
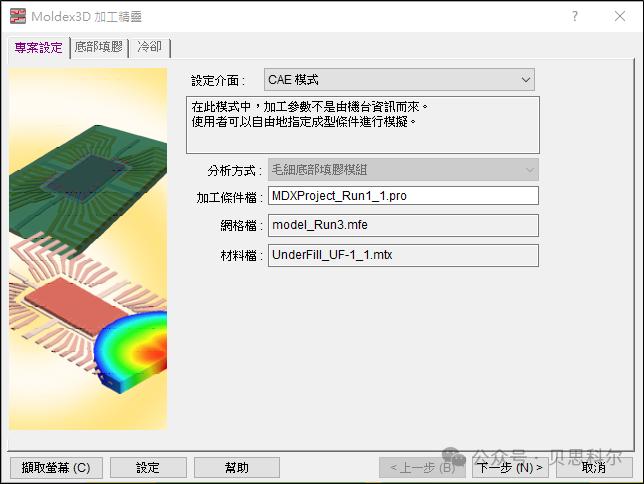
3.底部填膠設(shè)定(Underfill Setting)
底部填膠(Underfill)制程位于項(xiàng)目設(shè)定頁簽中提供兩種分析方式選擇:毛細(xì)底部填膠(CUF)與成型底部填膠(MUF)。毛細(xì)底部填膠(CUF)需要點(diǎn)膠樣式設(shè)定(Dispensing pattern setting),而成型底部填膠(MUF)的成型條件設(shè)定與轉(zhuǎn)注成型(TM)相同。毛細(xì)底部填膠(CUF)與成型底部填膠(MUF)能在進(jìn)階設(shè)定中設(shè)定表面張力(Surface tension),但成型底部填膠(MUF)通常不需溢流區(qū)。在本范例中,將打點(diǎn)(Dotting)的毛細(xì)底部填膠(CUF)成型條件設(shè)定為如下的條件。在Moldex3D加工精靈中,將樹脂溫度設(shè)定為110°C,其余設(shè)定保持預(yù)設(shè)。
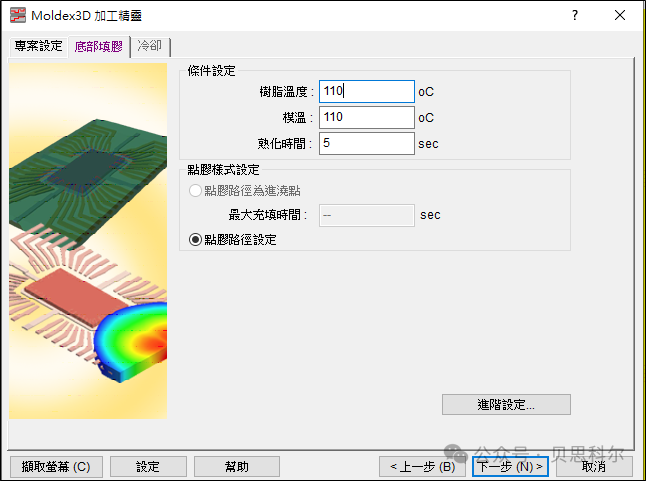
打點(diǎn)設(shè)定中包含的參數(shù)及其詳細(xì)定義如下所示。

注:在進(jìn)階設(shè)定下的估算熟化時(shí)間中,使用者可以根據(jù)材料、模具溫度、熔膠溫度和目標(biāo)換算來獲取預(yù)估固化時(shí)間。
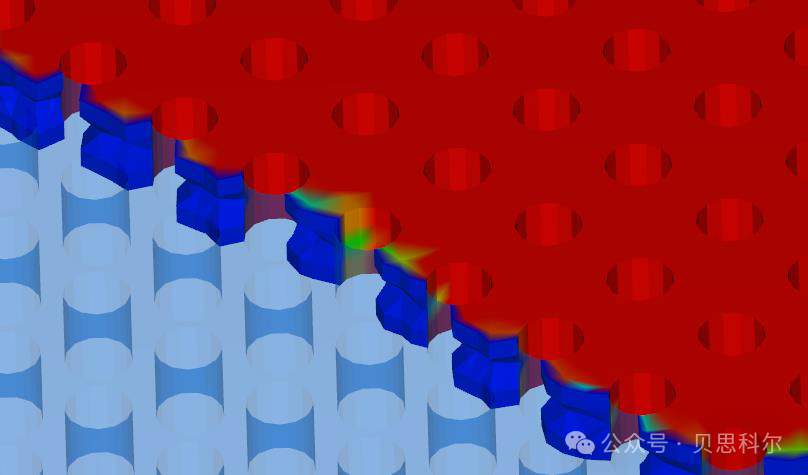
底部填膠的表面張力性質(zhì)
4.執(zhí)行分析(Run Analysis)
關(guān)閉成型條件(Process)精靈并返回主頁簽。設(shè)定完成型條件后,便可使用在主頁簽的開始分析(Run)按鈕,表示分析已經(jīng)準(zhǔn)備好提交計(jì)算。
計(jì)算參數(shù)(Computation Parameter)
雙擊計(jì)算參數(shù)(ComputationParameter)。打點(diǎn)分析中需要考慮重力和流動(dòng)求解器的精確度。
如果需要考慮這類影響,請(qǐng)至計(jì)算參數(shù)的流動(dòng)保壓頁簽,開啟客制分析并在對(duì)應(yīng)方向上指定重力的數(shù)值。

點(diǎn)擊進(jìn)階選項(xiàng),選擇客制,然后在求解器精度/效能選項(xiàng)上輸入0.1,以獲得準(zhǔn)確的方向張量。此處的效能參數(shù)若不是0.1,可能會(huì)導(dǎo)致隨后的打點(diǎn)分析失準(zhǔn)。其余計(jì)算參數(shù)可保留為默認(rèn)值。

在分析順序下的選單中將分析順序指定為充填分析(Filling,F)。點(diǎn)擊開始分析以開啟并提交工作給計(jì)算管理員,然后等待計(jì)算完成以得到結(jié)果。當(dāng)進(jìn)度條為100%時(shí),所有結(jié)果都將傳至Studio。

提交充填分析至計(jì)算管理員并得到結(jié)果
查看分析結(jié)果(Check Analysis Result)
所有分析工作完成后,項(xiàng)目樹的結(jié)果分支下會(huì)出現(xiàn)額外的項(xiàng)目。單擊結(jié)果項(xiàng)將其顯示在顯示窗口中或雙擊結(jié)果項(xiàng)(充填–流動(dòng)波前時(shí)間和保壓-壓力)以開啟結(jié)果判讀工具,其將提供結(jié)果介紹、統(tǒng)計(jì)數(shù)據(jù)和柱狀圖。
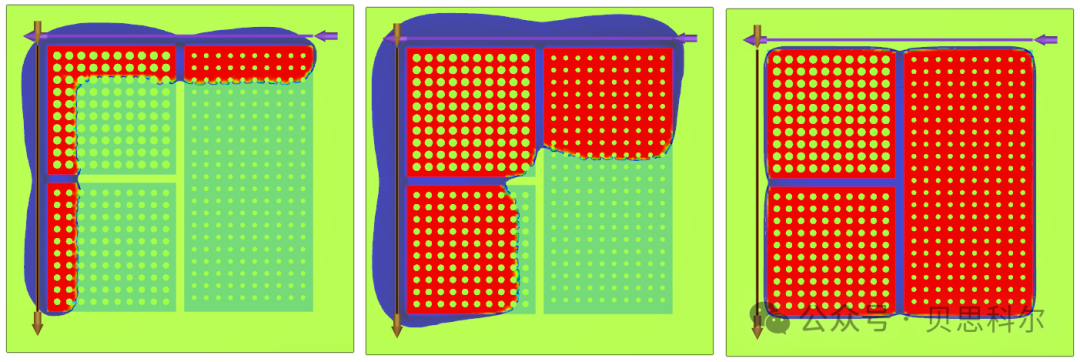
0.03秒與0.26秒和充填末端的流動(dòng)形式想要了解更多Moldex3D產(chǎn)品信息,歡迎聯(lián)系貝思科爾!
-
IC封裝
+關(guān)注
關(guān)注
4文章
196瀏覽量
27679 -
Quick
+關(guān)注
關(guān)注
0文章
17瀏覽量
12895 -
Simulation
+關(guān)注
關(guān)注
0文章
13瀏覽量
8445 -
Start
+關(guān)注
關(guān)注
0文章
73瀏覽量
13372
發(fā)布評(píng)論請(qǐng)先 登錄
Moldex3D模流分析之晶圓級(jí)封裝(EWLP)制程

C281x C/C++ Header Files and Peripheral Examples Quick Start
適用于Softing edgeConnector Siemens的AWS Quick Start全新發(fā)布
電子灌膠封裝——成就高精度電子灌膠未來

Moldex3D模流分析之晶片轉(zhuǎn)注成型

Moldex3D模流分析之建立IC組件

在Moldex3D Mesh建模 (Prepare Model in Moldex3D Mesh)

Moldex3D模流分析之Electronic Potting Process Simulation Quick Start

【Moldex3D丨產(chǎn)品技巧】使用金線精靈與樣板快速建立金線組件

【Moldex3D丨技術(shù)技巧】運(yùn)用Moldex3D Studio進(jìn)行CoWos自動(dòng)網(wǎng)格建模

【Moldex3D丨復(fù)合材料】樹脂轉(zhuǎn)注成型(RTM)制程已可用非匹配網(wǎng)格模擬

【Moldex3D丨技巧分享】__ 壓縮制程模溫分析支援模板移動(dòng)

【Moldex3D丨技巧分享】使用Moldex3D FEA接口讓結(jié)構(gòu)分析更貼近現(xiàn)實(shí)




 Moldex3D模流分析之CUF Simulation Quick Start
Moldex3D模流分析之CUF Simulation Quick Start





評(píng)論