共讀好書

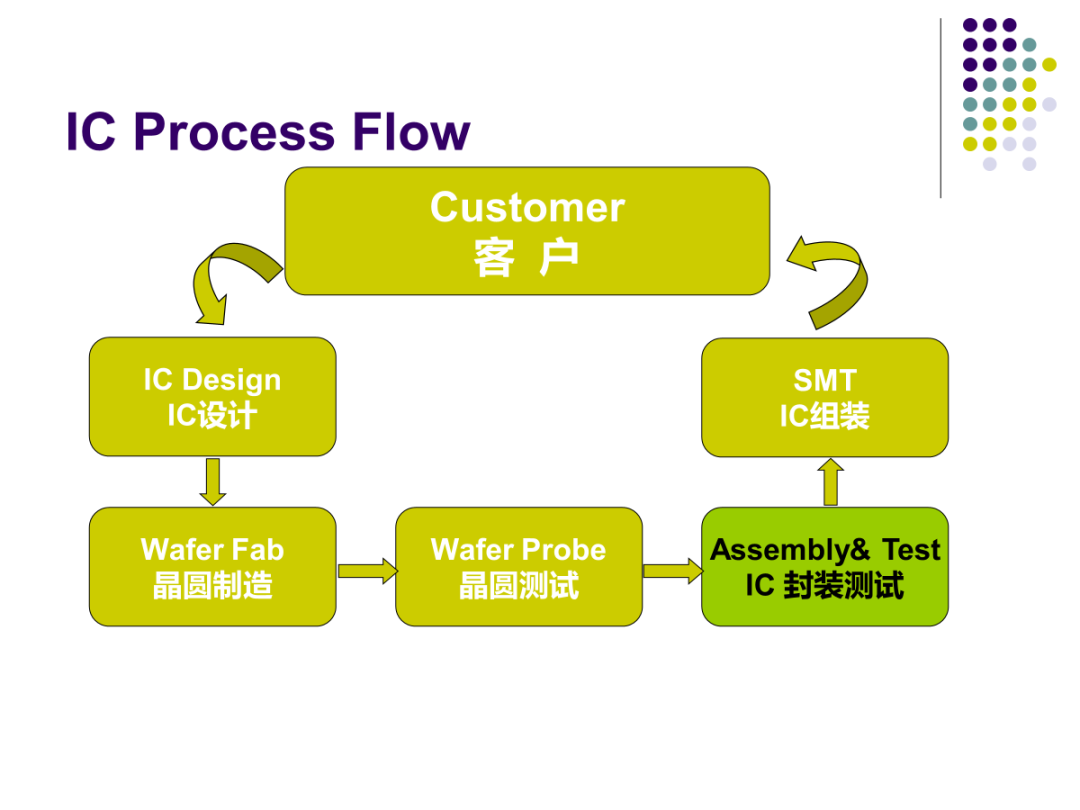


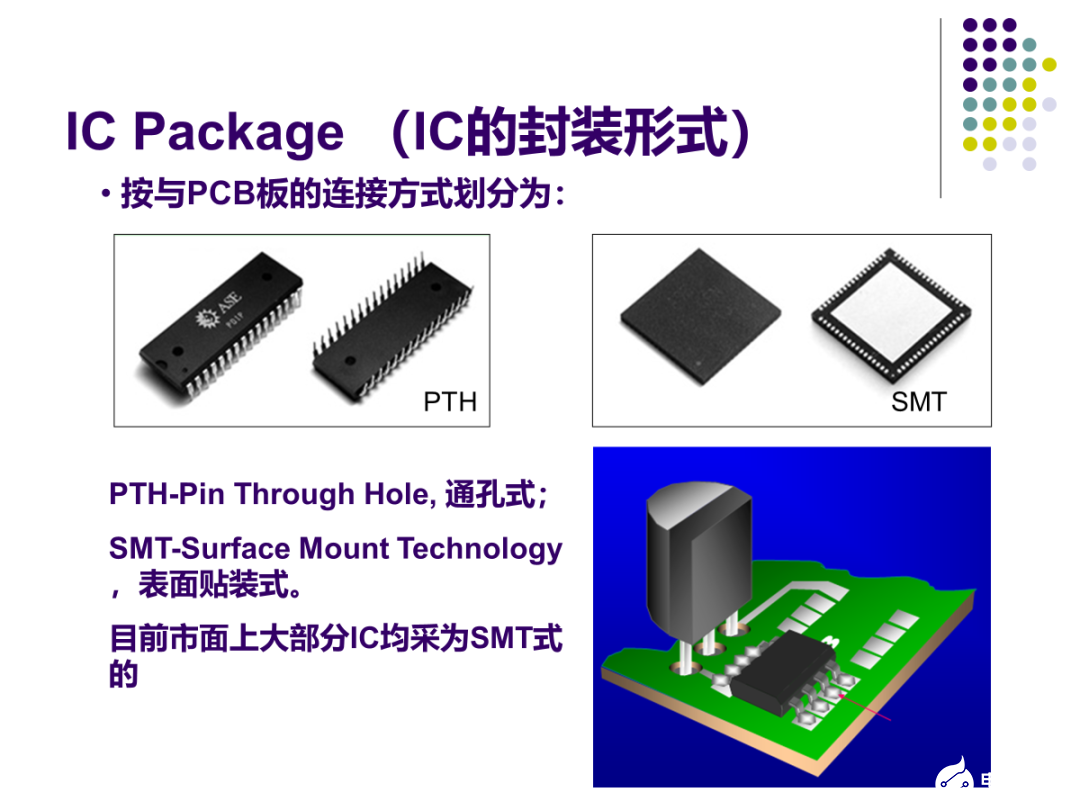


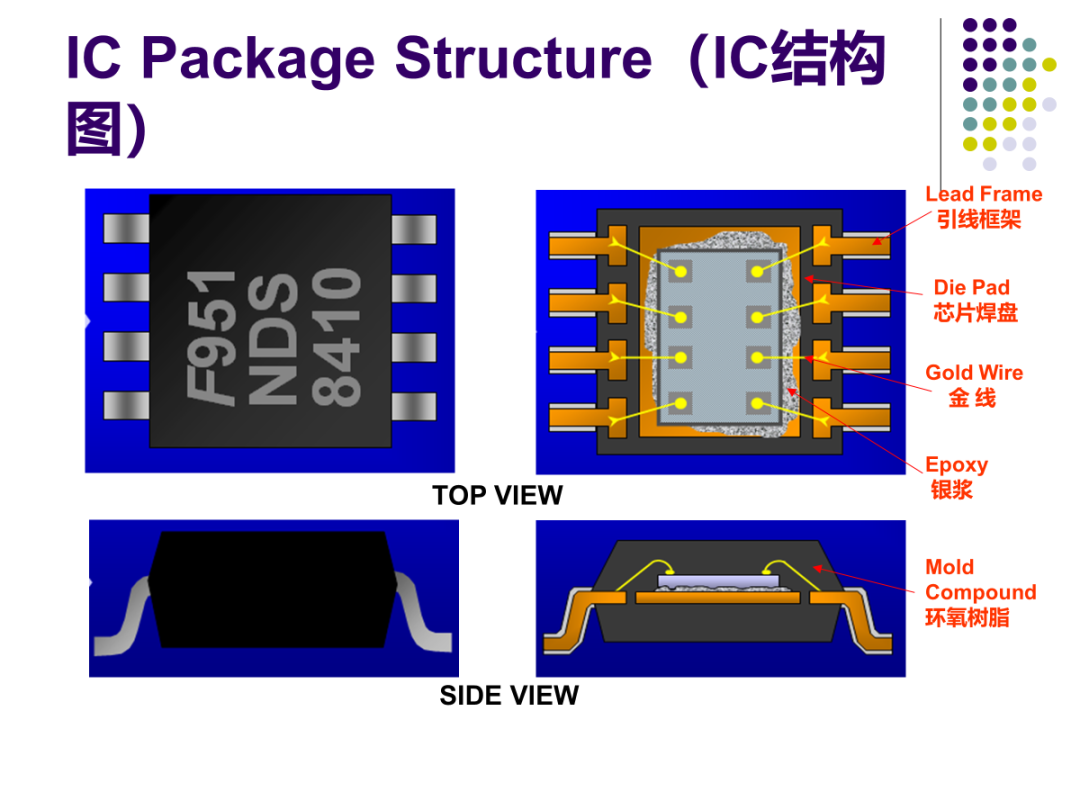

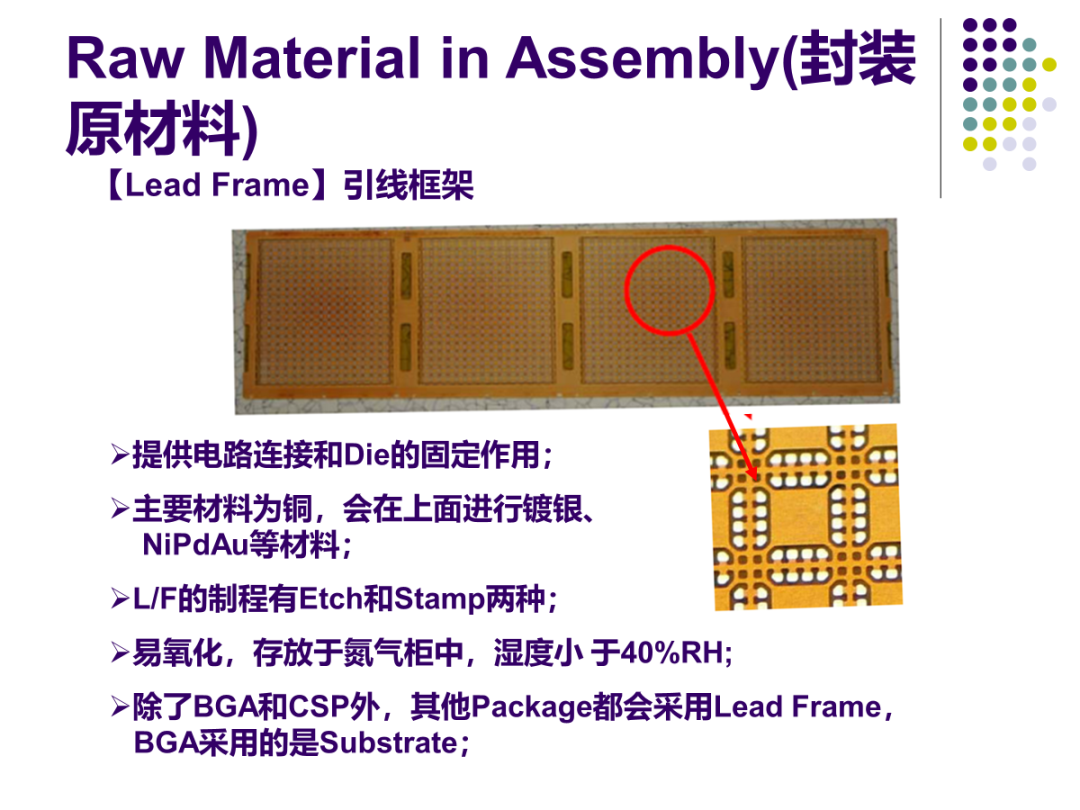



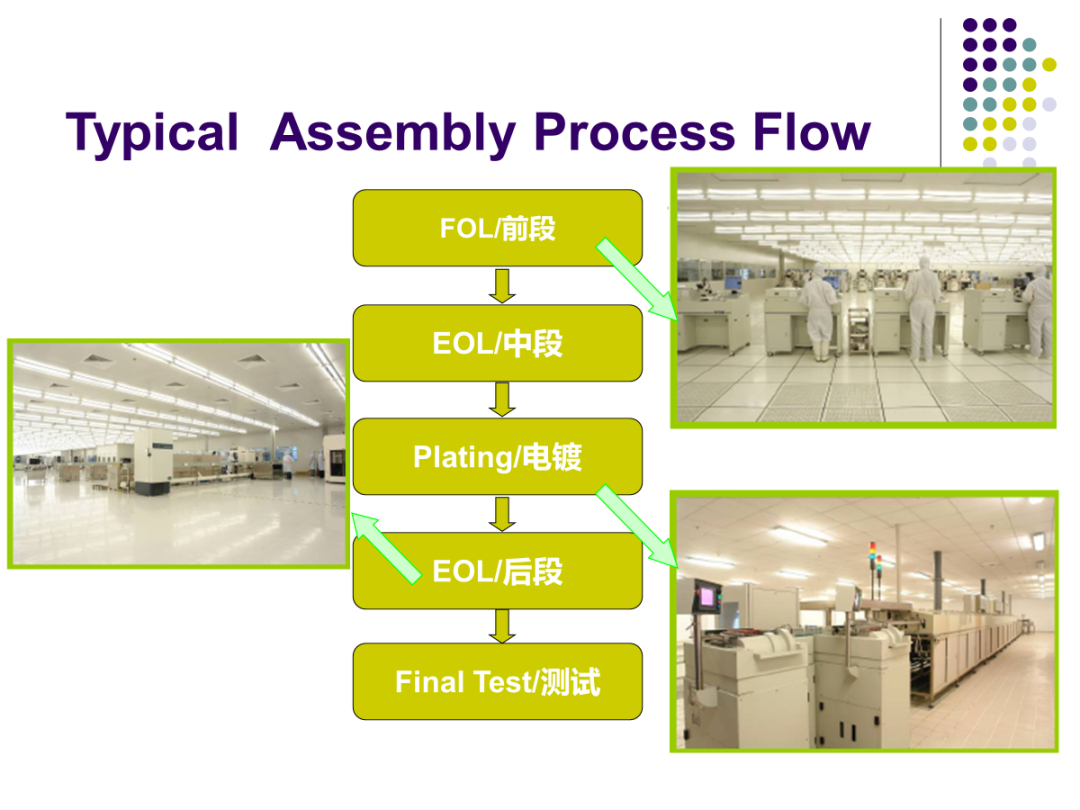
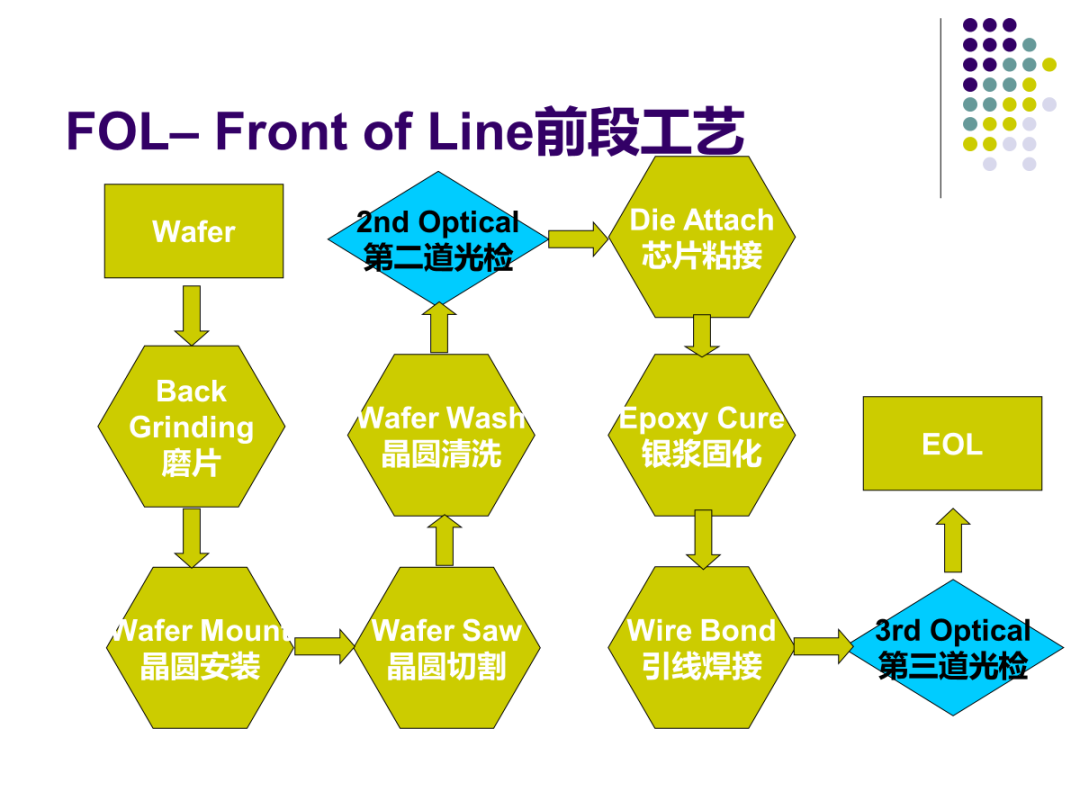
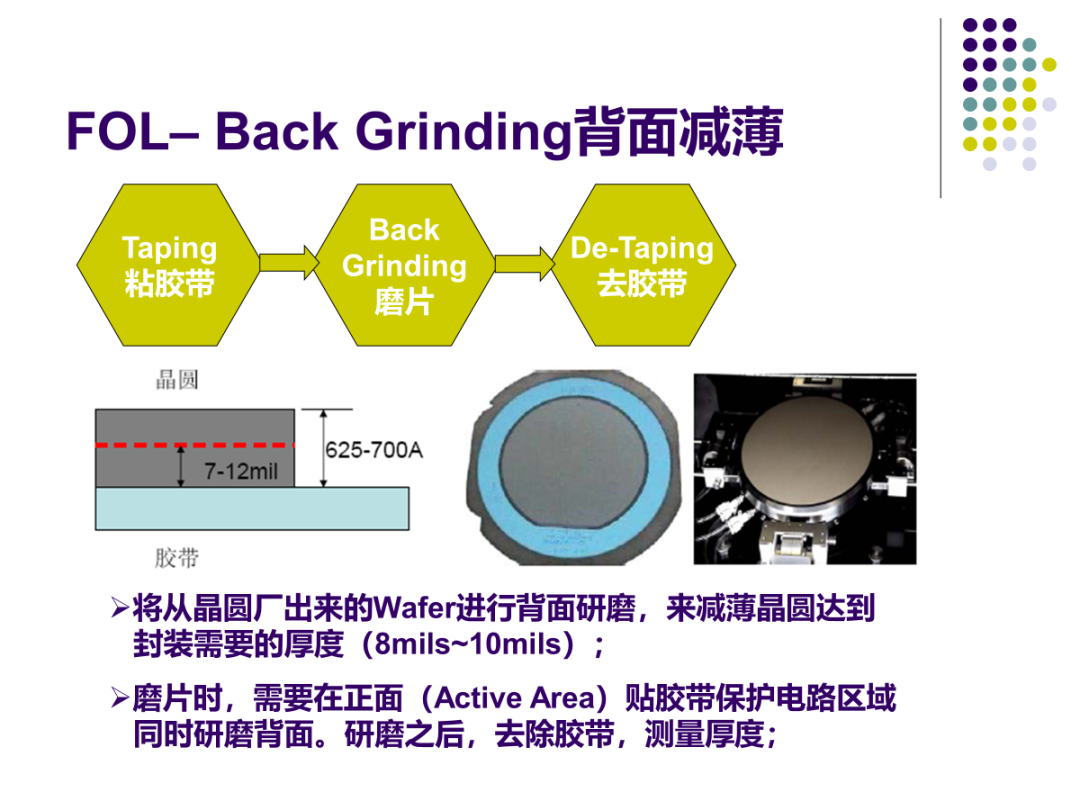
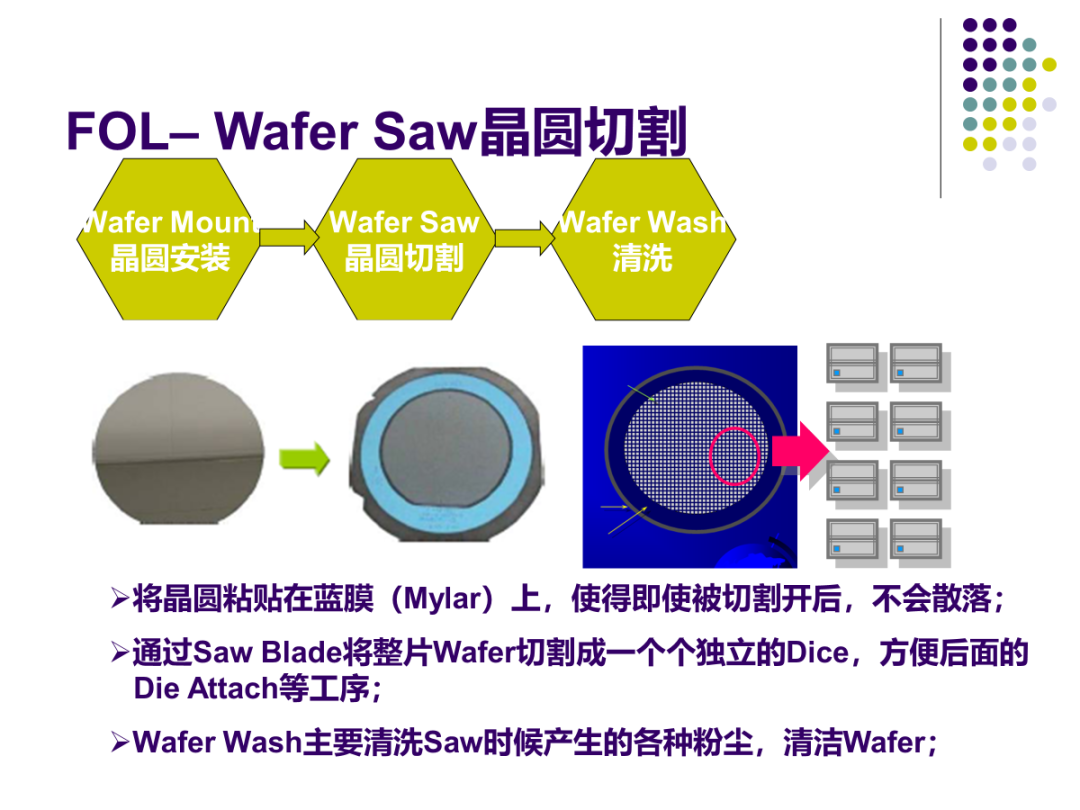




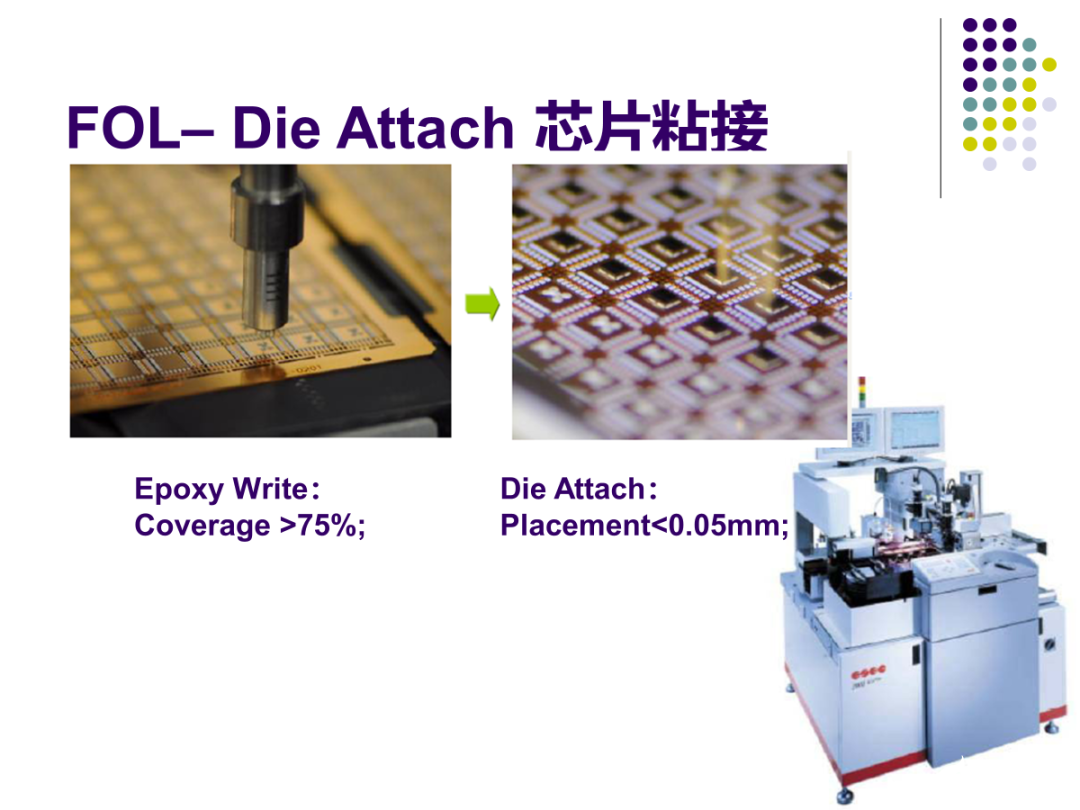





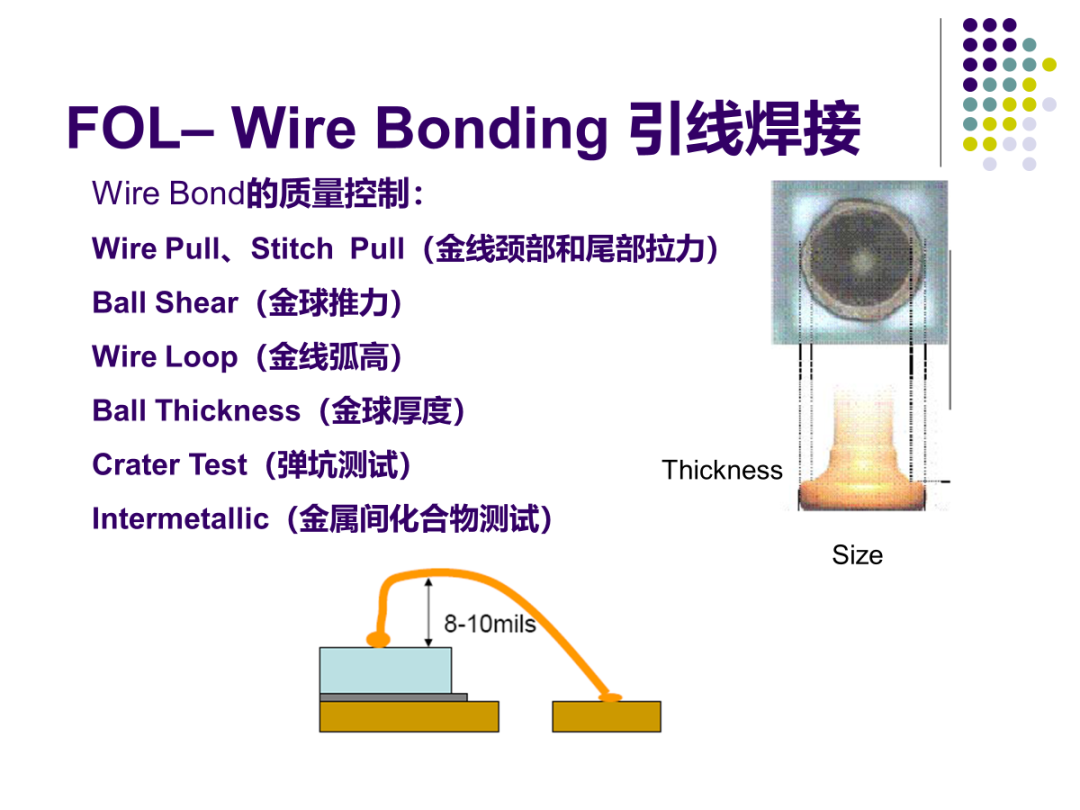

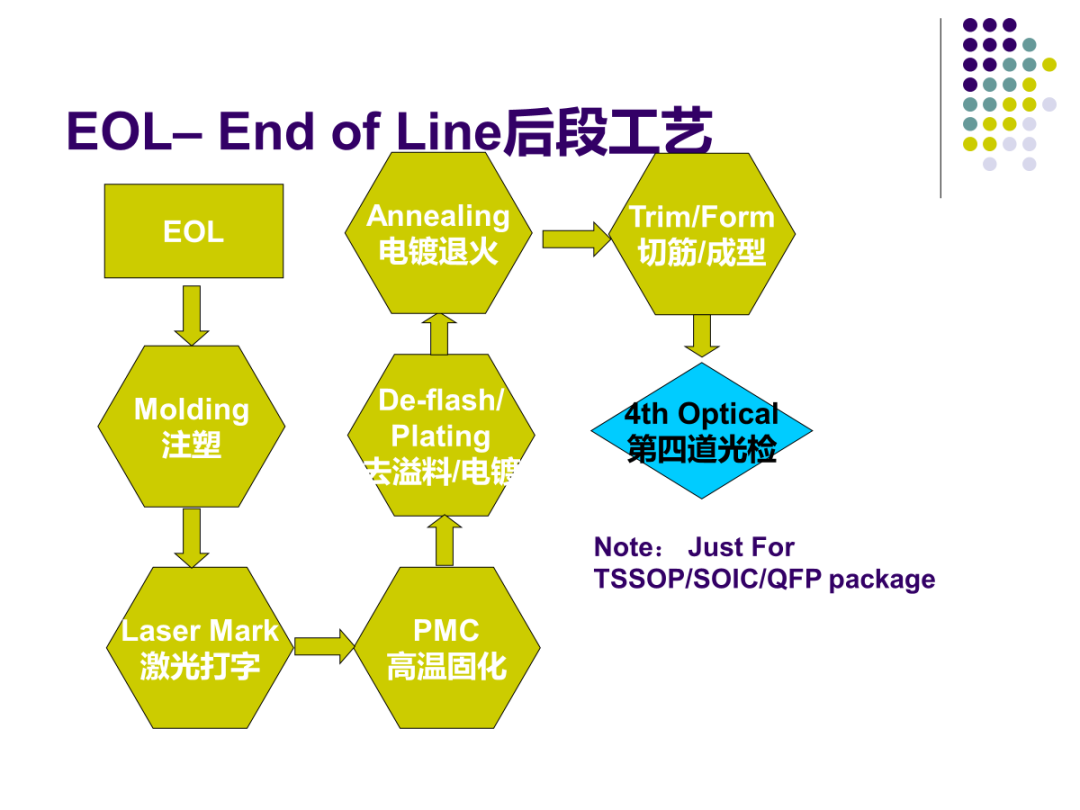
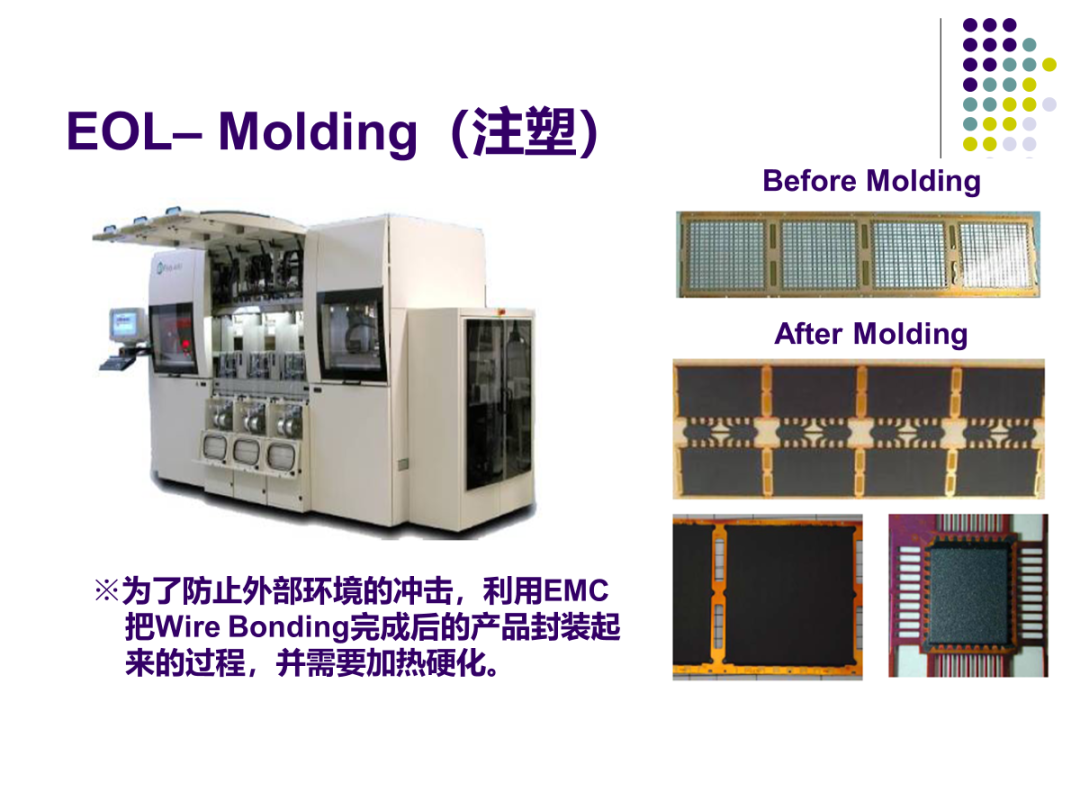
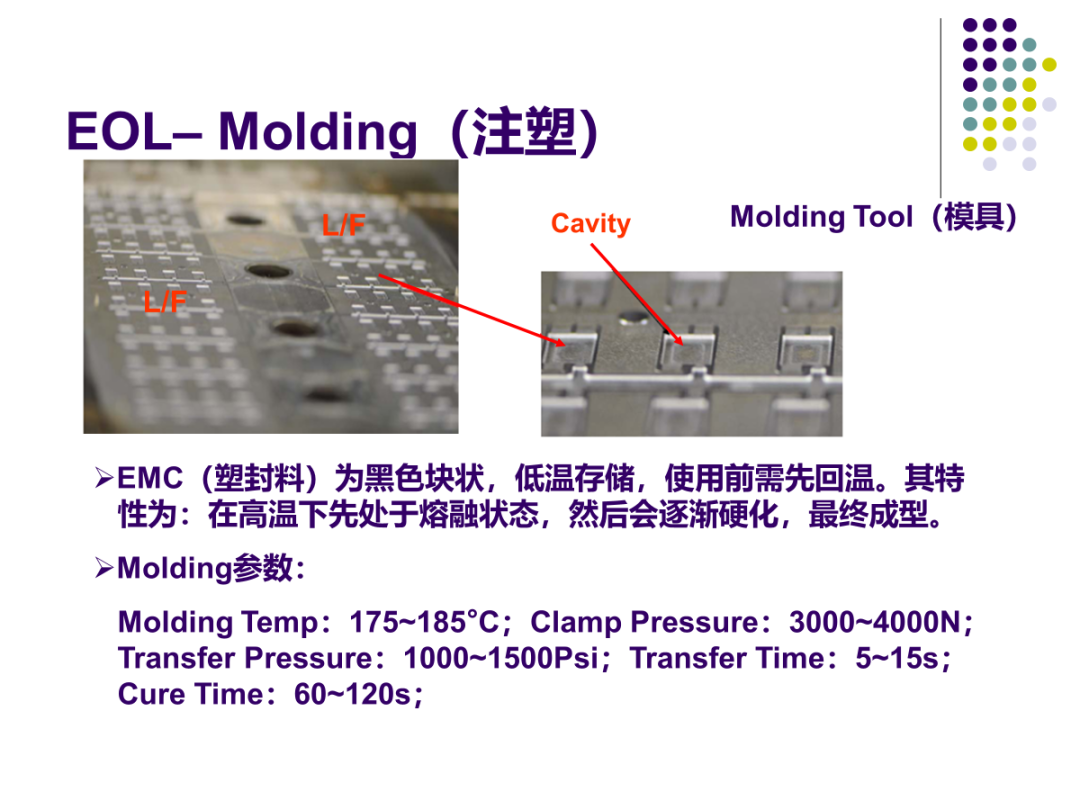
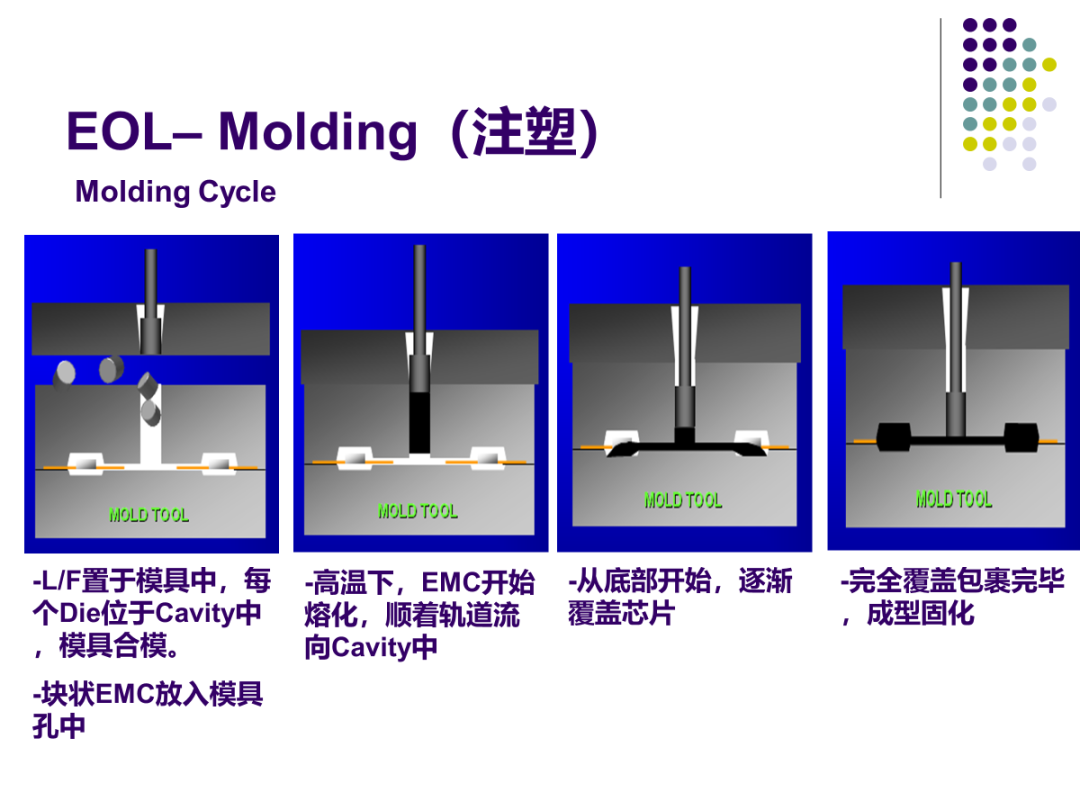
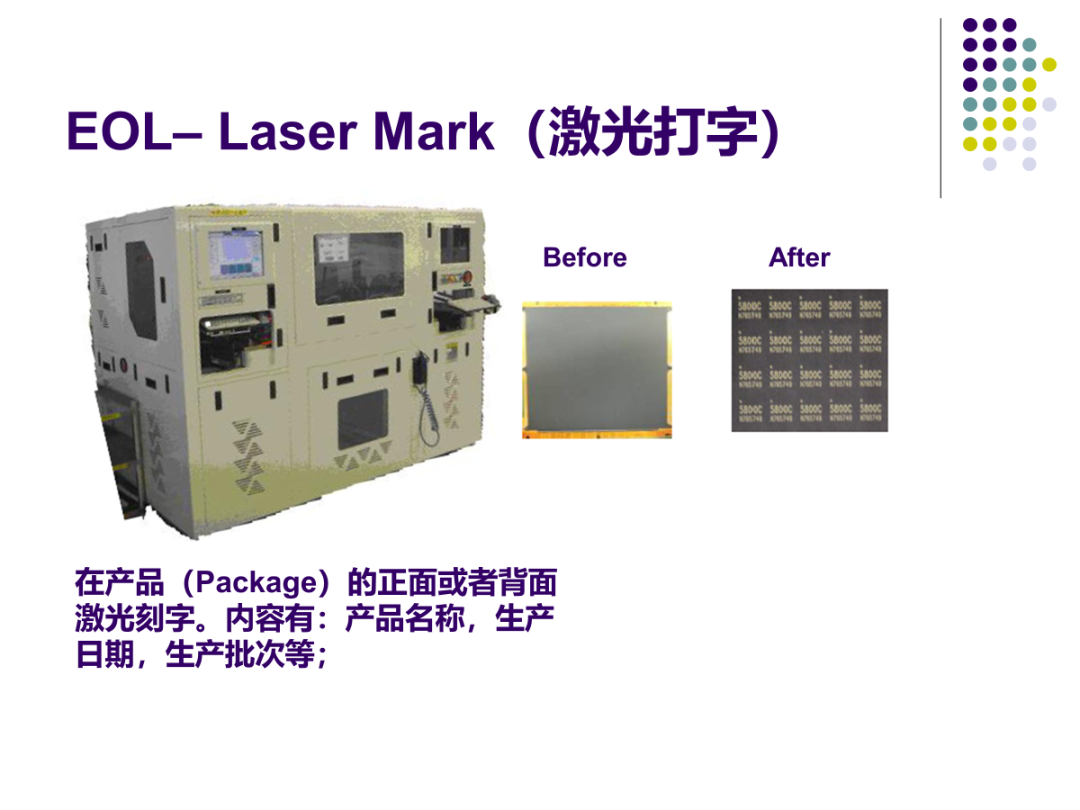
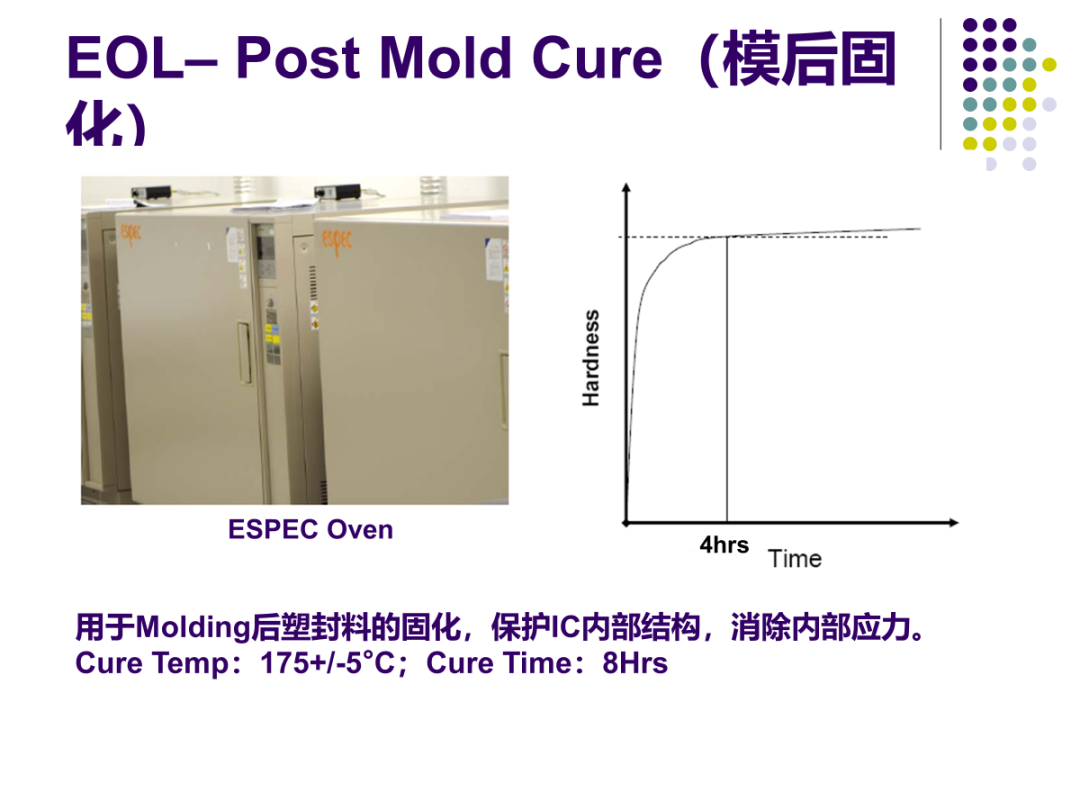
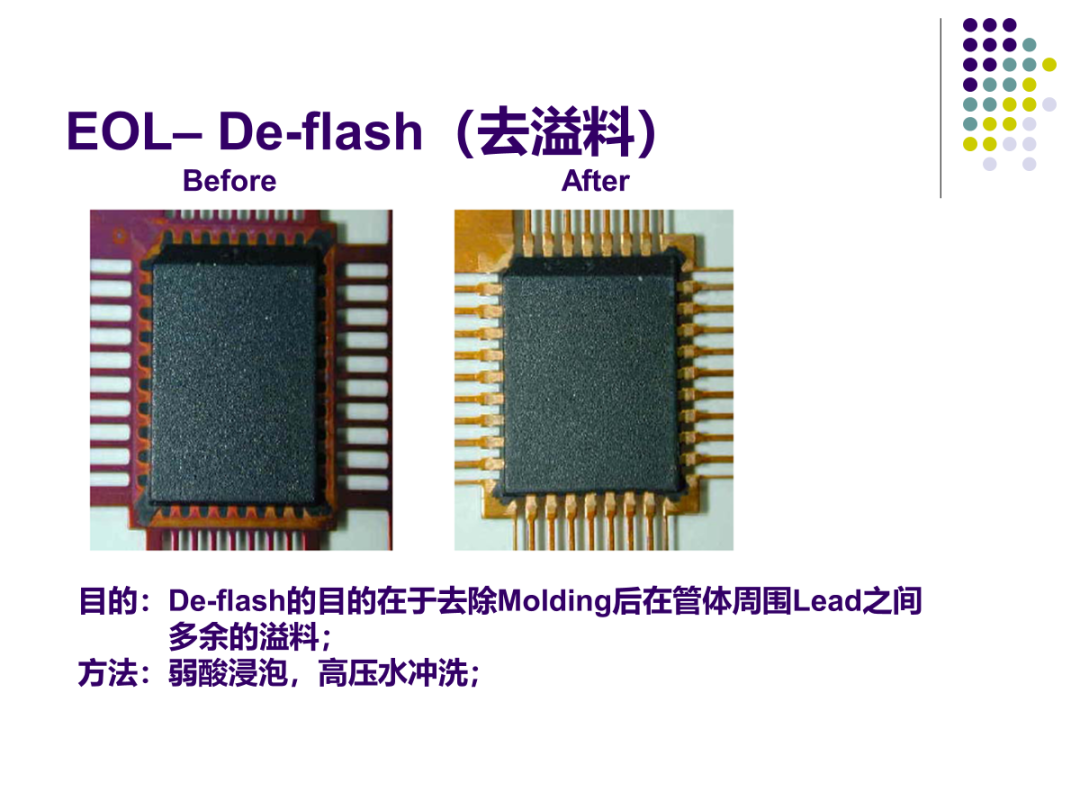
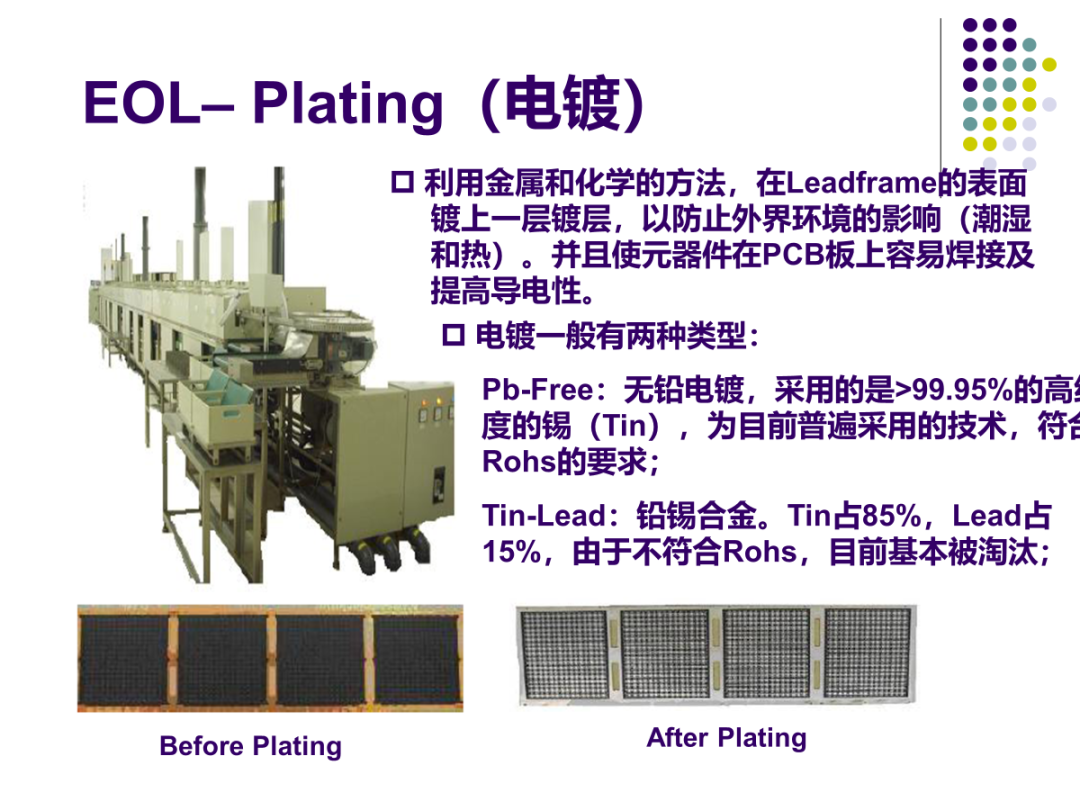
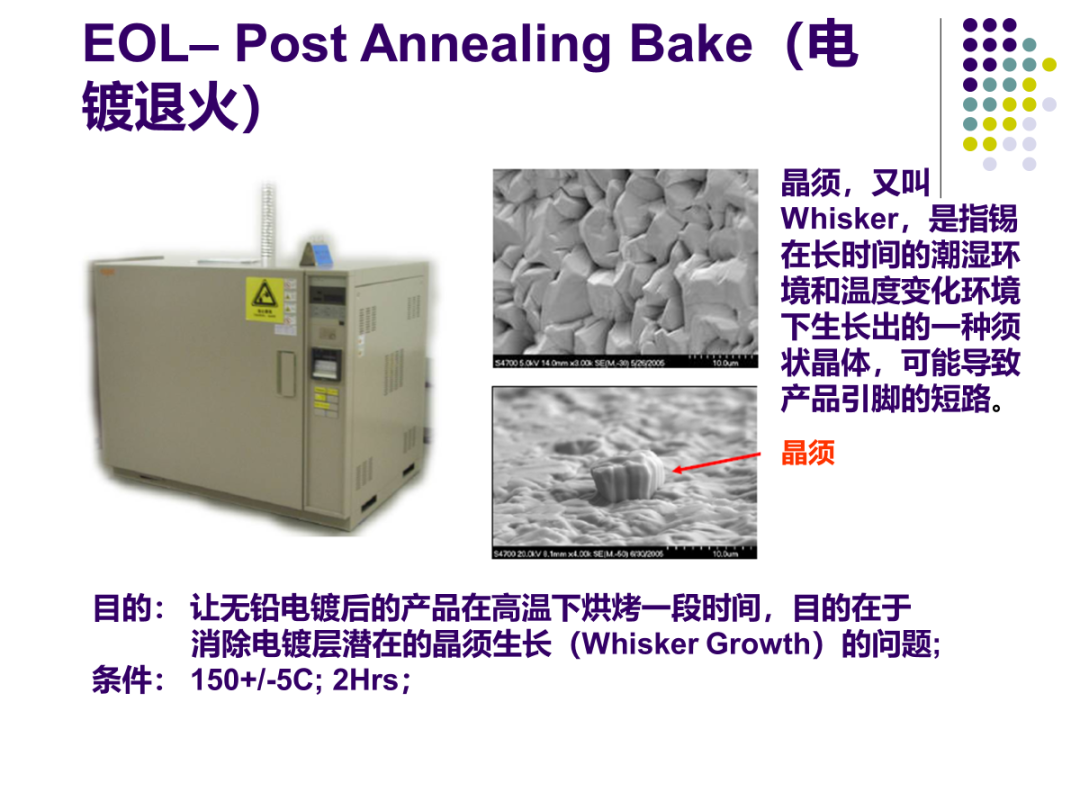




審核編輯 黃宇
聲明:本文內容及配圖由入駐作者撰寫或者入駐合作網站授權轉載。文章觀點僅代表作者本人,不代表電子發燒友網立場。文章及其配圖僅供工程師學習之用,如有內容侵權或者其他違規問題,請聯系本站處理。
舉報投訴
-
IC封裝
+關注
關注
4文章
196瀏覽量
27683
發布評論請先 登錄
相關推薦
熱點推薦
云臺驅動板拆裝工藝與硬件結構拆解分析
云臺驅動板作為姿態控制核心執行單元,集成了功率驅動、主控邏輯、傳感器接口、電源管理等功能模塊,其結構設計呈現 “高密度布局、多維度固定、強熱耦合” 特征。規范的拆裝工藝是保障設備維修可靠性、結構
短距離光模塊 COB 封裝與同軸工藝的區別有哪些
在短距離光通信領域,光模塊封裝工藝直接影響產品性能、成本及應用場景適配性。COB 封裝(Chip On Board,板上芯片封裝)與同軸工藝作為兩種主流技術,在結構設計、性能表現等方面

人工智能加速先進封裝中的熱機械仿真
為了實現更緊湊和集成的封裝,封裝工藝中正在積極開發先進的芯片設計、材料和制造技術。隨著具有不同材料特性的多芯片和無源元件被集成到單個封裝中,翹曲已成為一個日益重要的問題。翹曲是由封裝材

SK海力士HBS存儲技術,基于垂直導線扇出VFO封裝工藝
垂直導線扇出(VFO)的封裝工藝,實現最多16層DRAM與NAND芯片的垂直堆疊,這種高密度的堆疊方式將大幅提升數據處理速度,為移動設備的AI運算提供強有力的存儲支撐。 ? 根據早前報道,移動HBM通過堆疊和連接LPDDR DRAM來增加內存帶寬,也同樣采用了

TSV技術的關鍵工藝和應用領域
2.5D/3D封裝技術作為當前前沿的先進封裝工藝,實現方案豐富多樣,會根據不同應用需求和技術發展動態調整,涵蓋芯片減薄、芯片鍵合、引線鍵合、倒裝鍵合、TSV、塑封、基板、引線框架、載帶、晶圓級薄膜

傳統封裝與晶圓級封裝的區別
在芯片制造的最后環節,裸片(Die)需要穿上“防護鎧甲”——既要抵抗物理損傷和化學腐蝕,又要連接外部電路,還要解決散熱問題。封裝工藝的進化核心,是如何更高效地將硅片轉化為功能芯片。
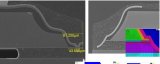
PPS注塑IC元件封裝中的應用優勢與工藝
在當今數字化時代,集成電路(IC)作為現代科技的核心,封裝是電子制造中的關鍵環節。IC元件封裝不僅是保護芯片免受外界環境影響的關鍵屏障,更是確保電子設備性能穩定、高效運行的重要保障。
半導體封裝工藝流程的主要步驟
半導體的典型封裝工藝流程包括芯片減薄、芯片切割、芯片貼裝、芯片互連、成型固化、去飛邊毛刺、切筋成型、上焊錫、打碼、外觀檢查、成品測試和包裝出庫,涵蓋了前段(FOL)、中段(EOL)、電鍍(plating)、后段(EOL)以及終測(final test)等多個關鍵環節。

芯片封裝工藝詳解
封裝工藝正從傳統保護功能向系統級集成演進,其核心在于平衡電氣性能、散熱效率與制造成本?。 一、封裝工藝的基本概念 芯片封裝是將半導體芯片通過特定工藝
先進封裝工藝面臨的挑戰
在先進制程遭遇微縮瓶頸的背景下,先進封裝朝著 3D 異質整合方向發展,成為延續摩爾定律的關鍵路徑。3D 先進封裝技術作為未來的發展趨勢,使芯片串聯數量大幅增加。



 IC封裝工藝講解
IC封裝工藝講解




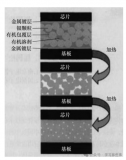



評論