文章來源:半導體與物理
原文作者:jjfly686
本文主要講述芯片制造中的從傳統封裝到晶圓級封裝。
在芯片制造的最后環節,裸片(Die)需要穿上“防護鎧甲”——既要抵抗物理損傷和化學腐蝕,又要連接外部電路,還要解決散熱問題。封裝工藝的進化核心,是如何更高效地將硅片轉化為功能芯片。
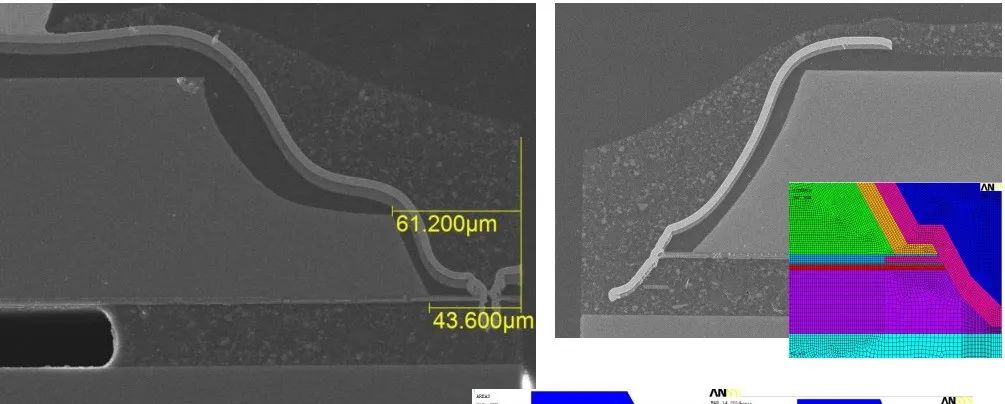
一、傳統封裝:先切割,后穿衣
核心流程:Wafer → Dicing → Packaging
晶圓切割(Dicing)
用金剛石刀片或激光將晶圓切成獨立裸片
芯片粘接(Die Attach)
銀膠或DAF薄膜(Die Attach Film)將裸片固定在基板
互聯工藝
金線鍵合(Wire Bonding):用25μm金線(比頭發細1/3)連接芯片焊盤與基板
模塑封裝(Molding)
環氧樹脂模塑料(EMC)注入模具,高溫固化形成保護殼

晶圓級封裝(WLP):先穿衣,后切割
核心流程:Wafer → Packaging → Dicing
晶圓級加工
重布線層(RDL):在整片晶圓上光刻出銅導線,重新排布焊盤位置
植球(Solder Bumping):通過電鍍在焊盤上制作錫球或銅柱凸塊
整片封裝
整片晶圓涂覆保護層(PI/BCB介電材料);部分工藝增加硅通孔(TSV)實現3D堆疊
切割分離
完成所有封裝步驟后切割晶圓,單片芯片直接可用

技術對比
| 特性 | 傳統封裝 | 晶圓級封裝(WLP) |
|---|---|---|
| 流程順序 | 先切后封 | 先封后切 |
| 處理對象 | 單個芯片 | 整片晶圓(批量處理) |
| 厚度 | 0.8-1.2mm | 0.3-0.5mm(減薄60%) |
| I/O密度 | ≤500 pin/cm2 | ≥2000 pin/cm2 |
| 生產速度 | 每小時數千顆 | 每小時數萬顆 |
| 典型應用 | 家電MCU、功率器件 | 手機射頻芯片、傳感器、MEMS |
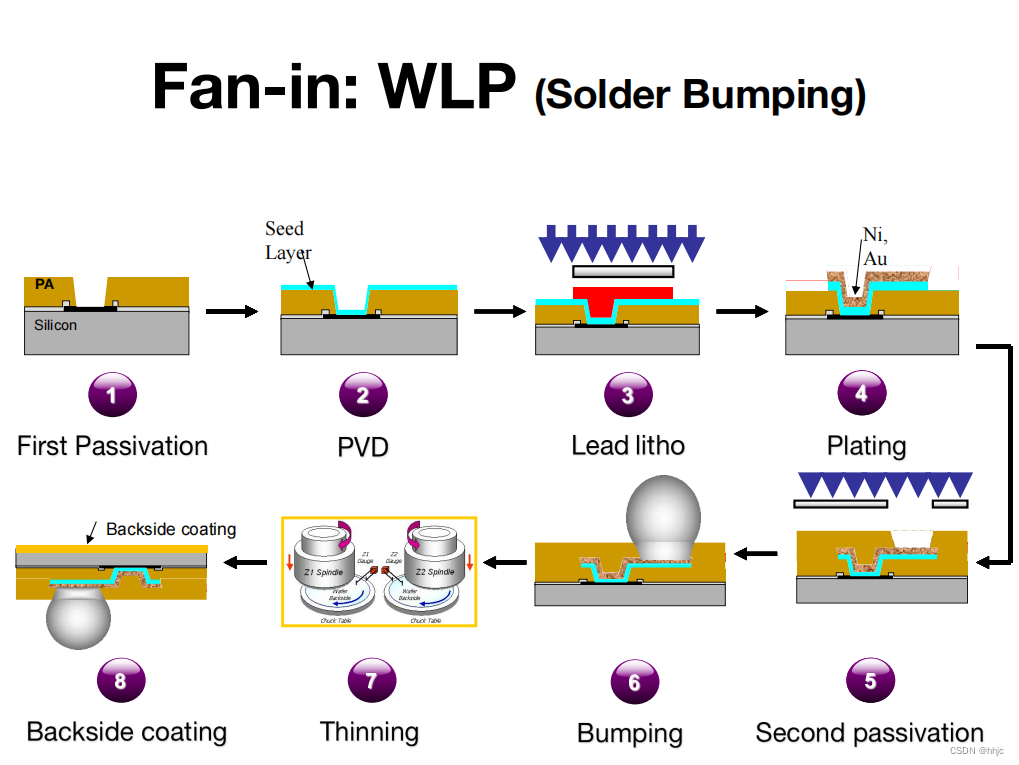
-
芯片制造
+關注
關注
11文章
731瀏覽量
30501 -
晶圓級封裝
+關注
關注
5文章
46瀏覽量
11816
原文標題:芯片制造:從傳統封裝到晶圓級封裝
文章出處:【微信號:bdtdsj,微信公眾號:中科院半導體所】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄



 傳統封裝與晶圓級封裝的區別
傳統封裝與晶圓級封裝的區別









評論