在后摩爾時代,芯片算力提升的突破口已從單純依賴制程工藝轉向先進封裝技術。當硅基芯片逼近物理極限,2.5D/3D堆疊技術通過Chiplet(芯粒)拆分與異構集成,成為突破光罩限制的核心路徑。而在這場技術革命中,玻璃基板封裝憑借其優異的物理特性——更大的封裝尺寸、更低的傳輸損耗、更強的抗翹曲能力,被視為替代硅中介層的關鍵材料。然而,玻璃通孔(TGV)技術作為玻璃基板封裝的“心臟”,仍面臨鉆孔工藝成熟度低、玻璃材料力學性能復雜等挑戰。西北工業大學先進電子封裝材料及結構研究中心教授龍旭提出的五點力學問題,直指TGV技術產業化的核心痛點。
一、玻璃本征特性:脆性材料下的熱機械應力危機
玻璃的脆性本質與低抗拉強度,使其在溫度劇烈變化的場景中(如回流焊或冷熱沖擊測試)極易產生熱機械應力。當玻璃基板與銅互連層因熱膨脹系數(CTE)不匹配(玻璃CTE約3-5 ppm/℃,銅約17 ppm/℃)時,界面處會形成分層或微裂紋。例如,臺積電CoWoS技術中硅中介層的CTE與芯片接近,而玻璃基板的CTE差異可能導致封裝結構在熱循環中失效。龍旭指出,這種失效模式在高頻通信(如5G毫米波)或車載雷達(77GHz)等嚴苛環境中尤為突出,需通過材料改性(如添加低CTE填料)或界面優化(如梯度過渡層)緩解應力集中。
二、電遷移失效:高電流密度下的“隱形殺手”
TGV互連結構在高電流密度下易發生電遷移(EM)失效。電流集中于RDL(重布線層)-TGV交界及異質界面處,受電-熱-力耦合作用加速,導致銅原子遷移形成空洞,最終演變為裂紋并擴展。例如,三星I-cube技術中HBM與邏輯芯片的TSV互連已面臨電遷移挑戰,而TGV的玻璃-銅界面因玻璃的絕緣性可能進一步加劇電流集中。龍旭強調,需通過優化銅籽晶層沉積工藝(如化學鍍替代物理濺射)或引入阻擋層(如TaN)抑制電遷移。
三、熱力荷載:裂紋敏感性與界面應力失配
玻璃基體在熱載荷下易產生裂紋,尤其是大直徑TGV(如>100μm)會顯著提高裂紋敏感性。實驗表明,升溫速率每提高1倍,徑向裂紋形成概率呈指數增加。此外,玻璃與銅的彈性模量差異(玻璃約70 GPa,銅約110 GPa)導致熱變形不匹配,引發界面應力集中。龍旭團隊研究發現,通過降低升溫速率(如從10℃/s降至1℃/s)或采用低應力RDL設計(如柔性聚酰亞胺替代剛性銅),可有效減少裂紋風險。
四、TGV-RDL互連:高頻應用下的信號完整性挑戰
在高頻(如>28GHz)或大電流密度場景中,TGV的側壁粗糙度、通孔錐度對信號完整性影響顯著。粗糙度增大會導致插入損耗增加0.5dB/cm以上,錐度過大則可能引發阻抗不連續。例如,云天半導體在77GHz汽車雷達AiP(封裝天線)中,通過優化濕法刻蝕工藝將側壁粗糙度控制在50nm以下,使信號損耗降低40%。龍旭指出,需結合電磁仿真優化TGV幾何參數,并采用化學機械拋光(CMP)降低表面粗糙度。
五、制造加工缺陷:激光鉆孔與微裂紋的“雙刃劍”
玻璃的脆性特性使其在激光鉆孔、砂噴等加工過程中易引入微裂紋、孔周應力集中。例如,沃格光電在3μm孔徑、150:1深徑比的TGV制造中,通過脈沖激光參數優化(如降低單脈沖能量、提高重復頻率)將微裂紋率從15%降至3%以下。龍旭建議,采用超快激光(如皮秒/飛秒激光)替代傳統納秒激光,可減少熱影響區,同時結合后處理工藝(如氫氟酸緩沖液清洗)去除表面損傷層。
產業化破局:從實驗室到量產的跨越
盡管挑戰重重,TGV技術已在全球范圍內加速落地。臺積電與日月光已搭建玻璃基板工程生產線,三星計劃2028年將玻璃中介層應用于芯片封裝,而國內沃格光電、東旭集團等企業已在高密度互連、高頻集成等領域取得突破。例如,沃格光電的4層玻璃基板堆疊技術已適配AI芯片3D封裝需求,云天半導體的77GHz汽車雷達AiP通過TGV-RDL協同設計,使誤報率下降50%。在設備領域,Manz亞智科技是全球領先的半導體封裝設備制造商,在TGV技術及玻璃基板應用上成果斐然。憑借RDL領域積累,成功將RDL工藝用于玻璃基板,達成高密度、窄線寬線距芯片封裝。其高密度玻璃通孔技術,能在不同類型、厚度玻璃基板上精準制備高縱深比、高真圓度(>95%)的TGV結構,保障信號傳輸穩定可靠,滿足高性能計算領域需求。針對不同厚度基板,開發定制化溫控系統與專屬藥液配方,解決厚基板加工孔徑偏差問題,提升均勻性。此外,公司已向多家國際大廠交付不同尺寸板級封裝RDL量產線,推動TGV技術邁向規模化生產。
龍旭教授的五大力學問題,為TGV技術產業化指明了方向:通過材料創新(如低CTE玻璃復合材料)、工藝優化(如超快激光加工)、設計協同(如電磁-熱-力多物理場仿真)解決玻璃本征缺陷;通過標準化測試方法(如X射線3D成像、高頻電阻率測量)提升良率。隨著6G通信、智能汽車、空間通信等高頻需求爆發,TGV技術有望從“備選方案”升級為“主流選擇”,為芯片封裝開辟一條更高效、更可靠的路徑。
在這場技術革命中,玻璃基板不再是“沉默的配角”,而是通過TGV技術成為連接未來的“信息高速公路”。正如龍旭所言:“玻璃的力學性能問題,本質是材料科學與工程技術的博弈。解決這些問題,TGV技術將真正釋放其潛力,推動芯片封裝進入玻璃時代。”
審核編輯 黃宇
-
芯片封裝
+關注
關注
13文章
614瀏覽量
32261
發布評論請先 登錄
【新啟航】《超薄玻璃晶圓 TTV 厚度測量技術瓶頸及突破》

善思創興薄膜力學斷層掃描測試儀:聚焦鋰電池材料檢測,解決行業核心測試痛點
柔性屏彎折試驗機如何推動UTG超薄玻璃和鉸鏈技術發展

「行業動態」玻璃基技術:透明基板上的中國智造革命
TGV技術:推動半導體封裝創新的關鍵技術




 TGV產業發展:玻璃通孔技術如何突破力學瓶頸?
TGV產業發展:玻璃通孔技術如何突破力學瓶頸?

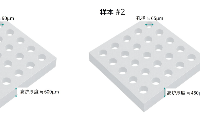



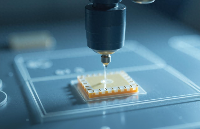

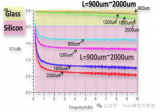
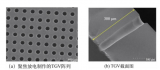



評論