通訊計算卡BGA四角填充加固膠應用案例由漢思新材料提供
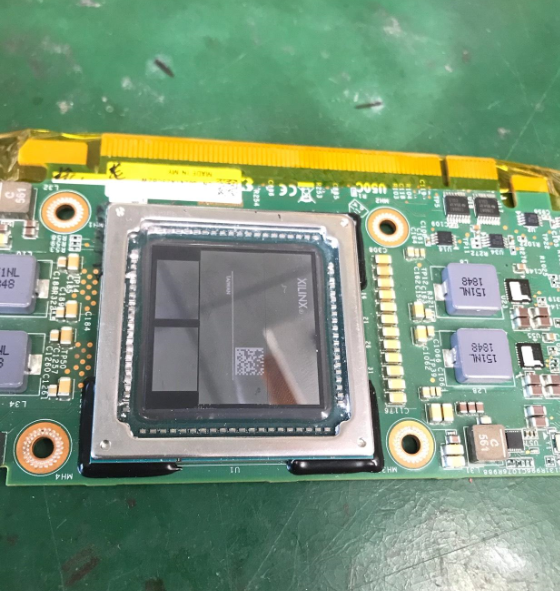
客戶產品:通訊計算卡
用膠部位:通訊計算卡BGA四角填充加固
芯片尺寸 :50*50mm 錫球高度:3.71mm 錫球間距:1.00mm 錫球數量:2000顆 錫球大小:0.25mm
用膠目的:粘接、固定,抗震動。
施膠工藝:簡易型點膠機
固化方式:接受150度7~8分加熱固化
顏色:無要求
換膠原因:新項目研發。
客戶用膠要求:
a.主芯片較大與板之間的應力,緩解外應力
b.主芯片持續性工作溫度100度,要求緩解熱應力,耐高溫沖擊
c.要求膠水可返修和超強粘接力
漢思新材料推薦用膠:
經過漢思工作人員和客戶詳細溝通對接,推薦底部填充膠HS710給客戶測試。
聲明:本文內容及配圖由入駐作者撰寫或者入駐合作網站授權轉載。文章觀點僅代表作者本人,不代表電子發燒友網立場。文章及其配圖僅供工程師學習之用,如有內容侵權或者其他違規問題,請聯系本站處理。
舉報投訴
-
芯片
+關注
關注
463文章
54007瀏覽量
465949 -
BGA
+關注
關注
5文章
584瀏覽量
51525 -
計算卡
+關注
關注
0文章
16瀏覽量
4427
發布評論請先 登錄
相關推薦
熱點推薦
漢思新材料:電路板IC加固環氧膠選擇與應用
在電路板制造與運維過程中,IC(集成電路)作為核心部件,其固定可靠性直接決定設備的穩定性與使用壽命。環氧膠因具備優異的粘接強度、耐環境性及電氣絕緣性能,成為IC加固的首選材料。一、環氧膠適配IC

在芯片封裝保護中,圍壩填充膠工藝具體是如何應用的
圍壩填充膠(Dam&Fill,也稱Dam-and-Fill或圍堰填充)工藝是芯片封裝中一種常見的底部填充(Underfill)或局部保護技術,主要用于對芯片、焊點或敏感區域提供機械支撐

5G通信模組和gps天線封裝加固用什么膠
5G通信模組和gps天線封裝加固用什么膠在5G通信模組和GPS天線封裝加固中,需根據具體應用場景,工作環境、結構特點及性能要求選擇適配的膠粘劑,以下是不同場景下的膠水推薦及分析:5G通信模組和gps

漢思新材料:芯片底部填充膠可靠性有哪些檢測要求
芯片底部填充膠可靠性有哪些檢測要求?芯片底部填充膠(Underfill)在先進封裝(如FlipChip、CSP、2.5D/3DIC等)中起著至關重要的作用,主要用于緩解焊點因熱膨脹系數

漢思底部填充膠:提升芯片封裝可靠性的理想選擇
解決方案,在半導體封裝領域占據了重要地位。底部填充膠主要用于BGA(球柵陣列)、CSP(芯片級封裝)和FlipChip(倒裝芯片)等先進封裝工藝中,通過填充芯片與

漢思新材料:底部填充膠可靠性不足如開裂脫落原因分析及解決方案
底部填充膠(Underfill)在電子封裝(尤其是倒裝芯片、BGA、CSP等)中起著至關重要的作用,它通過填充芯片與基板之間的間隙,均勻分布應力,顯著提高焊點抵抗熱循環和機械沖擊的能力

漢思新材料:底部填充膠二次回爐的注意事項
底部填充膠(Underfill)是一種在電子組裝中用于增強焊點可靠性的工藝,特別是在倒裝芯片封裝中。針對底部填充膠(Underfill)進行二次回爐(通常發生在返修、更換元件或后道工序

漢思新材料HS711板卡級芯片底部填充封裝膠
漢思新材料HS711是一種專為板卡級芯片底部填充封裝設計的膠水。HS711填充膠主要用于電子封裝領域,特別是在半導體封裝中,以提供機械支撐、應力緩沖和保護芯片與基板之間的連接免受環境因素的影響。漢思

漢思新材料:車規級芯片底部填充膠守護你的智能汽車
看不見的"安全衛士":車規級芯片底部填充膠守護你的智能汽車當你駕駛著智能汽車穿越顛簸山路時,當車載大屏流暢播放著4K電影時,或許想不到有群"透明衛士"正默默

無人機控制板與遙控器板BGA芯片底部填充膠加固方案
無人機控制板與遙控器板BGA芯片底部填充膠加固方案方案提供方:漢思新材料無人機應用趨勢概覽隨著科技的飛速發展,無人機已廣泛應用于航拍、農業監測、物流配送、緊急救援等多個領域,成為現代生
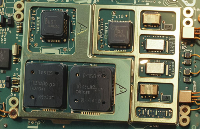



 通訊計算卡BGA四角填充加固膠應用案例
通訊計算卡BGA四角填充加固膠應用案例









評論