摘要
大直徑高質(zhì)量 SiC 襯底對提高 SiC 和 GaN 器件的良率、降低器件成本具有重要意義。然而,隨著單晶直徑的擴大,如何實現(xiàn)襯底片內(nèi)單晶質(zhì)量均勻性是亟需解決的問題之一。使用數(shù)值模擬軟件構(gòu)建了兩種生長模型并研究其溫場分布,模擬結(jié)果表明微凸溫場生長的晶體外形更加平整。對兩個批次的 6 英寸 ( 1 英寸= 2. 54 cm) SiC 單晶襯底分別進行了 ( 004) 面 X 射線搖擺曲線全圖掃描,評價了襯底結(jié)晶質(zhì)量,并在襯底上進行了 GaN 外延生長。結(jié)果表明,采用結(jié)晶質(zhì)量好且均勻的 SiC 單晶襯底,外延生長的 GaN 質(zhì)量更高。
0引言
半導(dǎo)體材料作為信息產(chǎn)業(yè)的基石,被廣泛用于集成電路、電力電子器件和微波射頻器件的制備。所謂“一代材料決定一代器件”,以硅 ( Si)、砷化鎵 ( GaAs) 為代表的第一、二代半導(dǎo)體材料,其器件特性目前已逼近材料的物理極限。
碳化硅( SiC) 材料具有禁帶寬度大、飽和電子速度高、臨界擊穿電場強度高、熱導(dǎo)率高等特性,其品質(zhì)因子優(yōu)異,在高溫、高頻、大功率及抗輻射領(lǐng)域獲得了廣泛應(yīng)用。近年來,SiC 產(chǎn)業(yè)在國內(nèi)外均成為科技戰(zhàn)略布局熱點,極大地促進了 SiC 單晶制備技術(shù)的發(fā)展。高質(zhì)量、大直徑 SiC 單晶有利于提高器件良率、降低器件成本,是未來 SiC 單晶發(fā)展的方向。目前國外 6 英寸 ( 1 英寸= 2. 54 cm) SiC 襯底已成為主流產(chǎn)品,國內(nèi)商業(yè)化 SiC 襯底直徑正處于 4 英寸向 6 英寸過渡階段。
SiC 單晶材料的制備方法主要有物理氣相傳輸( PVT ) 法、溶液法和高溫化學(xué)氣相沉積( HTCVD) 法。其中 PVT 法是技術(shù)成熟度最高、應(yīng)用最廣泛的方法。
在該方法中,一般采用中頻感應(yīng)加熱系統(tǒng),SiC 在超過 2 000 ℃的密閉石墨坩堝內(nèi)進行生長,整個生長體系類似“黑盒子”,無法對坩堝內(nèi)溫度場和生長過程進行直接觀察和測量,只能通過晶體的外形推測溫場分布情況。隨著 SiC單晶直徑增大,中頻感應(yīng)的“趨膚效應(yīng)”使晶體生長前沿徑向溫度梯度增大,導(dǎo)致大直徑 SiC 晶體中的應(yīng)力增大,晶體結(jié)晶質(zhì)量不均勻,劣化晶體質(zhì)量。因此生長結(jié)晶質(zhì)量均勻的大直徑 SiC 單晶,單晶生長的裝配設(shè)計工作尤為重要。
本文借助 Virtual Reactor-PVT SiCTM軟件開展了6 英寸 SiC 單晶生長溫場及流場研究。加入三代半交流群,加vx:tuoke08。采用高分辨X 射線衍射儀研究了兩個批次 SiC 單晶質(zhì)量均勻性,并在制備的 SiC 襯底上進行了 GaN 異質(zhì)外延,驗證了 SiC 結(jié)晶質(zhì)量和均勻性對 GaN 外延層質(zhì)量的影響。
1工藝實驗
1. 1 Virtual Reactor-PVT SiCTM數(shù)值模擬
Virtual Reactor-PVT SiCTM是一款基于有限元算法的專門應(yīng)用于 PVT 生長 SiC 單晶的數(shù)值模擬軟件。該軟件的計算原理是: 根據(jù)麥克斯韋方程組,計算感應(yīng)加熱體系內(nèi)各點的電場強度和磁場強度;根據(jù)坡印亭定理,求得坩堝各點的電阻熱量。石墨坩堝加熱后,其熱量會向坩堝內(nèi)部傳遞,形成 SiC單晶生長的溫度場。熱量的傳遞主要包括: 固態(tài)介質(zhì)中的熱傳導(dǎo)、氣態(tài)介質(zhì)中的熱傳導(dǎo)和對流、固氣界面上的熱輻射三部分。圖 1 為 SiC 單晶生長模型示意圖。通過對生長系統(tǒng)建立模型,設(shè)定初始條件及指定某一設(shè)定點溫度,軟件將根據(jù)系統(tǒng)配置的物理屬性對熱量的傳遞進行自動計算,求得 SiC晶體生長的溫度場。
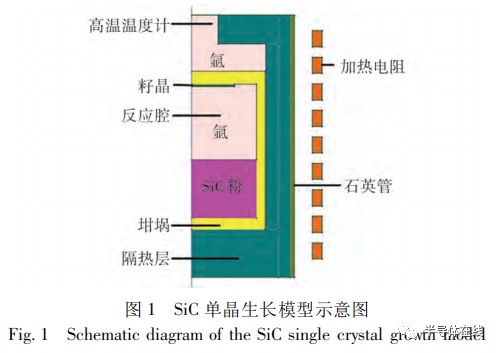
1. 2 6英寸SiC單晶表征及外延實驗
采用高分辨 X 射線衍射儀對兩個批次 6 英寸4H-SiC 單晶襯底 (004) 面進行搖擺曲線測試,評價其結(jié)晶質(zhì)量。在相同條件下,對 6 英寸 SiC 襯底進行 GaN 異質(zhì)外延生長,得到 GaN 外延薄膜。采用高分辨 X 射線衍射儀分別對 GaN 外延層的(002) 和 ( 102) 面進行對稱衍射和斜對稱衍射,比較兩個批次的 SiC 襯底外延 GaN 結(jié)晶質(zhì)量,研究襯底結(jié)晶均勻性對 GaN 外延質(zhì)量的影響。
2結(jié)果與分析
2. 1不同溫場及流場模擬
目前 SiC 單晶生長通常采用中頻感應(yīng)電源的加熱模式,生長腔內(nèi)存在溫度梯度。一般而言,生長腔內(nèi)的軸向溫度梯度決定了晶體的生長速率,而籽晶表面的徑向溫度梯度與晶體中的熱應(yīng)力有關(guān)。籽晶表面的徑向溫度梯度太小,則容易在晶體邊緣產(chǎn)生多晶,多晶與單晶競爭生長,不利于單晶尺寸的擴大; 而籽晶表面的徑向溫度梯度太大,會在晶體生長過程中產(chǎn)生較大的熱應(yīng)力,造成晶體應(yīng)力偏大,容易開裂。本文中構(gòu)建了兩種不同的生長模型,分別簡稱模型 A 和模型 B,設(shè)定主要初始參數(shù): 籽 晶 溫 度 為 2 400 ℃,生 長 壓 強 20 mbar( 1 mbar = 100 Pa) ,中頻電源頻率 10 kHz,生長時間 100 h,分析了兩種不同生長模型中的溫場分布和晶體生長情況。
為了便于直觀比較兩種模型的溫場分布,將模型 A 和模型 B 的溫度刻度線設(shè)置為相同的范圍和步長,由此可以通過等溫線的密集程度判斷溫場分布。圖 2 示出了模型 A 中的溫場分布圖和晶體生長示意圖,圖中 t 為生長溫度,X 為晶圓直徑。從圖 2 ( a) 中可以看出,模型 A 生長體系的高溫區(qū)接近料底部,料內(nèi)的等溫線分布稀疏; 從圖 2 ( b)中可以看出,生長的 SiC 單晶中心厚度明顯比晶體邊緣厚,晶體凸度為 14. 6 mm。晶體凸度較大與生長前沿的溫場分布有關(guān)。為了進一步量化模型 A 中的溫場分布情況,從溫場中提取相關(guān)數(shù)據(jù),描繪出生長前沿徑向溫度分布、生長腔內(nèi)軸向溫度分布、料內(nèi)軸向溫度分布和料表面徑向溫度分布,如圖3所示,圖中x1~x4分別為生長前沿徑向距離、生長腔內(nèi)軸向距離、料內(nèi)軸向距離以及料表面徑向距離。從圖 3 ( a) 中可以看出,籽晶中心到籽晶邊緣的溫度基本呈線性增加,徑向溫度差約為 12 ℃; 圖 3( b) 表明,生長腔內(nèi)越靠近料表面溫度變化越緩慢,越靠近籽晶溫度變化越明顯,生長腔內(nèi)的軸向溫度差為約 17 ℃; 通過圖 3 ( c) 可以看出,料內(nèi)軸向方向的最高溫基本處于料中間位置,這表明晶體生長過程中,一部分料會向生長腔內(nèi)傳輸,一部分料會向坩堝底部傳輸; 圖 3 ( d) 展示了料表面徑向溫度分布,可以看出靠近坩堝壁的溫度最高,而位于中心位置的 SiC 料溫度最低,料表面徑向溫度差約為 18 ℃。造成這種差異主要與中頻感應(yīng)的加熱模式的趨膚效應(yīng)有關(guān)。

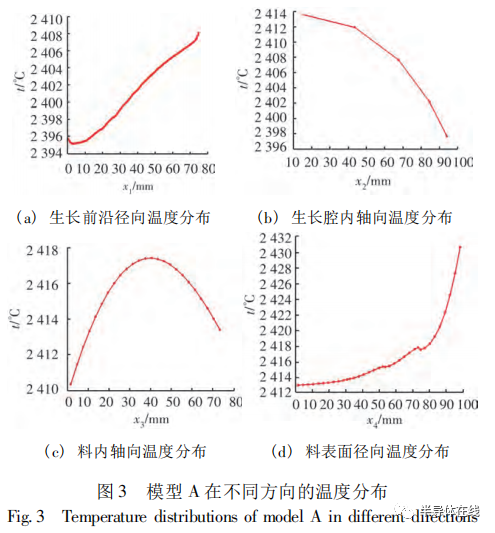
圖 4 示出了模型 B 中的溫場分布圖和晶體生長示意圖。從圖 4 ( a) 中可以看出,模型 B 生長體系的料內(nèi)的等溫線比模型 A 中的密集,表明料內(nèi)的溫度梯度變大; 從圖 4 ( b) 中可以看出,生長的SiC 單晶面形較為平整,晶體凸度為 5. 4 mm。說明籽晶生長前沿的溫度場相對較平。圖 5 ( a) 中可以看出,籽晶中心到籽晶邊緣的溫度盡管略有增加,但溫度差僅約為 6 ℃,明顯小于模型 A 中的籽晶表面徑向溫度差; 圖 5 ( b) 表明生長腔內(nèi)的軸向溫度差約為 14 ℃,基本與模型 A 中的生長腔內(nèi)溫度差一致; 通過圖 5 ( c) 可以看出,料內(nèi)軸向方向的最高溫基本處于料底部,高溫區(qū)位置比模型 A中相對靠下; 圖 5 ( d) 表明,料表面徑向溫度差約為 21 ℃,略大于模型 A 中料表面徑向溫度差。


通過對比模型 A 與模型 B 中的溫場分布,如表 1 所示,可以看出模型 A 生長前沿溫度場為典型的凸溫場,而模型 B 生長前沿的溫度場為典型的***溫場。根據(jù)晶體生長理論,凸溫場會導(dǎo)致晶體生長過程中產(chǎn)生較大的熱應(yīng)力,容易在晶體中產(chǎn)生晶格畸變和位錯等缺陷,劣化晶體的質(zhì)量。因此推測模型 B 中的溫場更適合生長高質(zhì)量 6 英寸 SiC 單晶。

2. 2 6英寸SiC襯底表征
采購了兩個批次 6 英寸 SiC 襯底,分別命名為批次 I 和批次 II。為了評價不同批次間的襯底結(jié)晶質(zhì)量,采用高分辨 X 射線衍射儀對兩個批次 SiC 襯底分別進行了 (004) 面對稱衍射搖擺曲線測試。測試前首先對樣品中心點進行優(yōu)化測試,獲得樣品中心點的最優(yōu)俯仰角。然 后 分 別 沿< 1120 >和<1100>兩個方向?qū)M行全圖掃描,研究晶片不同區(qū)域搖擺曲線的衍射角和半峰寬的變化,評價襯底結(jié)晶質(zhì)量均勻性。批次 I 和批次 II 的 SiC 襯底(004) 面搖擺曲線全圖掃描結(jié)果分別如圖 6 和圖 7所示。從圖 6 中可以看出,批次 I 中的 SiC 襯底<1120>和<1100>方向衍射角度變化分別為0. 880°和0. 577°,半峰寬分別為 84 "和 102 ",說明該晶片 (004) 面衍射角變化大; 半峰寬在不同區(qū)域波動大,晶片結(jié)晶質(zhì)量不均勻。從圖 7 中可以看出,批次 II 的 SiC 襯底<1120>和<1100>方向衍射角度變化分別為0. 060°和0. 027°,半峰寬分別為 40"和42 ",說明該晶片不同區(qū)域的 (004) 衍射角度變化不大,結(jié)晶質(zhì)量高、結(jié)晶質(zhì)量均勻。推測造成兩個批次襯底結(jié)晶質(zhì)量不一致的原因可能與 SiC 單晶生長的溫場不同有關(guān),凸溫場導(dǎo)致晶體中應(yīng)力大,造成了 SiC 晶面彎曲。

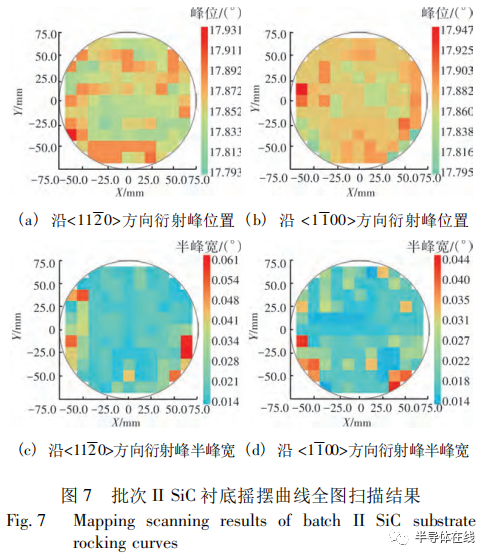
2. 3 6英寸SiC襯底GaN外延表征
對兩個批次 SiC 襯底分別在相同條件下進行GaN 異質(zhì)外延,并對 GaN (002) 和 ( 102) 面進行搖擺曲線全圖掃描測試。測試結(jié)果如圖 8 所示。可以看出批次 I 的 SiC 襯底外延 GaN (002) 和102) 面搖擺曲線半峰寬分別為 235 "~ 260"和293 "~ 333 ",批 次 II 的 SiC 襯 底 外 延 的 GaN(002) 和 ( 102) 面搖擺曲線半峰寬分別為 152 "~160"和 255 "~ 270",批次 II 的 SiC 襯底外延 GaN的晶體質(zhì)量明顯優(yōu)于批次 I 的 SiC 襯底外延 GaN。由此可以推斷 SiC 襯底結(jié)晶的均勻性對 GaN 外延層質(zhì)量有較大影響,襯底結(jié)晶質(zhì)量越高、越均勻,外延層的質(zhì)量越高。
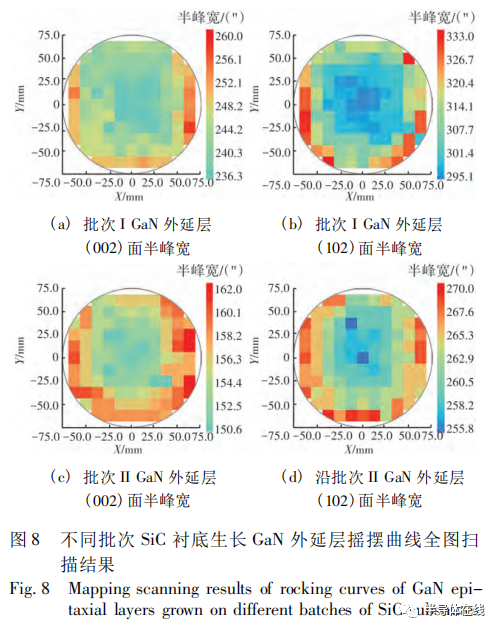
3 結(jié)論
本文利用數(shù)值模擬軟件構(gòu)建了兩種 6 英寸 SiC單晶生長模型,通過理論計算表明平溫場中生長的SiC 單晶面形平整,應(yīng)力較小。對兩批次 6 英寸SiC 襯底進行了 X 射線 (004) 面搖擺曲線全圖掃描測試,研究了其結(jié)晶質(zhì)量及其均勻性。在 SiC 襯底上外延了 GaN 材料,通過對外延層進行 (002)和 ( 102) 面搖擺曲線測試,表明 SiC 襯底對 GaN外延層質(zhì)量有重要影響,襯底結(jié)晶質(zhì)量越高、結(jié)晶質(zhì)量越均勻,有助于獲得高質(zhì)量 GaN 外延層。
審核編輯 :李倩
-
半導(dǎo)體材料
+關(guān)注
關(guān)注
11文章
577瀏覽量
30850 -
SiC
+關(guān)注
關(guān)注
32文章
3720瀏覽量
69388 -
GaN
+關(guān)注
關(guān)注
21文章
2366瀏覽量
82244
原文標題:6 英寸 SiC 單晶質(zhì)量對 GaN 外延薄膜的影響
文章出處:【微信號:cetc45_wet,微信公眾號:半導(dǎo)體工藝與設(shè)備】歡迎添加關(guān)注!文章轉(zhuǎn)載請注明出處。
發(fā)布評論請先 登錄
士蘭微電子迎來雙線里程碑:8英寸碳化硅產(chǎn)線通線, 12英寸高端模擬芯片產(chǎn)線同步開工

12英寸碳化硅外延片突破!外延設(shè)備同步交付
構(gòu)建CNN網(wǎng)絡(luò)模型并優(yōu)化的一般化建議
兩種散熱路徑的工藝與應(yīng)用解析
6英寸磷化銦(InP)工藝重大突破,光芯片成本降超30%

臺積電戰(zhàn)略收縮:兩年內(nèi)逐步關(guān)停6英寸晶圓產(chǎn)線
MOCVD技術(shù)丨實現(xiàn)6英寸藍寶石基板GaN基LED關(guān)鍵突破

12英寸碳化硅襯底,會顛覆AR眼鏡行業(yè)?
晶越半導(dǎo)體研制出高品質(zhì)12英寸SiC晶錠
一文詳解外延生長技術(shù)
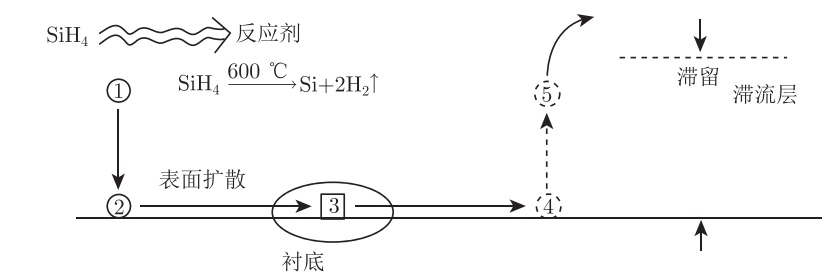
兩種感應(yīng)電機磁鏈觀測器的參數(shù)敏感性研究
12英寸SiC,再添新玩家
TSSG法生長SiC單晶的原理
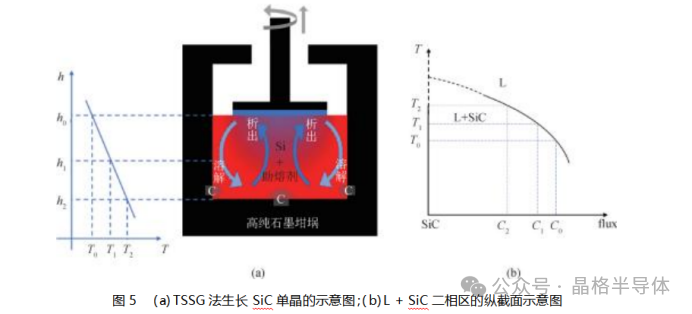
我國首發(fā)8英寸氧化鎵單晶,半導(dǎo)體產(chǎn)業(yè)迎新突破!




 利用數(shù)值模擬軟件構(gòu)建了兩種6英寸SiC單晶生長模型
利用數(shù)值模擬軟件構(gòu)建了兩種6英寸SiC單晶生長模型





評論