最近光博會上看到一本關于光刻的小冊子,里面有一點內容,分享給大家。
關于光刻的原理、光刻設備、光刻膠的種類和選擇等。
開篇 光刻的原理

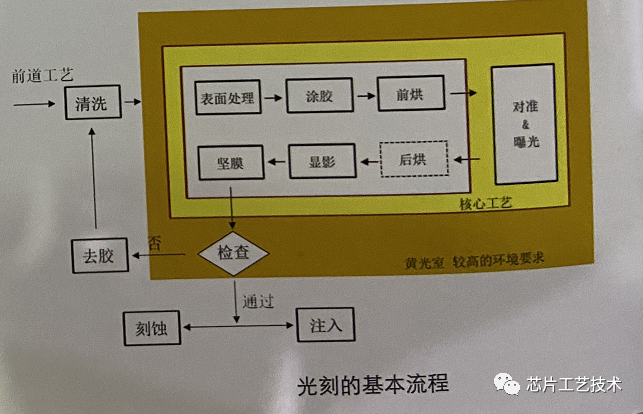
表面處理:一般的晶圓光刻前都需要清潔干凈,特別是有有機物的、顆粒的、會影響光刻膠的厚度。
涂膠:根據工藝要求,目前常用的兩種涂膠工藝,一個就是旋轉涂覆、一個就是噴涂。根據工藝要求和光刻膠的性能、可以有不同厚度的光刻膠。
前烘:就比較講究了,因為這東西肉眼看不見變化。只有最后出來光刻了才知道好壞,有時候還不明顯。


上圖是曝光機的汞燈光源光譜圖。
關于曝光劑量的問題:
通常我們監控曝光機的光強,主要針對單一波長測量。比如常用的UV探測器測試的波段一般是365nm和436nm,有的光刻機帶有濾波片,可以選擇其中一個波段使用。比如有的光刻膠給的曝光量是針對365nm的,也有光刻膠給的是436nm的,因此再沒有加濾光片的前提下,計算曝光時間時是不能直接用曝光劑量除以光強的,但是也不是上文中的再除以2.5~3的樣子,在2~3的樣子,還要看具體的設備和汞燈的壽命使用情況。
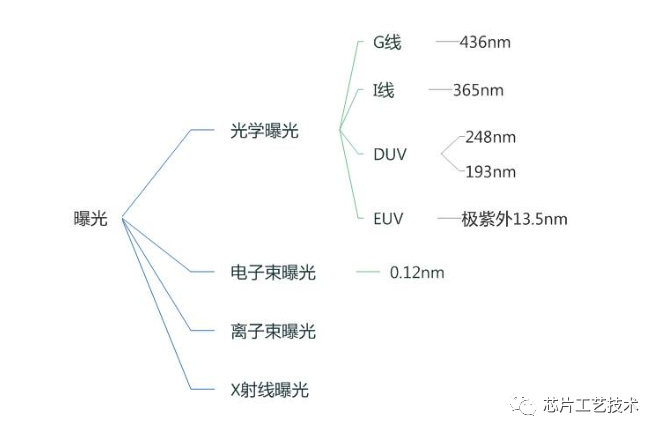
其他的曝光機根據曝光波段不同,分了很多種類型的曝光。

常用工藝和光刻膠選擇


編輯:jq
-
探測器
+關注
關注
15文章
2763瀏覽量
75895 -
光刻
+關注
關注
8文章
364瀏覽量
31339 -
光刻膠
+關注
關注
10文章
354瀏覽量
31779
原文標題:光刻知識點集合
文章出處:【微信號:dingg6602,微信公眾號:芯片工藝技術】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄

改善光刻圖形線寬變化的方法及白光干涉儀在光刻圖形的測量

改善光刻圖形垂直度的方法及白光干涉儀在光刻圖形的測量

ASML杯光刻「芯 」勢力知識挑戰賽正式啟動

MEMS制造領域中光刻Overlay的概念
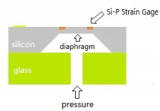
低含量 NMF 光刻膠剝離液和制備方法及白光干涉儀在光刻圖形的測量

為什么光刻要用黃光?
減少光刻膠剝離工藝對器件性能影響的方法及白光干涉儀在光刻圖形的測量

光刻工藝中的顯影技術
光刻膠剝離液及其制備方法及白光干涉儀在光刻圖形的測量




 關于光刻的原理、光刻設備等知識點集合
關于光刻的原理、光刻設備等知識點集合






評論