本次分享的3D封裝總共幾百種,包含常用元件封裝、插座封裝、排針座。比如:電阻,電容,晶體管、端子、模塊、傳感器、晶振、芯片等。
元器件的擺放也是一門美工藝術,先給大家看看板卡效果圖:
以下是免費分享給大家的3D封裝(其中一部分):








SSOP合集:
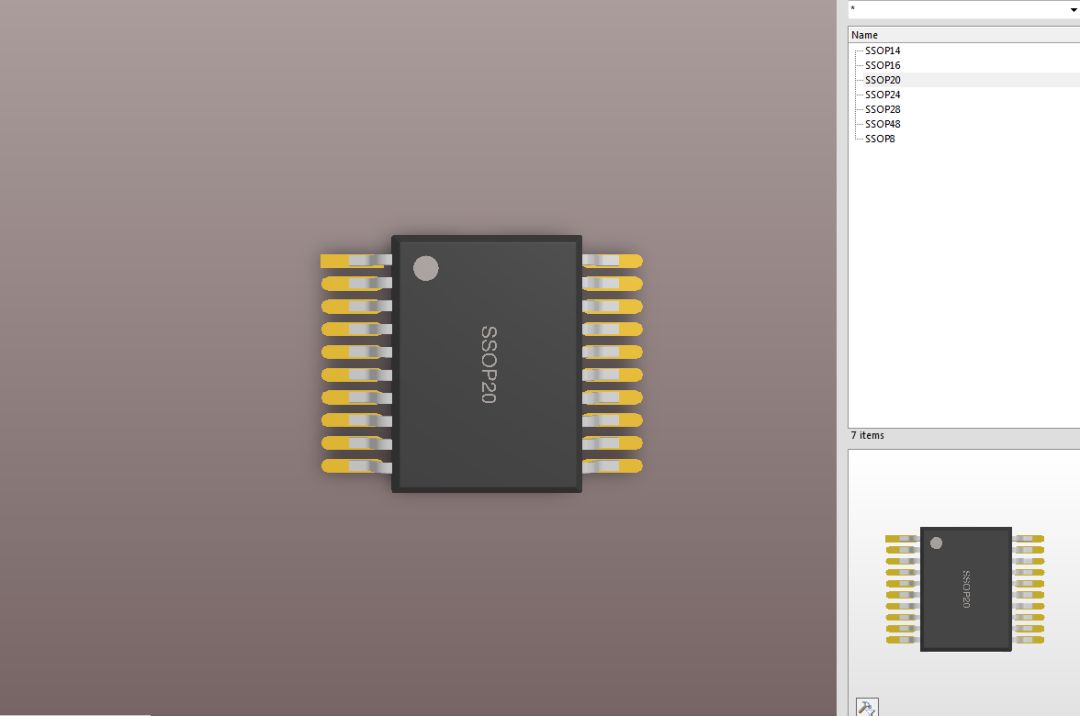
DIP合集:
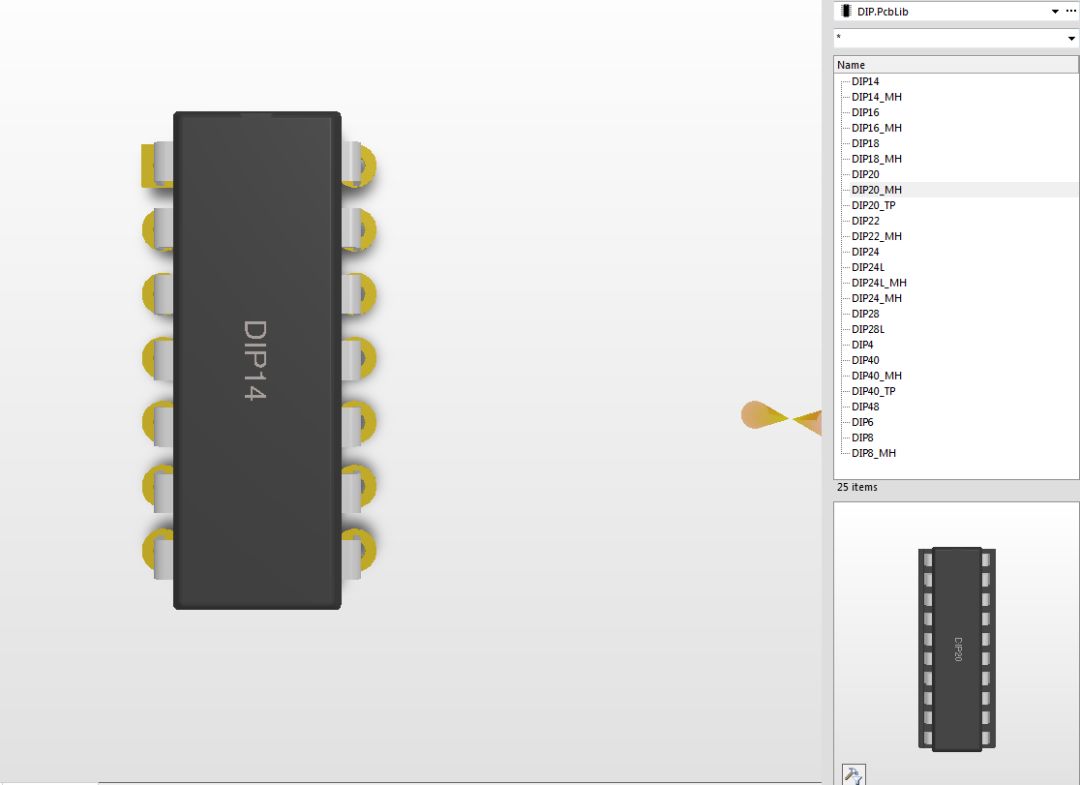
按鍵合集:

TO系列合集:

電源芯片合集:

LED合集:
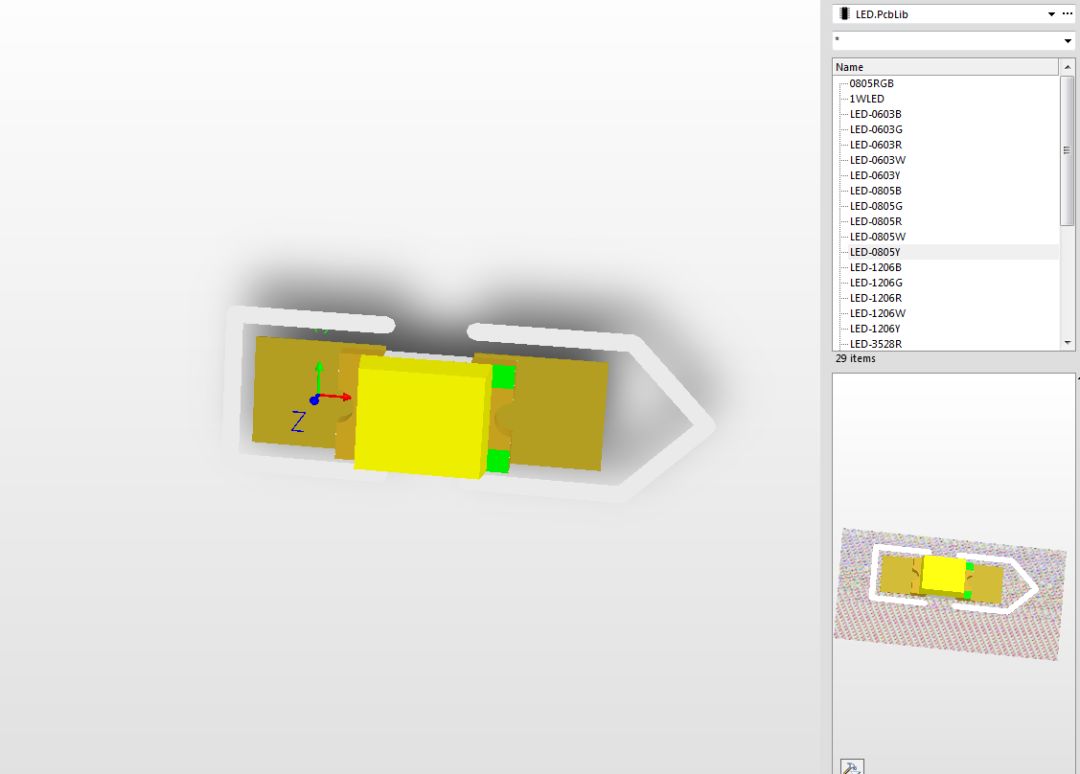
晶振合集:
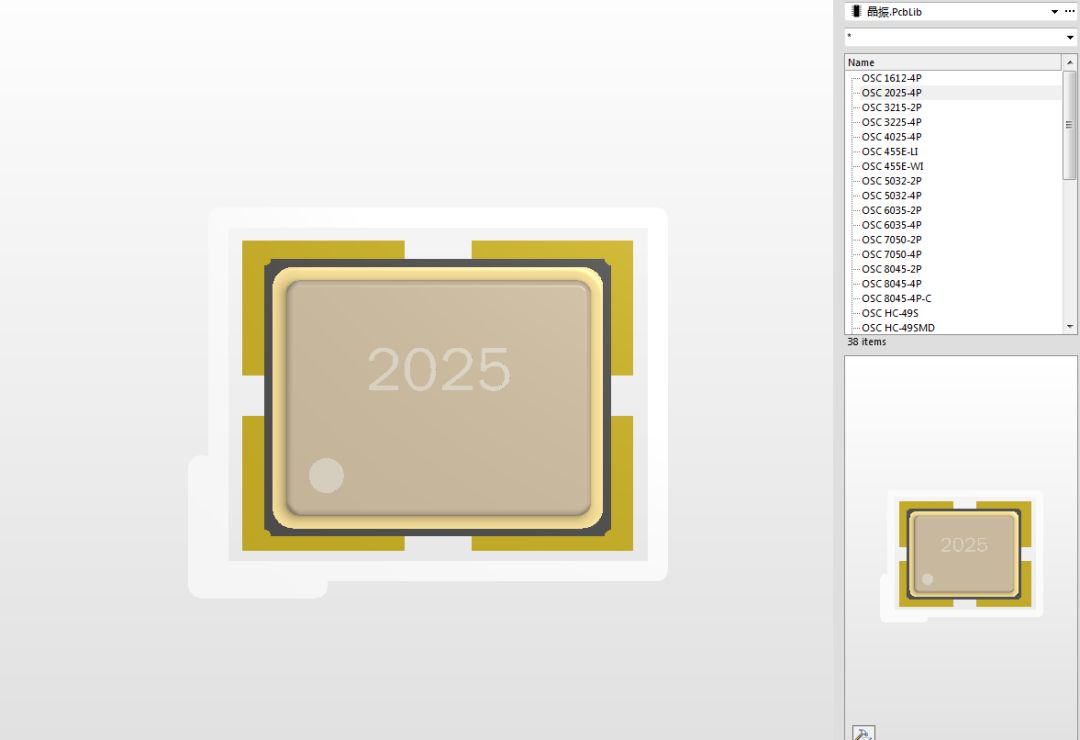
傳感器合集:

模塊合集:
聲明:本文內容及配圖由入駐作者撰寫或者入駐合作網站授權轉載。文章觀點僅代表作者本人,不代表電子發燒友網立場。文章及其配圖僅供工程師學習之用,如有內容侵權或者其他違規問題,請聯系本站處理。
舉報投訴
-
電阻
+關注
關注
88文章
5780瀏覽量
179512 -
封裝
+關注
關注
128文章
9249瀏覽量
148615 -
3D封裝
+關注
關注
9文章
149瀏覽量
28307
發布評論請先 登錄
相關推薦
熱點推薦
2D、2.5D與3D封裝技術的區別與應用解析
半導體封裝技術的發展始終遵循著摩爾定律的延伸與超越。當制程工藝逼近物理極限,先進封裝技術成為延續芯片性能提升的關鍵路徑。本文將從技術原理、典型結構和應用場景三個維度,系統剖析2D、2.5D

常見3D打印材料介紹及應用場景分析
3D打印材料種類豐富,不同材料性能差異明顯。本文介紹PLA、ABS、PETG等常見3D打印材料的特點與應用場景,幫助讀者了解3D打印用什么材料更合適,為選材提供基礎參考。

淺談2D封裝,2.5D封裝,3D封裝各有什么區別?
集成電路封裝技術從2D到3D的演進,是一場從平面鋪開到垂直堆疊、從延遲到高效、從低密度到超高集成的革命。以下是這三者的詳細分析:

【海翔科技】玻璃晶圓 TTV 厚度對 3D 集成封裝可靠性的影響評估
一、引言
隨著半導體技術向小型化、高性能化發展,3D 集成封裝技術憑借其能有效提高芯片集成度、縮短信號傳輸距離等優勢,成為行業發展的重要方向 。玻璃晶圓因其良好的光學透明性、化學穩定性及機械強度

玩轉 KiCad 3D模型的使用
“ ?本文將帶您學習如何將 3D 模型與封裝關聯、文件嵌入,講解 3D 查看器中的光線追蹤,以及如何使用 CLI 生成 PCBA 的 3D 模型。? ” ? 在日常的 PCB 設計中,

3D封裝的優勢、結構類型與特點
nm 時,摩爾定律的進一步發展遭遇瓶頸。傳統 2D 封裝因互連長度較長,在速度、能耗和體積上難以滿足市場需求。在此情況下,基于轉接板技術的 2.5D 封裝,以及基于引線互連和 TSV




 精心整理的3D封裝
精心整理的3D封裝









評論