來源:內容來自由半導體行業觀察翻譯自「semiwiki」,作者:Tom Dillinger,謝謝。
編者按:每年,臺積電都會在全球舉辦兩場大型客戶活動——春季臺積電技術研討會和秋季臺積電開放式創新平臺生態系統論壇。技術研討會最近在加州圣克拉拉舉行,廣泛介紹先進半導體和封裝技術發展的最新情況。本文簡要回顧了半導體工藝演示的要點,后續文章將回顧先進封裝的內容。
臺積電成立于1987年,自1994年以來一直舉辦年度技術研討會,今年是臺積電成立25周年(圣克拉拉會議中心普遍強調這一點)。臺積電北美總裁兼首席執行官Dave Keller表示:“第一屆硅谷研討會的與會者不足100人,而現在,出席人數已超過2000人。”
供公司發展總監Cheng-Ming Liu博士介紹了臺積電汽車客戶的獨特需求,特別是在更長的產品生命周期內的持續供應。他表示:
“我們對“舊”的工藝流程的承諾是堅定不移的。我們從未關閉過一家工廠,也從未關閉過一項工藝技術。”
研究與開發/技術開發高級副總裁Y.-J.Mii博士著重介紹了工藝技術發展的三個時代,如下圖所示:
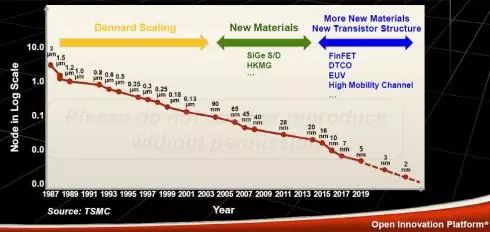
在第一階段,Dennard Scaling是指在后續的工藝節點中,將FEOL線性光刻尺寸按“s”(s < 1)的比率進行微縮,實現電路密度(1 / s^2)的提高(量度為gates / mm^2),下一階段的重點是材料的改進,而當前階段的重點是設計—技術的協同優化(馬上有更多介紹)。
在隨后的研討會上,集成互連和封裝研發副總裁DougYu博士介紹了先進封裝技術如何專注于微縮,盡管持續時間較短。 “十多年來,封裝還提供了再分布層(RDL)和凸點間距光刻的二維改進。借助我們今天所描述的多芯片、3D垂直堆疊封裝技術——特別是臺積電的SoIC產品,我們在電路密度方面取得了巨大的改善。S等于零。或者換句話說,我們實現了無限微縮。(實際上,很容易預見到產品技術將開始使用gates / mm^3進行度量。)
臺積電先進工藝技術現狀的簡要介紹
(一)N7/N7+(7nm/7nm+)
臺積電在兩年前的研討會上宣布了N7和N7 +工藝節點。
N7是“基線”的FinFET工藝,而N7+通過引入EUV光刻技術,為選定的FEOL層提供了更好的電路密度。設計IP從N7過渡到N7+需要重新部署,以實現1.2倍的邏輯門密度提高。主要亮點包括:
N7正在投產,2019年預計將有100多種新的流片(NTO)。
關鍵IP介紹:112Gbps PAM4 SerDes。
N7+受益于持續的EUV輸出功率(~280W)和uptime(~85%)的改善。臺積電表示:“雖然我們預計功率和uptime會進一步改善,但這些措施足以推動N7 +容量增長。”
臺積電專注于減少N7的缺陷密度(D0)。根據臺積電的說法,“在初始產量增加后,D0改進斜坡的速度比以前的節點快。”
臺積電展示了N7芯片尺寸的分裂:移動客戶<100 mm^2,HPC客戶>300 mm^2。
據我所知,臺積電還首次表示他們正專門為“大型芯片”追蹤D0,并報告說與其他N7產品相比,大型設計相對減少了學習。
N7+將于2009年下半年產量上升,并表現出與N7相當的D0缺陷率。
(二)讓5G成為現實
臺積電邀請高通首席技術官Jim Thompson介紹了他對N7的看法——這是一次非常有啟發性的演講:
“N7是5G的推動者,如我們最新的SnapDragon855版本所示。”
“具有256個天線單元的5G MIMO支持64個同步數字流(simultaneous digital streams),即16個用戶每個用戶在一部電話上接收4個數據流。”
“天線設計對于5G來說確實非常關鍵,可以克服路徑損耗和信號阻塞。人們正在尋求新的、創新的天線實施方案——歸根結底,這只是數學問題,盡管肯定是復雜的數學問題。”
“對于5G的采用率,肯定有很多人持懷疑態度。然而,5G的傳輸速度比4G快得多。在推出計劃中,只有5家運營商和3臺OEM設備支持4G,大部分在美國和韓國。目前,有超過20家運營商和20多家OEM設備專注于5G部署,包括歐洲、中國、日本和東南亞。”
“此外,不要忽視5G在消費類手機以外的應用中的部署,例如無線工廠自動化。與工業機器人的通信需要高帶寬、低延遲和極高的可用性。考慮一下5G帶來的在無線環境下制造靈活性的機會。”
(三)N6(6nm)
臺積電推出了一款新節點產品,名為N6。此節點具有一些非常獨特的特性:
與N7兼容的設計規則(例如,57 mm M1 pitch,與N7相同)
與N7兼容的IP模型
為有限的FEOL層提供EUV光刻,“比N7+多1個EUV層,充分利用了N7+和N5的學習經驗”
更嚴格的工藝控制,比N7更快的cycle time
同樣的EDA參考流程、填充算法等,與N7相同
N7設計可以簡單地“重新流片”(re-tapeout,RTO)到N6,以提高EUV掩模光刻的產量
或者,N7設計可以通過使用N6標準單元庫(H240)重新部署邏輯塊來提交新的流片(NTO),該庫利用單元之間的“公共PODE”(CPODE)設備將邏輯塊密度提高~18%。
2020年第一季度開始風險生產(圖示為13級金屬互連堆棧)
盡管設計規則與N7兼容,但N6還引入了一個非常獨特的功能“M0路由”。
下圖說明了“典型”FinFET器件layout,其中M0僅用作局部互連,用于連接multi-fin器件的源極或漏極節點,并在單元內用于連接通用nFET和pFET原理圖節點。
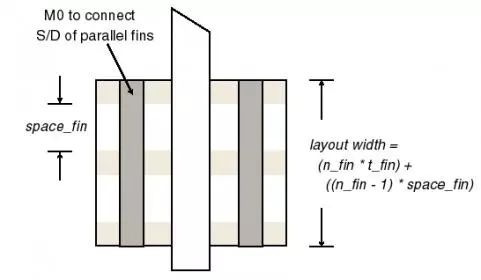
我需要更多地思考使用M0作為路由層的機會,臺積電表示EDA路由器對此功能的支持仍然是合格的。
在我看來,N6是臺積電引入“半節點”流程路線圖的延續,如下圖所示。
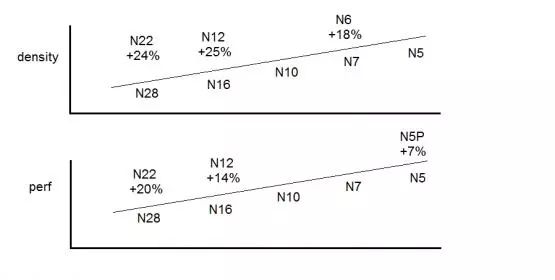
半節點工藝既是工程驅動的決策,也是業務驅動的決策,目的是提供低風險的設計遷移路徑,為現有N7設計提供一個降低成本的選項,作為一個“mid-life kicker”。
N6的引入也凸顯了一個問題,這個問題將變得越來越棘手。集成外部IP的設計的遷移取決于IP提供商的工程和財政資源,以便按照適當的時間表在新節點上開發、發布(在測試站點上)、表征IP并對其進行鑒定。N6提供了在不受外部IP釋放約束的情況下引入kicker的機會。
(四)N5(5nm)
工藝節點N5合并了額外的EUV光刻,以減少需要大量多重曝光處理的圖層的掩模數。
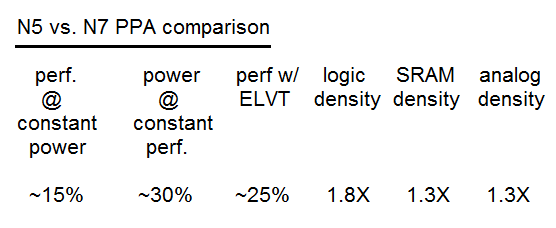
風險生產于19年3月開始,高產量增長將在2020年第二季度臺南Gigafab 18完成(19年3月完成的第1階段設備安裝)
旨在同時支持移動和高性能計算“平臺”客戶;高性能應用程序將希望使用新的“超低Vt”(ELVT)器件
1.5V或1.2V I / O器件支持
計劃提供N5P(“PLUS”)產品,在恒定功率下可提高+7%的性能,或在恒定perf 下比N5降低約15%的功率(N5后一年)
N5將使用高移動性(Ge)器件溝道
先進材料工程
除了N5推出高移動性溝道外,臺積電還強調了其他材料和器件工程更新:
超高密度MIM產品(N5),具有2X ff/um*2和2X插入密度
新型低K介電材料
金屬反應離子蝕刻(RIE),取代 Cu damascene,實現金屬間距<30um
石墨烯“cap”,降低Cu互連電阻率
改進的局部MIM電容將有助于解決由于較高的柵極密度而增加的電流。臺積電指出,高性能(高開關活動)設計可實現預期的個位數性能提升。
節點16FFC和12FFC都得到了器件工程改進:
16FFC+ :與16FFC相比,+10% perf @恒功率,+20%POWER@恒定perf
12FFC+ :與12FFC相比,+7% perf @恒功率,+15% POWER@恒定 perf
這些節點的NTO將在2019年第三季度被接受。
臺積電還簡要介紹了正在進行的未來節點材料研究的研發活動, 例如,Ge nanowire/nanoslab器件溝道,2D半導體材料(ZrSe2,MoSe2),請見下圖(來源:臺積電)。

Fab運營高級副總裁j.k Wang博士詳細討論了正在進行的降低DPPM和保持“卓越制造”的努力。特別值得注意的是為滿足汽車客戶苛刻的可靠性要求而采取的步驟。Wang博士演講的重點包括:
“自引入N16節點以來,我們在頭6個月加快了每個節點的產能提升速度。2019年N7的產能將超過每年100萬塊12英寸晶圓。自2017年以來,隨著Gigafab 15的第5至7階段已經投產,N10/N7產能增長了兩倍。”
“我們實施了積極的統計過程控制(在控制晶圓現場進行測量),以便及早發現、停止和修復過程的變化,例如基線測量的向上/向下偏移、方差偏移、工具之間的不匹配。我們建立了二維晶圓剖面測量標準,并對每個晶圓的‘驗收’剖面進行在線監測和比較。”
“N7的DDM降低率是所有節點中最快的。”
“對于汽車客戶,我們實施了獨特的措施,以實現苛刻的DPPM要求。我們會把壞區域中的好芯片標記出來。而且邊際批次會有SPC標準,它們會被廢棄。”
“我們將支持特定于產品的規格上限和下限標準。我們將報廢超出規格限制的晶圓,或保留整批晶圓進行客戶的風險評估。”(見下圖。資料來源:臺積電)
臺積電的不同技術平臺
臺積電開發了一種針對流程開發和設計支持功能的方法,主要關注四個平臺——移動、HPC、物聯網和汽車。汽車事業部總監Cheng-Min Lin博士介紹了該平臺的最新情況,以及汽車客戶的獨特特點。
(一)汽車平臺
Lin博士指出:“汽車系統既需要先進的ADAS邏輯技術,如N16FFC,也需要先進的V2X通信射頻技術。盡管從現在到2022年,汽車的復合年均增長率預計僅為1.8%,但半導體內容的復合年均增長率將為6.9%。
他繼續說:“L1/L2功能的使用率將達到30%左右,額外的MCU應用于安全、連接,以及電動/混合電動汽車功能。每輛車大約有30-40個單片機。”(在他的圖表中,預測L3/L4/L5的使用率在2020年約為0.3%,2025年為2.5%。)
“數字儀表板駕駛艙可視化系統的采用率也將提高,進一步推動半導體增長,2018年為0.2%,2025年達到11%。”
L2+
SAE International將自動駕駛輔助和最終自動駕駛的支持水平定義為“1級至5級”。也許是因為認識到實現L3到L5的困難,因此提出了一個新的“L2+”級別(盡管在SAE之外),帶有附加的攝像機和決策支持功能。
“L2+型汽車通常會集成6個攝像頭、4個短程雷達系統和1個遠程雷達單元,需要超過50GFLOPS圖形處理和>10K DMIPS導航處理吞吐量。”
N16FFC,然后是N7
16FFC平臺已通過汽車環境應用認證,例如SPICE和老化模型,基礎IP特性,非易失性存儲器,接口IP。N7平臺將于2020年通過(AEC-Q100和ASIL-B)認證。Lin博士表示:“汽車客戶往往落后消費者采用約2~3年來利用DPPM學習,盡管這一間隔正在縮短。我們預計N7汽車將在2021年被廣泛采用。”
“臺積電射頻CMOS產品將用于SRR、LRR和LIDAR。16FFC-RF增強型工藝將在2020年2季度符合合汽車平臺的要求。”
(二)物聯網平臺
臺積電物聯網平臺專注于低成本,低(有源)功耗和低泄漏(待機)功耗。物聯網業務開發總監Simon Wang博士提供了以下最新信息:
工藝流程路線圖
55ULP, 40ULP (w/RRAM): 0.75V/0.7V
22ULP, 22ULL: 0.6V
12FFC+_ULL: 0.5V (目標)
為22ULL節點引入新器件:EHVT器件,超低泄漏SRAM
22ULL SRAM是一種“雙VDD rail”設計,具有獨立的邏輯(0.6V,SVT+HVT)和bitcell VDD_min(0.8V)值,可實現最佳待機功耗。
22ULL節點還獲得非易失性存儲器的MRAM選項。
請注意,一種新的方法將被應用于低VDD設計的靜態時序分析。基于階段的OCV(降階乘法器,derating multiplier)單元延遲計算將使用自由變異格式(LVF)過渡到sign-off。
下一代物聯網節點將是12FFC+_ULL,風險生產將在2020年第二季度開始。(具有SVT低VDD標準單元, 0.5V VDD)
(三)射頻
臺積電強調了RF技術的過程開發重點,作為5G和汽車應用增長的一部分。RF和模擬業務開發總監Jay Sun博士重點介紹了以下要點:
對于RF系統收發器,22ULP / ULL-RF是主流節點。對于更高端的應用,16FFC-RF是合適的,其次是2020年下半年的N7-RF。
重要的器件研發正在研發,以增強這些節點的器件ft和fmax,期待2020年的16FFC-RF-Enhanced(fmax> 380GHz)和2021年的N7-RF-Enhanced。
新的頂級BEOL堆疊選項可用于“升高”的超厚金屬,用于電感器,使之具有更高的Q值。
對于低于6GHz的RF前端設計,臺積電將于2019年推出N40SOI——從0.18微米SOI過渡到0.13微米SOI,再過渡到N40SOI,以此提供ft和fmax大幅改進的器件。
先進封裝方面的表現
從研討會我們可以看得出,臺積電顯然已從一家“純”晶圓級代工廠轉型為復雜集成系統模塊的供應商——或者根據臺積電CEO C.C.Wei的說法,臺積電是“大規模納米生產創新”的領先供應商。這是多年研發投資的成果,例如,請參閱下文“SoIC”部分中關于3D堆疊的討論。
集成互連和封裝研發副總裁Doug Yu博士提供了詳細的最新信息。Yu博士將封裝技術分為獨特的類別——“前端”3D芯片集成(SoIC)和“后端”封裝進展(CoWoS, InFO)。此外,他還介紹了焊盤間距和 Cu pillar/ SnAg凸點光刻技術的進展,特別提到了汽車級可靠性要求。
(1)凸點(Bumping)技術
臺積電繼續推進凸點技術,可實現60-80um的凸點間距(適用于較小的芯片)。
(2)CoWos
臺積電最初的2.5D封裝產品是chip-on-wafer-on-substrate(CoWoS),它通過使內存“更接近處理器”,實現了非常高性能的系統集成。
?> 50種客戶產品
?臺積電正在開發“標準化”配置,例如,從具有2個或4個HBM的1個SoC,演變為具有8個HBM2E的2個以上SoC(96GB @ 2.5TB /秒)
相應地,臺積電將把最大2.5D中介層占用空間從1X光罩(~50x50)擴展到3X(~85x85),具有150um的凸點間距。
?硅中介層支持5個金屬層和(新)深溝道電容——請參見下圖。
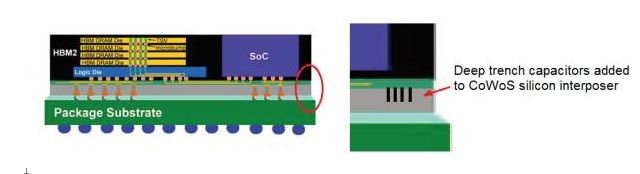
(3)InFo
臺積電繼續發展集成FanOut(InFO)封裝產品。回想一下,InFO是使用“重組晶圓”成型化合物集成(多個)芯片的手段,以提供用于RDL圖案化的封裝襯底。InFO以傳統的小封裝WLCSP技術為基礎,以實現(大面積)重分布互連和高凸點數——請參見下圖。
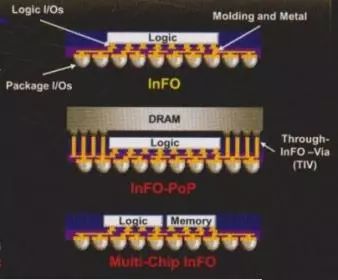
InFO-PoP支持在基極頂部堆疊邏輯芯片和DRAM芯片,使用through-InFO-vias(TIV)將DRAM連接到金屬層。InFO-PoP開發的重點是改善TIV的間距和縱橫比(垂直面與直徑)。
InFO-on-Substrate產品將(多芯片)InFO模塊連接到(大面積)基板,充分利用為CoWoS開發的多光罩綁結技術(multiple reticle stitching technology)。
(4)SoIC(“前端”3D集成)
研討會關于封裝的重要公告是介紹了“前端”3D芯片堆疊拓撲,稱為SoIC(System-on-Integrated Chips集成系統芯片)。
SoIC是一種多芯片之間的“無凸點”互連方法。如下圖所示(來自臺積電早期的一篇研發論文),來自基模的Cu焊盤和來自(變薄的)頂部芯片的裸露的Cu“nails”利用熱壓結合來提供電氣連接。(在 die-to-die接口也存在合適的底部填充材料。)
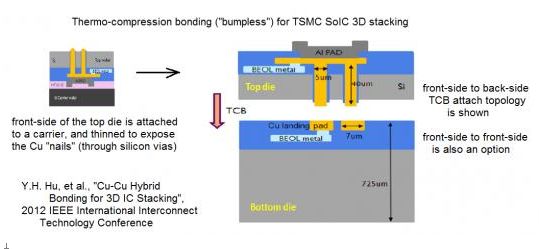
?芯片中的硅通孔提供連接,間距非常緊湊。
?支持face-to-face和face-to-back芯片連接。 “已知良好”的堆疊芯片可以是不同的尺寸,在堆疊層上具有多個芯片。
?臺積電展示了一個3高垂直SoIC 堆疊(3-high vertical SoIC stack)實體模型。
?EDA支持可用:物理設計(DRC、網絡列表/LVS)、寄生提取、時序、IR/EM分析、信號完整性/功率完整性分析、熱/材料應力分析。
?SOIC封裝產品的資格目標是2019年。(我從單獨的臺積電公告中了解到,SoIC的將在2021年量產。)
總結
幾年前,有人半猜測半開玩笑說,“只有7個客戶能負擔得起7nm設計,只有5個客戶能負擔得起5nm”。
顯然,N7/N6和N5在移動通信、HPC和汽車(L1-L5)應用中的發展勢頭打消了這種想法。臺積電正通過DTCO大力投資這些節點,充分利用EUV光刻領域的重大進展和新材料的引入。
另外,我們也看到,除了傳統的晶圓代工以外,臺積電的2.5D和InFO“后端”封裝產品都在不斷發展,重點是推出SoIC拓撲結構的緊密間距Cu壓接全3D堆疊芯片。可用的電路密度(mm ^3)將非常吸引人。然而,利用這項技術的挑戰相當大,從系統架構分區到堆疊芯片接口的復雜電氣/熱/機械分析,全都包括在內。
摩爾定律絕對具有活力,盡管需要戴上3D眼鏡才能看到。
-
芯片
+關注
關注
463文章
54007瀏覽量
465932 -
半導體
+關注
關注
339文章
30725瀏覽量
264037 -
機械
+關注
關注
8文章
1751瀏覽量
43607
發布評論請先 登錄
2025年半導體芯片技術多領域創新突破,應用前景無限
化圓為方,臺積電整合推出最先進CoPoS半導體封裝
看點:臺積電在美建兩座先進封裝廠 博通十億美元半導體工廠談判破裂
臺積電宣布逐步退出氮化鎵晶圓代工業務,力積電接手相關訂單




 關于臺積電半導體技術分享
關于臺積電半導體技術分享










評論